Estudio teórico y experimental sobre el diodo de barrera Schottky AlGaN / GaN en un sustrato de Si con doble heterounión
Resumen
Un diodo de barrera Schottky (SBD) AlGaN / GaN con doble heterounión se investiga teórica y experimentalmente en GaN / AlGaN / GaN / Si-sub. El gas de agujero bidimensional (2DHG) y el gas de electrones (2DEG) se forman en la interfaz GaN-top / AlGaN y AlGaN / GaN, respectivamente. En el estado desactivado, 2DEH y 2DHG se agotan parcialmente y luego desaparecen por completo. Quedan las cargas fijas de polarización positiva y negativa, que forman la unión de polarización. Por lo tanto, se obtiene un campo eléctrico plano en la región de deriva y un voltaje de ruptura alto (BV). Además, el ánodo está empotrado para reducir el voltaje de encendido ( V ACTIVADO ). El proceso de grabado ICP de bajo daño da como resultado contactos Schottky mejorados, una corriente de fuga baja y un V bajo. ACTIVADO es obtenido. El SBD fabricado exhibe un BV de 1109 V con una distancia de ánodo a cátodo ( L AC ) de 11 μm. Los SBD fabricados alcanzan un V bajo ACTIVADO de 0,68 V con buena uniformidad, una alta relación de corriente de encendido / apagado ∼ 10 10 a temperatura ambiente, una baja resistencia específica ( R ENCENDIDO, SP ) de 1,17 mΩ cm 2 y una alta figura de mérito (FOM) de Baliga de 1051 MW / cm 2 .
Introducción
El diodo lateral basado en heteroestructura AlGaN / GaN es un dispositivo atractivo debido a la alta movilidad electrónica del gas de electrones bidimensionales (2DEG), la alta velocidad de saturación de electrones y el alto campo eléctrico de ruptura [1, 2, 3]. Se han realizado grandes esfuerzos para lograr un voltaje de encendido bajo ( V ACTIVADO ), una baja corriente de fuga inversa y una alta tensión de ruptura (BV) para los diodos de GaN utilizados en convertidores e inversores para fuentes de alimentación y correcciones del factor de potencia [4,5,6,7,8,9,10,11,12] . Se han propuesto varios enfoques para resolver la distribución no uniforme del campo eléctrico. Uno de ellos es la tecnología de placa de campo (FP) [5, 13]. Un SBD de ánodo completamente empotrado con una placa de campo dual logra un alto voltaje de ruptura de 1.9 kV con 25 μm L AC [5] . También puede reducir significativamente el voltaje de encendido mientras mantiene un alto voltaje de ruptura. Además, el concepto convencional de campo de superficie reducido (RESURF) comúnmente empleado en la tecnología de silicio se ha demostrado en GaN HEMT [14]. Además, se propone la unión de polarización (PJ) que consiste en el gas de agujero bidimensional (2DHG) por encima del 2DEG para mejorar la relación entre la resistencia específica ( R ENCENDIDO, SP ) y BV [15,16,17,18]. Los dispositivos basados en GaN basados en el concepto PJ se han demostrado en sustratos de zafiro y SiC, mientras que el alto costo y los pequeños diámetros del GaN en sustratos de SiC van en contra de la aplicación comercial masiva. El GaN-sobre-Si con un gran diámetro se considera una opción prometedora debido a su bajo costo [19,20,21,22]. Por lo tanto, el rendimiento del diodo PJ en sustratos de silicio es digno de estudio.
En este trabajo, propusimos y demostramos experimentalmente un diodo de barrera Schottky GaN / AlGaN / GaN-on-Si con doble heterounión (DJ). El efecto de unión de polarización se confirma mediante simulaciones y experimentos. Se logra el campo eléctrico plano (campo E) entre los electrodos de ánodo y cátodo. El proceso ICP para grabar la zanja Schottky está optimizado para lograr una corriente de fuga inversa baja y un V bajo. ACTIVADO con excelente uniformidad de grabado. El proceso de contacto óhmico también está optimizado para lograr una baja resistencia de contacto (para 2DEG) basada en la capa epitaxial personalizada (con 45 nm GaN-top). Por lo tanto, se logra un voltaje de ruptura de 1109 V para los SBD con 11 μm L AC y la figura de mérito (FOM) de Baliga es 1051 MW / cm 2 . La dependencia de la temperatura y la R dinámica ENCENDIDO, SP también se investiga el rendimiento.
Método y experimento
La capa epitaxial se hizo crecer mediante deposición de vapor químico orgánico metálico en silicio de tipo p de 6 pulgadas, que consta de una capa tampón de GaN de 3,5 μm, una capa de canal de GaN de 150 nm, una capa intermedia de AlN de 1 nm, Al de 45 nm 0,25 Ga 0,75 Capa de barrera de N y capa superior de GaN de 45 nm de abajo hacia arriba. La capa superior de GaN incluye una capa de p-GaN de 35 nm y una capa de GaN sin dopar de 10 nm. Para un espesor de AlGaN dado de 45 nm, la densidad de 2DHG aumenta con el aumento del espesor de la parte superior de GaN [22]. La capa superior gruesa de GaN es vital para el 2DHG de alta densidad, mientras que va en contra de la resistencia de contacto de baja resistencia (para 2DEG). Las vistas esquemáticas del diodo de barrera Schottky de doble heterounión propuesto (DJ SBD) se muestran en la Fig. 1a. La fabricación de SBD comenzó con el aislamiento de mesa por Cl 2 / BCl 3 grabado con plasma acoplado inductivamente (ICP) a una profundidad de 300 nm. Luego, se formaron la zanja óhmica y la zanja del ánodo Schottky con el proceso de grabado ICP de bajo daño. La profundidad de la trinchera óhmica y la trinchera del ánodo de Schottky fue de 50 nm y 90 nm, respectivamente, lo que se confirmó mediante microscopía de fuerza atómica (AFM). Se introdujo una solución de hidróxido de tetrametilamonio (TMAH) a 85 ° C durante 15 min para eliminar los residuos posteriores al grabado y modificar la pared lateral de la zanja después de terminar el proceso de grabado [23]. Luego, el recocido a 400 ° C durante 10 min en N 2 ambiente se llevó a cabo. El cátodo óhmico se formó posteriormente con Ti / Al / Ni / Au evaporado con haz de electrones (20/140/55/45 nm), recocido a 870 ° C durante 35 s en N 2 ambiente, con una resistencia de contacto ( R C ) de 0,49 Ω · mm. Finalmente, el metal del ánodo y las interconexiones fueron depositados por Ni / Au para completar el flujo de fabricación. Los dispositivos presentaban varios L AC de 7 a 11 μm. La Figura 1b muestra la imagen TEM de sección transversal de alta resolución del ánodo después de ICP y deposición de metal, y la estructura de la capa se observó claramente.
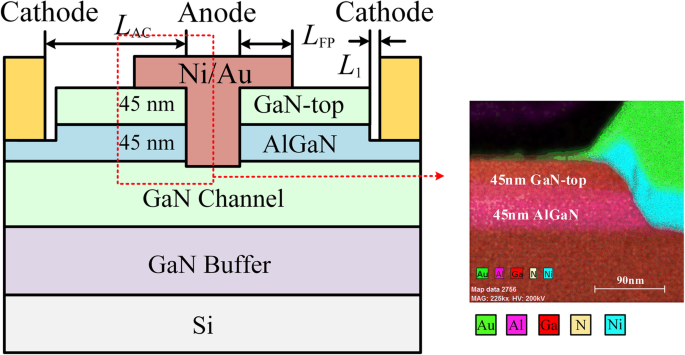
un Sección transversal de la propuesta de doble heterounión AlGaN / GaN SBD y proceso de fabricación principal. L AC es la longitud de ánodo a cátodo. L FP y L 1 son 1 μm y 2 μm, respectivamente. b Imagen HR-TEM del ánodo después de ICP y deposición de metal
El 2DEG es inducido por las cargas de polarización positivas a lo largo de la interfaz AlGaN / GaN. La interfaz superior GaN / AlGaN tiene cargas de polarización negativas y, por tanto, genera 2DHG en la interfaz superior [15]. El espacio entre la región de deriva y el cátodo ( L 1 ) se utiliza para reducir la ruta de la corriente del pozo como se muestra en la Fig. 2. Solo hemos investigado la influencia de L 1 de 2 a 3 μm en las características de bloqueo hacia adelante y hacia atrás debido al límite del diseño de trazado original. La V ACTIVADO y R ENCENDIDO, SP no muestran cambios porque L 1 no afecta el contacto Schottky y la ruta de la corriente de electrones. Además, el BV disminuye ligeramente con el aumento de L 1 debido a la región de deriva acortada. El mecanismo de funcionamiento de los DJ SBD con polarización directa es casi el mismo que el de los SBD convencionales, lo que significa que 2DHG apenas afecta la trayectoria de la corriente de electrones desde el cátodo al ánodo. Con el aumento del voltaje de polarización inversa, el 2DEG y 2DHG se agotan por completo. Quedan cargas fijas de polarización positiva y negativa, que forman la unión de polarización. Como resultado, se obtiene una distribución plana del campo E entre el cátodo y el ánodo (Fig. 3).
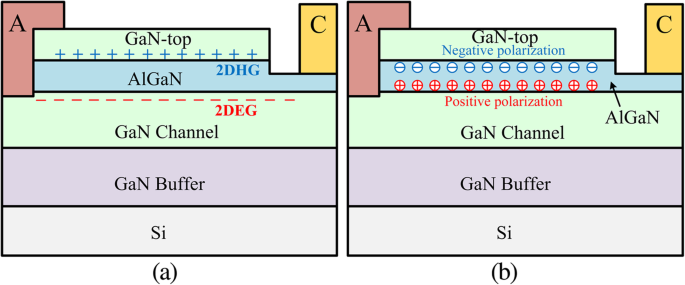
Análisis del mecanismo de funcionamiento de DJ SBD a sesgo cero y b sesgo inverso

Distribución del campo eléctrico a lo largo de la heterointerfaz del canal AlGaN / GaN mediante simulación TCAD. La fracción de Al se define como 0,25. La densidad del aceptador neto (nivel profundo) en la capa de búfer se establece en 1,5 × 10 16 cm −3 y el nivel de energía es 0,45 eV por debajo del mínimo de la banda de conducción. La densidad del aceptador de la interfaz AlGaN / GaN se establece en 6 × 10 12 cm −3 y el nivel de energía es 0,23 eV por debajo del mínimo de la banda de conducción
Como se muestra en la Fig. 3, la característica de ruptura y el mecanismo de unión de polarización fueron confirmados por 2-D Sentaurus TCAD de Synopsys. Habíamos tenido en cuenta varios fenómenos físicos importantes en la simulación, incluido el estrechamiento de la banda prohibida, la polarización, la movilidad de electrones / huecos, la ionización por impacto y la recombinación de SRH.
Se adoptó la medición del efecto Hall para determinar los valores de densidad y movilidad 2DHG o 2DEG [22]. Las mediciones se realizaron mediante el método de Van der Pauw a temperatura ambiente. Para medir 2DHG según Ref. [17], las muestras de medición Hall se fabricaron con contactos óhmicos de Ni / Au. La densidad y movilidad del 2DHG fueron 9 × 10 12 cm −2 y 15 cm 2 / V s, respectivamente. El 2DEG se midió mediante las muestras con la parte superior de GaN empotrada y parcialmente AlGaN fabricadas con contactos óhmicos de Ti / Al / Ni / Au (para 2DEG). La densidad y movilidad del 2DEG fueron 8.5 × 10 12 cm −2 y 970 cm 2 / V s, respectivamente. Las medidas de Hall mostraron que la movilidad del agujero era aún mucho menor que la movilidad global por encima de 100 cm 2 / V s. La degradación de la movilidad se atribuyó a la difusión de Mg desde el p-GaN al GaN no dopado durante el crecimiento de MOCVD.
Resultados y discusión
El I-V medido características de avance de los SBD con varias L AC se representan en la Fig. 4a y b. El voltaje de encendido ( V ACTIVADO ) es 0,68 V con una pequeña variación de 0,02 V. El factor de idealidad y la altura de la barrera de los SBD se calculan como 1,44 ± 0,15 y 0,76 ± 0,04 eV, respectivamente. La Figura 4a muestra que la alta densidad de corriente directa de 183 mA / mm y 144 mA / mm (@ polarización directa de 2,5 V) y la resistencia de encendido de 0,642 y 1,17 mΩ cm 2 se logran en L AC =7 y 11 μm, respectivamente. Además, una excelente relación de corriente de encendido / apagado ∼ 10 10 se obtiene como se muestra en la Fig. 4b. La pendiente subumbral (SS) es 63.0 mV / dec, que está cerca del SS ideal (59.6 mV / dec).
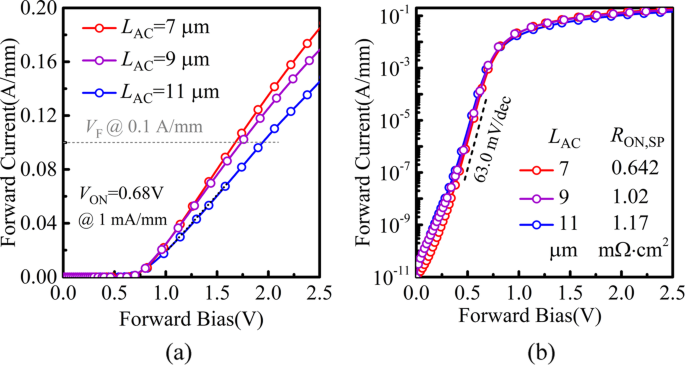
Sesgo directo medido I-V características de los DJ SBD en a lineal y b Escala semilogarítmica con diferentes L AC
La Figura 5a muestra el bloqueo inverso medido I-V características de los SBD con varias L AC a 300 K. El voltaje de ruptura de los dispositivos con diferentes L AC es 803 V, 940 V y 1109 V, respectivamente, a una corriente de fuga de 1 mA / mm. Se supone que las densidades de 2DEG y 2DHG son las mismas durante la simulación. Sin embargo, los resultados experimentales muestran que las densidades de 2DHG (9 × 10 12 cm −2 ) son ligeramente superiores a los de 2DEG (8,5 × 10 12 cm −2 ). La diferencia entre las cargas fijas de polarización positiva y negativa durante el estado desactivado afecta el equilibrio de carga y, por lo tanto, degrada la tensión de ruptura. La influencia de la L AC en el BV y el R ENCENDIDO, SP se muestra en la Fig. 5b. Una relación casi lineal entre BV y L AC se obtiene, lo que implica el campo E lateral relativamente plano en la región de deriva. Debido al efecto de polarización-unión, el dispositivo demuestra una alta figura de mérito de Baliga (FOM =BV 2 / R ENCENDIDO, SP ) de 1051 MW / cm 2 (@ L AC =11 μm).
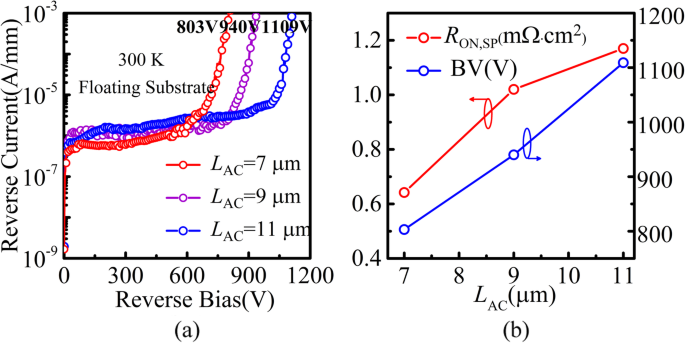
un Bloqueo inverso medido I-V características de DJ SBD con diferentes L AC ( b ) R ENCENDIDO, SP y BV como funciones de L AC
El proceso de grabado es vital para la interfaz Schottky de alta calidad y el contacto óhmico. La Figura 6a muestra la morfología de la superficie de la zanja empotrada después del grabado ICP (@ 5 ° C) y la solución de TMAH. La velocidad de grabado es de aproximadamente 4,9 nm / min y la receta final seleccionada es con un Cl 2 de 4 sccm, una potencia de ICP de 50 W y una potencia de RF de 15 W. La rugosidad de la raíz cuadrada media (RMS) es de 0,244 nm con el área de escaneo de 2 × 2 μm 2 .
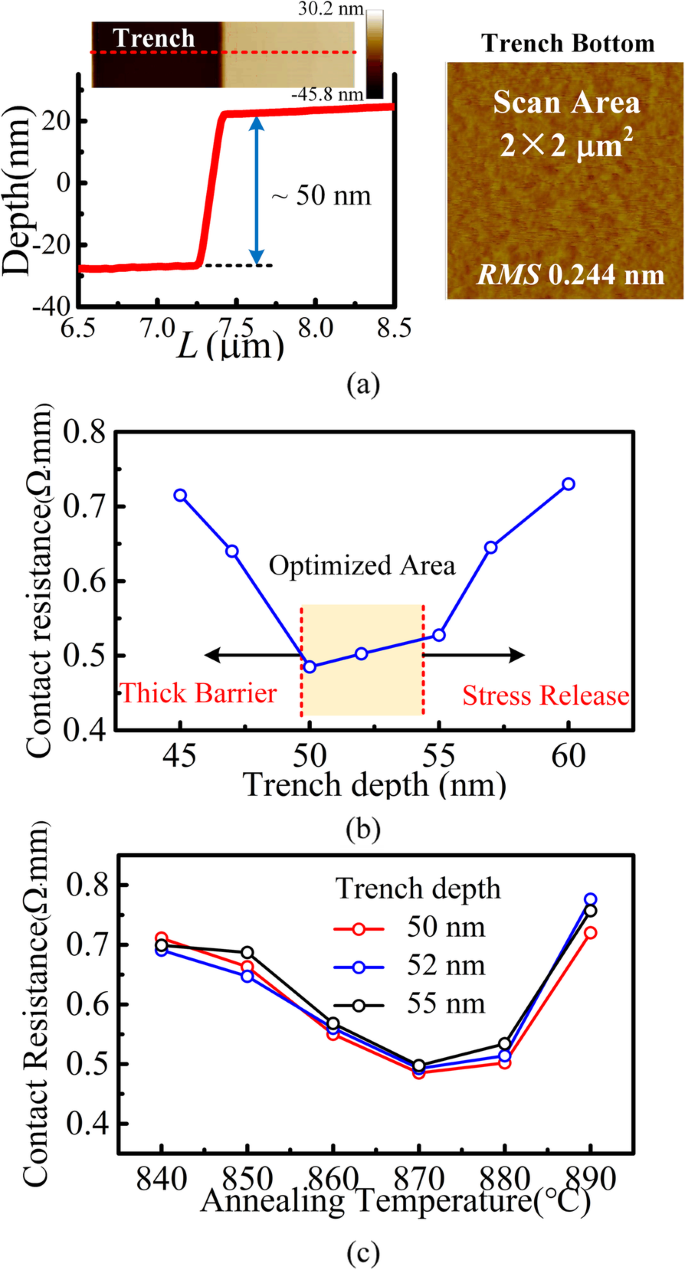
un Morfología AFM de la zanja después del grabado ICP. b Influencia de la profundidad de grabado en la resistencia óhmica de contacto mediante la prueba TLM. c Resistencia de contacto en función de la temperatura de recocido con la profundidad de la zanja de 50 a 55 nm. El tiempo de recocido fue de 35 s
Debido a que la capa epitaxial personalizada incluye una capa superior de GaN de 45 nm y una capa de AlGaN de 45 nm, el proceso de contacto óhmico (para 2DEG) es diferente de los SBD convencionales. Sin empotrar las capas de barrera de GaN-top y AlGaN, es difícil lograr una baja resistencia de contacto mediante el recocido debido a la barrera potencial entre el metal óhmico y el 2DEG. Sin embargo, si la barrera está demasiado empotrada, la liberación de tensión conduce a una reducción en la concentración de 2DEG. Los procesos adicionales se adoptan para reducir la resistencia óhmica de contacto. Las superficies de las muestras se tratan con la solución de HCl para eliminar la capa de óxido nativo antes de la deposición. Además, se adopta el tratamiento de superficie de plasma (potencia ICP 50 W BCl 3 10 sccm 3 min) para introducir estados donantes de superficie [24]. La Figura 6b demuestra la dependencia de la resistencia de contacto con la profundidad de la zanja. La profundidad optimizada se obtiene de 50 a 55 nm. El recocido térmico rápido (RTA) a alta temperatura para el contacto Ti / Al / Ni / Au se investiga en la Fig. 6c. La temperatura de recocido es de 840 a 890 ° C, y los 870 ° C dan como resultado la menor resistencia de contacto. El recocido a alta temperatura, es decir, 870 ° C, conduce a la formación de TiN en la interfaz Ti / nitruro. Sin embargo, una temperatura más alta (por ejemplo, 890 ° C) aumenta la interdifusión de Au y Al, lo cual es desventajoso para la formación de buenos contactos óhmicos.
Las figuras 7a-c muestran los gráficos estadísticos de las características estáticas, incluido V ACTIVADO , V F y BV. Los datos se extraen de 72 SBD con L AC de 7, 9 y 11 μm fabricados en 3 ciclos de proceso separados. Los dispositivos muestran características estables de encendido hacia adelante y el V ACTIVADO es independiente con L AC , porque V ACTIVADO está determinada principalmente por el contacto de Schottky. El proceso de grabado ICP de bajo daño, la profundidad de la zanja controlada con precisión y la interfaz Schottky de alta calidad contribuyen a la excelente uniformidad de la V ACTIVADO y V F . Además, con el aumento de L AC (de 7 a 11 μm), hay un aumento monotónico (∼ 100 V / μm) en el BV observado en las estructuras propuestas. La Figura 7d muestra las estadísticas del histograma de V ACTIVADO para 72 dispositivos, y el valor medio es 0,68 V con una pequeña derivación estándar de 0,02 V.

Gráficos estadísticos de a voltaje de encendido, b voltaje directo y c tensión de ruptura extraída de 72 SBD con L AC de 7, 9 y 11 μm fabricados en 3 ciclos de proceso separados. d Distribución de V ACTIVADO para 72 dispositivos
La dependencia de la temperatura de las características de avance y retroceso se evalúa en la Fig. 8. Como se muestra en la Fig. 8a, un aumento en la temperatura ambiente de 300 a 475 K da como resultado un aumento en el R ENCENDIDO, SP por un factor de 1,94.
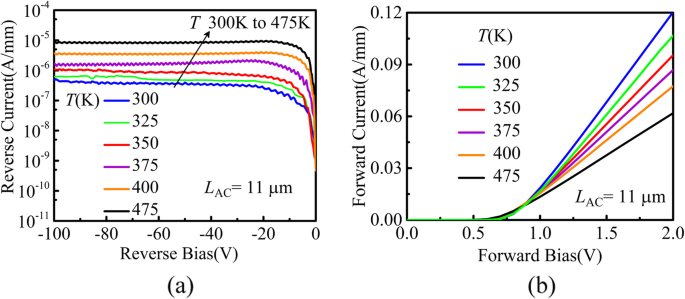
un Corriente de fuga inversa y b características de avance para los DJ SBD a diferentes temperaturas
Las características dinámicas de los DJ SBD se miden con el analizador de dispositivos de potencia Agilent B1505A. Los puntos de polarización inactiva del pulso del ánodo se establecen en - 10 V, - 20 V, - 30 V, - 40 V, - 70 V y - 100 V, con el ancho y el período del pulso del ánodo de 0,5 ms / 500 ms. La Figura 9b muestra la R dinámica ENCENDIDO, SP en función de la tensión de tensión. La R dinámica ENCENDIDO, SP incluso a 100 V, el voltaje de tensión de reserva es solo 1,18 veces mayor que el que no tiene tensión inversa, que es comparable a la Ref. [8]. El aumento limitado de la dinámica R ENCENDIDO, SP contribuye a la reducción del estado de la interfaz. La degradación de la R dinámica ENCENDIDO, SP necesita más trabajo.
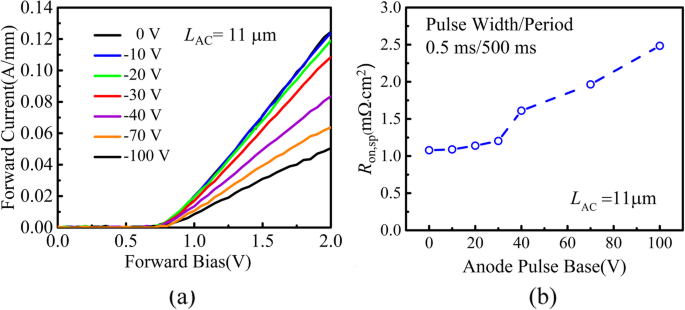
un I-V características bajo medición de pulso. b R extraído ENCENDIDO, SP versus base de pulso de ánodo con ancho / período de pulso =0.5 ms / 500 ms
La Figura 10 presenta la gráfica de referencia de BV versus R ENCENDIDO, SP para diodo de potencia GaN sobre sustratos de Si / SiC / zafiro [8, 10, 22, 25,26,27,28,29,30,31]. El dispositivo propuesto con L AC de 11 μm demuestra un BV de 1109 V con un R correspondiente ENCENDIDO, SP de 1,17 mΩ cm 2 , lo que lleva a un FOM alto de Baliga de 1051 MW / cm 2 . Este valor es el mejor resultado entre el diodo de potencia de GaN lateral en el sustrato de Si.
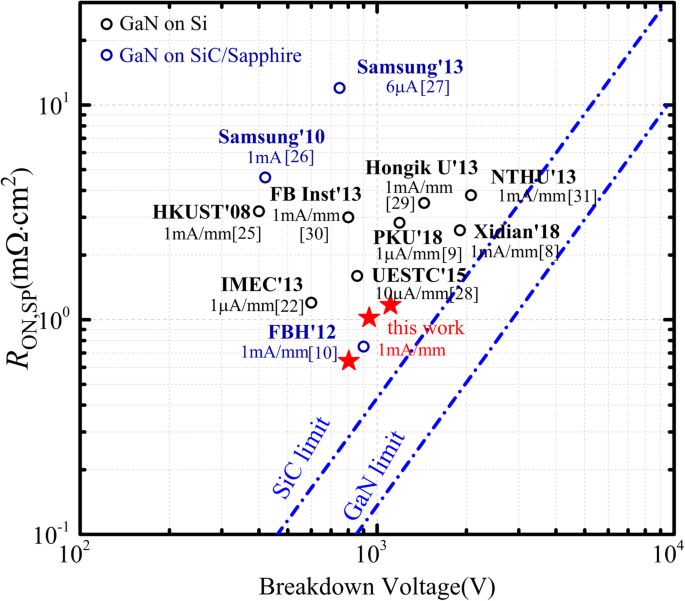
Gráfico de referencia de BV frente a R ENCENDIDO, SP de diodo de potencia GaN en sustratos de SiC / zafiro / Si. También se proporciona la fuga inversa utilizada para definir la avería
Conclusión
Se fabrica un SBD de doble heterounión GaN / AlGaN / GaN-sobre-Si con una alta figura de mérito. El proceso de grabado ICP de bajo daño da como resultado los contactos óhmicos y Schottky optimizados para el dispositivo propuesto. Por lo tanto, un V bajo ACTIVADO de 0,68 V con buena uniformidad y una R baja ENCENDIDO, SP de 1,17 mΩ cm 2 se obtienen en el dispositivo con L AC de 11 μm. FOM alto de Baliga de 1051 MW / cm 2 se logra debido al efecto de unión de polarización. El alto rendimiento junto con la tecnología de bajo costo GaN-on-Si exhibe un gran potencial para futuras aplicaciones de energía.
Disponibilidad de datos y materiales
Todos los datos generados o analizados durante este estudio se incluyen en este artículo.
Abreviaturas
- SBD:
-
Diodo de barrera Schottky
- 2DEG / 2DHG:
-
Electrón bidimensional / gas hueco
- MOCVD:
-
Deposición de vapor químico metalorgánico
- ICP:
-
Plasma acoplado inductivamente
- TEM:
-
Microscopio electrónico de transmisión
- AFM:
-
Microscopio de fuerza atómica
- BV:
-
Voltaje de ruptura
- R ENCENDIDO, SP :
-
On-resistencia específica
- V ACTIVADO :
-
Voltaje de encendido
- FOM:
-
Figura de mérito
Nanomateriales
- Impacto de los estados de la superficie y la fracción molar de aluminio en el potencial de la superficie y 2DEG en los HEMT de AlGaN / GaN
- Investigación experimental sobre la estabilidad y la convección natural de nanofluidos de agua-TiO2 en recintos con diferentes ángulos de rotación
- Investigación sobre la polarización de la superficie de la heteroestructura de GaN / AlGaN / GaN con cubierta de Al2O3 mediante espectroscopia de fotoelectrones de rayos X de ángulo resuelto
- RGO y redes de grafeno tridimensionales co-modificadas TIM con alto rendimiento
- Estudio experimental sobre las características de flujo y transferencia de calor de nanofluidos de agua-TiO2 en un tubo estriado en espiral
- Aerogel de grafeno / polianilina con superelasticidad y alta capacitancia como electrodo supercondensador altamente tolerante a la compresión
- Estudio experimental de etosomas encapsulados de 5-fluorouracilo combinados con láser fraccional de CO2 para tratar cicatrices hipertróficas
- Una descripción general del diodo de barrera Schottky basado en semiconductores Ga2O3 ultraancho para aplicaciones de electrónica de potencia
- Estudios experimentales y teóricos del contacto de Mo / Au Schottky en una película delgada de β-Ga2O3 exfoliada mecánicamente
- Rendimiento de recuperación de diodos de barrera Schottky GaN verticales dopados con Ge
- Beneficios y desventajas de los ángulos de hélice altos y bajos



