Un CRD de bloqueo inverso AlGaN / GaN de alta precisión (RB-CRD) con cátodo de trinchera híbrido
Resumen
Se ha propuesto y demostrado experimentalmente un diodo regulador de corriente de bloqueo inverso lateral (RB-CRD) de AlGaN / GaN con ánodo Schottky de trinchera y cátodo de trinchera híbrido en un sustrato de silicio. El diodo de barrera Schottky (SBD) integrado en el ánodo exhibe un voltaje de encendido de 0,7 V y un voltaje de ruptura inversa de 260 V. El cátodo de trinchera híbrido actúa como un CRD, que está en conexión en serie con el ánodo SBD. Se puede lograr un voltaje de rodilla de 1,3 V y un voltaje de funcionamiento directo superior a 200 V para el RB-CRD. El RB-CRD es capaz de generar una excelente corriente constante en un amplio rango de temperatura de 25 a 300 ° C. Además, la corriente de regulación directa exhibe pequeños coeficientes de temperatura negativos menores a - 0.152% / o C.
Antecedentes
Los semiconductores de banda ancha han atraído una atención considerable para la próxima generación de dispositivos de alta potencia, alta frecuencia y alta temperatura. GaN es uno de los semiconductores de banda ancha ancha más prometedores debido a sus propiedades superiores, como gran banda prohibida, alta movilidad de electrones y alto campo eléctrico crítico [1, 2, 3, 4, 5]. Además, debido a la combinación de polarización espontánea y polarización piezoeléctrica, se puede lograr un gas electrónico bidimensional de alta densidad (2DEG) en la heterointerfaz AlGaN / GaN. Estas excelentes propiedades permiten que los dispositivos de potencia basados en AlGaN / GaN funcionen con una baja resistencia mientras mantienen un alto voltaje de ruptura. La plataforma GaN-on-silicon (GaN-on-Si) [6,7,8] ha sido considerada como la tecnología más prometedora para dispositivos de potencia de alto rendimiento y bajo costo, debido a la disponibilidad de obleas de silicio de gran diámetro y al compatibilidad con el proceso de fabricación CMOS madurado existente. Hasta la fecha, se ha demostrado una variedad de dispositivos de potencia [9,10,11,12,13,14,15,16] en AlGaN / GaN-on-Si y algunos de ellos están disponibles comercialmente. Al mismo tiempo, el desarrollo del dispositivo AlGaN / GaN con nueva funcionalidad puede expandir el potencial de aplicación de AlGaN / GaN-on-Si, que es beneficioso para impulsar la comercialización extensa de la tecnología AlGaN / GaN.
Como se presenta en la Fig. 1a, en este trabajo, se demostró experimentalmente un nuevo tipo de dispositivo denominado diodo regulador de corriente de bloqueo inverso (RB-CRD) en AlGaN / GaN-on-Si. El RB-CRD cuenta con un ánodo Schottky de trinchera y un cátodo de trinchera híbrido. Se forma un diodo de barrera Schottky de zanja (SBD) en el ánodo mientras que se logra un CRD en el cátodo de zanja híbrido. El RB-CRD puede considerarse como un SBD en conexión en serie con un CRD. Una aplicación típica del RB-CRD es la carga de la batería, como se muestra en la Fig. 1b. En el circuito de carga de la batería antes mencionado, el CRD actúa como una fuente de corriente constante, que emite una corriente constante para cargar la batería [17, 18, 19] independientemente de la fluctuación de voltaje directo entre la entrada y la batería. Si el voltaje de entrada cae por debajo del voltaje de la batería, el SBD con polarización inversa en el circuito evitará que la batería se descargue.
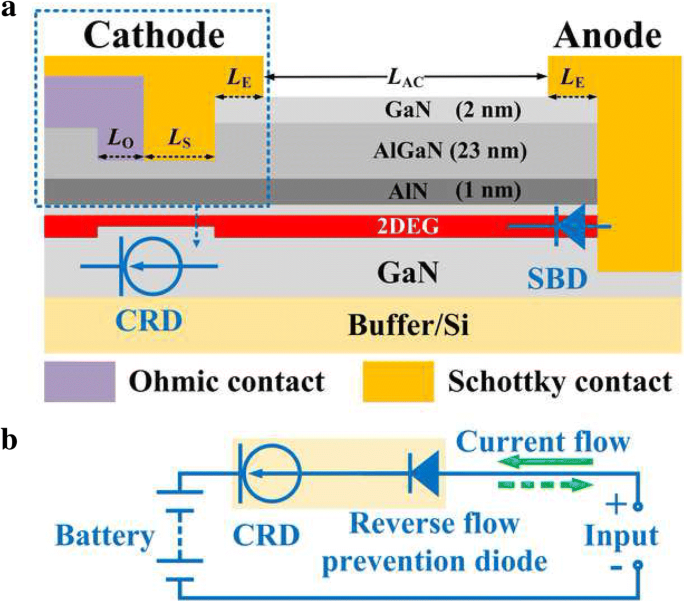
un Sección transversal esquemática del RB-CRD. b Diagrama de circuito de carga de la batería con el RB-CRD
Métodos
La heteroestructura epitaxial de AlGaN / GaN utilizada para fabricar los RB-CRD se cultivó en un sustrato de silicio de 6 pulgadas (111) mediante deposición de vapor químico orgánico metálico (MOCVD). Las capas epitaxiales constan de una capa de GaN de 2 nm, una barrera de AlGaN de 23 nm, una capa intermedia de AlN de 1 nm, un canal de GaN de 300 nm y un tampón de 3,5 μm. La densidad y la movilidad medidas del efecto Hall del 2DEG fueron 9,5 × 10 12 cm −2 y 1500 cm 2 / V · s, respectivamente. El proceso de fabricación del dispositivo se muestra en la Fig. 2. Primero, se grabó una zanja poco profunda (ver Fig. 3) en el cátodo del RB-CRD mediante un Cl 2 de baja potencia / BCl 3 técnica de grabado con plasma acoplado inductivamente (ICP). Se observó una velocidad de grabado de 7 nm / min utilizando la receta de grabado desarrollada con una potencia de RF de 20 W, una potencia de ICP de 60 W, un Cl 2 flujo de 5 sccm, y un BCl 3 flujo de 10 sccm. Luego, se formó un aislamiento de mesa con una profundidad de 300 nm utilizando la misma técnica de grabado ICP para desconectar los dispositivos. La zanja del ánodo se logró mediante este proceso simultáneamente. Después de eso, las pilas de metal de Ti / Al / Ni / Au (20/150/55/60 nm nm) se depositaron mediante la evaporación del haz de electrones, seguido por el recocido térmico rápido a 880 ° C durante 35 s en N 2 ambiente. La resistencia de contacto óhmica de 1,1 Ω mm y la resistencia de la hoja de 400 Ω / cuadrado se extrajeron mediante el método de línea de transmisión. Finalmente, el proceso de fabricación del dispositivo terminó con la deposición de pilas de metal Schottky de Ni / Au (50/300 nm). La distancia entre el ánodo y el cátodo ( L AC ) es de 4 μm. Las longitudes del contacto óhmico ( L O ) y el contacto de Schottky ( L S ) en la zanja del cátodo son de 0,5 μm y 1 μm, respectivamente. El voladizo extendido ( L E ) del contacto Schottky es de 0,5 μm.
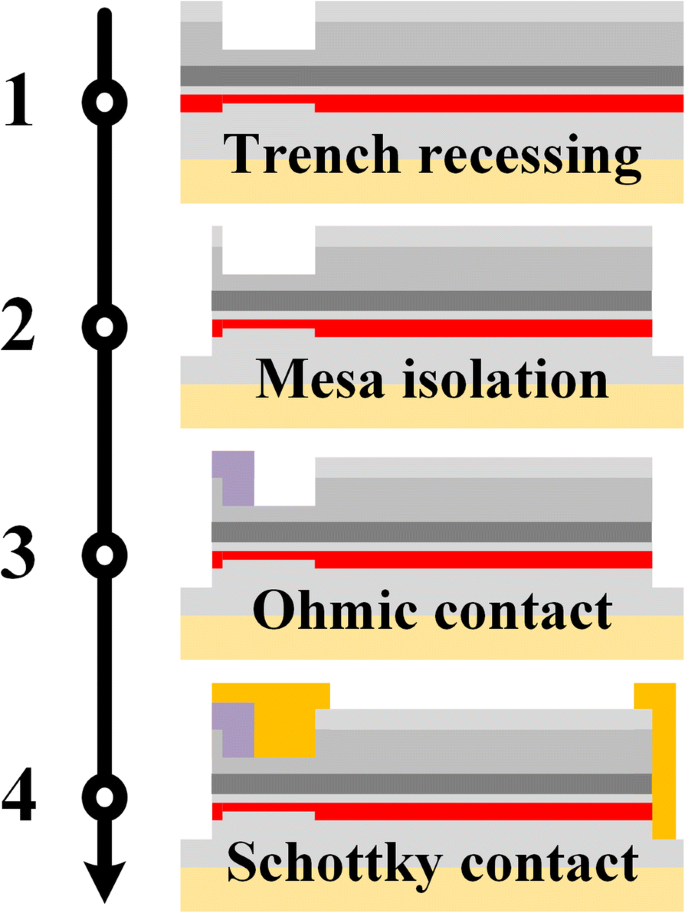
Flujo del proceso de fabricación del RB-CRD
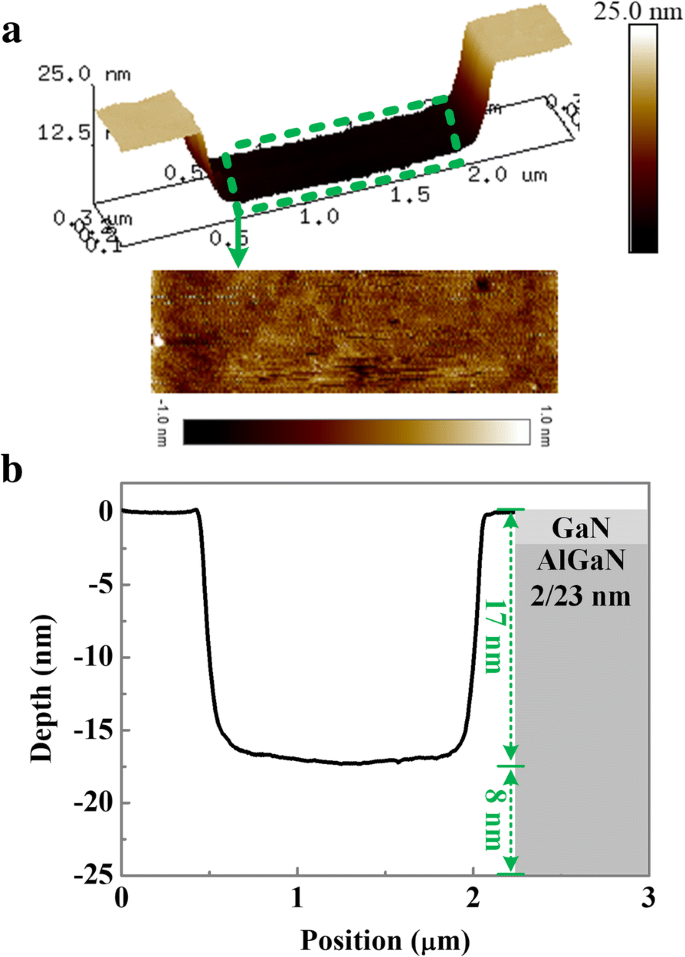
un Imágenes AFM de la trinchera catódica. b Perfil de altura tomado de la zanja del cátodo
Resultados y discusión
La Figura 3a muestra la imagen del microscopio de fuerza atómica 3D (AFM) de la zanja del cátodo fabricada. La rugosidad de la superficie del fondo de la zanja del cátodo es de 0,3 nm. Una rugosidad de superficie tan pequeña es beneficiosa para el siguiente contacto metal-semiconductor. Como se muestra en la Fig. 3b, con un receso de la zanja del cátodo de 17 nm de profundidad, la capa de barrera de AlGaN de 8 nm permanece en la región de la zanja del cátodo. Tal capa de barrera de AlGaN restante permite que el canal 2DEG en la región de la zanja del cátodo siempre exista con un sesgo cero.
La figura 4 ilustra el mecanismo de funcionamiento del RB-CRD. Cuando se aplica una polarización cero al ánodo ( V AC =0 V) (ver Fig. 4a), el RB-CRD es análogo a un HEMT en modo de agotamiento de drenaje Schottky con los electrodos de puerta-fuente conectados. Cuando se aplica un sesgo negativo al ánodo ( V AC <0 V) (ver Fig. 4b), los electrones se acumularán en la región de la zanja del cátodo, mientras que el canal 2DEG se agotará en la región del ánodo debido a la unión de Schottky con polarización inversa. No existe una corriente deseada siguiendo entre el ánodo y el cátodo, y el RB-CRD actúa como un SBD polarizado en reversa. Como se muestra en la Fig. 4c, cuando una polarización positiva que está más allá del voltaje de encendido ( V T , a 1 mA / mm) del ánodo SBD se aplica al ánodo ( V AC > V T ), los electrones fluirán entre el contacto óhmico en el cátodo y el contacto Schottky en el ánodo. Mientras tanto, la unión Schottky en el cátodo tiene polarización inversa y el canal 2DEG bajo el contacto Schottky se agotará gradualmente al aumentar la polarización directa. Por lo tanto, la corriente de salida aumentará inicialmente con el voltaje de ánodo aplicado y luego alcanzará gradualmente la saturación. En tal caso, se puede obtener una corriente de salida constante.
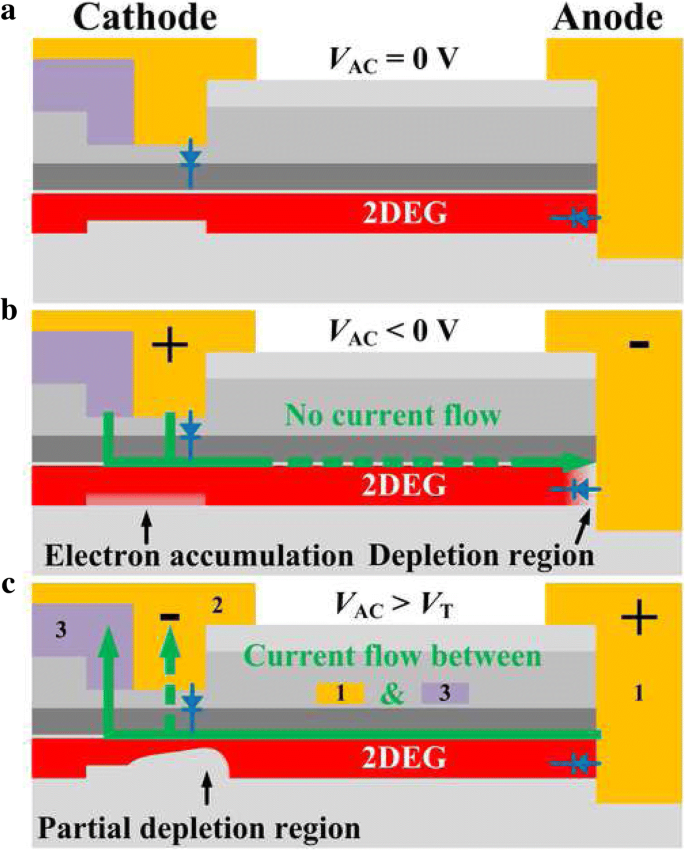
Mecanismo de funcionamiento esquemático del RB-CRD en a sesgo cero, b sesgo inverso y c condiciones de polarización directa
El avance I-V dependiente de la temperatura Las características del RB-CRD en la oblea se muestran en la Fig. 5. Como se muestra en la Fig. 5a, para el RB-CRD, un voltaje de rodilla ( V K , al 80% de la corriente de regulación constante) de 1,3 V, que es más alta que la de nuestros CRD informados anteriormente (por ejemplo, valor típico 0,6 V) [20, 21]. Esto se debe a la caída de voltaje adicional (por ejemplo, valor típico 0,7 V) en el ánodo SBD del RB-CRD. Con la temperatura aumentando de 25 a 300 ° C (ver Fig. 5a), un cambio negativo en el V T se observa, lo que puede explicarse por el modelo de emisión termoiónica (es decir, se necesita menos energía para que los electrones superen la barrera de Schottky a temperaturas más altas). El RB-CRD es capaz de emitir una corriente de regulación constante de hasta 200 V (ver Fig. 5b), que es más alta que el voltaje de operación máximo informado de los CRD comerciales basados en Si [22,23,24]. A 25 ° C, la razón de corriente de regulación ( I 200 V / Yo 25 V ) del RB-CRD propuesto es 0,998, lo que indica que la corriente de salida es bastante estable. Gracias a la capacidad de operación intrínseca a alta temperatura de la plataforma AlGaN / GaN, el RB-CRD exhibe una degradación insignificante en la estabilidad del I A hasta 200 V a temperaturas de hasta 300 ° C. Mientras tanto, con la temperatura aumentando de 25 a 300 ° C, el I delantero A se reduce de 31,1 a 23,1 mA / mm debido a la disminución de la movilidad de los electrones a temperaturas elevadas, como se muestra en la Fig. 5b. Los coeficientes de temperatura ( α ) de la corriente de regulación a diferentes rangos de temperatura se puede calcular mediante la siguiente fórmula
$$ \ alpha =\ frac {I_1- {I} _0} {I_0 \ left ({T} _1- {T} _0 \ right)} \ veces 100 \% $$donde yo 0 es la corriente de salida a la temperatura T 0 y yo 1 es la corriente de salida a la temperatura T 1 . Un pequeño coeficiente de temperatura inferior a - 0,152% / o Se observa C, lo que indica que el RB-CRD fabricado presenta una excelente estabilidad térmica.

Desviación directa dependiente de la temperatura I - V características del RB-CRD. Rangos de voltaje de ánodo: a 0–2 V, b 0-200 V
Como se muestra en el recuadro de la Fig. 6, la tensión de ruptura inversa del RB-CRD es de 260 V a 25 ° C. Se calcula que el campo eléctrico crítico promedio correspondiente es de 0,65 MV / cm. El inverso dependiente de la temperatura I-V Las características del RB-CRD se muestran en la Fig. 6. El aumento de la temperatura ambiente de 25 a 300 ° C da lugar a un aumento de la corriente de fuga en dos órdenes de magnitud.

Polarización inversa dependiente de la temperatura I - V características del RB-CRD
Conclusiones
En conclusión, se ha demostrado con éxito por primera vez un novedoso AlGaN / GaN-on-Si RB-CRD con ánodo Schottky de trinchera y cátodo de trinchera híbrido. El RB-CRD fabricado presenta una V K de 1,3 V, una tensión de funcionamiento directa superior a 200 V y una tensión de ruptura inversa de 260 V. Una excelente precisión, así como un pequeño coeficiente de temperatura negativo inferior a - 0,152% / o C se han obtenido para el RB-CRD. El RB-CRD multifuncional con alta precisión tiene un gran potencial para incorporarse en los sistemas electrónicos de potencia de GaN emergentes.
Abreviaturas
- 2DEG:
-
Gas de electrones bidimensionales
- AFM:
-
Microscopio de fuerza atómica
- ICP:
-
Plasma acoplado inductivamente
- MOCVD:
-
Deposición de vapor químico orgánico metálico
- RB-CRD:
-
Diodo regulador de corriente de bloqueo inverso
- SBD:
-
Diodo de barrera Schottky
Nanomateriales
- Creación de aplicaciones híbridas de blockchain / nube con Ethereum y Google
- Mejora de la fabricación aditiva con ingeniería inversa
- Infineon:IGBT de conducción inversa con funciones de protección
- Matrices de Python:Crear, Invertir, Explotar con Ejemplos de Matrices de Python
- Impacto de los estados de la superficie y la fracción molar de aluminio en el potencial de la superficie y 2DEG en los HEMT de AlGaN / GaN
- Emisión multicolor de una estructura de nanopiramida cuasicristalina fotónica ultravioleta basada en GaN con múltiples pozos cuánticos semipolares InxGa1 − xN / GaN
- Las propiedades eléctricas de los compuestos híbridos basados en nanotubos de carbono de paredes múltiples con nanoplaquetas de grafito
- Síntesis y propiedades electroquímicas de materiales de cátodo LiNi0.5Mn1.5O4 con dopaje compuesto Cr3 + y F− para baterías de iones de litio
- PEDOT altamente conductivo:Capa transportadora de orificios transparentes PSS con tratamiento solvente para células solares híbridas orgánicas / de silicio de alto rendimiento
- Investigación sobre la polarización de la superficie de la heteroestructura de GaN / AlGaN / GaN con cubierta de Al2O3 mediante espectroscopia de fotoelectrones de rayos X de ángulo resuelto
- Dirigirse a las células endoteliales con nanopartículas multifuncionales de GaN / Fe



