Transistores de película fina a-InGaZnO de alto rendimiento con un presupuesto térmico extremadamente bajo mediante el uso de un dieléctrico de Al2O3 rico en hidrógeno
Resumen
Las características eléctricas de los transistores de película fina (TFT) amorfos de In-Ga-Zn-O (a-IGZO) se comparan mediante el uso de O 2 deposición de capa atómica mejorada con plasma Al 2 O 3 dieléctricos a diferentes temperaturas. Los TFT a-IGZO de alto rendimiento se demuestran con éxito con un Al 2 O 3 dieléctrico depositado a temperatura ambiente, que exhibe una alta movilidad de efecto de campo de 19,5 cm 2 V - 1 s - 1 , una pequeña oscilación de subumbral de 160 mV / dec, un voltaje de umbral bajo de 0.1 V, una relación de corriente de encendido / apagado grande de 4.5 × 10 8 y estabilidades superiores de polarización de puerta positiva y negativa. Esto se atribuye al Al 2 rico en hidrógeno O 3 dieléctrico depositado a temperatura ambiente en comparación con temperaturas de deposición más altas, pasivando así de manera eficiente los estados interfaciales de a-IGZO / Al 2 O 3 y las vacantes de oxígeno y la mejora de la conductividad del canal a-IGZO mediante la generación de electrones adicionales debido al dopado con hidrógeno mejorado durante la pulverización catódica de IGZO. Un presupuesto térmico tan extremadamente bajo para los TFT a-IGZO de alto rendimiento es muy atractivo para aplicaciones electrónicas flexibles.
Antecedentes
Los transistores de película fina (TFT) amorfos basados en In-Ga-Zn-O (a-IGZO) han atraído mucha atención en la última década debido a su alta movilidad, buena uniformidad, alta transparencia a la luz visible y baja temperatura de proceso [1, 2,3]. Estos méritos lo convierten en un candidato prometedor para la aplicación de productos electrónicos de próxima generación, como pantallas transparentes, dispositivos flexibles o dispositivos electrónicos portátiles. En particular, para las aplicaciones de la electrónica flexible, los TFT se fabrican generalmente sobre sustratos poliméricos de baja estabilidad térmica. Por lo tanto, es necesario reducir el presupuesto térmico de la fabricación de a-IGZO TFT. Para este propósito, muchos investigadores se han centrado en a-IGZO TFT con aisladores de puerta fabricados a temperatura ambiente, como pulverización catódica [4, 5, 6], proceso de solución [7, 8, 9], evaporación de haz de electrones [10] y anodización [11]. Sin embargo, estas películas dieléctricas a menudo sufren de una alta densidad de trampas y una fuerte dispersión interfacial dieléctrica / a-IGZO, lo que resulta en una movilidad limitada del efecto de campo, una gran oscilación del subumbral y una pequeña relación de corriente de encendido / apagado [4,5,6 , 7,8,9,10,11].
Por otro lado, la deposición de capa atómica (ALD) es una técnica prometedora, que puede proporcionar películas de alta calidad, control preciso del espesor de la película, buena uniformidad en un área grande y baja temperatura de proceso [12,13,14]. Zheng y col. [15] informó que el a-IGZO TFT con ALD SiO 2 el dieléctrico exhibió un excelente rendimiento eléctrico sin la necesidad de un recocido posterior. Sin embargo, se requiere una alta temperatura del sustrato de 250 ° C para el ALD de SiO 2 películas [15], que es superior a las temperaturas de transición vítrea de la mayoría de los sustratos plásticos flexibles. Curiosamente, se informa que ALD de Al 2 O 3 las películas se pueden realizar incluso a temperatura ambiente (RT) [16, 17]; mientras tanto, el Al 2 O 3 La película depositada a TA contiene una gran cantidad de impurezas de hidrógeno (H) [17]. Sin embargo, hasta donde sabemos, el Al 2 rico en H mencionado anteriormente O 3 La película nunca se ha utilizado como aislante de puerta en a-IGZO TFT. Por lo tanto, es deseable explorar el a-IGZO TFT con un RT ALD Al 2 O 3 aislante de puerta.
En esta carta, el a-IGZO TFT de alto rendimiento se fabricó con éxito con un Al 2 depositado a temperatura ambiente O 3 dieléctrico de puerta. Comparando las características de los TFT a-IGZO con varios Al 2 O 3 aisladores de compuerta depositados a diferentes temperaturas, se abordó el mecanismo subyacente.
Métodos
Las obleas de silicio de tipo p altamente dopadas (<0,0015 Ω cm) se limpiaron mediante procesos RCA estándar y sirvieron como electrodos de puerta. Cuarenta nanómetros de Al 2 O 3 Las películas se depositaron en un sistema ALD comercial (Picsun Ltd.) utilizando trimetilaluminio (TMA) y O 2 plasma como precursor y reactivo, respectivamente. Un ciclo de crecimiento consistió en un pulso de TMA de 0,1 s, 10 s N 2 purga, 8 s O 2 pulso de plasma y 10 s N 2 purga. El TMA se mantuvo a 18 ° C para una presión y dosis de vapor estables, y el O 2 El caudal de gas se fijó en 150 sccm con una potencia de generador de plasma de 2500 W. Posteriormente, se depositaron películas de a-IGZO de 40 nm mediante pulverización catódica de RF utilizando un objetivo cerámico IGZO con una relación atómica de In:Ga:Zn:O =1 :1:1:4. Durante la pulverización catódica, la presión de trabajo y Ar y O 2 Los caudales de gas se fijaron en 0,88 Pa y 48 y 2 sccm, respectivamente. La región activa se formó mediante fotolitografía y grabado en húmedo. Después de eso, se prepararon electrodos fuente / drenaje de bicapas de 30 nm Ti / 70 nm Au mediante evaporación por haz de electrones y un método de despegue. No se aplicaron más procesos de recocido en estos dispositivos.
Las propiedades eléctricas de los TFT a-IGZO se caracterizaron utilizando un analizador de dispositivos semiconductores (Agilent Tech B1500A) en una caja oscura a temperatura ambiente. Las estabilidades del dispositivo se midieron bajo tensiones de polarización de puerta positivas y negativas, respectivamente. Los perfiles de profundidad de los elementos y la composición química se midieron mediante espectrometría de masas de iones secundarios (SIMS) y espectroscopía de fotoelectrones de rayos X (XPS), respectivamente.
Resultados y discusión
La figura 1a compara las constantes dieléctricas del Al 2 O 3 películas depositadas a diferentes temperaturas en función de la frecuencia (es decir, de 10 Hz a 10 5 Hz). A medida que la temperatura de deposición aumenta de 100 a 150 ° C, la película muestra una disminución gradual de la constante dieléctrica. También se informó una tendencia similar en la literatura anterior para el cambio de temperatura de deposición de RT a 150 ° C [18, 19]. Esto se debe a que el RT Al 2 O 3 La película contiene la mayor concentración de hidrógeno (H) en forma de grupos OH. Por lo tanto, la constante dieléctrica correspondiente se mejora debido a una rotación de más grupos OH en un campo eléctrico [20]. En términos de la frecuencia de medición de 10 Hz, las constantes dieléctricas extraídas para el RT, 100 ° C y 150 ° C Al 2 O 3 películas son iguales a 8,6, 7,9 y 7,4, respectivamente, que se utilizan para la extracción de la movilidad de efecto de campo ( μ FE ) y densidad de trampa interfacial ( D eso ) del dispositivo TFT fabricado. La Figura 1b muestra las características de la corriente de fuga de diferentes Al 2 O 3 Película (s. Se encuentra que el RT Al 2 O 3 la película presenta una pequeña densidad de corriente de fuga de 2,38 × 10 - 8 A / cm 2 a 2 MV / cm y un campo eléctrico de ruptura de 5,3 MV / cm. Además, el campo eléctrico de ruptura aumenta gradualmente al aumentar la temperatura de deposición de 100 a 150 ° C.
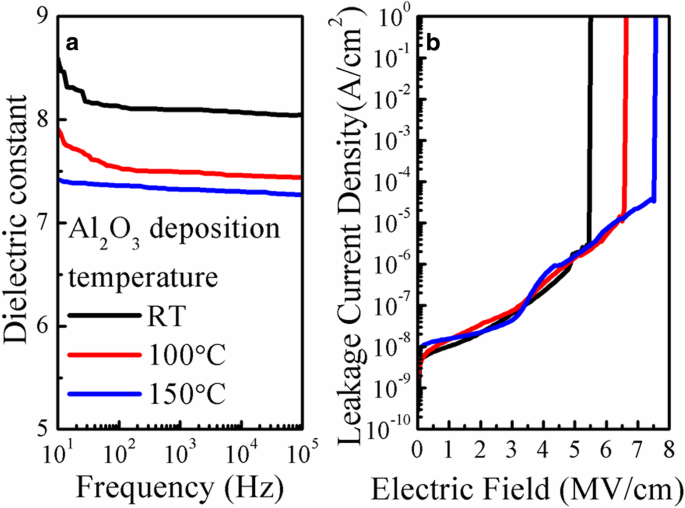
Propiedades eléctricas de Al 2 O 3 películas depositadas a diferentes temperaturas. un Constante dieléctrica versus frecuencia. b Densidad de corriente de fuga versus campo eléctrico
La Figura 2 muestra las curvas de transferencia típicas de los TFT a-IGZO con diferentes Al 2 O 3 aisladores de puerta. El RT Al 2 O 3 TFT presenta el mejor rendimiento, como una alta μ FE de 19,5 cm 2 V - 1 s - 1 , una pequeña oscilación de subumbral (SS) de 160 mV / dec, una pequeña tensión de umbral ( V T ) de 0,1 V y una gran relación de corriente de encendido / apagado ( I activar / desactivar ) de 4,5 × 10 8 . Sin embargo, los TFT a-IGZO con Al 2 O 3 Los aisladores de compuerta depositados a 100 y 150 ° C muestran un rendimiento mucho más pobre, es decir, corrientes de encendido reducidas (10 - 7 y 3 × 10 - 9 A) y SS degradados. La D eso en la interfaz de Al 2 O 3 / a-IGZO se puede calcular basándose en la siguiente ecuación [21]:
$$ {D} _ {\ mathrm {it}} =\ left (\ frac {\ mathrm {SS} \ times \ lg e} {kT / q} -1 \ right) \ frac {C_ {ox}} { q ^ 2} $$ (1)donde e , k , T y q representan el número de Euler, la constante de Boltzmann, la temperatura absoluta y la carga electrónica unitaria, respectivamente. C buey es la capacitancia dieléctrica de la puerta por unidad de área. Para RT Al 2 O 3 TFT, la D eso es igual a 1,1 × 10 12 eV - 1 cm - 2 , que es más de una o dos veces menor que las de los TFT con Al 2 O 3 aisladores de puerta depositados a 100 y 150 ° C.

Transferir curvas de los TFT a-IGZO con ALD Al 2 O 3 aisladores de compuerta depositados a diferentes temperaturas junto con los parámetros del dispositivo extraídos
Las estabilidades de polarización de la puerta de los dispositivos se midieron además aplicando voltajes negativos y positivos. La Figura 3 muestra la V T cambio en función del tiempo de tensión de sesgo para diferentes TFT. En términos de tensión de polarización de puerta negativa (NGBS), el RT Al 2 O 3 TFT presenta una V insignificante T cambio de - 0.04 V después de ser estresado a - 10 V durante 40 min. Sin embargo, el Al 2 de temperatura más alta O 3 los aisladores de la puerta generan una V más grande T cambios especialmente para 150 ° C. Una estabilidad NGBS tan alta para RT Al 2 O 3 debe atribuirse a una baja concentración de vacantes de oxígeno ( V O ) en el canal a-IGZO [22]. Con respecto a la tensión de polarización de puerta positiva (PGBS), el RT Al 2 O 3 TFT muestra una V T desplazamiento de 1,47 V, que es mucho más pequeño que los (8,8 V y 12,1 V) para 100 y 150 ° C Al 2 O 3 TFT. Además, se investigó la influencia del tiempo de almacenamiento en el rendimiento del dispositivo, como se muestra en la Fig. 4. Aunque no se cubre ninguna capa de pasivación en el canal posterior, el dispositivo aún mantiene un rendimiento excelente después de guardarlo en un gabinete (20% de HR). durante 60 días a 30 ° C; mientras tanto, no hay variaciones significativas en μ FE y SS se observan. Esto indica el RT Al 2 O 3 Los TFT sin ninguna capa de pasivación tienen una buena estabilidad dependiente del tiempo de almacenamiento en el ambiente actual.

V T cambio en función del tiempo de tensión de polarización bajo NGBS =- 10 V y PGBS =10 V para los TFT con Al 2 O 3 aisladores depositados a diferentes temperaturas

Estabilidad dependiente del tiempo de RT Al 2 O 3 TFT después de ser guardado en un gabinete (20% RH) a 30 ° C. un Transferencia de curvas. b Movilidad y oscilación por debajo del umbral
La Tabla 1 compara el rendimiento de nuestro RT Al 2 O 3 TFT con otros informes. Se encuentra que nuestro dispositivo exhibe una V cercana a cero T , SS más pequeño y I más grande activar / desactivar en el caso de movilidad comparable [4, 23]. Aunque use un Ta 2 O 5 El aislador de la puerta puede obtener una mayor movilidad de 61,5 cm 2 V - 1 s - 1 , tanto SS como I activar / desactivar deteriorarse notablemente [10]. En una palabra, nuestro RT Al 2 O 3 TFT posee un rendimiento completo superior en comparación con 100 y 150 ° C Al 2 O 3 TFT. Dado que todos los pasos de procesamiento son idénticos excepto el paso de deposición de Al 2 O 3 , diferencias tan significativas en el rendimiento eléctrico deben originarse en el Al 2 O 3 aisladores de puerta.
Para comprender el mecanismo subyacente, los perfiles de profundidad de los elementos en el a-IGZO / Al 2 O 3 Las películas apiladas fueron analizadas por SMIS. La Figura 5a muestra la dependencia de la concentración de H de la profundidad en las pilas de IGZO / Al 2 O 3 , donde el Al 2 O 3 las películas se depositaron a temperatura ambiente y 150 ° C, respectivamente. A modo de comparación, también se analizó una película de IGZO depositada sobre un sustrato de Si desnudo. La película IGZO depositada sobre Si desnudo contiene una concentración de H de ~ 3 × 10 21 cm - 3 , que se origina a partir del gas residual en el sistema de pulverización catódica y absorbió H 2 / H 2 O moléculas en la superficie de Si. Ambas películas IGZO depositadas en el Al 2 O 3 Las películas contienen concentraciones de H más altas que las del sustrato de Si desnudo. Esto indica que el aumento de las concentraciones de H debe provenir de la liberación de impurezas de H en el Al 2 subyacente. O 3 películas durante la pulverización catódica de IGZO. Además, se observa que la concentración de H en la película IGZO encima del RT Al 2 O 3 La película es más alta que la de 150 ° C en la región cercana a la interfaz, lo que puede proporcionar una pasivación más eficiente de los estados interfaciales. Esto mejora así la estabilidad SS y PGBS del RT Al 2 O 3 TFT al reducir el atrapamiento de portadores interfaciales. Además, los espectros O 1s XPS de las películas a-IGZO cerca de la interfaz de IGZO / Al 2 O 3 fueron analizados, como se muestra en la Fig. 5b. Los picos ajustados se ubican en 530,2 ± 0,1 eV, 530,9 ± 0,1 eV y 531,6 ± 0,1 eV, correspondientes a O 2− iones unidos con metal (O1), V O (O2) y grupos OH (O3), respectivamente [13, 24]. El porcentaje de O2 es del 26,3% en la capa a-IGZO encima del Si desnudo; sin embargo, disminuye a 12,3% y 6,8% para 150 ° C y RT Al 2 O 3 películas subyacentes, respectivamente. Esto indica que más V O en el canal IGZO puede pasivarse eficazmente por las impurezas de H adicionales que se originan en el Al 2 subyacente O 3 películas, especialmente para RT Al 2 O 3 película con una concentración de H más alta. Se informa que cuando V O y H están presentes en la película a-IGZO, pueden combinarse para formar un estado estable en el que H está atrapado en V O ( V O H), y la V resultante O H es un donante de nivel superficial [25, 26, 27]. Por lo tanto, dopaje H mejorado en el canal IGZO encima del RT Al 2 O 3 mejora la conductividad del canal proporcionando electrones adicionales. Además, la pequeña V T cambiar bajo el NGBS para el RT Al 2 O 3 TFT también se puede atribuir a la pasivación H efectiva de V O [28]. Como se informa en la literatura, la inestabilidad de TFT bajo NGBS se origina por la ionización de V neutro O ( V O → V O 2+ + 2e - ) [17, 29]. Además, el porcentaje de O3 de la película a-IGZO en el RT Al 2 O 3 es del 6,9%, que es superior a los de 150 ° C Al 2 O 3 (5,3%) y el Si desnudo (4,6%), respectivamente. El grupo OH podría originarse a partir de la reacción O 2− + H → OH - + E - durante la deposición de películas IGZO [30]. Por lo tanto, el dopaje H mejorado en el canal IGZO encima del RT Al 2 O 3 La película genera más grupos OH y también contribuye a mejorar la conductividad del canal.

un Perfiles SIMS de concentración de hidrógeno en Al 2 O 3 depositado a TA y 150 ° C. b Espectros XPS de O1s de alta resolución del canal IGZO depositados en RT Al 2 O 3 , 150 ° C Al 2 O 3 y desnudo Si
Conclusiones
Se fabricó con éxito un a-IGZO TFT de alto rendimiento bajo el presupuesto térmico extremadamente bajo de RT utilizando un Al 2 rico en H O 3 dieléctrico de puerta preparado por O 2 ALD mejorada con plasma. Esto se atribuye al hecho de que el Al 2 O 3 El dieléctrico depositado a TA contiene más impurezas de hidrógeno que las depositadas a temperaturas más altas. Por lo tanto, las impurezas de H liberadas durante la pulverización catódica de IGZO generaron más electrones y pasivaron de manera eficiente los estados interfaciales de a-IGZO / Al 2 O 3 y la V O en el canal a-IGZO.
Abreviaturas
- a-IGZO:
-
Amorfo In-Ga-Zn-O
- ALD:
-
Deposición de la capa atómica
- D eso :
-
Densidad de la trampa interfacial
- H:
-
Hidrógeno
- I activar / desactivar :
-
Relación de corriente de encendido / apagado
- NGBS:
-
Tensión de sesgo de puerta negativa
- PGBS:
-
Tensión de polarización de puerta positiva
- RT:
-
Temperatura ambiente
- SIMS:
-
Espectrometría de masas de iones secundarios
- SS:
-
Oscilación del subumbral
- TFT:
-
Transistor de película fina
- V O :
-
Vacante de oxígeno
- V O H:
-
Hidrógeno atrapado en la vacante de oxígeno
- V T :
-
Voltaje umbral
- XPS:
-
Espectroscopia de fotoelectrones de rayos X
- μ FE :
-
Movilidad de efecto de campo
Nanomateriales
- Accesorios de impresión 3D con materiales de alto rendimiento
- Uso de resina epoxi con obras de arte
- Control completo de polarización de terahercios con ancho de banda ampliado a través de metauperficies dieléctricas
- Transistores de efecto de campo de nanoflake SnSe multicapa con contactos au óhmicos de baja resistencia
- Gran mejora de la conductividad térmica del compuesto de silicona con nanocables de cobre ultralargos
- Fabricación de nanopatrón ordenado utilizando copolímero ABC Triblock con sal en tolueno
- Electrodo de puerta plateado impreso con inyección de tinta y curado por UV con baja resistividad eléctrica
- RGO y redes de grafeno tridimensionales co-modificadas TIM con alto rendimiento
- Deposición de capa atómica de nanopelículas de óxido de indio para transistores de película delgada
- Mejora del rendimiento del dispositivo a-IGZO TFT mediante un proceso de interfaz limpia a través de nanocapas Etch-Stopper
- Preparación y caracterización de transistores de película fina de CuAlO2 nanocristalinos de tipo p procesados en solución



