Estudios experimentales y teóricos del contacto de Mo / Au Schottky en una película delgada de β-Ga2O3 exfoliada mecánicamente
Resumen
Estudiamos el mecanismo de emisión de corriente inversa del Mo / β-Ga 2 O 3 Diodo de barrera Schottky a través de las características de corriente-voltaje (IV) dependientes de la temperatura de 298 a 423 K. La variación de la corriente inversa con el campo eléctrico indica que la emisión de Schottky es el mecanismo de transporte de la portadora dominante bajo polarización inversa en lugar de Frenkel-Poole modelo de emisión asistida por trampa. Además, se obtuvo una tensión de ruptura de 300 V en ambiente Fluorinert con un campo eléctrico promedio de 3 MV / cm en Mo / β-Ga 2 O 3 Diodo de barrera Schottky. Los efectos de los estados de la superficie, sobre la distribución del campo eléctrico, también fueron analizados mediante simulación TCAD. Con el aumento de las densidades de carga de la superficie negativa, el campo eléctrico máximo se reduce de manera monótona. Además, también se discutió la falta de homogeneidad de la altura de la barrera de Schottky bajo el sesgo hacia adelante.
Antecedentes
Recientemente, el semiconductor de banda prohibida ultra ancha β-Ga 2 O 3 ha atraído muchos intereses por sus excelentes características, como alta estabilidad química, gran banda prohibida directa de 4,8 a 4,9 eV, campo eléctrico de alta ruptura teórica ( E BR ) de 8 MV / cm, y la alta figura de mérito de Baliga de 3400, que es unas diez veces mayor que la del SiC y cuatro veces mayor que la del GaN [1, 2, 3]. La combinación de todas estas propiedades con la alta calidad, área grande y rentable β-Ga 2 O 3 el sustrato cultivado mediante técnicas de crecimiento en fusión hace que la β-Ga 2 O 3 un material preferido para aplicaciones de electrónica de alta tensión y alta potencia [4, 5, 6, 7, 8, 9]. Como dispositivo electrónico prometedor, β-Ga 2 O 3 Los diodos de barrera Schottky (SBD) se fabricaron con varios metales de electrodo de ánodo, incluidos Cu [8], Pd [10], Pt [5, 6, 11,12,13], Au [10, 14], Ni [13, 15 , 16,17,18] y TiN [12], y sus características eléctricas de avance y retroceso, como la resistencia específica de encendido, I en / Yo desactivado La relación, las alturas de las barreras, la corriente de fuga inversa y la tensión de ruptura se investigaron exhaustivamente. La altura de barrera de Schottky no homogénea y la corriente de polarización inversa no saturada se informaron en β-Ga 2 O 3 SBDs [6, 8, 11, 18, 19] mientras que se conocía mucha menos información sobre el mecanismo de transporte de portadora bajo polarización inversa, que es esencial para la mejora del voltaje de ruptura.
Además, no se ha realizado ninguna investigación para analizar los mecanismos de emisión de Mo / β-Ga 2 O 3 contacto. Si hay algunas trampas o defectos en el β-Ga 2 O 3 del sustrato, se encontrará que la corriente de fuga está de acuerdo con el modelo de emisión de Frenkel-Poole, y la corriente inversa es la emisión de electrones de un estado atrapado cerca de la interfaz metal-semiconductor. De lo contrario, el proceso principal en corriente inversa estará dominado por la emisión de Schottky de que los electrones sobre la barrera de Schottky dan como resultado una corriente inversa. β-Ga 2 O 3 El cristal también tiene una propiedad única, una gran constante de celosía de 12,23 Å a lo largo de la dirección [100], que permite una escisión fácil en cinturones delgados o nanomembranas [9, 20]. Entonces, en este trabajo, exfoliamos mecánicamente β-Ga 2 a gran escala O 3 a partir del sustrato a granel de baja densidad de dislocación y, por primera vez, se eligió el molibdeno (Mo) térmicamente estable como el metal del electrodo del ánodo para fabricar el β-Ga 2 O 3 diodos de barrera vertical Schottky. El mecanismo de conducción eléctrica bajo el sesgo inverso se discutió en el rango de temperatura de 298 a 423 K. Este trabajo proporciona información sobre los mecanismos de transporte de portadores que pueden ayudar a mejorar las funcionalidades de β-Ga 2 O 3 dispositivos basados en.
Métodos / Experimental
Como se muestra en la Fig. 1a, b, el diodo de barrera Schottky se fabricó en el β-Ga 2 O 3 (100) película exfoliada mecánicamente del β-Ga 2 dopado con Sn O 3 sustrato, con un espesor de 15 μm y una concentración de electrones de 2 × 10 17 cm - 3 . Como se presenta en la Fig.1d, e, el ancho completo a la mitad del máximo (FWHM) y la raíz cuadrada media (RMS) se estimaron en 51.9 arcsec y 0.19 nm, respectivamente, por difracción de rayos X de alta resolución (HRXRD) y atómica mediciones de microscopio de fuerza (AFM). La medición confirmó la excelente calidad del cristal y la superficie lisa. Después de la limpieza química húmeda, la pila de metal de Ti / Au (20 nm / 100 nm) se depositó usando evaporación por haz de E en la parte posterior y seguido por el recocido térmico rápido (RTA) a 600 ° C durante 60 s bajo una atmósfera de nitrógeno para formar el contacto óhmico. Los electrodos circulares de ánodo de Schottky con diámetros de 100 μm se formaron en la parte frontal por evaporación de metales Mo / Au (40 nm / 100 nm) y proceso de despegue. La Figura 1c muestra la estructura de la sección transversal esquemática del β-Ga 2 O 3 SBD en este trabajo.
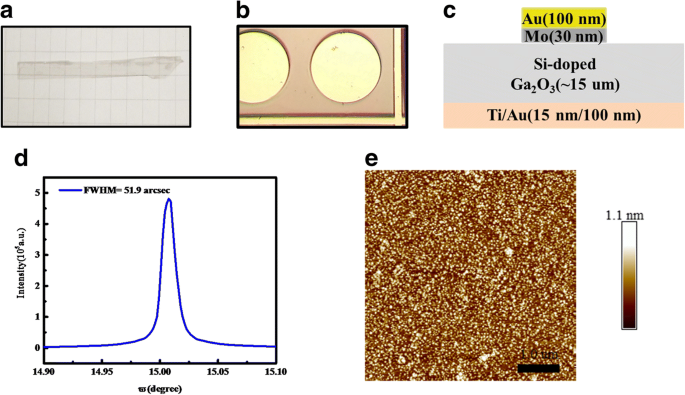
un El β-Ga 2 dopado con Sn O 3 sustrato con un espesor de 300 μm. b Los electrodos del ánodo de Schottky se formaron en la parte frontal con diámetros de 100 μm. c La estructura del esquema transversal a la sección del β-Ga 2 O 3 SBD. d Curva oscilante XRD y e Imagen AFM del β-Ga 2 O 3 capa de deriva exfoliada mecánicamente de (100) β-Ga 2 O 3 sustrato
Resultados y discusión
Las características de corriente-voltaje (I-V) de Au / Mo / β-Ga 2 O 3 Los diodos de barrera Schottky se investigaron utilizando un sistema de caracterización de semiconductores Keithley 4200 entre 298 y 423 K. Como se muestra en la Fig. 2a, el I en / Yo desactivado la proporción es cercana a 10 10 a 298 K, lo que indica un buen comportamiento rectificador. Para la polarización directa de 0,1 a 0,7 V, las curvas I-V semilogarítmicas son casi lineales y muestran un fuerte comportamiento de dependencia de la temperatura. Con la polarización directa aumentando aún más, la desviación de la linealidad de las curvas IV se atribuye a la resistencia en serie del diodo de barrera Schottky y la relación entre el voltaje aplicado y la corriente se puede expresar como \ (I ={I} _s \ left \ {\ exp \ left [\ frac {q \ left (V- {IR} _s \ right)} {nkT} \ right] -1 \ right \} \) [21,22,23], donde V es el voltaje aplicado, R s la resistencia en serie, T la temperatura absoluta, k la constante de Boltzmann, n el factor ideal, y yo s es la corriente de saturación inversa. El n y yo s se puede determinar a partir de la pendiente y la intersección del ln Gráficos I-V, respectivamente. Para el diodo de barrera Schottky ideal, el factor de idealidad n debe ser igual a la unidad. Cuanto mayor sea la n , mayor es la desviación del modelo de emisión térmica (TE). Además, de acuerdo con la ecuación \ ({\ phi} _b =\ frac {kT} {q} \ ln \ left [\ frac {AA ^ {\ ast} {T} ^ 2} {I_s} \ right] \ ) [21,22,23], los valores de ϕ b a diferentes temperaturas también se determinaron, como se muestra en la Fig. 2b, donde ϕ b es la altura de la barrera, A es el área del diodo y A * es la constante de Richard efectiva 40,8 A cm −2 K - 2 con el β-Ga 2 O 3 masa efectiva de m * = 0,34 m 0 [5, 24]. Con el aumento de temperatura de 298 a 423 K, el ϕ b aumenta mientras n disminuye, lo que indica otro mecanismo de transporte que también contribuye al transporte actual y conduce a la desviación de las características I-V del modelo TE puro, que se informó anteriormente en β-Ga 2 O 3 Diodos de barrera Schottky [25] y otros dispositivos con banda prohibida amplia [26,27,28,29,30]. El análisis de inhomogeneidad de la altura de la barrera se puede describir mediante una distribución gaussiana en las alturas de la barrera,
$$ {\ phi} _b =\ overline {\ phi_ {b0}} \ left (T =0 \ right) - \ frac {q {\ sigma} _s ^ 2} {2 kT} $$ (1)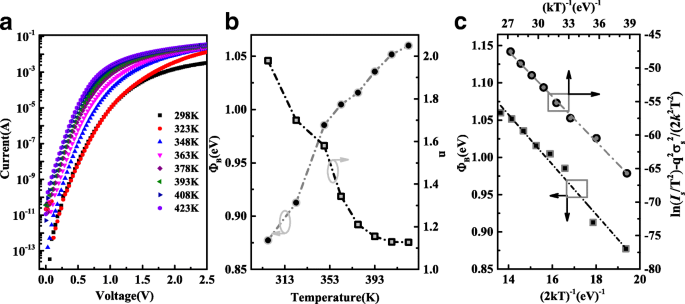
un Características de avance I-V de Mo / β-Ga 2 O 3 Diodos de barrera Schottky a diferentes temperaturas. b Dependencia de la temperatura del factor de idealidad y la altura de la barrera de Schottky de β-Ga 2 O 3 Diodo de barrera Schottky. c Parcelas de ϕ ap versus q / 2 k Gráfico de T y Richardson modificado versus 1 / k T para el β-Ga 2 O 3 Diodos de barrera Schottky
Los valores de la altura media de la barrera \ (\ overline {\ phi_ {b0}} \) y la desviación estándar σ s se extraen para ser 1,55 eV y 0,186 eV, respectivamente, de la Fig. 2c. Además, considerando las inhomogeneidades de la altura de la barrera, el gráfico de Richardson convencional se modifica de la siguiente manera:
$$ \ ln \ left (\ frac {I _ {\ mathrm {s}}} {T ^ 2} \ right) - \ left (\ frac {q ^ 2 {\ sigma} _ {\ mathrm {s}} ^ 2} {2 {k} ^ 2 {T} ^ 2} \ right) =\ ln \ left ({AA} ^ {\ ast} \ right) - \ frac {q \ overline {\ phi_ {b0}}} {kT} $$ (2)Como se muestra en la Fig. 2c, el \ (\ ln \ left ({I} _ {\ mathrm {s}} / {T} ^ 2 \ right) modificado - \ left ({q} ^ 2 {\ sigma} _ {\ mathrm {s}} ^ 2/2 {k} ^ 2 {T} ^ 2 \ right) \) versus 1 / kT es una línea recta. La intersección de la curva se usa para obtener la A * de 44,7 A cm −2 K −2 , que está muy cerca del valor teórico de β-Ga 2 O 3 de 40,8 A cm −2 k −2 . Por lo tanto, las inhomogeneidades de la barrera en la interfaz metal / semiconductor para β-Ga 2 O 3 El SBD se puede explicar mediante TE con una distribución gaussiana de la barrera sobre los SBH.
La medición de ruptura inversa a temperatura ambiente también se llevó a cabo utilizando el sistema analizador de semiconductores de alto voltaje Agilent B1505A, como se muestra en la Fig. 3. La tensión de ruptura fue de 260 V mientras que fue de 300 V con la muestra sumergida en Fluorinert ™ producido por la empresa 3M. que puede prevenir la degradación del aire bajo alta polarización inversa. Para comprender la distribución del campo eléctrico, se realizó una simulación numérica con el software ATLAS, como se muestra en la Fig. 4a, b. A medida que aumenta la distancia desde la interfaz entre el semiconductor y el ánodo hasta aproximadamente 1 μm, el campo eléctrico disminuye gradualmente. En la posición de x =4 μm, el campo eléctrico promedio es de 3 MV / cm, calculado a partir de la Fig. 4c. También se muestra en la Fig. 4d, en la posición de y =1 nm, el campo eléctrico máximo a la tensión de ruptura fue de aproximadamente 8 MV / cm en el borde del contacto Schottky, que es aproximadamente 2,7 veces el del campo eléctrico promedio. Según lo informado por AJ Green et al [31] y K. Zeng et al [32], el campo eléctrico pico y el campo eléctrico promedio del borde del electrodo fueron 5.3, 3.8 MV / cm y 6.1, 4.4 MV / cm, respectivamente, y el campo eléctrico máximo de Mo / Ga 2 O 3 El diodo Schottky es relativamente alto. Se supone que el β-Ga 2 O 3 La nanomembrana obtenida por exfoliación mecánica tiene un gran número de enlaces colgantes y estados superficiales que capturan electrones para agotar los portadores de ánodo a cátodo bajo polarización inversa [33]. Teniendo en cuenta la carga superficial negativa, el resultado de la simulación mostró que el campo eléctrico en el borde del contacto de Schottky se redujo con densidades de carga superficial negativas que aumentaron de 0.5 × 10 13 cm −2 hasta 3 × 10 13 cm −2 , respectivamente. Especialmente con las densidades de carga superficial negativa de 3 × 10 13 cm −2 , el campo eléctrico máximo en el borde del contacto Schottky es de aproximadamente 5,2 MV / cm. Por lo tanto, la tensión de ruptura inversa de 300 V se puede lograr en el β-Ga 2 O 3 nanomembrana con N D =3 × 10 17 cm −2 sin estructuras de terminación de borde. Como se muestra en la Fig. 4d, debido a la existencia de un estado de interfaz en X -posición por debajo de 2 μm, los electrones pueden quedar atrapados y se puede formar la región de agotamiento, lo que da como resultado el campo eléctrico en la Y dirección. A medida que aumenta la concentración del estado de la interfaz, el campo eléctrico en Y dirección aumenta, aunque el campo eléctrico en la X la dirección se aproxima a cero. Entonces el campo eléctrico aumenta en X -posición por debajo de 2 μm.
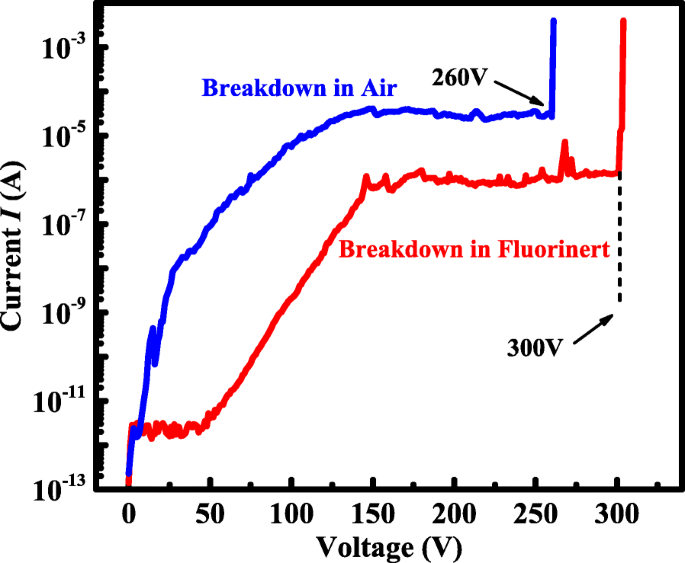
Las características I-V inversas del β-Ga 2 O 3 muestras a temperatura ambiente en flúor y aire respectivamente

un Simulación de campo eléctrico TCAD fuera de estado de los diodos de barrera Schottky con polarización de - 300 V. b La simulación del campo eléctrico de las regiones seleccionadas en un cuadro de trazos verdes. El potencial a lo largo del y eje en x =4 μm está presente en ( c ), y el campo eléctrico en el borde del contacto de Schottky reducido con diferentes densidades de carga de superficie negativas efectivas están presentes en ( d )
Por otro lado, con el sesgo inverso V re aumentando, la corriente de fuga I re aumenta en lugar de saturar para | V |> 3 k B T / q , como se muestra en la Fig. 5a, que es inconsistente con la teoría TE. Por lo tanto, se consideró la emisión termoiónica mejorada del campo eléctrico para discutir la dependencia de la I re en V re , incluyendo la emisión de Poole-Frenkel y la emisión de Schottky [34, 35]. En la emisión de Poole-Frenkel, los electrones se transportan del metal al semiconductor a través de un estado atrapado y el I re está dado por
$$ {I} _ {re} \ propto E \ exp \ left (\ frac {q} {kT} \ sqrt {\ frac {qE} {{\ pi \ varepsilon} _S}} \ right) $$ (3 )mientras que en la emisión de Schottky, los electrones ganarán suficiente energía para superar la barrera en el metal / semiconductor para formar la corriente y el I re puede ser expresado por
$$ {I} _ {re} \ propto {T} ^ 2 \ exp \ left (\ frac {q} {2 kT} \ sqrt {\ frac {qE} {{\ pi \ varepsilon} _S}} \ right ) $$ (4)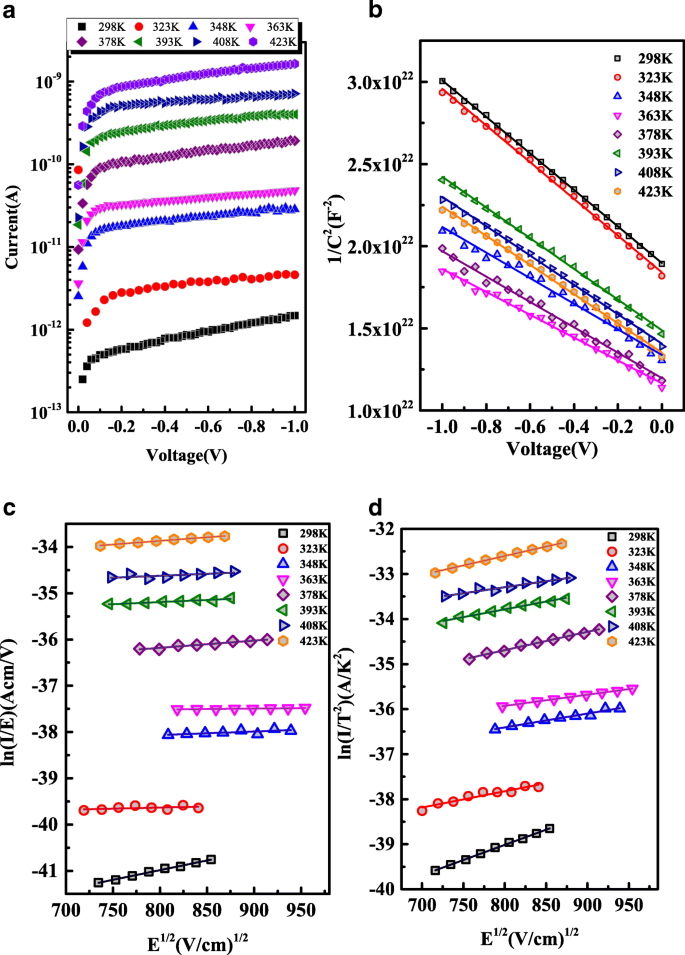
un Características I-V inversas de Mo / β-Ga 2 O 3 Diodos de barrera Schottky a diferentes temperaturas. b Dependencia de la temperatura de 1 / C 2 características del Mo / β-Ga 2 O 3 Diodos de barrera Schottky. El análisis de dependencia del campo eléctrico de Mo / β-Ga 2 O 3 Contacto de Schottky con diferentes mecanismos. c Mecanismo de Poole-Frenkel ( I / E ) versus E 1/2 y d Mecanismo de Schottky ln ( Yo / T 2 ) versus E 1/2
donde ε s es la permitividad del β-Ga 2 O 3 (~ 10 ε 0 ) y E es el campo eléctrico aplicado, calculado por \ (E \ kern0.5em =\ kern0.5em \ sqrt {\ frac {2 {qN} _D} {\ varepsilon_S} \ left (V + {V} _ {bi} - \ frac {k_BT} {q} \ right)} \), N D es la densidad del donante de β-Ga 2 O 3 y V bi es el potencial incorporado. Como se muestra en la Fig. 5b, N D y V bi se puede extraer de la pendiente y la intersección de la capacitancia del cuadrado inverso (1 / C 2 ) frente a la V re traza usando la siguiente expresión
$$ \ frac {1} {C ^ 2} =\ frac {2 \ left ({V} _ {\ mathrm {bi}} - kT / qV \ right)} {q {\ varepsilon} _s {A} ^ 2 {N} _D} $$ (5)Si la curva de ln ( I / T 2 ) versus E 1/2 es lineal, el mecanismo de emisión de Schottky es dominante. Y si la trama de ln ( Yo / E ) versus E 1/2 En el transatlántico, la emisión de Poole-Frenkel domina el transporte de corriente inversa. La Figura 5c, d muestra las gráficas de ln ( Yo / E ) y ln ( Yo / T 2 ) versus E 1/2 , respectivamente. Ambos conjuntos de curvas son lineales, lo que indica que no solo están presentes la emisión de Poole-Frenkel sino también la emisión de Schottky. Para aclarar el mecanismo de transporte de la portadora dominante, la pendiente de las curvas o el coeficiente de emisión se pueden expresar como [34,35,36].
$$ S =\ frac {q} {nkT} \ sqrt {\ frac {q} {\ pi \ varepsilon}} $$ (6)donde n =1 es para la emisión de Poole-Frenkel ( S PF ) y n =2 para la emisión Schottky ( S S ). Los valores experimentales de S se indican como S m-PF y S m-S para la emisión de Poole-Frenkel y Schottky dada por la pendiente de las curvas en la Fig. 5c, d, respectivamente. Las relaciones entre el valor experimental y el valor teórico, N PF (= S m-PF / S PF ) y N S (= S m-S / S S ), se muestran en la Fig. 6. Dado que los valores de N S están más cerca de la unidad que los de N PF , la corriente inversa está dominada por la emisión Schottky.

Gráficas de coeficientes relativos de la emisión de Poole-Frenkel N PF (= S m-PF / S PF ) y emisión de Schottky N S (= S m-S / S S ) versus temperatura
Conclusiones
Hemos investigado las características eléctricas de los diodos de barrera Mo / Au Schottky fabricados en el (100) β-Ga 2 O 3 película exfoliada mecánicamente del β-Ga 2 dopado con Sn O 3 sustrato. Sobre la base del modelo TE, el ϕ extraído b y n aumenta y disminuye con el aumento de temperatura, respectivamente. Suponiendo la distribución gaussiana de la altura de la barrera no homogénea, se obtuvieron la altura media de la barrera de 1,55 eV y la desviación estándar de 0,186 eV . Finalmente, según el ln ( Yo / T 2 ) y ln ( Yo / E ) versus E 1/2 parcelas, el parámetro N S de la emisión de Schottky está cerca de la unidad, lo que ilustra que la emisión de Schottky es el mecanismo de transporte dominante de la corriente inversa. La tensión de ruptura de 300 V con muestras en Fluorinert se obtiene en diodos de barrera Schottky Mo / Au con un campo eléctrico promedio de 3 MV / cm, indicando el gran potencial de β-Ga 2 O 3 para aplicaciones de electrónica de potencia.
Abreviaturas
- I-V:
-
Corriente-voltaje
- Mo:
-
Molibdeno
- RTA:
-
Recocido térmico rápido
- SBD:
-
Diodo de barrera Schottky
- TE:
-
Emisión termoiónica
Nanomateriales
- Investigación experimental sobre la estabilidad y la convección natural de nanofluidos de agua-TiO2 en recintos con diferentes ángulos de rotación
- El efecto del plasma de no equilibrio por contacto sobre las propiedades estructurales y magnéticas de Mn Х Fe3 - X О4 Espinelas
- Estudio experimental sobre las características de flujo y transferencia de calor de nanofluidos de agua-TiO2 en un tubo estriado en espiral
- Fabricación de películas delgadas de SrGe2 en sustratos Ge (100), (110) y (111)
- Nanoconjuntos de ácido 5-aminolevulínico-escualeno para fotodetección y terapia de tumores:estudios in vitro
- Estudio de la fuerza de adhesión y la transición vítrea de películas delgadas de poliestireno mediante microscopía de fuerza atómica
- Preparación y características termoeléctricas de ITO / PtRh:termopar de película fina PtRh
- Estudios TEM y STEM sobre las morfologías transversales de películas antirreflectantes de SiO2 de banda ancha de doble / triple capa
- Estudios teóricos sobre fotodiodos de avalancha de InGaAs / InAlAs SAGCM
- Una simulación teórica de las respuestas a la radiación de la superrejilla de Si, Ge y Si / Ge a la irradiación de baja energía
- Comprensión del mecanismo de crecimiento de las capas epitaxiales de GaN en grafito exfoliado mecánicamente



