Estudio de los primeros principios de los defectos puntuales en la superrejilla de GaAs / AlAs:la estabilidad de fase y los efectos sobre la estructura de la banda y la movilidad del portador
Resumen
Las superredes de semiconductores avanzados desempeñan un papel importante en las futuras aplicaciones críticas de alta tecnología, como la aeroespacial, la física de altas energías, la detección de ondas gravitacionales, la astronomía y las áreas relacionadas con la energía nuclear. En condiciones tan extremas como entornos de alta irradiación, estas superredes de semiconductores tienden a generar varios defectos que, en última instancia, pueden resultar en la falla de los dispositivos. Sin embargo, en la superrejilla como GaAs / AlAs, la estabilidad de fase y el impacto en el rendimiento del dispositivo de los defectos puntuales aún no están claros hasta la fecha. Los cálculos actuales muestran que en la superrejilla de GaAs / AlAs, los defectos antisitio son energéticamente más favorables que los defectos de vacancia e intersticial. El As X (X =Al o Ga) y X As los defectos siempre inducen la metalicidad de la superrejilla de GaAs / AlAs, y Ga Al y Al Ga Los defectos antisitio tienen efectos leves sobre la estructura electrónica. Para la superrejilla de GaAs / AlAs con defectos intersticiales o de vacancia, se encuentra una reducción significativa de la banda prohibida o la metalicidad inducida. Otros cálculos muestran que los defectos intersticiales y de vacancia reducen significativamente la movilidad de los electrones, mientras que los defectos antisitio tienen influencias relativamente menores. Los resultados avanzan en la comprensión de los efectos del daño por radiación de la superrejilla de GaAs / AlAs, que por lo tanto proporciona una guía para el diseño de sistemas electrónicos y optoelectrónicos basados en superredes de semiconductores altamente estables y duraderos para aplicaciones en entornos extremos.
Antecedentes
La superrejilla (SL) es un material artificial que consta de capas delgadas alternas de dos o más componentes diferentes. Los (GaAs) n / (AlAs) m es uno de los SL más importantes desde el desarrollo de los transistores de alta movilidad de electrones (HEMT) y los láseres de cascada cuántica (QCL) hace unas décadas [1,2,3,4,5,6]. Recientemente, con los avances de las técnicas de epitaxia y nanofabricación de películas, las (GaAs) n / (AlAs) m Los SL y nanodispositivos basados en (n + m) que van de 2 a 10 han demostrado propiedades físicas interesantes relacionadas con la luminiscencia y la absorción óptica, la absorción de dos fonones y el Raman, así como los espectros infrarrojos, que por lo tanto encontraron aplicaciones prometedoras en optoelectrónica, detección, Áreas civiles e industriales relacionadas con LED, energía y láser [7,8,9,10,11,12]. Mientras tanto, hacia otras aplicaciones críticas de alta tecnología como la industria aeroespacial, la física de alta energía, la detección de ondas gravitacionales, la astronomía, los viajes espaciales, áreas relacionadas con la seguridad nuclear y nacional, los SL de semiconductores y los dispositivos están expuestos a diferentes entornos de radiación, es decir, X- rayos, neutrones, electrones, iones, etc., que pueden resultar en la generación de defectos que contengan impurezas, vacantes, intersticiales, antisitios y complejos de estos. Dado que los materiales semiconductores y las propiedades físicas relacionadas desempeñan un papel importante en el funcionamiento y funcionamiento de estos dispositivos electrónicos y circuitos integrados, pequeñas cantidades de defectos pueden cambiar drásticamente sus propiedades ópticas y de transporte, especialmente en sistemas multicapa [13].
Los efectos de las impurezas extrañas o los defectos intrínsecos en los semiconductores SL y los materiales que los componen se han investigado exhaustivamente en las últimas décadas. Zollo y col. han empleado el método de la teoría funcional de la densidad (DFT) para investigar la estabilidad de los defectos puntuales en GaAs, y han descubierto que los defectos antisitio eran más favorables [14]. Kahaly y col. han estudiado la estructura de GaAs / AlAs SL mediante el método DFT y han encontrado la vacante de arsénico (V As ) un defecto en y cerca de la interfaz condujo a una conducción cuasi 2-DEG entre el arseniuro dieléctrico aislante [7]. Spasov y col. han estudiado los efectos de las impurezas de nitrógeno sobre el transporte de portadores y la recombinación de huecos de electrones en diodos SL de GaAs / AlAs [9]. Informaron que las impurezas de N modificaron la energía de la minibanda electrónica e impidieron la difusión de electrones a través de la minibanda SL, lo que puede conducir a una fuerte recombinación radiativa de pares de electrones y huecos [9]. Wang y col. estudiaron la interdifusión inducida por la impureza de Zn en estructuras de GaAs / AlAs SL empleando un ab initio método de dinámica molecular (AIMD) [15]. Sus resultados sugirieron que la difusión de Zn fue asistida por los elementos del grupo III, que fueron expulsados al canal intersticial y se difundieron rápidamente, alterando así la superrejilla [15]. Mitra y Stark encontraron que la presencia de vacantes mejoraba la mezcla de Ga / Al en GaAs / AlAs SL, como resultado del mecanismo de difusión de anillo de dos átomos propuesto [16]. Recientemente, se ha realizado una simulación AIMD de la respuesta a la radiación de GaAs / AlAs SL [17], en la que se han determinado las energías mínimas para que cada átomo sea desplazado permanentemente de su sitio de celosía, se han proporcionado las vías para la generación de defectos, y se han identificado los tipos de defectos creados. Reveló que la pareja Ga (o Al o As) Frenkel creada y As Ga -Ga Como El par antisitio tiene efectos profundos sobre la densidad de distribución de estado y la estructura de banda de GaAs / AlAs SL [17].
Hasta ahora, la estabilidad de los defectos puntuales en la estructura de SL y las propiedades de transporte como la movilidad del transportador siguen siendo desconocidas. Por tanto, es de vital importancia investigar cómo la presencia de defectos de vacantes, intersticiales y antisitio influye en la estabilidad estructural y las propiedades eléctricas de GaAs / AlAs SL. En este estudio, la estabilidad de fase de un solo Ga (o Al o As) vacante, un solo Ga (o Al o As) intersticial y un solo Ga As (o Al Como o como Ga o como Al ) Se han estudiado los defectos antisitio. Se demuestra que los defectos antisitio son energéticamente más favorables que los defectos de vacante e intersticial. Las estructuras de banda de estos estados defectuosos se han investigado mediante el método híbrido DFT, que incorpora una parte del intercambio exacto de la teoría de Hartree-Fock con el resto de la energía de correlación de intercambio de otras fuentes ( ab initio o empírica) [18], y se espera que ofrezca una descripción más precisa de la estructura electrónica de los materiales semiconductores que la DFT estándar. En particular, se ha predicho la movilidad de los electrones. Resulta que los defectos intersticiales y de vacancia reducen significativamente la movilidad de los electrones, mientras que los defectos antisitio tienen influencias relativamente menores. Este trabajo avanzará en la comprensión de los efectos del daño por radiación de la superrejilla de semiconductores y proporcionará una guía para el diseño de sistemas electrónicos y optoelectrónicos basados en superredes de semiconductores altamente estables y duraderos para aplicaciones en entornos extremos.
Métodos
En este estudio, las relajaciones estructurales se llevan a cabo dentro del marco DFT estándar y las estructuras de banda se calculan mediante el DFT híbrido en el marco de Heyd-Scuseria-Emzefhof (HSE) [19] basado en las estructuras relajadas. Todos los cálculos se llevan a cabo empleando Viena Ab Initio Paquete de simulación (VASP) [20]. Los pseudopotenciales de onda aumentada del proyector se utilizan para describir la interacción entre iones y electrones, y los efectos de intercambio-correlación se tratan utilizando la aproximación de densidad local en la parametrización de Ceperley-Alder [21]. Los criterios de convergencia para las energías y fuerzas totales son 10 −4 eV y 10 −3 eV / Å, respectivamente. El grupo de puntos de origen del cristal de AlAs y GaAs es el T d grupo de mezcla de zinc, como se muestra en la Fig. 1a. La ilustración de los defectos puntuales considerados se proporciona en la Fig. 1b. En este estudio se considera el GaAs / AlAs SL que contiene dos monocapas de GaAs alternadas con dos monocapas de AlAs y la configuración geométrica se ilustra en la Fig. 2, junto con los defectos puntuales considerados.

Vista esquemática de estructuras geométricas de a XAs (X =Ga o Al); b los defectos en XAs. V X :(X =Ga, Al o As) X vacante; X int :X intersticial; X Como :X ocupa el sitio de celosía As; Como X :Como ocupando el sitio de celosía X. Las esferas amarilla y violeta representan la vacante y los defectos intersticiales, respectivamente

Vista esquemática de estructuras geométricas de a superrejilla ideal de GaAs / AlAs; b y c Superrejilla de GaAs / AlAs con diferentes defectos puntuales. X Y :(X, Y =Ga, Al o As) X ocupa el sitio de la red Y; V X :X vacante; X int :X intersticial. Las esferas amarilla y carmín representan la vacante y los defectos intersticiales, respectivamente
Resultados y discusión
Propiedades del estado fundamental de GaAs y AlAs
Como se muestra en la Tabla 1, las constantes de celosía de GaAs y AlAs a granel se determinan en 5,61 y 5,63 Å, respectivamente, lo que concuerda bien con los valores experimentales y otros teóricos [22,23,24]. Parece que el desajuste de la red entre GaAs y AlAs es pequeño, y la constante de red de GaAs / AlAs SL se establece en el valor intermedio de 5,62 Å. El módulo volumétrico se calcula mediante \ (B =\ frac {1} {3} \ left ({C} _ {11} +2 {C} _ {12} \ right) \) [25], donde C 11 y C 12 representan las constantes elásticas. El módulo volumétrico de GaAs se calcula en 76,3 GPa, que está cerca del resultado de 76,5 GPa para AlAs. Estos resultados concuerdan razonablemente con los datos teóricos y experimentales [22, 26, 27].
La energía de formación de defectos en la superrejilla de GaAs / AlAs
Para GaAs / AlAs SL y estados generales, la energía de formación del defecto se calcula mediante \ ({E} _f ={E} _ {def} - {E} _ {undef} + \ sum \ limits_i \ Delta {n} _i { \ mu} _i \) [28]. Aquí, E def es la energía total de la celda de simulación defectuosa después de la relajación, E undef es la energía total de la supercélula ideal relajada, Δ n i es el cambio en el número de especies i ( yo =Ga, Al o As) y μ i es el potencial químico de las especies i [28].
Para XA masivos (X =Al o Ga), los potenciales químicos de As y X obedecen a las siguientes restricciones:\ ({\ mu} _X \ le {\ mu} _X ^ {bulk} \), \ ({\ mu} _ {As} \ le {\ mu} _ {As} ^ {bulk} \) y \ ({\ mu} _ {As} + {\ mu} _X ={\ mu} _ {XAs} ^ {bulk } \), donde \ ({\ mu} _X ^ {bulk} \), \ ({\ mu} _ {As} ^ {bulk} \) y \ ({\ mu} _ {XAs} ^ {bulk } \) corresponden a la energía total de la masa X, la masa As y la masa XA, respectivamente. Las energías de formación de defectos en condiciones ricas en X, es decir, \ ({\ mu} _X ={\ mu} _X ^ {bulk} \) y \ ({\ mu} _ {As} ={\ mu} _ {XAs } ^ {bulk} - {\ mu} _X ^ {bulk} \) y condición rica en As, es decir, \ ({\ mu} _ {As} ={\ mu} _ {As} ^ {bulk} \ ) y \ ({\ mu} _X ={\ mu} _ {XAs} ^ {bulk} - {\ mu} _ {As} ^ {bulk} \), se resumen en la Tabla 2. Para GaAs, en As- condiciones ricas el As Ga (Al ocupar el sitio de la red de Ga) se encuentra que el defecto antisitio es el más favorable desde el punto de vista energético, como lo indica la energía de formación más pequeña de 1,57 eV. El siguiente defecto favorable es el Ga As (Ga ocupando el sitio de celosía As) defecto antisitio, con energía de formación de 2,31 eV. El intersticial As (As int ) tiene la energía de formación más grande de 5,20 eV, lo que sugiere que es más difícil de formar que otros defectos puntuales considerados. En condiciones ricas en Ga, el V Ga , Como int y como Ga defectos tienen mayores energías de formación, y el V As , Ga int y Ga As los defectos tienen energías de formación más pequeñas, en comparación con la condición rica en As. Evidentemente, la estabilidad del defecto depende del entorno químico. En comparación con GaAs, las energías de formación de defectos en AlAs son generalmente mayores, excepto en los casos de As int y como X (X =Al o Ga) en condiciones ricas en As. El As Al y Al As Se determina que los defectos antisitio son el defecto más favorable en condiciones ricas en As y ricas en Al, respectivamente. Similar al caso de GaAs, el As int También es desfavorable en AlAs. Las energías de formación de defectos en condiciones ricas en As y ricas en X (X =Ga o Al) en XA a granel se representan en la Fig. 3. La Figura 3a muestra que el As Ga y Ga As los defectos de antisitio son más favorables en condiciones ricas en As y ricas en Ga, respectivamente. Se observa que el As Al El defecto antisitio es preferible en la mayoría de los casos (ver Fig. 3b). En condiciones ricas en Al, la estabilidad de fase de Al As , V Como y como Al los defectos están próximos entre sí, como lo indican las energías de formación de 3,0, 3,16 y 3,24 eV, respectivamente. Además, encontramos que tanto en GaAs como en AlAs, la no favorabilidad de As int es independiente del entorno químico. Zollo y col. llevaron a cabo cálculos de primeros principios en GaAs y sus resultados de DFT mostraron que las energías de formación de As Ga y Ga As fueron más pequeños que los de vacantes y defectos intersticiales [14], que son consistentes con nuestros resultados.
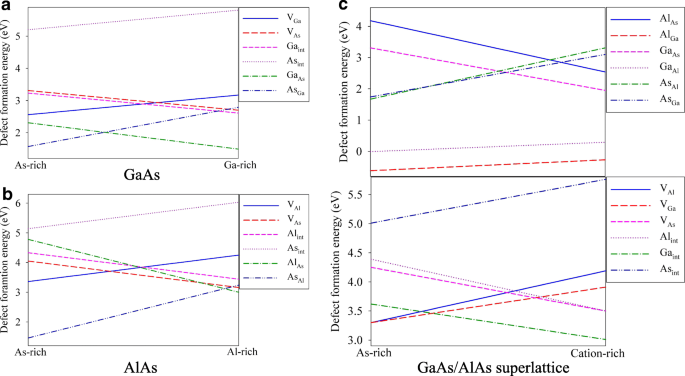
Las energías de formación de defectos en condiciones ricas en As y ricas en cationes en a GaAs, b AlAs y c Superrejilla de GaAs / AlAs. X Y :(X, Y =Ga, Al o As) X ocupa el sitio de la red Y; V X :X vacante; X int :X intersticial
El E f en la estructura de GaAs / AlAs SL también se calculan bajo la condición As-rich, es decir, \ ({\ mu} _ {As} ={\ mu} _ {As} ^ {bulk} \), \ ({\ mu} _ {Al} ={\ mu} _ {Al As} ^ {bulk} - {\ mu} _ {As} ^ {bulk} \) y \ ({\ mu} _ {Ga} ={\ mu} _ {Ga As} ^ {bulk} - {\ mu} _ {As} ^ {bulk} \) y condición rica en cationes, es decir, \ ({\ mu} _ {Al} ={\ mu} _ {Al } ^ {bulk} \), \ ({\ mu} _ {Ga} ={\ mu} _ {Ga} ^ {bulk} \) y \ ({\ mu} _ {As} =\ left ({\ mu} _ {SL} ^ {bulk} - {n} _ {Al} \ times {\ mu} _ {Al} ^ {bulk} - {n} _ {Ga} \ times {\ mu} _ {Ga} ^ {bulk} \ right) / {n} _ {As} \), donde n Al , n Ga y n Como representan el número de átomos de Al, Ga y As en la celda de simulación, respectivamente. Como se muestra en la Tabla 3, el Al Ga El defecto tiene energías de formación negativas, es decir, - 0,62 y - 0,27 eV en condiciones ricas en As y ricas en cationes, respectivamente, lo que indica que la formación de Al Ga El defecto antisitio es un proceso exotérmico. En cuanto a Ga Al defecto, las energías de formación son tan pequeñas como - 0,01 eV en condiciones ricas en As y 0,29 eV en condiciones ricas en cationes. Obviamente, la formación de Al Ga y Ga Al Los defectos antisitio en la estructura de GaAs / AlAs SL son mucho más fáciles que otros defectos puntuales. En condición rica en As, las energías de formación de los segundos defectos favorables de As Ga y como Al se determinan en 1,67 y 1,74 eV, respectivamente. Para los intersticiales, la estabilidad de fase sigue la tendencia de Ga int > Al int > Como int en condiciones ricas en As y ricas en cationes. Las energías de formación de defectos en la estructura de GaAs / AlAs SL también se representan en la Fig. 3c. En comparación con los GaAs a granel, los defectos puntuales en GaAs / AlAs SL son generalmente más difíciles de formar, excepto en el caso de As int (ver Fig. 3a, c). Las energías de formación de As int a granel, los GaAs son 5,20 y 5,81 eV en condiciones ricas en As y ricas en Ga, que son ligeramente mayores que los valores correspondientes de 5,01 y 5,76 eV en GaAs / AlAs SL. Como se muestra en la Fig. 3b yc, la estabilidad de los defectos puntuales en la estructura de AlAs y SL a granel muestra un carácter diferente. El Al As y como int Los defectos son energéticamente más favorables en GaAs / AlAs SL que los AlAs a granel, mientras que V As El defecto es más preferible en la estructura de AlA a granel que en SL. Es notable que en condiciones ricas en As y Al, las energías de formación de Al int a granel, los AlA son comparables a los de GaAs / AlAs SL. Similar al caso de Al int , el V Al El defecto en la estructura de AlAs y SL muestra una preferencia similar, como lo indican las energías de formación comparables. En el caso de As Al defecto, la energía de formación en condiciones ricas en As es menor (1,46 eV) en la estructura SL, mientras que en condiciones ricas en cationes, el valor es menor (3,10 eV) en los AlA a granel, lo que sugiere que la estabilidad de As Al depende del entorno químico.
Comparando la estabilidad de defectos en AlAs, GaAs y GaAs / AlAs SL a granel, encontramos que los defectos antisitio son siempre más preferibles que las vacantes e intersticiales, especialmente para los casos de Ga Al y Al Ga en GaAs / AlAs SL. También se observa que en condiciones ricas en As y ricas en cationes, el As int El defecto es el más difícil de formar tanto en los estados generales como en la estructura de GaAs / AlAs SL.
Los efectos de los defectos puntuales en las estructuras de banda de la superrejilla de GaAs / AlAs
El estado prístino de la superrejilla de GaAs / AlAs
Las brechas de banda para GaAs, AlAs y GaAs / AlAs SL a granel se resumen en la Tabla 4, y sus estructuras de banda se presentan en la Fig. 4. Los cálculos de DFT híbrida determinan que la brecha de banda directa de GaAs es de 1,44 eV (ver Fig. 4a ), que concuerda bien con el valor experimental de 1,52 eV [29] y otros cálculos [24]. Por el contrario, la DFT estándar predice un valor de banda prohibida de 0,5 eV, que subestima en gran medida la banda prohibida de GaAs. Para los AlA, la estructura de bandas es de carácter indirecto y la banda prohibida híbrida DFT es 2,16 eV (ver Fig. 4b), que es 0,85 eV mayor que el resultado DFT y concuerda bien con el valor experimental de 2,22 eV [23]. Como se muestra en la Fig. 4c, se determina que la banda prohibida de GaAs / AlAs SL es directa y es consistente con el estudio de Botti et al., Quienes encontraron la banda prohibida de (GaAs) m / (AlAs) m SL (m ≥ 2) debe ser directo en el punto Γ [3]. En nuestros cálculos, se determina que la banda prohibida directa para GaAs / AlAs SL es 2,06 eV mediante el método híbrido DFT, que está de acuerdo con el valor experimental de 2,10 eV [30].

Las estructuras de bandas de a GaAs, b AlAs y c Superrejilla de GaAs / AlAs. Los valores de DFT híbridos se trazan en los paneles de la izquierda y los resultados de DFT se trazan en los paneles de la derecha
Los efectos de los defectos antisitio en la estructura de banda de la superrejilla de GaAs / AlAs
En la estructura de GaAs / AlAs SL, el Ga Al y Al Ga Los defectos antisitio son energéticamente más favorables que otros defectos puntuales. Como se muestra en la Fig. 5a yb, las estructuras de banda de Ga Al y Al Ga los estados defectuosos son muy similares a los del estado prístino y se determina que los espacios de banda son 1,98 y 2,01 eV, respectivamente. Esto debería deberse al hecho de que los elementos químicos Al y Ga tienen una configuración de electrones de valencia similar, es decir, 3s 2 3p 1 para Al y 4s 2 4p 1 para Ga, y no se introducen electrones ni huecos adicionales tras la formación de Ga Al y Al Ga defectos antisitio. Las estructuras de banda para As Ga y como Al los estados defectuosos se muestran en la Fig. 5c y d. Resulta que estos dos defectos modifican considerablemente la estructura de bandas de GaAs / AlAs SL. Tanto el As Ga y como Al los defectos de antisitio introducen electrones adicionales y actúan como dopantes de tipo n. Se encuentra que los niveles de impurezas están lejos de las bandas de valencia y cruzan el nivel de fermi, como se muestra en la Fig. 5c y d. Estos niveles de defectos profundos pueden actuar como centro de recombinación para los portadores.

Las estructuras de bandas de la superrejilla de GaAs / AlAs defectuosa con diferentes defectos de antisitio. un :Ga ocupando el sitio de celosía de Al; b :Al ocupar el sitio de celosía de Ga; c :Como ocupando el sitio de celosía de Ga; d :Como ocupar el sitio de celosía de Al
La Figura 6 presenta las estructuras de banda y la densidad de estado parcial (PDOS) de SL defectuoso con Ga As y Al As defectos. Como se muestra en la Fig. 6a, la estructura de bandas para Ga As SL defectuoso es de carácter separador de spin. En las subbandas de spin-down, el nivel de fermi pasa a través de los niveles de defecto introducidos por el Ga As defecto, indicativo de carácter semimetálico del SL defectuoso. De acuerdo con la definición de brecha semimetálica [31], la brecha de banda de Ga As el estado defectuoso es de aproximadamente 0,10 eV. Como se muestra en el PDOS del SL defectuoso con Ga As , las subbandas de spin-down cercanas al nivel fermi son principalmente contribuidas por p ondas parciales. Debido a las configuraciones de electrones de valencia similares entre los átomos de Ga y Al, las estructuras de bandas de spin-up y spin-down calculadas de Al As Se determinan los estados defectuosos (ver Fig. 6b) y se calcula que la banda prohibida es de 0,15 eV. En general, el Al Ga y Ga Al Los defectos antisitio tienen efectos insignificantes en la estructura electrónica de GaAs / AlAs SL. También se observa que el SL defectuoso con As Al y como Ga los defectos muestran metalicidad, mientras que los SL defectuosos con Ga As y Al As son semimetálicas.

Las estructuras de bandas y la densidad parcial del estado de la superrejilla de GaAs / AlAs defectuosa con a Ga Como y b Al Como defectos antisitio. X Como (X =Ga o Al) X ocupando el sitio de celosía As
Los efectos de los defectos de vacantes en la estructura de banda de la superrejilla de GaAs / AlAs
Las estructuras de banda de la estructura de SL con diferentes vacantes se representan en la Fig. 7, y sus correspondientes PDOS se muestran en la Fig. 8. El carácter de división de espín de la estructura de banda también se encuentra en el caso de SL defectuoso con V Ga y V Al defectos, como se muestra en la Fig. 7a y b. De hecho, la eliminación de átomos de sus posiciones originales deja cuatro enlaces colgantes relacionados con el sp 3 orbitales. Durante la relajación estructural, los átomos más cercanos alrededor de la vacante se desplazan igualmente hacia el sitio de celosía vacío, lo que da como resultado la simetría del sitio definida por la D tetragonal 2 d grupo de puntos. Los niveles de defectos inducidos aparecen cerca de la banda de valencia y se localizan en la región prohibida de GaAs / AlAs SL. Se determina que la banda prohibida es de 0,47 y 0,44 eV para el SL con V Ga y V Al defectos, respectivamente. Como se muestra en el PDOS de SL defectuoso con V Ga y V Al (ver Fig. 8a yb), la principal influencia de las vacantes del grupo III está en la p estados. Como se muestra en la Fig. 7c, la estructura de la banda del SL defectuoso con V As el defecto se divide en partes de giro hacia arriba y hacia abajo, y los niveles de defecto aparecen cerca de la banda de conducción. Dado que la V As El defecto actúa como un dopante de tipo n, el nivel de fermi se desplaza a una energía superior y cruza el borde del nivel del defecto. Kahaly y col. han investigado las propiedades eléctricas de las heterointerfaces GaAs-AlAs y han descubierto que V As defecto en la interfaz conducen a cuasi 2-DEG [7], lo cual es consistente con nuestros resultados. Nuestros cálculos muestran que las vacantes tienen diferentes efectos en la estructura de bandas de GaAs / AlAs SL, es decir, el V As El defecto induce la metalicidad de GaAs / AlAs SL, y el V Ga y V Al los defectos reducen significativamente la banda prohibida de la estructura SL.

Las estructuras de bandas de la superrejilla de GaAs / AlAs defectuosa con a V Ga , b V Al y c V Como defectos de vacante. V X (X =Ga, Al o As) X vacante

La densidad parcial del estado de la superrejilla de GaAs / AlAs defectuosa con a V Ga , b V Al y c V Como defectos de vacante. V X (X =Ga, Al o As) X vacante
Los efectos de los defectos intersticiales en la estructura de banda de la superrejilla de GaAs / AlAs
La Figura 9 presenta las estructuras de bandas de la estructura SL con defectos intersticiales. Se observa que el nivel de fermi cambia a alta energía y cruza el borde de la banda de conducción (ver Fig. 9a yb), debido al hecho de que los intersticiales del grupo III son defectos de tipo donante. En consecuencia, las SL defectuosas con Ga int y Al int mostrar carácter metálico. Como se muestra en la Fig. 9c, en las partes de giro hacia arriba y hacia abajo de la estructura de la banda, los niveles de impurezas aparecen cerca de la banda de conducción y el nivel de fermi cruza el borde del nivel de impureza, lo que indica la metalicidad inducida de GaAs / AlAs SL defectuoso con Como int . Obviamente, los defectos intersticiales cambian significativamente las estructuras electrónicas de GaAs / AlAs SL y generalmente inducen la metalicidad de la estructura SL defectuosa.

Las estructuras de bandas de la superrejilla de GaAs / AlAs defectuosa con a Ga int defecto, b Al int defecto y c Como int defecto. X int (X =Ga, Al o As) X intersticial
Comparando las estructuras de banda y PDOS representativos de GaAs / AlAs SL con antisitios, vacantes e intersticiales, encontramos que los defectos modifican considerablemente las estructuras electrónicas, excepto los casos de Ga Al y Al Ga defectos antisitio. Además, se induce el estrechamiento de la banda prohibida e incluso la metalicidad, lo que influirá drásticamente en el rendimiento de GaAs / AlAs SL.
Los efectos de los defectos puntuales en la movilidad electrónica de la superrejilla de GaAs / AlAs
La movilidad de los electrones a 0 K se puede calcular a partir de la ecuación μ = eτ / m ∗ , donde e es la carga del electrón, τ es el tiempo de relajación, y m ∗ es la masa efectiva del portador [32]. Las masas efectivas de los electrones se pueden evaluar a partir de la curvatura de las estructuras de bandas mediante la relación \ ({m} ^ {\ ast} ={\ mathrm {\ hslash}} ^ 2 {\ left (\ frac {d ^ 2 \ varepsilon } {dk ^ 2} \ right)} ^ {- 1} \) [32], donde ℏ es la constante de Planck reducida, k es el vector de onda y ε es la energía de la banda de conducción mínima. Como se muestra en la Fig. 4a yb, obtenemos m * =0,057 m e para GaAs y m * =0,19 m e para AlA, concordando bien con los valores experimentales de 0.057 m e para GaAs [33] y 0,124 m e para AlAs [34], donde m e es la masa del electrón estático. Se supone que el tiempo de relajación para AlAs y GaAs es de 0,17 y 0,48 ps, respectivamente [35]. Se calcula que la movilidad electrónica de GaAs y AlAs a 0 K es 1,48 × 10 4 cm 2 / Vs y 1,57 × 10 3 cm 2 / Vs, respectivamente, que es comparable a los valores experimentales de 0,94 × 10 4 cm 2 / Vs para GaAs [36] y 0,28 × 10 3 cm 2 / Vs para AlAs [37].
Como se muestra en la Tabla 5, se determina que la masa efectiva del electrón en el punto Г (\ ({m} _ {\ Gamma} ^ {\ ast} \)) es 0.113 m e para el prístino GaAs / AlAs SL y el tiempo de relajación τ se supone que es 0,4 ps [38]. La movilidad del electrón a lo largo de la dirección z, es decir, la dirección Γ-X en la zona de Brillouin ( μ Γ - X ) se calcula en 0,623 × 10 4 cm 2 / Vs para GaAs / AlAs SL ideal, que es comparable al valor experimental de 1.0 × 10 4 cm 2 / Vs [38]. En cuanto al SL defectuoso con defectos antisitio, el valor de μ Γ - X es comparable con el del SL ideal, excepto en los casos de Ga As y Al As defectos. Se determina que la movilidad de los electrones a lo largo de la dirección Γ-X es de 0,263 × 10 4 cm 2 / Vs y 0.311 × 10 4 cm 2 / Vs para Ga As y Al As estados defectuosos, respectivamente, que son mucho más pequeños que los del estado ideal. Se observa que el Ga int , Al int y como int Los defectos también reducen significativamente la movilidad de los electrones, como lo indican los valores de 0,225 × 10 4 cm 2 / Vs para Ga int , 0,243 × 10 4 cm 2 / Vs para Al int y 0,315 × 10 4 cm 2 / Vs para As int . En comparación con el defecto antisitio e intersticial, las vacantes tienen los efectos más profundos. Para V Ga y V Al defectos, los valores de μ Γ - X son aproximadamente seis veces más pequeñas que las del estado prístino. La V As El defecto también disminuye significativamente la movilidad de los electrones, como lo indica 0.127 × 10 4 cm 2 / Vs. Tanaka y col. han investigado los efectos de la irradiación de electrones sobre las propiedades eléctricas de las heteroestructuras de GaAs / AlGaAs y han descubierto que la movilidad de los electrones se reduce a dosis superiores a 5 × 10 20 cm −2 [10]. Especialmente, se cree que la creación de defectos en la región del canal de GaAs, en lugar de la capa n-AlGaAs, es la principal causa de la degradación de la movilidad [10]. Recientemente, se ha sugerido que los electrones posiblemente estén atrapados por defectos o impurezas y produzcan estados metaestables acompañados de relajación reticular [39]. En consecuencia, la estructura electrónica y la movilidad del portador de GaAs / AlAs SL están influenciadas significativamente por los defectos puntuales. Por lo tanto, es necesario mejorar la tolerancia a la radiación de GaAs / AlAs SL para mejorar su rendimiento electrónico en entornos de radiación.
Conclusiones
En este trabajo, se realiza un estudio de teoría funcional de densidad híbrida para investigar los efectos del defecto puntual en las propiedades eléctricas de la superrejilla de GaAs / AlAs (SL). Las energías de formación de defectos calculadas muestran que los defectos antisitio son los más favorables en GaAs y AlAs a granel. En la estructura de GaAs / AlAs SL, los defectos antisitios son siempre dominantes en condiciones ricas en cationes y ricos en As y los defectos intersticiales son muy difíciles de formar durante toda la gama de potenciales químicos. Se muestra que los diferentes defectos puntuales tienen diversos efectos sobre las estructuras electrónicas de GaAs / AlAs SL. El As X (X =Al o Ga) y X As Los defectos antisitio siempre inducen metalicidad, aunque los SL defectuosos con X As los antisitios muestran rotura de espín. En cuanto a las vacantes, el SL defectuoso con V As muestra carácter de metalicidad, y los defectos de vacantes del grupo III reducen significativamente la banda prohibida de la superrejilla. La metalicidad también se encuentra en el GaAs / AlAs SL defectuoso con los defectos intersticiales. Los cálculos de movilidad de portadora adicionales muestran que los defectos intersticiales y de vacancia reducen significativamente la movilidad de los electrones, mientras que los defectos antisitio tienen una influencia relativamente menor.
Abreviaturas
- 2-GRADOS:
-
Gas de electrones bidimensionales
- AIMD:
-
Ab initio dinámica molecular
- Al:
-
Aluminio
- AlAs:
-
Arseniuro de aluminio
- Como:
-
Arsénico
- Como X :
-
Como ocupando el sitio de celosía X
- DFT:
-
Teoría funcional de la densidad
- Ga:
-
Galio
- GaAs:
-
Arseniuro de galio
- HEMT:
-
Transistores de alta movilidad de electrones
- HSE:
-
Heyd-Scuseria-Emzefhof
- LED:
-
Diodo emisor de luz
- N:
-
Nitrógeno
- PDOS:
-
Densidad parcial del estado
- QCL:
-
Láseres de cascada cuántica
- SL:
-
Superrejilla
- VASP:
-
Viena Ab Initio Paquete de simulación
- V X (X =Ga, Al o As):
-
X vacante
- X Como :
-
X ocupando el sitio de celosía As
- X int :
-
X intersticial
- Zn:
-
Zinc
Nanomateriales
- Presentación de la estructura atómica y electrónica de las nanofibras de carbono de copa apilada
- Absorbedor perfecto de banda ultra estrecha y su aplicación como sensor plasmónico en la región visible
- Estudio de los primeros principios sobre la estabilidad y la imagen STM del borofeno
- Efecto del tratamiento de recocido in situ sobre la movilidad y morfología de transistores de efecto de campo orgánico basados en TIPS-pentaceno
- Los efectos de la relación Li / Nb en la preparación y el rendimiento fotocatalítico de los compuestos Li-Nb-O
- Influencia del agua en la estructura y propiedades dieléctricas de la microcristalina y nanocelulosa
- Efectos del espesor de la bicapa en las propiedades morfológicas, ópticas y eléctricas de los nanolaminados de Al2O3 / ZnO
- Estudio experimental sobre las características de flujo y transferencia de calor de nanofluidos de agua-TiO2 en un tubo estriado en espiral
- Los efectos de acoplamiento de los polaritones de plasma superficial y las resonancias magnéticas dipolo en metamateriales
- Estudio sobre la memoria de conmutación de resistencia multinivel y el fotovoltaje dependiente del estado de la memoria en uniones Pt / Nd:SrTiO3
- Diseño y ajuste de la función de trabajo del grafeno mediante tamaño, modificación, defectos y dopaje:un estudio de teoría del primer principio



