Efecto fotovoltaico lateral grande en heterounión MoS2 / GaAs
Resumen
Disulfuro de molibdeno (MoS 2 ) las películas a nanoescala se depositan en sustratos de GaAs mediante la técnica de pulverización catódica con magnetrón y MoS 2 Se fabrican heterouniones / GaAs. El efecto fotovoltaico lateral (LPE) del MoS 2 fabricado Se investigan las heterouniones de / GaAs. Los resultados muestran que se puede obtener un LPE grande en el MoS 2 / n -Herounión GaAs. El LPE muestra una dependencia lineal de la posición de la iluminación láser y la sensibilidad considerablemente alta de 416,4 mV mm - 1 . Esta sensibilidad es mucho mayor que los valores en otros MoS 2 informados -dispositivos basados en. Comparativamente, el LPE en el MoS 2 / p -La heterounión GaAs es mucho más débil. Los mecanismos del LPE se revelan mediante la construcción de la alineación de la banda de energía del MoS 2 / Heterouniones de GaAs. Las excelentes características de LPE hacen que MoS 2 películas combinadas con semiconductores de GaAs prometedores candidatos para la aplicación de detectores sensibles a la posición de alto rendimiento.
Antecedentes
Debido a sus excelentes propiedades, el disulfuro de molibdeno (MoS 2 ) se está investigando como un tipo típico de materiales bidimensionales para desarrollar dispositivos microelectrónicos y optoelectrónicos de próxima generación [1, 2, 3, 4, 5]. A diferencia del grafeno, MoS 2 tiene un intervalo de banda obvio y su intervalo de banda disminuye al aumentar el número de capas [6]. La presencia de la banda prohibida obvia permite la fabricación del MoS 2 transistores con una relación de encendido / apagado superior a 10 8 y los fotodetectores con alta capacidad de respuesta [7, 8]. Recientemente, MoS 2 combinado con otros semiconductores ha atraído mucho interés, como GaAs, Si y GaN [9,10,11,12,13]. Estas heteroestructuras diseñadas proporcionan una ruta técnica viable para MoS 2 -materiales basados en el desarrollo de dispositivos optoelectrónicos de aplicación práctica. Entre todos estos semiconductores a granel, GaAs tiene una banda prohibida directa adecuada de ~ 1,42 eV y una alta movilidad de electrones (~ 8000 cm 2 V −1 s −1 ). Lin y col. MoS 2 fabricado / Células solares de GaAs con una eficiencia de conversión de energía superior al 9,03% [9]. Además, Xu et al. informó un MoS 2 / Fotodetector autónomo de GaAs con una detección extremadamente alta de 3,5 × 10 13 Jones [10]. En informes anteriores, los estudios sobre MoS 2 / Las heteroestructuras de GaAs se han centrado principalmente en la aplicación en el área de células solares y fotodetectores. Sin embargo, el MoS 2 / GaAs como detector sensible a la posición (PSD) basado en el efecto fotovoltaico lateral (LPE) se ha informado en raras ocasiones. A diferencia del efecto fotovoltaico longitudinal ordinario, el LPE se origina a partir de la difusión lateral y la recombinación de los portadores generados por fotones en la capa de inversión en la interfaz [14, 15, 16, 17, 18]. En el efecto LPE, se puede obtener un fotovoltaje lateral (LPV) que cambia linealmente con la posición del punto láser en la región activa de la superficie del dispositivo. Estas características hacen que LPE sea muy útil en el desarrollo de PSD de alto rendimiento y se han estudiado ampliamente en el área de robótica, aplicaciones biomédicas, control de procesos, sistemas de información de posición, etc.
En este trabajo, MoS 2 películas delgadas con diferentes espesores se depositan en la superficie de n - / p -Sustratos de GaAs mediante técnica de pulverización catódica con magnetrón. Se observa un gran LPE en el MoS 2 fabricado / n -Herounión GaAs, y la sensibilidad alcanzó 416,4 mV mm −1 . Nuestros resultados muestran además que el LPE muestra una dependencia obvia de los tipos de portadores de los sustratos de GaAs y el grosor del MoS 2 Película (s. Mediante la construcción de la alineación de la banda de energía en la interfaz, se proponen los mecanismos para el LPE en los dispositivos.
Métodos
MoS 2 Se depositaron películas delgadas sobre sustratos de GaAs orientados (100) utilizando la técnica de pulverización catódica con magnetrón de CC. El MoS 2 los polvos (pureza, ~ 99%) se prensaron en frío en un disco bajo la presión de 20,0 MPa. El disco tal como estaba fabricado (Φ60,0 mm × 4,5 mm) se utilizó como objetivo durante la pulverización catódica. El n- / p -Se utilizaron sustratos de GaAs en nuestros experimentos, respectivamente. Antes de la deposición, los sustratos se limpiaron ultrasónicamente en secuencia con alcohol, acetona y agua desionizada. Posteriormente, MoS 2 películas delgadas con diferentes espesores ( d MoS2 =~ 10, 30, 50, 90 nm) se cultivaron sobre los sustratos de GaAs a la temperatura de 400 ° C, respectivamente. Durante la deposición, la presión de trabajo y la potencia se mantuvieron en 1,0 Pa y 10,0 W, respectivamente. Como referencia, MoS 2 También se depositaron películas delgadas en GaAs intrínsecos ( i -GaAs) substratos en las mismas condiciones. Finalmente, se presionaron electrodos en el MoS 2 de aproximadamente 300 μm In con un diámetro de 0,5 mm como electrodos película.
El MoS 2 Las películas se caracterizaron mediante espectroscopía Raman (HORIBA, HR800) con una longitud de onda de excitación de 488 nm. La superficie de la muestra se escaneó con un microscopio de fuerza atómica (AFM). La espectroscopia de fotoemisión de rayos X (XPS) se realizó mediante un espectrómetro Kratos Axis ULTRA con una fuente de rayos X monocromática de Al Kα. La tasa de deposición se obtuvo por el espesor del microscopio electrónico de barrido transversal (SEM) (archivo adicional 1:Figura S1) y el tiempo de deposición, luego cada espesor de película se determinó por la tasa de deposición y cada tiempo de deposición. Los espectros de transmisión se midieron con un espectrofotómetro Shimadzu UV-3150. La espectroscopia de fotoelectrones ultravioleta (UPS) se realizó utilizando una lámpara de descarga de gas He-I (21,22 eV) sin filtrar. Los LPV se midieron utilizando un voltímetro Keithley 2000 y una platina motorizada eléctrica tridimensional con un láser de longitud de onda de 650 nm como fuente de iluminación. La corriente-voltaje ( I - V ) las curvas se midieron con un Keithley 2400 SourceMeter.
Resultados y discusión
La Figura 1 muestra el espectro Raman de MoS 2 película sobre el sustrato de GaAs. Además del pico del sustrato de GaAs a ~ 287,1 cm −1 , dos MoS 2 característicos Se pueden ver los picos de Raman, el A 1g modo a ∼ 406,7 cm −1 y E 1 2g modo a ∼ 378,9 cm −1 . Los dos recuadros de la derecha muestran la ilustración de la vibración atómica en MoS 2 . El A 1g El modo corresponde a los átomos de S que oscilan en antifase a lo largo de la dirección fuera del plano, y el E 1 2g El modo corresponde a los átomos de S y Mo que oscilan en antifase paralelos al plano del cristal. Como se muestra en la figura, el pico Raman correspondiente al A 1g El modo está preferentemente emocionado por la película. Según nuestras mediciones, la relación de intensidad de A 1g / E 1 2g es aproximadamente 2.1. Estas características Raman son similares con otros resultados informados sobre MoS 2 películas delgadas [19]. El recuadro izquierdo muestra una imagen topográfica AFM del MoS 2 de 40 nm película cultivada sobre el sustrato de GaAs. En la figura, podemos ver que la superficie de la película está compuesta de densos granos en forma de cono. Según las mediciones, la rugosidad de la raíz cuadrada media (RMS) de la película es de aproximadamente 1,7 nm y el tamaño medio de los granos es de aproximadamente 76,3 nm de diámetro. Estos granos en la superficie podrían disminuir el reflejo de la superficie a la luz externa y mejorar la absorción de luz del dispositivo fabricado.

Espectro Raman del MoS 2 película sobre GaAs. Los dos recuadros de la derecha muestran las ilustraciones esquemáticas del modo oscilante de E 1 2g y A 1g , respectivamente. Código de color del átomo:azul-verde claro, Mo; amarillo, S. El recuadro izquierdo muestra la imagen de la morfología de la superficie del MoS 2 recién crecido películas
La Figura 2 muestra los espectros XPS del MoS 2 película. Como se muestra en la Fig. 2a, los picos en 229,3 y 232,5 eV están relacionados con el Mo 3d 5/2 y Mo 3d 3/2 orbitales, respectivamente. Como se muestra en la Fig. 2b, S 2p 3/2 y S 2p 1/2 orbitales de iones sulfuro divalentes (S 2− ) se observan en 162,2 y 163,3 eV, respectivamente. Los resultados concuerdan bien con los valores informados para el MoS 2 cristal [17, 18].

Espectros XPS del MoS 2 película para un Mo y b Elementos S, respectivamente
La figura 3a muestra la I longitudinal - V curva del MoS 2 fabricado / n -Herouniones GaAs. Se presionaron dos electrodos In con un diámetro de aproximadamente 0,5 mm sobre la superficie del MoS 2 película y la parte trasera de los GaAs, respectivamente. El recuadro muestra el circuito esquemático para las medidas longitudinales. El voltaje directo se define como un voltaje de polarización positivo aplicado en el electrodo de entrada superior. Como se muestra en la figura, el MoS 2 fabricado / n -La heterounión GaAs muestra un comportamiento rectificador obvio. La relación de rectificación ( I + / Yo - ) medido a ± 1.0 V es aproximadamente 520. En nuestros experimentos, tanto In / MoS 2 e In / GaAs pertenecen a contactos óhmicos y sus I - V las curvas son casi lineales. Por lo tanto, el I rectificador - V La característica en la heterounión se origina principalmente en el MoS 2 / Contacto de GaAs. La figura 3b muestra la I transversal - V curva del MoS 2 fabricado / n -Herouniones GaAs. Se presionaron dos electrodos In con un diámetro de aproximadamente 0,5 mm sobre la superficie del MoS 2 película. El recuadro superior muestra el circuito esquemático para las medidas transversales. De la figura, el I - V La curva muestra un aumento levemente no lineal de las corrientes con voltajes crecientes. Esto indica que una capa de inversión en el MoS 2 / n -Se forma la interfaz GaAs [18]. El recuadro inferior muestra el I - V curvas del único MoS 2 películas sobre el sustrato intrínseco de GaAs. De la figura, una I casi lineal - V se puede ver la curva, lo que indica además la naturaleza óhmica del In / MoS 2 contacto. A la tensión de + 0,5 V, la corriente del único MoS 2 es aproximadamente 3,1 × 10 −2 μA, mucho más pequeño que el valor en MoS 2 / n -GaAs, alrededor de 2,3 μA. Por lo tanto, en comparación con MoS 2 película, la capa de inversión en el MoS 2 / n -La interfaz GaAs proporciona una ruta con una resistividad mucho menor para el transporte de portadores durante las mediciones transversales del MoS 2 / n -Herounión GaAs.

un I longitudinal - V curva del MoS 2 fabricado / n -Herouniones GaAs. El recuadro muestra el circuito esquemático para las medidas longitudinales. b Transversal I - V curvas del MoS 2 fabricado / n -Herouniones GaAs. El recuadro superior muestra el circuito esquemático para las medidas transversales. El recuadro inferior muestra el I - V curvas del MoS 2 películas sobre el sustrato intrínseco de GaAs
La Figura 4a muestra el circuito esquemático para la medición del LPE del MoS 2 fabricado / Heterounión GaAs. Se presionan dos electrodos In con un diámetro de 0,5 mm sobre la superficie del MoS 2 película para realizar las medidas del LPE. La distancia (2 L ) entre los electrodos es de ~ 1,0 mm. Durante nuestras mediciones, los electrodos A y B se conectaron a las sondas positiva y negativa de un voltímetro Keithley 2000, respectivamente. La Figura 4b muestra las curvas LPE del MoS 2 / n -GaAs y MoS 2 / p -GaAs heterouniones, respectivamente. El grosor del MoS 2 películas es ~ 30,0 nm. Cuando la superficie del MoS 2 La película está parcialmente iluminada por un punto láser con un diámetro de aproximadamente 0,1 mm, se puede observar un gran LPE en el MoS 2 / n -Herounión GaAs. Como se muestra en la figura, el LPE muestra una dependencia aproximadamente lineal de la posición del punto del láser cuando el punto del láser se mueve entre los electrodos A y B en el MoS 2 superficie. En la figura, podemos ver que el LPV depende de la posición del punto láser. Esto se puede ajustar con la teoría de la difusión [16],
$$ \ mathrm {LPV} ={K} _0 \ Big [\ exp \ left (- \ frac {\ left | Lx \ right |} {d} \ right) - \ exp \ left (- \ frac {\ left | L + x \ right |} {d} \ right) $$donde K 0 , 2 L , d y x representan un coeficiente de proporcionalidad, la distancia entre dos electrodos, la longitud de difusión del portador y la posición del punto láser, respectivamente. Los resultados bien ajustados en la figura sugieren claramente que el LPE en el MoS 2 / n La heterounión -GaAs surge del flujo difuso lateral y la recombinación de los portadores excitados lejos de la posición del láser. Como se muestra en la figura, el valor de LPV es cero cuando el punto de luz está en el centro entre dos electrodos, lo que se puede atribuir a la simetría de difusión de los portadores. Cuando la posición de la luz está cerca del electrodo A, el LPV es positivo y viceversa. Esto indica que el LPE en el MoS 2 / n -La heterounión de GaAs es causada por los portadores fotoexcitados de tipo agujero. El LPV máximo se obtiene cuando la iluminación láser está más cerca de los electrodos. Según nuestras medidas, el fotovoltaje lateral máximo (LPV max ) es de aproximadamente 208,2 mV en la región lineal del MoS 2 / n -Herounión GaAs. Comparativamente, el LPV del MoS 2 / p -La heterounión GaAs es mucho más pequeña y su LPV max es de solo 7,3 mV, como se muestra en la figura. En la figura, podemos ver que el LPE del MoS 2 / p La heterounión -GaAs está determinada por los portadores fotoexcitados de tipo electrón. Además, las características de LPE no lineales del MoS 2 / p -La heterounión GaAs se puede ver en la figura cuando el punto láser se mueve entre los electrodos A y B.
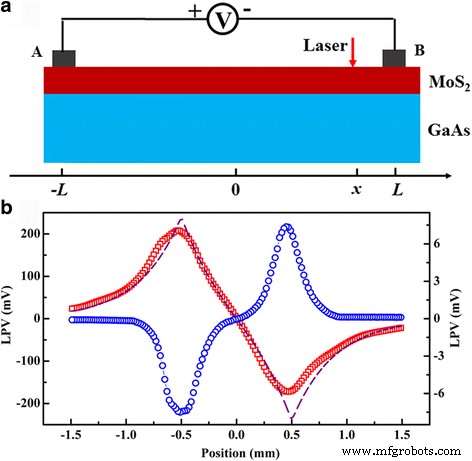
un Circuito esquemático para la medida del LPE. b Curvas LPE del MoS 2 / n -GaAs y MoS 2 / p -GaAs heterouniones, respectivamente
La Figura 5 muestra la sensibilidad LPE del MoS 2 / n -Herounión GaAs en función de la potencia del láser y el espesor ( d MoS2 ) del MoS 2 película. La sensibilidad está definida por S =LPV max / L . Obviamente, la S aumenta drásticamente al aumentar la potencia del láser inicialmente, pero luego se satura lentamente cuando la potencia aumenta más. Esta saturación podría deberse al rápido aumento de la tasa de recombinación de los orificios fotoexcitados con el aumento de la intensidad del láser en la región iluminada [20]. Como se muestra en la figura, se puede obtener un LPE obvio y una alta sensibilidad incluso bajo la iluminación láser débil de 100.0 μW. De la figura, una dependencia significativa de la sensibilidad en el grosor del MoS 2 se pueden ver películas. Cuando d MoS2 =~ 10,0 nm, S =165,4 mV mm −1 bajo la iluminación láser de 100,0 μW. Al aumentar el espesor de la película, S aumenta gradualmente. Cuando d MoS2 =30,0 nm, S alcanza 416,4 mV mm −1 . Esta sensibilidad es mucho mayor que el MoS 2 informado / Dispositivos de Si [17, 18]. Después de d MoS2 > 30,0 nm, S disminuye con el aumento adicional de MoS 2 grosor. Cuando d MoS2 =90,0 nm, S = 283,3 mV mm −1 . Por lo tanto, para obtener el mayor LPE y sensibilidad, existe un grosor óptimo de MoS 2 película en el MoS 2 fabricado / n -GaAs, alrededor de 30.0 nm.

Dependencia de sensibilidades positivas y negativas del MoS 2 fabricado / n -GaAs heterounión en potencias láser, respectivamente
La Figura 6a presenta los espectros de UPS del MoS 2 película sobre el sustrato de Si. La función de trabajo ( W ) de la película se puede calcular a partir de la diferencia entre el corte de la energía de enlace más alta y la energía del fotón de la radiación excitante. De la figura, W =Se pueden obtener 5,24 eV. La distancia (∆ E ) entre la banda de valencia ( E V ) y el nivel de Fermi ( E F ) de MoS 2 La película se puede extraer de la energía de inicio, como se muestra en el recuadro. El ∆ E para MoS 2 la película es de aproximadamente 0,51 eV. Usando los datos del espectro de transmitancia del MoS 2 película sobre sustrato de cuarzo, ( αhν ) 2 se representa en función de la energía de los fotones hν , donde h es la constante de Planck y ν es la frecuencia de los fotones. El α es el coeficiente de absorción, calculado por αd =ln (1 / T ) [21], en el que d y T son el espesor y la transmitancia de la película, respectivamente. La banda prohibida ( E g ) de la película se puede determinar a partir de la intersección de la línea en el hν eje, E g =1,54 eV, como se muestra en la Fig. 6b. Según estos parámetros de la banda de energía, el p -tipo de comportamiento del MoS 2 se puede determinar la película, lo que se puede probar mediante mediciones de Hall. Los resultados de Hall muestran que la concentración del portador de tipo agujero y la movilidad son aproximadamente 3.8 × 10 15 cm −3 y 11,2 cm 2 V −1 s −1 , respectivamente.

un Espectros de UPS del MoS 2 película en GaAs, que muestra el nivel de Fermi de las películas y la distancia entre el nivel de Fermi y el borde superior de la banda de conducción. b ( αhν ) 2 ~ hν curva del espectro UV del MoS 2 película sobre sustrato de cuarzo en las mismas condiciones de deposición
Para aclarar los mecanismos del LPE en el MoS 2 / Ga Como heterouniones, los diagramas de bandas de energía en la interfaz se construyen basándose en los resultados de la Fig. 6. Aquí, E g =1,42 eV y E F =4.17 eV para n -Los GaA se tienen en cuenta para construir la estructura de bandas [22]. Cuando el MoS 2 La película se deposita sobre el sustrato de GaAs, los electrones fluyen desde el GaAs hacia el MoS 2 película en la interfaz debido a la mayor E F de los GaAs. El proceso de flujo se detiene cuando los niveles de Fermi son iguales y el MoS 2 / GaAs p - n La unión está fabricada, como se muestra en la Fig. 7a. En consecuencia, un campo integrado ( E bi ) se forma en la interfaz del MoS 2 / Heterounión GaAs. E bi =[ E F ( n -GaAs) - E F (MoS 2 )] / e =1.07 V y apunta desde los GaAs al MoS 2 película. Por lo tanto, la I longitudinal asimétrica - V La curva se muestra en la Fig. 3a. Debido a la existencia de un fuerte E bi , se acumulan grandes cantidades de portadores de tipo agujero cerca de la interfaz y se forma una capa de inversión en el n -Sustrato de GaAs cerca de la interfaz, como se muestra en la Fig. 7b. Al igual que con el gas de agujero bidimensional (2DHG) [23], la capa de inversión podría exhibir la característica de alta conducción debido a la alta concentración de hojas de los agujeros ( p + ). De la Fig. 3b, podemos ver que la conducción de la capa de inversión es mucho más grande que el MoS 2 película. Por lo tanto, la conducción entre dos electrodos en el mismo lado del MoS 2 la película está dominada por la capa de inversión en lugar de MoS 2 película. Cuando la unión está parcialmente iluminada por el láser, la luz se absorbe y los pares de electrones y huecos en el MoS 2 pueden inducirse película y GaAs, respectivamente, como se muestra en la Fig. 7c. Sin embargo, se puede esperar que la mayor parte del láser sea absorbido por los sustratos de GaAs debido a su grosor mucho mayor y su banda prohibida más pequeña. Bajo la iluminación láser, los pares de electrones y agujeros solo pueden excitarse en la región iluminada y separarse espacialmente por E bi . Debido a la orientación del E bi apuntando de GaAs a MoS 2 , los agujeros fotoexcitados fluyen hacia la interfaz y entran en la capa de inversión en los GaAs, como se muestra en la Fig. 7c. Los agujeros fotoexcitados en la capa de inversión se difunden lateralmente desde el punto iluminado hacia los dos electrodos. La concentración de los agujeros excitados recogidos por los dos electrodos es diferente para diferentes distancias del punto iluminado. Por tanto, se forma un LPV grande entre los electrodos y se observa el LPE en la heterounión. Esto está de acuerdo con los resultados ajustados de la Fig. 3b, y el LPE en el MoS2 / n -Las heterouniones de GaAs se originan principalmente en la difusión del portador. Cuando el MoS 2 la película se deposita en la p -Sustrato de GaAs, una p - p se forma la heterounión, como se muestra en la Fig. 7d. E F ( p -GaAs) =5,32 eV se utiliza en el diagrama de bandas [22]. El E bi de la p - p Se puede calcular la heterounión, 0.08 V, y su dirección apunta desde la película al sustrato. Debido a la E bi , los portadores de tipo electrónico se acumulan cerca de la interfaz de la heterounión y se forma la capa de inversión. Así, el LPE inducido por la difusión de los electrones fotoexcitados se obtiene en el MoS 2 / GaAs p - p heterounión, como se muestra en la Fig. 4. Sin embargo, la concentración del portador acumulado en la capa de inversión podría ser menor debido a la débil V bi de solo 0,08 V en el p - p heterounión en comparación con la p -MoS 2 / n -Unión de GaAs. Esto aumenta las dificultades del transporte de los electrones fotoexcitados en la capa de inversión. En serio, las barreras de Schottky se pueden formar entre n -tipo capa de inversión y la p -MoS 2 película, como se muestra en la Fig. 7e. Estas características del p -MoS 2 / p La unión -GaAs suprime la colección de electrones fotoexcitados en los electrodos. Como resultado, el LPE podría reducirse en gran medida. Como se muestra en la Fig. 4b, el LPV max para la p - p la unión es de solo 7.3 mV mientras que alcanza 208.2 mV en el p - n cruce.

un Alineación de la banda de energía del MoS 2 / n -GaAs heterounión y b la ilustración correspondiente del contacto eléctrico en la interfaz. c Mecanismo del LPE en el MoS 2 / n -Herounión GaAs. d Alineación de la banda de energía del MoS 2 / p -Heterounión GaAs y e la ilustración correspondiente del contacto eléctrico en la interfaz
Por lo general, ocurre en los PSD de tipo heterounión informados que el LPE se puede ajustar cambiando el grosor de las capas de la tapa [20]. Esto puede entenderse bien si se considera la recombinación de los portadores fotoexcitados en la película y la evolución del campo incorporado. En MoS 2 / GaAs p - n unión, la recombinación de portadores generados por fotones se puede mejorar debido a la larga ruta de transporte en el MoS grueso 2 película antes de que sean recogidos por los electrodos. Esto reduce el LPE de las heterouniones. A la inversa, una película más delgada puede disminuir en gran medida la recombinación, lo que provoca el aumento del LPE. Sin embargo, cuando el MoS 2 el espesor es menor que el valor crítico, el E bi en la interfaz disminuye al disminuir aún más MoS 2 espesor [24]. Esto puede reducir la separación de pares de huecos de electrones generados por fotones y el LPE disminuye. Por lo tanto, hay un grosor óptimo de MoS 2 película para obtener el LPE más alto, alrededor de 30 nm.
Conclusiones
En resumen, MoS 2 Se depositaron películas delgadas sobre la superficie del sustrato de GaAs mediante la técnica de pulverización catódica con magnetrón. Se obtuvo un LPE grande en el MoS 2 fabricado / n -La heterounión GaAs y la dependencia del LPV de la posición de la iluminación láser mostraron una buena linealidad. Debido a la formación del fuerte campo integrado en la interfaz, el MoS 2 / n -La heterounión GaAs exhibió una alta sensibilidad de 416,4 mV mm −1 , mientras que el valor era de solo 7,3 mV mm −1 para MoS 2 / p -GaAs. Nuestros resultados mostraron además que el LPE exhibía una dependencia obvia del grosor del MoS 2 películas y aproximadamente 30.0 nm fue el grosor óptimo de MoS 2 película para adquirir el LPE más alto en el MoS 2 fabricado / n -Herouniones GaAs. Los mecanismos del LPE en el MoS 2 Los dispositivos / GaAs se aclararon en función de la alineación de la banda de energía en la interfaz.
Abreviaturas
- ∆ E :
-
Distancia entre E V y E F
- d MoS2 :
-
Espesor del MoS 2 película
- E bi :
-
Campo integrado
- E C :
-
Nivel de banda de conducción
- E F :
-
Nivel de energía Fermi
- E g :
-
Brecha de banda de energía
- E V :
-
Nivel de la banda de valencia
- I - V :
-
Corriente-voltaje
- LPE:
-
Efecto fotovoltaico lateral
- LPV:
-
Fotovoltaje lateral
- LPV max :
-
Fotovoltaje lateral máximo
- MoS 2 :
-
Disulfuro de molibdeno
- PSD:
-
Detector sensible a la posición
- UPS:
-
Espectroscopia de fotoelectrones ultravioleta
- W :
-
Función de trabajo
Nanomateriales
- Características fotovoltaicas de los dispositivos de heterounión GaSe / MoSe2
- MoS2 con espesor controlado para evolución electrocatalítica de hidrógeno
- Cristalización dependiente de la temperatura de nanoflakes de MoS2 en nanohojas de grafeno para electrocatálisis
- Compuesto negro de acetileno / MoS2 de pocas capas como material de ánodo eficiente para baterías de iones de litio
- Fotoresponsividad dependiente del sesgo de fototransistores MoS2 multicapa
- Rendimiento de detección de H2 altamente mejorado de heterouniones de MoS2 / SiO2 / Si de pocas capas mediante la decoración de superficies de nanopartículas de Pd
- Efecto de diferentes morfologías de CH3NH3PbI3 en las propiedades fotovoltaicas de las células solares de perovskita
- Optimización de celdas solares de matriz de unión de pines de nanocables GaAs mediante el uso de heterouniones AlGaAs / GaAs
- Propiedades fotovoltaicas mejoradas en la celda solar de heterounión plana Sb2S3 con un enfoque de selección rápida
- Propiedades de transporte de portadora del sensor de gas asimétrico MoS2 bajo carga Modulación de barrera basada en transferencia
- Observación del efecto Hall de giro inverso fotoinducido extrínseco en un gas electrónico bidimensional GaAs / AlGaAs



