Un sensor de deformación biaxial con una sola rejilla de MoS2
Resumen
En este documento, informamos sobre un nuevo tipo de MoS 2 -sensor de rejilla para galgas extensiométricas biaxiales en plano con un límite de precisión de ~ 1 ‰. El MoS 2 la rejilla se simula numéricamente con diferentes cepas biaxiales hasta un 5%. Nuestros cálculos de primeros principios revelan que la sensibilidad a la deformación del MoS 2 El espectro de reflectancia puede considerarse un sensor de deformación adicional integrado con la estructura de la rejilla, lo que permite el mapeo de deformaciones biaxiales en el plano. Nuestros estudios experimentales sobre un prototipo de MoS 2 El sensor de rejilla confirma además que un componente de deformación perpendicular al período de la rejilla puede provocar cambios de pico de intensidad en los patrones de difracción de primer orden de la rejilla. Este trabajo abre un nuevo camino hacia la detección de tensión biaxial en el plano dentro de un dispositivo de rejilla única. Nuestro nuevo enfoque es aplicable a otros materiales que tienen una respuesta de reflectancia predecible bajo tensiones biaxiales y la capacidad de formar una capa monocristalina bidimensional.
Introducción
La tecnología de la electrónica flexible ha recibido una amplia atención de las comunidades académicas e industriales, pero el diseño y la aplicación de dispositivos flexibles a microescala y nanoescala es un desafío debido a las dificultades en el control de deformaciones y desplazamientos dinámicos [1, 2, 3, 4, 5]. La mayoría de los métodos convencionales de detección de deformaciones basados en galgas extensométricas de resistencia requieren una matriz de sensores miniaturizados [4, 6, 7], que es difícil de producir para aplicaciones electrónicas flexibles. Las técnicas de detección de deformaciones bidimensionales (2D) basadas en ópticas, como la interferometría moteada, son superiores a las basadas en piezorresistividad debido a su mayor precisión [8]. Sin embargo, su estrategia de medición de la correlación de imágenes se ve desafiada por los requisitos de la tecnología compleja de procesamiento de imágenes [8, 9, 10]. Una rejilla de reflexión puede proporcionar una alta resolución para la medición de la deformación, pero carece de la capacidad para detectar la deformación en 2D dentro de un solo dispositivo [11].
En los últimos años, los materiales 2D han atraído un enorme esfuerzo de investigación. Tras la introducción del grafema [12, 13], la familia de materiales 2D se ha ampliado con muchos miembros nuevos, como fósforo negro delgado doble atómico [14], dicalcogenuros de metales de transición delgados triples atómicos [15], grupo delgado atómico cuádruple III monocalcogenuros metálicos [16] y otros materiales 2D no estratificados [17]. Se han encontrado muchas propiedades interesantes en estos materiales, manteniéndolos bajo el foco de la ciencia de los materiales [18,19,20,21,22,23,24].
Los dicalcogenuros de metales de transición exhiben excelentes propiedades ópticas y mecánicas [25, 26, 27]. Por ejemplo, MoS 2 puede tolerar hasta un 19,5% [26] de tensión biaxial acompañada de su modulación de reflectancia [28], y WSe 2 puede mostrar un dipolo de curvatura de Berry notable, así como un efecto Hall no lineal a través de la ingeniería de deformaciones [29]. La incorporación de la sensibilidad a la deformación del espectro de reflectancia de un material en la función del dispositivo de rejilla de reflexión puede ser una forma eficaz de extender las mediciones de deformación a la detección biaxial dentro de un solo dispositivo. Sin embargo, no hay informes de las rejillas de reflexión combinadas con la modulación de reflectancia del material inducida por deformación para aplicaciones de detección de deformación en 2D.
Aquí, proponemos un nuevo tipo de técnica de detección de deformación biaxial en el plano que involucra la sensibilidad a la deformación de MoS 2 reflectancia en un sensor de rejilla de reflexión. Los cálculos de los primeros principios revelan que las deformaciones biaxiales pueden cambiar el pico de la distribución de intensidad en los patrones de difracción de un MoS 2 -Dispositivo de rejilla basado en la reflectancia de MoS 2 es sensible a la deformación inducida por deformación. Este cambio de pico no lineal se demuestra bien agregando un término de segundo orden a la ecuación lineal de deformación uniaxial, a partir de la cual se puede extraer el componente de deformación perpendicular a la dirección del período de red con un límite de precisión de ~ 1 ‰. Nuestros estudios experimentales sobre un prototipo de MoS 2 El dispositivo de rejilla confirma que la deformación perpendicular al período de la rejilla puede inducir un cambio de pico de intensidad del patrón de difracción de primer orden de la rejilla. Nuestra investigación muestra la posibilidad de galgas extensométricas biaxiales en plano y de un solo paso con un solo sensor de rejilla.
Métodos
Cálculos teóricos para MoS 2 Copos
El MoS 2 Todas las respuestas ópticas a la deformación se estudian mediante cálculos de primer principio realizados con el Paquete de Simulación Ab-initio de Viena (VASP) [30]. Para todos los cálculos se utilizaron los potenciales de onda aumentada (PAW) de todos los proyectores de electrones [31]. La relajación geométrica y los cálculos estáticos se llevaron a cabo con el método de aproximación de gradiente generalizado (GGA) de Perdew-Burke-Ernzerhof (PBE) [32]. El acoplamiento espín-órbita (SOC) [33] también se incluyó en los cálculos estáticos. Para determinar las propiedades ópticas, las energías de las cuasipartículas se obtuvieron primero mediante el método GW derivado de la teoría de la función de Green [34]. La función de onda obtenida de los cálculos estáticos y la energía de las cuasipartículas de los cálculos de GW se utilizaron para realizar los cálculos de la ecuación de Bethe-Salpeter (BSE) [35] para predecir la constante dieléctrica.
Se utilizó un modelo de cristal a granel para representar el MoS 2 escamas (que la diferencia de propiedades ópticas entre pilas de más de cinco capas es insignificante [36]). En los cálculos de optimización, el corte de energía se estableció en 400 eV y se utilizó un conjunto de puntos k Monkhorst-Pack de 15 * 15 * 4 para muestrear la zona de Brillouin. Los parámetros de la red se optimizaron primero como referencia para cálculos posteriores del MoS forzado 2 escama. Los parámetros de celosía optimizados fueron a = b =3,18 Å y c =13,87 Å. La geometría se relajó hasta que la energía convergió a 10 –5 eV. Adoptando una técnica de la literatura anterior [37], un corte de energía de 300 eV y k Se utilizó un conjunto de puntos de 6 × 6 × 2 en los cálculos ópticos. La energía estática convergió a 10 –6 eV en todos los cálculos. Los patrones de difracción se simularon basándose en el teorema de Helmholtz-Kirchhoff [38]. Se proporcionan más detalles en el archivo adicional 1.
Preparación de MoS 2 Muestra para medición de espectro
El MoS 2 La película delgada se exfolió mecánicamente a partir de un MoS 2 comercial monocristal (SPI Supplies) y se transfirió a un sustrato de polidimetilsiloxano (PDMS) con cinta. Después de la transferencia, se fabricó otra capa de PDMS sobre la escama y el sustrato para mejorar la adhesión.
Preparación de MoS 2 Rejilla sobre el sustrato flexible
El MoS 2 La película delgada se exfolió mecánicamente a partir de un MoS 2 comercial monocristal (SPI Supplies) y se transfirió a un sustrato de polidimetilsiloxano (PDMS) con cinta. Para fabricar el dispositivo de rejilla, el MoS 2 la escama se modeló en primer lugar en una estructura de rejilla mediante litografía por haz de electrones (EBL). Luego, la muestra modelada se grabó con plasma de oxígeno con una potencia de 20 W. Finalmente, obtuvimos el MoS 2 -dispositivo de rejilla a base de lavado de PMMA.
MoS 2 Medidas del dispositivo
Se utiliza una fuente de luz blanca supercontinua (NKT Photonics SuperK Compact) como láser de excitación, que pasa a través de una abertura y golpea la muestra de escamas o la muestra de rejilla en un cierto ángulo con respecto al plano de la muestra, como se muestra en la Fig. 1. En En la medida de reflectancia, el láser reflejado se recoge a través de una fibra óptica conectada a un espectrómetro. Los espectros de reflectancia bajo diferentes tensiones se calculan a partir de los datos medidos por el espectrómetro. Para probar el MoS 2 rejilla, el láser reflejado se proyecta sobre una pizarra blanca y aparece como un punto de luz elíptico largo. Las fotos del punto de luz se utilizan para analizar la distribución de la intensidad.
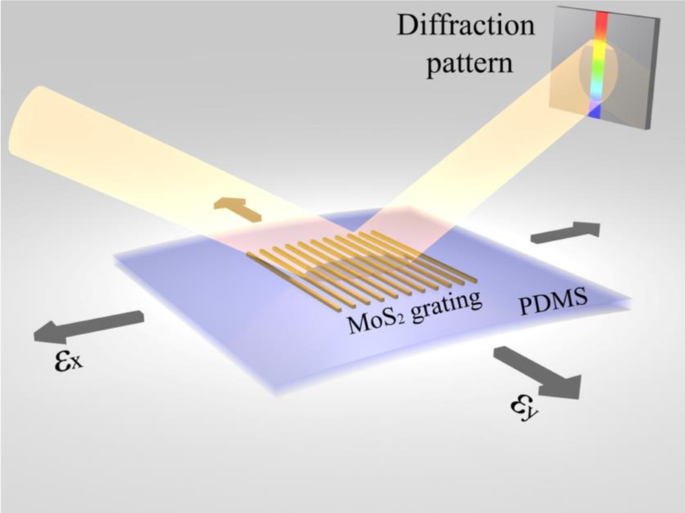
Ilustración esquemática de MoS 2 sensor de rejilla basado en un sustrato flexible de PDMS para galgas extensométricas biaxiales
Resultados y discusión
En un sensor de rejilla de reflexión convencional, una estructura periódica de tiras de rejilla paralelas puede difractar la luz, y la difracción se utiliza para medir una deformación que se encuentra a lo largo de la dirección del período de rejilla al monitorear un cambio de ubicación de los patrones de difracción [11]. Debido a la orientación de la estructura periódica, la función de detección de deformación de la rejilla de reflexión se limita a la galga extensométrica uniaxial en el plano (paralela a la dirección periódica). Para ampliar la función de rejilla de reflexión para su uso en galgas extensométricas biaxiales en el plano, proponemos que las propiedades ópticas intrínsecas del material de la rejilla, como la sensibilidad a la deformación de la reflectancia del material, se pueden considerar como un sensor de deformación adicional para detectar en -componentes de deformación plana perpendiculares a la dirección periódica.
MoS 2 tiene una estructura en capas:una capa de átomos de Mo intercalada entre dos capas de átomos de S. La interacción entre las capas es una fuerza de van der Waals débil. Aquí, diseñamos un MoS 2 sensor de rejilla de reflexión basado en escamas (Fig. 1) e investigue los patrones de difracción del dispositivo bajo diferentes deformaciones biaxiales en el plano mediante cálculos de primeros principios. El rango de longitud de onda del haz incidente en nuestro cálculo es de 400 a 850 nm. La rejilla de difracción se puede describir mediante:
$$ d \ left (\ mathrm {sin} {\ theta} _ {i} - \ mathrm {sin} {\ theta} _ {m} \ right) =n \ lambda $$ (1)donde \ (d \) es la distancia entre dos tiras de rejilla adyacentes, \ ({\ theta} _ {i} \) es el ángulo entre el haz incidente y la normal a la rejilla, \ ({\ theta} _ {m } \) es el ángulo entre el haz de difracción y la normal cuando el haz de difracción tiene máximos, n es el orden de difracción y \ (\ lambda \) es la longitud de onda del haz [11]. De la ecuación. (1), vemos que los haces incidentes con diferentes \ (\ lambda \) deben tener diferentes \ ({\ theta} _ {m} \). Por lo tanto, un haz de longitud de onda continua provoca una serie continua de puntos de difracción correspondientes a diferentes \ ({\ theta} _ {m} \), formando un patrón de difracción elíptico de primer orden.
La Figura 2a muestra la imagen simulada de los patrones de difracción del sensor de rejilla como se diseñó sin aplicar tensión. La Figura 2b muestra el pico de intensidad y la evolución de la ubicación del patrón del patrón de difracción de primer orden simulado del dispositivo bajo diferentes cepas biaxiales. El borde del patrón de difracción de primer orden correspondiente al haz incidente de 850 nm se etiqueta "LW". Cuando aplicamos una deformación por tracción uniaxial en el plano a lo largo de la dirección del período de rejilla (\ ({\ varepsilon} _ {x} \)), esta deformación puede inducir un aumento en el espaciado d entre cada tira. Como resultado, \ ({\ theta} _ {m} \) disminuye porque \ (d \ mathrm {sin} {\ theta} _ {m} \) es constante para cualquier \ (\ lambda \) y fijo \ ({\ theta} _ {i} \). Por lo tanto, cuando aumentamos gradualmente la deformación \ ({\ varepsilon} _ {x} \) de 0 a 4,3%, la ubicación de cada punto en el patrón de difracción de primer orden se acerca al centro del punto de difracción de orden cero. en una relación proporcional con la longitud de onda del haz correspondiente, lo que es consistente con la función del sensor de rejilla de reflexión convencional [11].

un Imagen simulada del patrón de difracción. No se aplicó tensión. La intensidad se representa con colores. Existe un comportamiento asimétrico entre el punto de difracción de primer orden en ambos lados del haz de orden cero porque la pantalla en nuestra simulación está configurada para ser paralela a la rejilla en lugar de perpendicular a la dirección de reflexión. b Evolución simulada de un punto de difracción de primer orden bajo diferentes cepas biaxiales. El diferencial parcial de intensidad se representa con colores. La coordenada horizontal y la coordenada vertical denotan la posición relativa al centro del punto de difracción de orden cero. El pico está marcado con una línea discontinua. De izquierda a derecha, \ ({\ varepsilon} _ {x} \) se estableció como 0%, 0.9%, 2.6% y 4.3%, respectivamente. De arriba a abajo, el \ ({\ varepsilon} _ {y} \) fue 0%, 1%, 3% y 5%, respectivamente
Un haz incidente con una longitud de onda más larga \ (\ lambda \) tiene una variación \ ({\ theta} _ {m} \) más grande, por lo que el borde LW tiene el cambio de ubicación más aparente. Sin embargo, cuando se aplica simultáneamente una deformación por tracción en el plano perpendicular a la dirección del período de rejilla (\ ({\ varepsilon} _ {y} \)), se observa un cambio de intensidad máxima dentro del patrón de difracción de primer orden, marcado por una línea discontinua en la Fig. 2b. Cuando la deformación \ ({\ varepsilon} _ {y} \) aumenta de 0 a 5%, el pico de intensidad se aleja más del centro del punto de difracción de orden cero. Atribuimos este cambio máximo de la distribución de intensidad a la modulación inducida por deformación del MoS 2 reflectancia. La literatura anterior ha informado que el espectro de reflectancia de MoS 2 puede sintonizarse mediante una deformación externa [28], y la reflectancia es igual a la relación de intensidad del haz difractado al haz incidente de la rejilla de reflexión. Por tanto, la intensidad de los haces con diferentes longitudes de onda difractados por el MoS 2 la rejilla puede ser modulada por las deformaciones en el plano. Mientras tanto, no se produce ningún cambio de ubicación del borde LW porque la deformación \ ({\ varepsilon} _ {y} \) no ejerce ningún impacto en el período de rejilla.
La Figura 3a muestra el comportamiento lineal en los cambios máximos del MoS 2 espectros de reflectancia cuando una deformación por tracción uniaxial a lo largo del vector de red \ ({\ varvec {b}} \) de MoS 2 Está aplicado. Esta deformación por tracción uniaxial provoca un corrimiento al rojo en la posición máxima en el MoS 2 reflectancia. Sin embargo, hay una modulación no lineal en el cambio de posición del pico de reflectancia cuando aplicamos una deformación por tracción biaxial en el plano. La relación entre la posición del pico en los espectros de reflectancia y la deformación por tracción biaxial en el plano se puede describir mediante una ecuación de segundo orden:
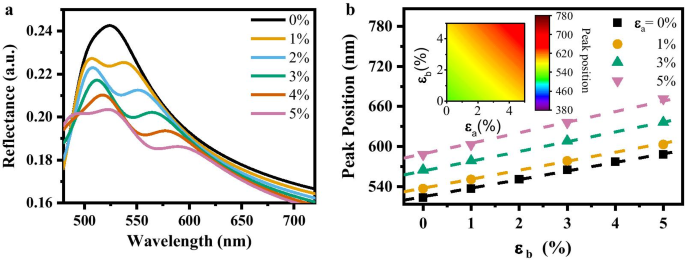
un Espectros de reflectancia del MoS 2 escamas en función de la longitud de onda bajo diferentes deformaciones uniaxiales. b Posiciones de los picos de los espectros de reflectancia del MoS 2 escamas bajo diferentes cepas biaxiales. Las líneas discontinuas representan las curvas de ajuste. Recuadro:la imagen de mapeo de las posiciones de los picos de la ecuación de ajuste
$$ \ mathrm {Posición máxima} =l \ left ({\ varepsilon} _ {a} + {\ varepsilon} _ {b} \ right) + m {\ varepsilon} _ {a} {\ varepsilon} _ {b } + n $$ (2)donde l , m y n son tres constantes, y ε a y ε b son los componentes de deformación a lo largo de los dos vectores de celosía del MoS 2 . El primer término describe el comportamiento lineal del cambio de posición del pico bajo deformaciones uniaxiales de tracción a lo largo del vector de red \ ({\ varvec {a}} \) o \ ({\ varvec {b}} \). El segundo término describe el comportamiento de orden superior en la situación de deformación por tracción biaxial. El tercer término es la posición del pico de reflectancia del MoS 2 no tensado . Dado que MoS 2 Los vectores de celosía \ ({\ varvec {a}} \) y \ ({\ varvec {b}} \) son simétricamente equivalentes, las deformaciones por tracción a lo largo de las dos direcciones tienen el mismo factor de contribución. Los resultados del ajuste muestran que la diferencia más alta entre la curva de ajuste y las posiciones de pico calculadas por el primer principio es 1,76 nm, lo que indica que se puede obtener un límite de precisión de la galga extensométrica de ~ 1 ‰ cuando se utiliza la posición del pico de reflectancia para calcular la cepa con la Eq. (2). La Figura 3b muestra la imagen de mapeo de la posición del pico de reflectancia bajo diferentes deformaciones de tracción biaxiales en el plano obtenidas de la ecuación ajustada. (2) (ver gráficos detallados de reflectancia en el archivo adicional 1).
En nuestra simulación, el vector de red \ ({\ varvec {a}} \) es perpendicular a la dirección del período de la rejilla simulada. Por lo tanto, la cepa \ ({\ varepsilon} _ {y} \) es igual a \ ({\ varepsilon} _ {a} \), y la cepa \ ({\ varepsilon} _ {x} \) es igual a \ (\ sqrt {3} / 2 \ times {\ varepsilon} _ {b} \). Nuestros cálculos revelan que en un MoS 2 sensor de rejilla basado en, la deformación en el plano \ ({\ varepsilon} _ {x} \) se puede medir mediante el desplazamiento de la ubicación del borde LW del patrón de difracción de primer orden. Con base en el cambio de pico de intensidad en el patrón de difracción de primer orden, podemos utilizar la ecuación de segundo orden. (2) para restar la contribución de la deformación en el plano \ ({\ varepsilon} _ {x} \) del desplazamiento del pico. Entonces podemos calcular cuantitativamente la deformación en el plano \ ({\ varepsilon} _ {y} \).
Para seguir estudiando experimentalmente la sensibilidad a la tensión del MoS 2 reflectancia, exfoliamos mecánicamente un MoS 2 escama (espesor de varias decenas de nanómetros; consulte los detalles en el archivo adicional 1) y adjuntó la escama a un sustrato flexible de polidimetilsiloxano (PDMS) mediante un método de transferencia en seco (que se muestra en la Fig. 4a insertada). Se impuso una deformación por tracción uniaxial en el plano a este MoS 2 fabricado dispositivo fijando los dos lados del sustrato en dos etapas de traslación y estirando el sustrato. Estimamos la deformación por tracción uniaxial en el plano calculando ε \ (=\ delta L / L \), donde \ (L \) es la longitud del sustrato entre los dos clips y \ (\ delta L \) es el cambio de longitud. Cuando la deformación varía de 0 a 4%, hay un corrimiento al rojo de la posición del pico en el MoS 2 espectro de reflectancia, y la magnitud de este cambio concuerda bien con nuestros cálculos teóricos, como se muestra en la Fig. 4a. La Figura 4b, c muestra la imagen óptica de un sensor de rejilla de reflexión basado en MoS2 con un período de 2 μm en un sustrato flexible PDMS fabricado por litografía por haz de electrones (detalles en Métodos). Al estirar el sustrato PDMS, se ejerce una tensión de tracción en el plano perpendicular a la dirección del período en el MoS 2 -dispositivo de rejilla a base de (Fig. 4d). Al monitorear la distribución de intensidad en el patrón de difracción de primer orden, observamos que el pico de intensidad se desplaza más lejos del centro del punto de orden cero en comparación con el caso sin tensión cuando introducimos una deformación por tracción en el plano del 4% perpendicular a la dirección del período (Fig. 4e). No se obtiene ningún cambio de ubicación del patrón de difracción porque la deformación por tracción es perpendicular a la dirección del período y el espaciado d entre cada tira cambia poco.
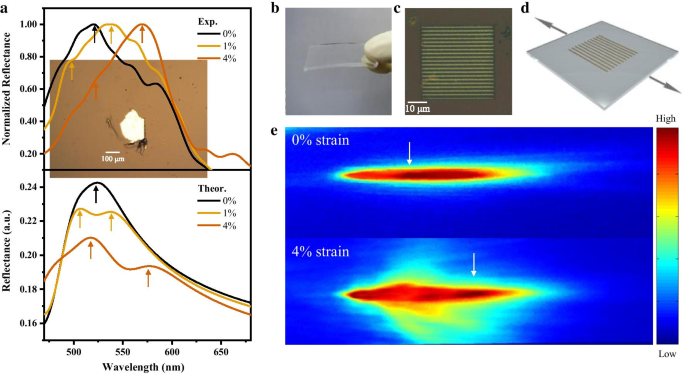
un Resultados experimentales de los espectros de reflectancia con deformaciones uniaxiales (arriba) y el espectro de reflectancia calculado de los primeros principios con deformaciones uniaxiales (abajo). Las flechas indican las ubicaciones de los picos de reflectancia. Recuadro, imagen óptica del MoS 2 escamas utilizadas para pruebas de espectro de reflectancia. b - c Imágenes ópticas del MoS 2 fabricado -rejilla basada en PDMS. d Diagrama esquemático de MoS 2 -rejilla de base estirada por etapas de traducción. e Imagen del punto de difracción de primer orden de la rejilla no tensada (superior) y tensada (inferior). Las flechas blancas indican el pico de intensidad
Conclusión
En resumen, demostramos una nueva técnica para medir la deformación biaxial en el plano utilizando un MoS 2 -sensor de rejilla de reflexión basado en Probamos el concepto simulando numéricamente la rejilla con diferentes deformaciones biaxiales hasta un 5%. En esta nueva técnica, la estructura de rejilla para detectar el componente de deformación a lo largo de la dirección del período (\ ({\ varepsilon} _ {x} \)) se combina con la sensibilidad a la deformación del MoS 2 reflectancia para actuar como un sensor adicional para obtener el componente de deformación en el plano perpendicular a la dirección del período (\ ({\ varepsilon} _ {y} \)). El componente \ ({\ varepsilon} _ {y} \) se calcula con una ecuación de aproximación de segundo orden y el cambio de pico de intensidad dentro de los patrones de difracción de primer orden. Los resultados teóricos están bien respaldados por nuestros experimentos. Nuestro trabajo abre un camino para el diseño de sensores de rejilla flexible y proporciona un enfoque novedoso para realizar galgas extensométricas biaxiales en plano de un solo uso con un solo sensor de rejilla. Nuestro enfoque también es aplicable a otros materiales que tienen una respuesta de reflectancia predecible bajo tensiones biaxiales y la capacidad de formar capas de monocristales bidimensionales.
Disponibilidad de datos y materiales
Los conjuntos de datos utilizados y analizados durante el estudio actual están disponibles del autor correspondiente a solicitud razonable.
Abreviaturas
- 2D:
-
Bidimensional
- VASP:
-
Paquete de simulación de Viena Ab-initio
- PAW:
-
Proyector de todos los electrones de onda aumentada
- PBE:
-
Perdew – Burke – Ernzerhof
- GGA:
-
Aproximación de gradiente generalizada
- SOC:
-
Acoplamiento giro-órbita
- BSE:
-
Ecuación de Bethe-Salpeter
- PDMS:
-
Polidimetilsiloxano
- EBL:
-
Litografía por haz de electrones
Nanomateriales
- Uso de etiquetas RFID para supervisar la seguridad del hogar
- Biblioteca Python del sensor de temperatura TMP006 con Raspberry pi,
- Sensor de temperatura Python y Raspberry Pi
- Transmisión de datos del sensor desde una placa ppDAQC Pi utilizando InitialState
- Sensor de movimiento con Raspberry Pi
- Uso del sensor de radar pulsado A111 con una Raspberry Pi
- MoS2 con espesor controlado para evolución electrocatalítica de hidrógeno
- Cristalización dependiente de la temperatura de nanoflakes de MoS2 en nanohojas de grafeno para electrocatálisis
- Efecto fotovoltaico lateral grande en heterounión MoS2 / GaAs
- Fotoresponsividad dependiente del sesgo de fototransistores MoS2 multicapa
- Sensor de deformación ultrasensible basado en una película piezoeléctrica de poli (fluoruro de vinilideno) flexible



