HEMT AlGaN de doble canal de alto rendimiento con densidad de corriente de drenaje mejorada y alto voltaje de ruptura
Resumen
En este trabajo, se propone la heteroestructura de doble canal de AlGaN y se hace crecer mediante deposición de vapor químico orgánico metálico (MOCVD), y se fabrican e investigan transistores de alta movilidad de electrones de doble canal de AlGaN de alto rendimiento (HEMT). La implementación de la función de doble canal mejora eficazmente las propiedades de transporte de las heteroestructuras del canal AlGaN. Por un lado, la densidad de gas de electrones bidimensional total (2DEG) se promueve debido a los pozos de doble potencial a lo largo de la dirección vertical y al confinamiento mejorado del portador. Por otro lado, la densidad 2DEG media en cada canal se reduce y la movilidad se eleva como resultado de la supresión del efecto de dispersión portadora-portadora. Como resultado, la densidad máxima de corriente de drenaje ( I máx ) de los HEMT de doble canal AlGaN alcanza 473 mA / mm con un voltaje de puerta de 0 V. Además, también se demuestra el rendimiento superior de ruptura de los HEMT de doble canal AlGaN. Estos resultados no solo muestran el gran potencial de aplicación de los HEMT de doble canal de AlGaN en la electrónica de potencia de microondas, sino que también desarrollan un nuevo pensamiento para los estudios de dispositivos electrónicos basados en nitruros del grupo III.
Introducción
Los transistores de alta movilidad de electrones (HEMT) basados en nitruros del grupo III han sido identificados como el candidato más prometedor para la electrónica de potencia de microondas de próxima generación debido a su velocidad de conmutación rápida y baja pérdida de conmutación [1,2,3,4,5] . Últimamente, los HEMT de nitruro más avanzados han logrado una comercialización inicial de hasta 650 V. Sin embargo, con la madurez de la tecnología de fabricación de dispositivos, se ha vuelto cada vez más difícil aumentar aún más los voltajes de ruptura ( V b ) y mejorar la fiabilidad del dispositivo a altas temperaturas. Por lo tanto, en vista de la banda prohibida más grande y la estabilidad térmica superior de AlGaN sobre GaN, los dispositivos de canal de AlGaN se han propuesto como candidatos prometedores para mejorar aún más los límites de rendimiento de los HEMT de nitruro en aplicaciones de alta tensión y alta temperatura [6,7,8 , 9,10,11,12,13,14,15].
Nanjo y col. demostraron la notable mejora del voltaje de ruptura de los HEMT del canal AlGaN, y los voltajes de ruptura máximos obtenidos fueron 1650 V en el Al 0.53 Ga 0,47 N / Al 0.38 Ga 0,62 N HEMT con distancias puerta-drenaje de 10 μm [6]. Posteriormente, Nanjo et al. promovió aún más el voltaje de ruptura del Al 0.40 Ga 0.60 N / Al 0.15 Ga 0,85 N HEMT hasta 1700 V [8]. Zhang y col. fabricó los HEMT de canal AlGaN con un nuevo contacto de drenaje óhmico / Schottky-híbrido, y se obtuvo un voltaje de ruptura récord de más de 2200 V para los HEMT de canal AlGaN [11]. Xiao y col. propuso las heteroestructuras del canal AlGaN con alta movilidad 2DEG de 807 cm 2 / V · s, y los registros de corriente de drenaje máxima y I en / I desactivado Se informó la relación para los HEMT de canal AlGaN fabricados [14]. Posteriormente, Xiao et al. propuso por primera vez los HEMT normalmente desactivados con una capa de canal de AlGaN de superrejilla, y los dispositivos fabricados mostraron un voltaje de ruptura superior a 2000 V, una densidad de corriente alta de 768 mA / mm y un voltaje de umbral ( V T ) de 1,0 V [15]. Recientemente, Baca et al. evaluó el rendimiento de radiofrecuencia (RF) de los HEMT de canal AlGaN con una puerta de 80 nm de longitud. La f T de 28,4 GHz yf MAX de 18,5 GHz se determinaron a partir de mediciones del parámetro S de señales pequeñas [12]. Estos resultados ilustran la promesa de los HEMT de canal AlGaN para aplicaciones de potencia de RF.
Sin embargo, las limitaciones de los dispositivos de canal AlGaN informados anteriormente son igualmente obvias. Por un lado, debido al efecto de dispersión desordenada de la aleación ternaria, la movilidad bidimensional del gas de electrones (2DEG) en el canal AlGaN es mucho menor que en el canal GaN. Como resultado, la capacidad de transmisión actual de los dispositivos de canal AlGaN es mucho menor que la de los dispositivos de canal GaN tradicionales. Por otro lado, para inducir la misma cantidad de 2DEG en el canal de AlGaN, el componente de AlN en la capa de barrera de AlGaN debe ser mayor que el de las heteroestructuras de canal de GaN convencionales, lo que aumentará las dificultades en el proceso de crecimiento del material. Estas contradicciones inhiben seriamente la aplicación generalizada de los dispositivos de canal AlGaN, y se necesitan con urgencia optimizaciones del diseño de la heteroestructura.
La técnica de doble canal es un enfoque interesante para promover la densidad de portadores de canal de heteroestructuras basadas en nitruros sin ningún impacto adverso sobre la movilidad de los electrones, y se mejorará la capacidad de conducción de corriente de los dispositivos [16,17,18]. Sin embargo, ha habido pocos informes sobre las heteroestructuras de doble canal de AlGaN o dispositivos de electrones hasta ahora. En este trabajo, por primera vez, se propone y hace crecer la heteroestructura de doble canal de AlGaN para resolver las contradicciones entre la capacidad de excitación actual y el rendimiento de descomposición del dispositivo de electrones basado en nitruros. Además, los HEMT de doble canal AlGaN de alto rendimiento basados en la nueva heteroestructura se fabrican e investigan en detalle.
Métodos
El esquema de la sección transversal de la heteroestructura de doble canal de AlGaN se muestra en la Fig. 1a, y los procesos de crecimiento se pueden resumir como sigue. En primer lugar, se hizo crecer una capa tampón de GaN de 1600 nm sobre el sustrato de zafiro. Luego, se cultivó una capa tampón de AlGaN graduada de 500 nm con una composición de AlN que aumentó de 0 a 10%, lo que fue beneficioso para suprimir la formación de canales parásitos. Posteriormente, se cultivaron sucesivamente un canal de AlGaN inferior de 100 nm, una capa intermedia de AlN de 1 nm y una barrera de AlGaN inferior a 23 nm sucesivamente, y las composiciones de AlN en las capas de canal y barrera son del 10% y 31%, respectivamente. Finalmente, se cultivaron el canal de AlGaN superior de 30 nm, la capa intermedia de AlN de 1 nm y las capas de barrera de AlGaN superior de 23 nm, para las cuales las composiciones fueron las mismas que las capas inferiores. El diagrama de bandas de conducción de la heteroestructura de doble canal de AlGaN se puede calcular resolviendo de manera autoconsistente la ecuación unidimensional de Poisson-Schrödinger, que emplea el método de diferencias finitas con un tamaño de malla no uniforme [19]. El diagrama de bandas de conducción y la distribución de densidad de electrones extraídos de la heteroestructura de doble canal de AlGaN se ilustran en la figura 2a, y los resultados de la heteroestructura de canal único de AlGaN también se proporcionan en la figura 2b para su composición. Se forman dos pozos de potencial profundo en la interfaz de las capas intermedias de AlN y Al 0.10 Ga 0.90 N capas de canal para la heteroestructura de doble canal AlGaN, correspondiente a los canales dobles 2DEG. Además, se puede observar que la densidad 2DEG en el canal superior es mayor que en el canal inferior, lo que se puede explicar desde dos aspectos. Por un lado, la barrera inferior de AlGaN actúa como barrera trasera del canal superior, lo que es beneficioso para promover el confinamiento 2DEG del canal superior. Por otro lado, la principal fuente de suministro del canal 2DEG en heteroestructuras de nitruro son los estados superficiales de tipo donante [20], que están más cerca del canal superior.
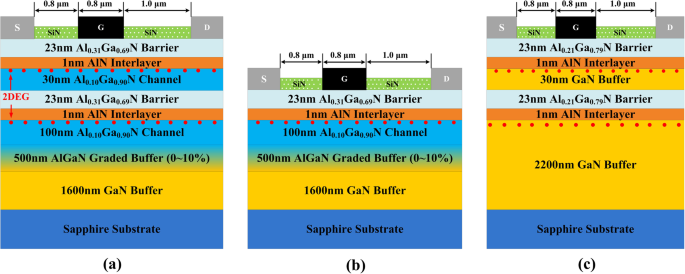
Vista en sección transversal (no a escala) de a AlGaN doble canal, b AlGaN monocanal y c Heteroestructuras de doble canal de GaN (HEMT)
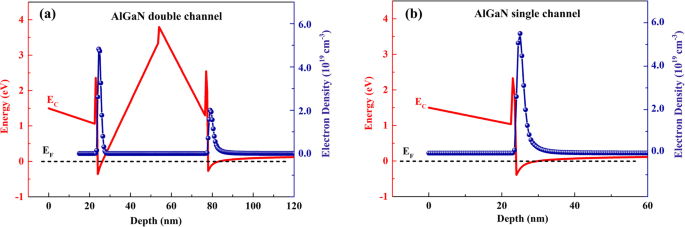
Diagramas de bandas de conducción y distribuciones de densidad de electrones de heteroestructuras de canal doble y monocanal de AlGaN
Resultados y discusión
La Figura 3 muestra el resultado de escaneo de difracción de rayos X de alta resolución (HRXRD) ω-2θ de la heteroestructura de doble canal AlGaN a partir de la reflexión simétrica (0004). Se puede observar la intensidad de difracción de la capa de nucleación de AlN, el tampón de GaN, el tampón graduado de AlGaN, el canal de AlGaN y las capas de barrera de AlGaN. Además, la exploración del espectro de 71,0 a 73,2 ° se presenta en la Fig. 2b con un aumento para mayor claridad, y la función de Lorentz se aplica para ajustar los picos múltiples. Los picos de difracción del tampón de GaN, el canal de AlGaN y la barrera de AlGaN se ubican en 71,6 °, 72,2 ° y 72,8 °, y el tampón graduado de AlGaN da como resultado una plataforma entre los picos del tampón de GaN y el canal de AlGaN. Estos resultados indican la estructura multicapa distintiva y el control sofisticado del proceso de crecimiento, y se pueden extraer las composiciones de AlN del 10% y el 31% en el canal y la barrera de AlGaN.

HRXRD (0004) plano ω-2θ escaneo de heteroestructura de doble canal AlGaN
Se realizó una medición de capacitancia-voltaje (C-V) con configuración de sonda de mercurio para investigar las características de doble canal de la heteroestructura. Como se muestra en el recuadro de la Fig.4, se pueden observar dos pasos de capacitancia distintos en alrededor de - 2.5 V y - 10 V con el voltaje aplicado barrido de 0 a - 15 V, correspondiente al agotamiento de 2DEG en AlN / Al 0,10 Ga 0.90 interfaces. Además, las propiedades de distribución de portadores se pueden extraer de la curva C-V y el resultado se ilustra en la Fig. 4. Dos picos de concentración de portadores se ubican a 24 y 78 nm con valores de 6,1 × 10 19 y 2,5 × 10 19 cm −3 , que está de acuerdo con el resultado calculado como se muestra en la Fig. 2. Especialmente, no se puede observar ningún canal de conducción parásito hasta que la profundidad de prueba alcanza 1 μm, lo que sugiere el logro exitoso de las propiedades de doble canal de la heteroestructura. Además, se determinó que la densidad y la movilidad de la hoja 2DEG eran 1,3 × 10 13 cm −2 y 1130 cm 2 / V ∙ s por la medición del efecto Hall.
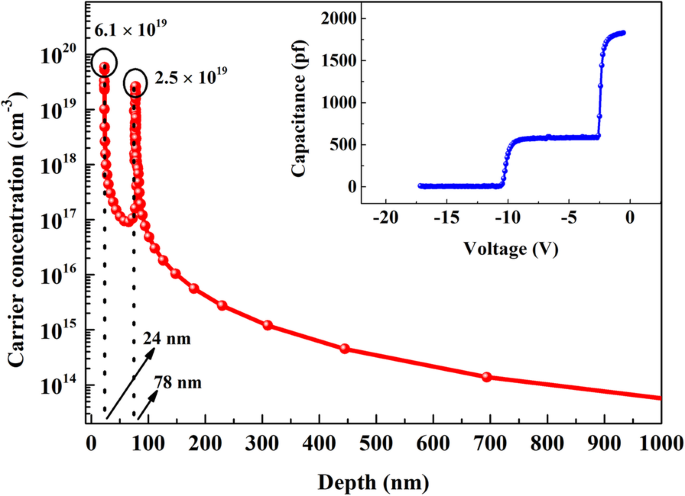
Características C-V y curva de distribución de electrones de la heteroestructura de doble canal de AlGaN
El proceso de fabricación estándar de HEMT se llevó a cabo en la heteroestructura de doble canal AlGaN. El proceso de fabricación del dispositivo comenzó con un contacto óhmico formado con una pila de metal multicapa de Ti / Al / Ni / Au depositada por evaporación por haz de electrones, seguido de un recocido térmico rápido a 850 ° C durante 30 s en N 2 atmósfera. Luego, el aislamiento de mesa fue realizado por Cl 2 / BCl 3 Se formó un grabado con plasma acoplado inductivamente a una profundidad de 200 nm y una capa de pasivación de SiN de 100 nm de espesor mediante deposición química en fase de vapor mejorada con plasma. Posteriormente, un área de puerta con una longitud ( L G ) de 0,8 μm se definió mediante fotolitografía después de grabar el SiN superior con CF 4 plasma, y luego se depositó un electrodo de puerta Schottky de Ni / Au. La fuente de la puerta ( L GS ) y desagüe de la puerta ( L GD ) las distancias son de 0,8 y 1 μm, respectivamente. Para fines de comparación, también se fabricaron dos muestras de HEMT adicionales basadas en las heteroestructuras convencionales de canal único de AlGaN y de canal doble de GaN, y los esquemas de sección transversal se muestran en la Fig. 1 by c. El proceso del dispositivo y los parámetros característicos de las muestras de HEMT adicionales son exactamente los mismos que los de los HEMT de doble canal AlGaN. Las propiedades de salida y transferencia de los dispositivos se llevaron a cabo con el analizador de parámetros de semiconductores Keithley 4200, y las características de ruptura se realizaron utilizando el sistema analizador de semiconductores de alto voltaje Agilent B1505A.
Las características de salida típicas de los HEMT se ilustran en la Fig.5, para las cuales el V GS y V DS fueron barridos de 0 ~ - 10 V y 0 ~ 10 V. La densidad máxima de corriente de drenaje ( I máx ) y diferencial de resistencia ( R en ) de la muestra de canal único AlGaN son 265,3 mA / mm y 27,1 Ω ∙ mm, respectivamente. Estos resultados están de acuerdo con los informes anteriores, lo que sugiere la deficiencia de los HEMT del canal AlGaN en la capacidad de transmisión actual. Para los HEMT de doble canal AlGaN, el I máx aumenta drásticamente a 473 mA / mm, que es 1,8 veces más alto que el de los HEMT de canal único AlGaN. Atribuimos la mejora en I máx a las propiedades de transporte superiores de la heteroestructura de doble canal de AlGaN. Por un lado, la estructura de doble canal posee dos pozos potenciales a lo largo de la dirección vertical y se promueve la capacidad de almacenamiento de portadores del canal de conducción AlGaN. Por otro lado, aunque aumenta la densidad de portadora de canal total, se reduce la densidad de electrones promedio en cada canal. Como resultado, se suprime el efecto de dispersión portadora-portadora y se eleva la movilidad de los electrones del canal. Sin embargo, se puede observar que la R en de los HEMT de doble canal de AlGaN es de 12,5 Ω ∙ mm, aún mayor que la de los HEMT de doble canal de GaN. Este fenómeno está relacionado con la gran altura de la barrera de contacto de las capas de barrera de AlGaN, para las cuales la composición de AlN es tan alta como 31%. Debido al efecto de autocalentamiento resultante de la disipación de alta potencia, se puede observar el efecto de resistencia diferencial negativo para los HEMT de doble canal de GaN cuando V GS > - 4 V y V DS > 6 V. Sin embargo, para los HEMT de canal AlGaN (tanto de un solo canal como de doble canal), este efecto de resistencia diferencial negativo se suprime significativamente, manifestando el rendimiento superior de los HEMT de canal AlGaN en condiciones de temperatura elevada.

Características de salida de los HEMT de doble canal AlGaN, canal único AlGaN y canal doble GaN
La Figura 6 ilustra las propiedades de transferencia típicas de los HEMT con V DS de 10 V. Los HEMT de canal único AlGaN exhiben un voltaje de umbral ( V T ) de - 3,8 V, junto con un pico de transconductancia extrínseca inferior ( G m, máximo ) de 80,5 mS / mm en las proximidades de V GS =- 1,5 V. Para los HEMT de doble canal AlGaN y GaN de doble canal, el V T disminuye notablemente a -9,2 y -11,2 V, que es el resultado de la alta densidad de portadora del canal y la distancia relativamente larga desde el electrodo de puerta al canal 2DEG inferior. El alto V T puede resultar en una gran pérdida de potencia de los dispositivos en estado apagado, y este problema se puede mejorar optimizando aún más los parámetros de crecimiento de las estructuras de doble canal, como la reducción adecuada del grosor de la barrera y las capas del canal superior. Especialmente, se pueden observar características de doble joroba de las curvas de transconductancia de los HEMT de doble canal de AlGaN y de doble canal de GaN. Para los HEMT de doble canal AlGaN, se pueden extraer dos valores pico de 97,9 y 42,5 mS / mm a V G =- 1.0 y - 6.0 V. El valor de subpico alcanza el 43% de G m, max , lo que indica la capacidad de control de puerta decente y la linealidad de los HEMT de doble canal AlGaN. Además, en base a nuestro logro de investigación anterior [21], los resultados pueden mejorarse aún más modulando los parámetros de la estructura, como el grosor y la composición de los canales dobles de AlGaN, y el efecto de acoplamiento entre los canales dobles y la linealidad del dispositivo puede ser mejorado.

Características de transferencia de los HEMT de canal doble AlGaN, canal único AlGaN y canal doble GaN
Las características de avería fuera de estado de los HEMT basados en diferentes heteroestructuras se miden y se muestran en la Fig. 7. La V b se define por el criterio de corriente de fuga que alcanza los 5 μA / mm. Se puede observar que las tres muestras presentan características de ruptura dura, y el rendimiento de ruptura de los HEMT del canal AlGaN es obviamente mejor que el de los HEMT del canal GaN. La V b de los HEMT de doble canal de AlGaN es de 143,5 V, más de dos veces mayor que la de los HEMT de doble canal de GaN. Tomando el L GD =1 μm en consideración, la V b, estándar (definido por V b / L GD ) es tan alto como 143,5 V / μm para los HEMT de doble canal AlGaN. El yo máx y V b, estándar Los resultados de los HEMT de doble canal de AlGaN en este trabajo se comparan con los HEMT de canal de GaN y de canal de AlGaN informados por otros grupos en la Fig.8, y se distinguen los resultados de los dispositivos de modo de agotamiento (DM) y de modo de mejora (EM). Además, los índices centrales de los HEMT del canal AlGaN (heteroestructuras) en informes anteriores y este trabajo se resumen en la Tabla 1. Como se muestra en la Fig. 8, es obvio que el rendimiento de ruptura de los HEMT del canal AlGaN es generalmente mejor que el de GaN canal HEMT, acompañando con el deterioro en I máx . Notablemente, el I máx del doble canal AlGaN en este trabajo es comparable a la mayoría de los resultados de los HEMT del canal GaN. Además, es necesario tener en cuenta que el I máx El valor en este trabajo se obtiene en V GS =0 V, que es conservador y se puede mejorar aún más mediante la aplicación de voltaje de puerta positivo. Por lo tanto, estos resultados demuestran de manera convincente el enorme potencial de los HEMT de doble canal AlGaN en aplicaciones de dispositivos de potencia de microondas.

Características de avería de los HEMT de canal doble AlGaN, canal único AlGaN y canal doble GaN
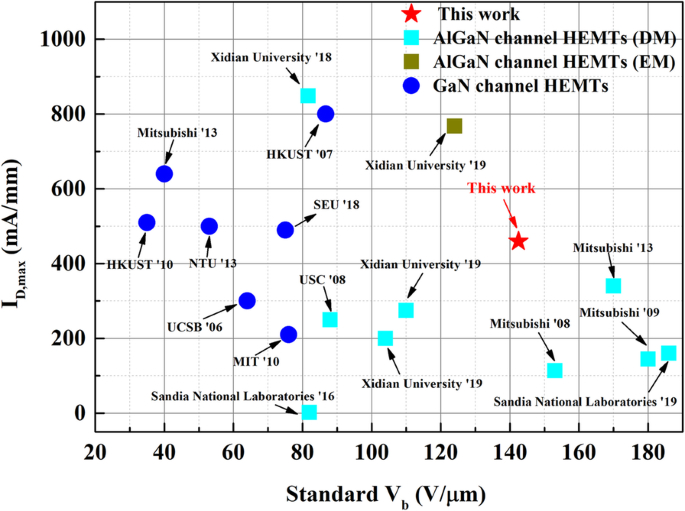
Punto de referencia de I máx y V b, estándar para HEMT de canal AlGaN y canal GaN
Conclusiones
En resumen, se propone la heteroestructura de doble canal de AlGaN para fabricar HEMT de alto rendimiento. Se revelan las propiedades de transporte superiores de la heteroestructura de doble canal de AlGaN, lo que conduce a la capacidad mejorada de transmisión de corriente de los HEMT. Además, se demuestra el excelente rendimiento de avería de los HEMT de doble canal AlGaN. Los resultados de este trabajo muestran el gran potencial de los dispositivos de doble canal AlGaN en aplicaciones de energía de microondas en el futuro.
Disponibilidad de datos y materiales
Todos los datos generados o analizados durante este estudio se incluyen en este artículo publicado y sus archivos de información complementaria.
Abreviaturas
- MOCVD:
-
Deposición de vapor químico orgánico metálico
- HEMT:
-
Transistores de alta movilidad de electrones
- 2DEG:
-
Gas de electrones bidimensionales
- I máx :
-
Densidad máxima de corriente de drenaje
- V b :
-
Voltaje de ruptura
- V T :
-
Voltaje umbral
- RF:
-
Radiofrecuencia
- HRXRD:
-
Difracción de rayos X de alta resolución
- C-V:
-
Capacitancia-voltaje
- L G :
-
Longitud de la puerta
- L GS :
-
Distancia puerta-fuente
- L GD :
-
Distancia puerta-drenaje
- R en :
-
On-resistencia
- G m :
-
Transconductancia
- DM:
-
Modo de agotamiento
- EM:
-
Modo de mejora
Nanomateriales
- Voltaje y corriente
- Voltaje y corriente en un circuito práctico
- Voltaje de ruptura del aislador
- Condensadores y cálculo
- Cálculos de voltaje y corriente
- Cálculos complejos de voltaje y corriente
- Inductancia mutua y funcionamiento básico
- Qué es el mantenimiento de averías y cómo solucionarlo
- Impacto de los estados de la superficie y la fracción molar de aluminio en el potencial de la superficie y 2DEG en los HEMT de AlGaN / GaN
- RGO y redes de grafeno tridimensionales co-modificadas TIM con alto rendimiento
- Materiales y diseño de PCB para alta tensión



