Mediciones locales de COV mediante microscopía de fuerza de sonda Kelvin aplicada en nanocables de Si de unión radial P-I-N
Resumen
Este trabajo se centra en la extracción de la tensión de circuito abierto ( V OC ) en nanocables fotovoltaicos por fotovoltaje de superficie (SPV) basado en mediciones de microscopía de fuerza de sonda Kelvin (KPFM). En un primer enfoque, los dispositivos de nanocables de silicio (SiNW) de unión radial (RJ) P-I-N se investigaron bajo iluminación mediante KPFM y análisis de corriente-voltaje (I-V). Dentro del 5%, el SPV extraído se correlaciona bien con el V OC . En un segundo enfoque, las mediciones locales de SPV se aplicaron en SiNW de unión radial única y aislada, señalando los efectos de sombra de la punta del AFM que pueden tener un fuerte impacto en la evaluación de SPV. Se han implementado varias estrategias en términos de la forma de la punta del AFM y la orientación de la iluminación para minimizar este efecto. Las mediciones de SPV locales en SiNW de unión radial aislada aumentan logarítmicamente con la potencia de iluminación y demuestran un comportamiento lineal con V OC . Los resultados muestran notablemente que las mediciones sin contacto de V OC llegar a ser factible a escala de dispositivos SiNW fotovoltaicos individuales.
Introducción
Las nanoestructuras de semiconductores atraen un gran interés de investigación debido a sus propiedades a nanoescala que ofrecen un gran potencial para mejorar el rendimiento en los dispositivos existentes. Los arreglos de nanocables basados en uniones radiales (RJ) son nanoestructuras prometedoras para aplicaciones fotovoltaicas (PV) debido a sus propiedades de captura de luz y recolección de portadores [1, 2] que se combinan deliberadamente para mejorar la eficiencia solar con respecto a las estructuras planas convencionales. La eficiencia de las células solares de nanocables puede verse limitada por las uniones de nanocables dañadas en la matriz; no obstante, ya se han demostrado eficiencias de hasta el 9,6% para los RJ de nanocables de silicio (SiNW) basados en la tecnología de película fina de Si [3]. La caracterización de tales estructuras sigue siendo un tema crítico y, en particular, la posibilidad de caracterizar el rendimiento fotoeléctrico de los nanocables individuales es un valor agregado para la mejora del dispositivo final.
En el presente estudio, utilizamos microscopía de fuerza de sonda Kelvin (KPFM) para evaluar el voltaje de circuito abierto local ( V OC ) en SiNW RJs. El análisis de V OC KPFM ha evaluado con éxito varios tipos de tecnologías fotovoltaicas, principalmente estructuras planas [3, 4]. Sin embargo, el análisis KPFM en nanodispositivos fotovoltaicos no es sencillo debido a que puede requerir la realización de mediciones tanto en condiciones de oscuridad como de iluminación para extraer la variación del potencial de superficie, denominada fotovoltaje de superficie (SPV).
Nuestro primer enfoque para sondear el V local OC de RJ SiNWs fue analizar los dispositivos completados. El término completado se refiere a las células solares RJ SiNW que se completan con ITO como electrodo frontal. Los siguientes dispositivos completados se caracterizaron secuencialmente mediante mediciones de corriente-voltaje (I-V) y KPFM. Ambas mediciones se realizaron en condiciones de oscuridad e iluminación con el objetivo final de extraer y comparar V OC y SPV. Nuestro segundo enfoque fue analizar RJ SiNWs individuales aislados que no fueron recubiertos por ITO. Nuestro objetivo particular fue optimizar la señal KPFM bajo iluminación evitando muchos artefactos que pueden resultar en la subestimación del valor SPV. Se hará referencia a cada uno de los RJ SiNW aislados como dispositivos aislados.
Finalmente, para completar los resultados, también se aplicó la técnica macroscópica de sonda Kelvin en un dispositivo RJ completo y en un grupo de dispositivos aislados. Esto se hizo bajo iluminación a diferentes longitudes de onda para realizar espectroscopía de fotovoltaje de superficie (SPS).
Materiales y métodos
Crecimiento de SiNW y fabricación de dispositivos de unión radial P-I-N
Los RJ SiNW se prepararon sobre un sustrato de vidrio Corning revestido con ZnO:Al (Cg). El crecimiento de SiNWs se realizó a una temperatura del sustrato de 500 ° C mediante deposición química en fase de vapor mejorada con plasma (PECVD) y fue mediado usando nanopartículas de Sn como catalizadores. El P-I-N RJ se obtuvo depositando capas delgadas conformadas de Si (a-Si:H) amorfo hidrogenado intrínseco (80 nm) y luego de tipo n (10 nm) también mediante PECVD a 175 ° C en el núcleo de SiNW de tipo p. Los dispositivos completados se finalizaron con una deposición conformada de ITO que formaba contactos superiores circulares de 4 mm de diámetro definidos por una máscara durante la deposición por pulverización catódica. Los detalles completos de la fabricación se explican en otra parte [1, 5, 6, 7].
Sonda Kelvin y fotovoltaje de superficie
Las mediciones de KPFM se pueden realizar utilizando dos modos diferentes, modulación de amplitud (AM) y modulación de frecuencia (FM). Ambos modos permiten obtener el mismo valor de propiedad de diferencia de potencial de contacto (CPD) existente entre la punta y la superficie de la muestra. El modo AM fue el elegido en este estudio, debido a su mayor estabilidad de medición en presencia de variaciones de altura significativas como las que se ven en el borde de los nanocables de muestra.
Las mediciones de KPFM y SPV se realizaron utilizando un sistema de microscopía de sonda de barrido de HORIBA / AIST-NT (plataforma TRIOS) que ofrece varias ventajas. De hecho, para este microscopio de fuerza atómica (AFM), el sistema de deflexión basado en rayos láser (LBBDS) emplea una longitud de onda láser a 1310 nm que minimiza las posibles interacciones fotoeléctricas con la muestra [8,9,10 ] . Esto se enfatizará aquí comparando los datos adquiridos usando esta plataforma con los obtenidos usando un sistema AFM que usa una longitud de onda de 690 nm para el LBBDS.
La plataforma TRIOS es muy adecuada para estudiar las propiedades fotoeléctricas de los materiales ya que incluye tres objetivos de microscopio que permiten la iluminación de la muestra desde diferentes direcciones (superior, lateral e inferior). Las mediciones de SPV en la escala micro / nano se obtienen aquí restando el CPD en la oscuridad al CPD bajo iluminación. Este tipo de medición se ha utilizado anteriormente para realizar V OC mediciones de dispositivos fotovoltaicos [5, 11]. La iluminación de la muestra se logró utilizando un diodo láser estabilizado OXXIUS de longitud de onda de 488 nm con un módulo de potencia variable.
Se utilizaron dos tipos de puntas de AFM conductoras para las mediciones aplicadas de la sonda de barrido, el ARROW-EFM y el ATEC-EFM. Ambos tienen un voladizo de silicio dopado y un revestimiento de PtIr. Su diferencia radica en su forma con una forma de punta convencional para el ARROW y una forma inclinada para el ATEC.
Finalmente, las mediciones de SPV a nanoescala se complementaron con mediciones macroscópicas de la sonda Kelvin con la posibilidad de variar la longitud de onda de iluminación para realizar mediciones de SPS, es decir, mediciones de SPV resueltas espectralmente. Para este propósito, se utilizó una configuración de sonda Kelvin ASKP200250 de KPTechnology equipada con una punta de acero de 2 mm de diámetro. Esta configuración incluye una iluminación desde el lado que acopla una fuente de lámpara halógena a un monocromador que cubre el rango de longitud de onda de 400 nm a 1000 nm. Tenga en cuenta que esta configuración no permite realizar mediciones de SPV a un flujo constante y, por esta razón en particular, solo se pueden realizar observaciones cualitativas.
Mediciones I-V macroscópicas combinadas con KPFM
Como se indicó anteriormente, nuestro primer enfoque fue realizar mediciones macroscópicas I-V en un dispositivo SiNW RJ completo. Para ello utilizamos un SourceMeter KEITHLEY 2450 y un microposicionador con una aguja de tungsteno que permite contactar con el dispositivo mientras se encuentra bajo la configuración de AFM como se esquematiza en la Fig. 1.
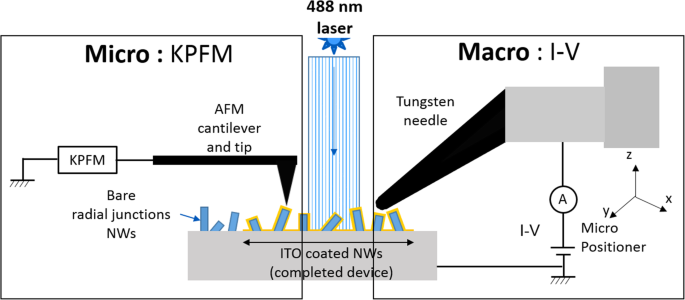
Esquemas de la configuración de medición tanto para KPFM como para mediciones macroscópicas I-V
Las mediciones de I-V y KPFM se realizaron en condiciones de oscuridad y luego utilizando la misma iluminación descrita en la subsección anterior, es decir, una fuente de láser a 488 nm con potencia ajustable. La iluminación se realizó desde el lado superior a través de un objetivo MITUTOYO 10X y la iluminación de potencia incidente se calibró en el rango de 70-1000 μW.
Las mediciones de KPFM se realizaron además en los dispositivos aislados con dos tipos de puntas AFM, ARROW y ATEC. La iluminación de la muestra durante la medición se realizó desde dos direcciones, superior y lateral, y utilizando la misma potencia nominal que las utilizadas anteriormente en el dispositivo completo.
Resultados y discusión
Antes de comenzar las mediciones de I-V y KPFM, se investigó el impacto del LBBDS del AFM. De hecho, ya se ha demostrado que la longitud de onda del LBBDS puede tener una interacción significativa con las muestras fotovoltaicas [8,9,10] y, por tanto, puede influir en las mediciones de propiedades eléctricas con el AFM. La Figura 2 ilustra las mediciones macroscópicas I-V de un completado El dispositivo SiNW RJ se realiza en condiciones de oscuridad (LBBDS apagado) y cuando el LBBDS se mantiene encendido. Como se mencionó anteriormente, las mediciones también se realizaron en una configuración de AFM diferente utilizando una longitud de onda de 690 nm en lugar de 1310 nm para el LBBDS. Las curvas I-V obtenidas en condiciones de oscuridad y con el LBBDS a 1310 nm son casi idénticas. Solo al hacer zoom alrededor del origen se puede observar un cambio muy pequeño para las mediciones realizadas con el LBBDS mantenido, que puede expresarse por valores muy pequeños en términos de V OC (0,5 mV) y corriente de cortocircuito, I SC, (1 nA). En comparación, la curva I-V medida con el sistema usando una longitud de onda de 690 nm para el LBBDS exhibe un efecto fotovoltaico significativo, con valores de V OC y yo SC de 545 mV y 28 μA, respectivamente. Esto evidencia claramente el efecto disruptivo de un LBBDS con una longitud de onda láser en el rango visible. Estos resultados muestran las dificultades para realizar mediciones de KPFM en condiciones reales de oscuridad cuando, en particular, la longitud de onda de LBBDS puede interactuar con la muestra. Los siguientes resultados ilustrados se realizaron con el LBBDS del AFM operando a 1310 nm descrito en la subsección Kelvin-Probe.
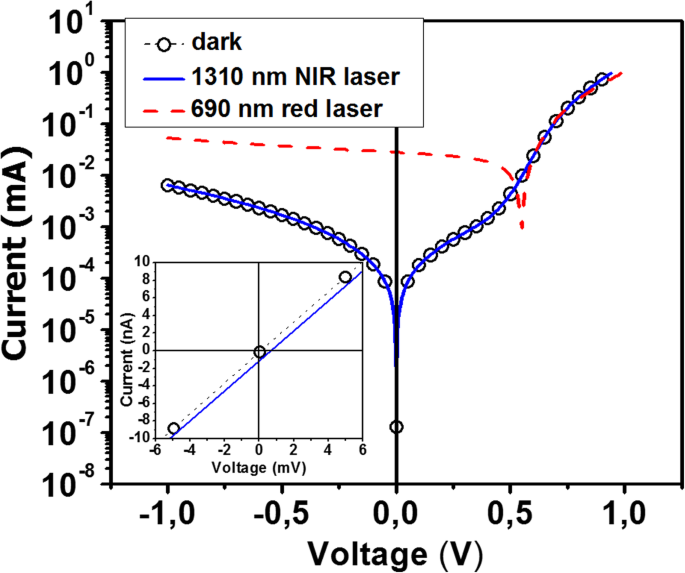
Curvas I-V obtenidas en un dispositivo SiNW RJ en condiciones de oscuridad (círculos negros), con el rayo láser de 1310 nm del TRIOS AFM (línea continua azul) y con el rayo láser de 690 nm del Enviroscope AFM (línea discontinua roja). El gráfico principal ilustra las curvas log | I | -V en el rango - 1 V y + 1 V, y el gráfico de inserción representa una ampliación de las curvas I-V lineales entre - 5 mV y + 5 mV
En la Fig. 3 se muestra un ejemplo de medición fotovoltaica en un dispositivo SiNW RJ completo. En la Fig. 3.a se presentan en particular mediciones macroscópicas I-V bajo diferentes iluminaciones de potencia (70, 150, 270 y 560 μW). Las curvas I-V muestran un comportamiento operativo típico de una celda fotovoltaica donde I SC y V OC aumenta con la potencia de la luz incidente. La Figura 3.b muestra un ejemplo de mapeo KPFM que representa, de izquierda a derecha, la topografía, el CPD en la oscuridad y el CPD en la iluminación de 488 nm. El escaneo de la topografía revela NW con alturas de varios cientos de nanómetros y que muestra una densidad por unidad de área de alrededor de 10 9 cm -2 . Las exploraciones CPD muestran variaciones de potencial local de alrededor de ± 10 mV que tienen lugar principalmente en los bordes NW. Estas variaciones se pueden considerar como artefactos debido al cambio rápido en la topografía que atraviesa la punta del AFM durante el movimiento de escaneo y, en particular, cuando pasa entre dos NO. Los lugares que están exentos de tal artefacto son la parte superior de los NW, donde el cambio de altura de la topografía sigue siendo insignificante. Todos los valores de CPD presentados a continuación se extrajeron en la parte superior de los NW.
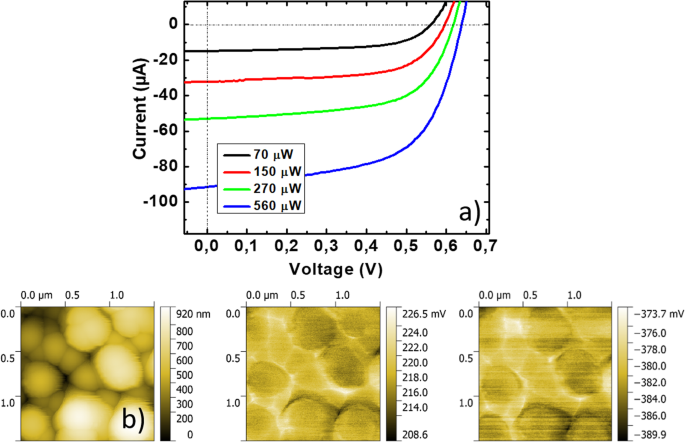
un Curvas macroscópicas I-V medidas bajo diferentes iluminaciones de potencia (66, 5, 149, 268 y 555 μW a 488 nm); b de izquierda a derecha:topografía, CPD en condiciones de oscuridad y CPD en condiciones de iluminación (270 μW a 488 nm), respectivamente
La figura 4 compara el V OC y valores SPV extraídos de las mediciones macroscópicas I-V y KPFM como funciones de la potencia de iluminación incidente. Esta comparación se realizó para dos dispositivos completos diferentes y se ilustró en una escala semilogarítmica. La diferencia máxima entre las curvas Voc y SPV es inferior al 5% para la potencia de iluminación más baja (~ 70 μW) y se vuelve inferior al 2% para la potencia de iluminación más alta. Es importante tener en cuenta que la barra de error asociada a la evaluación experimental de la potencia de la luz incidente aumenta cuando la potencia de iluminación disminuye, lo que puede explicar la diferencia del 5% entre V OC y SPV mencionado anteriormente. Para ambos gráficos, SPV y V OC los valores siguen un comportamiento logarítmico con valores en el rango 500-600 mV. Las pendientes de Voc y SPV dan un factor de idealidad (n) de 1,5 ± 0,1 para el dispositivo 1 y 1,75 ± 0,25 para el dispositivo 2, respectivamente. Estos valores concuerdan bien con los valores reportados en la literatura para la unión a-Si:H P-I-N que están en el rango 1.5-2 [12,13,14]. En la Fig. 5 ilustramos las mediciones de SPV frente a la potencia de la luz realizadas en dispositivos RJ SINW aislados. El término aislado se refiere aquí al hecho de que los RJ de nanocables no están cubiertos con ITO, por lo que no están conectados eléctricamente a través de la capa conductora superior. Como guía de referencia, la curva SPV obtenida previamente para el dispositivo RJ completado en la Fig. 4.a también se mostró en la Fig. 5. Los valores SPV reportados corresponden a un valor promedio resultante de varios NW para tamaños de escaneo de 3x3 μm². Las mediciones de SPV en dispositivos aislados se realizaron primero con una punta de AFM en forma de flecha (ARROW-EFM) y una iluminación proveniente de la parte superior al igual que la medición de SPV realizada en el dispositivo completo. Los valores muy bajos de SPV para esta curva (Fig. 5.a, cuadrados) así como su pendiente por debajo de 1 (~ 0.4) sugieren un efecto de sombra debido a la punta AFM. De hecho, mantener la misma iluminación superior y cambiar la punta del AFM por una sonda inclinada (ATEC-EFM) nos permitió observar un aumento del 40% de los valores de SPV para el mismo rango de iluminación de potencia (Figura 5.b, triángulo). Se obtuvieron resultados similares al cambiar la iluminación de la parte superior a la lateral y reemplazar el ATEC de la punta de AFM por la FLECHA de la punta de AFM inicial (Fig. 5.c, puntos azules). Aunque los valores de SPV han aumentado significativamente en comparación con las mediciones con iluminación superior y punta ARROW-EFM, permanecen por debajo del de referencia mientras mantienen pendientes similares (~ 1.3-1.4). Tenga en cuenta que este efecto de sombreado no fue observable en el caso de dispositivos completados porque para esta configuración, el SPV toma imágenes del fotovoltaje de todo el dispositivo:miles de nanocables conectados entre sí por el contacto frontal de ITO.
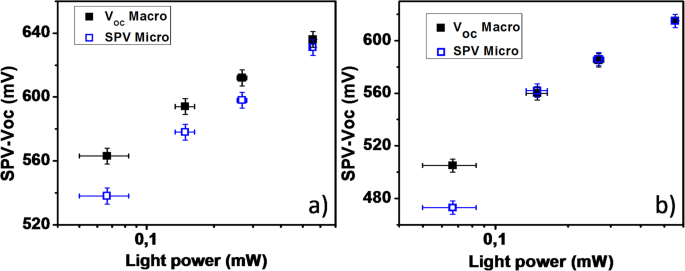
V OC y SPV versus potencia de luz para dos dispositivos diferentes:dev 1 ( a ) y dev 2 ( b )

SPV versus potencia de luz obtenida en RJ NW aislados. Las mediciones se realizaron con diferentes formas de punta de AFM (ARROW-EFM y ATEC-EFM) y diferentes direcciones de iluminación (superior y lateral). El dispositivo RJ de referencia designa el dispositivo 1 ilustrado en la Fig. 4a. La imagen AFM en la parte inferior derecha muestra un ejemplo de la topografía medida en NW aislados
Para complementar esos resultados, se realizó un análisis SPS cualitativo por encima de un grupo de dispositivos aislados y luego por encima de un dispositivo completo. La Fig. 6.a muestra los espectros SPV obtenidos con claras diferencias en todo el espectro. Es interesante subrayar que el dispositivo completo muestra un SPV insignificante (~ 10 mV) en la región del infrarrojo cercano (NIR) con un umbral de SPV que tiene lugar alrededor de 800 nm y por debajo del cual el SPV aumenta rápidamente alcanzando un máximo de 560 mV a 630 Nuevo Méjico. Por el contrario, el grupo de dispositivos aislados revela un SPV significativo de 80-260 mV en el NIR (800-1000 nm) que aumenta gradualmente con la disminución de la longitud de onda, hasta 435 mV para 665 nm. Por debajo de 665 nm y 630 nm, ambas curvas SPV disminuyen con la disminución de la longitud de onda, lo que puede estar relacionado con la disminución esperada de la irradiancia de la lámpara halógena utilizada en esta configuración (como se mencionó anteriormente, el enfoque SPS aquí se basa en mediciones cualitativas ya que el flujo no puede mantenerse constante). En un segundo enfoque, las mediciones de SPS se realizaron en un dispositivo completo y después de eliminar localmente el contacto superior de ITO con una solución de HF al 1% aplicada como una gota en el dispositivo. La Figura 6.b ilustra estas mediciones, y los espectros de SPV se recopilaron específicamente justo después de eliminar ITO y 72 horas después. La eliminación de la capa ITO tiene un efecto importante en el espectro SPV en comparación con el dispositivo completo. Se observa una fuerte disminución de la señal SPV en el rango de 400-750 nm justo después de la eliminación de ITO. Después de 72 horas, la señal SPV se estabiliza a un nivel más alto que puede diferir, dependiendo de la longitud de onda, en más de un factor de 2. También resulta que la señal SPV aumenta ligeramente a longitudes de onda más largas (λ> 750 nm). Comparando los espectros SPV de la Fig. 6, parece que después de la eliminación de ITO ilustrada en la Figura 6.by especialmente después de 72 h de estabilización, los dispositivos NW muestran un estado similar a los designados como grupo de NW aislados en la Fig. 6.a, este último nunca ha tenido ningún revestimiento ITO. Otra observación importante se refiere a la señal SPV medida a 488 nm cuyo valor es un factor ~ 1,7 más bajo para un grupo de NW aislados que para un dispositivo completo. Esta observación apoya los resultados de SPV de la Fig. 5 realizados por KPFM en RJ NW aislados con una iluminación a 488 nm. De hecho, a pesar de la optimización de la forma de la punta del AFM y las condiciones de iluminación, los valores de SPV medidos también fueron más bajos que los del dispositivo completo en un factor que variaba entre 1,5 y 2, dependiendo de la potencia de iluminación.
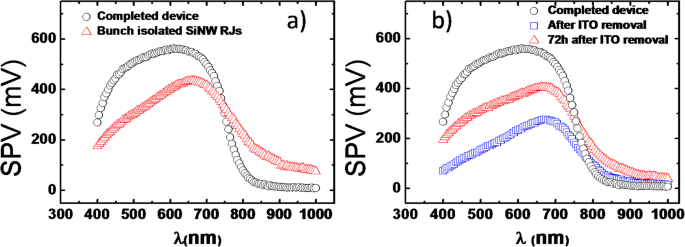
Mediciones de SPS realizadas en a un dispositivo completo y un montón de SiNW aislados; b un dispositivo completo, justo después de eliminar ITO y 72 h después
Los resultados de la Fig.6 muestran claramente que se requiere el contacto superior ITO para desarrollar valores más altos de SPV (es decir, V OC ) y, más específicamente, el punto clave sigue siendo la interfaz (n) a ‑ Si:H / ITO. Esta interfaz se caracteriza por una capa a-Si:H de tipo n muy fina (~ 10 nm) para favorecer la transmisión óptica. El nivel de dopaje de esta capa y la función de trabajo ITO pueden provocar en particular el agotamiento total de la capa a-Si:H. Por lo tanto, puede producirse una caída repentina de potencial en la interfaz antes de alcanzar un potencial de banda plana en la ITO. Tal caída en el potencial en la interfaz con el contacto superior ITO ya se ha ilustrado en estructuras P-I-N a-Si:H que fueron analizadas por perfiles SPV [12, 15]. Las mismas interfaces con capas ultrafinas de a ‑ Si:H también se investigaron en la tecnología de células solares de la heterounión a ‑ Si:H / Si cristalino enfatizando nuevamente el impacto del nivel de dopaje y el espesor de la capa a-Si:H en la V OC con y sin ITO [16, 17].
Las consideraciones anteriores indican que el análisis de SPV local por KPFM en RJ NW aislados no puede reflejar cuantitativamente el valor óptimo de V OC debido a la ausencia de ITO. El V OC local extraído está restringido aquí por la flexión de la banda superficial como consecuencia del agotamiento total de la capa de a-Si:H de tipo n y su estado de superficie de oxidación. El SPV medido no solo incluye el V OC sino también el cambio de flexión de la banda fotoinducido cerca de la superficie de la capa de tipo n a-Si:H [18].
Conclusión
Los dispositivos completos basados en RJ SiNW se analizaron conjuntamente bajo iluminación mediante mediciones I-V y KPFM. Esta primera comparación realizada para diferentes potencias de iluminación muestra que los valores de SPV locales extraídos de KPFM son muy cercanos al V OC valores obtenidos del análisis I-V. Las mediciones de SPV locales en RJ SiNW aislados muestran, por el contrario, una diferencia significativa con respecto al V OC anterior. valores. Se ha evidenciado un efecto de sombra de la punta AFM y se ha minimizado cambiando la forma de la punta y / o la orientación de la iluminación. Los valores de SPV optimizados recopilados de RJ SiNW aislados muestran un comportamiento logarítmico con la potencia de iluminación, pero permanecen muy por debajo del V OC Valores de referencia. El análisis SPS realizado en grupos de dispositivos SiNW aislados resalta la ausencia de la interfaz (n) a-Si:H / ITO como la causa de la pérdida de potencial, y notablemente porque los dispositivos SiNW aislados estudiados no tienen ITO como contacto superior. A pesar de esto, el SPV local extraído en dispositivos SiNW aislados bajo diferentes condiciones de iluminación muestra una correspondencia lineal con el V OC medido en dispositivos completados, confirmando en particular que el SPV local puede reflejar el V OC .
Disponibilidad de datos y materiales
Los conjuntos de datos utilizados y / o analizados durante el estudio actual están disponibles del autor correspondiente a solicitud razonable.
Abreviaturas
- AFM:
-
Microscopía de fuerza atómica
- AM:
-
Modulación de amplitud
- a-Si:H:
-
Silicio amorfo hidrogenado
- Cg:
-
Vidrio Corning
- CPD:
-
Diferencia de potencial de contacto
- FM:
-
Modulación de frecuencia
- ITO:
-
Óxido de indio-estaño
- I-V:
-
Corriente-voltaje
- KPFM:
-
Microscopía de fuerza de sonda Kelvin
- LBBDS:
-
Sistema de deflexión basado en rayo láser
- n:
-
Factor de idealidad
- NW:
-
Nanocable
- PECVD:
-
Deposición de vapor químico mejorada con plasma
- PV:
-
Fotovoltaica
- RJ:
-
Unión radial
- SiNW:
-
Nanoalambre de silicio
- SPS:
-
Espectroscopia de fotovoltaje de superficie
- SPV:
-
Fotovoltaje superficial
- V OC :
-
Voltaje de circuito abierto
Nanomateriales
- Imágenes de átomos en cristales atómicos 2D en líquidos
- Los científicos de materiales enseñan a los nanocables cómo 'bailar'
- Absorción de luz mejorada con plasmón en (p-i-n) células solares de nanocables GaAs de unión:un estudio de método de simulación FDTD
- Nanocables de silicio amorfo cultivados en película de óxido de silicio mediante recocido
- Investigación teórica de nanocables de germanio tensados biaxialmente por tracción
- Estudio de la fuerza de adhesión y la transición vítrea de películas delgadas de poliestireno mediante microscopía de fuerza atómica
- Sensor de gas de hidrógeno de nanocables de óxido de cobre asistido por luz ultravioleta
- Reducción de óxido de grafeno a baja temperatura:Conductancia eléctrica y microscopía de fuerza de sonda Kelvin de barrido
- Caída potencial en energía fotovoltaica orgánica sondada por microscopía de fuerza de sonda Kelvin de sección transversal
- Fabricación controlable de sondas AFM recubiertas de Au mediante un procedimiento de química húmeda
- ¿Qué es la fuerza radial?



