Característica de conmutación resistiva de baja potencia en la memoria de acceso aleatorio resistiva de dos capas de HfO2 / TiOx
Resumen
Dispositivos de memoria resistiva de acceso aleatorio con deposición de capa atómica HfO 2 y chisporroteo de radiofrecuencia TiO x ya que las capas de conmutación resistivas se fabricaron con éxito. La característica de baja potencia con una potencia de ajuste de 1,52 μW (1 μA@1,52 V) y una potencia de reinicio de 1,12 μW (1 μA@1,12 V) se obtuvo en el HfO 2 / TiO x dispositivos de memoria resistiva de acceso aleatorio (RRAM) mediante el control del contenido de oxígeno del TiO x capa. Además, la influencia del contenido de oxígeno durante el TiO x El proceso de pulverización catódica sobre las propiedades de conmutación resistiva se discutirá en detalle. Las investigaciones indicaron que la "ruptura suave" ocurrió fácilmente durante el proceso de formación / fraguado eléctrico en el HfO 2 / TiO x Dispositivos RRAM con alto contenido de oxígeno de TiO x capa, lo que da como resultado una alta potencia de conmutación resistiva. La característica de baja potencia se obtuvo en HfO 2 / TiO x Dispositivos RRAM con una densidad de vacantes de oxígeno adecuadamente alta de TiO x capa, lo que sugiere que la densidad de vacantes de oxígeno adecuada en el TiO x La capa podría evitar una "ruptura suave" a través de todas las capas dieléctricas durante el proceso de formación / fraguado, limitando así el flujo de corriente a través del dispositivo RRAM y disminuyendo el consumo de energía operativa.
Introducción
La memoria resistiva de acceso aleatorio (RRAM) proporciona una solución prometedora para escalar más allá de la memoria tradicional basada en carga debido a una estructura de celda simple, almacenamiento no volátil, operación de alta velocidad y alta relación de encendido / apagado [1,2,3, 4,5,6,7,8,9,10]. Recientemente, One-transistor one-resistor (1T1R) es una estructura ampliamente aceptada para evitar mediciones de resistencia inexactas causadas por una corriente de fuga en la matriz 1R [11, 12]. Además, la memoria emergente, especialmente RRAM basada en óxido, se ha propuesto para dispositivos sinápticos plásticos debido a la modulación de conductancia gradual con número de pulso, que puede imitar el comportamiento sináptico biológico para recibir señales de neuronas presinápticas y postsinápticas [13,14,15 , 16,17]. Sin embargo, la alta corriente de conmutación resistiva es la principal limitación para aplicaciones de baja potencia y alta densidad [18,19,20]. La matriz 1T1R también enfrenta desafíos de escala si la corriente de operación de RRAM no puede escalar en consecuencia. Por ejemplo, cuando la tecnología CMOS se reduce a 27 nm, la corriente de excitación disminuirá a 40 μA [21]. Por lo tanto, es necesario reducir la corriente de operación del dispositivo RRAM a 10 μA optimizando la estructura y el material para continuar con el escalado 1T1R [22]. Además, las sinapsis biológicas consumen alrededor de 1 ~ 10 fJ por evento en el cerebro humano complejo, por lo que reducir el consumo de energía de los dispositivos sinápticos eléctricos tan poco como las sinapsis biológicas es importante para el desarrollo de redes neuronales artificiales neuromórficas (ANN) [23, 24,25]. Por lo tanto, limitar la corriente del dispositivo y reducir el consumo de energía beneficiará el proceso práctico para el almacenamiento de datos y la aplicación de computación neuromórfica.
En este trabajo, Pt / HfO 2 / TiO x / Dispositivos Pt con un contenido de oxígeno diferente de TiO x Se fabricaron películas y se demostró la característica de bajo poder en bajo contenido de oxígeno. El dispositivo de memoria alcanzó una potencia establecida de 1,52 μW y una potencia de reinicio de 1,12 μW mediante la disminución del contenido de oxígeno del TiO x película durante el proceso de pulverización catódica. El mecanismo conductor para la característica de baja potencia se analizó más a fondo para proporcionar información sobre el diseño de RRAM de óxido.
Métodos
El Pt / HfO 2 / TiO x / La estructura del dispositivo Pt y el proceso de fabricación se muestran en la Fig. 1a y b. Al principio, en Si / SiO 2 / Sustrato de Ti, se preparó un electrodo de fondo (BE) de Pt de 100 nm mediante pulverización catódica de corriente continua (CC) a temperatura ambiente. A continuación, 3 nm HfO 2 se depositó mediante la técnica de deposición de capa atómica (ALD) (Picosun R200) a 300 ° C utilizando TEMAH y H 2 O como precursores. Posteriormente, 30 nm TiO x fue depositado con diferente contenido de oxígeno por pulverización catódica por radiofrecuencia. Durante TiO x proceso de pulverización catódica de película, que fija el flujo total de gas de argón (Ar) y oxígeno (O 2 ) como 20 sccm y cambiando la presión parcial de oxígeno con 9%, 11% y 13%, se obtuvieron tres dispositivos de muestra (S1, S2 y S3) para investigar la influencia del contenido de oxígeno de TiO x película sobre el rendimiento de conmutación resistiva. A continuación, se depositó un electrodo superior (TE) de Pt de 70 nm mediante pulverización catódica con CC y se modeló con litografía. Finalmente, se formaron dispositivos de forma cuadrada de 100 μm × 100 μm mediante grabado con iones reactivos (RIE). Se aplicó voltaje de polarización en el TE y el BE se conectó a tierra. Las imágenes del microscopio electrónico de transmisión de alta resolución (HRTEM) de la sección transversal del Pt / HfO 2 / TiO x / Pt se muestran en la Fig. 2. Las características eléctricas de los dispositivos se midieron con el analizador de parámetros de semiconductores Agilent B1500A. Los estados químicos de los átomos en el TiO x Las películas se investigaron mediante espectroscopia de fotoelectrones de rayos X (XPS, Axis Ultra).
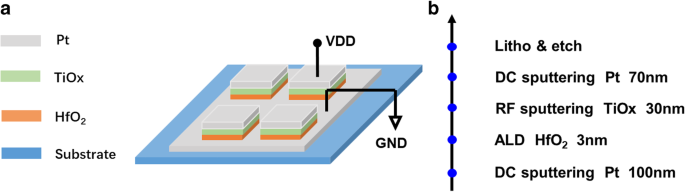
un La estructura de Pt / HfO2 / TiO x / Pt dispositivo. b El flujo del proceso de fabricación
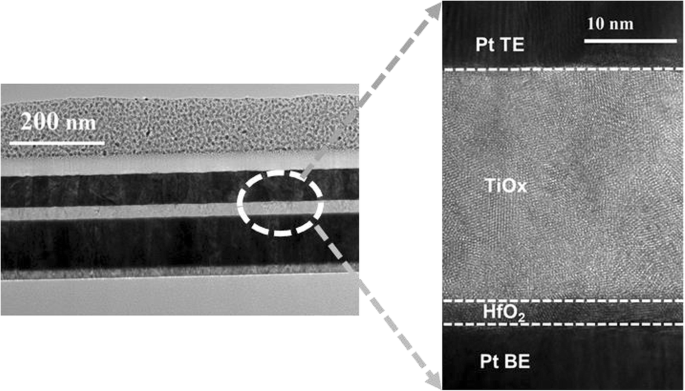
Secciones transversales TEM del Pt / HfO 2 / TiO x / Pt dispositivo
Resultados y discusión
Las figuras 3a, byc muestran los espectros de nivel de núcleo de XPS O 1s de TiO x Película (s. Para aclarar el enlace químico del oxígeno en las películas, los picos asimétricos de O 1s se dividen en dos picos, que generalmente se atribuyen al O 2− unido por iones metálicos y O 2− en la región deficiente en oxígeno [26]. Presión parcial de oxígeno durante TiO x El proceso de pulverización catódica de la película se estableció en 9%, 11% y 13%, respectivamente, y el contenido deficiente de oxígeno correspondiente en tres muestras es de aproximadamente 28,23%, 24,06% y 23,63%, lo que indica que el contenido de iones de oxígeno no reticulados y las vacantes de oxígeno disminuyen con el aumento de la presión parcial de oxígeno.

Espectros de escaneo XPS de O 1s de TiO x películas en S1, S2 y S3. La presión parcial de oxígeno se estableció como a 9%, b 11% y c 13% durante TiO x proceso de pulverización catódica de película
Para los dispositivos nuevos, el estado original es en estado de alta resistencia (HRS). Como se muestra en la Fig. 4, la formación de corriente (CF) se aplica para iniciar la formación del filamento conductor y cambiar el estado del dispositivo a un estado de baja resistencia (LRS) [27]. Cuando se aplica 1 μA de cumplimiento de corriente, se forma una ruta conductora en S1 y el proceso estable de activación / desactivación se puede lograr en la operación posterior. Para S2 y S3, la operación de reinicio no es exitosa desde el estado medio del dispositivo durante el proceso de CF hasta que el cumplimiento actual es de hasta 20 mA.
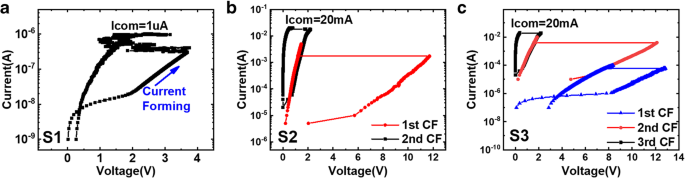
Proceso de formación actual de Pt / HfO2 / TiO x / Pt dispositivo RRAM en a S1, b S2 y c S3
Para probar el rendimiento eléctrico del dispositivo RRAM, se llevan a cabo mediciones de CC bajo barrido de voltaje. La tensión de polarización positiva en el proceso de formación y fraguado se aplica en TE para completar el filamento conductor, y la tensión de polarización negativa en el proceso de reinicio es para romper el filamento. Cuando la polarización se desplaza hacia adelante y hacia atrás, en la figura 5 se muestran 100 ciclos de curvas de corriente-voltaje (IV) de conmutación bipolar de tres muestras. hasta 10 mA para las otras dos muestras. La característica de baja potencia de S1 podría atribuirse a un alto contenido de vacantes de oxígeno preexistente en TiO x película, que limita la corriente de manera efectiva durante el proceso de formación / fraguado.
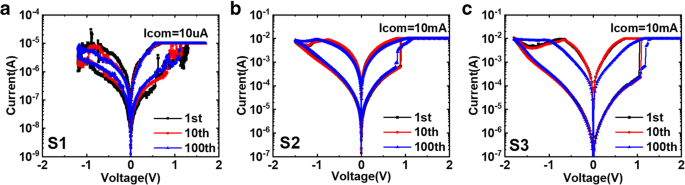
Curvas I-V bidireccionales estables de 100 ciclos en a S1, b S2 y c S3
Las figuras 6 y 7 representan la variación de ciclo a ciclo y de dispositivo a dispositivo (desviación estándar relativa, ( σ / μ )) de tres muestras, y las estadísticas se resumen en las Tablas 1 y 2. Para S1, la corriente de salto débil causa una distribución de resistencia modesta, y los filamentos conductores fuertes formados en S2 y S3 garantizan la distribución de resistencia relativamente estable. Aunque hay una pequeña degradación para S3 después de docenas de ciclos, la relación de encendido / apagado sigue siendo superior a 100.

Variación de ciclo a ciclo de R LRS y R HRS durante 100 ciclos en a S1, b S2 y c S3

Variación de dispositivo a dispositivo de R LRS y R HRS para 20 dispositivos en a S1, b S2 y c S3
Como se muestra en la Fig. 8, la potencia establecida (Pset) 1,52 μW y la potencia de reinicio (Preestablecido) 1,12 μW se alcanzan bajo una baja corriente de cumplimiento de 1 μA. El consumo de energía de las otras dos muestras es de decenas de milivatios debido a los 10 mA de corriente de funcionamiento. Además, los estados de resistencia de S1 pueden mantener las características de retención por encima de 10 4 s por debajo de 85 ° C con una relación de encendido / apagado de aproximadamente 100, que es estable para la aplicación de almacenamiento de datos.
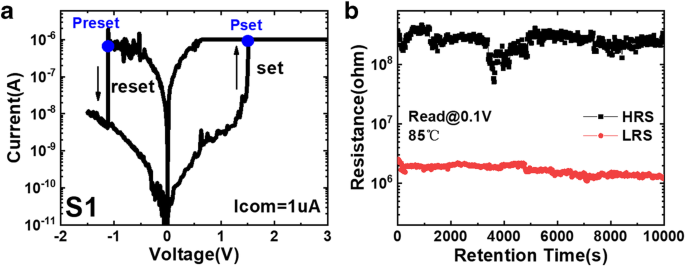
un Rendimiento de conmutación resistiva con una limitación de corriente de 1 μA. b La característica de retención en S1 es superior a 10 4 s por debajo de 85 ° C
Para dilucidar el mecanismo conductor de la característica de baja potencia, llevamos a cabo mediciones de temperatura para S1 y S3 con diferentes corrientes de operación e investigamos el mecanismo correspondiente, como se muestra en las Figs. 9 y 10. De 25 ° C a 125 ° C, la resistencia de S1 disminuye con la temperatura, pero la resistencia de S3 casi no cambia. La conductancia y temperatura experimentales se ajustan con el modelo de salto de rango variable de Mott [28], como se muestra en la Fig. 11, que indica que el mecanismo conductor principal de S1 es el salto de electrones a través de defectos localizados de vacancia de oxígeno en el óxido dieléctrico [29]. Al disminuir la presión parcial de oxígeno durante el TiO x proceso de pulverización catódica, como se muestra en S1, el contenido de vacantes de oxígeno en el TiO inicial x La capa aumenta y la resistencia de la película disminuye [30]. El voltaje en el TE se aplica principalmente en el HfO 2 La capa y una masa de vacantes de oxígeno están motivadas para formar el filamento conductor. Después de eso, las nuevas vacantes de oxígeno también están motivadas en el TiO x capa, pero la conexión entre las vacantes de oxígeno es débil. Por lo tanto, la conducción de salto de electrones en TiO x es dominante, lo que garantiza una corriente de conmutación resistiva baja de 1 μA.

un La resistencia cambia con la temperatura en S1. b El diagrama esquemático correspondiente del mecanismo conductor

un La resistencia cambia con la temperatura en S3. b El diagrama esquemático correspondiente del mecanismo conductor

Dependencia de la temperatura de la conductancia de S1 en a LRS y b HRS
Sin embargo, como se muestra en la Fig. 10, después de aumentar el contenido de oxígeno durante TiO x El proceso de pulverización catódica, HRS y LRS permanecen casi sin cambios con la temperatura, que probablemente esté asociada con el mecanismo de transporte de tipo metálico, inducido por el transporte de electrones a través del filamento conductor formado por vacantes de oxígeno concentrado. En comparación con el dispositivo RRAM de S1, menos vacantes de oxígeno en TiO inicial x La capa de S3 no es suficiente para que los electrones salten por conducción. Además, debido a la mayor resistencia de TiO x película, la polarización de voltaje se aplica tanto en HfO 2 capa y TiO x capa al mismo tiempo. La inicialización eléctrica genera una gran cantidad de vacantes de oxígeno motivadas en HfO 2 y TiO x capas. Estas vacantes de oxígeno forman un filamento conductor fuerte en ambas dos capas dieléctricas, y los abundantes electrones extendidos fluyen a través de las dos vacantes de oxígeno adyacentes, lo que provoca una alta corriente de operación durante el proceso de conmutación resistiva.
En principio, es posible controlar el contenido de oxígeno con cuidado para lograr un rendimiento de baja potencia en otras memorias resistivas de óxido (OxRRAM) relacionadas con la vacante de oxígeno. El requisito para la capa de óxido es que debe haber suficientes vacantes de oxígeno en el estado inicial para la conducción de salto eléctrico en caso de avería del dispositivo. Sin embargo, las vacantes de oxígeno excesivas causarán una característica de resistencia inestable y deteriorarán el rendimiento del dispositivo. Por lo tanto, las vacantes de oxígeno adecuadas son necesarias para limitar la corriente de funcionamiento y reducir el consumo de energía.
La Tabla 3 compara algunos de los parámetros clave de Pt / HfO 2 / TiO x / Pt dispositivo con otros informes recientes. El dispositivo tiene ventajas importantes de una potencia de conmutación resistiva baja de 1,12 μW y una relación de más de 100 HRS / LRS entre varios dispositivos RRAM.
Conclusiones
En este trabajo, se demostró una corriente de conmutación resistiva de 1 μA en Pt / HfO 2 / TiO x / Dispositivo de estructura de Pt. Para el mecanismo conductor, la conducción por salto de electrones es dominante en el bajo contenido de oxígeno del TiO x capa, que limita la corriente de funcionamiento y reduce el consumo de energía. El transporte de tipo metálico es dominante en el alto contenido de oxígeno del TiO x capa, y la "ruptura suave" de dos capas dieléctricas provoca una alta corriente de operación y un alto consumo de energía. El contenido de oxígeno apropiado de TiO x La película puede limitar la corriente RRAM y contribuir a la característica de baja potencia, lo que proporciona una solución para problemas de alta potencia y corriente de operación grande y muestra la promesa para futuras memorias no volátiles integradas y aplicaciones de Internet de las cosas (IoT).
Abreviaturas
- 1T1R:
-
Un transistor un resistor
- ALD:
-
Deposición de la capa atómica
- ANN:
-
Redes neuronales artificiales
- BE:
-
Electrodo inferior
- CF:
-
Formación actual
- HRS:
-
Estado de alta resistencia
- HRTEM:
-
Microscopio electrónico de transmisión de alta resolución
- IoT:
-
Internet de las cosas
- I-V:
-
Corriente-voltaje
- LRS:
-
Estado de baja resistencia
- Proporción de encendido / apagado:
-
HRS / LRS
- OxRRAM:
-
Memoria resistiva de óxido
- Valor predeterminado:
-
Restablecer energía
- Pset:
-
Establecer potencia
- RIE:
-
Grabado de iones reactivos
- RRAM:
-
Memoria resistiva de acceso aleatorio
- TE:
-
Electrodo superior
- XPS:
-
Espectroscopia de fotoelectrones de rayos X
- σ / μ :
-
Desviación estándar relativa
Nanomateriales
- Oxígeno
- Nano grafema, memoria transparente flexible basada en silicio
- Características de conmutación resistiva bipolar de dispositivos RRAM con estructura de tres capas de HfO2 / TiO2 / HfO2 en sustratos recubiertos de Pt y TiN fabricados por deposición de capa atóm…
- Memoria resistiva ZrO2 / ZrO2 - x / ZrO2 sin cumplimiento con comportamiento de conmutación multiestado interfacial controlable
- Una SRAM 4T integrada de RRAM con carga de conmutación resistiva autoinhibida mediante un proceso lógico CMOS puro
- Un estudio colectivo sobre modelado y simulación de memoria resistiva de acceso aleatorio
- Efecto de campo ferroeléctrico Inducido por efecto de conmutación asimétrica resistiva en BaTiO3 / Nb:Heterouniones epitaxiales SrTiO3
- Reacción de reducción de oxígeno en nanocatalizador de PtCo:Envenenamiento por aniones (bi) sulfato
- Un estudio de la variabilidad en la memoria de acceso aleatorio resistivo de contacto por modelo de vacante estocástico
- Fabricación de patrones de conmutación óptica con microfibras de colores estructurales
- Nuevo método crea memoria de computadora a partir de óxido de titanio



