Mejora dieléctrica de capacitores MIM de Al2O3 / ZrO2 / Al2O3 depositados en capas atómicas mediante recocido por microondas
Resumen
Para los condensadores de metal-aislante-metal (MIM) aplicados en los campos de RF, DRAM y circuitos integrados de señal analógica / mixta, es imperativa una alta densidad de capacitancia con la reducción del tamaño de la característica del dispositivo. En este trabajo, se investiga la técnica de recocido por microondas para mejorar las características dieléctricas de Al 2 O 3 / ZrO 2 / Al 2 O 3 condensadores MIM basados. Los resultados muestran que la permitividad de ZrO 2 aumenta a 41,9 (~ 40% mejorado) con un recocido de microondas a 1400 W durante 5 min. La temperatura del sustrato es inferior a 400 ° C, lo que es compatible con el proceso de final de línea. Las densidades de corriente de fuga son 1,23 × 10 −8 y 1,36 × 10 −8 A / cm 2 para la muestra depositada y la muestra de 1400 W, respectivamente, lo que indica que la propiedad de fuga no se deteriora. Se confirma que el mecanismo de conducción es un túnel asistido por el campo.
Antecedentes
Los condensadores metal-aislante-metal (MIM) se han utilizado ampliamente en los campos de la radiofrecuencia (RF), la memoria dinámica de acceso aleatorio (DRAM) y los circuitos integrados de señal analógica / mixta. Con la reducción del tamaño de la función del dispositivo, es deseable obtener una densidad de capacitancia cada vez mayor. Por ejemplo, se requiere que la densidad de capacitancia sea mayor que 10 fF / μm 2 según el nodo 2020 de la Hoja de ruta tecnológica internacional para semiconductores (ITRS) [1]. Como consecuencia, se ha investigado una gran cantidad de materiales con alto contenido de kappa, como HfO 2 [2, 3, 4, 5, 6], ZrO 2 [7,8,9,10,11,12,13,14], Ta 2 O 5 [15,16,17,18] y TiO 2 [19,20,21,22,23,24]. Entre estos materiales con alto contenido de κ, ZrO 2 tiene una constante dieléctrica (κ) de 16 ~ 25 (fase monoclínica) y una banda prohibida de 5,8 eV. Sin embargo, el valor κ de ZrO 2 se puede mejorar a 36,8 y 46,6 cuando se cristaliza en fase cúbica y tetragonal, respectivamente [25]. Por tanto, la densidad de capacitancia se puede incrementar aún más. La técnica de recocido por microondas (MWA) ha sido tremendamente explorada para la activación de dopantes en silicio [26, 27, 28] y la formación de siliciuro [29, 30] debido a su menor temperatura de proceso en comparación con las técnicas convencionales de procesamiento térmico. Además, Shih et al. [31] investigó el efecto de MWA sobre las características eléctricas de TiN / Al / TiN / HfO 2 / Condensadores Si MOS. Se mejoraron algunos parámetros clave como el espesor de óxido equivalente, la densidad del estado de la interfaz y la densidad de la corriente de fuga.
En este trabajo, el efecto de MWA sobre las propiedades eléctricas de TaN / Al 2 O 3 / ZrO 2 / Al 2 O 3 Se investigan los condensadores MIM / TaN (TaN / A / Z / A / TaN). Con el uso de MWA, la permitividad de ZrO 2 se mejora notablemente y la densidad de corriente de fuga aumenta ligeramente. Además, también se estudia el mecanismo de conducción subyacente.
Métodos
En primer lugar, un SiO 2 de 500 nm de espesor La película se hizo crecer sobre un sustrato de Si mediante PECVD, seguido de la deposición de películas de TaN (20 nm) / Ta (100 nm), y se cultivó TaN mediante pulverización catódica de Ta en N 2 / Ar plasma. Posteriormente, la oblea de Si recubierta con las películas de TaN / Ta se transfirió a la cámara de ALD y la nanoapila de Al 2 O 3 (2 nm) / ZrO 2 (20 nm) / Al 2 O 3 (2 nm) se depositaron a 250 ° C. Al 2 O 3 y ZrO 2 las películas se cultivaron a partir de Al (CH 3 ) 3 / H 2 O y [(CH 3 ) 2 N] 4 Zr / H 2 O, respectivamente. Vale la pena mencionar que un ultrafino Al 2 O 3 capa entre el electrodo inferior de TaN y el ZrO 2 Se insertó una capa para restringir la formación de la capa interfacial durante el recocido de ALD y posterior a la deposición. Posteriormente, las muestras se sometieron al recocido por microondas. El MWA se realizó en una cámara octagonal DSGI a 5,8 GHz. Durante el recocido, las muestras se colocaron en el centro de la cámara, donde el campo electromagnético es más uniforme. La temperatura in situ de las muestras se controló mediante un pirómetro infrarrojo de la serie Raytek XR orientado hacia la parte posterior de las muestras. La potencia se varió de 700 W a 1400 W con un tiempo de recocido fijo de 5 min. Finalmente, se formó a su vez un electrodo superior de TaN de 100 nm de espesor mediante pulverización catódica reactiva, litografía y grabado con iones reactivos.
Los espesores de película de ALD se midieron con un elipsómetro (SOPRA GES 5E) y se confirmaron mediante microscopio electrónico de transmisión (TEM). Capacitancia-voltaje ( C-V ) se midió con un analizador de impedancia de precisión (Agilent 4294A) con una amplitud de CA de 50 mV. Corriente-voltaje ( I-V ) las mediciones se realizaron con un analizador de dispositivos semiconductores (Agilent B1500) en una caja oscura. La polarización se aplicó al electrodo superior.
Resultados y discusión
Las estructuras esquemáticas del condensador MIM basado en A / Z / A y la cámara MWA se muestran en la Fig. 1a yb, respectivamente. La Figura 1c muestra la imagen TEM en sección transversal del condensador MIM basado en A / Z / A que está sujeto al MWA a 1400 W durante 5 min. Se observa que el ZrO 2 La capa está completamente cristalizada y las capas apiladas se pueden distinguir claramente, vea el recuadro. La Figura 2a muestra la gráfica de probabilidad acumulada de la densidad de capacitancia a diferentes potencias de recocido. Los resultados muestran que las densidades de capacitancia de los capacitores MIM son 7.34, 8.87, 8.96 y 9.06 fF / μm 2 respectivamente para 0, 700, 1050 y 1400 W con una probabilidad acumulada del 50%. Por lo tanto, la densidad de capacitancia aumenta bajo el efecto de las microondas. La distribución muy estrecha de la densidad de capacitancia para los capacitores MIM de pila A / Z / A con MWA indica una muy buena uniformidad de recocido. El recuadro de la Fig. 2a muestra las curvas CV típicas de todas las muestras. Excluyendo el efecto de Al 2 O 3 (κ ≈ 8), las constantes dieléctricas del ZrO 2 las películas se extraen como 28,3, 40,1, 41 y 41,9 para 0, 700, 1050 y 1400 W, respectivamente, revelado por la Fig. 2b. Con respecto a la potencia de microondas de 1400 W, la constante dieléctrica del ZrO 2 la película aumenta en un 40% en comparación con la muestra depositada. La mejora significativa de la permitividad de ZrO 2 puede atribuirse a la cristalización de alto grado durante el recocido por microondas, que se muestra en la Fig. 1c. Como se mencionó anteriormente, la constante dieléctrica de ZrO 2 se puede mejorar a 36,8 y 46,6 cuando se cristaliza en fase cúbica y tetragonal, respectivamente [25]. Por lo tanto, la medición de XRD se realizó para investigar más el mecanismo de mejora de la constante dieléctrica. Como se muestra en el recuadro de la Fig. 2b, existía un pico a ~ 30,7 ° después del procesamiento de MWA a 1400 W, lo que indica la aparición de la fase tetragonal (111) en ZrO 2 [32, 33]. La presencia de esta fase tetragonal es responsable de la mejora de la constante dieléctrica de 28,3 a más de 40.

un La estructura esquemática de Al 2 O 3 / ZrO 2 / Al 2 O 3 condensador MIM basado en b La estructura esquemática de la cámara MWA. c Imagen TEM de Al 2 O 3 / ZrO 2 / Al 2 O 3 condensador MIM basado en MWA a 1400 W durante 5 min

un La gráfica de probabilidad acumulada de la densidad de capacitancia para diferentes muestras; el recuadro muestra la densidad de capacitancia contra el sesgo. b La gráfica de probabilidad acumulada de la permitividad de ZrO 2 para diferentes muestras; el recuadro muestra los patrones XRD de las muestras depositadas y de 1400 W
Dado que los condensadores MIM se fabrican en el extremo posterior de la línea (BEOL) de los circuitos integrados, la temperatura del proceso debe ser inferior a 400 ° C [34]. Como se muestra en la Fig. 3, las curvas de temperatura de MWA indican que las temperaturas más altas del sustrato son 260, 350 y 400 ° C para 700, 1050 y 1400 W, respectivamente. Por tanto, MWA es compatible con el proceso CMOS desde el punto de vista de la temperatura del proceso. Además, en el trabajo anterior [13], Al 2 O 3 (2 nm) / ZrO 2 Los condensadores MIM basados en (20 nm) se sometieron a recocido térmico rápido (RTA) a 420 ° C durante 10 min en N 2 / H 2 ambiente y la constante dieléctrica resultante de ZrO 2 se evaluó como 40. Para RTA, el tiempo de recocido se mantuvo constante a 420 ° C durante 10 min, por lo que el balance térmico fue mucho mayor en comparación con MWA. Para MWA [35, 36], se cree que la polarización dipolar es el mecanismo más importante para la transferencia de energía a nivel molecular. Cuando los materiales en contacto tienen diferentes propiedades dieléctricas, las microondas se acoplarán selectivamente con los materiales de mayor pérdida dieléctrica. Por el contrario, el RTA convencional transfiere el calor de manera más eficiente a materiales con alta conductividad.
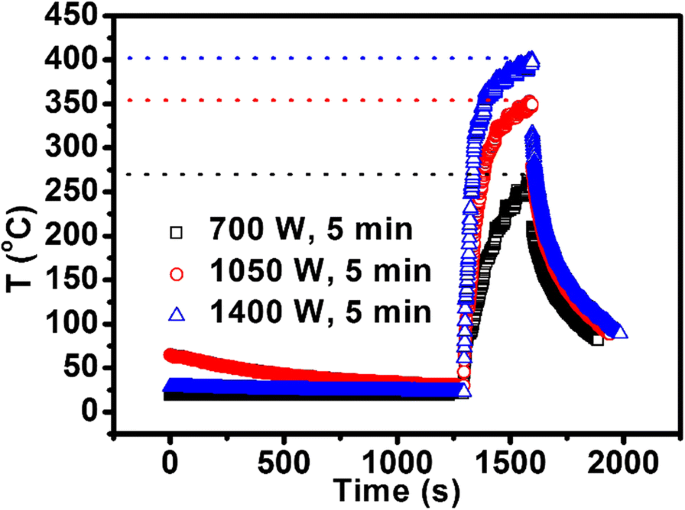
Las curvas de temperatura del sustrato para diferentes muestras durante el recocido por microondas
La corriente de fuga es otro parámetro importante para los condensadores MIM. Como se muestra en la Fig. 4a, la curva de la corriente de fuga se puede dividir en dos secciones para todas las muestras, ya que existe un punto de inflexión obvio, que indica diferentes mecanismos de conducción de electrones. En cuanto a las muestras con procesamiento MWA, la tensión correspondiente al punto de inflexión es menor en comparación con la muestra depositada. La Tabla 1 enumera la densidad de corriente de fuga a ± 4 V para todas las muestras. Tome 4 V, por ejemplo, la densidad de corriente de fuga aumenta de 1.06 × 10 −7 a 1,92 × 10 −5 A / cm 2 , es decir, dos órdenes de amplitud mejoradas cuando la potencia de microondas aumenta de 0 a 1400 W. Debido a una alta cristalización del ZrO 2 película, aparecerá una gran cantidad de límites de grano y servirán como el camino con fugas, mejorando así la conducción de electrones bajo un campo eléctrico alto. Sin embargo, considerando un voltaje de trabajo de 2 V, las densidades de corriente de fuga son 1.23 × 10 −8 y 1,36 × 10 −8 A / cm 2 para la muestra depositada y la muestra de 1400 W, respectivamente. Obviamente, el recocido por microondas tiene poco efecto sobre el comportamiento de la fuga bajo un campo eléctrico bajo. Además, el voltaje de ruptura se extrajo del I - V prueba y se traza en la Fig. 4b. Para la muestra depositada, el voltaje de ruptura es de aproximadamente 9,8 V con una probabilidad acumulada del 50%. Con la aplicación de MWA, la tensión de ruptura se reduce a ~ 9 V. Esta reducción de la tensión de ruptura podría estar relacionada con el cambio de ZrO 2 microestructura.
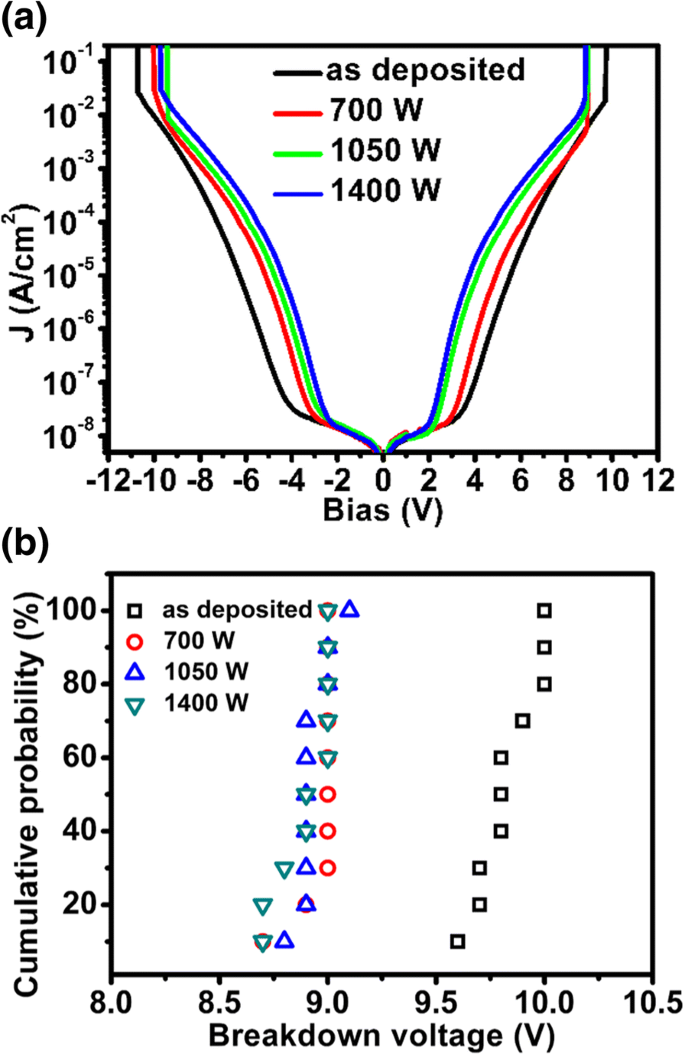
un La gráfica de la densidad de corriente de fuga ( J ) vs sesgo y b la gráfica de probabilidad acumulada del voltaje de ruptura para diferentes muestras
Para comprender mejor el efecto de MWA sobre la corriente de fuga, se investigan los mecanismos de conducción de los condensadores MIM. Basado en la investigación anterior sobre Al 2 O 3 (2 nm) / ZrO 2 Condensador MIM basado en (20 nm) [13, 14], el mecanismo de conducción dominante en un campo eléctrico alto se confirmó como tunelización asistida por campo (FAT). Para FAT, que es un túnel relacionado con trampas, los electrones son capturados por las trampas en el aislante en primer lugar y luego hacen un túnel a la banda de conducción del aislante directamente [37]. En el trabajo actual, el Al 2 O 3 y ZrO 2 Las películas en los condensadores MIM basados en A / Z / A se depositaron en las mismas condiciones, por lo que la corriente de fuga probablemente también sea predominante por FAT. El modelo FAT se puede expresar mediante la ecuación. (1) [37]
$$ J ={AE} ^ 2 \ exp \ left (- \ frac {8 \ pi \ sqrt {2 {m} ^ {\ ast} q {\ varphi} _t ^ 3}} {3 hE} \ right) $$ (1)donde A es una constante, E es el campo eléctrico, q es la carga electrónica, m * representa la masa efectiva del electrón (aproximadamente 0,25 m 0 , donde m 0 es la masa del electrón libre), k es la constante de Boltzmann, φ t es la barrera de energía que separa las trampas de la banda de conducción, y h es la constante de Planck.
En términos de los dieléctricos apilados, el campo eléctrico aplicado a cada capa difiere entre sí debido a la diferente permitividad y espesor. Por lo tanto, el uso del campo eléctrico promedio en toda la pila provocará errores graves al discutir el mecanismo de conducción. Como consecuencia, el campo eléctrico a través del ZrO 2 La capa debe extraerse con precisión. Los campos eléctricos a través de ZrO 2 son 3,125 × 10 7 × V pila , 2,5 × 10 7 × V pila , 2,47 × 10 7 × V pila y 2,44 × 10 7 × V pila respectivamente para muestras depositadas de 700 W, 1050 W y 1400 W de acuerdo con la ley de Gauss y la ley de voltaje de Kirchhoff [38, 39]:
$$ \ left \ {\ begin {array} {c} {k} _A {E} _A ={\ kappa} _Z {E} _Z \\ {} {d} _A {E} _A + {d} _Z {E } _Z ={V} _ {pila} \ end {matriz} \ derecha. $$ (2)donde k A y κ Z representar las constantes dieléctricas de Al 2 O 3 y ZrO 2 , respectivamente; E A y E Z denotar los campos eléctricos a través de Al 2 O 3 y ZrO 2 , respectivamente; d A y d Z igualar los espesores de Al 2 O 3 y ZrO 2 , respectivamente; y V pila es el voltaje aplicado a la pila. En consecuencia, Ln ( J / E Z 2 ) versus 1 / E Z se representó arbitrariamente en la Fig. 5, donde se logró un ajuste en línea recta en la región de campo alto para cada muestra bajo inyección inferior de electrones (ver Fig. 5a) o inyección superior de electrones (ver Fig. 5b). Esto significa que el mecanismo FAT está dominado por campos eléctricos elevados. El φ extraído t es 0,73, 0,51, 0,38 y 0,35 eV respectivamente para muestras depositadas de 700 W, 1050 W y 1400 W bajo inyección de fondo de electrones. En términos de inyección superior de electrones, el φ correspondiente t es 0,82, 0,53, 0,47 y 0,43 eV, respectivamente. Por lo tanto, el MWA induce algunas trampas poco profundas. Se informa que las trampas poco profundas surgen de los defectos en los límites del grano que pueden introducir estados electrónicos adicionales cerca de la banda de conducción [40]. Además, lo más probable es que el mecanismo de conducción en campos bajos sea la tunelización asistida por trampa (TAT).
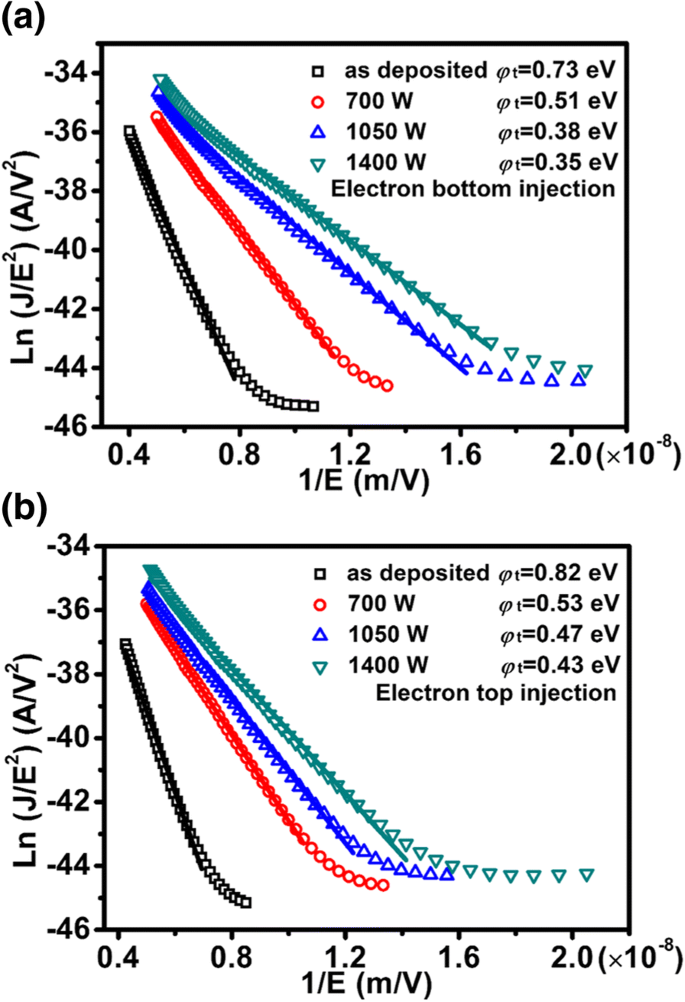
La trama de Ln ( J / E 2 ) frente a 1 / E para diferentes muestras. un Inyección inferior de electrones y b inyección superior de electrones
Conclusiones
Al 2 depositado en capa atómica O 3 / ZrO 2 / Al 2 O 3 nano-stack se utiliza como aislante de los condensadores MIM. Con el efecto de MWA a 1400 W durante 5 min, la densidad de capacitancia aumenta a 9,06 fF / μm 2 , aproximadamente 23,4% de capacitancia mejorada. Desacoplamiento de la influencia de Al 2 O 3 , la constante dieléctrica se deduce como 41,9 para una muestra de 1400 W (~ 40% de la permitividad aumentada). Tal aumento de la permitividad se origina a partir de una alta cristalización del ZrO 2 película. Además, la temperatura del sustrato es inferior a 400 ° C, lo que permite un MWA compatible con el proceso BEOL. Esta menor temperatura del sustrato se puede atribuir al calentamiento selectivo de los materiales de MWA. En términos de una tensión de trabajo de 2 V, las densidades de corriente de fuga son 1,23 × 10 −8 y 1,36 × 10 −8 A / cm 2 para la muestra depositada y la muestra de 1400 W, respectivamente. El mecanismo de conducción dominado en los campos eléctricos elevados se confirma como un proceso FAT. La corriente de fuga en los campos eléctricos bajos probablemente la dicte TAT. Con base en los hechos anteriores, el recocido de microondas es una técnica prometedora utilizada en el proceso CMOS para mejorar el rendimiento dieléctrico de los condensadores MIM.
Abreviaturas
- A / Z / A:
-
Al 2 O 3 / ZrO 2 / Al 2 O 3
- ALD:
-
Deposición de la capa atómica
- BEOL:
-
Final de línea
- C-V :
-
Capacitancia-voltaje
- DRAM:
-
Memoria dinámica de acceso aleatorio
- FAT:
-
Túneles asistidos por campo
- ITRS:
-
Hoja de ruta tecnológica internacional para semiconductores
- I-V :
-
Corriente-voltaje
- MIM:
-
Metal-aislante-metal
- MWA:
-
Recocido por microondas
- PECVD:
-
Deposición de vapor químico mejorada por plasma
- RF:
-
Radiofrecuencia
- RTA:
-
Recocido térmico rápido
- TAT:
-
Túneles asistidos por trampa
- TEM:
-
Microscopio electrónico de transmisión
Nanomateriales
- AVX lanza nuevos condensadores de línea de transmisión de película fina ultraminiatura para aplicaciones de RF y microondas de alto rendimiento
- Imágenes de átomos en cristales atómicos 2D en líquidos
- Imagen de carbono oceánico en escala atómica
- Memoria resistiva ZrO2 / ZrO2 - x / ZrO2 sin cumplimiento con comportamiento de conmutación multiestado interfacial controlable
- Formación y propiedades luminiscentes de Al2O3:nanocompuestos de SiOC en la base de nanopartículas de alúmina modificadas por feniltrimetoxisilano
- Efectos del espesor de la bicapa en las propiedades morfológicas, ópticas y eléctricas de los nanolaminados de Al2O3 / ZnO
- Sensor plasmónico basado en nanoprismas dieléctricos
- Fotodetector controlado por longitud de onda basado en Nanobelt de CdSSe único
- Efecto del recocido térmico posterior en las propiedades ópticas de las películas de puntos cuánticos de InP / ZnS
- RRAM basado en HfAlOx depositado en capa atómica con bajo voltaje de funcionamiento para aplicaciones informáticas en memoria
- Efecto fototérmico de la irradiación láser moduladora sobre la difusividad térmica de los nanofluidos de Al2O3



