Dependencia del espesor de las propiedades interfaces y eléctricas en la capa atómica depositada AlN en el plano c GaN
Resumen
Se investigaron las propiedades interfaciales y eléctricas de la capa atómica depositada AlN sobre n-GaN con diferentes espesores de AlN. Según capacitancia-voltaje ( C - V ), la muestra con un AlN de 7,4 nm de espesor mostró las densidades de interfase y trampa de óxido más altas. Cuando el espesor de AlN fue de 0,7 nm, los espectros de espectroscopía de fotoelectrones de rayos X (XPS) mostraron el pico dominante asociado con los enlaces Al – O, junto con un pico de AlN no claro. Se encontró que la cantidad de átomos de oxígeno restantes cerca de la superficie de GaN disminuía para el AlN más grueso. Sin embargo, muchos átomos de oxígeno estaban presentes a través de la capa de AlN, proporcionando los defectos relacionados con el oxígeno, que finalmente aumentaron la densidad del estado de la interfaz. El modelo de inhomogeneidad de barrera con emisión termoiónica (TE) fue apropiado para explicar la corriente de polarización directa para la muestra con un AlN de 7,4 nm de espesor, que no era adecuado para la muestra con un AlN de 0,7 nm de espesor. Las corrientes de fuga inversa para las muestras con AlN de 0,7 y 7,4 nm de espesor se explicaron mejor utilizando emisiones de Fowler-Nordheim (FN) en lugar de las de Poole-Frenkel.
Antecedentes
Debido a la gran banda prohibida, la alta velocidad de saturación de electrones y el alto campo de ruptura, los materiales de nitruro III son de gran interés no solo para dispositivos optoelectrónicos como diodos emisores de luz azul (LED), diodos láser (LD) y detectores UV, sino también para dispositivos electrónicos como transistores de alta movilidad de electrones (HEMT) y dispositivos de potencia [1, 2, 3, 4]. La realización de dispositivos basados en GaN de alto rendimiento requiere una interfaz metal / GaN con una densidad de estado de interfaz mínima, que puede actuar como trampas de electrones o limitar la modulación de las alturas de la barrera de acuerdo con la función del trabajo del metal fijando el nivel de Fermi [5, 6]. Para otras técnicas de mejora de dispositivos basadas en GaN, algunos métodos, como el crecimiento excesivo de coalescencia de nanocolumnas de GaN, m no polares -plano GaN, plantilla de nanoimpresión GaN y nanobarras de GaN de cara semipolar también se han demostrado [7,8,9,10,11]. Entre los semiconductores compuestos de nitruro III, el nitruro de aluminio (AlN) se puede aplicar a detectores UV, emisores y detectores de longitud de onda corta, debido a su alta banda prohibida (∼ 6.2 eV), alta conductividad térmica, alta resistencia eléctrica y baja expansión. a altas temperaturas [12, 13]. Además, el AlN se puede depositar en un proceso complementario compatible con semiconductores de óxido de metal (CMOS) mediante deposición de capa atómica (ALD) (~ 300 ° C), lo cual es una gran ventaja. Las películas de AlN policristalinas y amorfas cultivadas con ALD se pueden utilizar como capa dieléctrica para dispositivos microelectrónicos [14]. A pesar del progreso de las técnicas de crecimiento de AlN, la AlN cultivada con ALD todavía revela una propiedad no estequiométrica que contiene una gran cantidad de impurezas relacionadas con el oxígeno [15]. La cantidad de átomos de oxígeno en AlN puede afectar fuertemente las propiedades eléctricas y ópticas de AlN [16].
Alto- k óxidos dieléctricos como Al 2 O 3 y HfO 2 se han empleado como capa de pasivación en transistores de alta movilidad de electrones (HEMT) AlGaN / GaN [17, 18]. Pero la formación de enlaces Ga – O en el Al 2 O 3 Se sabe que la interfaz / (Al) GaN produce una alta densidad de estados de interfaz profundos (y lentos) [19]. Como material de pasivación alternativo con estados de interfaz bajos, AlN se ha considerado para dispositivos basados en GaN debido a su menor desajuste de celosía con GaN [20, 21]. Además, se ha informado en GaN de la modulación de las propiedades eléctricas, como la altura de las barreras en los contactos de metal / semiconductor (MS) mediante la inserción de una capa de óxido muy fina [22, 23]. Aumento de la altura de la barrera en Pt / HfO 2 / Diodos semiconductores-aislantes de metal (MIS) de GaN con un HfO 2 de 5 nm de espesor capa se informó [22]. Se encontró que la inserción de una capa de MgO de 3 nm en una interfaz Fe / GaN reduce la altura de la barrera efectiva a 0,4 eV [23]. Sin embargo, todavía ahora hay un número limitado de artículos que informan sobre las propiedades de contacto de ingeniería con AlN desarrollado con ALD en GaN. En este trabajo, depositamos capas de AlN en n-GaN por ALD con diferentes espesores e investigamos las propiedades de la interfaz AlN / n-GaN.
Métodos
Fabricación de materiales y dispositivos
Epitaxia en fase de vapor de hidruro (HVPE):crecido, sin dopar, c -plano (0001) a granel GaN (espesor 300 μm, concentración de portador 5 × 10 14 cm −3 , densidad de dislocación de subprocesos 1,5 × 10 7 cm −2 ) comprado a Lumilog se utilizó en este trabajo. Después de cortar la oblea en trozos pequeños, algunos de ellos se cargaron en una cámara ALD después del proceso de limpieza en un HCl:H 2 Solución O (1:1). Luego, la temperatura se elevó hasta 350 ° C para depositar la capa de AlN. Las películas delgadas de AlN se depositaron mediante un sistema de ALD térmico (fabricante:CN-1 en Corea; modelo:Atomic Classic) utilizando trimetilaluminio (TMA) y NH 3 como precursores. Se prepararon tres capas gruesas diferentes de AlN (0,7, 1,5 y 7,4 nm) variando el número de ciclos de ALD. Los espesores de la película de AlN se midieron usando un elipsómetros de longitud de onda múltiple FS-1 (fabricante:Film Sense en los EE. UU.; Modelo:FS-1). Para examinar las características eléctricas de las películas, se fabricaron diodos MIS con un electrodo Pt Schottky (diámetro 500 μm, espesor 50 nm) y un contacto posterior de Al (espesor 100 nm). Como referencia, también se fabricaron diodos Schottky Pt / n-GaN (es decir, sin capa de AlN).
Caracterización
Corriente-voltaje dependiente de la temperatura ( I - V - T ) las mediciones se realizaron con un analizador de parámetros de semiconductores HP 4155B después de colocar las muestras en un mandril en caliente conectado con un controlador de temperatura, y capacitancia-voltaje ( C - V ) las mediciones se realizaron utilizando un medidor LCR HP 4284A. Las mediciones de espectroscopía de fotoelectrones de rayos X (XPS) se llevaron a cabo utilizando un Al Κα monocromático Fuente de rayos X para observar el mecanismo de formación en la interfaz AlN / GaN.
Resultados y discusión
La Figura 1a-c muestra las imágenes de microscopía electrónica de transmisión de barrido (STEM) en sección transversal alrededor de la capa de AlN. Los espesores estimados de las capas de AlN fueron similares a los valores del elipsómetro. La densidad-voltaje de corriente semilogarítmica típica ( J - V ) las curvas se muestran en la Fig. 2a. En comparación con la muestra sin AlN (es decir, muestra de referencia), los valores actuales aumentaron para la muestra con un AlN de 0,7 nm de espesor y disminuyeron para las muestras con AlN de 1,5 y 7,4 nm de espesor. Utilizando el modelo de emisión termoiónica (TE) [24], se analizó el transporte de corriente de polarización directa de un diodo Schottky para obtener tanto la altura de la barrera como el factor de idealidad. Las alturas de barrera se calcularon en 0,77 (± 0,03), 0,61 (± 0,01), 0,83 (± 0,05) y 1,00 (± 0,08) eV para las muestras con 0-, 0,7-, 1,5- y 7,4 nm- grueso de AlN, respectivamente. Se encontró que los factores de idealidad eran 1,63 (± 0,18), 4,19 (± 0,16), 1,83 (± 0,33) y 1,57 (± 0,03) para las muestras con 0, 0,7, 1,5 y 7,4 nm de espesor. AlN, respectivamente. Con un AlN de 0,7 nm de espesor, la altura de la barrera disminuyó y el factor de idealidad aumentó. Con capas de AlN más gruesas, el factor de idealidad fue similar pero la altura de la barrera aumentó en comparación con la muestra de referencia. Se ve en la Fig. 2c que al aumentar el espesor de AlN, la altura de la barrera disminuyó primero y luego aumentó debido a la resistencia a la formación de túneles inducida por la capa gruesa de AlN. Esto indica que alrededor de 0,7 nm es un punto de inflexión para la altura de la barrera en términos de espesor de AlN.
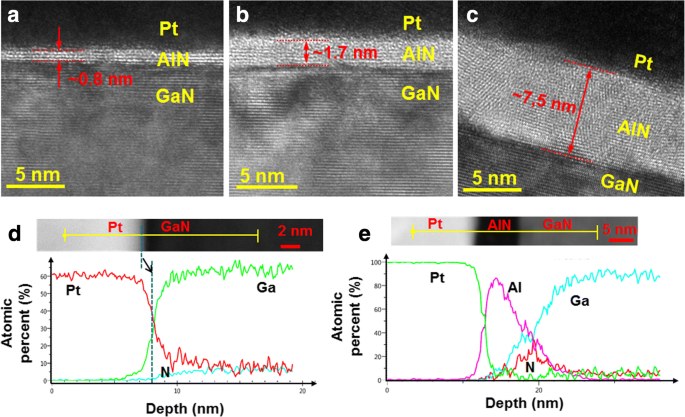
Imágenes de microscopía electrónica de transmisión de barrido (STEM) de sección transversal con a 0,7-, b 1.5- y c AlN de 7,4 nm de espesor. d , e Porcentaje atómico frente a perfiles de profundidad obtenidos de escaneos de línea de espectroscopia de rayos X de dispersión de energía (EDS) para las muestras con AlN de 0 y 7,4 nm de espesor, respectivamente

un Corriente-voltaje semilogarítmica típica ( I - V ) características. b Gráficos de altura de barrera frente a factor de idealidad. c Alturas de barrera y factores de idealidad en función del espesor de AlN
La figura 3 muestra la C - V curvas medidas a varias frecuencias. Cuando los espesores de AlN son 0 y 0,7 nm, la inversión en los valores de capacitancia se observó por debajo de 10 kHz. En lugar de inversión, normalmente se observa un agotamiento profundo para materiales con banda prohibida amplia como GaN debido a la baja tasa de generación de portadores minoritarios (huecos) [25, 26]. Como se muestra en la Fig. 3c, d, dicha inversión no se observó para capas de AlN más gruesas. Aquí, debe tenerse en cuenta que en la unión Au / GaN, no se observó inversión a bajas frecuencias. Utilizando espectroscopia transitoria de nivel profundo (DLTS), Auret et al. observaron defectos inducidos por haz de electrones en las uniones Pt / n-GaN Schottky [27]. Aquí, realizamos mediciones de espectroscopía de rayos X de dispersión de energía (EDS) y los perfiles de profundidad para las muestras con AlN de 0 y 7,4 nm de espesor se muestran en la Fig. 1d, e, respectivamente. Se ve claramente en la Fig. 1d que los átomos de Pt se difundieron en la capa de GaN, mientras que la difusión de los átomos de Pt en la capa de GaN se suprimió eficazmente debido a la capa de AlN. Por lo tanto, sería posible sugerir que los defectos inducidos por la deposición de Pt cerca de la superficie de GaN produjeron la capacitancia de inversión a bajas frecuencias y la formación de estos defectos se suprimió con una capa de AlN relativamente gruesa (> 1,5 nm).
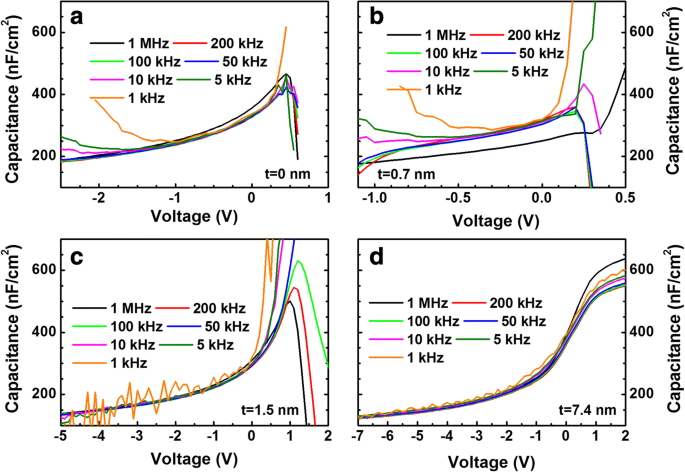
Capacitancia-voltaje ( C - V ) datos medidos en varias frecuencias para las muestras con a 0-, b 0,7-, c 1,5 y d AlN de 7,4 nm de espesor
Excepto la muestra con un AlN de 7,4 de espesor, todas las demás muestras mostraron el pico anómalo en la C - V curva con el aumento del voltaje de polarización, que se asociaron con la distribución de trampas profundas en el espacio, la resistencia en serie y los estados de la interfaz [28, 29]. La dispersión de frecuencia en la región de acumulación está asociada con la formación de una capa no homogénea en la interfaz. La capacitancia de dicha capa actúa en serie con la capacitancia del óxido provocando la dispersión en la acumulación [30]. La dispersión en el agotamiento se debe a la presencia de estados de interfaz que responden a la frecuencia aplicada. Si las constantes de tiempo de los estados de la interfaz son comparables a la frecuencia de la señal pequeña, los estados de la interfaz contribuyen a la capacitancia total de manera que la capacitancia umbral aumenta al disminuir la frecuencia [31].
La Figura 4 muestra la conductancia-voltaje ( G / ω - V ) curvas medidas a varias frecuencias. Bajo sesgos hacia adelante y hacia atrás suficientemente altos, los defectos activados podrían comunicarse con los estados vecinos de la interfaz de manera más efectiva a bajas frecuencias y, por lo tanto, aumentaron la conductancia. Aproximadamente en el rango de -1 y 0 V, todas las muestras mostraron el aumento de la conductancia al aumentar la frecuencia. Este comportamiento se hizo más prominente para la muestra con un AlN de 7,4 nm de espesor. El aumento de la conductancia con el aumento de la frecuencia se asoció con los centros de recombinación que promueven la corriente de recombinación en la región de agotamiento y los estados de la interfaz que proporcionan la corriente de carga y descarga o el proceso de conducción de salto que se produce a alta frecuencia [32]. Los resultados, por lo tanto, indican que los estados de la interfaz con varias constantes de tiempo están presentes para todas las muestras, y la presencia de tales defectos es más significativa para la muestra con un AlN de 7,4 nm de espesor.
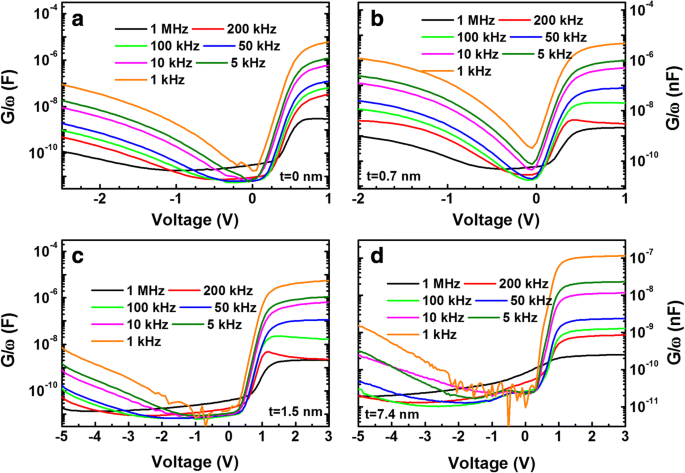
Conductancia-voltaje ( G / ω - V ) datos medidos en varias frecuencias para las muestras con a 0-, b 0,7-, c 1,5 y d AlN de 7,4 nm de espesor
Como se muestra en la Fig. 5a, una estimación de la densidad del estado de la interfaz ( D eso ) se realizó aplicando el método Terman al C – V experimental curvas medidas a 1 MHz [33]. La D obtenida eso frente a E C - E t (ubicación del estado de la interfaz) se presenta en la Fig. 5b. Aquí, no analizamos el C – V curva de la muestra con un AlN de 0,7 nm de espesor porque la muestra tenía fugas y la capacitancia de óxido exacta ( C OX ) no se definió bien. La muestra con un AlN de 7,4 nm de espesor mostró la densidad de estado de interfaz más alta, especialmente para E C - E t > 0,4 eV. Además, la interfaz promedio y la densidad de la trampa de óxido ( Q T ) a lo largo de la banda prohibida de GaN ( E g ) se calcularon analizando C - V gráficos de histéresis, utilizando el cambio de voltaje de banda plana (Δ V FB ) a través de la ecuación Q T =( C OX Δ V FB ) / qE g [34]. El pequeño cambio de voltaje de banda plana y la pequeña ventana de histéresis indican una baja densidad de trampa. El recuadro de la Fig. 4b muestra C - V gráficos de histéresis. Las densidades de carga atrapadas se calcularon en 4,2 × 10 9 , 9,3 × 10 9 y 3.6 × 10 11 cm −2 eV −1 para las muestras con AlN de 0, 1,5 y 7,4 nm de espesor, respectivamente. La histéresis puede originarse a partir de las trampas de interfaz de AlN / GaN y las trampas de borde (o de volumen) en la capa de AlN. Al igual que el método Terman, la capa de AlN de 7,4 nm de espesor reveló la mayor densidad de interfase y trampa de óxido. Por lo tanto, es posible sugerir en esta muestra que las trampas de borde en la capa de AlN así como las trampas de interfaz contribuyeron significativamente al cambio en C - V parcelas.
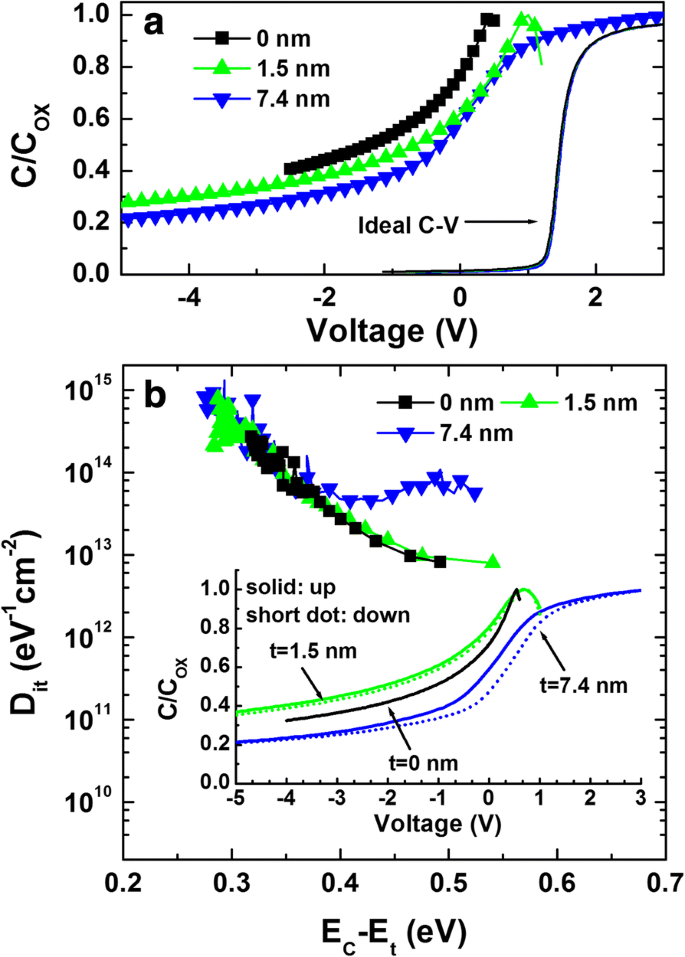
un Comparación de capacitancia experimental-voltaje ( C - V ) datos medidos a 1 MHz y C– V ideal datos y b densidad de estado de la interfaz ( D eso ) distribuciones determinadas aplicando el método de Terman para las muestras con capa de AlN de 0, 1,5 y 7,4 nm de espesor. El recuadro en b muestra la C - V Gráficos de histéresis medidos a 1 MHz
La composición química en la interfase AlN / GaN se investigó mediante mediciones de XPS para dos muestras con AlN de 0,7 y 7,4 nm de espesor. Aquí, el tratamiento de grabado catódico se realizó en la muestra con un AlN de 7,4 nm de grosor porque el grosor de AlN era demasiado grueso para obtener la información exacta cerca de la interfaz AlN / InP. También se escaneó la superficie de GaN desnudo como referencia. La Figura 6a muestra los perfiles de profundidad de XPS para cada elemento obtenido de la muestra con un AlN de 7,4 nm de espesor. La difusión de átomos de Ga en la capa de AlN se vio claramente. Se encontró que había una cantidad bastante grande de átomos de oxígeno a través de la capa de AlN. Sin embargo, los átomos de O y Al no se observaron bien cerca de la interfaz AlN / GaN. La mayor cantidad de oxígeno cerca de la superficie de AlN, en comparación con la interfase AlN / GaN, indica que una parte significativa del mismo resultó de la oxidación atmosférica, no del proceso de deposición de ALD en sí. A continuación, seleccionamos los espectros XPS de escaneado estrecho a una profundidad de grabado (el grosor del AlN restante era de aproximadamente 1,5 a 2,0 nm) y los comparamos con los datos de otras muestras. La Figura 6b muestra el Ga 2 p 3/2 espectros a nivel del núcleo. Los picos a ~ 1118.0 eV y ~ 1119.2 eV tanto para el GaN desnudo como para la muestra con un AlN de 0.7 nm de espesor están asociados con GaN y Ga 2 O 3 , respectivamente [35, 36]. El pico de ~ 1117,4 eV para la muestra con un AlN de 7,4 nm de espesor se debe al Ga unido al AlN [37]. Sin embargo, no podemos descartar la posibilidad de que sea de Ga 2 O pico (~ 1117,3 eV) [38].

un Perfiles de profundidad XPS para cada elemento obtenido de la muestra con un AlN de 7,4 nm de espesor. Espectros de nivel de núcleo XPS de b Ga 3 p 3/2, c O 1 s y d Al 2 p para las muestras con AlN de 0, 1,5 y 7,4 nm de espesor
Como se muestra en la Fig. 6c, los picos en ~ 530.2 y ~ 531.9 eV se atribuyen al O y Ga 2 quimisorbidos O 3 , respectivamente [39]. Además, el pico de ~ 532,8 eV se asocia con Al-OH [40]. Sin embargo, no se observó ningún pico peculiar para la muestra con un AlN de 7,4 nm de espesor a la profundidad seleccionada. De manera similar, no se observó ningún pico en las profundidades de grabado más profundas (no se muestra). Cuando el espesor de AlN es delgado (0,7 nm), se eliminaron los átomos de oxígeno quimisorbidos, pero los átomos de Al se unieron con OH. Al aumentar el espesor de AlN, había muy poca cantidad de átomos de oxígeno cerca de la región de la superficie de GaN, lo que indica el efecto de limpieza. Sin embargo, una gran cantidad de átomos de oxígeno estaban presentes en la región de AlN sobrecrecida, lo que proporcionó cargas de óxido. O 1 s Se encontró que los espectros a nivel del núcleo en las profundidades de grabado donde la cantidad de átomos de Ga son despreciables (aproximadamente 0 ~ 3 nm de la superficie de AlN en la Fig. 6a) exhiben el pico dominante en ~ 531.8 eV, asociado con Al 2 O 3 [41]. Esto significa que una parte de la capa de AlN se compone de Al 2 O 3 . Como se muestra en la Fig. 6d, el pico relacionado con AlN no se observa bien para la muestra con un AlN de 0,7 nm de espesor. Más bien, se observan dos picos a ~ 74,1 y ~ 75,6 eV, asociados con AlO x y Al – OH, respectivamente [42]. Estos picos relacionados con el enlace Al – O como AlO x y Al-OH pueden actuar como defectos. El pico a ~ 73,6 eV para la muestra con un AlN de 7,4 nm de espesor está asociado con AlN [43].
Las propiedades de transporte de corriente de las muestras con AlN de 0,7 y 7,4 nm de espesor se investigaron más a fondo utilizando corriente-voltaje dependiente de la temperatura ( I - V - T ) mediciones. Como se muestra en la Fig. 7, tanto la corriente de polarización directa como la inversa aumentaron en un grado similar para la muestra con un espesor de 0,7 nm. Sin embargo, para la muestra con un AlN de 7,4 nm de espesor, las corrientes de fuga inversas dependían más de la temperatura que las corrientes directas. Bajo polarización inversa, una temperatura más alta podría causar una emisión térmica de huecos desde los niveles profundos hacia la banda de valencia de AlN y, por lo tanto, introduciría otro suministro de electrones [44]. Según el modelo de barrera no homogéneo [24], la altura de barrera efectiva dependiente de la temperatura ( φ B ) está relacionado con una altura de barrera media de sesgo cero (\ ({\ overline {\ varphi}} _ B \)) y una desviación estándar ( σ 0 ) como \ ({\ varphi} _B ={\ overline {\ varphi}} _ B-q {\ sigma_0} ^ 2/2 kT \). El σ 0 se obtuvieron valores de 0,147 y 0,204 V para las muestras con AlN de 0,7 y 7,4 nm de espesor, respectivamente. Usando estos valores, las gráficas de Richardson modificadas de ln ( I 0 / T 2 ) - q 2 σ 0 2 / 2 k 2 T 2 frente a 1 / kT se obtuvieron, que se muestran en la Fig. 8a. Las intersecciones en ordenadas produjeron las constantes de Richardson de A ** como 397,3 y 27,1 A cm −2 K −2 para las muestras con AlN de 0,7 y 7,4 nm de espesor, respectivamente. El valor de la muestra con un AlN de 7,4 nm de espesor es similar al valor teórico de 26,4 A cm −2 K −2 para n-GaN, lo que indica que la inhomogeneidad de la barrera con el modelo TE puede explicar el transporte actual. Sin embargo, para la muestra con un AlN de 0,7 nm de espesor, el valor es demasiado alto en comparación con el valor teórico, lo que indica que el modelo TE, incluso incluyendo la inhomogeneidad de la barrera, no puede explicar el transporte de corriente. La Figura 8b muestra los valores de nkT en función de kT . La línea recta con pendientes de 1,15 coincide con los datos experimentales de la muestra con un AlN de 7,4 nm de espesor utilizando el modelo TE. Sin embargo, para la muestra con un AlN de 0,7 nm de espesor, se encontró que la pendiente era de 5,11. Una desviación tan grande de la unidad podría deberse a los estados de la interfaz, la capa aislante y la corriente de túnel.
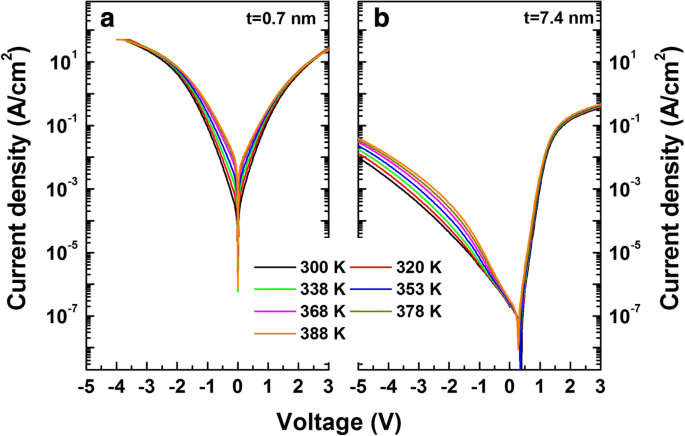
Densidad de corriente-voltaje dependiente de la temperatura ( J - V ) características de las muestras con a 0,7- y b AlN de 7,4 nm de espesor
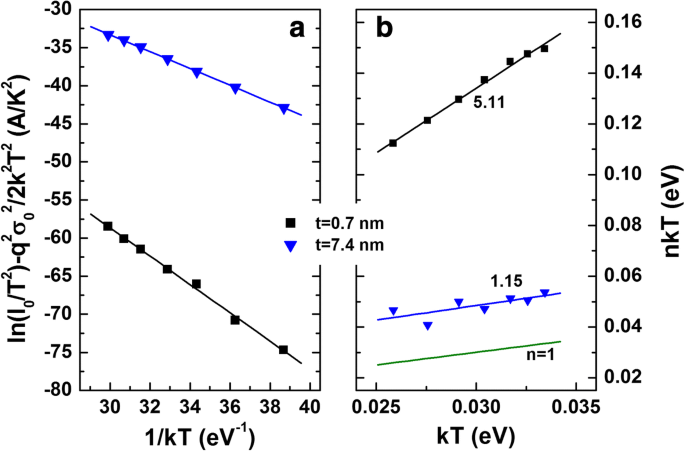
un Gráficos de Richardson modificados y b nkT frente a kT gráficos con los ajustes lineales a los datos experimentales. En b , la línea con una pendiente de 1 ( n =1) también se incluyó como referencia
La densidad de corriente de fuga inversa se analizó utilizando el modelo de túnel de Fowler-Nordheim (FN), dado por [45].
$$ J =\ alpha {E} ^ 2 \ exp \ left (- \ beta / E \ right) $$ (1)donde α =1,54 × 10 −6 / m ∗ Φ B y β =6,83 × 10 −7 ( m ∗ ) 1/2 (Φ B ) 3/2 ; m * ( m * =0.30 para AlN [46]) es la masa efectiva de electrones en el aislante y Φ B es la altura de la barrera de tunelización. La Figura 9a, b muestra que se observó emisión de FN para las muestras con AlN de 0,7 y 7,4 nm de espesor, cuando los voltajes de polarización son superiores a - 0,9 V y - 3 V, respectivamente. El voltaje más alto para la muestra con un AlN de 7,4 nm de espesor se debe al hecho de que el AlN más grueso necesita un voltaje de túnel más alto. A partir de la pendiente que se muestra en la Fig. 9, se determinaron las alturas de la barrera de túneles para cada temperatura, que se presentan en el recuadro de la Fig. 9b. A temperatura ambiente, las alturas de barrera para las muestras con AlN de 0,7 y 7,4 nm de espesor se calcularon en aproximadamente 1,67 y 0,78 eV, respectivamente. Estos valores son inferiores a la desviación de la banda de conducción informada de 2,58 eV en la interfaz AlN / GaN [47]. La mala calidad de la interfaz cerca de la interfaz AlN / GaN podría producir valores más bajos. La altura de barrera más baja para la muestra con un AlN de 7,4 nm de espesor también se puede asociar con la alta densidad de interfase y trampa de óxido cerca de la interfase AlN / GaN y defectos relacionados con el oxígeno en la capa de AlN. Como resultado, la tunelización asistida por trampa ocurrió más fácilmente y aumentó la corriente de fuga inversa.
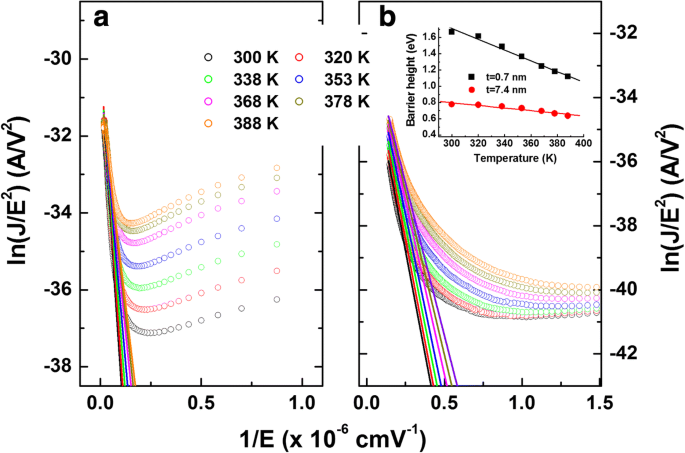
Parcelas de tunelización de Fowler – Nordheim (FN) de ln ( J / E 2 ) frente a 1 / E con los ajustes lineales a los datos experimentales para las muestras con a 0,7- y b AlN de 7,4 nm de espesor. El recuadro en b presenta las alturas de barrera calculadas en función de la temperatura
El modelo de emisión de Poole-Frenkel (PF) también se aplicó a la corriente de fuga inversa, dada por [48].
$$ \ ln \ left (J / E \ right) =m (T) {E} ^ {1/2} + b (T) \ Big) $$ (2)con
$$ m (T) =\ frac {q} {kT} \ sqrt {\ frac {q} {{\ pi \ varepsilon} _0 {\ varepsilon} _ {\ mathrm {AlN}}}}, b (T) =- \ frac {q {\ varphi} _t} {kT} + \ ln C $$ (3)donde ϕ t es la altura de la barrera de emisión de electrones desde los estados de la trampa, ε AlN es la permitividad dieléctrica relativa del aislador de la puerta a alta frecuencia ( ε AlN 4.77 [49]), ε 0 es la permitividad del espacio libre y C es una constante. La validez del accesorio de emisión de PF se verificó verificando la dependencia de la temperatura del coeficiente lineal m ( T ) obtenido del ajuste lineal de las gráficas PF ln ( J / E ) en función de E 1/2 [50], que se muestra en la Fig. 10. Desde el m ( T ) valores obtenidos del ajuste lineal a estos gráficos (recuadro en la Fig. 10a), ε AlN se encontró que era 64,9 y 959,0 para las muestras con AlN de 0,7 y 7,4 nm de espesor, respectivamente. Los valores obtenidos son demasiado altos en comparación con el valor teórico de 4,77, lo que señala que la emisión de PF no puede explicar correctamente el transporte de corriente para ambas muestras. Por lo tanto, la tunelización FN es un mecanismo de transporte más apropiado en la corriente de fuga inversa.
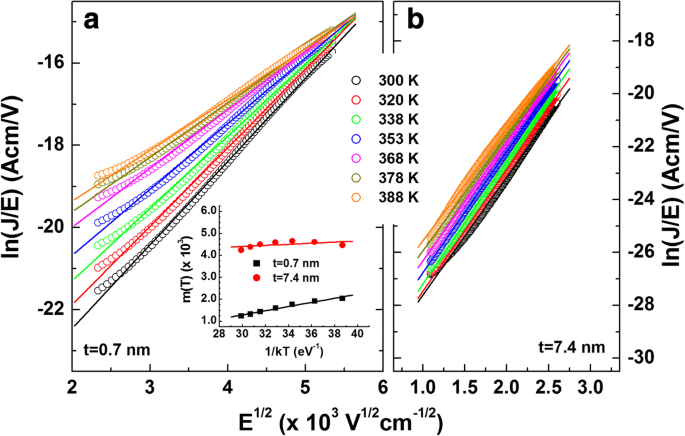
Gráficos de emisión de Poole-Frenkel (PF) de ln ( J / E ) frente a E 1/2 / con el ajuste lineal a los datos experimentales de la muestra con a 0,7- y b AlN de 7,4 nm de espesor. El recuadro en a presenta el m calculado ( T ) valores frente a temperatura
Aunque la ecuación. (1) no contiene dependencia de la temperatura, las alturas de barrera obtenidas disminuyeron al aumentar la temperatura. Las pendientes se obtuvieron como - 6,67 meV / K y - 1,62 meV / K para las muestras con AlN de 0,7 y 7,4 nm de espesor, respectivamente. Se ha informado en la estructura de SiO2 / 4H-SiC que el túnel FN posee una dependencia de la temperatura con una pendiente de - 7,6 meV / K [51]. Los electrones expulsados del electrodo de Pt siguieron la distribución de Fermi-Dirac [52] y, por lo tanto, la corriente de fuga inversa por el túnel también podría aumentar con la temperatura. En este caso, el aumento con la temperatura sería mayor para una capa de AlN más delgada.
Mientras tanto, se ha informado que los mecanismos de transporte actuales en campos eléctricos elevados no pueden explicarse únicamente por el túnel FN [53, 54]. Incluso incluyendo los cambios en las cargas en el nivel de óxido y Fermi del sustrato, y la distribución de energía electrónica en el SiO 2 / Interfaz SiC con temperatura, la corriente de fuga inversa en SiO 2 / 4H-SiC no se explicó satisfactoriamente [53]. Se propuso que la emisión de PF activada térmicamente de los electrones atrapados de las trampas de electrones interfaciales contribuye significativamente al aumento de la corriente de fuga [54]. Por lo tanto, reducir tales defectos en AlN durante el proceso ALD es crucial en el rendimiento del dispositivo basado en AlN / GaN, especialmente durante la operación a alta temperatura.
Como se ve en el gráfico de la altura de la barrera frente al espesor de AlN en la Fig. 2c, Li et al. observó un comportamiento similar en contactos de metal / n-Ge con Y 2 O 3 capas [55]. Atribuyeron la reducción en la altura de la barrera a la supresión de la inestable GeO x el crecimiento y la pasivación de enlaces colgantes en la superficie de Ge. Karpov y col. insertado Si 3 N 4 capa en contactos de Ni / n-GaN y encontró que la altura de la barrera disminuyó de 0,78 a 0,27-0,30 eV con un Si 3 N 4 capa. Los resultados se explicaron por la formación de dipolos en el Si 3 N 4 / Interfaz GaN [56]. Además, Zheng et al. investigó la resistencia de contacto frente a Al 2 O 3 de espesor en la estructura de Al / n-SiC y se encontró que el dipolo de interfaz comenzó a formarse con un espesor de 1,98 nm [57]. Por encima de este espesor, la resistencia de contacto disminuyó primero debido al efecto dipolo y luego aumentó debido al aumento de la resistencia al túnel. Según los datos de XPS en la Fig. 6, la formación de la capa de AlN no está clara para la muestra con un AlN de 0,7 nm de espesor. Por lo tanto, la reducción de la altura de la barrera con un AlN de 0,7 nm de espesor se debe más al efecto de pasivación que a la formación de un dipolo de interfaz.
El proceso de grabado en seco, como el grabado con plasma de acoplamiento inductivo (ICP), se usa ampliamente en dispositivos basados en GaN debido a la estabilidad química de GaN [58], aunque se demostró un grabado químico húmedo mejorado con ultravioleta [59]. Sin embargo, el proceso de grabado en seco puede provocar daños en la superficie de GaN, aumentando la corriente de fuga y degradando el comportamiento de rectificación. Se descubrió que el tratamiento posterior al grabado con recocido térmico y una solución de KOH después del grabado con iones reactivos (RIE) elimina eficazmente el daño superficial en GaN [60]. Teniendo en cuenta los resultados hasta ahora, sugerimos que se pueda aplicar una deposición de AlN (mayor de 1 nm) para reducir el daño en la superficie de GaN grabada, que se espera que aumente aún más la calidad de la interfaz y las características de rectificación.
Conclusiones
Hemos investigado las propiedades interfaciales y eléctricas de la capa atómica depositada AlN sobre n-GaN con diferentes espesores de AlN. Según capacitancia-voltaje ( C - V ), la muestra con un AlN de 7,4 nm de espesor mostró la mayor densidad de interfase y trampa de óxido. Según las mediciones de espectroscopía de fotoelectrones de rayos X (XPS), la muestra con un AlN de 0,7 nm de espesor reveló un pico dominante relacionado con los enlaces Al – O, sin un pico claro asociado con AlN. Se descubrió que los átomos de oxígeno restantes cerca de la superficie de GaN eran muy pequeños para la muestra con un AlN de 7,4 nm de espesor. Por otro lado, se encontró que muchos átomos de oxígeno estaban presentes a través de la capa de AlN, lo que proporcionó los defectos relacionados con el oxígeno en la capa de AlN. Los análisis de la corriente de fuga inversa revelaron que la emisión de Fowler-Nordheim (FN) en lugar de la de Poole-Frenkel (PF) era más apropiada para explicar el transporte de corriente de las muestras con AlN de 0,7 y 7,4 nm de espesor.
Abreviaturas
- ALD:
-
Deposición de la capa atómica
- AlN:
-
Nitruro de aluminio
- C - V :
-
Capacitancia-voltaje
- FN:
-
Fowler – Nordheim
- J - V :
-
Densidad de corriente – voltaje
- PF:
-
Poole – Frenkel
- TE:
-
Emisión termoiónica
- XPS:
-
Espectroscopia de fotoelectrones de rayos X
Nanomateriales
- Tecnologías avanzadas de deposición de capas atómicas para micro-LED y VCSEL
- Características de alineación interfacial, eléctrica y de banda de pilas de HfO2 / Ge con capa intermedia de SiO2 formada in situ mediante deposición de capa atómica mejorada por plasma
- Características ópticas y eléctricas de los nanocables de silicio preparados por grabado electrolítico
- Las nanofibras jerárquicas de poliamida 6-ZnO antibacteriana fabricadas por deposición de capas atómicas y crecimiento hidrotermal
- Investigación sobre la polarización de la superficie de la heteroestructura de GaN / AlGaN / GaN con cubierta de Al2O3 mediante espectroscopia de fotoelectrones de rayos X de ángulo resuelto
- Propiedades fotocatalíticas de los polvos de TiO2 recubiertos con Co3O4 preparados por deposición de capa atómica mejorada con plasma
- Efectos del espesor de la bicapa en las propiedades morfológicas, ópticas y eléctricas de los nanolaminados de Al2O3 / ZnO
- Ajuste de las morfologías de la superficie y las propiedades de las películas de ZnO mediante el diseño de la capa interfacial
- Ajuste de nivel de Fermi de películas de ZnO mediante deposición de capa atómica superciclada
- Dependencia de la toxicidad de las nanopartículas en sus propiedades físicas y químicas
- Efectos del tamaño y la agregación / aglomeración de las nanopartículas en las propiedades interfaciales / interfásicas y la resistencia a la tracción de los nanocompuestos poliméricos



