Deposición de capa atómica de nanopelículas de óxido de indio para transistores de película delgada
Resumen
Deposición de capa atómica (ALD) de In 2 O 3 Las nanopelículas se han investigado utilizando ciclopentadienil indio (InCp) y peróxido de hidrógeno (H 2 O 2 ) como precursores. El In 2 O 3 las películas se pueden depositar preferentemente a temperaturas relativamente bajas de 160–200 ° C, exhibiendo una tasa de crecimiento estable de 1.4–1.5 Å / ciclo. La rugosidad de la superficie de la película depositada aumenta gradualmente con la temperatura de deposición, lo que se atribuye a la cristalización mejorada de la película a una temperatura de deposición más alta. A medida que la temperatura de deposición aumenta de 150 a 200 ° C, la banda prohibida óptica (E g ) de la película depositada aumenta de 3,42 a 3,75 eV. Además, con el aumento de la temperatura de deposición, la relación atómica de In a O en la película depositada se desplaza gradualmente hacia la de la In 2 estequiométrica O 3 , y el contenido de carbono también se reduce gradualmente. Para una temperatura de deposición de 200 ° C, la película depositada exhibe una relación In:O de 1:1.36 y sin incorporación de carbono. Además, alto rendimiento en 2 O 3 transistores de película fina con un Al 2 O 3 El dieléctrico de la puerta se logró mediante el recocido posterior en aire a 300 ° C durante el tiempo adecuado, lo que demuestra una movilidad de efecto de campo de 7,8 cm 2 / V⋅s, una oscilación de subumbral de 0,32 V / dec y una relación de corriente de encendido / apagado de 10 7 . Esto se atribuyó a la pasivación de las vacantes de oxígeno en el canal del dispositivo.
Antecedentes
Óxido de indio (In 2 O 3 ) es un semiconductor de óxido metálico transparente, que exhibe una banda prohibida amplia de ~ 3.7 eV a temperatura ambiente, una alta transparencia para la luz visible y una excelente estabilidad química [1, 2]. Por lo tanto, en 2 O 3 ha sido investigado para diversas aplicaciones, como dispositivos fotovoltaicos, sensores electroquímicos y pantallas planas [3, 4, 5]. Hasta ahora, se han desarrollado varias técnicas de deposición para preparar In 2 O 3 películas delgadas, incluida la pulverización catódica [6, 7], sol-gel [8, 9] y deposición química en fase de vapor (CVD) [10, 11]. Sin embargo, las técnicas de pulverización catódica y sol-gel generalmente adolecen de una mala uniformidad en un área grande, así como una composición elemental inexacta; la técnica CVD generalmente requiere temperaturas de deposición relativamente altas de> 300 ° C. Estos inconvenientes hacen que sea difícil lograr un uniforme En 2 O 3 película con control preciso de espesor y composición a baja temperatura de deposición.
En los últimos años, la deposición de capa atómica (ALD) ha surgido como un enfoque prometedor que puede producir una excelente cobertura de pasos, controlabilidad del espesor de escala atómica, buena uniformidad y una temperatura de deposición relativamente baja. En consecuencia, el crecimiento de In 2 O 3 Las películas delgadas se han explorado mediante ALD con diferentes precursores, incluido InCl 3 -H 2 O [12], InCl 3 -H 2 O 2 [13], InCp-O 3 [14], InCp-O 2 -H 2 O [15] y en (CH 3 ) 3 -H 2 O [16]. En términos de los precursores de InCl 3 -H 2 O e InCl 3 -H 2 O 2 , las temperaturas de deposición para In 2 O 3 las películas deben aumentarse a ~ 300–500 ° C [13]; mientras tanto, el InCl 3 El recipiente debe calentarse a 285 ° C para obtener una cantidad suficiente de InCl 3 vapor [15]. Además, el subproducto de HCl corrosivo puede dañar el equipo ALD y grabar el In 2 depositado O 3 película [17] y la tasa de crecimiento de In 2 O 3 es tan bajo como 0.25–0.40 Å / ciclo. Aunque otros precursores como TMIn-H 2 O y TMIn-H 2 O 2 han sido adoptados para ALD en 2 O 3 películas, las temperaturas de deposición siguen siendo altas (es decir, 200–450 ° C) a pesar de tasas de crecimiento relativamente altas (1.3–2 Å / ciclo) [18].
En este trabajo, InCp y H 2 O 2 fueron propuestos como los precursores de ALD en 2 O 3 películas delgadas, por lo tanto, el In 2 O 3 las películas delgadas se depositaron con éxito a temperaturas más bajas, mostrando una tasa de crecimiento satisfactoria. Además, se caracterizaron las propiedades físicas y químicas de las películas depositadas. Además, el In 2 O 3 transistores de película fina (TFT) con ALD Al 2 O 3 Se han fabricado dieléctricos de compuerta que demuestran un buen rendimiento eléctrico, como una movilidad de efecto de campo de 7,8 cm 2 V −1 s −1 y una relación actual de encendido / apagado de 10 7 etc.
Experimental
Las obleas de Si (100) se limpiaron usando el proceso estándar de Radio Corporation of America, sirviendo como sustratos iniciales. En 2 O 3 Se depositaron películas delgadas sobre los sustratos de Si (100) previamente limpiados utilizando el equipo ALD (Wuxi MNT Micro Nanotech Co., LTD, China) a temperaturas relativamente bajas de 150-210 ° C, donde las temperaturas de InCp (Fornano Electronic Technology Co., LTD, China, impureza:99,999%) y H 2 O 2 (Solución acuosa al 30%) los precursores se mantuvieron a 130 y 50 ° C, respectivamente. Se utilizó gas nitrógeno como gas de purga. Para demostrar la función del ALD en 2 O 3 película delgada, el In 2 O 3 Los TFT de canal basados en datos se fabricaron según los siguientes procesos. En primer lugar, un Al 2 de 38 nm O 3 La película dieléctrica de puerta se hizo crecer en un sustrato de Si (100) tipo p previamente limpiado (<0,0015 Ω · cm) a 200 ° C mediante ALD utilizando trimetilaluminio y H 2 O, y un sustrato de silicio de baja resistividad sirvió como puerta trasera. Luego, un In 2 de 20 nm O 3 La capa del canal se hizo crecer en Al 2 O 3 película a 160 ° C. Los contactos de fuente / drenaje de las pilas de Ti / Au (30 nm / 70 nm) se formaron a su vez mediante litografía óptica, evaporación por haz de electrones y un proceso de despegue. Finalmente, los dispositivos fabricados se recocieron a 300 ° C en aire durante diferentes tiempos.
La cristalinidad, morfología de la superficie, composición elemental, coeficiente de absorción y espesor del In 2 O 3 Las películas se caracterizaron por difracción de rayos X (XRD) (Bruker D8 Discover), microscopía de fuerza atómica (AFM) (Bruker Icon), espectroscopía de fotoelectrones de rayos X (XPS) (Kratos Axis Ultra DLD), espectroscopía ultravioleta-visible (UV- VIS) y elipsómetro (Sopra GES-SE, Francia), respectivamente. Las mediciones eléctricas de los dispositivos se realizaron utilizando un analizador de parámetros de semiconductores (B1500A, Agilent Technologies, Japón) con estación de sonda Cascade en aire ambiente a temperatura ambiente.
Resultados y discusión
La Figura 1a muestra la tasa de crecimiento de In 2 O 3 película en función de la temperatura del sustrato. Se encuentra que se logra una tasa de crecimiento estable de ~ 1,46 Å / ciclo en el rango de 160 ~ 200 ° C, lo que revela una tasa de crecimiento rápida y una ventana de temperatura bien definida para ALD en 2 O 3 Película (s. Cuando la temperatura del sustrato se redujo a 150 ° C o aumentó a 210 ° C, la tasa de crecimiento resultante se hizo mayor [19, 20]. La primera se atribuye a la condensación de InCp sobre el sustrato, mientras que la segunda se debe a la descomposición térmica de InCp a una temperatura más alta. Además, la evolución del In 2 depositado O 3 El espesor de la película se evaluó en función de los ciclos de ALD, como se muestra en la Fig. 1b. Está claro que el In 2 O 3 el espesor de la película aumenta linealmente con el número de ciclos de deposición, lo que indica un crecimiento bastante uniforme.

un Tasa de crecimiento de ALD en 2 O 3 película sobre el sustrato de Si en función de la temperatura del sustrato, y b dependencia del In 2 O 3 espesor de película en el número de ciclos ALD a 160 ° C
Para observar la evolución del In 2 O 3 textura de la película con temperatura de deposición, los patrones XRD del In 2 O 3 Las películas depositadas a diferentes temperaturas se presentan en la Fig. 2. Cuando la temperatura de deposición no excede los 160 ° C, no se puede observar ningún pico de difracción. Esto indica que el depositado en 2 O 3 las películas a temperaturas más bajas son amorfas. Cuando la temperatura de deposición aumenta hasta 170 ° C, comienzan a aparecer algunos picos de difracción. Además, con la temperatura de deposición aumentando gradualmente a 210 ° C, las intensidades de los picos de difracción aumentan drásticamente, como se muestra típicamente por los picos a 2θ =30,3 ° y 35,4 °. Esto indica que la cristalinidad y el tamaño de grano del In 2 depositado O 3 Las películas se mejoran gradualmente al aumentar la temperatura de deposición. La Figura 3 muestra las morfologías de la superficie del representante In 2 O 3 películas depositadas a diferentes temperaturas. Se encuentra que la superficie de la película se vuelve más rugosa y rugosa al aumentar la temperatura de deposición, es decir, la rugosidad de la raíz cuadrada media (RMS) resultante aumenta de 0,36 a 1,15 nm al aumentar la temperatura de deposición de 160 a 210 ° C. Esto debería estar relacionado con la cristalinidad del In 2 O 3 película. En términos de la temperatura de deposición de 160 ° C, el In 2 depositado O 3 La película es amorfa y presenta una superficie muy lisa. Cuando la temperatura de deposición alcanza los 180 ° C, la película depositada se vuelve policristalina. Esto significa que la película resultante contiene una gran cantidad de granos cristalinos, y los tamaños de los granos se vuelven cada vez más grandes con el aumento de la temperatura de deposición, como se muestra en la Fig. 2. Esto concuerda bien con nuestra observación de que los tamaños de los montículos en la superficie de la película aumenta gradualmente con el aumento de la temperatura de deposición, lo que resulta en un valor RMS incrementado.
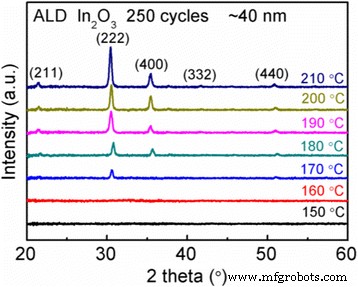
Patrones de difracción de rayos X del In 2 O 3 películas depositadas a diferentes temperaturas durante 250 ciclos

Las imágenes AFM del In 2 O 3 películas depositadas a diferentes temperaturas: a 160 ° C, b 180 ° C, c 200 ° C y d 210 ° C. Los ciclos de deposición se fijaron en 250 para cada película
La Figura 4 muestra los espectros de alta resolución C 1 s, In 3d y O1s XPS del In 2 O 3 películas depositadas a diferentes temperaturas. Con respecto a los espectros XPS de C 1 s que se muestran en la Fig. 4a, la película depositada a 160 ° C presenta un pico a 289,8 eV, que debería corresponder a C-O [21]. Cuando la temperatura de deposición aumenta a 180 ° C, el pico se vuelve mucho más débil. Además, en términos de temperatura de deposición de 200 ° C, el pico de C 1 s desaparece. Así, se indica que cuanto mayor es la temperatura de deposición, menor es la impureza de C en el In 2 depositado O 3 película. La Figura 4b muestra los espectros In 3d XPS del In 2 O 3 películas, que demuestran claramente picos gaussianos de un doblete a 444,7 y 452,3 eV, que están asociados con In 3d 5/2 y en 3d 5/2 niveles básicos para In 2 O 3 [22, 23]. Los espectros XPS de O 1 s se muestran en la Fig. 4c. Se encuentra que el espectro de O 1 s para cada muestra se puede separar bien en tres picos, que se ubican en 529,8, 531,0 y 532,0 eV, respectivamente. Estos picos corresponden a O 2− iones unidos con metal (O1), vacantes de oxígeno (O2) y –OH / CO (O3), respectivamente [24, 25]. A medida que la temperatura de deposición aumenta de 160 a 200 ° C, el porcentaje relativo de O1 aumenta de 76 a 92%; y el porcentaje relativo de O2 disminuye gradualmente del 16 al 4%. Además, el porcentaje relativo de O3 también muestra una tendencia a la baja. Estos resultados indican que una temperatura de deposición más alta es beneficiosa para reducir la concentración de vacantes de oxígeno en la película depositada, así como los grupos hidroxilo y los enlaces C-O. Además, las composiciones elementales del In 2 O 3 Las películas depositadas a diferentes temperaturas se enumeran en la Tabla 1. Curiosamente, la relación atómica de In / O en la película depositada disminuye en grados al aumentar la temperatura de deposición. Sin embargo, incluso para el In 2 puro O 3 película depositada a 200 ° C, la relación atómica (1:1.36) de In / O es aún mayor que la (1:1.5) de la In 2 estequiométrica O 3 . Esto revela que el ALD In 2 O 3 la película es generalmente rica en vacantes de oxígeno.

a de alta resolución C 1s, b En 3d y c Espectros XPS de O 1 s del In 2 O 3 películas depositadas a 160, 180 y 200 ° C, respectivamente. Para eliminar los contaminantes superficiales adventicios, todas las muestras se grabaron con bombardeo de iones de Ar in situ durante 6 minutos antes de la recolección de la señal
La figura 5a muestra la variación de (αhν) 2 en función de la energía de los fotones para el In 2 depositado O 3 películas a diferentes temperaturas de deposición. La banda prohibida óptica (E g ) del In 2 O 3 La película puede ser determinada por la relación de Tauc:αhν =A (hν-E g ) n [26], donde α es el coeficiente de absorción, A es una constante, h es la constante de Plank, ν es la frecuencia y el exponente n caracteriza la naturaleza de la transición de banda. Aquí, n =1/2, lo que indica que In 2 O 3 es un semiconductor con una transición permitida directamente. E g se extrae extrapolando la parte de la línea recta al sesgo de energía en α =0. La E extraída g para el In 2 O 3 La película se muestra en la Fig. 5b. Se ve que E g aumenta de 3,42 a 3,75 eV con el aumento de la temperatura de deposición de 150 a 200 ° C. El aumento de E g a temperaturas de deposición más altas podría resultar de la reducción de las vacantes de oxígeno y la impureza de C en la película depositada. De hecho, otros investigadores también informaron que cuando existían muchas vacantes de oxígeno en ZnO, los estados de impurezas se deslocalizaban más y se superponían con el borde de la banda de valencia, lo que provocaba un estrechamiento de la banda prohibida [27]. Además, la cristalinidad mejorada gradualmente en función de la temperatura de deposición podría influir en la banda prohibida óptica del In 2 O 3 película. Esto se puede explicar de la siguiente manera. A medida que aumenta la temperatura de deposición, el tamaño de grano del In 2 depositado O 3 aumenta la película, como se muestra en la Fig. 2. Esto conduce a una disminución en la densidad de los límites de grano en la película. Dado que los electrones quedan atrapados fácilmente en los límites de los granos, la cantidad de electrones libres debería aumentar en el In 2 O 3 película con menos bordes de grano [28, 29]. Por lo tanto, tal aumento de la concentración de electrones da como resultado una mayor banda prohibida óptica debido al desplazamiento de Burstein-Moss [30].

un Trazado de (αhν) 2 frente a la energía de los fotones para el In 2 O 3 películas depositadas a diferentes temperaturas; b dependencia de la banda prohibida extraída (E g ) de In 2 O 3 sobre la temperatura de deposición
Para demostrar la función del ALD en 2 O 3 película que actúa como canal de TFT, el In 2 O 3 -TFT basados en canales con Al 2 depositado en capa atómica O 3 Se fabricaron dieléctricos de compuerta. La Figura 6a muestra las características de transferencia de In 2 O 3 TFT. Se encuentra que el dispositivo tal como está fabricado no exhibe las características de conmutación típicas de los transistores de efecto de campo, sino una especie de conductor entre la fuente y el drenaje. Esto debe atribuirse a la existencia de muchas vacantes de oxígeno en el In 2 O 3 canal porque las vacantes de oxígeno pueden suministrar electrones libres. Por lo tanto, con el fin de reducir la concentración de vacantes de oxígeno en el In 2 O 3 canal, el post-recocido en aire se llevó a cabo a 300 ° C. Está claro que el In 2 O 3 TFT exhibe un comportamiento de conmutación típico después de un recocido de 2 h. Esto indica que el post-recocido al aire puede mejorar significativamente el rendimiento del dispositivo. Además, a medida que el tiempo de recocido aumenta gradualmente a 10 h, el voltaje umbral (V th ) del TFT se desplaza en la dirección del sesgo positivo, y la oscilación del subumbral (SS) mejora poco a poco. Sin embargo, cuando el tiempo de recocido aumenta a 11 h, el rendimiento del dispositivo comienza a degenerar. Se observa que el hidrógeno puede incorporarse a la película durante el proceso de fabricación, actuando como una trampa de electrones al formar enlaces –OH en el canal o en la interfaz entre el canal y el dieléctrico [31]. Estas trampas de electrones tal vez provoquen la degradación de SS. Después del recocido en aire, los enlaces OH se redujeron mediante la incorporación de O 2 moléculas [32]. Esto podría conducir a una disminución en la densidad de trampas, mejorando así la SS del dispositivo. En términos de recocido al aire de 10 h, el In 2 O 3 TFT exhibe una movilidad de efecto de campo (μ EF ) de 7,8 cm 2 V −1 s −1 , una V ésima de −3,7 V, un SS de 0,32 V / dec y una relación de corriente de encendido / apagado (I encendido / I desactivado ) de 10 7 . Las características de salida correspondientes también se presentan en la Fig. 6b, demostrando comportamientos claros de saturación de corriente y de pellizco bajo varios voltajes de puerta positivos. Además, las curvas de salida también indican una n -modo de mejora de tipo. A modo de comparación, la Tabla 2 resume las características de la ALD informada en 2 O 3 películas y TFT de diferentes grupos de investigación [33,34,35,36,37]. Está demostrado que nuestro In 2 O 3 la película muestra una tasa de crecimiento superior a una temperatura relativamente baja, y el dispositivo fabricado también presenta una pequeña SS. Sin embargo, el rendimiento general del dispositivo no es tan perfecto, lo que podría mejorarse mediante algunas optimizaciones de la estructura del dispositivo y del proceso.
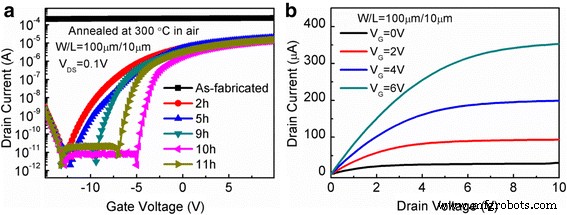
un Características de transferencia del In 2 O 3 TFT recocidos a 300 ° C en aire durante diferentes tiempos; b Características de salida del In 2 O 3 TFT recocido a 300 ° C en aire durante 10 h
Para comprender bien la influencia del post-recocido en aire en la composición de In 2 O 3 canal, el In 2 O 3 Las películas se recocieron a 300 ° C durante diferentes tiempos y luego se analizaron mediante XPS. La Tabla 3 enumera los porcentajes elementales de varias películas recocidas. A medida que aumenta el tiempo de recocido de 2 a 11 h, la relación atómica de In:O disminuye de 1:1,22 a 1:1,48, acercándose gradualmente a (1:1,5) de la In 2 estequiométrica O 3 . Esto confirma además que el aumento del tiempo de recocido en el aire redujo efectivamente la densidad de las vacantes de oxígeno en el In 2 O 3 película. Por tanto, la mejora en el rendimiento del In 2 O 3 La TFT debe atribuirse principalmente a la pasivación de las vacantes de oxígeno que podrían estar ubicadas en el canal principal y / o en la interfaz entre el canal y el dieléctrico [25]. Sin embargo, el recocido excesivo degradó el rendimiento del dispositivo, como lo reveló el recocido de 11 h. Esto podría atribuirse al cambio de cristalización del In 2 O 3 capa de canal, así como posible oxidación de los electrodos de Ti durante el post-recocido superfluo en aire. Por lo tanto, se requiere un tiempo de recocido adecuado para lograr un buen rendimiento del In 2 O 3 TFT.
Conclusiones
El rápido crecimiento de ALD de In 2 O 3 películas se ha logrado a temperaturas relativamente bajas (160-200 ° C) con InCp y H 2 O 2 precursores, que exhiben una tasa de crecimiento uniforme de 1,46 Å / ciclo. A medida que aumentó la temperatura de deposición, se mejoró gradualmente la cristalización de la película depositada. Mientras tanto, tanto las vacantes de oxígeno como las impurezas de carbono en las películas depositadas también se redujeron significativamente. Esto llevó a un aumento en el E g de En 2 O 3 . Además, con ALD In 2 O 3 capa de canal, los TFT con un ALD Al 2 O 3 Se fabricaron dieléctricos. A medida que se alargaba el tiempo posterior al recocido en el aire, el rendimiento eléctrico del In 2 O 3 La TFT mejoró claramente hasta el recocido de 10 h. Esto se debe principalmente a la pasivación de las vacantes de oxígeno ubicadas en el canal a granel y / o la interfaz entre el canal y el dieléctrico después del recocido en aire. En términos de recocido de 10 h, el dispositivo mostró un buen rendimiento, como una movilidad de efecto de campo de 7,8 cm 2 / V⋅s, una oscilación de subumbral de 0,32 V / dec y una relación de corriente de encendido / apagado de 10 7 . En términos de temperatura de deposición de 200 ° C, la película depositada exhibe una relación In:O de 1:1.36 sin carbono detectable, lo que revela la existencia de vacantes de oxígeno en la película depositada.
Nanomateriales
- Separadores de aire para chips de 10 nm
- Tecnologías avanzadas de deposición de capas atómicas para micro-LED y VCSEL
- Optimización de película fina altamente reflectante para micro-LED de ángulo completo
- Efecto de diferentes aglutinantes sobre el rendimiento electroquímico del ánodo de óxido metálico para baterías de iones de litio
- Nanopétalos mesoporosos de óxido de níquel (NiO) para detección de glucosa ultrasensible
- Un ánodo de película de Fe2O3 nanocristalino preparado por deposición de láser pulsado para baterías de iones de litio
- Modulador de electroabsorción de polarización de plasma superficial insensible a la polarización basado en óxido de estaño indio Epsilon-Near-Zero
- Desarrollo de biocompuesto electrohilado de quitosano-óxido de polietileno / fibrinógeno para posibles aplicaciones de cicatrización de heridas
- Tensioactivo aniónico / Líquidos iónicos Intercalado de óxido de grafeno reducido para supercondensadores de alto rendimiento
- Absorción de luz eficaz utilizando rejillas piramidales de doble cara para células solares de silicio de película delgada
- Conjunto de antenas de película delgada y alta frecuencia para comunicaciones inalámbricas



