Investigación sobre la polarización de la superficie de la heteroestructura de GaN / AlGaN / GaN con cubierta de Al2O3 mediante espectroscopia de fotoelectrones de rayos X de ángulo resuelto
Resumen
La polarización de la superficie de nitruro de galio Ga-face (GaN) (2 nm) / AlGaN (22 nm) / canal de GaN (150 nm) / tampón / Si con Al 2 O 3 La capa de cobertura se investiga mediante espectroscopía de fotoelectrones de rayos X de resolución angular (ARXPS). Se encuentra que la banda de energía varía desde la flexión hacia arriba hasta la flexión hacia abajo en la región de la interfaz, lo que se cree que corresponde a la variación de polarización. Se forma una capa interfacial entre el GaN superior y el Al 2 O 3 debido a la ocurrencia de la rotura del enlace Ga – N y la formación del enlace Ga – O durante Al 2 O 3 deposición a través de la deposición de la capa atómica (ALD). Se cree que esta capa interfacial elimina la polarización de GaN, reduciendo así las cargas negativas inducidas por la polarización. Además, esta capa interfacial juega un papel clave para la introducción de las cargas positivas que conducen a la banda de energía hacia abajo. Finalmente, un N 2 Se observa que el recocido a 400 ° C mejora el crecimiento de la capa interfacial aumentando así la densidad de cargas positivas.
Antecedentes
El nitruro de galio (GaN) se considera uno de los materiales semiconductores más atractivos en muchos campos que van desde las industrias de LED hasta las industrias de electrónica de potencia [1, 2]. La popularidad se debe a una serie de ventajas con respecto al silicio:alto campo eléctrico de ruptura, alta movilidad de electrones y excelente estabilidad térmica [3, 4]. El transistor de alta movilidad de electrones (HEMT) de GaN se ha estudiado ampliamente para aplicaciones de alta potencia y alta frecuencia [1, 5, 6]. En el HEMT, si se adopta la puerta Schottky, esta interfaz de puerta genera estados de interfaz grandes que exacerban la gran corriente de fuga y el bajo campo de ruptura [7]. Un aislante inducido como la capa de pasivación de la superficie y el dieléctrico de la compuerta podría ayudar a mitigar los problemas anteriores [8, 9, 10].
Al 2 O 3 se prefiere para una aplicación de aislante de este tipo debido a su gran banda prohibida, alta constante dieléctrica y energía libre de Gibbs más negativa en comparación con Ga 2 O 3 , por lo que se cree que Al 2 O 3 podría pasivar los estados de la superficie y mejorar el campo de ruptura eléctrica [5]. Sin embargo, una capa interfacial se forma inevitablemente en el GaN / Al 2 O 3 interfaz después de la deposición del Al 2 O 3 [11, 12]. Se cree que esta capa interfacial está correlacionada con la confiabilidad del voltaje umbral y la propiedad del gas de electrones bidimensionales (2DEG) y juega un papel clave para controlar la flexión de la banda [2, 13,14,15,16].
Aunque la capa interfacial ha sido estudiada por varios grupos de investigación, el papel desempeñado por la capa interfacial no se ha explotado en profundidad [12, 17]. Por lo tanto, en este artículo utilizamos la espectroscopia de fotoelectrones de rayos X de resolución angular (ARXPS) para detectar los cambios graduales de la flexión de la banda y obtener la estructura atómica de la capa interfacial [11]. Diferentes espesores de Al 2 O 3 se depositan en muestras de GaN por deposición de capa atómica (ALD). ALD aprovecha una tecnología de deposición capa por capa a baja temperatura, que limita la reacción térmica entre GaN y Al 2 O 3 . Por lo tanto, las industrias favorecen el ALD para depositar dieléctricos de alto k debido a su alta conformabilidad y uniformidad, precisión en el control del espesor, alta calidad de la película y baja densidad de defectos [4]. Esto permite un Al 2 suave y con pocos defectos O 3 / Interfaz GaN. Después de Al 2 O 3 deposición, también se prepara una muestra de recocido posterior a la deposición (PDA) a 400 ° C para intensificar la reacción de la capa interfacial, mejorando la formación de la capa interfacial. Con base en los resultados de ARXPS, se encuentra que la banda se dobla hacia arriba inicialmente desde el sustrato de GaN a la interfaz cercana debido a las cargas negativas inducidas por la polarización. Sin embargo, como un aumento en el ángulo de detección θ , la banda se dobla hacia abajo gradualmente debido a la formación de cargas positivas [5, 11,12,13].
Métodos
La oblea Ga-face GaN / AlGaN / GaN-on-Si (111) se compró a una empresa comercial (Enkris.com). La estructura de wurtzita epitaxial comprende una capa de GaN de 2 nm encima de una capa de AlGaN de 22 nm, y las dos capas epitaxiales se cultivan en una capa de i-GaN de 150 nm. Una capa amortiguadora sirve como capa de transición que conecta la depiladora de GaN y el sustrato de Si. Se preparan tres muestras, S1, S2 y S3. Todas las muestras se redujeron primero durante 5 minutos en acetona, seguido de inmersión en alcohol isopropílico y un enjuague en agua desionizada (DI). A continuación, se eliminó el óxido nativo sumergiéndolo en una solución diluida de HCl (HCl:H 2 O =1:10) durante ~ 1 min, seguido de un enjuague en agua desionizada. El Al 2 O 3 son depositados por ALD sobre GaN, con trimetil aluminio (TMA) y H 2 O como precursor de metal y oxidante, respectivamente. El Al 2 O 3 el espesor es de 1 nm para la muestra S1 y de 3 nm para las muestras S2 y S3. El espesor se mide con el elipsómetro. Además, S3 se sometió a PDA en N 2 a 400 ° C durante 5 min.
Las mediciones de ARXPS se llevaron a cabo en un sistema Thermo Fisher Scientific Theta Probe equipado con una fuente de rayos X monocromática, microfocalizada Al Kα (1486,6 eV) y un analizador de energía de electrones hemisférico. La calibración de la energía de enlace (BE) se realizó utilizando muestras estándar puras de Ni, Au, Ag y Cu estableciendo el borde de Ni Fermi, Au 4 f 2/7 , Ag 3 d 5/2 y Cu 2 p 3/2 picos a 0.00 ± 0.02, 83.98 ± 0.02, 368.26 ± 0.02 y 932.67 ± 0.02 eV, respectivamente. Se permitió que la FWHM de un espectro de componente dado variara solo dentro de un rango estrecho (± 0,1 eV). Se utilizó el menor número de espectros de componentes para obtener valores residuales aceptablemente bajos [11]. Los espectros XPS se registraron en diferentes ángulos de detección ( θ ), que van desde 27,5 ° a 72,5 ° con respecto a la muestra normal en paralelo sin inclinar la muestra. Para eliminar por posible cambio de BE inducido por carga positiva, los espectros XPS obtenidos se referenciaron a los C 1 s pico a 285,0 eV. El análisis cuantitativo, incluida la determinación de la relación elemento / enlace, se logró utilizando factores de sensibilidad relativa y algoritmos integrados en el software Avantage [11].
Resultados y discusión
El Ga 3 d Los espectros a nivel del núcleo para S1 – S3 en diferentes ángulos de detección de fotoelectrones se muestran en la Fig. 1a – c, respectivamente. Para S1, cada Ga 3 d el espectro se puede ajustar con dos picos, correspondientes a los enlaces Ga – N y Ga – O. Los enlaces Ga – O se deben a la formación de óxido como resultado de la exposición al oxígeno en el ALD, y el oxígeno penetró en el Al 2 delgado inicial. O 3 capa [3]. Para S2 y S3, se pueden identificar tres picos, señalados como Ga – N, Ga – O y O 2 s , respectivamente. Los O 2 s el pico se atribuye a los enlaces Ga – O y Al – O, y se vuelve obvio cuando el ángulo de detección se hace más grande. Como este artículo no se centra en este pico, no se discutirá más. La Figura 2 presenta el BE de los picos de Ga – N en función de θ para S1 – S3. Se obtiene una disminución de 0.2 eV de θ =27,5 ° a 72,5 ° para S1. Sugiere una flexión de la banda hacia arriba, que es consistente con las publicaciones [3, 11]. Para S2, el BE presenta una disminución de 0.1 eV, lo que indica una leve flexión de banda hacia arriba cerca de la interfaz en comparación con S1 o una banda de energía plana sin flexión de banda en consideración del error experimental. Sin embargo, para S3, hay un aumento de 0,2 eV en el BE, que contrasta con las muestras S1 y S2, lo que aconseja una flexión de banda hacia abajo. La Figura 3 registra el Al 2 p espectros para todas las muestras, y no hay cambios en los BE. Además, el pico se indica como el enlace Al – O y, en consecuencia, la capa de AlGaN tiene una influencia insignificante en la variación de Ga – N BE. La Tabla 1 resume los BE de Ga 3 d y Al 2 p a diferentes ángulos de detección para todas las muestras, con un error de ± 0,1 eV.

El XPS Ga 3 d espectros a nivel de núcleo para a S1, b S2 y c S3

El BE del pico del espectro Ga – N en función del ángulo de detección θ (relativo a lo normal) para S2. La barra de error es ± 0,1 eV

El XPS Al 2 p espectros a nivel de núcleo para a S1, b S2 y c S3, y el pico indica el enlace Al – O. Además, no hay una variación significativa de BE
Las relaciones del pico de Ga – O a Ga – N para todas las muestras se dan en la Tabla 2. La relación es de alrededor de 0,2 para las muestras S1 y S2, lo cual es consistente con los resultados anteriores [3]. Sin embargo, después del tratamiento con CAP, la proporción aumenta a ~ 0.3 y denota un aumento de GaO x capa interfacial. Además, la relación Ga / N también se da en la Tabla 2. La relación se calcula comparando las intensidades integradas de Ga 3 d y N 1 s picos con factores de sensibilidad atómica [18]. Para las muestras S1 y S2, la relación alrededor de 1,7 sugiere una capa interfacial rica en Ga. Sin embargo, después de la N 2 recocido, la relación disminuye a ~ 1.0. Además, la profundidad de muestreo también se da en la Tabla 2 para cada ángulo. Debido a la atenuación exponencial de los fotoelectrones, el 63 y el 95% de los electrones detectados se originan dentro de una distancia de 1λ (es decir, λ representa el camino libre medio inelástico del electrón (IMFP)) y 3λ, respectivamente, de la superficie. Por lo tanto, la profundidad de muestreo de XPS se define como 3λ nanómetros debajo de la superficie de la muestra. En nuestro caso, Al 2 O 3 es la capa de cobertura y el λ de Ga 3 d fotoelectrones en Al 2 O 3 se estima en ~ 3.4 nm. Para una estimación aproximada, la profundidad de muestreo en diferentes ángulos se da como 3λcos θ . Sin embargo, la profundidad de muestreo real de Ga – N BE debe considerar el espesor de Al 2 O 3 , por lo que la profundidad de muestreo se estima en 3λcos θ menos el límite de Al 2 O 3 grosor. Porque el GaO x La capa está encima de la heteroestructura de GaN, la señal de esta capa se incluye para cada ángulo de detección. Sin embargo, con el aumento del ángulo de detección, la intensidad de la señal del enlace Ga – N disminuye, lo que resulta en un aumento de la relación Ga – O / Ga – N. Comparando S2 con S3, el aumento de la relación Ga – O / Ga – N y la disminución de la relación Ga / N sugieren que la capa rica en Ga se ha oxidado para formar GaO x .
Para ilustrar los datos del experimento presentados aquí, se propone esquemáticamente un modelo en la Fig. 4. El nivel de energía de Fermi del sustrato GaN / AlGaN / GaN se calibra como 0 eV durante la medición XPS [19]. Se dan el máximo de la banda de conducción (CBM), el máximo de la banda de valencia (VBM) y el nivel del núcleo. El BE es la diferencia de energía entre el nivel básico y el nivel de Fermi. En la deposición de ALD, el O del oxigenado podría reemplazar al N en el enlace Ga-N para oxidar el GaN y los átomos de N circundantes podrían formar N 2 moléculas [20], lo que conduce a la formación de la capa rica en Ga y el óxido de galio (GaO x ) capa interfacial [11, 18]. Esto está respaldado por la relación Ga / N, que es mayor que 1 en la Tabla 2. Esta relación indica el cambio de la estequiometría de GaN, y el efecto de polarización espontánea intrínseca de GaN debería desaparecer [21, 22, 23]. Como resultado, la capa rica en Ga, como GaN a GaO x capa de transición, elimina las cargas negativas inducidas por polarización y da como resultado una banda de conducción plana [11], como se muestra en la Fig. 4.
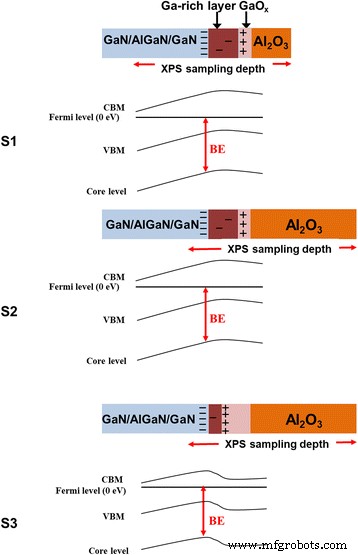
En la región de la interfaz, O reemplazando a N en el enlace Ga – N da como resultado una capa rica en Ga y un GaO x capa. La capa rica en Ga actúa como GaN a GaO x capa de transición. La formación de Ga – O elimina la polarización de GaN y actúa como cargas positivas. Como resultado, la banda de conducción se dobla gradualmente de arriba hacia abajo y el BE varía en consecuencia
Además, en el proceso de recocido, la superficie rica en Ga se oxida para formar un GaO x más grueso capa. Debido a que la oxidación es una reacción cinéticamente limitada y está restringida a aproximadamente dos monocapas de superficie, la masa no se verá fuertemente perturbada [24]. Por lo tanto, la señal del enlace Ga-N proviene principalmente del volumen subyacente no oxidado, lo que da como resultado la relación estequiométrica Ga / N de 1 para S3. El GaO x Se ha informado que la capa produce cargas positivas que pueden ser cargas fijas interfaciales con estados de energía entre los mínimos de la banda de conducción del óxido nativo y GaN, lo que doblaría la banda hacia abajo [4, 11, 13, 14]. Por lo tanto, la banda de conducción de la capa rica en Ga comienza a disminuir en la región cercana al GaO x capa. Un GaO x más espeso Se espera que genere una mayor densidad de cargas positivas. Con respecto a la constante BE de Ga – O y Al – O en S3, indica que la carga positiva debe ubicarse en la interfaz de la capa rica en Ga / GaO x capa. Las cargas positivas y las cargas negativas inducidas por polarización construyen un campo eléctrico interno que modificó la curvatura de la banda desde la curvatura de la banda hacia arriba hasta la curvatura de la banda hacia abajo, como se muestra en la Fig. 4. Debido a la curvatura de la banda hacia abajo, el BE aumenta con el aumento del ángulo de detección. .
El GaO x La capa interfacial genera cargas positivas que aumentan la altura de la barrera de la interfaz ɸ b . ɸ b se define como la diferencia de energía entre el nivel de Fermi y el mínimo de la banda de conducción en la superficie o interfaz [25]. Como resultado, después de A 2 O 3 deposición, la movilidad del 2DEG aumenta y la densidad electrónica del 2DEG disminuye [16, 25, 26].
Con el aumento de Al 2 O 3 grosor, la señal XPS se refleja más en la región de la interfaz entre el Al 2 limitado O 3 y GaN / AlGaN / GaN, que está validado por la profundidad de muestreo XPS que se muestra en la Tabla 2. Esto explica que solo se pudo detectar una parte del perfil de flexión de la banda para S2 [27]. Como resultado, la variación de BE es de 0,1 eV, menor que 0,2 eV de S1. Para S3, con una capa interfacial más gruesa, la densidad de cargas positivas aumenta, lo que da como resultado una flexión de la banda hacia abajo.
Conclusiones
En resumen, la polarización de la interfaz de Al 2 O 3 -capped GaN / AlGaN / GaN es investigado por el ARXPS. La polarización intrínseca de GaN se elimina debido a una capa rica en Ga y un GaO x formación de capas. Además, los enlaces Ga – O del GaO x La capa trae cargas fijas interfaciales positivas. Debido a esta variación de polarización, la banda varía desde la flexión hacia arriba hasta la flexión hacia abajo en la región de la interfaz.
Nanomateriales
- 5G y GaN:innovaciones futuras
- Impacto de los estados de la superficie y la fracción molar de aluminio en el potencial de la superficie y 2DEG en los HEMT de AlGaN / GaN
- Análisis de reflectancia infrarroja de capas de GaN dopadas de tipo n epitaxiales cultivadas en zafiro
- Dirigirse a las células endoteliales con nanopartículas multifuncionales de GaN / Fe
- Ajuste de las morfologías de la superficie y las propiedades de las películas de ZnO mediante el diseño de la capa interfacial
- Capas óptimas de dopaje de silicio de barreras cuánticas en la secuencia de crecimiento que forman el potencial de confinamiento suave de ocho períodos In0.2Ga0.8N / GaN Pozos cuánticos de azul LE…
- Una investigación sobre una célula solar de silicio cristalino con una capa de silicio negro en la parte posterior
- Comprensión del mecanismo de crecimiento de las capas epitaxiales de GaN en grafito exfoliado mecánicamente
- Recombinación controlada por deformación en múltiples pocillos cuánticos de InGaN / GaN en sustratos de silicio
- Dependencia del espesor de las propiedades interfaces y eléctricas en la capa atómica depositada AlN en el plano c GaN
- Estudio de espectroscopia Raman y difracción de rayos X de alta presión in situ de Ti3C2Tx MXene



