Ge pMOSFET con pasivación GeOx formada por ozono y posoxidación del plasma
Resumen
Un estudio comparativo sobre el rendimiento eléctrico de Ge pMOSFET con un GeO x Se realiza la capa de pasivación formada por post oxidación de ozono (OPO) y post oxidación de plasma (PPO). PPO y OPO se llevaron a cabo en un Al 2 O 3 / n-Ge (001) sustrato seguido de un HfO 2 de 5 nm dieléctrico de compuerta in situ depositado en una cámara ALD. La calidad de la capa de interfaz dieléctrico / Ge se caracterizó por espectroscopía de fotoelectrones de rayos X y microscopía electrónica de transmisión. El tratamiento con PPO conduce a un voltaje de umbral positivo ( V TH ) cambio y un I más bajo ACTIVADO / Yo APAGADO relación, lo que implica una mala calidad de interfaz. Los pMOSFET de Ge con OPO exhiben un I más alto ACTIVADO / Yo APAGADO relación (hasta cuatro órdenes de magnitud), oscilación subumbral mejorada y características de movilidad de portadora mejoradas en comparación con los dispositivos PPO. Un Al 2 más espeso O 3 La capa de bloque en el proceso OPO conduce a una mayor movilidad en los transistores Ge. Al comparar dos métodos de oxidación diferentes, los resultados muestran que el OPO es una forma eficaz de aumentar la calidad de la capa de interfaz, lo que contribuye a mejorar la movilidad efectiva de los pMOSFET de Ge.
Antecedentes
Con los dispositivos semiconductores de óxido metálico complementario (CMOS) convencionales acercándose a su límite físico, la mejora del rendimiento es difícil de lograr para los dispositivos semiconductores de alta velocidad con silicio (Si) como material del canal. Reemplazar el sustrato o el material del canal por otro material de alta movilidad es una opción imperativa. El germanio (Ge) se ha considerado un material de canal alternativo prometedor debido a una mayor movilidad del portador que la del Si. El MOSFET generalmente necesita una interfaz de óxido / semiconductor de alta calidad para alcanzar una alta movilidad efectiva. Sin embargo, durante una historia bastante larga, los MOSFET de Ge sufrieron la alta densidad de estado de la interfaz ( D eso ) causado por la mala estabilidad térmica de GeO 2 y lazos colgantes [1]. Por lo tanto, se han realizado muchas investigaciones sobre la pasivación de la interfaz Ge.
Se han informado varios enfoques para lograr una capa de interfaz de Ge / dieléctrico de alta calidad, como la pasivación de Si depositando uniformemente varias monocapas de Si en el sustrato de Ge antes de la epitaxia dieléctrica o la autopasivación mediante la formación de GeO 2 a propósito [2, 3]. Para formar un GeO 2 de alta calidad capa, hay muchos procesos de oxidación para reducir D eso y mejorar la estabilidad térmica, incluida la oxidación a alta presión [4], la oxidación por ozono [5], H 2 O plasma [6] y plasma de resonancia ciclotrónica de electrones (ECR) posoxidación [7].
En los últimos años, se ha informado de muchos trabajos que indican que el MOSFET de Ge de alto rendimiento se puede realizar mediante la oxidación posterior a través de Al 2 O 3 / Ge interfaz. En 2014, se realizó un inversor Ge CMOS en un sustrato Ge-on-insulator (GeOI) con GeO x crecido por recocido térmico rápido en ambiente de oxígeno puro después de 1 nm Al 2 O 3 fue depositado en Ge [8]. En ref. [7], Ge pMOSFET y nMOSFET con GeO x pasivación se fabricaron con plasma de oxígeno post oxidación y dependencia de la temperatura de GeO x También se discutieron el espesor y el rendimiento eléctrico. La oxidación térmica del Ge por el ozono se puede realizar a una temperatura más baja, ya que el ozono es más reactivo que el oxígeno [5]. El impacto de la temperatura en GeO x Se demostró el espesor crecido por ozono en la superficie de Ge. Ge pMOSFET con GeO x También se informó de pasivación fabricada por ozono post oxidación [9].
En este trabajo, Ge pMOSFET con GeO x la pasivación se fabrica utilizando post-oxidación de ozono (OPO) y post-oxidación de plasma de oxígeno (PPO) del Al 2 O 3 Interfaz / n-Ge. Se realiza un estudio comparativo sobre el rendimiento eléctrico de Ge pMOSFET con OPO y PPO. Todos los procesos, excepto la pasivación, se controlan con precisión para que sean iguales. La post oxidación se llevó a cabo después de que el Al 2 O 3 deposición de la capa de bloque que es diferente de [9] en la que la posoxidación fue después de HfO 2 declaración. El mecanismo de degeneración de la movilidad de Coulomb y se investiga la dispersión por rugosidad. El impacto del espesor del Al 2 O 3 También se analiza la capa de bloques en el rendimiento del dispositivo. En general, demostramos que OPO es una técnica de pasivación prometedora para la fabricación futura de MOSFET Ge.
Métodos
Los pMOSFET de Ge se fabricaron en 4 pulgadas. Obleas de n-Ge (001) con una resistividad de 0.14–0.183 Ω cm. Se realizaron tres procesos de pasivación diferentes, y los pasos clave del proceso se muestran en la Fig. 1a. Las obleas se limpiaron con HF diluido (1:50) y agua desionizada durante varios ciclos para eliminar el óxido nativo y luego se transfirieron a una cámara PEALD de deposición de capa atómica mejorada con plasma (Picosun R200 Advanced) inmediatamente. Luego, una fina capa de Al 2 O 3 La película (~ 1 nm) se depositó a 300 ° C con trimetilaluminio (TMA) y agua desionizada (H 2 O) como precursores de Al y O, respectivamente. Porque el Al 2 O 3 / GeO 2 La capa es demasiado delgada para tener una proporción precisa de átomos de oxígeno, marcamos estas dos capas como AlO x / GeO x . La PPO se realizó con la fuente de plasma remota Litmas durante 60 s. Se utilizó un generador de ozono (generadores de ozono de la serie AC en EE. UU.) Con un flujo de oxígeno de entrada de 750 sccm para el tratamiento con OPO en 50% de O 3 / O 2 ambiente. Sin romper el vacío, HfO 2 de 60 ciclos luego se depositó en la parte superior de AlO x / GeO x después del tratamiento con PPO u OPO a 300 ° C usando tetrakis dimetil amino hafnio (TDMAHf) y H 2 O como precursores de Hf y O, respectivamente. A continuación, se depositó un TaN de 100 nm mediante pulverización catódica reactiva como metal de puerta. Después del modelado y grabado de la puerta, BF 2+ autoalineado implantación en regiones fuente / drenaje (S / D) con una energía de 20 keV y una dosis de 1 × 10 15 cm - 2 se llevo a cabo. Se depositó un metal Ni S / D de 20 nm y se modeló mediante un proceso de despegue. Finalmente, se siguió un recocido térmico rápido a 450 ° C durante 30 s para la activación del dopante y el contacto óhmico S / D. Las imágenes esquemáticas y de microscopía de los pMOSFET de Ge fabricados se muestran en la Fig. 1b yc, respectivamente.
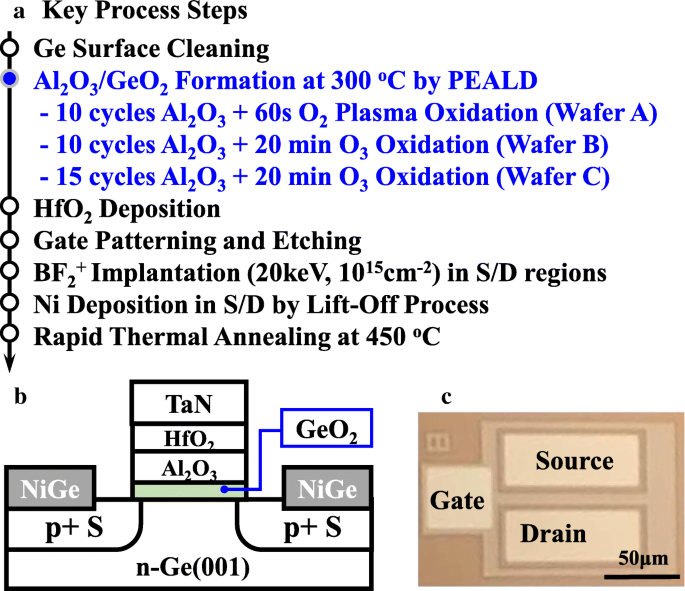
un Flujo de proceso clave para fabricar Ge pMOSFET con GeO 2 pasivación superficial con tres métodos diferentes de pasivación. b Esquema y c imágenes de microscopio del transistor Ge fabricado
La sección transversal de TaN / HfO 2 / AlO x / GeO x / La pila de compuertas Ge se representó usando un microscopio electrónico de transmisión (TEM) para comparar el impacto del plasma de oxígeno o el ozono en GeO x formación. Las figuras 2a yb muestran las imágenes TEM transversales de TaN / HfO 2 / AlO x / GeO x / Ge gate stack con PPO y OPO, respectivamente. El espesor del amorfo HfO 2 La capa en ambos dispositivos es de 6 nm. La oblea A con tratamiento PPO de los años 60 tiene un AlO x distinto / GeO x capa entre el HfO 2 y sustratos de Ge. Este AlO x / GeO x La capa de la oblea B formada por 20 min OPO tiene un margen desordenado. El grosor del GeO x capa está de acuerdo con los datos en [10].
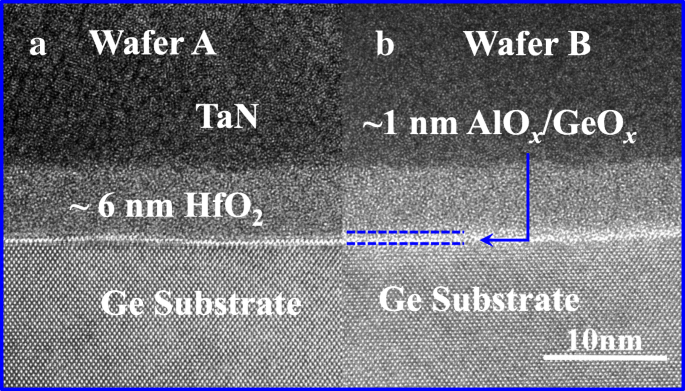
Imágenes TEM transversales de la pila de compuerta de metal / alto k con un AlO x / GeO x capa interfacial (IL) fabricada por a OPO y b PPO en un canal n-Ge (001)
Resultados y discusión
Keithley 4200-SCS midió las características de salida y transferencia junto con el voltaje de capacitancia (CV) de puerta a fuente de alta frecuencia. La Figura 3 muestra la comparación de las características de transferencia y salida de Ge pMOSFET con tres condiciones de formación diferentes del AlO x / GeO x capa de pasivación. Todos los dispositivos de varias obleas tienen una longitud de puerta ( L G ) de 3 μm. Los dispositivos en la oblea A exhiben una corriente de drenaje saturada más alta ( I DS ) en comparación con las otras dos obleas. Pero las obleas B y C con OPO muestran una corriente en estado APAGADO mucho menor ( I APAGADO ) en comparación con la oblea A con PPO. También se ve que las obleas B y C con OPO funcionaron en modo de mejora y la oblea A funcionó en modo de agotamiento. Se infiere que, después del tratamiento con PPO, la superficie de n-Ge sigue siendo de tipo p debido a la alta D eso valor que se ha discutido en [11]. Oblea C con un Al 2 más espeso O 3 la capa de bloque muestra un V positivo TH cambio en comparación con la oblea B y una D más alta eso que la oblea B. Se observa a partir de las características de salida que se muestran en la Fig. 3b que, bajo un voltaje de puerta bajo ( V GS ), la oblea A tiene un I más bajo DS sobre las obleas B y C debido a la oscilación del subumbral menos pronunciada (SS). Cuando el V GS aumenta, I DS de la oblea A es cada vez mayor en comparación con los otros dos dispositivos. Por lo tanto, a partir de las imágenes de la Fig.3 y TEM de la Fig.2, la difusión de AlO x / GeO x capa puede suprimir el I APAGADO , lo que resulta en una mejora de los efectos de pasivación.
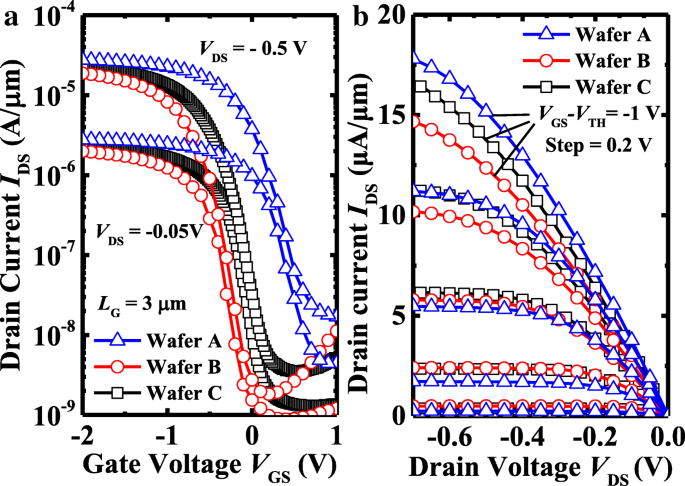
un yo DS –V GS y b yo DS –V DS características de Ge pMOSFET con un Al 2 O 3 / GeO 2 capa de pasivación fabricada por PPO (oblea A) y OPO (obleas B y C)
La Figura 4 resume los resultados estadísticos del I ACTIVADO / Yo APAGADO relación y oscilación subumbral de los dispositivos en diferentes obleas. Los pMOSFET de Ge con OPO exhiben un I más alto ACTIVADO / Yo APAGADO relación (~ 4 órdenes de magnitud) y SS notablemente mejorada en comparación con el dispositivo PPO, lo que indica una mayor calidad de la interfaz dieléctrica / canal. En comparación con la oblea B, la oblea C exhibe una corriente de estado ON más alta ( I ACTIVADO ) pero un I inferior ACTIVADO / Yo APAGADO proporción.
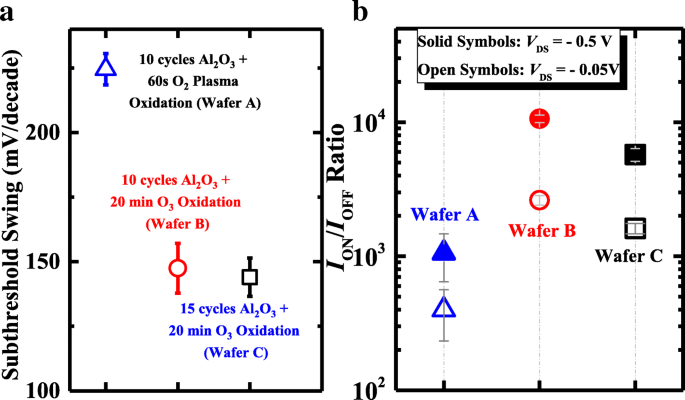
Gráficos estadísticos de a SS y b yo ACTIVADO / I APAGADO relación para Ge pMOSFET con diferentes condiciones de pasivación
Para representar aún más la calidad de la capa interfacial de diferentes métodos de posoxidación, las obleas A, B y C (muestras ficticias sin HfO 2 y metales de la puerta) se probaron mediante espectroscopía de fotoelectrones de rayos X (XPS). La medición de XPS se llevó a cabo en tres muestras ficticias posteriores a la oxidación después del tratamiento con PPO u OPO sin HfO 2 deposición y pulverización catódica de TaN. La estequiometría de GeO x en Al 2 O 3 Las muestras de / GeO / Ge se investigaron con una fuente de rayos X monocromática blanda de Al Kα (1486,6 eV). Ge 3 d Los picos y el análisis de diferenciación de picos se muestran en la Fig. 5. El Ge 3 d 5/2 El pico de las tres muestras se unifica a 29,7 eV, y los cambios químicos de Ge 3 d 3/2 , Ge 1+ , Ge 2+ , Ge 3+ y Ge 4+ a Ge 3 d 5/2 se establecen en 0,6, 0,8, 1,8, 2,75 y 3,4 eV, respectivamente [12]. En la Fig. 5b, la oblea A muestra que después de un PPO de 60, la principal valencia de Ge en GeO x son Ge 1+ y Ge 3+ . Se observa una distribución de estado de equilibrio de Ge similar en la oblea C, y un Ge 3+ el componente aumenta ligeramente. En la Fig. 5b, la oblea B muestra que un dispositivo OPO con Al 2 más delgado (10 ciclos) O 3 oxidará aún más Ge 1+ en Ge 2+ , Ge 3+ y Ge 4+ , mientras que Ge 1+ se reduce significativamente.
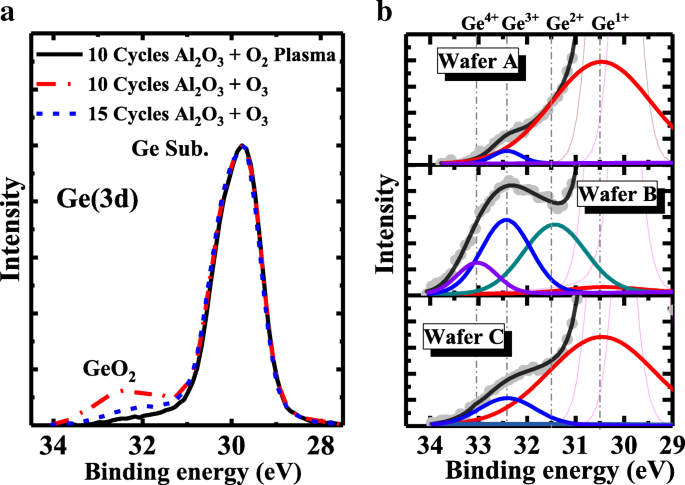
un Ge 3 d Espectros XPS de Al 2 O 3 / GeO x / Ge formado por diferentes condiciones. b Accesorios de pico del Ge 3 d Espectros XPS de GeO 2 capa para las tres muestras
Las características de CV de puerta a fuente se muestran en la Fig. 6. A partir de la curva CV de 1 MHz, la D eso cerca de la brecha media es estimada por Terman's método [13], y un valor de espesor de óxido equivalente (EOT) también se evalúa como se enumera en la Tabla 1. La OPO de veinte minutos (obleas B y C) da como resultado una EOT más alta en comparación con la PPO (oblea A). La oblea C exhibe un EOT más alto que la oblea B, debido al Al 2 más grueso O 3 como capa de bloqueo. Se ha informado que el espesor de GeO x sobre una superficie de Ge desnuda en O 3 la temperatura ambiente alcanza la saturación en unos pocos minutos y el espesor de saturación está dominado por la temperatura en lugar del tiempo de oxidación [10]. Entonces, en este documento, el grosor de GeO x por ozono después de la oxidación se satura después de unos minutos y el tiempo de oxidación que queda es solo para el recocido.
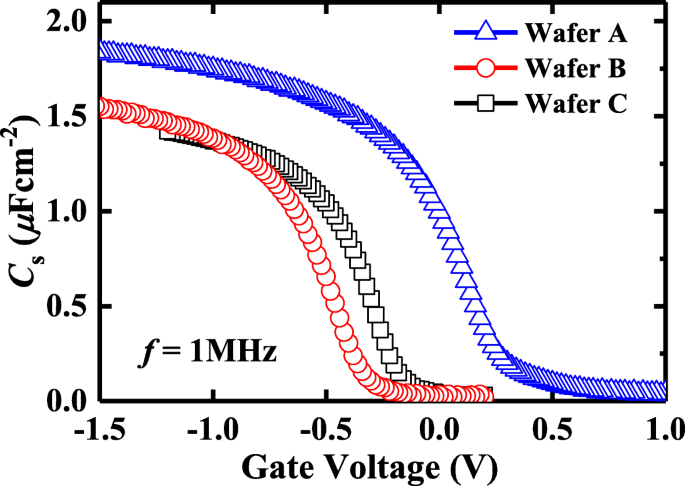
Capacitancia de puerta a fuente versus V GS características de Ge pMOSFET pasivados por PPO (obleas A) y OPO (obleas B y C)
La Figura 7 resume la resistencia total ( R T ) versus L G de cada dispositivo en este trabajo. Aquí, R T se define como V DS / Yo DS en V DS =0.05 V y V GS - V TH =1 V. La resistencia en serie de fuente / drenaje (S / D) ( R SD ) y resistencia del canal ( R CH ) se puede extraer de la intersección y la pendiente del ajuste lineal de R T - L G líneas como se muestra en la Fig. 7. La R extraída SD y R CH Los resultados se resumen en la Tabla 1. La Figura 7 muestra que los Ge pMOSFET con PPO exhiben una R más baja SD y R CH que es consistente con los resultados de capacitancia que se muestran en la Fig. 6.
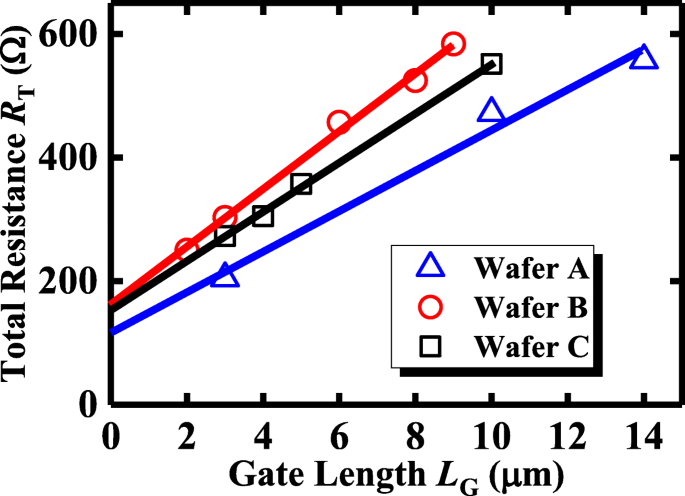
Resistencia total ( R T ) versus la longitud de la puerta ( L G ) de Ge pMOSFET
Movilidad efectiva del agujero μ ef se extrajo con base en un enfoque basado en pendiente de resistencia total. En la figura 8, comparamos el μ ef de nuestros Ge pMOSFET con tratamiento con PPO y OPO con los de otros Ge pMOSFET reportados [9, 14]. Q inv es la densidad de carga de inversión en el canal del dispositivo. Los pMOSFET de Ge con OPO exhiben un pico más alto μ ef en comparación con los dispositivos con PPO. Oblea C con un Al 2 más espeso O 3 La capa de bloque tiene una movilidad de pico más alta de 283 cm 2 / V s en comparación con la oblea B con el Al 2 más delgado O 3 . La oblea A con PPO presenta un orificio de campo alto inferior μ ef con los dispositivos con OPO, lo que se atribuye a la menor dispersión de rugosidad. Pero, en campo bajo, los transistores en la oblea A con PPO logran un μ más bajo ef que los dispositivos OPO debido a la mayor dispersión de coulomb [15]. Solo se han informado unos pocos trabajos sobre Ge pMOSFET fabricados por pasivación de ozono. Aquí, se lleva a cabo una comparación del rendimiento del dispositivo clave entre nuestros dispositivos y los pMOSFET Ge reportados tratados con OPO [9, 14], y los resultados se muestran en la Tabla 2. Se concluye que la oblea C en este trabajo alcanza el alto -campo μ ef mejora y superior I ACTIVADO / Yo APAGADO en comparación con el dispositivo informado tratado con OPO. Además, en una Q inv de 5 × 10 12 cm - 2 , la oblea C muestra un μ 2,37 veces superior ef en comparación con la movilidad universal Si. El yo ACTIVADO de la oblea C es ligeramente más baja que la de la Ref. [9] que se debe al EOT más grande.
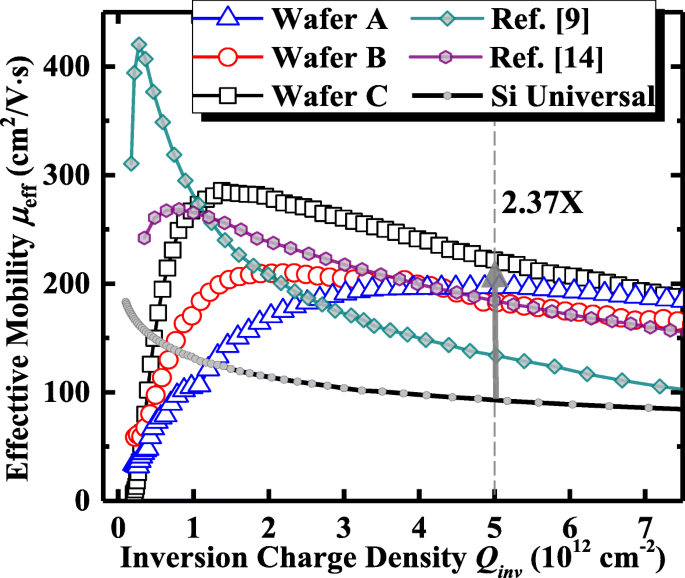
μ ef versus Q inv de Ge pMOSFET con diferentes condiciones de pasivación. Transistores Ge con 15 ciclos Al 2 O 3 + 20 min O 3 oxidación (oblea C) exhibe un pico μ ef de 283 cm 2 / Vs. El impacto de la resistencia S / D en μ ef La extracción se eliminó mediante el método de extracción de movilidad de canal efectiva basado en pendiente de resistencia total [16]
Conclusiones
Los pMOSFET de Ge se realizan con GeO x pasivación, que se forma mediante el tratamiento con OPO o PPO de Al 2 O 3 / n-Ge en PEALD. Los dispositivos OPO exhiben mejores características de transferencia y salida, mayor I ACTIVADO / Yo APAGADO relación, la oscilación mejorada del subumbral y el pico más alto μ ef en comparación con los dispositivos PPO. Para el proceso OPO de 15 ciclos, un Al 2 más espeso O 3 capa conduce a un valor EOT más alto y un μ mejorado ef en dispositivos en comparación con el caso de 10 ciclos. Todos los resultados de este trabajo indican que OPO es una forma de pasivación efectiva para lograr una interfaz Ge / dieléctrica de alta calidad y, por lo tanto, puede ser una técnica de pasivación candidata prometedora para la futura fabricación de MOSFET de Ge.
Abreviaturas
- Al 2 O 3 :
-
Óxido de aluminio
- ALD:
-
Deposición de la capa atómica
- BF 2 + :
-
Ión de fluoruro de boro
- EOT:
-
Espesor de óxido equivalente
- Ge:
-
Germanio
- GeO x :
-
Óxido de germanio
- HF:
-
Ácido fluorhídrico
- HfO 2 :
-
Dióxido de hafnio
- TEM:
-
Microscopio electrónico de transmisión
- MOSFET:
-
Transistores de efecto de campo semiconductores de óxido metálico
- OPO:
-
Post oxidación del ozono
- PPO:
-
Post oxidación del plasma
- Q inv :
-
Densidad de carga de inversión
- SS:
-
Oscilación del subumbral
- XPS:
-
Espectroscopia de fotoelectrones de rayos X
- μ ef :
-
Movilidad efectiva del pozo
Nanomateriales
- Creación de robots con Raspberry Pi y Python
- Liderando con persistencia y perseverancia
- Portenta y sensor de termopar (con MAX6675)
- Clase y objeto C++ con ejemplo
- Nanomaterial inteligente y nanocompuesto con actividades agroquímicas avanzadas
- Ajuste de la química superficial de la polieteretercetona mediante revestimiento de oro y tratamiento con plasma
- Resistencia de contacto reducida entre el metal y n-Ge mediante la inserción de ZnO con tratamiento con plasma de argón
- Ge pMOSFET de alta movilidad con pasivación de Si amorfo:impacto de la orientación de la superficie
- Pasivación de Si mejorada y eficiencia de células solares PERC mediante óxido de aluminio depositado en capa atómica con recocido posterior en dos pasos
- ¿Qué es el corte por plasma y cómo funciona el corte por plasma?
- Node-RED y los primeros pasos con Docker



