Transistor de efecto de campo de capacitancia negativa ZrOx con comportamiento de oscilación sub-60 subumbral
Resumen
Aquí informamos el ZrO x FET de capacitancia negativa (NC) basada en 45.06 mV / década de oscilación de subumbral (SS) por debajo de ± 1 V V GS gama, que puede lograr nuevas oportunidades en futuras aplicaciones NCFET escalables en voltaje. El comportamiento de tipo ferroeléctrico del Ge / ZrO x Se propone que los condensadores / TaN se originen a partir de los dipolos de vacancia de oxígeno. El efecto NC del amorfo HfO 2 y ZrO x Los dispositivos de películas pueden probarse por la caída repentina de la fuga de la puerta, el fenómeno de resistencia diferencial negativa (NDR), la mejora de I Oscilación subumbral sub-60 y DS. 5 nm ZrO x Los NCFET basados en el reloj logran una histéresis en el sentido de las agujas del reloj de 0,24 V, menos de 60 mV / década SS y un 12% I Mejora de DS en comparación con el dispositivo de control sin ZrO x . El efecto NC suprimido de Al 2 O 3 / HfO 2 NCFET en comparación con ZrO x NCFET está relacionado con el cambio parcial de dipolos vacantes de oxígeno en el barrido hacia adelante debido a dipolos interfaciales negativos en el Al 2 O 3 / HfO 2 interfaz.
Antecedentes
A medida que los dispositivos semiconductores de óxido de metal complementario (CMOS) se reducen constantemente, la técnica del circuito integrado (IC) ha entrado en la era de “más que la era de Moore”. La fuerza impulsora de la industria y la tecnología de los circuitos integrados se convierte en la reducción del consumo de energía, en lugar de la miniaturización de los transistores [1, 2]. Sin embargo, la tiranía de Boltzmann de los MOSFET, más de 60 mV / década SS ha restringido la eficiencia energética / energética [3]. En los últimos años, muchos dispositivos novedosos propuestos tienen la capacidad de lograr una oscilación del umbral inferior a 60 mV / década, incluidos los MOSFET de ionización por impacto, los FET de túnel y los NCFET [4, 5, 6, 7]. Debido a la estructura simple, la SS abrupta y la corriente de excitación mejorada, los NCFET con una película ferroeléctrica (FE) se han considerado una alternativa atractiva entre estos dispositivos emergentes [8,9,10]. Los experimentos informados sobre NCFET incluyen principalmente PbZrTiO 3 (PZT), P (VDF-TrFE) y HfZrO x (HZO) [11,12,13,14,15,16,17]. Sin embargo, la alta temperatura del proceso y la corriente de fuga de puerta no deseada a lo largo de los límites de grano de los materiales ferroeléctricos policristalinos han restringido su desarrollo para los nodos de tecnología de vanguardia [18,19,20,21,22,23,24,25 , 26]. Recientemente, la ferroelectricidad en el amorfo Al 2 O 3 y ZrO x Se han investigado las películas habilitadas por los dipolos de vacancia de oxígeno modulados por voltaje [27,28,29]. En comparación con la contraparte cristalina, las películas amorfas de tipo ferroeléctrico tienen ventajas significativas en cuanto a temperatura de proceso reducida y corriente de fuga. Por lo tanto, hay investigaciones masivas sobre FeFET con aislante de puerta amorfa para la memoria no volátil y aplicaciones de sinapsis analógicas [27, 30,31,32,33,34]. Sin embargo, la investigación sistemática sobre un transistor ZrO x NCFET basado en no se ha llevado a cabo.
En este trabajo, Ge NCFET con 5 nm ZrO x capa dieléctrica ferroeléctrica y 5 nm Al 2 O 3 / HfO 2 Se han propuesto capas dieléctricas ferroeléctricas, respectivamente. Observamos experimentalmente una pendiente pronunciada por debajo de 60 mV / década en ZrO x (5 nm) NCFET, que se puede atribuir al efecto NC de ZrO x capa ferroeléctrica. Y analizamos la polarización P en función de la tensión aplicada V para Ge / ZrO x / Condensadores TaN. El comportamiento de tipo ferroeléctrico del Ge / ZrO x Los condensadores / TaN son inducidos por los dipolos de vacancia de oxígeno inducidos por voltaje. Además, atribuimos la I mejorada DS y la repentina caída de I G en el Al 2 O 3 / HfO 2 NCFET y ZrO x NCFET al efecto NC. También observamos el fenómeno NDR en Al 2 O 3 / HfO 2 NCFET y ZrO x NCFET. Además, analizamos aún más el mecanismo físico de la disminución del efecto NC inducido por dipolos interfaciales en el Al 2 O 3 / HfO 2 NCFET. El ZrO x Los NCFET con pendiente pronunciada de menos de 60 mV / década, voltaje de drenaje mejorado y voltaje de funcionamiento bajo serán adecuados para el diseño de NCFET con bajo consumo de energía en la “era más que Moore”.
Métodos
Pasos clave del proceso para NCFET con ZrO x y Al 2 O 3 / HfO 2 La fabricación se muestra en la Fig. 1a. Aisladores dieléctricos de compuerta diferentes, incluido Al 2 O 3 / amorfo HfO 2 (5 nm) películas y ZrO amorfo x (4,2 nm) se cultivaron películas sobre sustratos de n-Ge (001) mediante deposición de capa atómica (ALD) a 300 ° C. TMA, TDMAHf, TDMAZr y H 2 Se utilizaron vapores de O como precursores de Al, Hf, Zr y O, respectivamente. El tiempo de pulso y el tiempo de purga de los precursores de Hf y Zr son 1,6 sy 8 s, respectivamente. El tiempo de pulso y el tiempo de purga de los precursores de Al son 0,2 sy 8 s, respectivamente. Luego se depositó un electrodo de puerta superior de TaN en HfO 2 o ZrO x superficies por pulverización catódica reactiva. Las regiones de fuente / drenaje (S / D) se definieron mediante patrones de litografía y grabado en seco. Después de eso, boro (B + ) y se depositó níquel (Ni) en las regiones de fuente / drenaje (S / D). Finalmente, recocido térmico rápido (RTA) a 350 ° C durante 30 s en 10 8 Se llevó a cabo Pa ambiente de nitrógeno. La Figura 1b, d muestra los esquemas del Al 2 fabricado O 3 / HfO 2 NCFET y ZrO x NCFET. La imagen de microscopio electrónico de transmisión de alta resolución (HRTEM) de la Fig. 1c muestra el HfO 2 amorfo (5 nm) película en Ge (001) con Al 2 O 3 capa interfacial. La imagen HRTEM en la Fig. 1e muestra el ZrO amorfo x (4,2 nm) película sobre Ge (001). La curva C – V de ZrO x NCFET y los espectros de fotoelectrones de rayos X (XPS) de TaN / ZrO x (4,2 nm) / condensadores de Ge se midieron en el archivo adicional 1:Fig. S1.
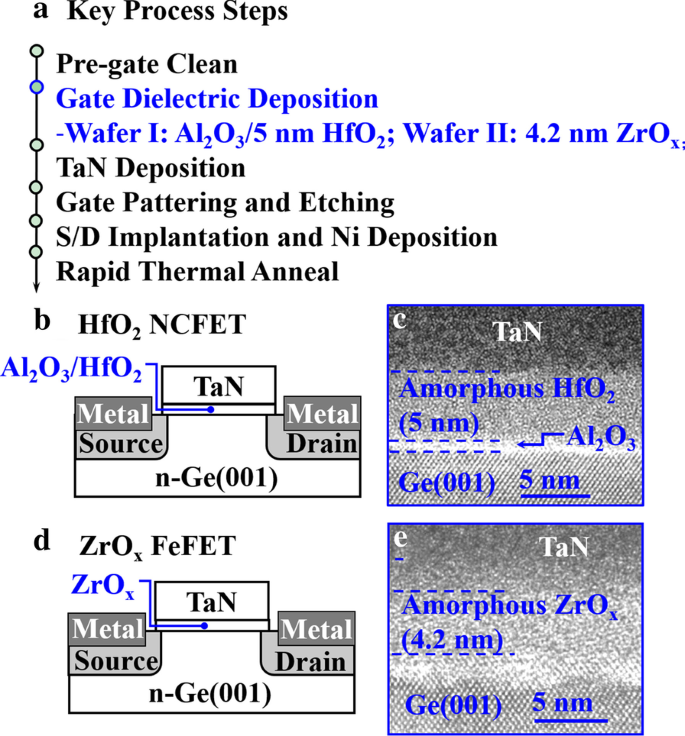
un Pasos clave del proceso para la fabricación de Al 2 O 3 / 5 nm HfO 2 NCFET y ZrO de 4,2 nm x NCFET. b Esquemas y c Imágenes HRTEM del ZrO x fabricado NCFET. d Esquemas y e Imágenes HRTEM del Al 2 fabricado O 3 / HfO 2 NCFET
Resultados y discusión
La figura 2a muestra las curvas medidas de polarización P vs. voltaje aplicado V características del Ge / ZrO x / Condensadores TaN a 3,3 kHz. La longitud de la puerta ( L G ) de los condensadores son de 8 μm. Se observa que la polarización remanente P r del Ge / ZrO x Los condensadores / TaN se pueden mejorar con un rango de barrido más amplio de V . El comportamiento de tipo ferroeléctrico del ZrO amorfo x Se propone que la película de la Fig. 2a se origine a partir de los dipolos de vacancia de oxígeno impulsados por voltaje [35]. La Figura 2b muestra el P – V medido curvas para Ge / ZrO x / Condensadores TaN en diferentes frecuencias de 200 a 10 kHz. Podemos ver que el comportamiento ferroeléctrico del ZrO amorfo x la película permanece estable para todas las frecuencias. Sin embargo, la P r del amorfo ZrO x la película se reduce con el aumento de frecuencias. Este fenómeno puede explicarse por la conmutación incompleta de dipolos bajo altas frecuencias de medición [36, 37]. A medida que aumentan las frecuencias de medición, el tiempo para el cambio de dirección del campo eléctrico en el ZrO amorfo x la película disminuye. Por lo tanto, parte del cambio de diploes de vacantes de oxígeno está incompleto, lo que proporciona una disminución de P r .

P medido versus V características del ZrO x de 4.2 nm condensadores con a diferentes rangos de barrido de V y b diferentes frecuencias de medición
La figura 3a muestra el I medido DS - V GS curvas de un Al 2 ferroeléctrico O 3 / HfO 2 NCFET en el V DS de - 0,05 V y - 0,5 V. La L G de los dispositivos es de 3 μm. Los bucles de histéresis de 0,14 V ( V DS =- 0,05 V, I ds =1 nA / μm) y 0,08 V ( V DS =- 0,5 V, I ds =1 nA / μm) se demuestran, respectivamente. Los bucles de histéresis en el sentido de las agujas del reloj se atribuyen a la migración de las vacantes de oxígeno y las cargas negativas acompañadas. Los dipolos vacantes de oxígeno se acumulan (agotan) en el Ge / Al 2 O 3 interfaz bajo positivo (negativo) V GS . Por lo tanto, el voltaje de umbral ( V TH ) aumenta (disminuye) bajo el barrido directo (inverso) de los voltajes de la puerta. Como se muestra en la Fig. 3b, las características de salida del Al 2 O 3 / HfO 2 Se comparan NCFET y el FET de control. La corriente de saturación del Al 2 O 3 / HfO 2 NCFET supera los 26 μA / μm, con un aumento del 23% en comparación con el control FET en | V GS - V TH | =| V DS | =0,8 V. La mejora de la corriente es inducida por el aumento de la intensidad de la carga de inversión ( Q inv ) en el campo eléctrico de polarización inversa y la amplificación del potencial de superficie [38, 39]. Además de la mejora actual, el NDR obvio obtenido demuestra el efecto NC del HfO 2 amorfo película. El efecto NDR es causado por el cambio incompleto de dipolos de vacancia de oxígeno debido al acoplamiento de drenaje a canal como V DS aumenta [40, 41]. La Figura 3c compara la fuga medida en la puerta I G - V GS curvas para el Al 2 de 5 nm O 3 / HfO 2 NCFET en el V DS de - 0,05 V y - 0,5 V. Las caídas repentinas de I G solo durante el barrido inverso indique la disminución de voltaje en el HfO 2 amorfo película y la amplificación del potencial superficial [42]. La ausencia de efecto NC durante el barrido hacia adelante es causada por el cambio parcial de dipolos vacantes de oxígeno en el amorfo HfO 2 película [43]. La diferente capacidad de contener átomos de oxígeno entre Al 2 O 3 y HfO 2 La capa conduce a la redistribución de oxígeno y dipolos interfaciales negativos en el Al 2 O 3 / HfO 2 interfaz [44, 45]. Debido a la presencia de dipolos interfaciales negativos, es difícil para el HfO 2 amorfo película para realizar un cambio de polarización completo (efecto NC) en el barrido hacia adelante (archivo adicional 1).
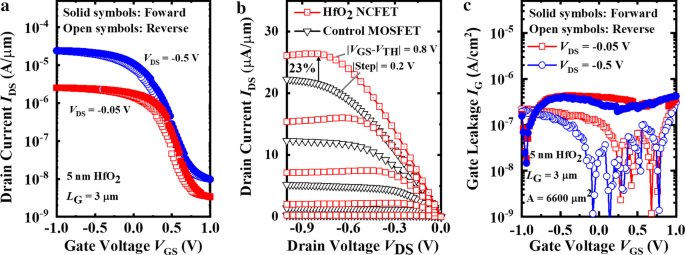
un Medido I DS - V GS curvas de 5 nm HfO 2 NCFET cuando V DS =- 0,5 V y V DS =- 0,05 V. b Medido I DS - V DS curvas del HfO 2 NCFET y el MOSFET de control. c Medido I G - V GS curvas de 5 nm HfO 2 NCFET cuando V DS =- 0,5 V y V DS =- 0,05 V
La Figura 4a muestra las curvas de transferencia medidas de un ZrO x ferroeléctrico NCFET en el V DS de - 0,05 V y - 0,5 V. La L G de los dos dispositivos son de 4 μm. Los bucles de histéresis en el sentido de las agujas del reloj de 0,24 V ( V DS =- 0,05 V, I ds =1 nA / μm) y 0,14 V ( V DS =- 0,5 V, I DS =1 nA / μm) se demuestran, respectivamente. Como se muestra en la Fig. 4b, las características de salida del ZrO x Se comparan NCFET y el FET de control. La corriente de saturación del ZrO x NCFET supera los 30 μA / μm, con un aumento del 12% en comparación con el control FET en | V GS - V TH | =| V DS | =1 V. La mejora de la corriente mejorada y el NDR más obvio indican el efecto NC mejorado del ZrO amorfo x película (5 nm) en contraste con la de 5 nm HfO 2 película. La Figura 4c compara la fuga medida en la puerta I G - V GS curvas para el ZrO de 5 nm x NCFET en el V DS de - 0.05 V y - 0.5 V. Comparado con el repentino I G gotas de Al 2 O 3 / HfO 2 NCFET solo durante el barrido inverso en la Fig. 3c, las caídas repentinas de I G tanto en el barrido hacia adelante como hacia atrás en la Fig. 4c también prueban el efecto NC mejorado en el ZrO amorfo x película.
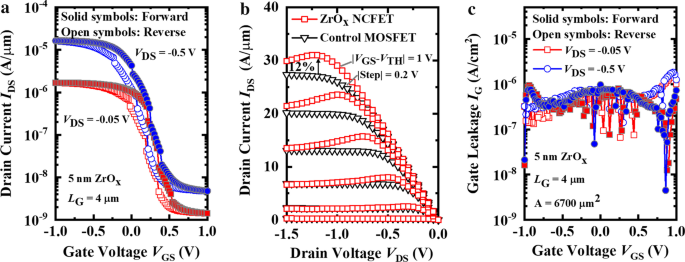
un Medido I DS - V GS curvas de 5 nm ZrO x NCFET cuando V DS =- 0,5 V y V DS =- 0,05 V. b Medido I DS - V DS curvas de la ZrO x NCFET y el MOSFET de control demostrando el obvio fenómeno NDR. c Medido I G - V GS curvas de 5 nm ZrO x NCFET cuando V DS =- 0,5 V y V DS =- 0,05 V
La figura 5a, b muestra el punto SS como función de I DS para el Al 2 O 3 / HfO 2 y ZrO x NCFET en el V DS de - 0.05 V y - 0.5 V. Como se muestra en la Fig. 5b, se puede lograr una oscilación del subumbral (SS) por debajo de 60 mV / década durante el barrido hacia adelante o hacia atrás de V GS en el V DS de - 0.05 V y - 0.5 V. Cuando V DS es - 0,05 V, se consiguió un punto SS hacia adelante de 45,1 mV / dec y un punto hacia atrás SS de 55,2 mV / dec. Cuando V DS es - 0,5 V, se consiguió un punto SS hacia adelante de 51,16 mV / dec y un punto hacia atrás SS de 46,52 mV / dec. Debido a la diferente capacidad de efecto de barrido del Al 2 O 3 / HfO 2 y ZrO x capa, el cambio de dipolos parciales se produce en el Al 2 O 3 / HfO 2 NCFET. Por lo tanto, el efecto NC más obvio con SS por debajo de 60 mV / década se logra en 5 nm ZrO x NCFET.
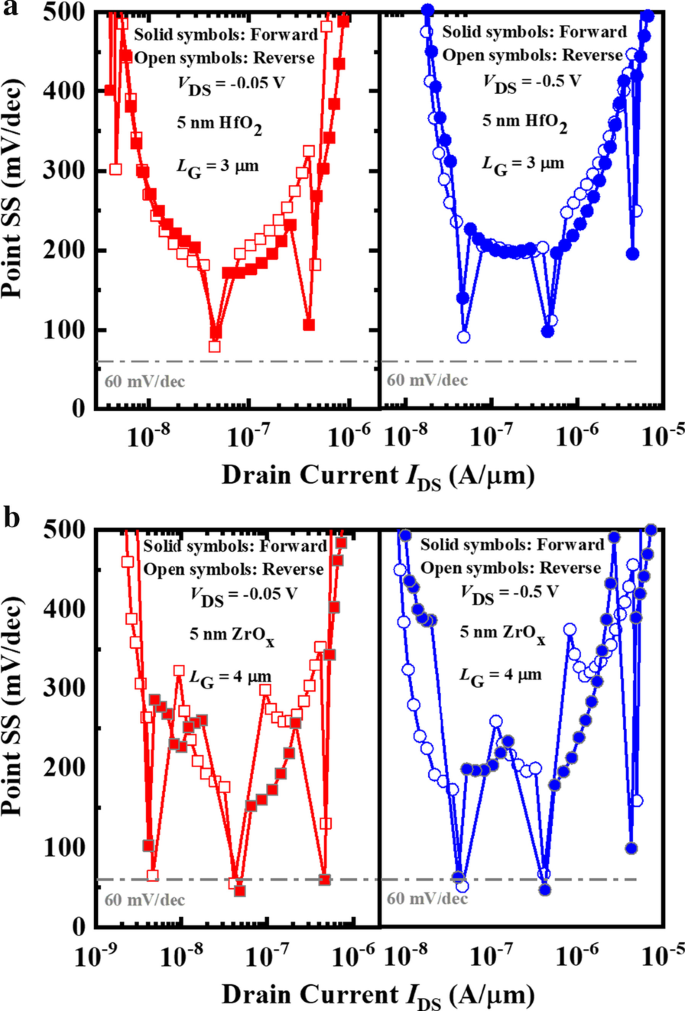
Punto SS en función de I DS para el un Al 2 O 3 / 5 nm HfO 2 NCFET y b 5 nm ZrO x NCFET
Conclusiones
Divulgamos la demostración de NC ZrO ferroeléctrico x pFET con SS inferior a 60 mV / década, voltaje de funcionamiento bajo de 1 V y una histéresis de menos de 60 mV. El impacto del ZrO amorfo x Las películas sobre el comportamiento ferroeléctrico se explican por los dipolos de vacancia de oxígeno. El I mejorado DS y el fenómeno NDR también se obtienen en Al 2 O 3 / HfO 2 NCFET y ZrO x NCFET en comparación con el dispositivo de control. El efecto NC suprimido del Al 2 O 3 / HfO 2 NCFET se puede atribuir al cambio de dipolo parcial debido a dipolos interfical en el Al 2 O 3 / HfO 2 interfaz. El ZrO x Los NCFET con pendiente pronunciada por debajo de 60 mV / década, voltaje de drenaje mejorado y bajo voltaje operativo allanan un nuevo camino para el diseño futuro de NCFET de bajo consumo de energía.
Disponibilidad de datos y materiales
Los conjuntos de datos que respaldan las conclusiones de este artículo se incluyen en el artículo.
Abreviaturas
- TaN:
-
Nitruro de tantalio
- ZrO x :
-
Dióxido de circonio
- TDMAZr:
-
Tetrakis (dimetilamido) circonio
- P r :
-
Polarización remanente
- E c :
-
Campo eléctrico coercitivo
- MOSFET:
-
Transistores de efecto de campo semiconductores de óxido metálico
- Ge:
-
Germanio
- ALD:
-
Deposición de la capa atómica
- B + :
-
Iones de boro
- Al 2 O 3 :
-
Óxido de aluminio
- HRTEM:
-
Microscopio electrónico de transmisión de alta resolución
- Ni:
-
Níquel
- RTA:
-
Recocido térmico reembolsado
- I DS :
-
Drenar corriente
- V GS :
-
Voltaje de puerta
- V TH :
-
Voltaje umbral
- NCFET:
-
Transistor de efecto de campo de capacitancia negativa
Nanomateriales
- El transistor de efecto de campo de unión (JFET) como interruptor
- Materiales:Espuma EPP con propiedades de superficie mejoradas y comportamiento de relleno optimizado
- Transistores de efecto de campo de nanoflake SnSe multicapa con contactos au óhmicos de baja resistencia
- Comportamiento de sinterización de SiC sinterizado por plasma de chispa con nanopartículas compuestas de Si-SiC preparadas mediante el proceso de plasma térmico de CC
- Aerogel de grafeno / polianilina con superelasticidad y alta capacitancia como electrodo supercondensador altamente tolerante a la compresión
- Transistores de efecto de campo ferroeléctricos basados en patrones de banda de micrones dominados por nanotubos de carbono de pared simple con capa de control de defectos de HfO2
- Rendimiento analógico / RF del transistor de efecto de campo de túnel de fuente dual de puerta en forma de T
- Transistor de canal de vacío a nanoescala basado en grafeno
- Transistor semiconductor de óxido metálico de doble difusión lateral de resistencia específica ultrabaja con doble puerta mejorada y capa parcialmente enterrada en P
- Transistor de efecto de campo SnSe2 con alta relación de encendido / apagado y fotoconductividad con conmutación de polaridad
- Capacidad de torneado de alto rendimiento con espacio reducido



