Comportamiento similar al ferroeléctrico que se origina a partir de dipolos vacantes de oxígeno en una película amorfa para memoria no volátil
Resumen
Los dispositivos ferroeléctricos tradicionales adolecen de falta de escalabilidad. Dopado HfO 2 La película delgada es prometedora para resolver el problema de las incrustaciones, pero se ve desafiada por la alta corriente de fuga y la preocupación por la uniformidad por la naturaleza policristalina. El comportamiento estable de tipo ferroeléctrico se demuestra en primer lugar en un Al 2 amorfo de 3,6 nm de espesor O 3 película. El amorfo Al 2 O 3 Los dispositivos son altamente escalables, lo que permite un transistor de efecto de campo no volátil (NVFET) de múltiples puertas con un paso de aleta a escala nanométrica. También posee las ventajas de baja temperatura de proceso, alta frecuencia (~ GHz), amplia ventana de memoria y larga duración, lo que sugiere un gran potencial en los sistemas VLSI. La polarización conmutable ( P ) inducida por los dipolos de vacancia de oxígeno modulados por voltaje.
Antecedentes
La memoria ferroeléctrica de acceso aleatorio (FeRAM) basada en ferroeléctricos de perovskita convencionales (por ejemplo, PZT) ha sido una de las memorias no volátiles comerciales (NVM) [1], aunque no se puede escalar y no es compatible con CMOS. La ferroelectricidad se observó ampliamente en una variedad de materiales diferentes, como las paredes aórticas porcinas [2], Sb 2 S 3 nanocables [3], GaFeO 3 película [4], poli-HfO dopado 2 películas [5], películas de hidroxiapatita nanocristalina [6] y LaAlO 3 -SrTiO 3 película [7]. Entre estos materiales, dopado-HfO 2 Las películas han atraído un interés especial para la aplicación NVM debido a su compatibilidad con el proceso CMOS. Pero la estructura policristalina es inevitable para generar ferroelectricidad en HfO 2 dopado , que trajo obstáculos para la aplicación del dispositivo a superar de la siguiente manera:1) es incompatible con el procesamiento de última puerta con respecto al balance térmico de 500 ° C requerido para formar fases cristalinas ortorrómbicas [8]; 2) el consumo de energía se induce a partir de una corriente de fuga no deseada a lo largo de los límites de los granos, que aumenta exponencialmente junto con la reducción del espesor ferroeléctrico. Recientemente, un estudio teórico propuso que la ferroelectricidad adicional en poli-HfO 2 gruesos (> 5 nm) puede provenir de las correlaciones de largo alcance en el ensamblaje de dipolos eléctricos creadas por las vacantes de oxígeno [9]. Se observó que el mecanismo de captura / eliminación de carga defectuosa produce un comportamiento similar al ferroeléctrico en un Al 2 amorfo de 5 nm de espesor O 3 para una memoria de varios estados, que, sin embargo, tiene una frecuencia de captura / eliminación de trampa muy baja (p. ej., ~ 500 Hz) [10].
En este trabajo, se demuestra un comportamiento similar al ferroeléctrico estable en un Al 2 amorfo de 3,6 nm de espesor O 3 película, donde la polarización conmutable ( P ) se propone que sea inducida por los dipolos de vacancia de oxígeno modulados por voltaje. El amorfo Al 2 O 3 La película posee las ventajas de una temperatura de proceso baja y una frecuencia de funcionamiento de hasta ~ GHz, lo que permite un transistor de efecto de campo no volátil (NVFET) de múltiples puertas con un paso de aleta a escala nanométrica. Al 2 O 3 Memoria NVFET con un programa de ancho de pulso de 100 ns / voltajes de borrado (P / E) y más de 10 6 Se demuestra la resistencia de los ciclos P / E. Los efectos de los electrodos y el espesor de la película en la P en Al 2 O 3 también se investigan los condensadores. Los dispositivos amorfos no volátiles muestran un futuro prometedor en las memorias VLSI.
Métodos
Amorfo Al 2 O 3 las películas se cultivaron sobre sustratos de Si (001), Ge (001) y TaN / Si mediante deposición de capa atómica (ALD). TMA y H 2 Se utilizaron vapores de O como precursores de Al y O, respectivamente. Durante la deposición, la temperatura del sustrato se mantuvo a 300 ° C. Se depositaron diferentes electrodos de metal superior, incluidos TaN / Ti, TaN y W, sobre Al 2 O 3 superficies por pulverización catódica reactiva. Se fabricaron condensadores con diferentes electrodos mediante modelado litográfico y grabado en seco. Se realizó un recocido térmico rápido (RTA) a 350 ° C durante 30 s. NVFET con TaN / Al 2 O 3 La pila de puertas se fabricó en Ge (001). Después de la formación de la puerta, las regiones de fuente / drenaje (S / D) fueron implantadas por BF 2 + con una dosis de 1 × 10 15 cm -2 y una energía de 20 keV, y luego se formaron electrodos metálicos de níquel S / D de 20 nm de espesor mediante un proceso de despegue. Las figuras 1a yb muestran los esquemas del Al 2 fabricado O 3 condensador y el canal p NVFET. Hay una capa interfacial (IL) entre el electrodo y el Al 2 O 3 película. Las figuras 1c yd muestran las imágenes de microscopio electrónico de transmisión de alta resolución (HRTEM) del TaN / Al 2 O 3 / Ge se apila con diferentes Al 2 amorfos O 3 espesores ( t AlO ) después de un RTA a 350 ° C.
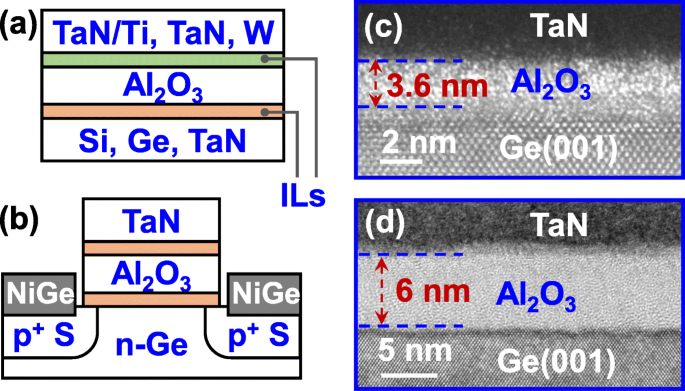
Esquemas del a fabricado Al 2 O 3 condensadores con varios electrodos y b Al 2 O 3 NVFET. c y d Imágenes HRTEM del TaN / Al 2 fabricado O 3 / Ge se apila con diferentes t AlO , mostrando el amorfo Al 2 O 3 películas después de un RTA a 350 ° C
Resultados y discusión
La Figura 2 muestra la P medida vs . voltaje V características para el amorfo Al 2 O 3 condensadores con diferentes t AlO y varios electrodos superior e inferior. La frecuencia de medición es de 1 kHz. Como se muestra en la Fig. 2a-c, con 3.6 nm fijos de t AlO , TaN / Al 2 O 3 / El condensador de Ge logra una mayor saturación P ( P sentado ) en comparación con los dispositivos con electrodos superiores TaN / Ti y W. El comportamiento de tipo ferroeléctrico está fuertemente correlacionado con interfaces, y se propone que la formación de TaAlO x IL entre TaN y Al 2 O 3 produce más vacantes de oxígeno, lo que contribuye a un cambio más fuerte P , en comparación con TiAlO x y WAlO x ILs. P-V Las curvas de la Fig. 2d indican que TaN / Al 2 O 3 / El condensador TaN tiene una P mucho más alta sentado en comparación con TaN / Al 2 O 3 / Ge, que se atribuye al hecho de que el doble TaAlO x Los IL proporcionan una mayor concentración de vacantes de oxígeno. Mientras P sentado es significativamente menor que con el electrodo inferior de Si (Fig. 2e), en comparación con el electrodo de Ge. Este resultado indica que Al 2 O 3 La calidad de la interfaz / Si es mejor, es decir, menos vacantes de oxígeno, en comparación con la del dispositivo basado en el sustrato de Ge. La figura 2f muestra el P-V curvas de un TaN / Al 2 O 3 (6 nm) / condensador de Ge, que exhibe un V más alto c y una P casi idéntica sentado en comparación con el del dispositivo con 3,6 nm de Al 2 O 3 película en la Fig. 2b. Cabe señalar que el motivo de la P no cerrada - V bucles se debe a que efectivamente existe una fuga. Se informó que la gran desviación en un campo eléctrico de cero siempre ocurría con un campo grande, y siempre desaparecía gradualmente con el rango de barrido más pequeño de V [11, 12].
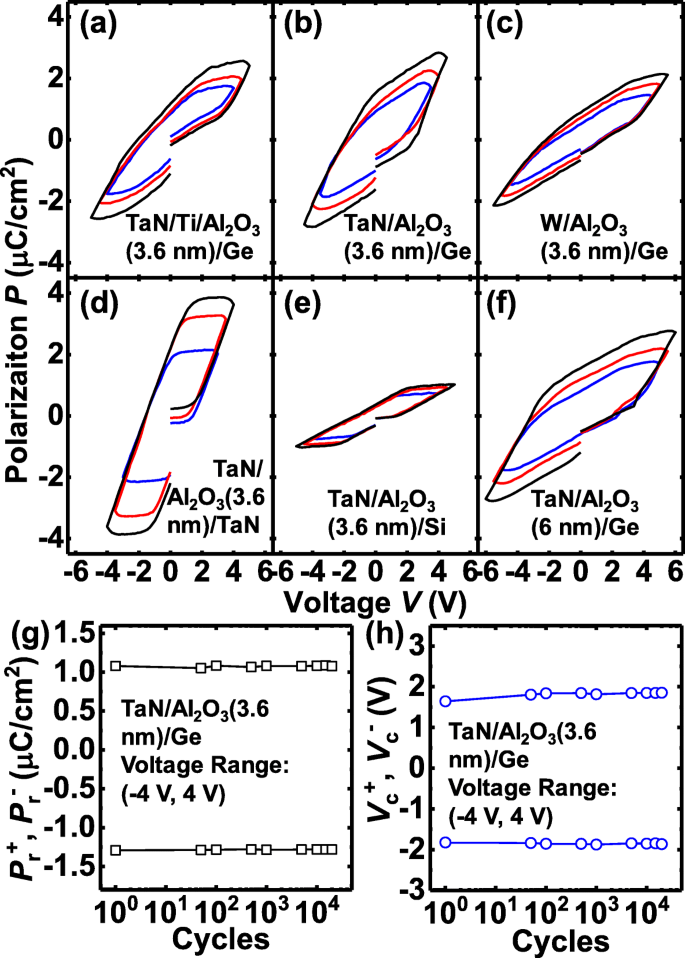
P medido frente a V características del Al 2 O 3 condensadores con diferentes electrodos. un , b y c mostrando la P - V curvas de TaN / Ti / Al 2 O 3 / Ge, TaN / Al 2 O 3 / Ge y W / Al 2 O 3 / Ge, respectivamente, con una t de 3,6 nm AlO . d y e mostrando que la P sentado se mejora (reduce) utilizando TaN (Si) como electrodo inferior en lugar de Ge. f TaN / Al 2 O 3 (6 nm) / El condensador de Ge tiene un V más alto c y una P similar sentado en comparación con el dispositivo de 3,6 nm de grosor en b . g y h Medidas de resistencia que no muestran degradación de P r y V c observado después de 10 4 ciclos de barrido para un TaN / Al 2 O 3 (3,6 nm) / condensador de Ge
Las figuras 2g yh muestran la evolución extraída del remanente positivo y negativo P ( P r ) y coercitivo V ( V c ) valores, respectivamente, superiores a 10 4 ciclos de barrido para un TaN / Al 2 O 3 / Condensador Ge. No se observa ningún efecto de despertar, impronta o fatiga. V c del dispositivo es ~ 1.8 V, lo que indica que el E en el Al 2 O 3 la película es de 4 ~ 6 MV / cm y en los IL puede superar los 8 MV / cm, que es lo suficientemente alta para impulsar las vacantes de oxígeno [13, 14]. P sentado de los dispositivos varía de 1 a 5 μC / cm 2 , correspondiente a una concentración de vacante de oxígeno razonable en el rango de 3 ~ 15 × 10 12 cm -2 asumiendo que tienen cargo de más dos.
El mecanismo subyacente del comportamiento ferroeléctrico asociado con las vacantes de oxígeno en Al 2 O 3 se discuten los dispositivos. La migración de las vacantes de oxígeno impulsadas por voltaje se ha demostrado ampliamente en dispositivos de memoria resistiva de acceso aleatorio [15, 16]. La Figura 3 muestra los esquemas de la P conmutable en TaN / Al 2 O 3 / Ge, que se origina en la segregación de las vacantes de oxígeno moduladas por voltaje y las cargas negativas para formar los dipolos eléctricos. Es razonable inferir que las vacantes de oxígeno móvil surgen principalmente de la formación de TaAlO x IL y se encuentran cerca de la interfaz superior en el estado inicial (Fig. 3a). Las figuras 3b yc indican cómo la P positiva y negativa se forman, respectivamente, con la modulación de la vacancia de oxígeno y los dipolos de carga negativa bajo el voltaje aplicado. Espectros de fotoelectrones de rayos X (XPS) de Al 2 O 3 / Ge y (Ti, TaN y W) / Al 2 O 3 / Las muestras de Ge se miden y se muestran en la Fig. 4). Para todo el metal / Al 2 O 3 / Ge muestras, hay un óxido metálico IL formado entre el metal y el Al 2 O 3 , que se propone que sean el reservorio de iones de oxígeno y las vacantes, lo que es consistente con la Ref. [17].
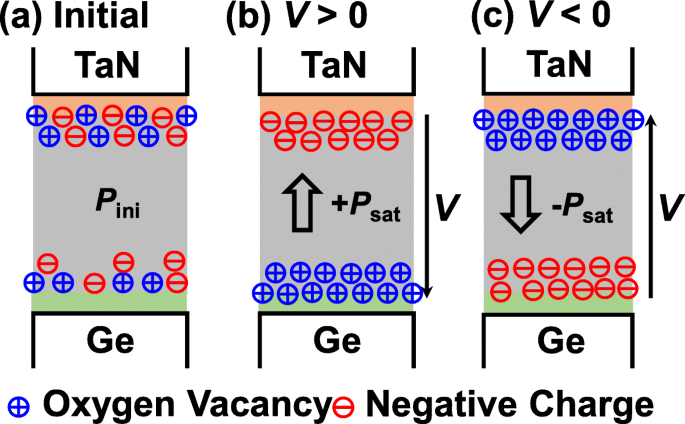
Esquemas del mecanismo para el comportamiento de tipo ferroeléctrico en Al 2 O 3 condensadores. P conmutable se debe a la migración de las vacantes de oxígeno y las cargas negativas para formar dipolos

Espectros XPS de nivel central de a Al 2 O 3 / Ge, b TaN / Al 2 O 3 / Ge, c Ti / Al 2 O 3 / Ge y d W / Al 2 O 3 / Ge muestras
Caracterizar el rendimiento eléctrico de Al 2 O 3 NVFET como NVM, la operación de programa (borrado) se logra aplicando pulsos de voltaje positivo (negativo) a la puerta, para aumentar (disminuir) su voltaje de umbral ( V TH ). La Figura 5a muestra cómo las características de transferencia de la región lineal del Al 2 O 3 Cambio de NVFET relativo al I inicial DS - V GS curva medida con ± 4 V programe (borre) voltajes con ancho de pulso de 100 ns. Aquí, V TH se define como una V GS a 100 nA⋅W / L, y MW se define como el cambio máximo en V TH . El Al 2 O 3 NVFET obtiene un MW de 0,44 V, aunque Al 2 amorfo O 3 la película tiene una P más pequeña r que el HfO dopado informado 2 películas [5, 8]. Se observa que la alta frecuencia operativa de hasta 10 MHz de Al 2 O 3 Memoria NVFET, que es indicativa de esa P conmutable en Al 2 O 3 se origina de la migración de la vacante de oxígeno impulsada por voltaje para formar dipolos, no de defectos de captura / eliminación de cargas. Se aplicaron programas alternos y pulsos de borrado al Al 2 O 3 dispositivos para estudiar más a fondo la resistencia del dispositivo. La Figura 5b muestra las gráficas de V TH vs . Número de ciclo P / E, lo que sugiere que se puede mantener un MW estable sin una degradación significativa sobre 10 6 Ciclos P / E para un Al 2 de 3,6 nm de espesor O 3 NVFET.
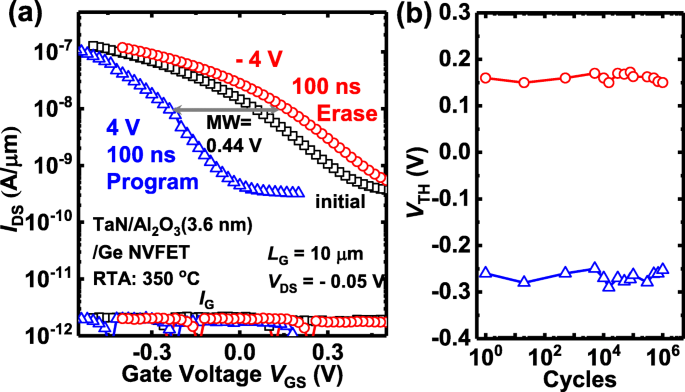
un Medido I DS - V GS curvas de un Al 2 de 3,6 nm de espesor O 3 NVFET para los estados inicial y dos de polarización. Se obtiene un MW de 0,44 V. b La medición de la resistencia demuestra que no se observa degradación de MW después de 10 6 Ciclos P / E
En particular, el comportamiento de tipo ferroeléctrico observado en el Al 2 amorfo O 3 Los dispositivos pueden extenderse a los óxidos amorfos universales, por ejemplo, óxido de hafnio (HfO 2 ) y óxido de circonio (ZrO 2 ).
Conclusiones
El comportamiento estable de tipo ferroeléctrico se realiza por primera vez en condensadores con un delgado Al 2 amorfo O 3 aislante. P conmutable en Al 2 amorfo O 3 condensadores se demuestra por P-V bucles y prueba NVFET. Se propone que el comportamiento de tipo ferroeléctrico se origina en las vacantes de oxígeno de la interfaz y los dipolos de iones. El Al 2 de 3,6 nm de espesor O 3 NVFET alcanza un MW de 0,44 V y más de 10 6 resistencia del ciclo por debajo de ± 4 V a 100 ns condición P / E. Con todo, este trabajo abrió un nuevo mundo para los dispositivos ferroeléctricos de óxido amorfo, que son prometedores para NVFET de múltiples puertas (en forma de aleta, nanocables o nanohojas) con paso de aleta potencialmente nanoescalado en sistemas VLSI.
Disponibilidad de datos y materiales
Los conjuntos de datos que respaldan las conclusiones de este artículo se incluyen en el artículo.
Abreviaturas
- Al 2 O 3 :
-
Óxido de aluminio
- ALD:
-
Deposición de la capa atómica
- BF 2 + :
-
Ión de fluoruro de boro
- E c :
-
Campo eléctrico coercitivo
- Ge:
-
Germanio
- GeO x :
-
Óxido de germanio
- HRTEM:
-
Microscopio electrónico de transmisión de alta resolución
- I DS :
-
Drenar corriente
- MOSFET:
-
Transistores de efecto de campo semiconductores de óxido metálico
- MW:
-
Ventana de memoria
- Ni:
-
Níquel
- NVFET:
-
Transistor de efecto de campo no volátil
- P r :
-
Polarización remanente
- P sentado :
-
Polarización de saturación
- RTA:
-
Recocido térmico reembolsado
- TaAlO x :
-
Óxido de tantalio y aluminio
- t AlO :
-
Espesor de óxido de aluminio
- TaN:
-
Nitruro de tantalio
- V GS :
-
Voltaje de puerta
- V TH :
-
Voltaje umbral
- XPS:
-
Espectros de fotoelectrones de rayos X
Nanomateriales
- Una memoria más inteligente para dispositivos IoT
- La familia de memorias no volátiles aumenta la densidad
- Comprobador de velocidad de obturación para cámaras de película
- Película de PC antivaho para visores, lentes y gafas
- Dielectroforesis mejorada por calentamiento para película alineada de nanotubos de carbono de pared simple de densidad ultra alta
- Nanocables de silicio amorfo cultivados en película de óxido de silicio mediante recocido
- Microesferas de carbono magnéticas como adsorbente reutilizable para la eliminación de sulfonamidas del agua
- Un enfoque simple para sintetizar puntos cuánticos de carbono fluorescente de aguas residuales de tofu
- Película a base de epoxi Solvay para preimpregnados
- Película de sensores para la industria aeroespacial
- Nuevo método crea memoria de computadora a partir de óxido de titanio



