Optimización de contactos óhmicos para nanocables p-GaAs
Resumen
El rendimiento de los contactos óhmicos aplicados a los nanocables semiconductores (NW) es un aspecto importante para permitir su uso en dispositivos electrónicos u optoelectrónicos. Debido a las pequeñas dimensiones y la orientación específica de la superficie de los NW, la tecnología de procesamiento estándar ampliamente desarrollada para heteroestructuras planas no se puede aplicar directamente. Aquí, informamos sobre la fabricación y optimización de contactos óhmicos de Pt / Ti / Pt / Au para nanocables de GaAs de tipo p cultivados por epitaxia de haz molecular. Los dispositivos se caracterizaron por mediciones de corriente-voltaje (IV). La linealidad de las curvas de características IV de los nanocables individuales se optimizó ajustando la disposición de las capas de metal de contacto, el tratamiento de la superficie antes de la evaporación del metal y el recocido térmico posterior al procesamiento. Nuestros resultados revelan que la resistencia de contacto disminuye notablemente cuando se deposita una capa de Pt en el nanoalambre de GaAs antes del diseño multicapa tradicional de Ti / Pt / Au utilizado para los GaAs planos de tipo p. Estos hallazgos se explican por una calidad mejorada de la interfaz metal-GaAs, que se evidenció mediante mediciones de difracción de rayos X de incidencia rasante en películas delgadas metálicas similares depositadas sobre sustratos de GaAs (110). En particular, mostramos que el Ti exhibe un bajo grado de cristalinidad cuando se deposita sobre la superficie de GaAs (110), lo que afecta directamente la resistencia de contacto de los dispositivos NW. La deposición de una capa delgada de Pt en los NW antes de Ti / Pt / Au da como resultado una disminución del 95% en la resistencia eléctrica total de los NW de GaAs dopados con Be, que se asocia con un mayor grado de cristalinidad del Pt que el Ti cuando se deposita directamente sobre GaAs (110).
Introducción
Un paso importante en la fabricación de dispositivos optoelectrónicos y electrónicos semiconductores es obtener contactos óhmicos confiables y de alta calidad en la interfaz metal-semiconductor. Para ello, el GaAs es un material importante y ampliamente utilizado en aplicaciones tecnológicas como dispositivos láser, células solares y fotodetectores. Por lo tanto, la fabricación de contacto óhmico con capas de GaAs dopadas de tipo p y tipo n ha sido objeto de un gran número de investigaciones [1]. En términos generales, la fabricación de contactos óhmicos a materiales semiconductores incluye cuatro pasos:(1) eliminación del óxido nativo de la superficie, (2) pasivación de los estados de la superficie en la interfaz semiconductor-metal, (3) deposición de capas metálicas que actúan como el contactos eléctricos y (4) recocido térmico [2, 3]. Partiendo de la selección de metales que proporcionan baja resistencia al contacto y excelente estabilidad térmica, las aleaciones a base de Au se han explotado ampliamente, específicamente para GaAs tipo p en forma de Au / Zn / Au [1, 3, 4] y Ti / Capas de Pt / Au [1, 5]. Por otro lado, los nanocables (NW) semiconductores III-V han surgido como una clase más nueva de materiales a nanoescala prometedores para su aplicación como LED [6, 7], células solares [8, 9] y fotodetectores [10], y estos han activado desarrollos específicos sobre el procesamiento de dispositivos.
La mayoría de la tecnología reportada en la literatura para la fabricación de contactos óhmicos se desarrolló para películas delgadas de GaAs (100) y estructuras a granel, mientras que el crecimiento autocatalizado de GaAs NWs produce (110) orientación de la superficie en las paredes laterales [11,12,13, 14,15]. Las diferentes orientaciones de la superficie exhiben diferentes estados electrónicos [16] que afectan las propiedades de la interfaz y las alturas de la barrera Schottky [17, 18, 19]. Además, la orientación de la superficie puede afectar la dinámica de cristalización de las películas de metal depositadas. Se informaron previamente buenos contactos óhmicos con p-GaAs NWs [20,21,22,23,24,25,26,27,28] mediante el uso de una variación de tratamientos químicos para eliminar el óxido nativo, la pasivación de la superficie y diferentes multicapas metálicas depositado en los NW. Luego, se informó que el uso de contactos eléctricos de Pt / Ti / Pt / Au para películas delgadas de GaAs tipo p producía una resistividad de contacto óhmica baja incluso para concentraciones moderadas de dopantes debido a la baja altura de la barrera Schottky de Pt / GaAs [29]. Además, se encontró que el Pt era térmicamente estable con pequeñas velocidades de reacción a GaAs para tratamientos térmicos con temperaturas que oscilan entre 300 y 500 ° C [29, 30, 31]. La multicapa metálica de Pt / Ti / Pt / Au es el contacto óhmico reportado con mayor frecuencia [20, 23, 25, 26, 28] con los NW de p-GaAs. Sin embargo, una comprensión más completa de las propiedades de los metales en la formación de contactos óhmicos es la clave para mejorar aún más la calidad del contacto eléctrico en los dispositivos a nanoescala. Debido a la amplia gama de técnicas de crecimiento de NW y concentraciones de dopantes en p-GaAs NWs reportadas recientemente, sería inviable hacer una comparación de las resistencias de contacto, cuando están disponibles. En cambio, una investigación exhaustiva de diferentes rutas de fabricación de contactos en el mismo conjunto de muestras NW sería más adecuada para excluir el efecto de las propiedades NW.
Aquí, abordamos los efectos de diferentes contactos eléctricos basados en Pt y Ti y tratamientos superficiales antes de la evaporación del metal en las características generales de corriente-voltaje (IV) de los NW de GaAs Be-dopados autocatalizados cultivados en sustratos de Si [11, 32 ]. Analizamos los cambios en la resistencia total de los canales NW basados en la investigación estructural por difracción de rayos X de películas delgadas de Ti, Pt y Pt / Ti depositadas sobre sustratos de GaAs (110). Mostramos que una alta resistencia de contacto se asocia con un bajo grado de cristalinidad de Ti cuando se deposita directamente sobre GaAs (110), mientras que los contactos eléctricos de Pt / Ti / Pt / Au dan como resultado una disminución notable de la resistencia de contacto, que se atribuye a la mejora de la calidad de la capa metálica observada en las primeras capas de Pt / Ti depositadas sobre la superficie de GaAs (110).
Materiales y métodos
Crecimiento de nanocables
Los NW de GaAs dopados con Be autocatalizados se cultivaron mediante epitaxia de haz molecular de fuente sólida (MBE) sobre patrones de óxido sin litografía fabricados en sustratos de p-Si (111) mediante epitaxia de gotitas y oxidación espontánea [32]. La temperatura de crecimiento NW fue de 640 ° C, determinada por pirómetro, y se utilizó un flujo de Ga correspondiente a una tasa de crecimiento planar de 0,3 μm / h en GaAs (100). Una humectación con Ga de 60 s precedió al crecimiento NW, que se inició proporcionando As 2 con una relación de presión equivalente del haz V / III de 9 y un flujo Be correspondiente a 2,0 × 10 19 cm −3 concentración de dopaje de tipo p; esto se determinó a partir del crecimiento de muestras de calibración planas con Be-dopado con GaAs (100) mediante mediciones de Hall a temperatura ambiente. La duración del crecimiento fue de 60 min. En las Refs. [11, 32, 33]. En resumen, los NW están compuestos de GaAs de mezcla de zinc puro con la formación de unos pocos planos gemelos [33]. Los NW tienen forma hexagonal con paredes laterales compuestas exclusivamente de (110) facetas orientadas, como se determinó previamente a partir del análisis estructural de los NW Be-dopados [33] y se confirmó en los NW de GaAs no dopados cultivados en condiciones similares [12].
Fabricación y caracterización de contactos
Los NW se transfirieron mecánicamente a un sustrato de p-GaAs (100) cubierto con un SiO 2 de 200 nm de espesor. capa, que fue prediseñada por fotolitografía y evaporación por haz de electrones de almohadillas de Ti / Au para la caracterización del transporte. La posición de los cables transferidos sobre el sustrato se identificó mediante imágenes de microscopía electrónica de barrido (SEM) de bajo aumento. Se aplicó una capa protectora de haz de electrones positivo sobre el sustrato y se expuso con un haz de electrones en las áreas de contacto eléctrico. La resistencia se desarrolló en una solución MIBK:IPA después de la exposición al haz de electrones y posiblemente seguida de un tratamiento con plasma de oxígeno para eliminar la resistencia residual de las paredes laterales NW, como se describe en la Tabla 1. Los efectos del tratamiento con plasma de oxígeno en el rendimiento del dispositivo serán luego discutido en el texto. Antes de la evaporación del metal de las capas de contacto, las muestras se trataron químicamente para eliminar el óxido nativo y pasivar las paredes laterales NW expuestas, como se describe más adelante en el texto. El despegue se realizó sumergiendo la muestra en acetona caliente, enjuagando con IPA y secando con nitrógeno.
Hemos desarrollado cinco procesos distintos que combinan diferentes tratamientos superficiales de las paredes laterales NW expuestas con diferentes multicapas metálicas utilizadas como contactos eléctricos. Esto nos permitió determinar las contribuciones individuales de cada parámetro en la resistencia de contacto resultante cuando se aplica a los NW de GaAs de tipo p. Para la eliminación de óxido nativo de la superficie, usamos un 2,8% NH 4 OH o HCl al 3,7% diluido en H 2 O seguido de H 2 O enjuague. Para la pasivación de la superficie, utilizamos una solución al 15% de (NH 4 ) 2 S x diluido en H 2 O (calentado a 45 ° C) seguido de H 2 O enjuague. Las multicapas metálicas se depositaron usando evaporación por haz de electrones y eran Ti / Pt / Au (20/20/200 nm) o Pt / Ti / Pt / Au (5/10/10/200 nm). Se utilizó un recocido térmico rápido (RTA) de 400 ° C durante 30 s para la multicapa de Pt / Ti / Pt / Au. Los procesos utilizados para cada muestra se especifican en la Tabla 1. Para cada muestra, se fabricaron 4 contactos eléctricos espaciados uniformemente a lo largo del eje NW. En este trabajo, restringimos el análisis de IV a los pares de contactos ubicados en la región central del NO. Los datos de IV se obtuvieron a temperatura ambiente utilizando una estación de sonda Keysight.
Investigación estructural por difracción de rayos X de incidencia rasante
Para investigar las propiedades estructurales de los contactos eléctricos en los NW, se midieron los patrones de difracción de rayos X de incidencia rasante (GIXRD) a partir de películas delgadas de Ti, Pt y Pt / Ti de referencia evaporadas en sustratos de GaAs (110) sin dopar. Preparamos las muestras de película delgada descritas en la Tabla 2 utilizando la eliminación de óxido nativo por HCl:H 2 O y pasivación superficial por (NH 4 ) 2 S x de la misma forma que para los dispositivos NW. El pequeño ángulo de incidencia de los rayos X utilizados en GIXRD nos permite analizar películas metálicas del mismo espesor que las utilizadas en los contactos NW debido a la pequeña profundidad de penetración. Los patrones de GIXRD se midieron utilizando radiación de Cu Kα con una longitud de onda de 1,54 Å y un ángulo de incidencia de ω =0,75 ° en relación con la superficie de la muestra. Las posiciones de los picos de difracción se indexan de acuerdo con los archivos ICDD n. ° 00-044-1294 y n. ° 00-004-0802 para Ti de empaque hexagonal cerrado (HCP) y Pt cúbico centrado en la cara (FCC), respectivamente, y se corrigen teniendo en cuenta el efecto de refracción de los rayos X en experimentos GIXRD como se describe en la Ref. [34].
Resultados y discusión
La Figura 1a muestra las características de IV para las muestras P1 a P5, y la Figura 1b una imagen SEM de un GaAs NW Be-dopado con contactos eléctricos usados para la caracterización del transporte. La forma casi simétrica y no lineal de los IV para P1 a P4 en la Fig. 1a indica que los contactos son de tipo Schottky con alturas de barrera similares para cada contacto [35]. La no linealidad de la IV para la muestra P1 muestra evidentemente que el proceso estándar de p-GaAs como en P1 no produce contactos óhmicos como es el caso de las películas delgadas planas de GaAs. Por lo general, en los NW de GaAs dopados, se utiliza la eliminación de óxido de HCl, posiblemente seguida de (NH 4 ) 2 S x pasivación de la superficie antes de la evaporación del metal para la formación de contacto óhmico [20, 21, 36, 37] en lugar de NH 4 OH. Además, el tratamiento con plasma de oxígeno de la superficie expuesta del NO se ha utilizado anteriormente para eliminar la capa protectora residual de las paredes laterales del NO [36, 38]. Sin embargo, como efecto secundario, este proceso puede inducir defectos superficiales en los GaAs, como las vacantes de As, lo que da como resultado trampas de tipo donante que son responsables de la compensación del portador y, por lo tanto, aumentan el ancho de la capa de agotamiento [5].
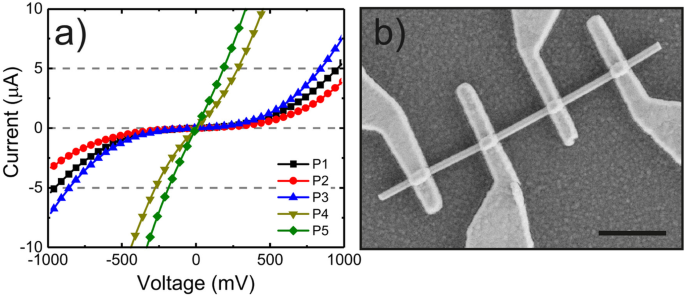
un IV de NW de GaAs Be-dopados con contactos eléctricos fabricados utilizando los procesos P1-P5 como se describe en la Tabla 1. b Imagen SEM de un GaAs NW Be-dopado representativo con cuatro contactos eléctricos espaciados uniformemente. La barra de escala es de 1 μm
Para evaluar el efecto del tratamiento con plasma de oxígeno sobre la resistencia de contacto de p-GaAs NWs, comparamos el IV de una muestra con (P2) y sin (P3) limpieza con plasma de oxígeno antes del tratamiento superficial con HCl y (NH 4 ) 2 S x en la Fig. 1a. P2 produce el peor rendimiento de IV (definido como el valor de corriente eléctrica para el mismo voltaje aplicado) en todas las muestras, pero la muestra P3 a su vez exhibe un mejor rendimiento de IV que el proceso estándar de p-GaAs P1, y el plasma de oxígeno limpiado P2. Esto implica dos resultados significativos:(i) el efecto del tratamiento con plasma de oxígeno es perjudicial sobre la resistencia por contacto, y (ii) el P3 con eliminación de óxido de HCl combinado con (NH 4 ) 2 S x La pasivación de la superficie se suma a una altura de barrera Schottky más baja de la interfaz metal-semiconductor en comparación con P1.
El rendimiento de IV y el carácter óhmico (evaluados cualitativamente por la linealidad de IV) se mejoraron fuertemente en P4 en comparación con P3 al agregar una capa de Pt de 5 nm debajo de la multicapa de Ti / Pt / Au, como puede verse en la Fig. 1a. La resistencia de contacto se reduce aún más en P5 después de RTA 30 sa 400 ° C, logrando un comportamiento IV lineal y un rendimiento IV mejorado en comparación con P4.
Para cuantificar el efecto de los parámetros de procesamiento sobre la resistencia de contacto de las muestras P1-P5 (tratamientos químicos, multicapa metálica), mostramos en la Fig. 2a los IV de P1-P5 usando un rango de sesgo menor; en este caso, los IV presentan un comportamiento lineal y se rigen principalmente por la resistencia de contacto [35]. La resistencia total del canal (contactos + NW) en el rango de 100 mV de la Fig. 2a se calculó a partir de un ajuste lineal de la curva de características IV, y los resultados se muestran en la Fig. 2b. Dado que los diámetros de todos los NW investigados son similares, y sólo hay una pequeña variación de cable a cable en la concentración de dopante, como hemos informado anteriormente [33], cualquier cambio de la resistencia total se atribuyó a la resistencia de contacto. La mayor resistencia en P2 en comparación con P1 y P3 confirma el efecto perjudicial del tratamiento con plasma de oxígeno a partir del análisis cualitativo de las IV en la Fig. 1a. Un resultado notable es la disminución en la resistencia total de 1400 kΩ en P3 a 72 kΩ en P4 y una disminución adicional a 40 kΩ después de RTA en P5, lograda al depositar una capa adicional de Pt antes de la multicapa Ti / Pt / Au utilizada en muestras P1 – P3.
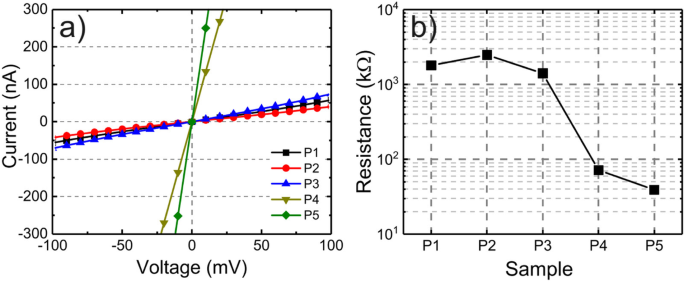
un IV de P1 a P5 en el rango de voltaje aplicado de 100 mV. b Resistencia total del canal de P1 – P5 obtenida del ajuste lineal de los IV en a
Se requiere una comprensión más completa de la microestructura de la interfaz metal-semiconductor después de la fabricación del contacto para establecer una correlación de los cambios en la resistencia del contacto observados en las muestras P1-P5. El uso de Ti y Pt en la fabricación de contactos óhmicos para GaAs se ha informado previamente [39, 40], y las propiedades estructurales de las películas delgadas de Ti y Pt se evaporaron a la superficie de GaAs (100) [41] y sustratos de vidrio amorfo [42, 43 ] también han sido analizados. Sin embargo, no se encontraron estudios tan detallados para la superficie de GaAs (110). Se espera que la diferente orientación de la superficie influya en la dinámica de cristalización de las películas delgadas de Ti y Pt. Además, la pasivación química de la superficie por (NH 4 ) 2 S x podría influir aún más en las películas delgadas resultantes. El grado de cristalización de películas delgadas de Pt (5 nm), Ti (20 nm) y Pt / Ti (5/20 nm) depositadas sobre sustrato de GaAs (110) sin dopar fue investigado por GIXRD para obtener información de las propiedades estructurales. de las primeras capas metálicas en contacto con los NO en P1 – P5. Antes de la evaporación del metal, los sustratos de GaAs (110) pasaron por la eliminación de óxido nativo por HCl:H 2 O y el (NH 4 ) 2 S x pasos de pasivación de superficie como las muestras NW P3 – P5. Los detalles de los tratamientos superficiales y las películas delgadas metálicas evaporadas sobre el sustrato de GaAs (110) se resumen en la Tabla 2.
Los patrones GIXRD de las muestras S1-S4 se muestran en el rango de ángulo de difracción de 30 a 60 ° en la Fig. 3a y en el rango de 60 a 90 ° en la Fig. 3b. Los patrones de difracción en la Fig. 3 se desplazan verticalmente y se separan en dos rangos de ángulos de difracción para proporcionar una mejor escala para la visualización. Primero, nos enfocamos en el efecto de (NH 4 ) 2 S x pasivación superficial sobre el grado de cristalinidad de las películas de Ti evaporadas sobre el sustrato de GaAs (110) comparando las muestras S1 y S2. En la Fig. 3a, observamos picos superpuestos de Ti (002) y Ti (101) de baja intensidad centrados en 38,4 y 40,2 °, respectivamente, tanto para S1 como para S2. Además, también se observa un pico de Ti (102) significativamente más amplio centrado en 53,0 ° para ambas muestras, lo que sugiere un carácter amorfo. El pico de Ti (103) centrado en 70,6 ° en la Fig. 3b solo se observa para S1, que es la única disparidad significativa entre las muestras. En general, las bajas intensidades y los picos anchos de S1 y S2 indican una escasa cristalinidad de las películas de Ti cuando se depositan sobre la superficie de GaAs (110) después de la eliminación del óxido de HCl e independientemente del uso de (NH 4 ) 2 S x pasivación. En el caso de S3, para el cual se depositó Pt sobre sustrato de GaAs (110) con el mismo tratamiento superficial que en S2, observamos Pt (111), Pt (200), Pt (220), Pt (311) mucho más pronunciados, y picos de difracción de Pt (222) centrados en 39,8 °, 46,3 °, 67,5 °, 81,3 ° y 85,7 °, respectivamente. Esto indica que la película de Pt en S3 exhibe un mayor grado de cristalinidad en comparación con las muestras de Ti. Lo mismo se aplica a S4 que muestra firmas de difracción de Pt similares a las de S3 en la Fig. 3a, b. Los picos anchos y asimétricos entre 35 ° -45 °, 65 ° -75 ° y 75 ° -90 ° para S4 se forman debido a la superposición de Ti (002) -Ti (101) -Pt (111), Ti ( 103) -Pt (220) y Ti (004) -Pt (311) -Pt (222) picos de difracción, respectivamente. Una comparación cualitativa de los patrones GIXRD de S2, S3 y S4 implica que el grado de cristalinidad de Ti en S4 está al menos en el mismo nivel que en S1. El pico de Ti (103) a 70,6 ° se observa como un hombro claro en el pico de Pt (220) en la Figura 3b y el pico de Ti (102) a 53,0 ° en la Figura 3a está presente con baja intensidad pero con un ancho de línea estrecho en S4. mientras que exhibe un pico muy amplio, similar a amorfo, en S1 y S2. Este resultado sugiere un grado mejorado de cristalinidad del Ti cuando se deposita sobre Pt en lugar de la superficie de GaAs (110), que a continuación se correlacionará directamente con las propiedades de los contactos eléctricos descritas en las Figs. 1 y 2.
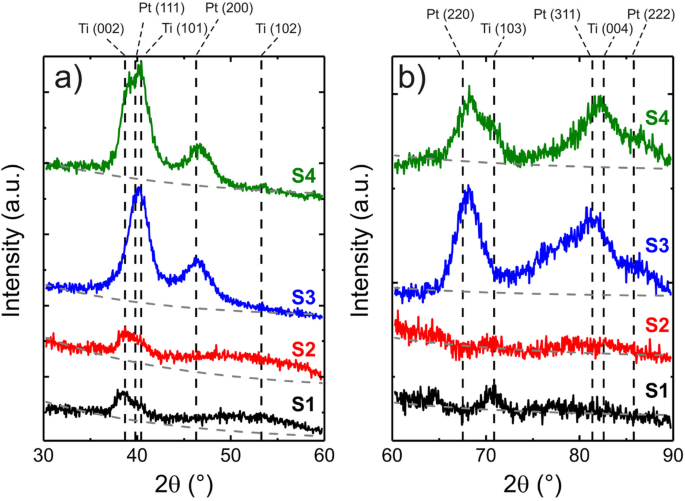
Patrones GIXRD de las muestras S1-S4 de a Rango de ángulo de difracción de 30 a 60 ° y ( b ) Rango de 60 a 90 °. Las líneas grises discontinuas representan líneas de base de desintegración exponencial que se originan a partir de la dispersión difusa de rayos X. Las líneas negras punteadas verticales corresponden a los diferentes planos de difracción de Ti y Pt, etiquetados en la parte superior de a y b
El análisis GIXRD de las capas metálicas en S1-S4 nos permite correlacionar el grado de cristalinidad de Ti y Pt depositados en el sustrato de GaAs (110) y la resistencia total resulta de P1-P5 en la Fig. 2b. Es importante destacar que en este trabajo basamos nuestras correlaciones de los cambios en la resistencia total de P1 – P5 principalmente en los datos de GIXRD obtenidos de S1 – S4. Suponemos que otros factores, como la calidad de la interfaz metal-NW debido a la geometría hexagonal de las paredes laterales del NW, tienen contribuciones insignificantes en los cambios de resistencia total observados en P1-P5. El (NH 4 ) 2 S x La pasivación de la superficie tiene un efecto beneficioso sobre las propiedades de la interfaz GaAs-metal, como parece al comparar el IV y la resistencia total de las muestras P1 y P3, pero con un bajo grado de cristalinidad de la película de Ti cuando se deposita directamente sobre la superficie de GaAs (110). , como se observa en S1 y S2. Esto podría ser el resultado de una reacción del azufre con el Ti desbordado. Además, se ha informado que el Ti es altamente reactivo con las impurezas restantes en la cámara de evaporación durante la deposición del metal [41], formando capas adicionales entre el metal / GaAs y por lo tanto aumentando la resistencia de contacto [5]. Como se discutió anteriormente, el aumento en la resistencia de contacto en P2 se atribuyó a los posibles daños superficiales causados por la limpieza con plasma de oxígeno. La adición de una fina capa de Pt entre la superficie de Ti y GaAs (110) como en S4 da como resultado un mayor grado de cristalinidad de la película de Ti en comparación con S1 y S2. Este resultado puede correlacionarse con la disminución de la resistencia total del canal de 1400 kΩ en P3 a 72 kΩ en P4 que se asocia a una disminución de la resistencia de contacto. El RTA reduce aún más la resistencia total del canal a 40 kΩ en P5 además del aumento del carácter óhmico del IV que se muestra en la Fig. 2a. Este resultado indica que no se producen reacciones perjudiciales entre la superficie de Pt y GaAs en la temperatura de recocido y el tiempo utilizado [29, 30, 31].
Conclusiones
La influencia del tratamiento químico de la superficie antes de la evaporación del metal y la formación de contactos óhmicos con los NW de GaAs autocatalizados con Be-dopados se investigó correlacionando la caracterización del transporte de NW individuales y el análisis estructural de películas delgadas de Ti, Pt y Pt / Ti depositadas en Sustratos de GaAs. Demostramos que el Ti exhibe un bajo grado de cristalinidad cuando se deposita sobre la superficie de GaAs (110), lo que afecta directamente la resistencia de contacto de los dispositivos NW. La deposición de una capa delgada de Pt en los NW antes de Ti / Pt / Au da como resultado una disminución del 95% en la resistencia eléctrica total de los NW de GaAs dopados con Be, que se asocia con un mayor grado de cristalinidad del Pt que el Ti cuando se deposita directamente sobre GaAs (110). Además, mostramos que el recocido térmico de las capas metálicas disminuye aún más la resistencia de contacto. Estos hallazgos son de importancia tecnológica al diseñar contactos óhmicos para dispositivos basados en GaAs NW y muestran las contribuciones individuales de cada paso de procesamiento, descrito en la Tabla 1, en la resistencia total y el carácter óhmico de los dispositivos NW. Para mejorar aún más el rendimiento del dispositivo, sería necesaria una optimización sistemática de los parámetros de cada paso individual. En particular, mostramos que la interfaz metal-semiconductor en las paredes laterales NW juega un papel importante en el rendimiento del dispositivo y abre el camino a nuevas investigaciones del proceso de cristalización de películas delgadas metálicas depositadas en diferentes orientaciones de superficie de materiales semiconductores III-V.
Disponibilidad de datos y materiales
Los conjuntos de datos que respaldan las conclusiones de este estudio se incluyen en el artículo.
Abreviaturas
- FCC:
-
Cúbico centrado en la cara
- GIXRD:
-
Difracción de rayos X de incidencia rasante
- HCP:
-
Envasado hexagonal cerrado
- IV:
-
Corriente-voltaje
- NW:
-
Nanocable
- RTA:
-
Recocido térmico rápido
- SEM:
-
Microscopía electrónica de barrido
Nanomateriales
- Contactos de tungsteno para electrodomésticos
- Cambiar diseño de contacto
- Póngase en contacto con "Rebote"
- Relés de retardo
- Funciones de lógica digital
- Lentes de contacto
- Los científicos de materiales enseñan a los nanocables cómo 'bailar'
- Optimización de película fina altamente reflectante para micro-LED de ángulo completo
- Transistores de efecto de campo de nanoflake SnSe multicapa con contactos au óhmicos de baja resistencia
- Matrices de nanopilares de GaAs con tapa de Au fabricadas mediante grabado químico asistido por metal
- Nanocables de silicio amorfo cultivados en película de óxido de silicio mediante recocido



