Investigación de propiedades conductoras dependientes del tamaño en nanocables de Si individuales
Resumen
Las matrices ordenadas periódicamente de nanocables de Si alineados verticalmente (Si NW) se fabrican con éxito mediante litografía de nanoesferas combinada con grabado químico asistido por metal. Al ajustar el tiempo de grabado, tanto el diámetro como la longitud de los nanocables pueden controlarse bien. Las propiedades conductoras de tales Si NW y, en particular, su dependencia del tamaño se investigan mediante microscopía de fuerza atómica conductiva (CAFM) en nanocables individuales. Los resultados indican que la conductancia de Si NW es muy relevante para su diámetro y longitud. Los Si NW con diámetros más pequeños y longitudes más cortas exhiben mejores propiedades conductoras. Junto con la caracterización de la curva I – V, se supone un posible mecanismo con el punto de vista de la altura de la barrera Schottky dependiente del tamaño, que se verifica además mediante las mediciones de microscopía de fuerza electrostática (EFM). Este estudio también sugiere que CAFM puede actuar como un medio eficaz para explorar la dependencia del tamaño (u otros parámetros) de las propiedades conductoras de las nanoestructuras individuales, lo que debería ser esencial tanto para la optimización de la fabricación como para las posibles aplicaciones de las nanoestructuras.
Introducción
Los nanocables de silicio (Si NW) han ganado aplicaciones prometedoras en los campos electrónico, fotónico, optoelectrónico y muchos otros debido a su alta relación de aspecto y propiedades eléctricas, termoeléctricas y fotoeléctricas únicas, así como la compatibilidad con la tecnología de silicio tradicional [1,2,3 , 4,5]. En las últimas décadas, las investigaciones de Si NW se han centrado principalmente en las mejoras del crecimiento y la medición de la propiedad. Se han desarrollado muchos métodos para preparar Si NW, incluidos los métodos de abajo hacia arriba, como el método de vapor-líquido-sólido, la deposición de vapor químico y la epitaxia de haz molecular [6,7,8,9,10] y los enfoques de arriba hacia abajo que utilizan electrones. -litografía en haz, grabado con iones reactivos o grabado químico asistido por metal [11,12,13,14,15,16]. Entre estos métodos, la litografía de nanoesferas (NSL) combinada con el grabado químico asistido por metal (MACE) se ha adoptado intensivamente para fabricar matrices ordenadas de gran área de Si NW alineadas verticalmente por su simplicidad, bajo costo y versatilidad [15,16,17 , 18,19,20,21,22,23]. Los Si NW conseguidos por MACE suelen tener superficies muy rugosas e incluso porosas [18,19,20,21], lo que hace que tengan una gran superficie específica y excelentes propiedades, lo que genera grandes potenciales de aplicación en biosensores, dispositivos termoeléctricos, litio. -baterías de iones, células solares, etc. [22,23,24]. Para realizar esas aplicaciones, es esencial comprender bien sus propiedades eléctricas. Hoy en día, a menudo se han aplicado dos tipos de métodos para investigar las propiedades eléctricas de los nanocables. Uno se lleva a cabo mediante métodos macroscópicos ordinarios, que es relativamente fácil de hacer, pero solo puede proporcionar resultados promediados en un gran conjunto de nanocables [24, 25]. El otro se realiza en nanocables individuales con dispositivos de nanocables únicos fabricados de forma especial [21, 26, 27, 28], lo que podría excluir la influencia de la falta de homogeneidad del tamaño, pero no es fácil de lograr, especialmente cuando se mide la dependencia de la propiedad. Por lo tanto, se requieren métodos más convenientes para estudiar las propiedades eléctricas en NW individuales sin una nanofabricación compleja.
En las últimas décadas, las mediciones eléctricas basadas en microscopía de sonda de barrido (SPM) se revelan como técnicas poderosas para caracterizaciones eléctricas a nanoescala [29, 30]. Entre estas técnicas de SPM, la microscopía de fuerza atómica conductiva (CAFM) se ha aplicado con éxito para estudiar las propiedades conductoras en nanoestructuras individuales o individuales [30,31,32]. Ya se han informado investigaciones de CAFM en una variedad de nanocables, como ZnO, InAs, CdS, CdSe, GaAs, InAsSb y Si NWs [33,34,35,36,37,38]. Si bien la mayoría de las investigaciones se centraron en las propiedades conductoras de los nanocables con parámetros fijos, se llevaron a cabo algunas investigaciones para explorar la dependencia del dopaje de las propiedades conductoras [37,38,39]. Las dependencias de tamaño de las propiedades conductoras de los nanocables se han investigado mucho menos todavía. Sólo se han informado unos pocos estudios sobre las propiedades conductoras dependientes del diámetro de los nanocables, incluso no restringidos al CAFM, y una parte considerable de ellos se ocupó de la dependencia del diámetro de la resistividad de los nanocables [25, 40,41,42]. Por ejemplo, un par de investigaciones sobre nanocables de GaN encontraron que la resistividad era alta en un diámetro crítico (20 ~ 80 nm, dependiendo de los métodos de fabricación) y se mantuvo sin cambios más allá de ella [41, 43], mientras que otras investigaciones sobre nanocables de Si informaron que la resistividad del nanoalambre disminuyó con el aumento del diámetro en el rango de decenas a cientos de nanómetros [40, 44]. Para los nanocables semiconductores con contactos metálicos, la barrera de Schottky puede desempeñar un papel importante en sus propiedades conductoras. Por lo tanto, a excepción de la resistividad, la barrera de Schottky debe tenerse en cuenta en presencia de nanocables semiconductores. Varios artículos se han centrado en la dependencia del diámetro de la altura de la barrera de Schottky (SBH), pero los resultados no son consistentes. Por ejemplo, Calahorra et al. calculó el SBH resolviendo la ecuación de Poisson en nanocables, y encontró una clara tendencia de aumento de la altura de la barrera con reducción de tamaño [45]. Soudi et al. al investigar el fotovoltaje de la superficie dependiente del diámetro y la densidad del estado de la superficie en un dispositivo de nanocables único de ZnO. Descubrieron que la altura de la barrera de la superficie aumentaba con la disminución del diámetro (20-60 nm), lo que se interpretó mediante la densidad del estado de la superficie simulada mediante la ecuación de Poisson [46]. Por el contrario, las mediciones de microscopía de fotocorriente de barrido en transistores de efecto de campo de nanocables de Si individuales de Yoon et al. revelaron una dependencia contraria, es decir, la altura de la barrera disminuyó con la disminución del diámetro debido a la contribución de los estados de la interfaz [47]. Otro trabajo experimental de Mao et al. en diodos Schottky de nanoagujas de Pt / ZnO individuales también informaron que la altura de la barrera disminuyó con la disminución del diámetro, lo que se explicó por un efecto de calentamiento en julios y / o falta de homogeneidad electrónica de la interfaz [48]. Por lo tanto, hasta ahora, la dependencia del diámetro de las propiedades conductoras de los nanocables no ha llegado a un consenso todavía y está lejos de entenderse completamente. Especialmente, las propiedades conductoras dependientes del tamaño, así como los estudios SBH dependientes del tamaño, no se han informado sobre Si NW individuales fabricados por el método MACE, que tienen una superficie bastante rugosa para aplicaciones prometedoras.
En este artículo, se preparan matrices periódicas de Si NW alineadas verticalmente con diferentes diámetros y longitudes mediante el método de NSL combinado con MACE. Tanto el diámetro como la longitud de los SiNW se pueden controlar bien ajustando el tiempo de grabado. Las propiedades conductoras de Si NW individuales dentro de la matriz son investigadas por CAFM sin ninguna nanofabricación adicional, que puede estudiar las propiedades conductoras dependientes del tamaño en Si NW individuales de manera conveniente simplemente reemplazando la muestra. Los resultados demuestran que la corriente medida en los Si NW individuales depende en gran medida del diámetro y la longitud de los NW. Los Si NW con diámetros más pequeños y longitudes más cortas exhiben mejores propiedades conductoras. A partir del ajuste de la curva I – V, se pueden obtener alturas de barrera Schottky dependientes del tamaño, que se considera que actúa como un factor clave para determinar las propiedades conductoras dependientes del tamaño de los nanocables. Además, se obtuvo SBH dependiente del tamaño similar mediante mediciones de microscopía de fuerza electrostática (EFM). Por lo tanto, nuestro estudio no solo revela las propiedades dependientes del tamaño de los Si NW, sino que también sugiere que CAFM puede actuar como un medio eficaz para explorar la dependencia del tamaño (u otros parámetros) de las propiedades conductoras en nanoestructuras individuales.
Materiales y métodos
Materiales
Las obleas de Si se adquirieron en MTI (China). Las suspensiones (2,5% en peso en agua) de esferas de poliestireno (PS, 490 nm de diámetro) se adquirieron de Duke Scientific (EE.UU.). Se adquirieron acetona, metanol, ácido sulfúrico, peróxido de hidrógeno y ácido fluorhídrico para fabricar Si NW de Sinopharm Chemical Reagent (China). Se obtuvo agua desionizada (DI, 18,2 MΩ · cm) de un sistema de ultrafiltración (Milli-Q, Millipore, Marlborough, MA).
Fabricación de Si NWs
Las matrices de nanocables de silicio ordenadas verticalmente se fabrican mediante NSL en combinación con MACE, que se han descrito en detalle en publicaciones anteriores [49, 50]. El proceso de fabricación principal está programado en la Fig. 1a. En primer lugar, se autoensambló una monocapa de esferas de poliestireno (PS) con un diámetro de 490 nm sobre la oblea de Si plana limpiada químicamente (tipo n, 0,01 Ω cm) para formar una monocapa hexagonal compacta. Posteriormente, la muestra cubierta con PS se grabó mediante grabado con iones reactivos (RIE, Trion Technology) (50 W, 70 mTorr) con O 2 gas (20 sccm) para reducir el diámetro de PS, que actuó como capa de máscara en los siguientes procedimientos. Posteriormente, se depositó una película de Au de 20 nm mediante pulverización iónica sobre la muestra enmascarada por la capa de PS que actuó como catalizador para el siguiente tratamiento con MACE. La muestra fue tratada por MACE en HF (40%) y H 2 O 2 (30%) solución mezclada (relación de volumen 4:1) a temperatura ambiente. En el proceso MACE, la superficie de Si cubierta con Au fue atacada eficazmente mientras que la cubierta por PS (sin Au) se protegió, lo que resultó en la formación de Si NW. Finalmente, la capa de Au restante y las esferas de PS se eliminaron sumergiendo la muestra en KI / I 2 y soluciones de tetrahidrofurano, respectivamente. Con este método de fabricación, se pueden obtener matrices periódicas de gran área de matrices Si NW alineadas verticalmente.

un Ilustración esquemática de los procedimientos para fabricar una matriz de nanocables de Si alineada verticalmente. b Diagrama esquemático de las configuraciones experimentales para mediciones CAFM y EFM en nanocables de Si individuales
Caracterización de Si NWs
La morfología de los Si NW fabricados se verificó mediante microscopía electrónica de barrido (SEM, SIGMA300), mientras que sus propiedades estructurales se investigaron mediante espectroscopía Raman (sistema Jobin Yvon HR-Evolution 2) con una longitud de onda de excitación de 532 nm y una baja potencia de aproximadamente 1 mW. .
Las propiedades eléctricas de Si NW fueron investigadas por CAFM y EFM con un equipo SPM comercial (Multimode V, Bruker Nano Surfaces), como se muestra en el diagrama de la Fig. 1b. Se utilizaron puntas recubiertas de Cr / Pt (Multi75E-G, Budget Sensors, radio de aproximadamente 25 nm) para las mediciones de CAFM y EFM. En CAFM, la punta conductora se escaneó sobre la superficie de la muestra en modo de contacto con un voltaje de polarización de CC aplicado al sustrato mientras la punta estaba conectada a tierra, y se midió la corriente entre la punta y la muestra. Como la oxidación anódica de la superficie es grave bajo los sesgos de muestra positivos, todas las imágenes actuales se midieron con sesgos de muestra negativos. En los experimentos CAFM se probaron varios voltajes negativos que oscilaron entre - 0,5 y - 3,0 V. Se encontró que, cuando el voltaje de polarización se estableció por debajo de -1,5 V, la corriente era demasiado pequeña para ser detectada para muestras con mala conductancia. Si bien el voltaje de polarización se estableció en - 2.0 V o más, las mediciones fueron inestables, probablemente debido al daño de la punta y / o muestra bajo un gran campo electrostático. Por lo tanto, se eligió el voltaje de polarización de -1,5 V para las mediciones de imágenes actuales. Las mediciones de EFM se llevaron a cabo en Si NW en el modo de dos pasos. En la primera pasada, funcionó en modo de tapping para obtener la imagen de la topografía, mientras que en la segunda pasada la punta se levantó lo suficiente para ignorar la fuerza de Van der Waals. En el paso elevado, se agregó un voltaje de CC entre la muestra y la punta conectada a tierra, y se detectó la señal de cambio de fase inducida por la fuerza electrostática. Todos los experimentos se operaron en un flujo de N 2 ambiente para mediciones eléctricas estables y las muestras se sumergieron previamente en la solución de HF (5%) durante 30 s para reducir efectivamente la influencia de la capa de óxido en la caracterización conductiva. Dado que las mediciones se llevaron a cabo inmediatamente después de la inmersión en HF, la capa de oxígeno reformada debe ser lo suficientemente delgada para ser penetrada por la punta conductora y su efecto sobre la conductancia es mínimo.
Resultados y discusiones
Fabricación de Si NWs
La fabricación de matrices de nanocables de Si ordenadas y alineadas verticalmente de gran área se ilustra en la Fig. 1a. Al cambiar el tiempo de RIE, el diámetro de las esferas de PS se puede reducir a los valores deseados y, por lo tanto, se pueden lograr Si NW con diámetros controlables. Las imágenes SEM de Si NW obtenidas después de 90, 120 y 150 s de grabado con RIE se presentan en la Fig. 2 a, byc, respectivamente. Se puede observar que los Si NW están alineados verticalmente en una disposición periódicamente hexagonal en un área grande. Estos Si NW alineados verticalmente tienen el mismo período de 490 nm y la misma longitud de aproximadamente 350 nm (mismo tiempo MACE de 40 s). Los diámetros de los Si NW en (a), (b) y (c) son alrededor de 350, 260 y 190 nm, respectivamente. La dependencia del diámetro de NW del tiempo de grabado de RIE se representa en la Fig. 2d, lo que muestra una buena correlación lineal. Por otro lado, la longitud de los nanocables podría ajustarse variando el tiempo de MACE en HF y H 2 O 2 solución mixta. Las imágenes SEM de sección transversal de Si NW después de 40, 60, 80 y 100 s MACE se muestran en la Fig. 2e. Se puede ver que la longitud de los NW aumenta de 350 a 960 nm al aumentar el tiempo MACE. De manera similar, la longitud de Si NW exhibe una buena dependencia lineal del tiempo MACE, como se muestra en la Fig. 2f. Estos resultados indican que los Si NW ordenados con diámetros y longitudes controlables se fabrican con éxito mediante el método de NSL combinado con MACE.
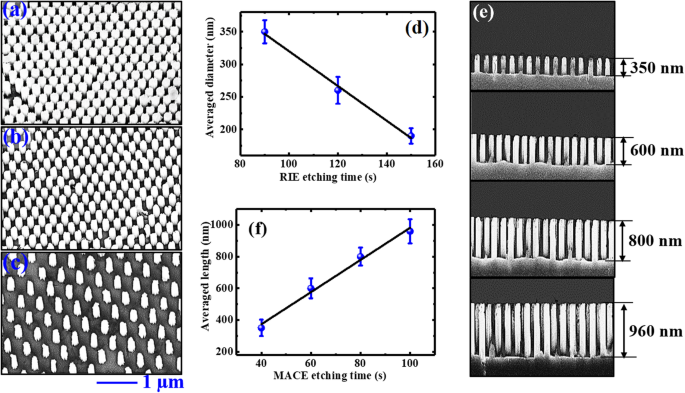
Imágenes SEM de vista superior de Si NW con la misma longitud de 350 nm, pero diferentes diámetros de a 350 nm; b 260 nm; y c 190 nm. La dependencia del diámetro de NW del tiempo de grabado de RIE se representa en d . e Imágenes SEM transversales de Si NW con el mismo diámetro de 260 nm, pero diferentes longitudes de 350, 600, 800 y 960 nm. f Presenta la dependencia de la longitud de NW del tiempo MACE
A partir de las imágenes SEM, también se puede encontrar que los Si NW tienen una superficie muy rugosa después del grabado químico, y la superficie de sus paredes laterales es especialmente rugosa. Para comprobar la microestructura de la capa superficial en función del diámetro y la longitud, se midieron los espectros Raman tanto en Si a granel como en Si NW con diferentes diámetros y diferentes longitudes. Cada espectro se normalizó utilizando la intensidad máxima máxima a 520 cm - 1 , y los resultados para diferentes diámetros y diferentes longitudes se muestran en la Fig. 3 ayb, respectivamente. El espectro de silicio a granel muestra un pico agudo que se ubica en ~ 520,1 cm - 1 . Tanto el desplazamiento al rojo de la posición del pico como el ensanchamiento del ancho del pico (denominado ancho completo a la mitad del máximo, FWHM) se pueden observar en Si NW, como se representa en la Fig. 3 cyd, correspondientemente. El desplazamiento al rojo y el ensanchamiento máximos son bastante pequeños para los nanocables con longitudes cortas de 350 y 600 nm y se vuelven relativamente obvios a medida que la longitud del nanoalambre aumenta a 800 nm o más. Este corrimiento al rojo y ensanchamiento del pico Raman se atribuye a veces a cambios en el nivel de dopante o contenido cristalino. Según la literatura anterior [5, 51], para los Si NW fabricados por el mismo método MACE, la concentración de dopaje podría poseer el mismo nivel de dopaje que la oblea de partida. Debido a las limitaciones del equipo, no pudimos confirmar este resultado. Por otro lado, aunque estos Si NW tienen una superficie rugosa, la bibliografía anterior encontró que los Si NW fabricados por el método MACE podrían mantener principalmente sus estructuras cristalinas para el dopaje n y p y el dopaje ligero y pesado [5, 51 , 52]. Solo se observó una fina capa amorfa en la superficie de la pared de los NW. Se obtuvieron resultados similares en Si NW con diferentes diámetros y longitudes por diferentes grupos. Como tal, se podría suponer que los Si NW fabricados por el método MACE pueden mantener su nivel de dopante y contenido cristalino casi sin cambios como su contraparte a granel, excepto la capa superficial delgada.

Espectros Raman típicos de nanocables de Si y Si a granel con a misma longitud de 350 nm pero diferentes diámetros y b mismo diámetro de 190 nm pero diferentes longitudes. c y d representan el corrimiento al rojo de la posición del pico y el ensanchamiento de FWHM en función de la longitud del nanocable
Por lo tanto, lo más probable es que el cambio y el ensanchamiento del pico Raman sean inducidos por la superficie rugosa dañada de los nanocables [53]. Hay varios artículos que informan sobre los resultados Raman de Si NW fabricados mediante el mismo método MACE. Por ejemplo, Feser et al. encontró que el pico significativo que se ensancha a 520 cm - 1 aumentó con el tiempo MACE y atribuyó este pico de ampliación al desorden cristalino (por ejemplo, grupos de defectos puntuales) inducidos por el proceso de grabado [23]. Lajvardi y col. encontró que el corrimiento al rojo Raman aumentó con el tiempo MACE, i. mi. el pico TO Raman se ubicó a 521,1 cm - 1 para Si a granel y cambiado a 518,7 cm - 1 para muestras grabadas de 80 min, respectivamente [54]. Afirmaron que el origen del cambio Raman puede deberse a la formación de nanocristales de Si en la pared del nanoalambre. Lin y col. observó que el pico TO Raman cambió de 520 a 516 cm - 1 cuando la longitud de los NW aumenta de 0 (Si a granel) a 2,73 μm, mientras que el ancho del pico se amplía de 3 a 9 cm - 1 con el aumento de la longitud de los NW de 0,19 a 2,73 μm [55]. Pensaron que el ensanchamiento del pico Raman estaba dominado por la interacción fonón-deformación y se demostró que el cambio de pico Raman era proporcional a la distorsión de la red de superficie inducida por deformación. Dado que la deformación inducida por el grabado de HF aumentó con la longitud de los NW (más tiempo de grabado), tanto el corrimiento al rojo del pico Raman como el ensanchamiento aumentaron con el aumento de la longitud de los NW. En nuestro caso, a partir de los espectros Raman como se muestra en la Fig. 3 ayb, podemos encontrar que el pico TO Raman se desplaza de 520 a 519,4 cm - 1 cuando la longitud de los NW aumenta de 0 (Si a granel) a 960 nm, mientras que el FWHM se amplía de 4,41 a 4,47 cm - 1 a medida que la longitud de NW aumenta de 350 a 960 nm. Preferimos este cambio de pico Raman dependiente de la longitud y el ensanchamiento se origina en la superficie dañada (deformación o desorden). Sin embargo, debido a la variación muy pequeña tanto en el corrimiento al rojo como en el ensanchamiento del pico para nanocables con diferentes diámetros y diferentes longitudes (<1.0 cm - 1 ), el cambio de tensión / trastorno con el tamaño puede considerarse mínimo. Por lo tanto, la tensión / trastorno puede modificar la conductancia de los NW, pero su influencia en la dependencia del tamaño de la conductancia no se trata en las siguientes secciones.
Mediciones de propiedades conductoras en NW individuales de Si
Las propiedades conductoras de los Si NW se miden mediante CAFM en NW individuales con diferentes diámetros y longitudes. Las imágenes topográficas típicas de los Si NW alineados verticalmente con la misma longitud de 350 nm pero diferentes diámetros de 350, 260 y 190 nm se muestran en la Fig.4 a, byc, respectivamente, mientras que sus correspondientes imágenes actuales obtenidas en la muestra Los sesgos de -1,5 V se presentan en (d), (e) y (f). Cabe señalar que, como la punta AFM recubierta de Cr / Pt es una cuña con un ángulo grande, los Si NW presentan un diámetro mayor que los reales. Además, la corriente que sale de los nanocables no se puede detectar bien ya que es posible que la punta no pueda entrar en contacto con el sustrato, por lo que solo se tienen en cuenta las corrientes medidas en los nanocables. A partir de las imágenes actuales, se puede observar que la mayoría de los bordes de los nanocables de Si exhiben una conductancia un poco mejor que el centro. Esto puede deberse al contacto lateral entre la punta AFM y el Si NW con un área de contacto más grande. Además, debido a la obvia rugosidad en la superficie superior, algunas regiones en el área central también pueden mostrar una gran corriente similar al borde, lo que no da como resultado una distribución de corriente distinta en forma de anillo. Por otro lado, la conductancia de Si NW está obviamente relacionada con el diámetro de los nanocables. Se puede ver que tanto la relación del área conductora de los nanocables como los valores de la corriente absoluta aumentan significativamente a medida que el diámetro disminuye de 350 a 190 nm. Los resultados sugieren que los Si NW con diámetros más pequeños son más conductores que aquellos con diámetros más grandes. Para obtener la dependencia del diámetro de manera más intuitiva, los perfiles de corriente a lo largo de las líneas marcadas en la Fig. 4 d af se muestran en la Fig. 4g. Muestra claramente que los Si NW con un diámetro de 190 nm son mucho más conductores que los que tienen los diámetros de 260 nm y 350 nm. Tal dependencia del diámetro también se puede obtener a partir de los histogramas estadísticos de las distribuciones de corriente en Si NW con diferentes diámetros, como se muestra en el archivo adicional 1:Figura S1 (a), que muestra los cambios de distribución de corriente a valores altos cuando el diámetro disminuye. Las corrientes promediadas ( I av ) de Si NWs se calculan promediando la corriente sobre todos los nanocables en las imágenes actuales, que se representa en la Fig. 4h como una función del diámetro de NWs. La corriente promedio de Si NW exhibe un dramático aumento de nueve veces cuando el diámetro de los NW disminuye de 350 a 190 nm. Se ha logrado una dependencia de corriente similar del diámetro en nanocables individuales de InAs, así como en dispositivos de nanocables de Si únicos [35, 47].

Las imágenes topográficas de Si NW con la misma longitud de 350 nm pero diferentes diámetros de a 350 millas náuticas, b 260 nm, c 190 nm. Las imágenes de corriente correspondientes obtenidas con el sesgo de muestra de - 1,5 V se dan en d , e y f , respectivamente. Perfiles actuales a lo largo de las líneas marcadas en d - f están representados en g y h presenta la corriente promediada ( I av ) sobre los nanocables en función del diámetro de NW. Las líneas correspondientes se agregan en las imágenes topográficas de a - c y las curvas del perfil en g se desplazan verticalmente como guía
En la Fig. 5 se presentan imágenes de corriente típicas de Si NW con diferentes longitudes y el mismo diámetro de 190 nm medido con el sesgo de la muestra de - 1,5 V. La Figura 5 a ad muestra las imágenes actuales de Si NW con longitudes de 350, 600, 800 y 960 nm, respectivamente. Se puede ver que en estas imágenes de corriente, las áreas conductoras disminuyen obviamente con el aumento de la longitud, mientras que la disminución de la corriente absoluta no es tan obvia, especialmente para los NW con la longitud de 350 nm y 600 nm. Quizás debido a la existencia de rugosidad superficial irregular local, se observó una corriente aún mayor en algunos puntos de la Fig. 5b. Sin embargo, la corriente promedio de la Fig. 5b fue mucho menor que la de la Fig. 5a. Utilizando los mismos análisis que el anterior, los perfiles actuales a lo largo de las líneas marcadas se presentan en la Fig. 5e, y los histogramas estadísticos se muestran en el archivo adicional 1:Figura S1 (b). Ambos muestran claramente una disminución de corriente significativa con el aumento de la longitud de los NW. Las corrientes promediadas de los nanocables en función de las longitudes de NW se representan en la figura 5f, y están en el orden de decenas a centenas pA, que es mucho más pequeña que la que se muestra en la figura 5 a a e en el orden de nA. . Esto se debe a que los nanocables exhiben una corriente relativamente grande solo en unos pocos puntos conductores cuando la mayoría de las regiones no son conductoras. De la Fig. 5f, la corriente promediada exhibe una disminución de más de tres veces cuando la longitud aumenta de 300 a 960 nm, lo que indica que la conductancia de los nanocables disminuye con la longitud aumentada. La dependencia de la resistencia de los nanocables con respecto a la longitud se ha investigado previamente mediante mediciones de resistencia de cuatro puntos en nanocables semiconductores, lo que sugiere que bajo contacto óhmico la resistencia del nanoalambre aumenta con su longitud linealmente con la pendiente de resistividad [56, 57]. En nuestro caso, a partir de la gráfica de I ~ 1 / L como se muestra en el archivo adicional 1:Figura S2, la dependencia es notablemente no lineal; por lo tanto, la resistividad no se pudo obtener correctamente a partir de la pendiente de la curva. Cabe señalar que en las mediciones CAFM, la resistencia total medida incluye la resistencia de contacto entre las puntas recubiertas de Cr / Pt y Si NW ( R tip / NW ), la resistencia de Si NW ( R NW ) y la resistencia de las obleas de Si ( R masivo ). Dado que la resistencia medida por CAFM proviene principalmente del área de superficie localizada debajo de la punta y disminuye rápidamente con el área aumentada a lo largo de la ruta actual, R masivo es mucho más pequeño en comparación con R NW y R tip / NW . Por otro lado, debido a la muy pequeña área de contacto del semiconductor de metal entre la punta y el nanoalambre, la resistencia de contacto R tip / NW es mucho mayor que la resistencia del nanocable R NW . La no linealidad de la dependencia actual de 1 / L solo indica la presencia de una gran resistencia de contacto. Por tanto, en las mediciones realizadas por CAFM, se debe considerar enfáticamente la resistencia de contacto metal-semiconductor, en la que la barrera de Schottky juega un papel importante.

Las imágenes actuales de Si NW con el sesgo de muestra de - 1,5 V con el mismo diámetro de 190 nm pero diferentes longitudes de a 350 millas náuticas, b 600 nm, c 800 nm y d 960 nm, respectivamente. Los perfiles actuales a lo largo de las líneas marcadas en a - d están trazados en e y f presenta las corrientes promediadas de los nanocables ( I av ) en función de la longitud de NW. Las curvas del perfil en e se desplazan verticalmente como guía
Para verificar la inferencia anterior, se registraron curvas de corriente-voltaje (I – V) en Si NW individuales para investigar la barrera de Schottky en el contacto de la punta de metal / nanocable de Si. En la Fig. 6a se presentan las curvas I – V típicas en los Si NW con la misma longitud de 350 nm pero diferentes diámetros y en la Fig. 6b, respectivamente, las curvas de Si NW con el mismo diámetro de 190 nm pero diferentes longitudes. Todas las curvas I-V exhiben corrientes más grandes en la región de voltaje de muestra negativo, de acuerdo con las curvas I-V típicas con el contacto Schottky entre la punta de metal y el semiconductor tipo n. Como las curvas I-V exhiben buenas características de semiconductores de metal, indica que el efecto de la capa de oxígeno sobre la conductancia no es serio y, por lo tanto, se asume mínimo en la siguiente discusión. Mientras tanto, los resultados muestran que los nanocables más pequeños y más cortos exhiben una conductancia más grande que los más grandes y más largos, muy en consonancia con los resultados obtenidos a partir de las imágenes actuales. Para los análisis cuantitativos, se adopta un modelo de emisión termoiónica bien conocido para un contacto metal-semiconductor [58, 59]. En este modelo, las características I – V de un contacto Schottky con un semiconductor de tipo n en presencia de resistencia en serie se pueden aproximar como [59]:
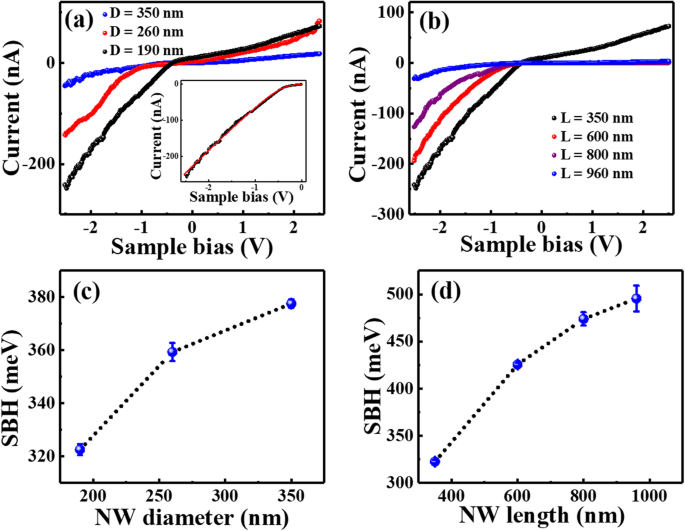
Curvas I-V típicas en Si NW con la misma longitud de 350 nm pero diferentes diámetros ( a ) y el mismo diámetro de 190 nm pero diferentes longitudes ( b ). El recuadro en a muestra un resultado de ajuste típico de Si NW con un diámetro de 190 nm y una longitud de 350 nm. c y d representan las alturas de barrera de Schottky obtenidas a partir de los resultados del ajuste en función del diámetro y la longitud de NW, respectivamente
$$ I ={I} _S \ left [\ exp \ left (\ frac {q \ left (VI {R} _S \ right)} {\ mathrm {n} kT} \ right) -1 \ right], $ $ (1)donde n es el factor ideal y R S es la resistencia en serie. yo S es la corriente de saturación, que se puede expresar mediante:
$$ {I} _S =\ mathrm {AA} \ ast {T} ^ 2 \ exp \ left (- \ frac {\ varphi_B} {kT} \ right), $$ (2)donde A es el área de contacto, A * es la constante de Richardson y φ B es la altura de la barrera de Schottky (SBH) entre la punta de metal y el nanoalambre de Si. Así, SBH se puede obtener con la fórmula:
$$ {\ varphi} _B =kT \ ln \ left (\ frac {\ mathrm {AA} \ ast {T} ^ 2} {I _ {\ mathrm {S}}} \ right), $$ (3)Las curvas I – V de la Fig. 6 ayb pueden ajustarse bien con la Ec. (1), y una línea de ajuste típica en la región delantera se muestra en el recuadro de la Fig. 6a. Para obtener los valores SBH de la corriente de saturación, se supone que la constante de Richardson efectiva A * es aproximadamente igual a la del silicio a granel, es decir, 112 A cm - 2 K - 2 para silicio de tipo n [59]. Se supone que el área de contacto es 2 × 10 - 11 cm 2 tomando el radio de la punta recubierta de Cr / Pt como 25 nm. Los valores de SBH se obtienen en aproximadamente 322, 359 y 377 meV para los Si NW con la misma longitud de 350 nm y diferentes diámetros de 190, 260 y 350 nm, respectivamente. Para Si NW con el mismo diámetro de 190 nm y diferentes longitudes de 350, 600, 800 y 960 nm, los valores de SBH son 322, 425, 473 y 495 meV, correspondientemente. A modo de comparación, la curva I – V típica se midió en el mismo tipo de oblea de Si, como se muestra en el archivo adicional 1:Figura S3 (a). Muestra claramente que la conductancia de la oblea de Si es mucho menor que la de los NW producidos. La corriente detectable solo se puede medir con voltajes de polarización altos (- 4 ~ - 10 V). Después de ajustar las curvas I – V con el modelo de emisión termoiónica anterior (archivo adicional 1:Figura S3 (b)), se obtuvo un valor SBH de 0,60 eV para el Si a granel. Obviously, all of the measured SBH values for Si NWs with different diameters and lengths are smaller than that of the bulk Si. Similar Schottky barrier lowering in nanowires has been reported by different groups on different types of nanowires, which was attributed to the carrier recombination in depletion region [46, 60], barrier inhomogeneity and Joule heating effect [48], or image potential lowering [47]. In our case, the barrier lowering can be also attributed to the large density of surface states induced image potential lowering and carrier charging in depletion region.
The dependence of SBH values on nanowires’ diameter and length is plotted in Fig. 6 c and d respectively, and it can be found that the SBH increases obviously with the increasing of both nanowires’ diameter and length. In addition, the same measurements were done on Si NWs with different diameters of 260 and 350 nm for all lengths, and the I–V curves are shown in Additional file 1:Figure S4 a and b, respectively. The obtained diameter-dependent SBH values from curve fitting for all lengths are listed in Table 1 and plotted in Additional file 1:Figure S5. The results show that the SBH values increase with increased diameter for all lengths, and also increase with increased length for all diameters. Therefore, the results obtained from the I–V curves analyses suggest that the Schottky barrier lowering is more significant for the nanowires with smaller diameters and shorter lengths. On the other hand, the ideal factor n and series resistances R s of Si NWs with different diameters and lengths can also be obtained from the fitting results, as listed in Table 1. The results show that n is much larger than 1 for all nanowires (2.8 ~ 9.4), indicating that the contact between the tip and nanowire is not ideal metal-semiconductor contact, probably due to the existence of oxide layer. On the other hand, the R s increases with increased diameter as well as increased length. For example, R S increases from 6.1 to 21.6 MΩ as the diameter increases from 190 to 350 nm for the same length of 350 nm and increases from 6.1 to 32.3 MΩ for the length from 350 to 960 nm with the same diameter of 190 nm. The increase of R s with increased length is reasonable, while that increase with increased diameter is out of expectation. There is no good explanation for it at present, which may because that the series resistance is not simply the resistance of nanowire and the effective tip-nanowire contact area is not exactly equal to the nanowire’s sectional area. Nevertheless, the series resistances of Si NWs did be much smaller than the contact resistances, therefore the conductance of Si NWs should be dominated by the SBH determined contact resistance.
The origin of the size-dependent SBH is not very clear yet. The mechanism explanation for similar diameter dependence of SBH has been supposed in several literatures [45,46,47,48, 60]. For example, Leonard et al. interpreted this effect with the point of electron-hole recombination in depletion region [60]. As the recombination time decreased as the nanowire diameter was reduced, current density increased with decreasing nanowire diameter. Yoon et al. explained the diameter-dependent SBH using the presence of interface states [47]. Mao et al. attributed its origin to barrier inhomogeneity and Joule heating effect [48]. In our case, the Si NWs are made by the MACE method, so there inevitably exist an amount of defects on the surface and a reformed thin oxygen layer, resulting in a large density of surface states. Actually, from the enlarged SEM images and AFM observation, the top surface of Si NWs is very rough, further increasing the density of surface states. We think the presence of surface (or interface) states should be the main cause of the diameter dependence of SBH. According to previous literatures [47, 61, 62], the SBH lowering was interpreted by charged interface states. By adopting the cylindrical coaxial capacitor model used in reference [47], interface state–induced carrier transfer will form two opposite charged layers (metal and semiconductor contact surface) which generates an electric field opposite to the built-in electric field and lowers the barrier potential. As the surface state density increases with decreased nanowire diameter, smaller SBH is obtained on nanowires with a smaller diameter. Why the values of SBH related to the nanowire length is not clear yet. As the MACE time increased, the surface disorder or roughness increases correspondingly. Different changes in the surface microstructures may introduce different changes of SBH values, which need further investigations to work it out. Anyway, whatever the origin of size dependence of conductive properties, the size-dependent SBH lowering could result in higher conductance, which should be beneficial for practical applications.
EFM Measurements on Single Si NWs
To further verify the size-dependent SBH results of Si NWs obtained by CAFM, the EFM measurements were performed on the same samples and the EFM phase shift was measured as a function of applied DC bias. In previous literatures [63, 64], the relation between phase shift and electrostatic force has already been established, where the tip-sample system is roughly treated as a plane capacitor. When a bias is applied between the tip and the sample, the capacitive electrostatic force gradient would cause a phase shift. At a lifted height where the Van de Waals force can be ignored, the electrostatic force acted on the tip can be expressed as [63]:
$$ F=\frac{1}{2}\frac{\partial C}{\partial z}{\left({V}_{EFM}-{V}_{CPD}\right)}^2, $$ (4)donde C , V EFM y V CPD are the capacitance, applied DC voltage and contact potential difference (CPD) between the sample and tip, respectively. V CPD can be written as (φ sample − φ tip )/e when the bias voltage V EFM was applied to the sample in our experiments. The phase shift detected by EFM is proportional to the gradient of the electrostatic force, which can be written as:
$$ \varDelta \varPhi =-\frac{Q}{k}\frac{\partial F}{\partial z}=-\frac{Q}{k}\left[\frac{1}{2}\frac{\partial^2C}{\partial {z}^2}{\left({V}_{EFM}-{V}_{CPD}\right)}^2\right], $$ (5)where Q is the quality factor, k is the spring constant of the probe and z is the distance between tip and top of Si NW.
De la ecuación. (5), it can be seen that the EFM phase shift should be equal to zero at V EFM = V CPD . Therefore, V CPD can be achieved from the EFM measurements. The ΔΦ ~V EFM curves measured at a lift height of 100 nm on the individual Si NWs with different diameters and lengths are shown in Fig. 7 a and b as the scattered dots, respectively. By using Eq. (5), the ΔΦ ~V EFM curves can be fitted well, shown as the solid lines in Fig. 7 a and b. From the fitting parameters, the values of V CPD can be obtained, as presented in Fig. 7 c and d as a function of diameter and length respectively. The results show that the CPD values increase with increased diameter and increased length. Similar CPD results have been reported in a previous work performed by Kelvin probe force microscopy on ZnO NWs, in which the absolute value of CPD between ZnO nanowire and Pt/Ir tip also increased with increased diameter [65]. As diagrammed in Additional file 1:Figure S6, the value of SBH roughly equals to qV CPD plus E n (=E C − E F ). As E n is a constant for all Si NWs made from the same material, the size dependence of V CPD well represents the size dependence of SBH. Therefore, from the EFM results, it can be suggested that, the SBH values increase with the increasing of NWs’ diameter and length, well consistent with the results achieved by CAFM measurements. Similarly, the EFM measurements are performed on all series of Si NWs, and the diameter-dependent V CPD values at different lengths are shown in Additional file 1:Figure S7(a) and (b) respectively, which exhibit same diameter dependence as that obtained by CAFM.

∆Φ ~ V curves measured by EFM on individual Si NWs with a different diameters of 190, 260, and 350 nm (length = 350 nm) and b different lengths of 350, 600, 800, and 960 nm (diameter = 190 nm). c y d present the V CPD values obtained by curve fitting as a function of NWs’ diameter and length. The curves in a y b are vertically shifted for guidance
Conclusión
In summary, by a simple, low-cost method without involving any intricated procedures, Si NWs arrays with controllable diameters and lengths are prepared. Both the diameter and length of SiNWs can be well controlled by adjusting the etching time. The conductive properties include the current map and I–V curves are directly measured on individual Si NWs without complex nanofabrication procedure by the means of CAFM. Size-dependent conductance of Si NWs can be obtained from both the current images and I–V curves. Our results demonstrate that the Si NWs with a smaller diameter and shorter length exhibit better conductance. It can be attributed to the size dependence of SBH, which increased from 322 to 377 meV with the diameter increasing from 190 to 350 nm for the same length of 350 nm. Correspondingly, the SBH values increased from 322 to 495 meV as the length varies from 350 to 960 nm for the same diameter of 190 nm. The same size-dependent SBH can also be obtained from the EFM measurements. Such SBH lowering is interpreted by charged interface states. Therefore, our study not only reveals the size-dependent properties of Si NWs but also suggests that CAFM can act as an effective means to explore the size (or other parameters) dependence of conductive properties on individual nanostructures.
Disponibilidad de datos y materiales
The datasets used for supporting the conclusion are included in the article and the supporting file.
Abreviaturas
- CAFM:
-
Microscopía de fuerza atómica conductiva
- CPD:
-
Contact potential difference
- EFM:
-
Electrostatic force microscopy
- MACE:
-
Metal-assisted chemical etching
- NSL:
-
Litografía de nanoesferas
- PD:
-
Esferas de poliestireno
- RIE:
-
Grabado de iones reactivos
- SBH:
-
Altura de la barrera Schottky
- SEM:
-
Microscopía electrónica de barrido
- Si NWs:
-
Si nanowires
- SPM:
-
Scanning probe microscopy
Nanomateriales



