Mejora de la propagación de la corriente mediante la modulación local del tipo de dopaje en la capa n-AlGaN para diodos emisores de luz ultravioleta profunda basados en AlGaN
Resumen
En este informe, modulamos localmente el tipo de dopaje en n -Capa AlGaN proponiendo una capa de dispersión de corriente estructurada n-AlGaN / p-AlGaN / n-AlGaN (NPN-AlGaN) para diodos emisores de luz ultravioleta profunda (LED DUV) basados en AlGaN. Después de insertar una capa delgada de p-AlGaN en la capa proveedora de electrones n-AlGaN, se puede generar una barrera de banda de conducción en el n capa de proveedor de electrones de tipo p, que permite la modulación de la distribución de corriente lateral en la capa de proveedor de orificios de tipo p para LED DUV. Además, según nuestros estudios, la concentración de dopaje de Mg, el grosor, la composición de AlN para la capa de inserción de p-AlGaN y el número de unión NPN-AlGaN tienen una gran influencia en el efecto de propagación actual. Una capa de propagación de corriente NPN-AlGaN correctamente diseñada puede mejorar la potencia de salida óptica, la eficiencia cuántica externa (EQE) y la eficiencia del enchufe de pared (WPE) para los LED DUV.
Introducción
Debido a diversas aplicaciones, como desinfección, purificación de agua, tratamiento médico y registro óptico de alta densidad [1,2,3,4,5,6,7,8], se han invertido esfuerzos intensivos para desarrollar AlGaN- de alta eficiencia. diodos emisores de luz ultravioleta profunda basados en (LED DUV). En la etapa actual, se ha logrado un progreso notable para mejorar la calidad cristalina de las películas de AlGaN ricas en Al, por ejemplo, el cultivo de películas de AlN en sustratos de zafiro con nano patrones mediante la epitaxia cuasi-Van der Waals asistida por grafeno puede liberar en gran medida la tensión y reducir la densidad de dislocación [9], que indica la eficiencia cuántica interna (IQE) del 80% [10]. Vale la pena señalar que dicho IQE se mide utilizando el método de fotoluminiscencia a baja temperatura, que no involucra ninguna inyección de portador. Sin embargo, los LED DUV funcionan mediante polarización eléctrica, que está asociada con el flujo de corriente y el transporte de portadores [11,12,13]. Otro aspecto muy importante con respecto al flujo de corriente es el efecto de acumulación de corriente, que se produce fácilmente cuando el dispositivo está polarizado a un nivel de corriente muy alto [14]. Los LED DUV tienen una eficacia de dopaje de Mg muy inferior en la capa p-AlGaN con un alto componente de AlN [15, 16], lo que conduce a una baja conductividad eléctrica. Además, los LED DUV adoptan las estructuras flip-chip que presentan el esquema de inyección lateral para la corriente. Por lo tanto, en comparación con los LED UV, azules y verdes basados en InGaN / GaN, los LED DUV basados en AlGaN son más desafiados por el efecto de aglomeración actual [17]. La aparición del efecto de apiñamiento de corriente en el electrodo de contacto p o en el borde de la mesa conduce a una intensidad de electroluminiscencia desigual en los pozos cuánticos múltiples (MQW) y al aumento de la temperatura de unión [18]. Como resultado, es crucial promover la propagación de corriente lateral para los LED DUV. Para ello, el electrodo de tipo p de tiras múltiples estrechas propuesto permite una distribución uniforme de la corriente, aumentando así la eficiencia del enchufe de pared (WPE) en un 60% [19]. Además, la capa de difusión de corriente ITO / ZGO (ZnGaO) puede distribuir mejor la corriente y mejorar la eficiencia cuántica externa (EQE), pero el aumento de la resistividad interfacial en las interfaces ZGO / p-GaN hace que el WPE sea menos mejorado para los LED DUV [20] .
Por lo tanto, en la etapa actual, la atención de la investigación se pone en el lado p para facilitar la propagación de la corriente para los LED DUV. En este trabajo, a diferencia de otros enfoques, proponemos y demostramos que la distribución de corriente mejorada en la capa de proveedor de orificios tipo p para LED DUV se puede lograr mediante la ingeniería de la capa de proveedor de electrones n-AlGaN. La barrera de energía se genera en la banda de conducción modulando el tipo de dopaje en la capa proveedora de electrones, es decir, se propone y estudia paramétricamente la estructura n-AlGaN / p-AlGaN / n-AlGaN (NPN-AlGaN). Nuestros resultados muestran que la distribución lateral de los orificios se puede homogeneizar utilizando la unión NPN-AlGaN, que por lo tanto mejora la potencia de salida óptica, la eficiencia cuántica externa y la eficiencia del enchufe de pared para los LED DUV. Otra ventaja de nuestro diseño es que, desde el punto de vista del crecimiento epitaxial, tener la capa de propagación actual en la capa proveedora de electrones de tipo n permite a los productores de epi más libertad para optimizar las condiciones de crecimiento.
Métodos de investigación y modelos físicos
Las estructuras de LED NPN-AlGaN DUV se dibujan esquemáticamente en la Fig. 1a. En cada LED DUV estudiado, tenemos un n-Al de 4 μm de espesor 0.60 Ga 0.40 N / p-Al x Ga 1− x N / n-Al 0.60 Ga 0.40 Capa de N, y la concentración de dopaje de Si del n-Al 0.60 Ga 0.40 La región N es 5 × 10 18 cm −3 . Luego, cinco pares de Al 0.45 Ga 0,55 N / Al 0.56 Ga 0,44 Se diseñan N capas activas de pozos cuánticos múltiples (MQW), para las cuales los espesores de los pozos cuánticos y las barreras cuánticas son de 3 nm y 12 nm, respectivamente. Los MQW están cubiertos por un p-Al 0.60 dopado con Mg de 18 nm de espesor Ga 0.40 N capa que actúa como p-EBL, después de la cual un p-Al dopado con Mg de 50 nm de espesor 0.40 Ga 0.60 Siguen una capa de N y una capa de p-GaN dopada con Mg de 50 nm de espesor. La concentración de orificios para la p-EBL y las capas del proveedor de orificios se establecen en 3 × 10 17 cm −3 . Diseñamos la geometría del dispositivo con una mesa rectangular de 350 × 350 μm 2 . La Figura 1b muestra los perfiles de banda de conducción esquemáticos cuando se emplean dos uniones NPN-AlGaN (es decir, estructura NPNPN-AlGaN) en la estructura del LED DUV, y podemos ver las barreras de energía existentes en el p-Al agotado x Ga 1− x N regiones. Las barreras de energía pueden ajustar la distribución de corriente horizontal en la capa de proveedor de orificios tipo p. Tenga en cuenta que para garantizar el flujo de corriente a través de la unión n-AlGaN / p-AlGaN con polarización inversa, es muy importante tener la capa de inserción p-AGaN completamente agotada para que la unión NPN-AlGaN esté en un modo de ruptura de alcance. [21]. Posteriormente se presentarán análisis y debates detallados. Nuestro LED DUV de referencia es idéntico a los LED NPN-AlGaN DUV excepto que el n-Al dopado con Si de 4 μm de espesor 0.60 Ga 0.40 La capa N se utiliza como capa proveedora de electrones.
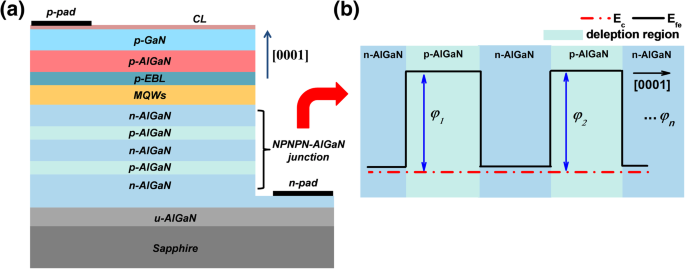
un Estructuras esquemáticas para el LED NPN-AlGaN. b Perfil de banda de conducción esquemático para la estructura NPNPN-AlGaN que tiene dos uniones NPN-AlGaN; definimos las alturas de barrera para cada unión NPN-AlGaN como φ 1 , φ 2 y φ n y n es el número de unión NPN-AlGaN
Para comprender mejor el mecanismo físico para el efecto de dispersión de corriente mejorado que es habilitado por la unión NPN-AlGaN, en la Fig. 2a se muestra un circuito equivalente para el LED DUV con un esquema de inyección de corriente lateral. Podemos ver que la corriente fluye desde la capa proveedora de agujeros tipo p hacia la región n-AlGaN a lo largo de las direcciones vertical y lateral. Si la resistencia eléctrica de la capa proveedora de electrones n-AlGaN es menor que la de la capa de propagación de corriente (CL), la corriente tiende a acumularse en la región debajo del contacto óhmico de tipo p, es decir, I 1 > Yo 2 > Yo 3 >…> Yo n [14]. La incorporación de uniones NPN-AlGaN en la estructura del LED DUV puede suprimir el efecto destructivo de acumulación de corriente. Luego, simplificamos aún más las rutas de flujo de corriente para el LED NPN-AlGaN DUV en la Fig. 2b, de modo que la corriente total se pueda dividir en una porción vertical ( I 1 ) y una porción horizontal ( I 2 ) desde el punto A al punto B . Por lo tanto, el voltaje total entre los dos puntos es compartido por la capa de propagación de corriente, la capa p-GaN, la capa p-AlGaN, las MQW, las uniones NPN-AlGaN y la capa n-AlGaN. Basado en las rutas actuales de I 1 y yo 2 , Ecs. 1 y 2 se obtienen, respectivamente, y resolviendo las dos fórmulas anteriores, Eq. Luego se deriva 3:
$$ {I} _1 {R} _ {\ mathrm {CL} - \ mathrm {V}} + {I} _1 {R} _X + {I} _1 \ bullet N \ bullet {R} _ {npn} + { I} _1 \ left ({R} _ {n- \ mathrm {V}} + {R} _ {nL} \ right) ={U} _ {\ mathrm {AB}}, $$ (1) $$ {I} _2 \ left ({R} _ {\ mathrm {CL} - \ mathrm {L}} + {R} _ {\ mathrm {CL} - \ mathrm {V}} \ right) + {I} _2 {R} _X + {I} _2 \ bullet N \ bullet {R} _ {npn} + {I} _2 {R} _ {n- \ mathrm {V}} ={U} _ {\ mathrm {AB}} , $$ (2) $$ \ frac {I_1} {I_2} =1 + \ frac {R _ {\ mathrm {CL} - \ mathrm {L}} - {R} _ {n- \ mathrm {L}} } {R _ {\ mathrm {CL} - \ mathrm {V}} + {R} _X + {R} _n + N \ bullet {R} _ {npn}} $$ (3)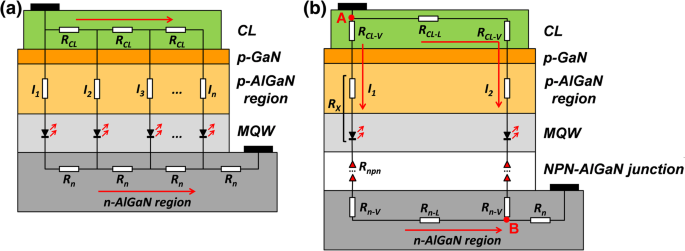
un LED DUV con circuito equivalente de esquema de inyección de corriente lateral ( I 1 > Yo 2 > Yo 3 > ……> Yo n ). b Circuito equivalente simplificado LED DUV estructurado NPN-AlGaN y rutas de corriente I 1 y yo 2 se exhiben
donde R CL − V y R CL − L son las resistencias vertical y horizontal para la capa de difusión de corriente, respectivamente; R n - V y R n - L denotar las resistencias vertical y horizontal para la capa n-AlGaN, respectivamente; R n es la suma de R n - V y R n - L (es decir, R n = R n - V + R n - L ) para la ruta actual I 1 ; la suma de la resistencia para la región de inyección del orificio tipo p y la región MQW está representada por R x ; R npn es la resistencia interfacial inducida por la altura de la barrera en cada unión NPN-AlGaN; N significa el número total de la unión NPN-AlGaN y la caída de voltaje total entre los puntos A y B es descrito por U AB . Vale la pena mencionar que la capa de difusión de corriente de 200 nm de espesor es mucho más delgada que la capa proveedora de electrones n-AlGaN de 4 μm de espesor para todos los dispositivos estudiados. Por tanto, se obtiene un CL cuya resistencia eléctrica es mucho mayor que la de la capa n-AlGaN, es decir, R CL − L - R n - L ≫ 0. Es obvio que la razón de I 1 / Yo 2 se puede reducir haciendo N × R npn aumento de valor . Por lo tanto, el efecto de propagación de la corriente en la capa proveedora de huecos de tipo p puede mejorarse usando la unión NPN-AlGaN en la capa proveedora de electrones de tipo n para estructuras LED DUV. Por un lado, el N × R npn El valor se puede mejorar aumentando N . Por otro lado, el valor de R npn se ve afectado por el componente de AlN, el espesor y la concentración de dopaje de Mg para la capa de inserción de p-AlGaN. Por lo tanto, se realizará un análisis detallado en las discusiones posteriores.
El simulador Crosslight APSYS se utiliza para investigar la física del dispositivo, y los modelos que utilizamos son fiables de acuerdo con nuestras publicaciones anteriores sobre LED basados en nitruro azul, UVA y DUV [22,23,24]. En nuestros modelos físicos, la relación de compensación de la banda de energía para la heterounión AlGaN / AlGaN se establece en 50:50 [25]. El coeficiente de recombinación Auger, la vida útil de la recombinación Shockley-Read-Hall (SRH) y la eficiencia de extracción de luz se establecen en 1.0 × 10 −30 cm 6 / s [26], 10 ns [27] y ~ 8% [28] para LED DUV, respectivamente. Las cargas de la interfaz inducidas por la polarización en la interfaz no coincidente de la red se consideran asumiendo el nivel de polarización del 40% [29].
Resultados y discusiones
Influencia de la estructura NPN-AlGaN en el efecto de propagación actual de los LED DUV
El LED A (es decir, el LED DUV de referencia sin unión NPN-AlGaN) y el LED B (es decir, el LED DUV con unión NPN-AlGaN) se han investigado en primer lugar para probar la influencia de la estructura NPN-AlGaN en la homogeneización de la corriente para el Capa de proveedor de orificios tipo p. Cada unión NPN-AlGaN tiene un p-Al 0.60 de 20 nm de espesor Ga 0.40 Capa de inserción de N, para la cual la concentración de dopaje de Mg es 1 × 10 18 cm −3 . La Figura 3a muestra el perfil de la banda de energía cuando la densidad de corriente es de 170 A / cm 2 para LED B. Se forman dos barreras de energía en la banda de conducción en las uniones NPN-AlGaN, y la formación de la barrera de energía está bien atribuida al efecto de agotamiento del p-Al insertado 0.60 Ga 0.40 Capa N. Las barreras generadas en el LED B inducen la resistencia interfacial de R npn en la región de unión NPN-AlGaN, lo que ayuda a disminuir I 1 / Yo 2 como se menciona en la ecuación. 3, de modo que fluyan más agujeros a lo largo de la ruta actual I 2 . Luego calculamos y mostramos la concentración del agujero horizontal en el último pozo cuántico (LQW) para los LED A y B cuando la densidad de corriente es 170 A / cm 2 , como se presenta en la Fig. 3b. Podemos ver claramente que el LED B obtiene una mejor propagación de corriente lateral en comparación con el LED A. Por lo tanto, demostramos que el NPN-AlGaN en la capa proveedora de electrones de tipo n facilita el efecto de propagación de corriente en la capa proveedora de huecos tipo p para LED DUV.

un Perfil de banda de energía para LED B, en el que definimos la banda de conducción, los niveles de cuasi-Fermi para electrones y huecos, y la banda de valencia como E c , E fe , E fh y E v , respectivamente. b Concentración de orificios horizontales en el LQW para los LED A y B cuando la densidad de corriente es de 170 A / cm 2
Además de mostrar la concentración de orificios laterales, también demostramos los niveles de concentración de orificios en los MQW para los LED A y B en la Fig. 4a. Podemos ver que, debido al efecto de dispersión de corriente mejorado, la concentración de orificios en los MQW se mejora para el LED B en comparación con la del LED A. El nivel de concentración de orificios mejorado en los MQW favorece más la recombinación radiativa para el LED B (ver Figura 4b).
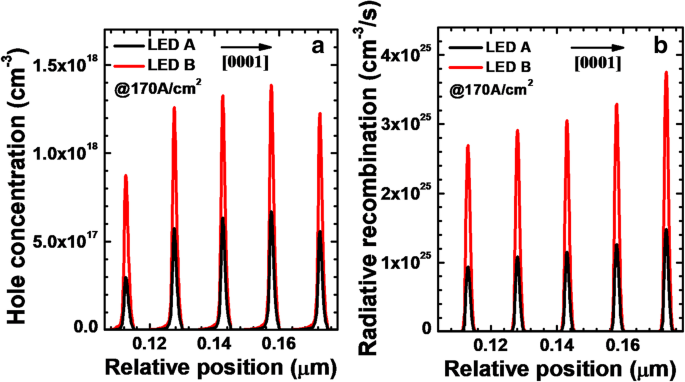
un Niveles de concentración de pozos y b perfiles de recombinación radiativa en los MQW para LED A y B, respectivamente. Recopilamos los datos en la ubicación de 120 μm de distancia del borde derecho de la mesa cuando la densidad de corriente es de 170 A / cm 2
El impacto de la unión NPN-AlGaN también se justifica por los rendimientos ópticos y eléctricos calculados para los LED A y B, como se muestra en la Fig. 5. La Figura 5a presenta el EQE y la densidad de potencia óptica como una función de la corriente inyectada para ambos LED. A y B. Podemos ver que el LED B tiene mayor EQE y densidad de potencia óptica que el LED A, gracias al efecto de distribución de corriente mejorado y la eficiencia de inyección de orificios habilitada por la unión NPN-AlGaN. Por ejemplo, la mejora de la densidad de potencia óptica para el LED B es ~ 1,67% cuando la densidad de corriente es 170 A / cm
2
de acuerdo con la Fig. 5a. Las investigaciones en la Fig. 5b ilustran que el voltaje directo para el LED B con la unión NPN-AlGaN tiene un ligero aumento en comparación con el del LED A. Atribuimos este fenómeno a las barreras de energía en las regiones de agotamiento que son causadas por el NPN-AlGaN empalmes. Afortunadamente, el voltaje directo más alto del LED B no tiene un efecto perjudicial en la eficiencia del enchufe de pared (WPE), y el WPE para el LED B supera al del LED A cuando la densidad de corriente de inyección es mayor que ~ 56 A / cm
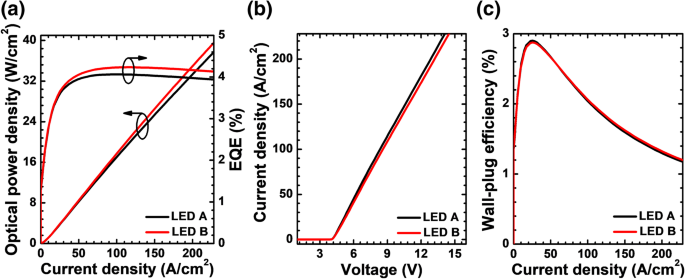
un EQE y densidad de potencia óptica en términos de corriente de inyección, b característica corriente-voltaje, y c WPE en función de la corriente de inyección para LED A y B
Efecto de la composición de AlN para la capa p-AlGaN sobre el efecto de propagación actual
En esta sección, se estudia el impacto de la composición de AlN para la unión NPN-AlGaN en las propiedades ópticas y eléctricas de los LED DUV. Para ilustrar claramente este mecanismo, utilizamos cinco LED DUV, es decir, LED C i ( yo =1, 2, 3, 4 y 5) con diferentes NPN-Al x Ga 1− x N uniones, para las cuales las composiciones de AlN para p-Al x Ga 1− x N capas de inserción son 0,60, 0,63, 0,66, 0,69 y 0,72, respectivamente. La concentración y el espesor de dopaje para el p-Al x Ga 1− x N capas son 1.8 × 10 18 cm −3 y 20 nm, respectivamente. Se utilizan dos uniones NPN-AlGaN, es decir, uniones NPNPN-AlGaN para todos los dispositivos estudiados. Luego calculamos la altura de la barrera de la banda de conducción para cada NPN-Al x Ga 1− x Unión N para LED C i ( yo =1, 2, 3, 4 y 5) como se muestra en la Tabla 1. Es distinto ver que el valor de la altura de la barrera de conducción aumenta a medida que la composición de AlN para el p-Al x Ga 1− x N capa de inserción aumenta. La alta altura de la barrera de conducción puede hacer que el valor de R npn aumento y una disminución de la proporción de I 1 / Yo 2 se activa simultáneamente como se menciona en la Ec. 3. Para probar ese punto, las distribuciones de los orificios laterales en el último pozo cuántico para todos los dispositivos estudiados cuando la densidad de corriente es de 170 A / cm 2 se calculan y se muestran en la Fig. 6a. Para el LED C1, la distribución de los orificios se puede modular después del NPN-Al 0.60 Ga 0.40 Se adopta la estructura N, y es obvio que el efecto de propagación actual obtiene una mejora adicional una vez que el componente AlN de la capa de inserción de p-AlGaN aumenta hasta 0,63 para nuestras estructuras.
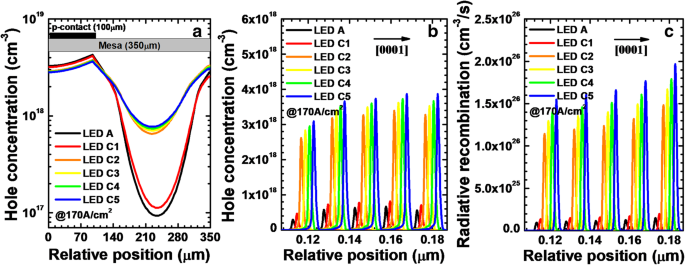
un Concentración de agujeros horizontales en el LQW, b niveles de concentración de agujeros y c Perfiles de recombinación radiativa en los MQW para LED A y D i ( yo =1, 2, 3, 4 y 5) cuando la densidad de corriente es 170 A / cm 2 . Desplazamos intencionalmente las curvas para b y c por 2 nm para una identificación más fácil
Demostramos los niveles de concentración de huecos simulados y los perfiles de recombinación radiativa en los MQW para los LED A y C i ( yo =1, 2, 3, 4 y 5) en la Fig. 6b yc cuando la densidad de corriente es 170 A / cm 2 , respectivamente. Los niveles de concentración de huecos y los perfiles de recombinación radiativa se recogen en la ubicación de 120 μm de distancia del borde derecho de la mesa. Desplazamos espacialmente los niveles de concentración de huecos y los perfiles de recombinación radiativa en la Fig. 6b yc para los LED DUV investigados en 2 nm para una identificación más fácil, respectivamente. La concentración de orificios más baja en los MQW se observa claramente para el LED A y, por lo tanto, la recombinación radiativa más baja también se muestra en la Fig. 6c. La concentración de huecos y la recombinación radiativa en los MQW aumentan debido a la adopción de la unión NPN-AlGaN, y pueden aumentar aún más con el aumento de la composición de AlN en la capa de inserción de p-AlGaN.
La densidad de potencia óptica y EQE en función de la densidad de corriente de inyección se calculan y muestran además para los LED estudiados en la Fig. 7a. Como se muestra en la figura, el EQE y la densidad de potencia óptica aumentan una vez que se adopta la unión NPN-AlGaN. Además, la EQE y la densidad de potencia óptica se pueden promover aún más a medida que aumenta la composición de AlN para la capa de inserción de p-AlGaN. Contribuimos a esto a la distribución de agujeros laterales más homogénea en los MQW como se muestra en la Fig. 6a. Las características de corriente-voltaje para los LED A y C i ( yo =1, 2, 3, 4 y 5) se presentan en la Fig. 7b. El voltaje directo para el LED C1 muestra un pequeño aumento en comparación con el LED A, y el LED C5 muestra el voltaje directo más grande. La figura insertada muestra el voltaje directo para todos los LED estudiados cuando la densidad de corriente es 170 A / cm 2 . Cabe señalar que el voltaje directo disminuye para los LED C2, C3 y C4 en comparación con el LED A. Aunque la unión NPN-AlGaN aumenta la resistencia vertical para los LED DUV, la concentración de portadora más uniforme a lo largo de la dirección horizontal mejora la conductividad horizontal, lo que conduce a un voltaje directo reducido. Indica que el efecto de dispersión de corriente mejorado puede ayudar a reducir el voltaje de funcionamiento directo de los LED DUV siempre que la capa de dispersión de corriente esté correctamente diseñada [30]. Sin embargo, nuestro diseño modula la ruta de la corriente induciendo barreras y, por lo tanto, una altura de barrera demasiado alta puede sacrificar la conductancia eléctrica [21], por ejemplo, LED C5.
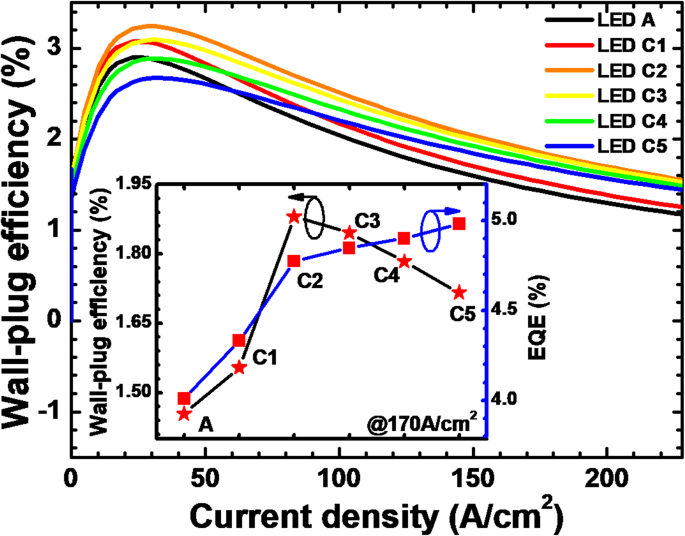
un EQE y densidad de potencia óptica en términos de corriente de inyección y b características de corriente-voltaje para LED A y C i ( yo =1, 2, 3, 4 y 5). Recuadro:los voltajes directos para los LED A y C i ( yo =1, 2, 3, 4 y 5) cuando la densidad de corriente es 170 A / cm 2
El WPE en función de la densidad de corriente de inyección para todos los dispositivos estudiados se muestra en la Fig. 8. Cuando se compara con el LED A, el WPE del LED C1 aumenta una vez que se adopta la unión NPN-AlGaN. WPE para LED C i ( yo =2, 3, 4 y 5) se puede mejorar aún más cuando la composición de AlN de la capa de p-AlGaN aumenta para la unión NPN-AlGaN. Sin embargo, el LED C2 muestra el WPE más alto debido al voltaje operativo directo más bajo a pesar de la densidad de potencia óptica relativamente baja entre los LED C i ( yo =2, 3, 4 y 5). Además, mostramos el WPE y EQE a la densidad de corriente de inyección de 170 A / cm 2 para todos los dispositivos investigados en la figura insertada. Es bien sabido que el efecto de apiñamiento de la corriente es grave con una alta densidad de corriente de inyección. La unión NPN-AlGaN para LED C5 juega mejor en homogeneizar la corriente. Sin embargo, el WPE no es satisfactorio una vez que el voltaje de operación directo aumenta significativamente. Por lo tanto, se optimizará completamente el valor del componente AlN de la capa de inserción p-AlGaN para la unión NPN-AlGaN antes de poder obtener la mejora tanto para EQE como para WPE.
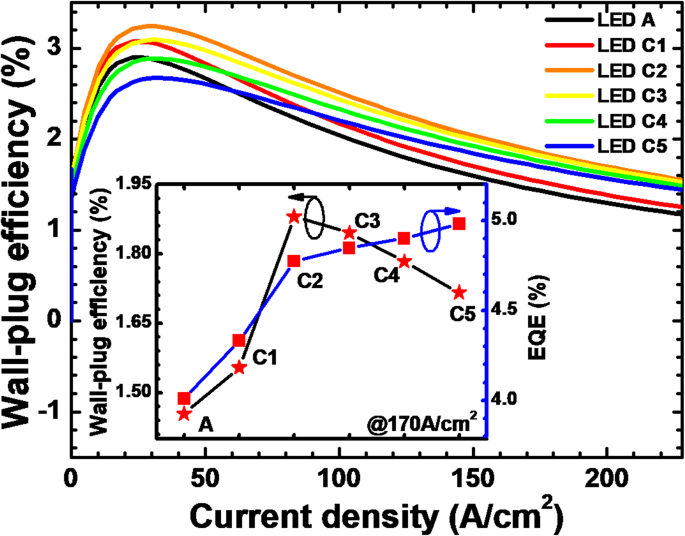
Relación entre WPE y la corriente de inyección para los LED A y C i ( yo =1, 2, 3, 4 y 5). Recuadro:EQE y WPE para los LED investigados estructurados con una capa p-AlGaN con varios componentes AlN cuando la densidad de corriente es 170 A / cm 2
Efecto de la concentración de dopaje de Mg para la capa p-AlGaN sobre el efecto de propagación actual
El ancho de la región de agotamiento para la unión NPN-AlGaN se puede gestionar variando la concentración de dopaje de Mg para la capa de inserción de p-AlGaN, y la altura de la barrera de la banda de conducción también cambiará en consecuencia. Por tanto, el valor de R npn se puede aumentar una vez que la región de agotamiento para la unión NPN-AlGaN se vuelve amplia, y el valor de I 1 / Yo 2 se reducirá, es decir, se puede mejorar el efecto de propagación de corriente para los LED DUV. Para aclarar mejor el punto, se han diseñado e investigado cinco LED DUV con diferentes concentraciones de dopaje de Mg para la capa de inserción de p-AlGaN en la unión NPN-AlGaN. Establecimos las concentraciones de dopaje de Mg para la capa de p-AlGaN en 3 × 10 17 , 7,5 × 10 17 , 1,7 × 10 18 , 2 × 10 18 y 3 × 10 18 cm −3 para LED D i ( yo =1, 2, 3, 4 y 5), respectivamente. El espesor y la composición de AlN para la capa de inserción de p-AlGaN son 20 nm y 0,61, respectivamente. Adoptamos dos uniones NPN-AlGaN. Como se muestra en la Tabla 2, la altura de la barrera de la banda de conducción aumenta a medida que aumenta la concentración de dopaje de Mg para la capa de p-AlGaN. Luego, calculamos y mostramos la concentración del agujero lateral en el último pozo cuántico cuando la densidad de corriente es de 170 A / cm 2 en la Fig. 9a, y es obvio que, en comparación con la distribución de los orificios laterales para el LED A, la distribución de los orificios laterales se vuelve más uniforme cuando se introduce la unión NPN-AlGaN para los LED DUV. Además, se puede obtener una distribución de agujeros aún más homogeneizada una vez que aumenta la concentración de dopaje de Mg para la capa p-AlGaN en la unión NPN-AlGaN.
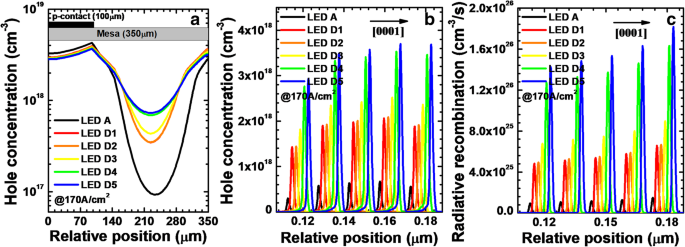
un Concentración de agujeros horizontales en el LQW, b niveles de concentración de agujeros y c Perfiles de recombinación radiativa en los MQW para LED A y D i ( yo =1, 2, 3, 4 y 5) cuando la densidad de corriente es 170 A / cm 2 . Desplazamos intencionalmente las curvas para b y c por 2 nm para una identificación más fácil
Luego, los niveles de concentración de orificios calculados y los perfiles de recombinación radiativa en los MQW se demuestran para todos los LED estudiados en la Fig. 9b yc cuando la densidad de corriente es 170 A / cm 2 , respectivamente, y la ubicación donde se recopilan los datos está a 120 μm del borde derecho de la mesa. Como era de esperar, los LED D i ( yo =1, 2, 3, 4 y 5) tienen los niveles de concentración de orificios y los perfiles de recombinación radiativa más altos en los MQW en comparación con el LED A, mientras que la concentración de orificios y la recombinación radiativa aumentan con las concentraciones crecientes de dopaje de Mg en la capa p-AlGaN para los LED con uniones NPN-AlGaN. Contribuimos al aumento de la concentración de orificios en los MQW para LED D i ( yo =1, 2, 3, 4 y 5) al efecto de propagación de corriente mejorado.
Debido al efecto de amontonamiento de corriente reducido y al aumento de la concentración de orificios en los MQW, los LED D i ( yo =1, 2, 3, 4 y 5) muestran en consecuencia el EQE promovido y la densidad de potencia óptica (ver en la Fig. 10a). Las características de corriente-voltaje de los LED A y D i ( yo =1, 2, 3, 4 y 5) se ilustran en la Fig. 10b. Aparentemente, los voltajes de funcionamiento directo para los LED D i ( yo =1, 2, 3, 4 y 5) aumentan con el aumento de la concentración de dopaje de Mg para la capa de inserción de p-AlGaN. Entre ellos, el LED D5 muestra el voltaje de encendido más grande, y esto se atribuye al diodo parásito que es causado por el nivel muy alto de concentración de dopaje de Mg en la capa p-AlGaN. De acuerdo con la figura insertada de la Fig. 10b, también se ve que el LED D5 muestra el voltaje de operación directo más grande entre todos los LED estudiados cuando la densidad de corriente de inyección es de 170 A / cm 2 .
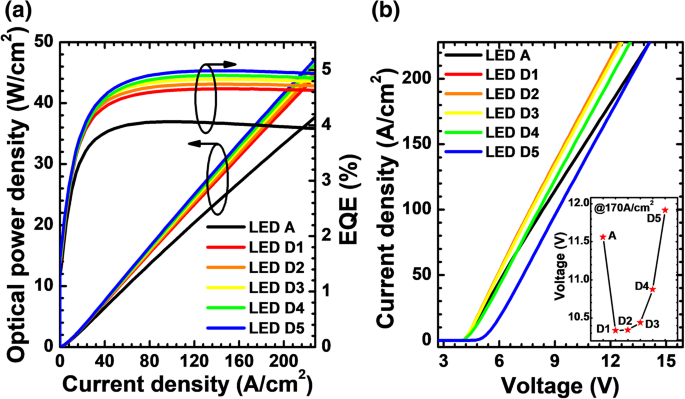
un EQE y densidad de potencia óptica en términos de corriente de inyección y b características de corriente-voltaje para LED A y D i ( yo =1, 2, 3, 4 y 5). Recuadro:los voltajes directos para los LED A y D i ( yo =1, 2, 3, 4 y 5) cuando la densidad de corriente es 170 A / cm 2
Para un análisis más completo, calculamos el WPE en función de la densidad de corriente de inyección para todos los LED estudiados como se muestra en la Fig. 11. Los WPE para LED D i ( yo =1, 2, 3 y 4) son más altos que los del LED A. El WPE del LED D5 supera al del LED A solo cuando la densidad de corriente de inyección es superior a 43 A / cm 2 . El WPE más bajo para el LED D5 con una densidad de corriente inferior a 43 A / cm 2 se debe al consumo de voltaje directo adicional en la unión NPN-AlGaN como se mencionó anteriormente. En la figura insertada, se puede ver que el EQE muestra una tendencia ascendente con el aumento de la concentración de dopaje de Mg para la capa p-AlGaN. Sin embargo, el WPE disminuye con el aumento adicional de la concentración de dopaje de Mg para la capa de p-AlGaN. Por lo tanto, llegamos a la conclusión de que el efecto de propagación de la corriente y el voltaje directo son muy sensibles al nivel de dopaje de Mg de la capa de inserción de p-AlGaN.
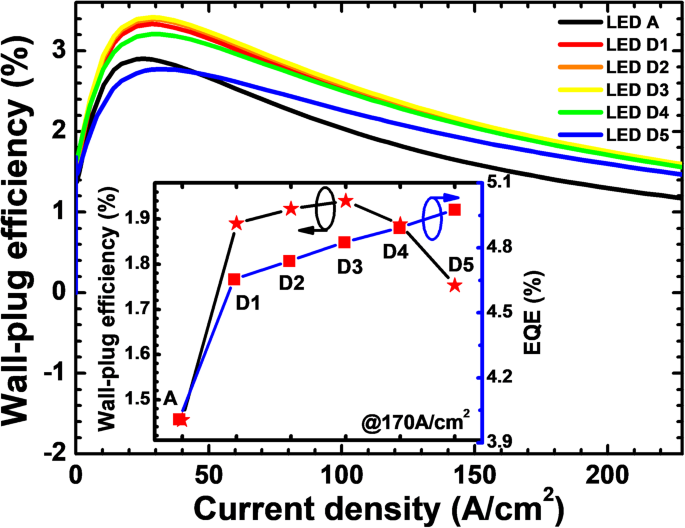
Relación entre WPE y la corriente de inyección para LED A y D i ( yo =1, 2, 3, 4 y 5). Recuadro:EQE y WPE para los LED investigados estructurados con una capa de p-AlGaN con varias concentraciones de dopaje cuando la densidad de corriente es de 170 A / cm 2
Efecto del grosor de la capa p-AlGaN sobre el efecto de propagación actual
En esta sección, se investiga el impacto del grosor de la capa de inserción de p-AlGaN en la unión NPN-AlGaN en el rendimiento del LED. En primer lugar, se aplican dos uniones NPN-AlGaN (es decir, unión NPNPN-AlGaN) para todos los LED DUV estudiados, de los cuales la composición de AlN y la concentración de dopaje para la capa p-AlGaN en la unión NPN-AlGaN son 0,61 y 1,5 × 10
18
cm
−3
, respectivamente. Luego, establecemos diferentes espesores de 18, 20, 24, 28 y 32 nm para la capa p-AlGaN en los LED T i ( yo =1, 2, 3, 4 y 5), respectivamente. Las alturas de barrera de la banda de conducción calculadas para cada unión NPN-AlGaN se presentan en la Tabla 3. Se puede ver que la altura de la barrera de la banda de conducción aumenta cuando la capa de p-AlGaN en la unión NPN-AlGaN se vuelve gruesa, lo que permite la reducción de
Calculamos y mostramos la concentración del agujero horizontal en el LQW para los LED A y T i ( yo =1, 2, 3, 4 y 5) cuando la densidad de corriente es 170 A / cm 2 en la Fig. 12a. Claramente, la distribución de los orificios se vuelve más homogénea cuando se introduce la unión NPN-AlGaN en la estructura del LED DUV, y se vuelve más uniforme si el grosor de la capa p-AlGaN en la unión NPN-AlGaN aumenta. El efecto de apiñamiento de corriente reducido se atribuye a la mayor altura de la barrera de la banda de conducción en la región de agotamiento provocada por la capa de p-AlGaN engrosada en la unión NPN-AlGaN. Las figuras 12b yc muestran los niveles de concentración de huecos y los perfiles de recombinación radiativa, respectivamente, para los LED A y T i ( yo =1, 2, 3, 4 y 5) con una densidad de corriente de inyección de 170 A / cm 2 . Los niveles de concentración de huecos y los perfiles de recombinación radiativa se recogen en la ubicación de 120 μm de distancia del borde derecho de la mesa. Podemos ver que, en comparación con el LED A en los MQW, los LED T i ( yo =1, 2, 3, 4 y 5) muestran los niveles de concentración de huecos más altos y, por lo tanto, los perfiles de recombinación radiativa más altos. Una vez que se aumenta el grosor de la capa de p-AlGaN, se puede obtener una concentración de orificios mejorada y una recombinación radiativa en los MQW.
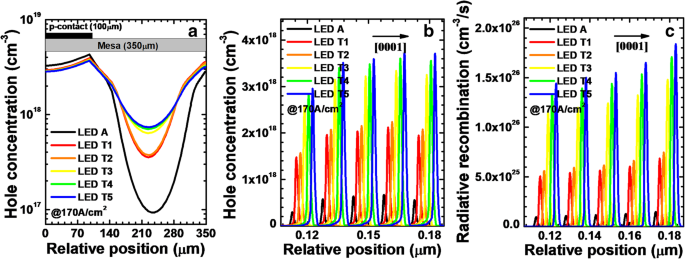
un Concentración de agujeros horizontales en el LQW, b niveles de concentración de agujeros y c Perfiles de recombinación radiativa en los MQW para LED A y T i ( yo =1, 2, 3, 4 y 5) cuando la densidad de corriente es 170 A / cm 2 . Desplazamos intencionalmente las curvas para b y c por 2 nm para una identificación más fácil
La densidad de potencia óptica observada y EQE para todos los LED estudiados en la Fig.13a concuerdan bien con los resultados mostrados en la Fig.12c, de modo que el aumento del espesor de la capa p-AlGaN en la unión NPN-AlGaN puede mejorar la densidad de potencia óptica y EQE. Además, calculamos y mostramos las características de corriente-voltaje para los LED A y T i ( yo =1, 2, 3, 4 y 5) en la figura 13b. Muestra que los voltajes de funcionamiento directo para los LED T i ( yo =1, 2, 3 y 4) presentan una reducción significativa en comparación con la del LED A con una densidad de corriente de inyección superior a 102 A / cm 2 , que se debe al efecto de propagación de corriente significativamente mejorado después de adoptar el NPN-Al 0.61 Ga 0,39 Unión N como se mencionó anteriormente. Sin embargo, una capa de p-AlGaN demasiado gruesa puede causar un aumento en el voltaje de encendido debido al diodo parásito N-AlGaN / P-AlGaN, por ejemplo, el LED T5 tiene el voltaje de operación directo más alto entre todos los LED investigados cuando la corriente la densidad es de 170 A / cm 2 , que también se muestra en la figura insertada de la Fig. 13b.
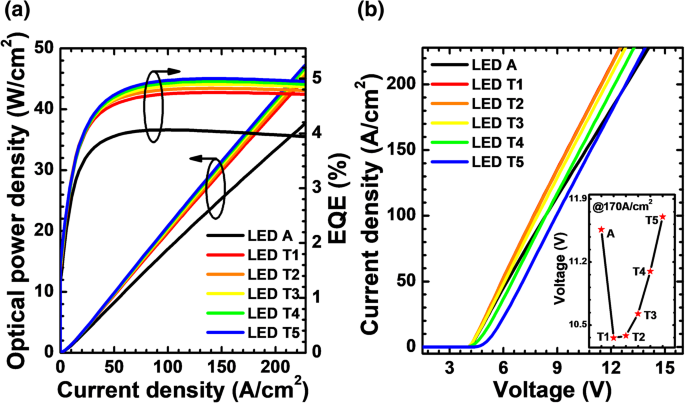
un EQE y densidad de potencia óptica en términos de corriente de inyección y b características de corriente-voltaje para LED A y T i ( yo =1, 2, 3, 4 y 5). Recuadro:los voltajes directos para los LED A y T i ( yo =1, 2, 3, 4 y 5) cuando la densidad de corriente es 170 A / cm 2
Con este fin, es particularmente importante discutir más a fondo el impacto de un voltaje de operación directo más alto en el rendimiento del LED DUV. Por lo tanto, calculamos el WPE para todos los dispositivos de investigación y mostramos los resultados en la Fig. 14. Podemos ver que el WPE para todos los LED con unión NPN-AlGaN exhibe una mejora distinta en comparación con el del LED A. Los WPE presentados en el recuadro La figura también indica que el LED DUV con estructura NPN-AlGaN puede ahorrar más energía eléctrica que el LED A. Vale la pena mencionar que el grosor de la capa de p-AlGaN no se puede mejorar a ciegas, de modo que solo cuando el grosor se establece correctamente, entonces Se puede obtener WPE completamente maximizado.
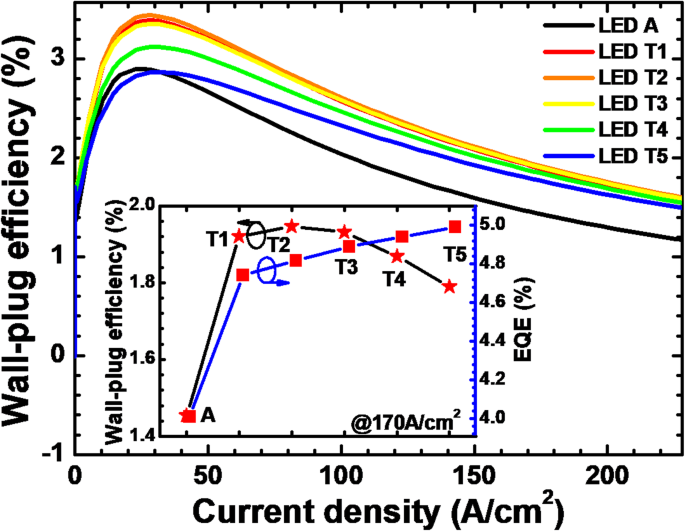
Relación entre WPE y la corriente de inyección para LED A y T i ( yo =1, 2, 3, 4 y 5). Recuadro:el EQE y WPE para los LED investigados estructurados con una capa de p-AlGaN con varios espesores cuando la densidad de corriente es de 170 A / cm 2
Efecto del número de unión NPN-AlGaN sobre el efecto de propagación actual
Finalmente, investigamos la influencia del número de unión NPN-AlGaN en el efecto de propagación actual. El p-Al 0.61 Ga 0,39 Se adopta una capa N en la unión NPN-AlGaN para los LED DUV propuestos en esta sección, para los cuales la concentración y el espesor de dopaje de Mg son 1.5 × 10 18 cm −3 y 20 nm, respectivamente. LED N i ( yo =1, 2, 3, 4 y 5) tienen 1, 2, 3, 4 y 5 uniones NPN-AlGaN, respectivamente. Como se presenta en la Tabla 4, las alturas de la barrera de conducción de todas las uniones NPN-AlGaN son casi las mismas para los LED N i ( yo =1, 2, 3, 4 y 5). Sin embargo, la altura total de la barrera de conducción para NPN-Al 0.61 Ga 0,39 N uniones en cada LED DUV investigado seguramente aumenta cuando más NPN-Al 0.61 Ga 0,39 Se utilizan uniones N. Por tanto, el valor de N × R npn se puede mejorar, lo que ayuda a distribuir mejor la corriente horizontalmente, es decir, el valor aumentado de I 2 en Eq. 3 se favorece. El efecto de propagación de corriente mejorado se puede observar en la Fig. 15a. La concentración de agujeros en el LQW puede volverse más uniforme si el número de unión NPN-AlGaN aumenta.
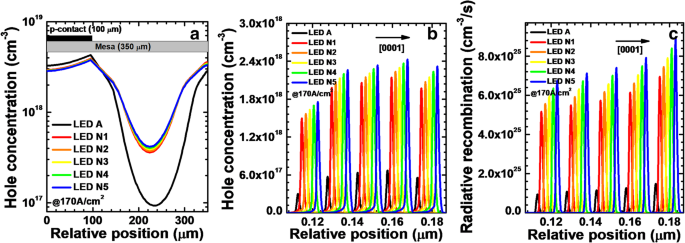
un Concentración de agujeros horizontales en el LQW, b concentración de agujeros y c Perfiles de recombinación radiativa en los MQW para LED A y N i ( yo =1, 2, 3, 4 y 5) cuando la densidad de corriente es 170 A / cm 2 . Desplazamos intencionalmente las curvas para b y c por 2 nm para una identificación más fácil
Luego, los niveles de concentración de huecos y los perfiles de recombinación radiativa en los MQW para LED N i ( yo =1, 2, 3, 4 y 5) cuando la densidad de corriente es 170 A / cm 2 se muestran en la Fig. 15b yc, respectivamente. Recopilamos los niveles de concentración de huecos y los perfiles de recombinación radiativa en la ubicación de 120 μm de distancia del borde de la mesa de la derecha. La concentración de huecos y la recombinación radiativa se mejoran mediante el uso de NPN-Al 0.61 Ga 0,39 Unión N, y se pueden obtener más mejoras cuando se incluyen más uniones NPN-AlGaN. Atribuido a la concentración de orificios mejorada en los MQW, la densidad de potencia óptica y EQE para los LED DUV con unión NPN-AlGaN también muestra una mejora significativa. Las características de corriente-voltaje para todos los dispositivos estudiados se muestran en la Fig. 16b, que ilustra que los voltajes de operación directa para los LED N i ( yo =1, 2, 3, 4 y 5) son más bajas que las del LED A, y esto indica que el efecto de propagación de la corriente puede ayudar a reducir el voltaje directo una vez que la concentración de dopaje de Mg, el espesor y la composición de AlN para el p- La capa de AlGaN se aplica apropiadamente a la unión NPN-AlGaN. El voltaje de encendido para todos los LED con unión NPN-AlGaN es casi el mismo que el del LED A, lo que ilustra el impacto insignificante de la unión parásita N-AlGaN / P-AlGaN con polarización inversa si la concentración de dopaje de Mg en el p- La capa AlGaN está configurada correctamente, es decir, la capa p-AlGaN debe agotarse por completo antes de que el dispositivo se desvíe.
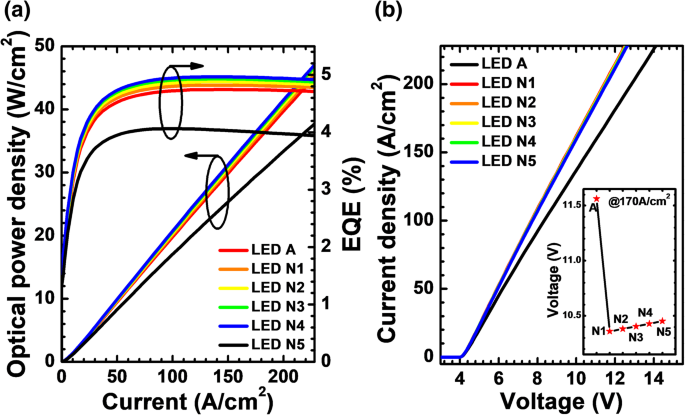
un EQE y densidad de potencia óptica en términos de corriente de inyección y b características de corriente-voltaje para LED A y N i ( yo =1, 2, 3, 4 y 5). Recuadro:los voltajes directos para los LED A y N i ( yo =1, 2, 3, 4 y 5) cuando la densidad de corriente es 170 A / cm 2
Por último, pero no menos importante, los WPE también se han demostrado para LED N i ( yo =1, 2, 3, 4 y 5) en la Fig. 17. Los WPE de todos los LED DUV con NPN-Al 0.61 Ga 0,39 La unión N se ha promovido debido a la tensión de funcionamiento directa reducida. En la figura insertada, mostramos el EQE y WPE para los LED A y N i ( yo =1, 2, 3, 4 y 5) cuando la densidad de corriente es 170 A / cm 2 . Aunque el EQE y WPE para LED N i ( yo =1, 2, 3, 4 y 5) aumentan con el aumento del número de unión NPN-AlGaN, claramente, podemos ver que la magnitud del aumento está disminuyendo gradualmente, lo que indica que el número de unión NPN-AlGaN también debe establecerse en un número adecuado, y creemos firmemente que el dispositivo consumirá más energía eléctrica si se adoptan demasiadas uniones NPN-AlGaN en los LED DUV.
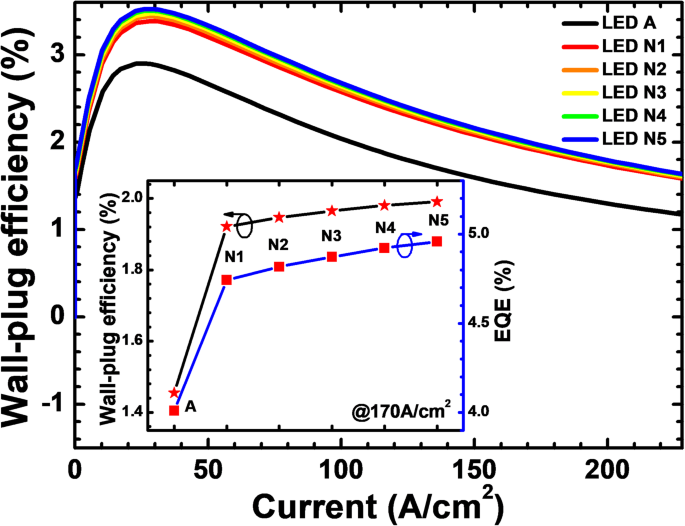
Relación entre WPE y la corriente de inyección para LED A y N i ( yo =1, 2, 3, 4 y 5). Recuadro:el EQE y WPE para los LED investigados estructurados con varios números NPN-AlGaN cuando la densidad de corriente es 170 A / cm 2
Conclusiones
Para concluir, hemos sugerido incrustar la unión NPN-AlGaN en la capa de proveedor de electrones de tipo n para LED DUV. Después de discusiones exhaustivas y sistemáticas, encontramos que la unión NPN-AlGaN puede reducir el efecto de apiñamiento actual en la capa del proveedor de orificios de tipo p y mejorar la inyección de orificios para los LED DUV. La unión NPN-AlGaN puede ajustar la conductividad para la capa proveedora de electrones de tipo n de modo que se pueda manipular la ruta de la corriente en la capa proveedora de huecos tipo p. Para exploraciones adicionales, hemos investigado el impacto de diferentes parámetros para las uniones NPN-AlGaN en el efecto de propagación actual, el EQE y el WPE. Encontramos que la corriente se puede homogeneizar aún más si la composición de AlN, la concentración de dopaje de Mg, el grosor de la capa de inserción de p-AlGaN y el número de unión NPN-AlGaN se aumentan correctamente. Aunque el EQE se puede promover utilizando las uniones NPN-AlGaN propuestas, el WPE no siempre mejora de manera monótona, lo que surge de la caída de voltaje adicional en las barreras dentro de las uniones NPN-AlGaN. Por lo tanto, se prestará más atención al diseñar capas de dispersión de corriente NPN-AlGaN para LED DUV. Sin embargo, creemos firmemente que nuestros resultados han proporcionado una estrategia de diseño alternativa para reducir el efecto de aglomeración actual de los LED DUV. Mientras tanto, también hemos introducido físicas de dispositivos adicionales y, por lo tanto, son muy útiles para la comunidad.
Disponibilidad de datos y materiales
Los datos y el análisis del trabajo actual están disponibles a través de los autores correspondientes previa solicitud razonable.
Abreviaturas
- APSYS:
-
Modelos físicos avanzados de dispositivos semiconductores
- CL:
-
Capa de difusión actual
- LED DUV:
-
Diodos emisores de luz ultravioleta profunda
- EQE:
-
Eficiencia cuántica externa
- ITO:
-
Óxido de indio y estaño
- LQW:
-
Último pozo cuántico
- MQW:
-
Múltiples pozos cuánticos
- NPN-AlGaN:
-
n-AlGaN / p-AlGaN / n-AlGaN
- IQE:
-
Eficiencia cuántica interna
- SRH:
-
Shockley-Read-Hall
- WPE:
-
Eficiencia del enchufe de pared
- ZGO:
-
Galato de zinc
Nanomateriales
- Los 4 tipos de unidades primarias ranuradas para sujetadores
- Defensa de los chips neuromórficos para la informática de IA
- El diseño de la capa de emisión para multiplicadores de electrones
- Síntesis ecológica de puntos cuánticos de núcleo / carcasa de InP / ZnS para su aplicación en diodos emisores de luz sin metales pesados
- El precursor de titanio óptimo para la fabricación de una capa compacta de TiO2 para células solares de perovskita
- Diodos emisores de luz ultravioleta basados en AlGaN casi sin caída de eficiencia con una capa de bloqueo de electrones tipo p de superrejilla diseñada específicamente para una alta eficiencia de…
- Diodos emisores de luz de perovskita de alta luminancia con disolvente de alcohol de alta polaridad que trata PEDOT:PSS como capa de transporte de huecos
- En la capa de difusión de corriente p-AlGaN / n-AlGaN / p-AlGaN para diodos emisores de luz ultravioleta profunda basados en AlGaN
- Influencia del ancho del pozo cuántico en las propiedades de electroluminiscencia de los diodos emisores de luz ultravioleta profunda AlGaN a diferentes temperaturas
- Integración de perovskitas ecológicas para diodos emisores de luz blanca de alta eficiencia
- Efectos de la estructura de contacto tipo p mallada en el efecto de extracción de luz para diodos emisores de luz ultravioleta ultravioleta profunda de chip giratorio



