En la capa de difusión de corriente p-AlGaN / n-AlGaN / p-AlGaN para diodos emisores de luz ultravioleta profunda basados en AlGaN
Resumen
En este informe, se han descrito e investigado diodos emisores de luz ultravioleta profunda (LED DUV) basados en AlGaN con diferentes capas de difusión de corriente estructuradas p-AlGaN / n-AlGaN / p-AlGaN (PNP-AlGaN). Según nuestros resultados, la estructura PNP-AlGaN adoptada puede inducir una barrera de energía en la capa de inyección del agujero que puede modular la distribución de corriente lateral. También encontramos que el efecto de propagación de la corriente puede verse fuertemente afectado por el grosor, la concentración de dopaje, el bucle de PNP y la composición de AlN para la capa de n-AlGaN insertada. Por lo tanto, si la estructura PNP-AlGaN está diseñada correctamente, el voltaje directo, la eficiencia cuántica externa, la potencia óptica y la eficiencia del enchufe de pared para los LED DUV propuestos se pueden mejorar significativamente en comparación con el LED DUV convencional sin el PNP. -Estructura AlGaN.
Introducción
Desde la primera aparición en 2003, los diodos emisores de luz ultravioleta profunda (LED DUV) basados en AlGaN han atraído mucho interés debido a su amplia gama de aplicaciones, como la esterilización del agua y la purificación del aire [1,2,3,4,5, 6,7]. Sin embargo, la eficiencia cuántica externa (EQE) de los LED DUV es inferior al 10% cuando la longitud de onda de emisión es inferior a 300 nm [8], lo que limita significativamente su aplicación posterior. El bajo EQE se debe en parte a la deficiente eficiencia cuántica interna (IQE). Se ha llamado mucho la atención sobre el hecho de que el IQE está notablemente influenciado por la inyección del portador y las luxaciones prolongadas [8]. Los LED DUV basados en AlGaN que se cultivan en sustratos aislantes de zafiro emplean la estructura de chip abatible para una mejor eficiencia de extracción de luz. Sin embargo, la estructura del LED DUV de chip invertido requiere que el electrodo n y el electrodo p estén en el mismo lado. Por lo tanto, se produce fácilmente la distribución de corriente lateral no homogénea, es decir, el efecto de apiñamiento de corriente [9]. El efecto de apiñamiento actual puede causar fácilmente el efecto de calentamiento de Joule local y la emisión de luz desigual [10, 11, 12]. Cabe mencionar que el sobrecalentamiento local deteriora gravemente la vida útil de los LED DUV. Además, la muy baja eficiencia de dopaje de Mg para la capa de inyección de agujeros basada en p-AlGaN rica en Al conduce a la mala conductividad eléctrica [13], lo que manifiesta aún más la importancia de mejorar la distribución de corriente para los LED DUV. Aunque Khan et al. han señalado que se debe prestar atención al hacinamiento actual en su artículo de revisión [14]; hasta ahora, el análisis detallado sobre el hacinamiento actual y las soluciones para él se han discutido menos para los LED DUV.
Se han informado extensas técnicas para promover la propagación de la corriente para los LED azules basados en GaN, y la propagación de la corriente se puede mejorar, por ejemplo, mediante la implantación selectiva de iones de la capa de p-GaN [15, 16], insertando una capa de bloqueo de la corriente (CBL) [17,18,19], produciendo selectivamente vacantes de nitrógeno para compensar los agujeros en la capa de p-GaN [20], optimizando el proceso de recocido para contacto óhmico [21]. Además de utilizar los enfoques posteriores a la fabricación, la capa de difusión de corriente también se puede obtener mediante el crecimiento epitaxial in situ en el sistema de deposición de vapor químico orgánico metálico (MOCVD). Ejemplos importantes son los siguientes:la estructura de superrejilla p-GaN / i-InGaN de período corto entre la estructura de múltiples pozos cuánticos (MQW) y la capa de p-GaN [22, 23], las uniones del túnel [24, 25] y la barrera uniones [10]. Sin embargo, rara vez se pueden encontrar informes sobre epi-estructuras para mejorar la difusión de corriente de los LED DUV. En esta carta, proponemos utilizar la capa p-AlGaN / n-AlGaN / p-AlGaN (PNP-AlGaN) para distribuir mejor la corriente lateral de los LED DUV. La estructura de PNP-AlGaN puede generar la barrera de energía en la banda de valencia de la capa de inyección del agujero tipo p. La barrera de energía puede modular la resistividad eléctrica para la capa de inyección de orificios de tipo p y, por lo tanto, se puede ajustar la trayectoria del flujo de corriente. Al diseñar correctamente la capa de distribución de corriente PNP-AlGaN, se puede mejorar el EQE, la eficiencia del enchufe de pared (WPE) y el voltaje directo. Además, este trabajo también investiga exhaustivamente la sensibilidad de la propagación de la corriente, el EQE, el WPE y el voltaje directo al bucle PNP-AlGaN, la concentración de dopaje de Si, el espesor y la composición de AlN para la capa de n-AlGaN insertada. de la arquitectura PNP-AlGaN.
Métodos de investigación y modelos físicos
Para aclarar mejor los mecanismos de propagación de corriente para los LED DUV basados en AlGaN, se diseñan diferentes dispositivos LED DUV (ver Fig. 1a). Todos los LED DUV constan de un Al 0.60 de tipo n de 4 μm de espesor Ga 0.40 Capa N con una concentración de dopaje de Si de 5 × 10 18 cm −3 . A continuación, cinco períodos de Al 0.45 de 3 nm Ga 0,55 N / 12 nm Al 0.56 Ga 0,44 Siguen N MQW. Luego tapamos los MQW con un tipo p de 18 nm de grosor Al 0.60 Ga 0.40 N capa de bloqueo de electrones (p-EBL), sobre la cual un Al de tipo p de 198 nm de espesor 0.40 Ga 0.60 La capa N y una capa superior de GaN de tipo p de 50 nm de espesor se emplean como capa de inyección de orificios. La concentración de agujeros para las capas de tipo p se establece en 3 × 10 17 cm −3 . Para los LED DUV con las estructuras PNP-AlGaN propuestas, el tipo p convencional Al 0.40 Ga 0.60 La capa N se reemplaza por p-Al 0.40 Ga 0.60 N / n-Al x Ga 1- x N / p-Al 0.40 Ga 0.60 Capa N. La Figura 1b presenta el diagrama de estructura esquemático para la capa PNP-AlGaN. La Figura 1c muestra el diagrama esquemático de bandas de valencia para la estructura PNP-AlGaN, desde el cual podemos ver la barrera para huecos. La barrera se genera debido al agotamiento de los dopantes de Si en el delgado n-Al x Ga 1- x Capa N [26]. Esta barrera es muy importante para determinar la ruta del flujo de corriente y el rendimiento del dispositivo para los LED DUV. Posteriormente se proporcionará un análisis detallado.
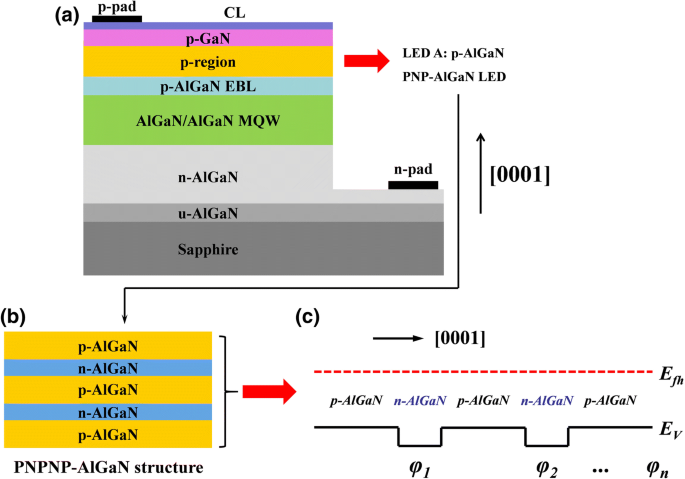
un Diagramas esquemáticos de los dispositivos estudiados (LED de referencia A y LED PNPNP-AlGaN), b diagramas esquemáticos de la estructura PNP-AlGaN con dos uniones PNP-AlGaN, c Diagrama esquemático de bandas de valencia para la estructura PNP-AlGaN con múltiples uniones PNP-AlGaN, en las que φ 1 , φ 2 y φ n denotar la altura de la barrera para cada unión PNP-AlGaN a lo largo de la orientación [0001] y n representa el número de unión PNP-AlGaN
Para ilustrar más el mecanismo de la estructura PNP-AlGaN en la distribución de la corriente, mostramos el circuito equivalente simplificado y las rutas de flujo de corriente para el LED DUV desarrollado en sustratos de zafiro en la Fig. 2a. La corriente fluye tanto vertical como lateralmente desde la región p-AlGaN a la región n-AlGaN. Normalmente, el grosor de la capa de propagación actual (CL) (es decir, 200 nm para nuestros dispositivos) es mucho más pequeño que el de la capa n-AlGaN (es decir, 4 μm para nuestros dispositivos). Por tanto, la resistencia eléctrica del CL es mucho mayor que la de la capa de inyección de electrones n-AlGaN. Entonces, la corriente tiende a acumularse debajo del electrodo p, es decir, J 1 > J 2 > J 3 > J 4 > .....> J n , que se conoce como el efecto de hacinamiento actual [27]. Afortunadamente, el efecto de apiñamiento de la corriente se puede suprimir incorporando la unión PNP-AlGaN en la capa de inyección del orificio tipo p, y el mecanismo subyacente se puede interpretar usando la Fig. 2b, de modo que dividimos la corriente total en una parte vertical ( J 1 ) y una parte horizontal ( J 2 ). Según Ref. [27], la relación entre J 1 y J 2 se puede vincular por Eq. (1) como sigue,
$$ \ frac {J_1} {J_2} \ cong \ frac {l} {\ frac {\ rho_p} {\ rho _ {\ mathrm {CL}}} {t} _p + \ frac {N \ cdot {\ rho} _ {\ mathrm {PNP}}} {\ rho _ {\ mathrm {CL}}}}, $$ (1)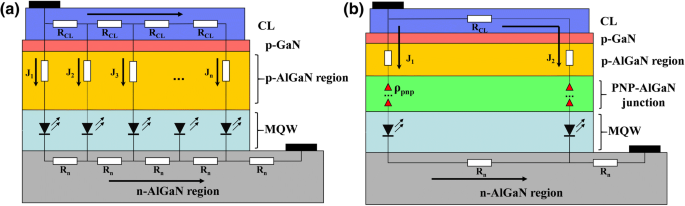
un Circuito equivalente de LED DUV con esquema de inyección de corriente lateral ( J 1 > J 2 > J 3 > J 4 > ……> J n ) y b circuito equivalente simplificado del LED con estructura PNP-AlGaN, las rutas de corriente ( J 1 y J 2 ) también se muestran
donde l es la longitud de la ruta de la corriente horizontal, t p es el espesor, ρ p representa la resistividad vertical para la capa de inyección de orificios tipo p, ρ CL denota la resistividad de la capa de propagación de corriente depositada ex situ, ρ PNP significa la resistividad interfacial específica inducida en cada unión PNP-AlGaN, y N representa el número de la unión PNP-AlGaN. Basado en Eq. (1), inferimos que podemos aumentar J 2 reduciendo ρ CL . La ecuación (1) también indica que el aumento adecuado de la resistencia vertical (es decir, ρ p × t p ) también ayuda a mejorar J 2 . Alternativamente, la resistencia vertical puede aumentar al incluir N · ρ PNP . Sin embargo, el valor de N · ρ PNP puede verse afectado por el número de conexiones PNP-AlGaN. Además, el valor de ρ PNP está sujeto a la concentración de dopaje, el espesor y la composición de AlN del n-Al x Ga 1- x Capa N. Por lo tanto, los detalles sobre las diferentes uniones PNP-AlGaN se discutirán posteriormente.
Las investigaciones sobre la física del dispositivo se llevan a cabo utilizando APSYS [28]. La relación de compensación de la banda de energía entre la compensación de la banda de conducción y la compensación de la banda de valencia para la heterounión AlGaN / AlGaN se establece en 50:50 [29]. El nivel de polarización se establece en 40% para calcular las cargas inducidas por polarización en las interfaces mal emparejadas de la red [30, 31]. El coeficiente de recombinación Auger y la vida útil de la recombinación Shockley-Read-Hall (SRH) se establecen en 1.0 × 10 −30 cm 6 / s [27] y 10 ns [32], respectivamente. La eficiencia de extracción de luz se establece en ~ 8% para los LED DUV [33]. Otros parámetros de los semiconductores III-V que contienen nitrógeno se pueden encontrar en otra parte [34].
Resultados y discusiones
Prueba de la eficacia de la unión PNP-AlGaN en la difusión de la corriente para LED DUV
Para mostrar la eficacia de la estructura PNP-AlGaN en la distribución de la corriente para el LED DUV, el LED DUV de referencia (es decir, el LED A) sin estructura PNP-AlGaN y el LED DUV con la estructura PNP-AlGaN (es decir, el LED B) son estudió. Tenga en cuenta que la información arquitectónica para los LED DUV se ha proporcionado en la sección de Métodos de investigación y modelos físicos, excepto la configuración PNP-AlGaN para el LED B. El LED B tiene dos bucles PNP-AlGaN, es decir, estructura PNPNP-AlGaN. Cada unión PNP-AlGaN comprende el p-Al 0.40 Ga 0.60 N / n-Al 0.40 Ga 0.60 N / p-Al 0.40 Ga 0.60 Estructura N, para la cual la concentración de dopaje de Si en el n-Al de 20 nm de espesor 0.40 Ga 0.60 N capa de inserción es 5.3 × 10 17 cm −3 . Calculamos y mostramos el diagrama de bandas de energía para el LED B a la densidad de corriente de 170 A / cm 2 en la Fig. 3a. Podemos ver que, en comparación con el LED A (la banda de energía no se muestra aquí), los agujeros encontrarán dos barreras antes de ser inyectados en los MQW. Las barreras en la banda de valencia aquí pueden difundir efectivamente la corriente y homogeneizar mejor los agujeros lateralmente. Para abordar aún más nuestro punto y para el propósito de la demostración, mostramos el perfil de concentración del agujero lateral en el pozo cuántico más cercano al p-EBL [es decir, el último pozo cuántico (LQW)] en la Fig. 3b, que encuentra que el La distribución de agujeros en el LED B muestra un perfil más uniforme en el LQW. Las observaciones de la Fig. 2b concuerdan bien con los diagramas de bandas de energía de la Fig. 3a y nuestro análisis anterior, de modo que la estructura PNP-AlGaN resulta útil para mejorar el efecto de propagación de la corriente.
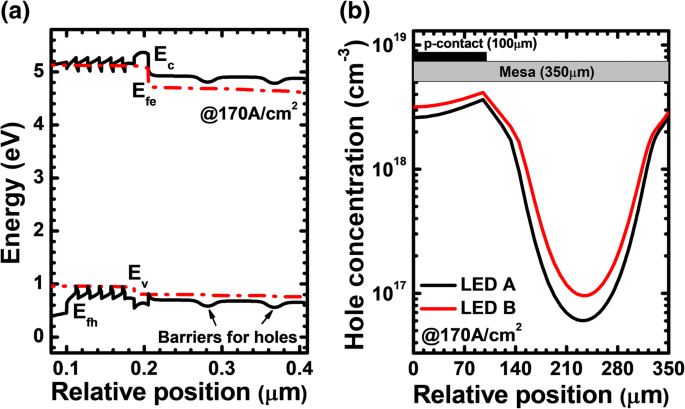
un Diagrama de bandas de energía para LED B a la densidad de corriente de 170 A / cm 2 . E c , E v , E fe y E fh denotan la banda de conducción, la banda de cenefa y los niveles de cuasi-Fermi para electrones y huecos, respectivamente, b Distribución de orificios laterales en el último pozo cuántico para LED A y B a la densidad de corriente de 170 A / cm 2 , respectivamente
A continuación, mostramos los perfiles para la concentración de huecos y la tasa de recombinación radiativa en la región MQW para los LED A y B en la Fig. 4a, b, respectivamente. Tenga en cuenta que para controlar el efecto de propagación de la corriente, los datos de la Fig. 4a, b se recopilan en la posición de 230 µm de distancia del borde de la mesa izquierdo. Se encuentra que la distribución de corriente mejorada para el LED B también permite la inyección de orificios promovida en los MQW. La mejora de la concentración de huecos en los MQW genera la tasa de recombinación radiativa mejorada para el LED B de acuerdo con la Fig. 4b.

un Perfiles de concentración de pozos y b Tasa de recombinación radiativa en la región MQW para LED A y B a la densidad de corriente de 170 A / cm 2 , respectivamente
La Figura 5a luego demuestra el EQE y la densidad de potencia óptica en términos del nivel de densidad de corriente de inyección para los LED A y B. Los niveles de EQE para los LED A y B son 3.38% y 4.13%, respectivamente, mostrando una mejora del rendimiento del 22.2% en la densidad de corriente de 170 A / cm 2 . Estas mejoras observadas se atribuyen al mejor efecto de propagación de la corriente y a la inyección de orificios mejorada en la región MQW para el LED B. Como se mencionó anteriormente, la adopción de la estructura PNP-AlGaN puede conducir a la barrera de energía en la banda de valencia, que puede influir en la tensión directa. La especulación está probada al referirse a la Fig. 5b que demuestra el voltaje directo ligeramente mayor para el LED B. A pesar del voltaje directo más alto para el LED B, la eficiencia del enchufe de pared para el LED es aún mayor que la del LED A según la Fig. 5c , de modo que los números son 3,56% y 4,27% para los LED A y B al nivel de densidad de corriente de 170 A / cm 2 , respectivamente. Si comparamos más las Fig. 5a, c, podemos encontrar que el WPE tiene una caída más pronunciada para el LED B, y esto se atribuye a la caída de voltaje adicional en la unión PNP-AlGaN. Por lo tanto, es fundamentalmente importante realizar un estudio más completo que revele la sensibilidad del EQE, el voltaje directo y el WPE a diferentes diseños de PNP-AlGaN.
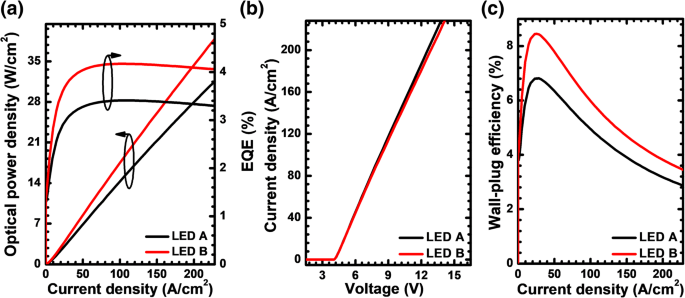
un Densidad de potencia de salida óptica y EQE en función de la corriente de inyección, b característica corriente-voltaje, c WPE en términos de la corriente de inyección para los LED A y B, respectivamente
Impacto del grosor de la capa n-AlGaN en el rendimiento del dispositivo
Según Eq. (1), podemos concluir que se puede obtener un flujo de corriente horizontal mejorado aumentando el valor de N · ρ PNP . La altura de la barrera en la unión PNP-AlGaN aumenta cuando el n-Al 0.40 Ga 0.60 N capa se vuelve gruesa de modo que una ρ más grande PNP puede obtenerse, lo cual es beneficioso para el efecto de propagación de corriente mejorado. Sin embargo, una vez que el n-Al 0.40 Ga 0.60 N capa es demasiado gruesa, más agujeros en el p-Al 0.40 Ga 0.60 La capa de N puede agotarse, lo que puede sacrificar la conductividad eléctrica. Por lo tanto, para ilustrar mejor la relación entre el espesor de n-Al 0.40 Ga 0.60 N capa y rendimiento para LED DUV, es necesario investigar el impacto del n-Al 0.40 Ga 0.60 Espesor de capa N para la unión PNP-AlGaN en la propagación de la corriente, la inyección del orificio, el EQE, el voltaje directo y el WPE. Para ello, variamos los valores de n-Al 0.40 Ga 0.60 N de espesor de capa entre 6, 13, 20, 27 y 34 nm, y los dispositivos se denominan LED T1, T2, T3, T4 y T5, respectivamente. La Tabla 1 resume la altura de la barrera de la banda de valencia para cada unión PNP-AlGaN, que muestra que la altura de la barrera aumenta a medida que el n-Al 0.40 Ga 0.60 El espesor de la capa N aumenta, lo que demuestra que el aumento del n-Al 0.40 Ga 0.60 El espesor de capa N permite la gran N · ρ PNP , aumentando así la corriente horizontal J 2 . La Figura 6a muestra los perfiles de concentración de orificios laterales en el último pozo cuántico para el LED A sin la capa de propagación de corriente estructurada PNP-AlGaN y los LED con varios n-Al 0.40 Ga 0.60 N espesores de capa a la densidad de corriente de 170 A / cm 2 . Aparentemente, se puede ver que los agujeros se distribuyen más uniformemente en el último pozo cuántico que el grosor del n-Al 0.40 Ga 0.60 N capa de inserción aumenta.
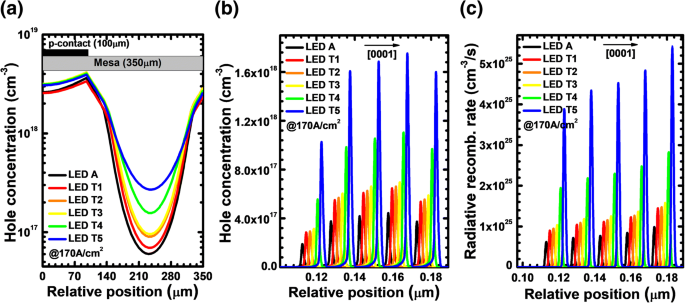
un Distribución de agujeros laterales en el último pozo cuántico, b perfiles de concentración de agujeros y c Perfiles de tasa de recombinación radiativa en la región MQW para LED A, T1, T2, T3, T4 y T5 a la densidad de corriente de 170 A / cm 2 . Las curvas trazadas para paneles b y c se desplazan deliberadamente 2 nm para una mejor resolución
Luego, mostramos los perfiles de concentración de agujeros y los perfiles de tasa de recombinación radiativa en la región MQW para todos los dispositivos estudiados a la densidad de corriente de 170 A / cm 2 en la Fig. 6b, c, respectivamente. Los perfiles de concentración de orificios y tasa de radiación se recogen en la posición de 230 μm aparte del borde de la mesa de la izquierda. Para una mejor resolución visual, los perfiles de concentración de huecos y de tasa de recombinación radiativa para los LED A, T1, T2, T3, T4 y T5 se desplazan espacialmente 2 nm en la Fig. 6b, c, respectivamente. Se muestra claramente que el LED A tiene la concentración de orificios más baja y, por lo tanto, la tasa de recombinación radiativa más baja en la región MQW. La concentración de huecos y la tasa de recombinación radiativa en la región MQW aumentan con el aumento del espesor del n-Al 0.40 Ga 0.60 Capa N.
Los resultados observados que se muestran en la Fig. 6c concuerdan bien con el EQE y la densidad de potencia óptica que se presentan en la Fig. 7a, de modo que el espesor creciente del n-Al 0.40 Ga 0.60 La capa N en la unión PNP-AlGaN puede mejorar el EQE y la densidad de potencia óptica. Sin embargo, la altura de la barrera de la banda de valencia para los agujeros en cada unión PNP-AlGaN se vuelve grande una vez que el n-Al 0.40 Ga 0.60 La capa N está engrosada de acuerdo con la Tabla 1, lo que aumenta correspondientemente el voltaje directo para los LED DUV propuestos como se muestra en la Fig. 7b. Por lo tanto, el impacto del n-Al 0.40 Ga 0.60 El espesor de capa N para la corriente PNP-AlGaN que se extiende sobre el rendimiento del LED se evaluará demostrando la relación entre el WPE y la densidad de la corriente de inyección (ver Fig. 8). Podemos ver que el WPE no aumenta monótonamente con el aumento de n-Al 0.40 Ga 0.60 N espesor de capa. El EQE y el WPE en términos de n-Al 0.40 Ga 0.60 N espesor de capa se ilustra en el recuadro de la Fig. 8. Para las arquitecturas de dispositivo propuestas en este trabajo, el WPE alcanza el valor más alto cuando el n-Al 0.40 Ga 0.60 La capa de inserción de N tiene un grosor de 20 nm y disminuye a medida que el n-Al 0.40 Ga 0.60 La capa de inserción de N se vuelve más gruesa. Atribuimos este fenómeno al aumento de la resistencia vertical cuando el n-Al 0.40 Ga 0.60 El espesor de la capa N se vuelve más grueso, y esto consume más energía eléctrica. Por lo tanto, el espesor de la capa de inserción de n-AlGaN para la unión PNP-AlGaN se optimizará cuidadosamente. En esta sección, establecemos la composición de AlN del 40%, es decir, n-Al 0.40 Ga 0.60 N con fines de demostración, y creemos que el grosor optimizado para la capa de inserción de n-AlGaN se reducirá si se aumenta la composición de AlN.
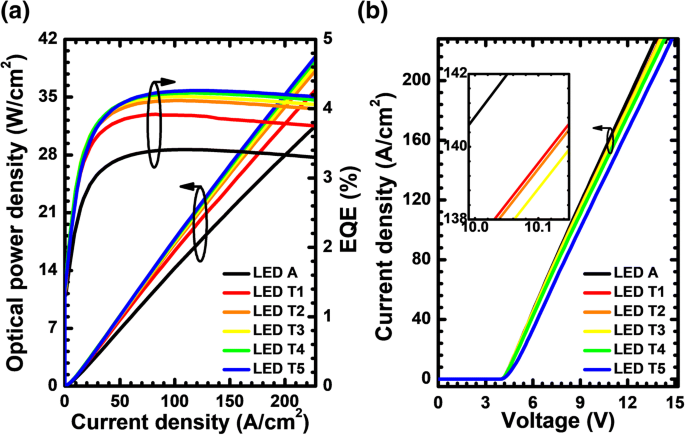
un Densidad de potencia de salida óptica, b características de corriente-voltaje para los LED A, T1, T2, T3, T4 y T5. La figura insertada muestra las curvas de voltaje-corriente con zoom
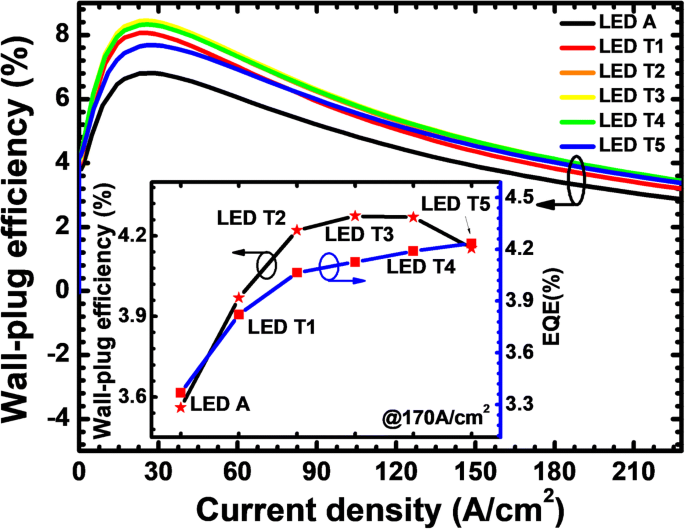
WPE en función de la corriente de inyección para los LED A, T1, T2, T3, T4 y T5. La figura insertada muestra el WPE y EQE para los LED estudiados con varios espesores de n-Al 0.40 Ga 0.60 Capa N para la unión PNP-AlGaN a la densidad de corriente de 170 A / cm 2
Impacto de la concentración de dopaje de la capa n-AlGaN en el rendimiento del dispositivo
Además del espesor de la capa de n-AlGaN, la concentración de dopaje para la capa de n-AlGaN también puede modificar la altura de la barrera de la banda de valencia para los agujeros, lo que afecta a N · ρ PNP . Para estudiar con mayor precisión el impacto de la concentración de dopaje para la capa n-AlGaN sobre el efecto de propagación de la corriente y el rendimiento óptico de los LED DUV con las uniones PNP-AlGaN, establecemos la concentración de dopaje de 1,3 × 10 17 , 5,3 × 10 17 , 9,3 × 10 17 , 1,33 × 10 18 y 1,73 × 10 18 cm −3 de las capas n-AlGaN para los LED D1, D2, D3, D4 y D5, respectivamente. El grosor de la capa n-AlGaN se establece en 20 nm y se adoptan dos uniones PNP-AlGaN. La composición de AlN es del 40%, es decir, n-Al 0.40 Ga 0.60 N.
La Tabla 2 muestra que la altura de la barrera de la banda de valencia para los agujeros aumenta cuando la concentración de dopaje de Si para el n-Al 0.40 Ga 0.60 La capa N de la unión PNP-AlGaN se vuelve alta. El aumento de la altura de la barrera de la banda de valencia indica la gran N · ρ PNP , que simultáneamente produce la alta corriente horizontal de J 2 . Según Eq. (1), el aumento de la propagación de la corriente se acompaña de un perfil de concentración de orificios laterales más uniforme y, por lo tanto, mostramos, en la Fig. 9a, que la distribución de orificios laterales en el último pozo cuántico se vuelve más homogeneizada una vez que el PNP-AlGaN La unión está dopada para los LED DUV en comparación con el LED A. Además, los orificios laterales se distribuyen de manera más uniforme una vez que la concentración de dopaje de Si para el n-Al 0.40 Ga 0.60 Aumenta la capa N de la unión PNP-AlGaN.
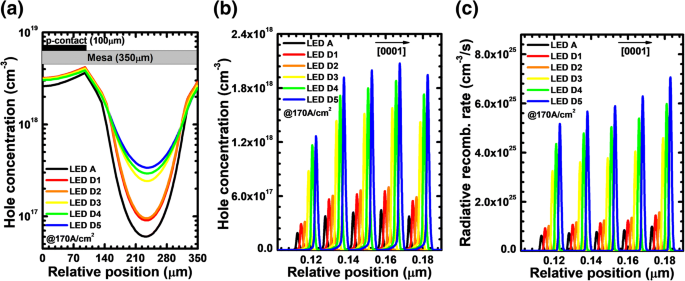
un Distribución de agujeros laterales en el último pozo cuántico, b perfiles de concentración de agujeros y c Perfiles de tasa de recombinación radiativa en la región MQW o LED A, D1, D2, D3, D4 y D5 a la densidad de corriente de 170 A / cm 2 . Las curvas trazadas para paneles b y c se desplazan deliberadamente 2 nm para una mejor resolución
Luego, mostramos los perfiles de concentración de agujeros y los perfiles de tasa de recombinación radiativa en la región MQW para todos los dispositivos estudiados a la densidad de corriente de 170 A / cm 2 en la Fig. 9b, c, respectivamente, que se recogen en la posición de 230 µm de distancia del borde de la mesa izquierdo. Se muestra claramente que el LED A tiene la concentración de orificios más baja y la tasa de recombinación radiativa más baja en la región MQW. La concentración de huecos y la tasa de recombinación radiativa en la región MQW aumentan con el aumento de las concentraciones de dopaje del n-Al 0.40 Ga 0.60 N capas para los LED con uniones PNP-AlGaN. El nivel de concentración de orificios mejorado en el MQW para los LED D1, D2, D2, D3, D4 y D5 se atribuye al mejor efecto de propagación de corriente, gracias a la unión PNP-AlGaN.
Luego calculamos y presentamos el EQE y la densidad de potencia óptica en términos de la densidad de corriente de inyección para los dispositivos investigados en la Fig. 10a. La EQE observada es coherente con los resultados de la Fig. 9b, c, de modo que la EQE puede mejorarse una vez que se emplea la unión PNP-AlGaN. Más que eso, ya que la concentración de dopaje de Si en el n-Al 0.40 Ga 0.60 La capa N para la unión PNP-AlGaN aumenta, el EQE se puede promover aún más, gracias a la mejor distribución de la corriente. La Figura 10b compara el voltaje de operación directo para los dispositivos investigados. Se muestra que el voltaje de operación directo aumenta con el aumento de la concentración de dopaje en el n-Al 0.40 Ga 0.60 Capa N. Tenga en cuenta que como las concentraciones de dopaje de Si son 1,33 × 10 18 y 1,73 × 10 18 cm −3 , el voltaje de encendido muestra un aumento significativo, lo que indica que la unión incorporada PNP-AlGaN se comporta como un diodo parásito cuando el dopaje de Si en el n-Al 0.40 Ga 0.60 La capa de N aumenta a un nivel muy alto. Para evaluar con mayor precisión el rendimiento de los LED DUV con diferentes uniones PNP-AlGaN, la Fig. 11 muestra WPE en función de la densidad de corriente de inyección para los LED A, D1, D2, D3, D4 y D5. Claramente, podemos ver que el WPE es el más bajo para el LED D5, lo que se debe al mayor consumo de voltaje directo. El recuadro de la Fig. 11 también indica que el WPE es más sensible a la concentración de dopaje de Si del n-Al 0.40 Ga 0.60 N capa que el EQE. Vale la pena concluir que la alta concentración de dopaje de Si del n-Al 0.40 Ga 0.60 De hecho, la capa N puede mejorar la capa de difusión actual y aumentar la tasa de generación de fotones. Sin embargo, la caída de voltaje directo adicional en las uniones PNP-AlGaN consume más energía eléctrica, lo que limita el WPE. Los resultados de esta sección también ilustran que la concentración de dopaje de Si en el n-Al x Ga 1- x La capa N se reducirá adecuadamente si se aumenta la composición de AlN y / o el espesor del n-Al x Ga 1- x Capa N para la unión PNP-AlGaN, ya que al hacerlo, se puede obtener tanto el EQE mejorado como el WPE decente.
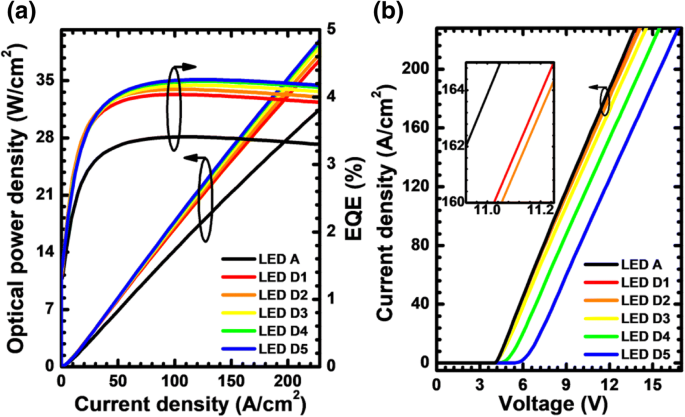
un Densidad de potencia de salida óptica y EQE en función de la corriente de inyección, b Características de corriente-voltaje para los LED A, D1, D2, D3, D4 y D5. La figura insertada muestra las curvas de voltaje-corriente con zoom
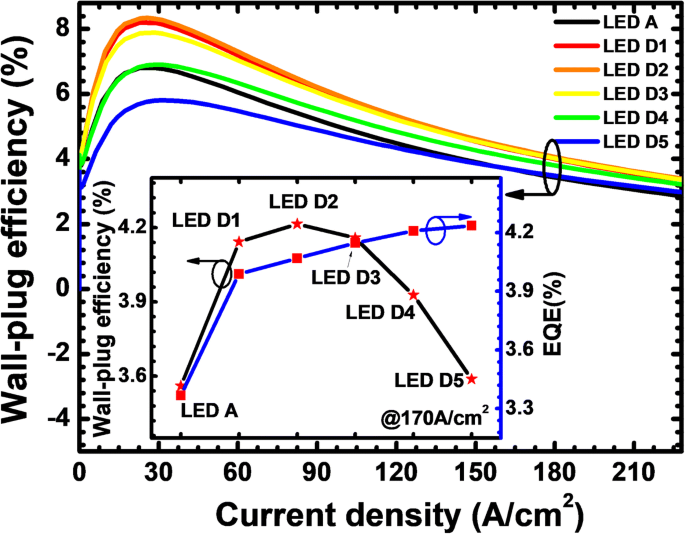
WPE en función de la corriente de inyección para los LED A, D1, D2, D3, D4 y D5. La figura insertada muestra el WPE y EQE para los LED estudiados con varias concentraciones de dopaje de n-Al 0.40 Ga 0.60 N capa a la densidad de corriente de 170 A / cm 2
Impacto del número de unión PNP-AlGaN en el rendimiento del dispositivo
En esta sección se estudia el impacto del número de la unión PNP-AlGaN en los rendimientos eléctricos y ópticos de los LED DUV. Para fines de demostración, fijamos la concentración de dopaje y el grosor de la capa de n-AlGaN en 5.3 × 10 17 cm −3 y 20 nm, respectivamente. La composición de AlN se selecciona a 0.40 tal como n-Al 0.40 Ga 0.60 N. Adoptamos diferentes bucles para la unión PNP-AlGaN, es decir, los números de bucle se establecen en 1, 2, 3 y 4 para los LED N1, N2, N3 y N4, respectivamente. En primer lugar, calculamos y presentamos la altura de la barrera de la banda de valencia para cada unión PNP-AlGaN en la Tabla 3. Obviamente, se puede leer que el aumento del número de unión PNP-AlGaN hace que el total N · ρ PNP alto. Luego calculamos y demostramos la distribución lateral de los agujeros en el último pozo cuántico para los LED A, N1, N2, N3 y N4 a la densidad de corriente de 170 A / cm 2 (ver Fig. 12a). Muestra que la distribución de huecos en el último pozo cuántico se vuelve más uniforme a medida que se incorporan más uniones PNP-AlGaN. Los resultados en la Fig. 12a apoyan aún más las predicciones hechas por la Ec. (1).
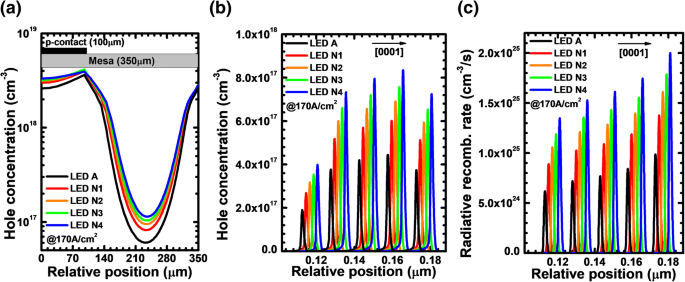
un Distribución de agujeros laterales en el último pozo cuántico, b perfiles de concentración de agujeros y c Perfiles de tasa de recombinación radiativa en la región MQW para LED A, N1, N2, N3 y N4 a la densidad de corriente de 170 A / cm 2 . Las curvas trazadas para paneles b y c se desplazan deliberadamente 2 nm para una mejor resolución
Luego, mostramos la concentración de huecos y los perfiles de tasa de recombinación radiativa en la región MQW para los LED A, N1, N2, N3 y N4 a la densidad de corriente de 170 A / cm 2 en la Fig. 12b, c, respectivamente. Los perfiles de la tasa de recombinación radiativa y del agujero se sondean en la posición de 230 µm de distancia del borde de la mesa izquierdo. Se indica que la concentración de huecos y la tasa de recombinación radiativa aumentan si el número de la unión PNP-AlGaN es mayor. Vale la pena mencionar aquí que no aumentamos el valor de N más allá de 4, desde cuando el N aumenta aún más, el espesor del p-Al 0.40 restante Ga 0.60 La capa de N se vuelve tan delgada que los orificios pueden ser agotados por los dopantes de Si ionizados y el suministro de orificios puede ser insuficiente.
Gracias al efecto de propagación de corriente mejorado, la concentración de orificios mejorada en la región MQW, los LED N1, N2, N3 y N4 promueven en consecuencia el EQE y la densidad de potencia óptica en comparación con el LED A (ver Fig. 13a). La Figura 13b demuestra que el voltaje de funcionamiento directo para los LED DUV sugeridos también aumenta si se incorporan más uniones PNP-AlGaN. Afortunadamente, el aumento del voltaje directo para los LED N1, N2, N3 y N4 no reduce el WPE de acuerdo con la Fig. 14. Investigaciones adicionales en el recuadro de la Fig. 14 pueden ilustrar que tanto el EQE como el WPE tienden a acercarse a un nivel de saturación a medida que aumenta el número de la unión PNP-AlGaN. Por lo tanto, creemos que, como también se ha señalado anteriormente, un mayor aumento del número de la unión PNP-AlGaN puede agotar los orificios y, en consecuencia, degradar la capacidad de suministro de orificios, por lo que contribuye poco a mejorar el EQE y el WPE para el arquitecturas de dispositivo propuestas en este trabajo.
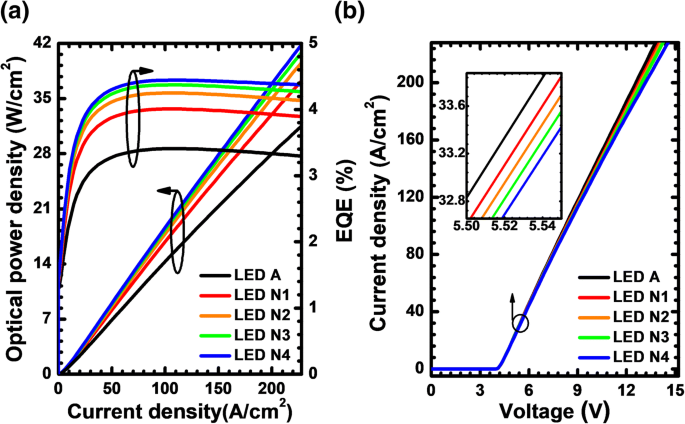
un Densidad de potencia de salida óptica y EQE en función de la corriente de inyección, b característica corriente-voltaje para los LED A, N1, N2, N3 y N4. La figura insertada muestra las curvas de voltaje-corriente con zoom
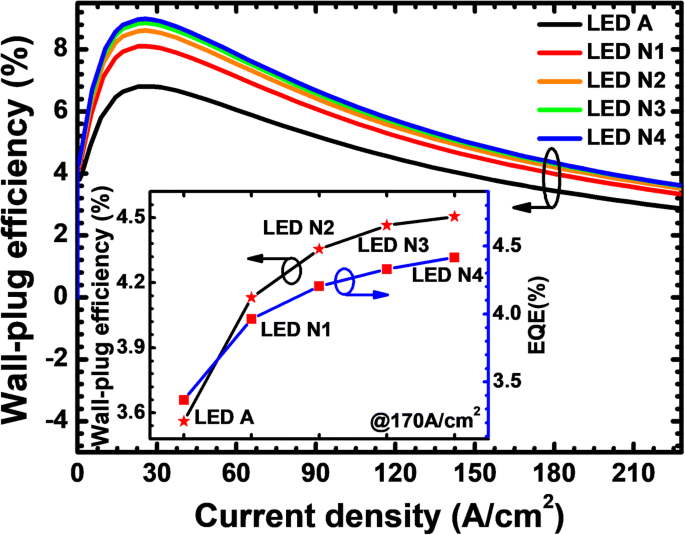
WPE en función de la corriente de inyección para los LED A, N1, N2, N3 y N4. La figura insertada muestra el WPE y EQE para LED con varios números de unión PNP-AlGaN a la densidad de corriente de 170 A / cm 2
Impacto de la composición de AlN para la capa n-AlGaN en el rendimiento del dispositivo
Por último, modificamos el ρ PNP variando la composición de AlN de la capa n-AlGaN para la unión PNP-AlGaN. Los valores de la composición de AlN de la capa n-AlGaN se establecen en 0,40, 0,43, 0,46, 0,49 y 0,51 para los LED C1, C2, C3, C4 y C5, respectivamente. El espesor y la concentración de dopaje de Si de la capa de n-AlGaN se establecen en 20 nm y 5,3 × 10 17 cm −3 , respectivamente. Adoptamos dos uniones PNP-AlGaN para los LED C1, C2, C3, C4 y C5. La composición de AlN para el resto de capas de p-AlGaN se fija en 0,40. La Tabla 4 demuestra la altura de la barrera de la banda de valencia para la unión PNP-AlGaN con diferentes composiciones de AlN en la capa de inserción de n-AlGaN. Es fácilmente comprensible que el aumento de la composición de AlN en la capa de n-AlGaN da lugar a una mayor altura de barrera de la banda de valencia para los agujeros. La Figura 15a muestra las distribuciones laterales de los agujeros en el último pozo cuántico para los LED A, C1, C2, C3, C4 y C5 a la densidad de corriente de 170 A / cm 2 . El efecto de propagación actual mejora significativamente a medida que la composición de AlN de la capa de n-AlGaN aumenta hasta 0,43. Parece que los huecos no se pueden esparcir de manera más sólida cuando la composición de AlN de la capa de n-AlGaN excede 0,43 para nuestras estructuras, porque una composición de AlN demasiado alta en el n-AlGaN puede bloquear la inyección del hueco.

un Distribución de agujeros laterales en el último pozo cuántico, b perfiles de concentración de agujeros y c Perfiles de tasa de recombinación radiativa en la región MQW para LED A, C1, C2, C3, C4 y C5 a la densidad de corriente de 170 A / cm 2 . Las curvas trazadas para paneles b y c se desplazan deliberadamente 2 nm para una mejor resolución
Los perfiles de concentración de orificios y tasa de recombinación radiativa en la región MQW para los LED A, C1, C2, C3, C4 y C5 a la densidad de corriente de 170 A / cm 2 se presentan en las Fig. 15b, c, respectivamente. Los datos también se recogen en la posición de 230 μm de distancia del borde de la mesa izquierda. Las conclusiones aquí son similares a las de la Fig. 6b, Fig. 9b y Fig. 12b, es decir, la adopción de la capa de difusión de corriente PNP-AlGaN aumenta la inyección del orificio y la concentración del orificio en la región MQW mejora aún más una vez aumenta la composición de AlN en la capa de n-AlGaN. Luego calculamos y presentamos el EQE y la densidad de potencia óptica en términos de la corriente de inyección para los dispositivos investigados en la Fig. 16a. Claramente, podemos ver que el EQE se puede mejorar una vez que se emplea la unión PNP-AlGaN. Además, a medida que aumenta la composición de AlN en la capa n-AlGaN para la unión PNP-AlGaN, se puede promover aún más la EQE, gracias a la mejor difusión de la corriente, que homogeneiza la concentración de huecos en cada plano de pozo cuántico como se ha demostrado anteriormente. .
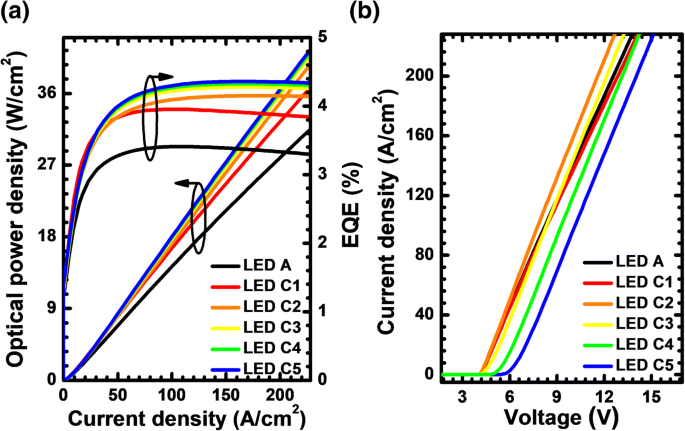
un Densidad de potencia de salida óptica y EQE en función de la corriente de inyección y b características de corriente-voltaje para LED A, C1, C2, C3, C4 y C5
La Figura 16b investiga las características de corriente-voltaje para los LED A, C1, C2, C3, C4 y C5. El dispositivo muestra un ligero aumento en el voltaje de operación directo para el LED C1 con el PNP-Al 0.40 Ga 0.60 Unión N en comparación con el LED A. Mientras tanto, el dispositivo consume más voltaje directo para los LED C4 y C5. La observación aquí es consistente con la de la Fig. 7b, Fig. 10b y Fig. 13b, de modo que la adopción de la unión PNP-AlGaN provoca la altura de barrera de banda de valencia adicional para los agujeros, lo que, como resultado, aumenta el voltaje directo e incluso el voltaje de encendido (por ejemplo, LED C4 y C5). Sin embargo, vale la pena mencionar que el voltaje de operación directo para los LED C2 y C3 disminuye en comparación con el LED A. El mecanismo subyacente no está claro en este momento. Sin embargo, tentativamente atribuimos el voltaje directo reducido para los LED C2 y C3 al efecto de aceleración del agujero [35].
La Figura 17 muestra la relación entre el WPE y la densidad de corriente de inyección para los LED probados. Podemos conseguir que el WPE se pueda mejorar para todos los LED propuestos, especialmente cuando la densidad de corriente de inyección supera los 89 A / cm 2 . Un estudio profundo sobre el LED C5 muestra que el WPE del LED C5 es menor que el del LED A cuando la densidad de corriente es inferior a 89 A / cm 2 . Sin embargo, el WPE para el LED C5 supera al del LED A cuando la densidad de corriente de inyección aumenta (es decir,> 89 A / cm 2 ). Como es bien sabido, la corriente se satura fácilmente cuando el dispositivo LED está polarizado a un alto nivel de corriente. El WPE para LED C5 refleja que el PNP-Al 0.51 Ga 0,49 De hecho, la unión N es eficaz para mejorar el efecto de propagación de la corriente. Sin embargo, considerando el consumo de voltaje adicional en la unión PNP-AlGaN, se debe tener mucho cuidado al establecer la composición de AlN para la capa n-AlGaN de modo que el WPE se pueda maximizar de acuerdo con el recuadro de la Fig. 17.
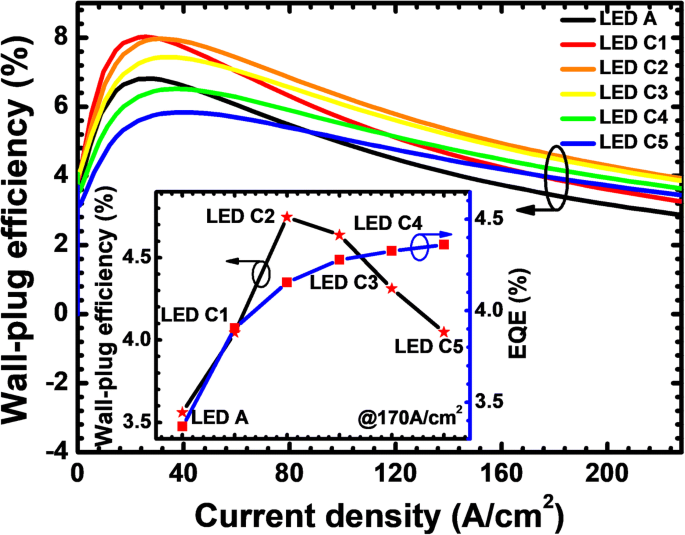
WPE en función de la corriente de inyección para los LED A, C1, C2, C3, C4 y C5. La figura insertada muestra el WPE y el EQE para los LED estudiados con varias composiciones de AlN para la capa n-AlGaN a la densidad de corriente de 170 A / cm 2
Conclusiones
En resumen, se explora y se demuestra la unión PNP-AlGaN para LED DUV. Con la ayuda de las uniones PNP-AlGaN propuestas, se puede mejorar el efecto de propagación de la corriente. El efecto de propagación de corriente mejorado se atribuye bien al aumento de la resistencia vertical y al flujo de corriente horizontal mejorado. Además, también hemos realizado el estudio paramétrico para revelar diferentes uniones PNP sobre el efecto de propagación actual, el EQE y el WPE. Encontramos que aumentando adecuadamente el espesor, la concentración de dopaje, la composición de AlN para la capa de inserción de n-AlGaN y el número de la unión PNP-AlGaN, se puede mejorar el efecto de propagación de la corriente. Por otro lado, también encontramos que el efecto de propagación actual puede mejorar el EQE. Sin embargo, el voltaje directo puede incrementarse si la unión PNP-AlGaN no está completamente optimizada, cuyo costo es el WPE reducido. También vale la pena señalar que la característica de propagación actual es la función cooperativa del espesor, la concentración de dopaje, la composición de AlN para la capa de inserción n-AlGaN y el número para la unión PNP-AlGaN. Como resultado, no existe una respuesta única para el mejor diseño de la capa de dispersión de corriente PNP-AlGaN para LED DUV. Sin embargo, creemos firmemente que los hallazgos de este trabajo introducen la comprensión física adicional de la capa de propagación de corriente PNP-AlGaN y el efecto de propagación de corriente para los LED DUV. Por lo tanto, este trabajo es muy útil para la comunidad de dispositivos semiconductores ópticos.
Abreviaturas
- APSYS:
-
Modelos físicos avanzados de dispositivos semiconductores
- CBL:
-
Capa de bloqueo actual
- CL:
-
Capa de difusión actual
- LED DUV:
-
Diodos emisores de luz ultravioleta profunda
- EQE:
-
Eficiencia cuántica externa
- IQE:
-
Eficiencia cuántica interna
- LQW:
-
Último pozo cuántico
- MOCVD:
-
Deposición de vapor químico metalorgánico
- MQW:
-
Múltiples pozos cuánticos
- PNP-AlGaN:
-
p-AlGaN / n-AlGaN / p-AlGaN
- SRH:
-
Shockley-Read-Hall
- WPE:
-
Eficiencia del enchufe de pared
Nanomateriales
- Defensa de los chips neuromórficos para la informática de IA
- Los científicos de IBM inventan un termómetro para nanoescala
- El diseño de la capa de emisión para multiplicadores de electrones
- Síntesis ecológica de puntos cuánticos de núcleo / carcasa de InP / ZnS para su aplicación en diodos emisores de luz sin metales pesados
- El precursor de titanio óptimo para la fabricación de una capa compacta de TiO2 para células solares de perovskita
- Diodos emisores de luz ultravioleta basados en AlGaN casi sin caída de eficiencia con una capa de bloqueo de electrones tipo p de superrejilla diseñada específicamente para una alta eficiencia de…
- Diodos emisores de luz de perovskita de alta luminancia con disolvente de alcohol de alta polaridad que trata PEDOT:PSS como capa de transporte de huecos
- Influencia del ancho del pozo cuántico en las propiedades de electroluminiscencia de los diodos emisores de luz ultravioleta profunda AlGaN a diferentes temperaturas
- Integración de perovskitas ecológicas para diodos emisores de luz blanca de alta eficiencia
- Efectos de la estructura de contacto tipo p mallada en el efecto de extracción de luz para diodos emisores de luz ultravioleta ultravioleta profunda de chip giratorio
- ¿Cuáles son las aplicaciones más comunes de la corriente CA?



