Investigación de la banda de energía en la capa atómica depositada en heterouniones AZO / β-Ga2O3 (\ (\ overline {2} 01 \))
Resumen
Los efectos dopados con Al en las compensaciones de banda de ZnO / β-Ga 2 O 3 Las interfaces se caracterizan por espectroscopía de fotoelectrones de rayos X y se calculan mediante simulaciones de primer principio. Las compensaciones de la banda de conducción varían de 1,39 a 1,67 eV, las compensaciones de la banda de valencia se reducen de 0,06 a - 0,42 eV, exhibiendo una dependencia casi lineal con respecto a la relación de dopaje de Al que varía de 0 a 10%. En consecuencia, se forma una alineación de banda de tipo I en la interfaz de ZnO / β-Ga 2 O 3 heterounión y el AZO / β-Ga 2 O 3 La interfaz tiene una alineación de banda de tipo II. Esto se debe a que la incorporación de Al en el ZnO abriría las brechas de banda debido a la fuerte mezcla de electrones de Al y O, y los bordes de la banda de conducción y valencia, en consecuencia, se desplazarían hacia el nivel inferior.
Antecedentes
Recientemente, un semiconductor de óxido Ga 2 O 3 ha atraído un gran interés debido a sus características únicas, como la gran banda prohibida, la alta velocidad de saturación de los electrones y la resistencia a altas temperaturas [1]. Hay cinco tipos de isómeros para Ga 2 O 3 :α, β, γ, δ y ε, donde β-Ga 2 O 3 se puede cultivar más fácilmente y se ha estudiado ampliamente [2]. En particular, β-Ga 2 O 3 tiene un campo eléctrico de ruptura mayor que el de los materiales semiconductores tradicionales de tercera generación, como el SiC y GaN [3]. Las propiedades conductoras de tipo n se pueden modular dopando Sn [4] o Si [5]. Entonces, β-Ga 2 O 3 Los dispositivos basados en tecnología [6, 7] tienen amplias perspectivas de aplicación en los campos de la tecnología de la información, la conservación de energía y la reducción de emisiones. Sin embargo, β-Ga 2 O 3 -basados en dispositivos tienen una limitación común:el contacto entre β-Ga 2 O 3 y la mayoría de los metales tienden a ser Schottky debido a la gran barrera inducida por el amplio intervalo de banda y la concentración finita de portadores. En los últimos años, la inserción de una capa intermedia, como ITO [8] y AZO [9], entre Ga 2 O 3 y los metales se muestra como un método válido para reducir la barrera de energía entre β-Ga 2 O 3 y metal.
El óxido de zinc dopado con Al (ZnO) ha ganado mucha atención debido a su baja resistividad y menor costo de fabricación que el ITO [10]. En particular, la alta estabilidad térmica, la alta movilidad y la concentración de portadores lo convierten en un candidato prometedor de la capa semiconductora intermedia (ISL) [11]. Hasta ahora, las películas de ZnO dopadas con Al se pueden cultivar mediante las siguientes técnicas:epitaxia de haz molecular (MBE) [12], pulverización catódica con magnetrón [13], deposición química en fase de vapor (CVD) [14] y deposición de capa atómica (ALD) [ 15]. Especialmente, ALD es un método reconocido para preparar películas de nanoespesor que exhibe una excelente uniformidad de área grande y une la tasa de crecimiento por ciclo debido a la reacción superficial autolimitante que incluye la adsorción química autolimitante y la reacción secuencial autolimitante [16]. Además, la ALD puede reducir el trastorno de la interfaz y modular de manera más precisa la concentración de dopaje de Al cambiando las proporciones de los ciclos de crecimiento.
Tenga en cuenta que el desplazamiento de la banda de conducción (CBO) determina la barrera de energía para el transporte de electrones, por lo que un CBO más pequeño es beneficioso para formar un contacto óhmico. Basado en nuestro trabajo anterior [17], al aumentar la concentración de dopaje de Al, la película de ZnO dopada con Al cambia de naturaleza policristalina a amorfa, y su banda prohibida también se ensancha. Sin embargo, las compensaciones de banda de diferentes ZnO / β-Ga 2 dopados con Al O 3 las heterouniones no se han estudiado ampliamente. En este trabajo, las películas de ZnO con diferentes proporciones de dopaje de Al se depositaron respectivamente sobre β-Ga 2 O 3 sustratos por ALD. Los resultados muestran que VBO y CBO dependen casi linealmente de la tasa de dopaje de Al.
Métodos
Los sustratos son β-Ga 2 a granel O 3 (\ (\ overline {2} 01 \)) y la concentración de dopaje es de aproximadamente 3 × 10 18 / cm 3 . El proceso de limpieza para Ga 2 O 3 Los sustratos se sometieron a un lavado ultrasónico en acetona e isopropanol por cada 10 min y se repitió tres veces. Posteriormente, el Ga 2 O 3 los sustratos se aclararon con agua desionizada. Posteriormente, las películas de ZnO dopadas con Al se cultivaron en el Ga 2 O 3 sustrato por ALD (Wuxi MNT Micro Nanotech Co., LTD, China). Se prepararon tres tipos de muestras. En primer lugar, las películas de ZnO sin dopar se cultivaron mediante ALD con los precursores de Zn (C 2 H 5 ) 2 (DEZ) y H 2 O a 200 o C. En segundo lugar, las películas de ZnO dopadas con Al se llevaron a cabo mediante la adición de un pulso de trimetilaluminio (TMA) y H 2 O cada ciclo 19 de DEZ y H 2 O pulsante (denotado como dopaje con 5% de Al) a una temperatura del sustrato de 200 o C durante ALD. En tercer lugar, también se prepararon las películas de ZnO dopadas con Al de proporción 9:1 (indicadas como dopadas con Al al 10%). La tasa de crecimiento de ZnO y Al 2 O 3 fue de 0,16 y 0,1 nm / ciclo, respectivamente. Cada tipo de película incluía dos espesores diferentes, es decir, 40 nm y 10 nm para la película gruesa y delgada, respectivamente. Además, el β-Ga 2 O 3 Se utilizó sustrato para estudiar el material a granel. Ga 2 p , Zn 2 p Los CL y el máximo de la banda de valencia (VBM) se midieron mediante espectroscopia de rayos X (XPS) (AXIS Ultra DLD, Shimadzu) y el paso de resolución del espectro XPS es de 0,05 eV. Para evitar la contaminación de la superficie de la muestra durante el proceso de transferencia de la cámara ALD a la cámara XPS, se realizó un grabado con iones de Ar antes de la medición de XPS. Tenga en cuenta que el efecto de carga puede cambiar el espectro XPS y el BE de C 1 s el pico está calibrado a 284,8 eV para resolver el problema.
Resultados y discusiones
El desplazamiento de la banda de valencia (VBO) de ZnO / β-Ga 2 dopado con Al O 3 La heterounión se puede obtener mediante la fórmula siguiente [18]:
$$ \ Delta {E} _V =\ left ({E} _ {\ mathrm {Ga} \ 2p} ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3} - {E} _ { \ mathrm {VBM}} ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3} \ right) - \ left ({E} _ {\ mathrm {Zn} \ 2p} ^ {\ mathrm { AZO}} - {E} _ {\ mathrm {VBM}} ^ {\ mathrm {AZO}} \ right) - \ left ({E} _ {\ mathrm {Ga} \ 2p} ^ {{\ mathrm {Ga }} _ 2 {\ mathrm {O}} _ 3} - {E} _ {\ mathrm {Zn} \ 2p} ^ {\ mathrm {AZO}} \ right) $$ (1)donde \ ({E} _ {\ mathrm {Ga} \ 2p} ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3} \) se refiere a la energía de enlace (BE) de Ga 2 p nivel de núcleo (CL) a granel β-Ga 2 O 3 , \ ({E} _ {\ mathrm {VBM}} ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3} \) se refiere al BE de VBM a granel β-Ga 2 O 3 , \ ({E} _ {\ mathrm {Zn} \ 2p} ^ {\ mathrm {AZO}} \) se refiere al BE de Zn 2 p CL en películas gruesas de ZnO dopado con Al, \ ({E} _ {\ mathrm {VBM}} ^ {\ mathrm {AZO}} \) se refiere al BE de VBM en películas gruesas de ZnO dopado con Al. El último \ ({E} _ {\ mathrm {Ga} \ 2p} ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3} \) y \ ({E} _ {\ mathrm {Zn } \ 2p} ^ {\ mathrm {AZO}} \) se refieren al BE de Ga 2 p y Zn 2 p CL en películas delgadas de ZnO dopadas con Al, respectivamente.
Posteriormente, en base a la E g y ∆E V , el CBO en el ZnO / β-Ga 2 dopado con Al O 3 La interfaz se puede calcular mediante la siguiente ecuación:
$$ \ Delta {E} _C ={E} _g ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3} - {E} _g ^ {\ mathrm {AZO}} - \ Delta {E } _V $$ (2)donde \ ({E} _g ^ {{\ mathrm {Ga}} _ 2 {\ mathrm {O}} _ 3} \) es la banda prohibida de Ga 2 O 3 y \ ({E} _g ^ {\ mathrm {AZO}} \) es la banda prohibida del ZnO dopado con Al. Los huecos de banda para ZnO dopado al 5% con Al sin dopar, ZnO dopado con Al al 10% y β-Ga 2 O 3 son 3,20 eV, 3,25 eV, 3,40 eV y 4,65 eV, respectivamente [17, 19]. La banda prohibida aumenta con una tasa de dopaje de Al más alta, concordando bien con la simulación de la siguiente parte.
La Figura 1 muestra los elementos CL y VBM de Ga y Zn de β-Ga 2 a granel O 3 , películas gruesas sin dopar y películas de ZnO dopadas al 5% y 10% con Al. Ajustando el área lineal y la zona de banda plana del espectro VBM puede deducir el VBM [20]. La figura 2 muestra Ga 2 p y Zn 2 p CL de varios ZnO / β-Ga 2 delgados dopados con Al O 3 heterouniones. Las diferencias BE de Ga 2 p y Zn 2 p CL para el ZnO / β-Ga 2 no dopado y dopado al 5% con Al O 3 y 10% de ZnO / β-Ga 2 dopado con Al O 3 se obtienen 96,12 eV, 96,16 eV y 95,94 eV, respectivamente. Luego, se determina que los VBO en las interfaces son 1,39 eV, 1,52 eV y 1,67 eV para el ZnO / β-Ga 2 dopado con 5% Al sin dopar. O 3 y 10% de ZnO / β-Ga 2 dopado con Al O 3 muestras, respectivamente.
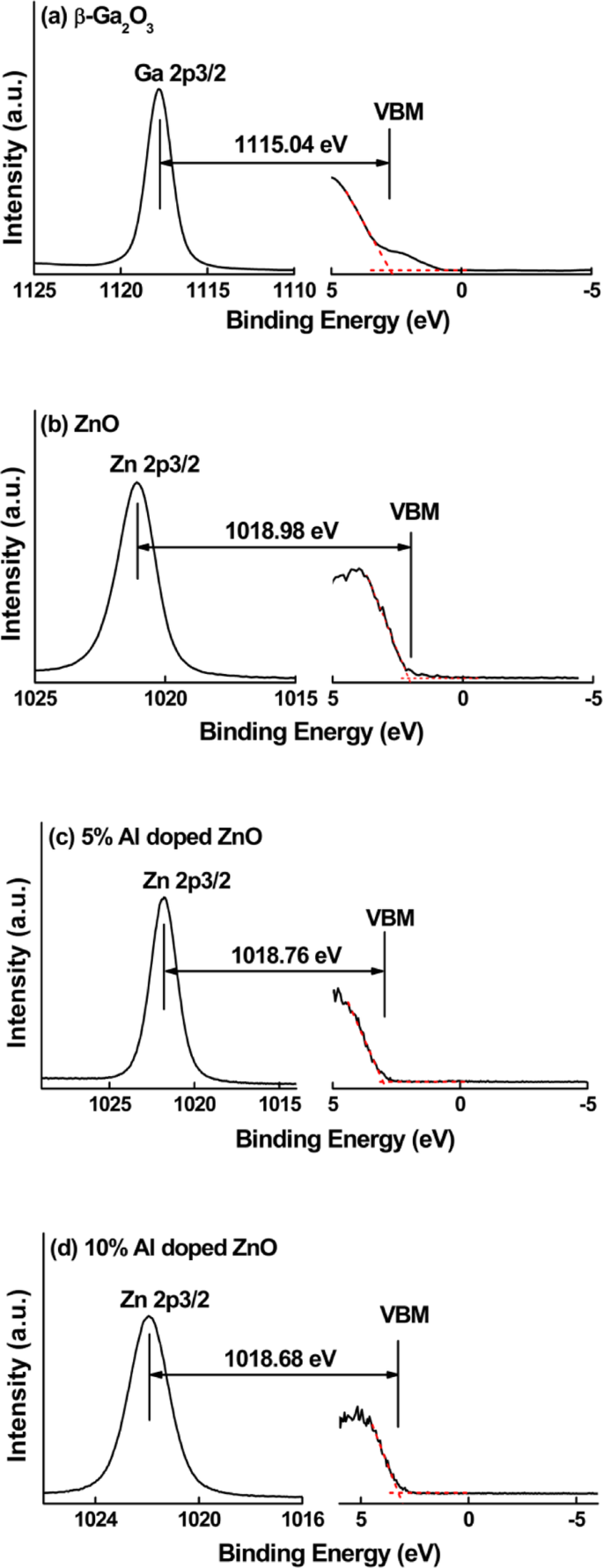
Espectros XPS de alta resolución para el nivel del núcleo y el máximo de banda de valencia (VBM) de a Ga 2 p espectro de nivel de núcleo y VBM de β-Ga 2 desnudo O 3 , b Zn 2 p espectro de nivel de núcleo y VBM de ZnO / β-Ga 2 puro y espeso O 3 , c Zn 2 p espectro de nivel de núcleo y VBM de espeso 5% de ZnO / β-Ga 2 dopado con Al O 3 y d Zn 2 p espectro de nivel de núcleo y VBM de espeso 10% de ZnO / β-Ga 2 dopado con Al O 3

Los espectros de nivel central de Ga 2 p y Zn 2 p obtenido de espectros XPS de alta resolución de a delgado ZnO / β-Ga 2 O 3 , b diluido 5% de ZnO / β-Ga 2 dopado con Al O 3 y c diluido 10% de ZnO / β-Ga 2 dopado con Al O 3
La alineación sistemática de bandas para el 0%, 5% y 10% de ZnO / β-Ga 2 dopado con Al O 3 las heterouniones se calculan mediante las ecuaciones anteriores, como se muestra en la Fig. 3. El desplazamiento de banda de ZnO / β-Ga 2 sin dopar O 3 la heterounión pertenece al tipo I. Mientras que tanto el 5% como el 10% de ZnO / β-Ga 2 dopado con Al O 3 las heterouniones tienen desplazamientos de banda de tipo II. La Figura 4 muestra las alineaciones de bandas de ZnO / β-Ga 2 dopado con Al O 3 las interfaces tienen una relación lineal similar con la concentración de dopaje de Al. El CBO varía de 1,39 a 1,67 eV y la concentración dopada con Al aumenta de 0 a 10%. Mientras que el VBO se reduce de 0,06 a - 0,42 eV y la concentración dopada con Al aumenta de 0 a 10%. Se observa que el CBO y VBO para AZO / β-Ga 2 pulverizados O 3 son 0,79 eV y 0,61 eV, respectivamente [9]. Tanto la banda de conducción como la de valencia se desplazan hacia abajo en este trabajo, lo que podría deberse a la diferente proporción de composición y estructura cristalina introducidas por los métodos depositados.

Diagrama esquemático de alineación de bandas de a ZnO puro / β-Ga 2 O 3 , b 5% de ZnO / β-Ga 2 dopado con Al O 3 y c ZnO / β-Ga 2 dopado con Al 10% O 3

Las compensaciones de las bandas de conducción y valencia del AZO / β-Ga 2 depositado en la capa atómica O 3 heterouniones fabricadas con diferentes proporciones de dopaje de Al
Aparte de eso, las simulaciones de primer principio fueron realizadas por el Paquete de Simulación Ab-initio de Viena (VASP) [21,22,23,24] para investigar la estructura de banda electrónica y la alineación de banda de ZnO / Ga 2 dopado con Al O 3 heterouniones. Durante el cálculo, las interacciones electrón-ión fueron tratadas por los pseudopotenciales ultra suaves, y las funciones de onda y los potenciales se expandieron por la base de onda plana [25]. Además, se implementó la aproximación de gradiente generalizada (GGA) propuesta por Perdew, Burke y Ernzerhof (PBE) para describir las energías de correlación de intercambio [26]. Antes de iniciar la simulación, se realizaron pruebas convergentes. Mostró que la energía de corte de 450 eV para la base de onda plana y cuadrículas de espacio k de 3 × 3 × 3 con el esquema Monkhorst Pack dio resultados bien convergentes. En la optimización de la estructura, se utilizó un método de gradiente conjugado y la fuerza residual se liberó hasta que fue inferior a 0,01 eV / Å. Además, se implementaron las funciones de densidad híbridas basadas en la aproximación PBE semilocal. Para corregir la banda prohibida subestimada, el 35% del intercambio de PBE fue reemplazado por el exacto [27]. Para identificar el desplazamiento del borde de la banda con el cambio del nivel de dopaje de Al, se calculó el potencial electrostático promedio (AEP) y se alineó con el nivel de vacío que se escaló a 0 V. El VBM y el mínimo de la banda de conducción (CBM) se alinearon en consecuencia a el AEP basado en el diagrama de bandas [28]. En este trabajo, se utilizó ZnO a granel con 16 átomos de O y 16 átomos de Zn en la supercélula. Para introducir el dopaje con Al, uno o dos átomos de Zn en la supercélula fueron reemplazados por los átomos de Al, creando la estructura dopada con Al con una concentración de dopaje de 3.21% y 6.25%, respectivamente.
La Figura 5 a – c muestra los diagramas de bandas calculados de las estructuras de ZnO dopado con 3,21% Al sin dopar y ZnO dopado con Al al 6,25%, respectivamente. Muestra claramente que ZnO es un semiconductor de banda prohibida directa con una banda prohibida de 3.42 eV, y tanto el CBM como el VBM se ubicaron en el punto Γ de la zona de Brillouin. Estos resultados de simulación teórica coinciden bastante bien con el valor experimental [29]. Con el dopaje de Al, se pudo encontrar que los niveles de Fermi se desplazaron hacia arriba en la banda de conducción, que convierte el ZnO puro en un semiconductor de tipo n. Mientras tanto, las bandas prohibidas también aumentaron a 4,83 eV y 5,42 eV para ZnO dopado con Al al 3,21% y ZnO dopado con Al al 6,25%, respectivamente. Aunque las bandas prohibidas aquí para el ZnO dopado son más altas que nuestros resultados experimentales; sin embargo, esto podría atribuirse a la negligencia de los estados de defectos interfaciales, así como a otros defectos cristalinos.
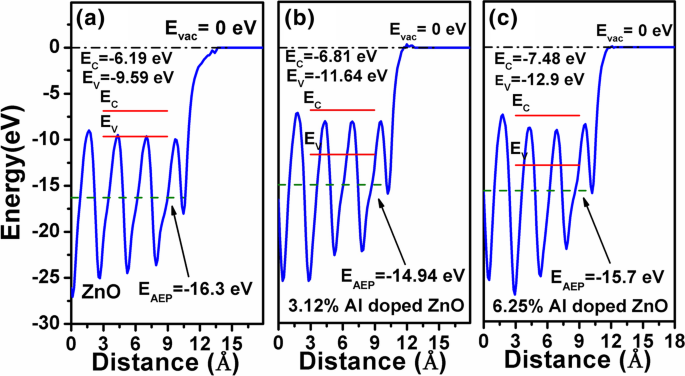
El diagrama de bandas calculado de a ZnO sin dopar, b 3,21% de ZnO dopado con Al y c Estructura de ZnO dopado con Al 6,25%. Los niveles de Fermi se establecieron en 0 eV
La Figura 6 a – c presenta las alineaciones de bandas de ZnO dopado con Al 3,21% sin dopar y ZnO dopado con Al al 6,25% hasta el nivel de vacío. Para las bandas de conducción de los materiales, debido a la fuerte mezcla de electrones entre el elemento Al y O, se pudo encontrar que el nivel de energía disminuye de - 6.19 eV del ZnO a - 6.81 eV para el 3.21% de ZnO dopado con Al ( Δ E =0,62 eV) y disminuye aún más a - 7,48 eV para el ZnO dopado con Al al 6,25% ( ΔE =1,29 eV). Mientras tanto, debido a la apertura de la banda prohibida, también se pudo encontrar que el borde de la banda de valencia se mueve hacia abajo desde - 9.59 eV para el ZnO a - 11.64 eV para el 3.21% de ZnO dopado con Al ( ΔE =2,05 eV) y - 12,9 eV para el ZnO dopado con Al al 6,25% ( ΔE =3,31 eV). En total, atribuido a la fuerte mezcla de electrones de Al y O, podría entenderse que la incorporación de Al en el ZnO abriría las brechas de banda. Además, cambiaría tanto la banda de conducción como el borde de la banda de valencia hacia el nivel de energía más bajo cuando se alinea con el nivel de vacío.
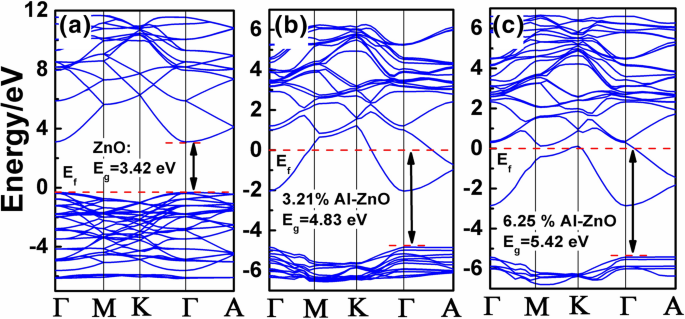
La alineación de banda de AZO / β-Ga 2 O 3 heterouniones con a deshacer, b 3,21% y c 6,25% de ZnO dopado con Al. Los niveles de vacío se escalaron a 0 eV
Conclusiones
En conclusión, las alineaciones de bandas de diferentes ZnO / β-Ga 2 dopados con Al O 3 (\ (\ overline {2} \) 01) las interfaces han sido investigadas por XPS. Se forma una alineación de banda de tipo I en la interfaz de ZnO / β-Ga 2 O 3 heterounión. Mientras que el AZO / β-Ga 2 O 3 La interfaz tiene una alineación de banda de tipo II. Los CBO varían de 1,39 a 1,67 eV y los VBO se reducen de 0,06 a - 0,42 eV y la concentración dopada con Al aumenta de 0 a 10%. Además, los cálculos de la función de densidad muestran que los desplazamientos de banda cambian debido a la fuerte mezcla de electrones de Al y O cuando Al se incorpora al ZnO. Estos resultados sugieren que el ZnO puro es un ISL válido para reducir la altura de la barrera y promover el transporte de electrones.
Disponibilidad de datos y materiales
Los conjuntos de datos que respaldan las conclusiones de este manuscrito se incluyen dentro del manuscrito.
Abreviaturas
- AEP:
-
Potencial electrostático medio
- ALD:
-
Deposición de la capa atómica
- BE:
-
Energía vinculante
- CBM:
-
Banda de conducción mínima
- CBO:
-
Desplazamiento de la banda de conducción
- CL:
-
Nivel básico
- CL:
-
Niveles básicos
- CVD:
-
Deposición de vapor químico
- DEZ:
-
Zn (C 2 H 5 ) 2
- Ga 2 O 3 :
-
Óxido de galio
- GaN:
-
Nitruro de galio
- GGA:
-
Aproximación de gradiente generalizada
- ISL:
-
Capa semiconductora intermedia
- PBE:
-
Perdew, Burke y Ernzerhof
- SiC:
-
Carburo de silicio
- TMA:
-
Trimetialuminio
- VASP:
-
Paquete de simulación de Viena Ab initio
- VBM:
-
Máximo de banda de valencia
- VBO:
-
Desplazamiento de la banda de valencia
- XPS:
-
Espectroscopia de rayos X
- ZnO:
-
Óxido de zinc
Nanomateriales
- Teoría de bandas de sólidos
- Tecnologías avanzadas de deposición de capas atómicas para micro-LED y VCSEL
- Características de alineación interfacial, eléctrica y de banda de pilas de HfO2 / Ge con capa intermedia de SiO2 formada in situ mediante deposición de capa atómica mejorada por plasma
- Propiedades fotocatalíticas de los polvos de TiO2 recubiertos con Co3O4 preparados por deposición de capa atómica mejorada con plasma
- Ajuste de nivel de Fermi de películas de ZnO mediante deposición de capa atómica superciclada
- Una investigación sobre una célula solar de silicio cristalino con una capa de silicio negro en la parte posterior
- Dependencia del espesor de las propiedades interfaces y eléctricas en la capa atómica depositada AlN en el plano c GaN
- Investigación de la banda de energía en las heterouniones de ZnO / β-Ga2O3 depositado en la capa atómica (\ (\ overline {2} 01 \))
- Investigación de la banda de energía en las heterouniones de disulfuro de molibdeno y ZrO2
- Deposición de capa atómica de SiO2 mejorada con plasma a baja temperatura utilizando dióxido de carbono
- Memristor flexible basado en Hf0.5Zr0.5O2 depositado en capa atómica con plasticidad sináptica a corto / largo plazo



