Análisis teórico de fotodiodos de avalancha de fotón único InGaAs / InAlAs
Resumen
Se reportan análisis teóricos y simulación bidimensional de fotodiodos de avalancha (APD) de InGaAs / InAlAs y APD de fotón único (SPAD). Se estudia la distribución del campo eléctrico y el efecto de túnel de los APD y SPAD de InGaAs / InAlAs. Cuando los SPAD de InGaAs / InAlAs se operan en el modo Geiger, el campo eléctrico aumenta linealmente en la capa de absorción y se desvía hacia abajo de sus relaciones lineales en la capa de multiplicación. Teniendo en cuenta el campo eléctrico del umbral de tunelización en la capa de multiplicación, el espesor de la capa de multiplicación debe ser superior a 300 nm. Además, los SPAD pueden funcionar bajo una gran tensión de polarización para evitar la formación de túneles en la capa de absorción con altas concentraciones de dopaje en la capa de carga.
Antecedentes
En 0.53 Ga 0,47 Como / en 0.52 Al 0,48 Los fotodiodos de avalancha (APD) de As (en lo sucesivo denominados InGaAs / InAlAs) e InGaAs / InP son los fotodetectores más importantes para la detección de infrarrojos de onda corta. En los últimos años, la investigación sobre la distribución de claves cuánticas ha progresado rápidamente, y ahora los APD InGaAs / InAlAs e InGaAs / InP pueden realizar el conteo y temporización de un solo fotón como APD de un solo fotón (SPAD) [1]. En comparación con otros detectores de fotón único en el rango de longitud de onda SWIR, como los tubos fotomultiplicadores, los diodos de avalancha de fotón único InGaAs tienen las ventajas distintivas de alto rendimiento, alta confiabilidad, bajo sesgo, tamaño pequeño, buena resolución de tiempo y facilidad de operación [ 2, 3]. Por lo tanto, los APD InGaAs / InAlAs e InGaAs / InP están atrayendo una atención considerable [4, 5]. En comparación con los APD que funcionan en modo lineal, los APD que funcionan en modo Geiger ya que los SPAD se aplican con una polarización inversa que excede el voltaje de ruptura [6]. Los SPAD logran una alta ganancia en la capa de multiplicación, y un solo fotón puede disparar un pulso de corriente macroscópico, lo que brinda la capacidad de detectar con precisión la llegada al detector de un solo fotón [7]. Por lo tanto, los SPAD pueden detectar un solo fotón a una longitud de onda de 1550 nm [8]. Mientras tanto, los materiales de la capa de absorción pueden controlar la longitud de onda de absorción [9].
En comparación con los SPAD basados en InAlAs, los estudios teóricos y de simulación de los SPAD basados en InP son más completos [2, 10, 11, 12]. Sin embargo, los APD basados en InAlAs se utilizan cada vez más en lugar de los APD basados en InP, ya que pueden mejorar el rendimiento tanto en APD como en SPAD [13]. La relación del coeficiente de ionización del electrón (α) al hueco (β) en InAlAs es mayor que en InP, lo que da como resultado un factor de ruido de exceso bajo y un producto de ancho de banda de alta ganancia en los APD basados en InAlAs [14]. La banda prohibida más grande de InAlAs puede mejorar las características de ruptura y disminuir la tasa de recuento oscuro (DCR) en SPADs [15]. Los APD basados en InAlAs tienen una alta movilidad de electrones, lo que conduce a tiempos de respuesta más rápidos que los APD basados en InP [16]. Además, la relación del coeficiente de ionización de los APD InAlAs es menos sensible a los cambios de temperatura de los APD basados en InP [17]. En consecuencia, los APD InGaAs / InAlAs pueden lograr un alto rendimiento en términos de características de ruptura, DCR, exceso de ruido, ganancia de ancho de banda, tiempo de respuesta y características de temperatura.
Los estudios sobre APD InGaAs / InAlAs se han centrado principalmente en aumentar la eficiencia de detección de fotón único (SPDE) y disminuir la DCR en SPAD. Karve y col. demostraron los primeros SAPD de InGaAs / InAlAs, que tienen un SPDE del 16% a 130 K [18]. Nakata y col. mejoró el rendimiento de temperatura de los SPAD, que alcanza un SPDE del 10% a 213 K [19]. Zhao y col. diseñó un SPAD de InGaAs / InAlAs que se apaga y se recupera automáticamente con un SPDE del 11,5% a 160 K; al mismo tiempo, se ha observado una DCR de 3,3 M Hz [20]. Meng y col. diseñó una estructura mesa InGaAs / InAlAs SPAD, que alcanza un SPDE del 21% a 260 K [21]. Luego, aplicaron una capa gruesa de absorción y multiplicación en una estructura similar, que mejora la SPDE al 26% a 210 K y disminuye la DCR a 1 × 10 8 Hz [22]. Sin embargo, en estos estudios, los DCR de los SPAD de InGaAs / InAlAs son demasiado altos en comparación con los SPAD de InGaAs / InP (en los SPAD de InP recientes, los DCR son típicos <10 4 Hz) [23]. Las DCR altas en los SPAD de InGaAs / InAlAs se atribuyen a las corrientes de túnel, que son causadas por el campo alto en el voltaje de sobrepolarización [21, 22, 24]. Por lo tanto, la disminución de los mecanismos relacionados con la tunelización es significativa para los SPAD de InGaAs / InAlAs, y estos mecanismos están relacionados con la distribución del campo eléctrico en los SAPD. De las literaturas [1. 9], el campo eléctrico del umbral de tunelización es 2,0 × 10 5 V / cm en la capa de absorción (InGaAs) y 6,8 × 10 5 V / cm en la capa de multiplicación (InAlAs). Por lo tanto, una distribución adecuada del campo eléctrico es significativa para los SPAD de InAlAs, que está determinada por el espesor de la capa de carga y la capa de multiplicación. Teniendo en cuenta la capa de carga de los APD de InAlAs, Kleinow et al. estudiaron la influencia de la concentración de dopaje en esta capa y encontraron que la concentración de dopaje es más importante para el desempeño de los APD InGaAs / InAlAs [25, 26]. Chen y col. estudiaron la influencia de las capas de carga y multiplicación en los voltajes de perforación y ruptura mediante análisis teóricos y simulación [27]. Estos estudios se han centrado en el desempeño de los APD de InAlAs bajo el modelo lineal. Sin embargo, el rendimiento de los SPAD de InAlAs aún no se ha comprendido completamente en el modo Geiger.
En este artículo, el análisis teórico y la simulación se utilizan para estudiar el efecto de túnel y la distribución del campo eléctrico en los SPAD de InGaAs / InAlAs. Con la consideración del campo eléctrico de umbral de tunelización en el modo Geiger, los criterios de diseño de los SPAD se optimizan para evitar el efecto de tunelización.
Métodos
Se realizan simulaciones numéricas para los APD SAGCM InGaAs / InAlAs con iluminación frontal mediante TCAD [28]. Los modelos físicos utilizados para la simulación se presentan a continuación. El modelo de ionización por impacto de Selberherr simula la multiplicación de avalanchas en InAlAs. La distribución del campo eléctrico y la corriente de difusión se describen mediante el modelo de deriva-difusión, que incluye las ecuaciones de continuidad de la portadora y de Poisson. Los modelos de tunelización de banda a banda y asistidos por trampa se utilizan para la corriente de tunelización. En la simulación se utilizan otros modelos básicos, incluidas las estadísticas de portadores de Fermi-Dirac, la recombinación Auger, la dependencia de la concentración de portadores, la recombinación Shockley-Read-Hall, la movilidad de campo bajo, la saturación de velocidad, la ionización por impacto y el método de trazado de rayos. La sección transversal esquemática de la estructura epitaxial del APD con iluminación frontal para la simulación se muestra en la Fig. 1.
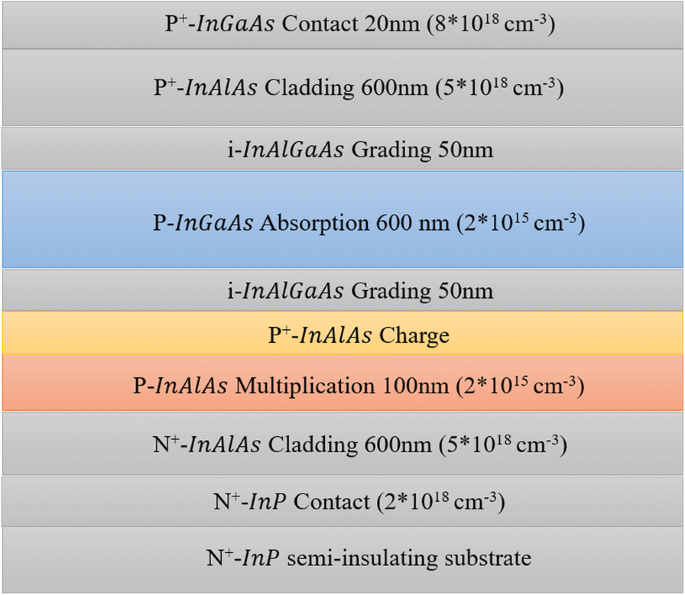
Sección transversal esquemática de los APD SAGCM con iluminación frontal. Presenta la sección transversal esquemática de la APD SAGCM InGaAs / InAlAs con iluminación superior. Incluye estructura, materiales, dopaje y espesor. De abajo hacia arriba, las capas se nombran secuencialmente como sustrato, capa de contacto, capa de revestimiento, capa de multiplicación, capa de carga, capa de clasificación, capa de absorción, capa de clasificación, capa de revestimiento y capa de contacto
De abajo hacia arriba, las capas se nombran secuencialmente como sustrato, capa de contacto, capa de revestimiento, capa de multiplicación, capa de carga, capa de clasificación, capa de absorción, capa de clasificación, capa de revestimiento y capa de contacto. Los portadores fotogenerados inducidos en la capa de absorción se desplazan hacia la capa de multiplicación, donde desencadenan la ruptura de la avalancha. El campo eléctrico en la absorción se ajusta usando el control de la capa de carga y mantiene un campo alto solo en la capa de multiplicación. Entre las capas de carga y absorción, una capa de graduación de InAlGaAs evita la acumulación de electrones en la heterounión InGaAs-InAlAs. La estructura del dispositivo en nuestra simulación es similar a la estructura experimental en la ref. [21].
La distribución del campo eléctrico en SAGCM APD se puede resolver con la ecuación de Poisson, el modelo de capa de agotamiento de PN y la ecuación de condición de contorno [29]. La ecuación de Poisson se da como
$$ \ frac {d \ xi} {d x} =\ frac {\ rho} {\ varepsilon} =\ frac {q \ ast N} {\ varepsilon}. $$ (1)La ecuación de la condición de contorno se da como
$$ Vbias + Vbi =- {\ int} _0 ^ w \ xi \ left (x, \ mathrm {w} \ right) dx. $$ (2)En estas ecuaciones, ρ es igual al ion dopante q × N en la capa de agotamiento, ε es la constante dieléctrica del material, V sesgo es el voltaje de polarización en los APD, V bi es el potencial incorporado, y w es el espesor de la capa de agotamiento. La relación matemática entre la distribución del campo eléctrico y el voltaje de polarización cuando el límite de la capa de agotamiento alcanza la capa de contacto en el dispositivo se puede derivar usando las Ecs. (1) y (2).
Las corrientes de tunelización se componen de tunelización de banda a banda y asistida por trampa. La corriente de túnel de banda a banda depende del campo en el material y se convierte en un componente dominante de la corriente oscura en campos altos [24, 30]. La tasa de generación del túnel de banda a banda se da como [31].
$$ {G} _ {\ mathrm {btb}} ={\ left (\ frac {2 {m} ^ {\ ast}} {E_g} \ right)} ^ {1/2} \ frac {q ^ 2E } {{\ left (2 \ pi \ right)} ^ 3 \ mathrm {\ hslash}} \ exp \ left (\ frac {- \ pi} {4q \ mathrm {\ hslash} E} {\ left (2 { m} ^ {\ ast} \ ast {E} _g ^ 3 \ right)} ^ {\ raisebox {1ex} {$ 1 $} \! \ left / \! \ raisebox {-1ex} {$ 2 $} \ right. } \ derecha) $$ (3)En la ecuación anterior, E g es la banda prohibida de energía de InGaAs (0,75 eV) o InAlAs (1,46 eV), m * (igual a 0,04 m e en InGaAs y 0,07 m e en InAlAs) es la masa reducida efectiva, y E es el campo eléctrico máximo. G btb depende del campo eléctrico E y banda prohibida de energía E g , w túnel se supone que es el espesor efectivo para el proceso de tunelización, y A se supone que es el área del dispositivo. Por lo tanto, la corriente de tunelización del túnel de banda a banda se da como [13].
$$ {I} _ {\ mathrm {túnel}} / A ={G} _ {\ mathrm {btb}} \ ast q \ ast {w} _ {\ mathrm {túnel}} $$ (4)Los resultados calculados de I túnel / A ( w túnel =1 μm) se presentan en la Fig. 2. I túnel se vuelve significativo a 2.0 × 10 5 V / cm de InGaAs y 6,9 × 10 5 V / cm de InAlAs, respectivamente. Encontramos que estos valores calculados se corresponden bien con el campo eléctrico del umbral de tunelización (2,0 × 10 5 V / cm, InGaAs) y (6,8 × 10 5 V / cm, InAlAs) en referencias. La corriente de túnel puede influir suficientemente en el rendimiento de los SPAD en un campo alto. Por lo tanto, el campo debe ajustarse por debajo del valor del umbral de tunelización tanto en los InGaAs como en los InAlAs de los SPAD. La Tabla 1 muestra los parámetros utilizados en la simulación.
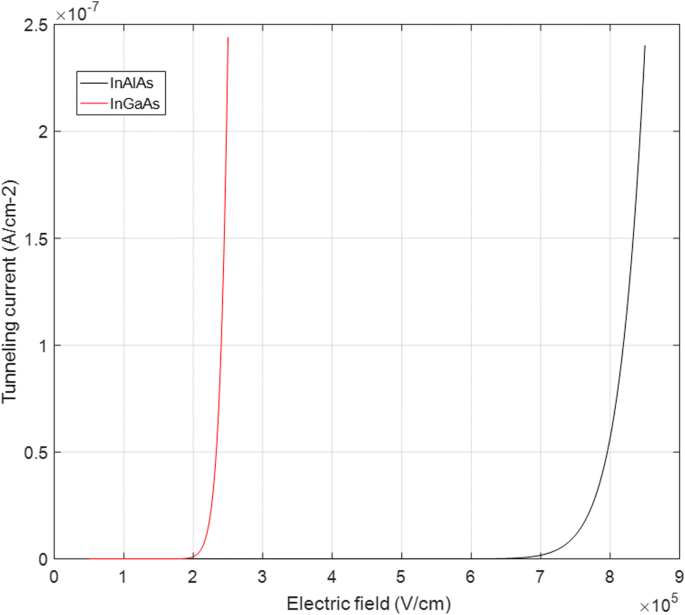
Relación entre yo túnel / A y campo eléctrico en InGaAs e InAlAs. Presenta los resultados calculados de I túnel / A . yo túnel se vuelve significativo a 2.0 × 10 5 V / cm de InGaAs y 6,9 × 10 5 V / cm de InAlAs, respectivamente
Resultados y discusión
En esta sección, el análisis teórico y las conclusiones se estudiaron mediante simulación. Primero, la distribución del campo eléctrico en el modo Geiger se estudió en la sección A. Luego, con la consideración del campo eléctrico de umbral de tunelización en el modo Geiger, los criterios de diseño de los SPAD se optimizan para evitar el efecto de tunelización en la sección B. El dispositivo típico La estructura de la referencia [22] se utilizó para probar el modelo de simulación. En esta simulación, usamos el mismo motor de simulación que la referencia [28] y la curva corriente-voltaje junto con la curva de ganancia vs voltaje fueron dadas por la Fig. 3. Se puede encontrar que la ganancia aumenta gradualmente después del voltaje de perforación y aumento repentino en el voltaje de ruptura.
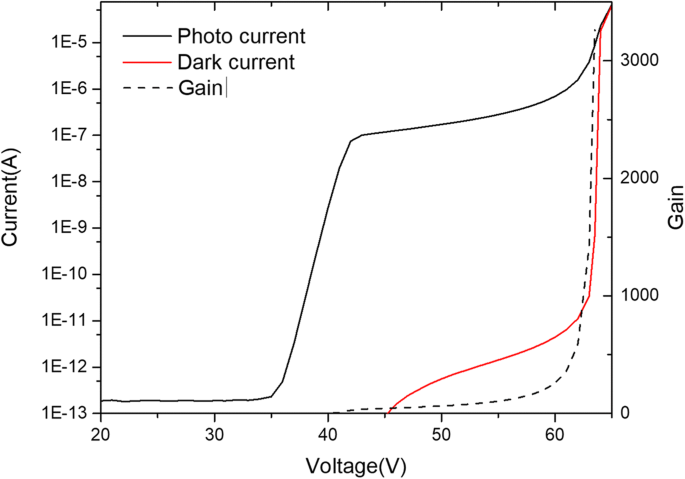
Curva de corriente-voltaje junto con ganancia vs voltaje de InGaAs / InAlAs APD. Presenta la curva i-v junto con la curva de ganancia frente a voltaje para una estructura de dispositivo típica como figura
Distribución del campo eléctrico en el modo Geiger
Descubrimos que el rendimiento del dispositivo está muy influenciado por la distribución del campo eléctrico. Para mantener la alta ganancia y la pequeña corriente oscura, es importante el control adecuado del campo eléctrico en las capas de multiplicación y absorción. De la ref. [32], una distribución de campo adecuada en InGaAs / InAlAs APD debería cumplir con esas reglas. La garantía V pt (voltaje de conexión)
Las Figuras 4 y 5 presentan las características de voltaje de campo simulado en las capas de multiplicación y absorción bajo el modo Geiger, respectivamente. Los APD operan en modo Geiger ya que los SPAD se aplican con una polarización inversa que excede el voltaje de ruptura 1 ~ 6 V en la simulación. El grosor de la capa de carga ( W cargar ) es de 50 nm, y el grosor de la capa de multiplicación ( W multiplicación ) son 100, 200 y 300 nm, respectivamente.
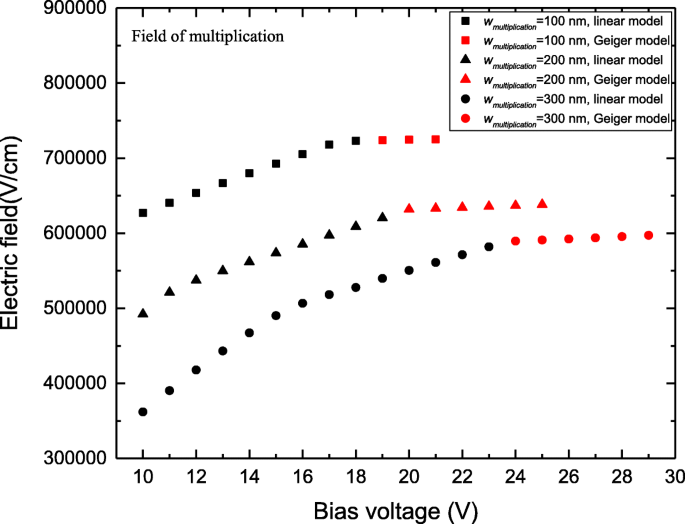
La simulación da como resultado el campo eléctrico en una multiplicación bajo el modo Geiger. Los valores de W multiplicación es 100 nm (cuadrado negro), 200 nm (triángulo negro), 300 nm (círculo negro). La Figura 3 presenta las características de voltaje de campo simuladas en las capas de multiplicación bajo el modo Geiger. El grosor de la capa de carga es de 50 nm y el grosor de la capa de multiplicación es de 100, 200 y 300 nm, respectivamente
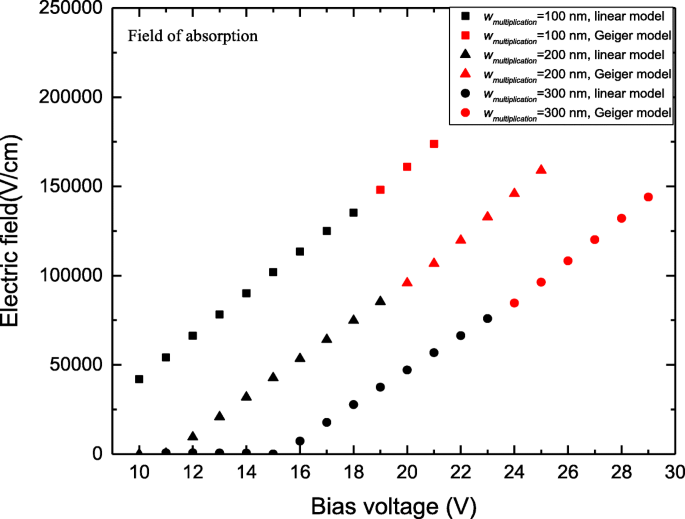
La simulación da como resultado un campo eléctrico en absorción bajo el modo Geiger. Los valores de W multiplicación es 100 nm (cuadrado negro), 200 nm (triángulo negro), 300 nm (círculo negro). La Figura 4 presenta las características de voltaje de campo simuladas en las capas de absorción bajo el modo Geiger. El grosor de la capa de carga es de 50 nm y el grosor de la capa de multiplicación es de 100, 200 y 300 nm, respectivamente.
Cuando los SPAD de InGaAs / InAlAs se operan bajo el modelo lineal (APD), el campo eléctrico en la capa de absorción y la capa de multiplicación aumenta linealmente con un voltaje de polarización incrementado. Sin embargo, a medida que el voltaje de polarización excede el voltaje de ruptura en el modo Geiger, el campo eléctrico en la capa de absorción aumenta linealmente como antes, mientras que el aumento en el campo eléctrico de avalancha en la capa de multiplicación se vuelve lento. En comparación con los APD InGaAs / InAlAs que operan en modo lineal, los SPAD InGaAs / InAlAs logran una alta ganancia en la capa de multiplicación con el campo de avalancha más alto, y un solo fotón puede disparar un pulso de corriente macroscópico. Al mismo tiempo, el campo de absorción en el modo Geiger es mayor que en el modelo lineal. La corriente de túnel se convierte en el componente dominante de la corriente oscura en el campo alto y un solo fotón puede disparar un pulso de corriente macroscópico con la ganancia de avalancha, que es mucho mayor que el modo lineal.
Consideración de diseño de SPAD
Sabemos que los SAPD funcionan en modo saturado. Para mantener la alta ganancia y la pequeña corriente oscura, es importante el control del campo eléctrico en las capas de multiplicación y absorción. Si el campo en absorción es menor que el campo de umbral de tunelización, puede mantener un campo eléctrico de alta avalancha en la capa de multiplicación y evitar una corriente de tunelización. En consecuencia, la concentración y el grosor de cada capa deben diseñarse correctamente para los SPAD.
La Figura 2 muestra que los SPAD tienen una probabilidad de un gran efecto de túnel debido al alto campo en las capas de multiplicación y absorción, que exceden el campo eléctrico del umbral de túnel. Por lo tanto, los campos eléctricos deben ajustarse por debajo del valor del umbral de tunelización tanto en la absorción de InGaAs como en la multiplicación de InAlAs. El análisis teórico muestra que el campo eléctrico de multiplicación de la avalancha se reduce por los productos de N cargar y w cargar [28]. Por tanto, la capa de carga puede controlar el campo en absorción; sin embargo, el campo eléctrico de la avalancha de la capa de multiplicación está determinado por w multiplicación . La Figura 6 presenta las características de voltaje de campo simulado para diferentes espesores de multiplicación (100-500 nm) cuando el dispositivo sufre una avería por avalancha. El dopaje de fondo en la capa de multiplicación y la capa de absorción es 2 × 10 15 cm −3 , que es la concentración intrínseca de epitaxia de haz molecular (MBE). Los resultados de la simulación muestran que el campo eléctrico de avalancha en la capa de multiplicación disminuye con el aumento del espesor de la capa de multiplicación. Por lo tanto, una capa de multiplicación gruesa puede evitar la probabilidad de efecto de túnel a través de un campo eléctrico de baja avalancha en la multiplicación.

Campo eléctrico en la capa de multiplicación con diferentes W multiplicación . La Figura 5 presenta las características de voltaje de campo simulado para diferentes espesores de multiplicación (100-500 nm) cuando el dispositivo sufre una avería por avalancha
Para evitar que el campo eléctrico de la avalancha en la multiplicación supere el valor del umbral de tunelización en el modo Geiger, el espesor de la multiplicación debe ser> 300 nm, que tiene un campo eléctrico de la avalancha inferior a 6 × 10 5 V / cm e incluso excede el voltaje de ruptura en la Fig. 4. Por lo tanto, una capa de multiplicación gruesa puede evitar el efecto de túnel en SPAD que bajo el modo Geiger. Es la razón por la que DCR bajo en SPAD con una multiplicación gruesa.
Como se mencionó en la sección A, el campo eléctrico en la capa de absorción aumenta linealmente en el modo Geiger. El aumento de la tensión de polarización influye significativamente en el campo eléctrico en la capa de absorción, lo que induce a que el campo tenga una gran probabilidad de superar 2,0 × 10 5 V / cm. La Figura 7 presenta la distribución del campo eléctrico simulado para diferentes concentraciones de dopaje en la capa de carga ( w cargar =50 nm). Encontramos que las concentraciones de dopaje más altas tienen un campo eléctrico bajo en la capa de absorción e incluso excede el voltaje de ruptura de 5 V en el modo Geiger; sin embargo, a concentraciones de dopaje más bajas, el campo eléctrico del umbral de tunelización se alcanza rápidamente. En consecuencia, las concentraciones de dopaje más pequeñas en la capa de carga provocan un inicio más temprano de los efectos de efecto túnel. Para adquirir suficiente voltaje de polarización de funcionamiento en el modo Geiger, el N cargar de SPAD es mayor que el N cargar de APD. En comparación con el N inferior cargar de SPAD, mayor N cargar de SPAD pueden funcionar bajo un voltaje de polarización grande para evitar el efecto de túnel y lograr una alta ganancia en la capa de multiplicación.
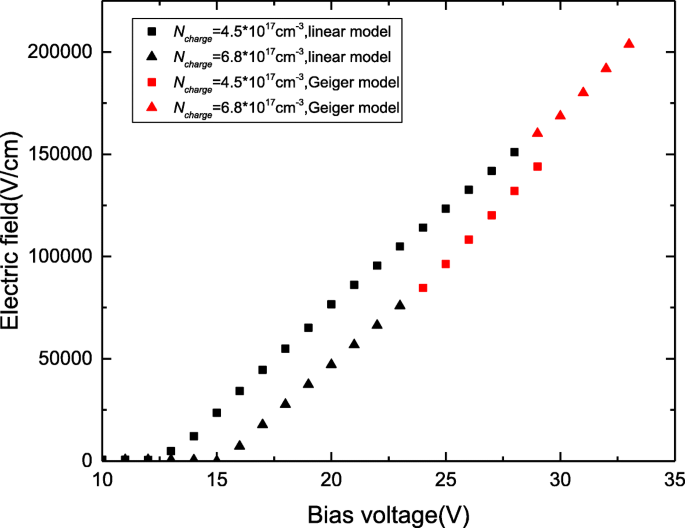
Campo en la capa de absorción con diferentes N cargar . Los valores de N cargar es 4.5 * 10 17 cm - 3 (cuadrado negro), 6,8 * 10 17 cm −3 (triángulo negro). La Figura 6 presenta la distribución de absorción del campo eléctrico para diferentes concentraciones de dopaje en la capa de carga ( W cargar =50 nm)
Conclusiones
Estudiamos la distribución del campo eléctrico y el efecto túnel de los APD y SPAD de InGaAs / InAlAs mediante análisis teórico y simulación. Cuando los SPAD de InGaAs / InAlAs se operan en el modo Geiger, el campo eléctrico en la capa de absorción aumenta linealmente y se desvía hacia abajo de sus relaciones lineales. Teniendo en cuenta el campo eléctrico del umbral de tunelización en la capa de multiplicación, el espesor de la capa de multiplicación debe ser superior a 300 nm. Además, los SPAD pueden funcionar bajo una gran tensión de polarización para evitar la formación de túneles en la capa de absorción con altas concentraciones de dopaje en la capa de carga.
Abreviaturas
- 2D:
-
Bidimensional
- APD:
-
Fotodiodo de avalancha
- DCR:
-
Tasa de recuento oscuro
- SAGCMAPDs:
-
Fotodiodos de avalancha separados de absorción, clasificación, carga y multiplicación
- SPAD:
-
Fotodiodo de avalancha de fotón único
- SPDE:
-
Eficiencia de detección de fotón único
Nanomateriales
- Opciones de análisis
- Análisis de actina y organización de la adhesión focal en células U2OS en nanoestructuras poliméricas
- Análisis de reflectancia infrarroja de capas de GaN dopadas de tipo n epitaxiales cultivadas en zafiro
- Fuente brillante de fotón único a 1,3 μm basada en punto cuántico bicapa InAs en micropilar
- Investigación teórica de nanocables de germanio tensados biaxialmente por tracción
- Análisis de mapeo Raman de resonadores de microanillos de silicio integrados con grafeno
- Fabricación de nanofibras helicoidales CA / TPU y análisis de su mecanismo
- Fotoconductividad entre bandas de puntos cuánticos de InAs / InGaAs metamórficos en la ventana de 1,3 a 1,55 μm
- Estudios teóricos sobre fotodiodos de avalancha de InGaAs / InAlAs SAGCM
- Una simulación teórica de las respuestas a la radiación de la superrejilla de Si, Ge y Si / Ge a la irradiación de baja energía
- Análisis de distribución Bi en GaAsBi epitaxial mediante HAADF-STEM con corrección de aberraciones



