Absorbedor de infrarrojo cercano mejorado:silicio negro estructurado fabricado en dos pasos y su aplicación en el dispositivo
Resumen
El silicio se usa ampliamente en la industria de los semiconductores, pero tiene un rendimiento deficiente en dispositivos fotoelectrónicos del infrarrojo cercano debido a su alta reflectancia y límite de banda prohibida. En este estudio, se utiliza un proceso de dos pasos, el método de grabado de iones reactivos profundos (DRIE) combinado con la implantación de iones por inmersión en plasma (PIII), para fabricar silicio negro microestructurado en la superficie de C-Si. Estas superficies mejoradas dopadas con elementos de azufre logran un intervalo de banda más estrecho y una mejora de la absortancia de la luz, especialmente en el rango del infrarrojo cercano (800 a 2000 nm). Mientras tanto, la absorción de luz máxima aumenta significativamente hasta un 83%. Un detector fotoelectrónico Si-PIN con silicio negro microestructurado en la superficie posterior exhibe un rendimiento notable del dispositivo, lo que lleva a una capacidad de respuesta de 0.53 A / W a 1060 nm. Este nuevo silicio negro microestructurado, que combina la característica de banda prohibida estrecha, podría tener una aplicación potencial en la detección fotoelectrónica del infrarrojo cercano.
Antecedentes
Hasta ahora, muchos materiales de silicio negro micro y nanoestructurados también se pueden fabricar mediante el tratamiento con DRIE y la implantación de iones, con el objetivo de reducir la reflectancia de la luz y mejorar la absortancia del infrarrojo cercano [1, 2, 3, 4, 5]. El proceso DRIE generalmente se lleva a cabo en un modo de pasos cíclicos de grabado-pasivación con una máscara fotorresistente que puede permitir la microfabricación de silicio de estructuras de alta relación de aspecto. Generalmente, este enfoque utiliza plasmas basados en F como SF 6 para un grabado isotrópico rápido y luego cambia a un ciclo de pasivación de la pared lateral usando C 4 F 8 [6,7,8]. Durante el ciclo de grabado subsiguiente, la película pasivante se retira preferentemente del fondo de la ranura debido al bombardeo iónico, al tiempo que se evita el grabado de las paredes laterales [9]. Finalmente, la alternancia de ciclos de grabado y pasivado podría formar las geometrías específicas de las estructuras de silicio grabadas, que dependen principalmente del tamaño de la máscara, flujo de gas, potencia del electrodo, tiempo de proceso, tiempos de ciclo, etc. Para mejorar la absorción de silicio en la longitud de onda del infrarrojo cercano, las estructuras de silicio grabadas serán dopadas mediante implantación de iones después del proceso DRIE. Bajo ciertas condiciones, se pueden obtener las matrices de silicio negro, y los dopantes de azufre resultantes contenidos dentro de la red de silicio eventualmente causarán una absortancia significativa de radiación por debajo de la banda prohibida [10, 11].
Como uno de los materiales más importantes en la industria de los semiconductores, el silicio negro se ha utilizado ampliamente en detectores fotoelectrónicos sensibles, células solares, sensores bioquímicos, dispositivos de visualización y objetos de comunicación óptica [12,13,14,15,16,17,18, 19,20]. Las micro y nanoestructuras de silicio negro han sido objeto de intensas investigaciones en los últimos años debido a su amplia aplicación en dispositivos. Un detector fotoelectrónico Si-PIN con silicio negro en la superficie frontal ha sido investigado en nuestro estudio inicial [21]. La estructura de este dispositivo tiene una capa de agotamiento amplia para que pueda reducir la influencia del movimiento de difusión del portador y lograr el propósito de mejorar la sensibilidad del dispositivo y la velocidad de respuesta. También se observa que el uso de silicio negro como una superficie fotosensible es muy difícil para que los portadores generados sean recolectados por la capa P para generar fotocorriente a través del electrodo, lo que da como resultado una respuesta de luz visible relativamente baja en comparación con un detector Si-PIN tradicional. Entonces, parece una duda que si un detector fotoelectrónico Si-PIN con silicio negro en la superficie posterior pudiera completar dos tareas a la vez, es decir, ¿aumentar la sensibilidad del dispositivo no solo en el infrarrojo cercano sino también en la longitud de onda visible?
En este artículo, informamos sobre la mejora de la absortancia de la luz y la característica de banda prohibida más estrecha del silicio negro microestructurado fabricado mediante un proceso de dos pasos:DRIE combinado con PIII. Se ha estudiado el efecto de diferentes procesos de grabado sobre la absortancia de luz en el rango de longitud de onda de 400 a 2000 nm, y el detector basado en este silicio negro microestructurado en la superficie posterior también se ha investigado con énfasis en la capacidad de respuesta del dispositivo en la longitud de onda de 400 ~ 1100 nm.
Métodos
Como se muestra en la Fig. 1a, se eligieron matrices cilíndricas de distribución uniforme y periódica para investigar las propiedades ópticas del silicio microestructurado mediante el software FDTD Simulation. La Figura 1b representa la relación entre la absorbancia y cuatro tamaños de modelo diferentes del silicio microestructurado después de una simulación optimizada, en la que cuatro modelos tienen el mismo diámetro de cilindro ( D =4 μm) pero diferente distancia entre centros ( T 1 =12 micras, T 2 =10 micras, T 3 =8 micras, T 4 =6 μm).
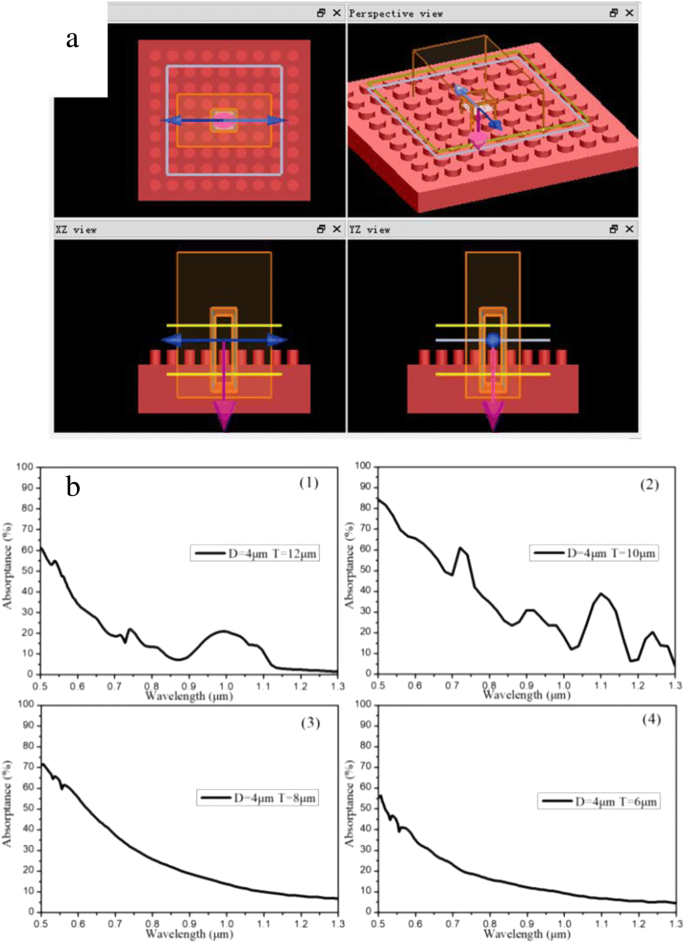
Modelo de simulación óptica ( a ) y resultados de simulación ( b ) de silicio microestructurado
Como se muestra en la Fig.2, en base a los resultados de simulación optimizados anteriores, se diseñaron tres máscaras de fotolitografía diferentes variando el tamaño de la máscara denominado máscara I ( D =4 micras, T =6 μm), máscara II ( D =4 micras, T =8 μm) y máscara III ( D =4 micras, T =10 μm), respectivamente. Luego se aplicó fotorresistente NR9-1500PY para depositar matrices circulares enmascaradas en la superficie de pulido de las piezas de silicio (15 × 15 cm 2 ), que se cortaron a partir de obleas de silicio tipo n con un espesor de 500 μm y una resistividad de 2500 a 3000 Ω · cm. Para investigar el efecto del proceso de grabado sobre la absorbancia de luz del silicio microestructurado, trasladamos las muestras de prueba resultantes de la máscara III a la cavidad del proceso (DRIE, ICP-100D) y cambiamos los tiempos de ciclo, en los que SF 6 se utilizó como gas de grabado y C 4 F 8 como gas pasivante, 30 veces, 70 veces y 100 veces, de manera diferente. Después de los procesos de grabado, las piezas de silicio se eliminaron de cualquier fotorresistente residual bajo la atmósfera de oxígeno para garantizar que la superficie del silicio estuviera limpia y lisa. Para mejorar la absortancia del silicio microestructurado, especialmente en la banda del infrarrojo cercano, las muestras de prueba resultantes de la máscara III en adelante se doparon con elementos de azufre a través del proceso PIII bajo la condición de 1.0E + 15 cm - 2 dosis de implantación y energía de implantación de 800 eV, respectivamente.

El diagrama esquemático del tamaño de la máscara
Las morfologías del silicio negro se caracterizaron mediante un microscopio electrónico de barrido de emisión de campo (SEM, JSM-7500F). La absortancia de luz se obtuvo a temperatura ambiente utilizando un espectrómetro de fibra óptica (NIR2500) equipado con una esfera integradora (Idea Optics, IS-20-5). La capacidad de respuesta del detector se midió usando un medidor de potencia óptica (OPHIR, Vega), un cortador óptico (Scitec Instruments, Modelo-300CD) y un aparato Keithley2636B en el ambiente de una habitación oscura. Para garantizar la precisión de la medición, realizamos la calibración antes de la prueba y cada una de estas mediciones se realizó en unas pocas muestras (generalmente de 4 a 6).
Resultados y discusión
La Figura 3 muestra las imágenes típicas de SEM de matrices de silicio microestructuradas alineadas que son perpendiculares a la superficie del sustrato para tres tamaños de máscara diferentes. Se muestra claramente que la vista superior del silicio microestructurado no es en realidad círculos estándar debido al hecho de que el proceso DRIE depende principalmente del tamaño de la máscara y la calidad de la técnica de fotolitografía. Luego, para investigar el efecto del proceso de grabado sobre la absorbancia de luz del silicio microestructurado, cambiamos los tiempos de ciclo a 30, 70 y 100 veces en muestras de prueba de máscara III bajo las condiciones de grabado con SF 6 durante 3 s, y pasivando con C 4 F 8 durante 2 s, cada ciclo.
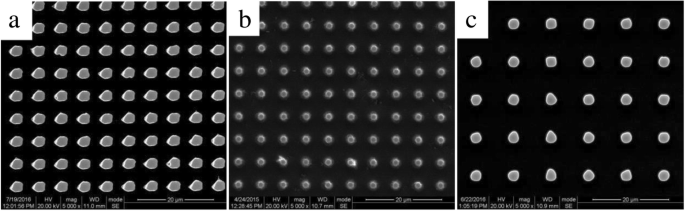
Arreglos típicos de silicio microestructurado fabricados por DRIE para diferentes tamaños de máscara. un Máscara I. b Máscara II. c Máscara III
De acuerdo con la diferente relación de velocidad de grabado entre el fotorresistente y el silicio, la profundidad del grabado se puede controlar mediante los parámetros del proceso siempre que el fotorresistente sea lo suficientemente grueso como una máscara. Puede verse en la Fig. 4 que la altura de los cilindros aumenta con el número de ciclos, en los que la altura desde la parte superior hasta el sustrato es de aproximadamente 1,87 μm, 2,35 μm y 3,15 μm, respectivamente. Es bien sabido que en el proceso DRIE, aunque existen gases de pasivación para proteger la pared lateral del objetivo de grabado, todavía está más o menos acompañado por un grabado lateral. Esta es la razón por la que las morfologías resultantes no son matrices cilíndricas ideales. Obviamente, las morfologías de estas matrices de silicio microestructuradas se pueden controlar bien variando el proceso de litografía y los tiempos del ciclo de grabado.
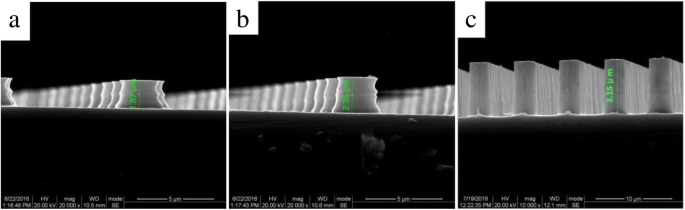
Vistas en sección de muestras de máscara III fabricadas para diferentes tiempos de ciclo. ( a ) 30, ( b ) 70 y ( c ) 100
La Figura 5a representa la absortancia de luz de matrices cilíndricas microestructuradas en diferentes tiempos de ciclo sin proceso PIII. Se muestra que el C-Si con matrices de silicio grabadas, en comparación con el C-Si ordinario, puede mejorar la absortancia de luz en todo el rango de longitud de onda de 400 a 2000 nm hasta cierto punto. La muestra grabada durante 100 ciclos presenta la mayor absortancia, hasta un 70% en el rango NIR (800 a 2000 nm), y la absortancia promedio de esta muestra alcanza el 55% en el rango de longitud de onda de 400 a 2000 nm. Esto se debe a la reflexión y absorción múltiples del silicio microestructurado (como en la Fig. 6). En el curso de la luz incidente que se refleja continuamente en la superficie lateral del cilindro, la longitud de la trayectoria de absorción de la luz incidente aumenta, dando como resultado una mejora de la absortancia. Sin embargo, la tasa de absorción aún no es lo suficientemente alta cuando la longitud de onda es superior a 1000 nm. Por lo tanto, para mejorar aún más la absortancia del silicio microestructurado, especialmente en la banda del infrarrojo cercano, las mismas muestras se dopan con elementos de azufre mediante el proceso PIII en la condición de 1.0E + 15 cm - 2 dosis de implantación y energía de implantación de 800 eV, respectivamente. Como se muestra en la Fig. 5b, la absortancia de luz aumenta obviamente en el rango de longitud de onda de 400 a 2000 nm después de la implantación de iones. Aquí, la absortancia de luz de la muestra grabada durante 100 ciclos es mucho mayor que la del C-Si. La absortancia de luz máxima y media aumentan significativamente hasta un 83% y un 62%, respectivamente. Además, se puede observar fácilmente (como en la Fig.5c) que la absortancia de muestras de 100 ciclos tiene un cambio significativo en la longitud de onda de 800 a 2000 nm antes y después del dopaje con elementos de azufre, en el que los valores máximo y promedio aumentan en un 13%. y 7%, respectivamente.
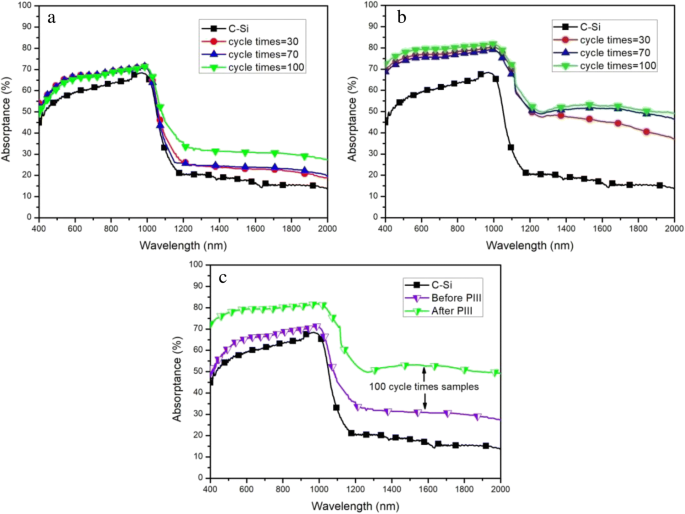
Absorción de C-Si y silicio negro fabricado por diferentes tiempos de ciclo antes ( a ) y después de PIII ( b ) y comparación de muestras de 100 ciclos ( c )

La ruta de transmisión de la luz incidente en la superficie del silicio microestructurado
Esta alta absortancia proviene principalmente del dopaje con azufre entre las matrices cilíndricas microestructuradas, que forman múltiples niveles de impurezas en la estructura de bandas de energía del C-Si. Como resultado, cuando estos niveles de impurezas múltiples inducidos se superponen, se forma una nueva banda de impurezas después del ensanchamiento, lo que finalmente reduce la banda prohibida de C-Si. La banda prohibida se puede obtener del espectro de absortancia de la muestra mediante mapeo Tauc. Los pasos específicos adoptados son los siguientes:
(i) el espectro de reflectancia se convierte a la función K-M F ( R ∞ ) utilizando la teoría de Kubelka-Munk:
$$ F \ left (R \ infty \ right) \ approx \ frac {A ^ 2} {2R} $$ (1)en el que R y A son el espectro de reflectancia y el espectro de absortancia de la muestra, respectivamente.
(ii) La función K-M F ( R ∞ ) se sustituye en la fórmula Tauc de la siguiente manera:
$$ {\ left (hv \ alpha \ right)} ^ {1 / n} =K \ left (hv- Eg \ right) $$ (2) $$ hv =\ frac {1239.7} {\ lambda} $$ (3)en el que el valor del índice n está relacionado con el tipo de transición de la muestra:transición directa, n =1/2; transición indirecta, n =2. F ( R ∞ ) es proporcional al coeficiente de absorción α, que puede sustituirse por F ( R ∞ ) y n =2 se sustituye en la fórmula (2) para obtener:
$$ {\ left (hv F \ left (R \ infty \ right) \ right)} ^ {1/2} =K \ left (hv- Eg \ right) $$ (4)(iii) Los datos espectrales de reflectancia y absortancia de la muestra se sustituyen en Eq. (1) y Eq. (1) se sustituye en la ecuación. (4), con hv como la abscisa ( X eje) y ( hvF (R ∞ )) 1/2 como la ordenada ( Y eje).
(iv) El punto de inflexión (el punto máximo de la primera derivada) se obtiene calculando la primera derivada de la hv - ( hvF (R ∞ )) 1/2 curva, y la tangente de la curva se hace en este punto. El valor de la abscisa de la intersección de la tangente y la X eje son la banda prohibida de la muestra.
La Figura 7 muestra los intervalos de banda calculados finales de C-Si y silicio negro con diferentes tiempos de ciclo. Se puede encontrar fácilmente que tres brechas de banda más bajas de silicio negro como 1.045 eV, 1.033 eV y 1.025 eV están obviamente disminuidas, respectivamente, en comparación con la brecha de banda de 1.12 eV de C-Si.
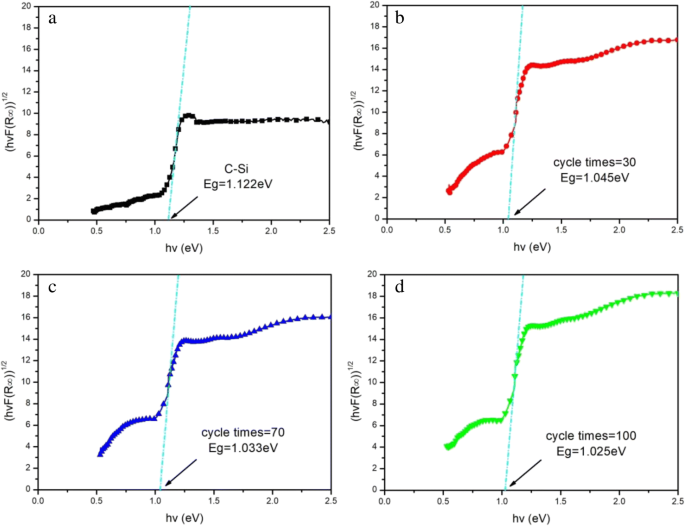
Brechas de banda de C-Si ( a ) y silicio negro elaborado por diferentes tiempos de ciclo:( b ) 30, ( c ) 70, ( d ) 100
Basado en el silicio negro anterior con propiedades ópticas mejoradas, se ha fabricado un detector Si-PIN con silicio negro formado en la superficie posterior. Primero, una oblea de silicio monocristalino intrínseco puro (tipo n) se oxida en ambos lados formando SiO 2 capas. En segundo lugar, la capa de P se fabrica mediante difusión de boro en la región fotosensible que se forma temprano al grabar el SiO 2 capa en la superficie frontal de la oblea a través del proceso de fotolitografía. En tercer lugar, una capa de Si 3 N 4 La película de permeación se deposita sobre la capa P, y luego la superficie posterior de la oblea se pule y muele hasta aproximadamente 200 µm de espesor. Cuarto, un N + dopado con P La capa se deposita sobre la superficie triturada, y luego se forma el silicio negro microestructurado en la parte superior de N + capa. Finalmente, las ventanas de los electrodos se graban mediante un proceso de fotolitografía y se depositan electrodos metálicos en ambos lados de la oblea. La Figura 8 muestra una imagen de dispositivo real (a), corriente oscura (b), curva I – V bajo iluminación de longitud de onda de 1060 nm (c) y la comparación de la capacidad de respuesta de dos detectores diferentes (d). Por la presente se declara que la capacidad de respuesta del dispositivo 1 (S1336-44BK, un detector Si-PIN comercial) se vuelve a trazar en función del sitio web público de Hamamatsu Photonics Company [22], y la capacidad de respuesta del dispositivo 2 se obtiene en nuestro nuevo detector Si-PIN fabricado con silicio negro formado en la superficie posterior, en el que la superficie fotosensible era un círculo con un diámetro de 2 mm. Se puede ver claramente que el dispositivo 2 realiza un aumento sustancial en la capacidad de respuesta, particularmente en longitudes de onda del infrarrojo cercano, es decir, 0.53 A / W a 1060 nm y 0.31 A / W a 1100 nm, respectivamente.
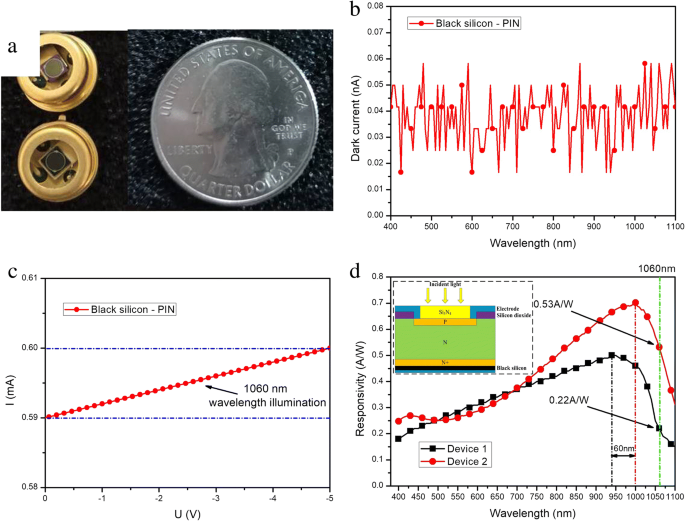
Imagen del detector ( a ), corriente oscura ( b ), Curva I – V con iluminación de longitud de onda de 1060 nm ( c ) y las respuestas de dos detectores diferentes ( d ):dispositivo 1 de la ref. [22] y el dispositivo 2 basado en los resultados del presente artículo. El recuadro de d muestra la estructura del dispositivo
Puede verse en la Fig.8b que aunque el detector Si-PIN con silicio negro formado en la superficie posterior (dispositivo 2) muestra una mejora relativamente pequeña en la capacidad de respuesta en el espectro visible, el espectro de respuesta da una capacidad de respuesta aún mayor en la longitud de onda. oscilan entre 680 y 1100 nm con un desplazamiento al rojo de aproximadamente 60 nm de la capacidad de respuesta máxima, en comparación con el detector comercial Si-PIN (dispositivo 1). La razón principal de tal distinción es que la estructura del dispositivo de estos dos detectores (dispositivos 1 y 2) es diferente. Cuando la energía del fotón es mayor que la banda prohibida de C-Si, la luz incidente es absorbida principalmente por la capa P y, por lo tanto, los portadores generados tienen suficiente energía para transitar la capa N. La mayoría de los portadores generados pueden ser recopilados por N + capa para emitir fotocorriente a través del electrodo. En esta condición, ya sea que la superficie posterior del detector se introduzca con o sin silicio negro, habrá una influencia limitada en la respuesta del dispositivo en la longitud de onda visible. A diferencia del detector con silicio negro en la superficie frontal [21], el dispositivo 2 demuestra una mejor respuesta en la longitud de onda visible. Es por eso que hay una mejora relativamente pequeña en la respuesta a la luz visible de acuerdo con la curva de respuesta medida. Nuevamente en el dispositivo 2, debido a que la capa de silicio negro se coloca en la superficie posterior, incluso si la energía del fotón es menor que la banda prohibida de C-Si, la luz del infrarrojo cercano es capaz de penetrar la capa P y ser absorbida por la capa N, y luego, N + puede recopilar una gran cantidad de portadores generados capa bajo la acción del sesgo inverso. Como resultado, habrá una salida de fotocorriente contable y el dispositivo representa un aumento sustancial de la capacidad de respuesta en la longitud de onda del infrarrojo cercano.
De acuerdo con los resultados anteriores, nuestro presente estudio podría proporcionar una estrategia factible para el campo de detección fotoelectrónica del infrarrojo cercano, pero todavía hay muchos aspectos que deben considerarse. Por ejemplo, se deberían explorar mejores procesos de fabricación y tecnologías de implantación de iones de silicio negro microestructurado, que podrían controlar con precisión las morfologías y los huecos de banda del silicio estructurado. Además, algunas otras estructuras de dispositivos novedosas de detector fotoelectrónico basadas en silicio negro deben diseñarse para lograr un mejor rendimiento del dispositivo.
Conclusiones
En resumen, los materiales de silicio negro microestructurado se fabrican mediante un proceso de dos pasos:grabado profundo de iones reactivos combinado con implantación de iones por inmersión en plasma. Las matrices cilíndricas microestructuradas en la superficie de las obleas de silicio tienen tres tamaños diferentes:máscara I ( D =4 micras, T =6 μm), máscara II ( D =4 micras, T =8 μm) y máscara III ( D =4 micras, T =10 μm), con una altura de 1,87 μm, 2,35 μm y 3,15 μm, respectivamente. Obviamente, se ha obtenido una absorción de luz mejorada del silicio negro en un amplio rango de longitud de onda de 400 a 2000 nm, y la absortancia de luz máxima y media alcanza el 83% y el 62%, respectivamente. Estas mejoras se discuten ampliamente sobre la base de la reflexión múltiple, el aumento de la longitud del camino de absorción y la brecha de banda estrecha. Se ha fabricado un nuevo detector fotoelectrónico Si-PIN con silicio negro formado en la superficie posterior, y se ha realizado una comparación de la capacidad de respuesta del dispositivo con un dispositivo comercial llamado S1336-44BK. Se concluye que nuestro detector fotoelectrónico Si-PIN con silicio negro formado en la superficie posterior tiene un aumento sustancial en la capacidad de respuesta, particularmente en las longitudes de onda del infrarrojo cercano, elevándose a 0.53 A / W a 1060 nm y 0.31 A / W a 1100 nm. , respectivamente.
Nanomateriales
- Aplicación del molibdeno y sus aleaciones
- Cómo lograr una incorporación de dispositivos fluida y efectiva a través de una aplicación móvil
- Gestión de dispositivos de IoT y su función para facilitar las implementaciones de IoT a escala
- La interacción giro-órbita de Coin Paradox mejora el efecto magnetoóptico y su aplicación en el aislador óptico integrado en el chip
- Estados electrónicos de nanocristales dopados con oxígeno y emisión visible en silicio negro Preparado por ns-Laser
- Absorbedor perfecto de banda ultra estrecha y su aplicación como sensor plasmónico en la región visible
- Una sonda fluorescente reanudable BHN-Fe3O4 @ SiO2 Nanoestructura híbrida para Fe3 + y su aplicación en bioimagen
- Revisar la aplicación de silicio negro nanoestructurado
- Anticuerpo monoclonal de heparanasa marcada con nanopartículas de oro magnético y su aplicación posterior para la obtención de imágenes por resonancia magnética tumoral
- Síntesis fácil de nanocables de cobre ultralargos y delgados y su aplicación a electrodos conductores transparentes flexibles de alto rendimiento
- Redes de almidón-agricultura flexibles y reciclables y su aplicación en el sensor de juntas



