Recombinación controlada por deformación en múltiples pocillos cuánticos de InGaN / GaN en sustratos de silicio
Resumen
Este artículo informa las propiedades de fotoluminiscencia (PL) de diodos emisores de luz de pozos cuánticos múltiples (MQW) de InGaN / GaN cultivados en sustratos de silicio que fueron diseñados con una arquitectura de control de tensión de tracción diferente, como el dopaje periódico de Si δ a la capa de GaN de tipo n o insertando la capa InGaN / AlGaN para investigar el mecanismo de recombinación controlado por cepa en el sistema. Los resultados de PL resultaron que las muestras liberadas por tensión de tracción tenían mejores rendimientos de PL ya que sus eficiencias cuánticas externas aumentaron al 17%, 7 veces mayor que la de la muestra regular. El análisis detallado confirmó que tenían tasas de recombinación no radiativa más pequeñas ((2.5 ~ 2.8) × 10 −2 s −1 en comparación con (3.6 ~ 4.7) × 10 −2 s −1 ), que se asoció con una mejor calidad cristalina y ausencia de dislocaciones o grietas. Además, sus tasas de recombinación radiativa se encontraron más estables y mucho más altas ((5,7 ~ 5,8) × 10 −3 s −1 en comparación con [9 ~ 7] × 10 −4 s −1 ) a temperatura ambiente. Esto se atribuyó a la supresión de estados localizados poco profundos en las interfaces MQW, dejando los centros de localización radiativa profunda dentro de las capas de InGaN dominando la recombinación radiativa.
Antecedentes
Las estructuras de pozos cuánticos múltiples (MQW) de InGaN / GaN cultivadas sobre sustratos de silicio en lugar de zafiro convencional han atraído cada vez más atención por sus aplicaciones potenciales en iluminación de estado sólido de bajo costo, visualización de paneles y fotónica de silicio [1,2,3,4, 5]. El obstáculo crítico en la fabricación de películas de GaN de alta calidad sobre Si es el desajuste de expansión térmica (56%) entre GaN y Si, que introdujo grandes esfuerzos de tracción y grietas en las películas de GaN crecidas [6,7,8,9]. Además, una capa de GaN de tipo n dopada con Si debajo de las capas de MQW es necesaria para los diodos emisores de luz (LED) o diodos láser (LD). En estos casos, se introducirán tensiones de tracción adicionales del dopaje de Si. En los últimos años, se han realizado esfuerzos para superar estas dificultades mediante el uso de capas intermedias con tensiones de compresión adecuadas para contrarrestar las tensiones de tracción [10,11,12,13,14, 15, 16], dopaje delta para la relajación de la deformación [17, 18], o la deposición de la capa tampón emparejada en la red [19, 20]. De acuerdo con trabajos previos [17], la arquitectura de dopaje de Si δ periódico de la capa de GaN tipo n podría lograr una capa de GaN más suave con mayor calidad cristalina y menor densidad de grietas que en el GaN dopado uniformemente con Si. Esto se atribuyó a la reducción de la tensión de tracción. Se han realizado varios trabajos para examinar la morfología de la superficie, la densidad de dislocación y las propiedades eléctricas de las capas cristalinas de GaN / Si con dopaje δ de GaN en sustratos de zafiro [21, 22] o de silicio [23]. Desafortunadamente, pocos de ellos investigaron directamente las propiedades de luminiscencia de las estructuras de InGaN / GaN MQW en la parte superior de una capa de GaN con dopaje de Si δ y aclararon la relación entre la mejora de la eficiencia de la luminiscencia y la liberación de tensión causada por las mejoras en la estructura de la película, que son críticas para el dispositivo. fabricación. También vale la pena mencionar que es difícil medir directamente la deformación o observar las distorsiones de la red sin descomponer las muestras de LED. Siempre se aplican métodos indirectos para evaluar la deformación interna. Por ejemplo, se aplicó presión mecánica para modular la deformación interna, lo que provocó cambios en el campo piezoeléctrico dentro de los MQW, así como el rendimiento optoelectrónico de los dispositivos LED [24,25,26,27]. En cualquiera de estos casos, las mediciones de espectros de luminiscencia resultaron indispensables para examinar el rendimiento del dispositivo relacionado con la deformación.
Por lo tanto, en este trabajo, las estructuras LED de InGaN / GaN MQW se depositaron sobre sustratos de silicio cristalino. Para comparación, se cultivó GaN dopado uniformemente con Si o GaN dopado con Si δ periódico que trabajaba como capa de GaN de tipo n. Además, también se prepararon dos muestras de control más basadas en capas de GaN de tipo n dopadas uniformemente con Si, insertadas mediante una capa delgada de AlGaN o InGaN respectivamente, para respaldar el análisis de la influencia de la tensión de compresión o tensión en el rendimiento del dispositivo, como AlGaN tiene una constante de celosía más pequeña que GaN, lo que liberará parcialmente la tensión de tracción en la superficie, así como la capa insertada de InGaN agravará la tensión de tracción por el contrario. Las eficiencias de fotoluminiscencia relativa (PL) y los tiempos de vida de recombinación (tasas) para cada muestra se extrajeron de los espectros PL de estado estable (SS) con temperatura variable y los espectros PL resueltos en el tiempo (TR) y luego se analizaron sistemáticamente. Los resultados resultaron que las muestras liberadas por tensión de tracción tenían mejores rendimientos de PL, ya que tanto la recombinación no radiativa relacionada con los defectos de la estructura como la supresión y la recombinación radiativa están más conectadas a estados de recombinación profunda dentro de las capas de pozos de InGaN, lo que condujo a una recombinación radiativa que es más estable con la temperatura. .
Métodos
Como se muestra en el esquema de la Fig. 1, el crecimiento epitaxial de los MQW de InGaN / GaN se realizó mediante deposición de vapor químico orgánico metálico que se informó en un trabajo anterior [17]:capa de AlN de 100 nm, capa de AlGaN graduada linealmente de 660 nm y 200 nm se cultivaron capas de GaN nominalmente no dopadas sobre el sustrato de Si (111) como tampón a 1060, 1060 y 1020ºC, respectivamente. Para las muestras S1, S3 y S4, se depositó una capa de GaN dopada uniformemente con 1 μm de Si en el tampón con una concentración estimada de átomos de Si de alrededor de 10 18 cm −3 . Para las muestras S3 y S4, se depositó una capa insertada de InGaN de 20 nm con In% ~ 10at% o una capa insertada de AlGaN de 20 nm con Al% ~ 20% después de la capa de GaN dopada uniformemente con Si de tipo n. Para la muestra S2, se cultivaron en el tampón 20 períodos de planos dopados con Si δ, cada uno seguido de GaN nominalmente no dopado de 50 nm con un espesor total de 1 μm en lugar de una capa de GaN dopada uniformemente con Si. Después de eso, en cada muestra de S1-S4, se cultivaron 6 períodos de QW de InGaN / GaN a 800 ° C, en los que la composición de indio es de alrededor de 22.0at%. El espesor medio del pozo / barrera se estimó en 2,4 nm / 10 nm. Después de eso, se cultivaron capas de GaN de tipo p dopadas con Mg de 220 nm a 1020ºC. Para las pruebas de espectros PL, se utilizó un sistema Zolix-750 PL con un láser pulsado de 10 mW y 377 nm como recurso de luz de excitación, y como fotodetector se utilizó un CCD ANDOR Newton con una resolución de 0,09 nm. En las mediciones de TRPL, las desintegraciones de PL se registraron mediante un sistema de conteo de fotón único correlacionado en el tiempo en 10-300 K.
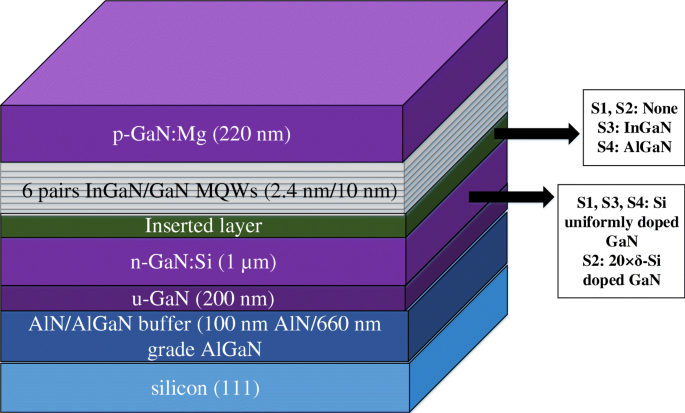
Estructuras de las muestras de LED MQW cultivadas en sustratos de Si. S1, S3 y S4 contienen una capa de GaN de tipo n dopada uniformemente con 1 μm de Si. S3 contiene una capa insertada de InGaN de 20 nm. S4 contiene una capa insertada de AlGaN de 20 nm. S2 contiene 20 períodos de planos dopados con Si-δ, cada uno seguido de GaN nominalmente no dopado de 50 nm con un espesor total de 1 μm en lugar de una capa de GaN tipo n dopado uniformemente con Si
Resultados y discusión
La descripción general de las propiedades de SSPL para cada muestra de MQW probada a 10 K se muestra en la Fig. 2. Como se ve en el inserto, el MQW original en S1 con estructura de Si exhibe picos de emisión alrededor de 500-650 nm con oscilación de Fabry-Perot. Los espectros PL para las cuatro muestras tienen el mismo carácter. Este fenómeno se observa comúnmente en LED basados en GaN cultivados en sustratos de Si [28, 29, 30], ya que la interfaz tampón / Si tiene una gran reflectancia, por lo que se refleja una notable fracción descendente de la intensidad PL de los MQW e interfiere con la directa ascendente fracción. Estos picos de oscilación se pueden describir simplemente como señales PL gaussianas multiplicadas por el elemento de oscilación (1 + Acos (4 πnd / λ )) (demostrado como la curva roja en el inserto de la Fig.1), en la que A representa la fuerza de oscilación, n es el índice de refracción promedio de la película MQW, d es el espesor total de la película MQW y λ es la longitud de onda PL. De acuerdo con el modelo anterior, el pico PL de Gauss original se puede ajustar y extraer de los picos de oscilación complejos (demostrado como la curva azul en el inserto de la Fig. 1). El resultado de SSPL resultó que S1 tiene un pico PL verde nítido a 531 nm, de acuerdo con la energía de banda prohibida del cristal de InGaN con In% ~ 22at%. Como comparaciones, S2 con una capa de GaN de tipo n dopada con Si δ tiene un pico PL desplazado al rojo notablemente a 579 nm, S3 con una capa insertada de InGaN tiene un pico PL ligeramente desplazado al azul a 517 nm, y S4 con una capa insertada de AlGaN tiene un PL ligeramente desplazado al rojo pico a 545 nm. Teniendo en cuenta que la capa insertada de AlGaN desempeña el papel de liberar la tensión de tracción que acaba de familiarizarse con la función del dopaje de Si δ, mientras que la capa insertada de InGaN agrava la tensión de tracción, estos resultados indican que la tensión de tracción en el sustrato conducirá al desplazamiento hacia el azul de la posición MQW PL o agrandamiento de la banda prohibida promedio del pozo InGaN. El efecto de liberación de tensión de la capa de GaN dopado con Si δ es mucho más fuerte que el de la introducción de la capa insertada.
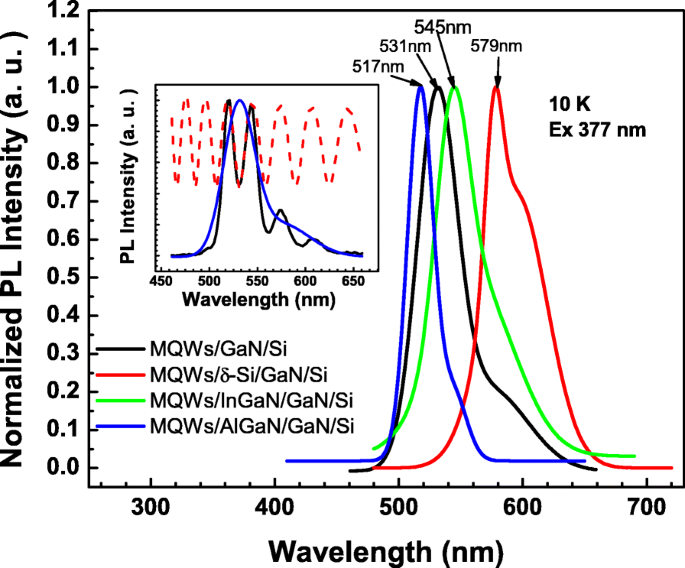
Descripción general de SSPL para S1 – S4 excitado por láser de 377 nm a 10 K. Las señales PL originales contienen oscilación de Fabry-Perot que se muestra como la curva negra en el inserto (S1 como ejemplo). El elemento de oscilación (curva de trazos rojos) y el pico PL de Gauss (curva azul) se dividen ajustando las señales originales. Todos los datos PL para S1-S4 se tratan con el mismo método, y luego, el PL gaussiano dividido se muestra en la figura
Para comprender la naturaleza de la recombinación en los MQW, es fundamental probar sus propiedades de desintegración de PL porque las vidas de las PL relacionadas con las tasas de recombinación radiativa / no radiativa se pueden extraer directamente de las curvas de desintegración. Aquí, las desintegraciones de PL se midieron fijando la longitud de onda detectada en los valores máximos de S1-S4, y las mediciones se realizaron a diferentes temperaturas en un rango de 10 a 300 K. La figura 3 muestra tres curvas de desintegración de PL típicas para S1 probadas a 10, 100 y 300 K. Se encuentra que las desintegraciones de PL para todos los S1-S4 tienden a variar con la temperatura. Este fenómeno refleja las dependencias de la temperatura tanto de las tasas de recombinación radiativa como de las tasas de recombinación no radiativa en las muestras. Se utilizó la siguiente función de caída exponencial única para ajustar cada curva de caída:
$$ I (t) ={I} _0 {e} ^ {- t / \ tau} $$ (1)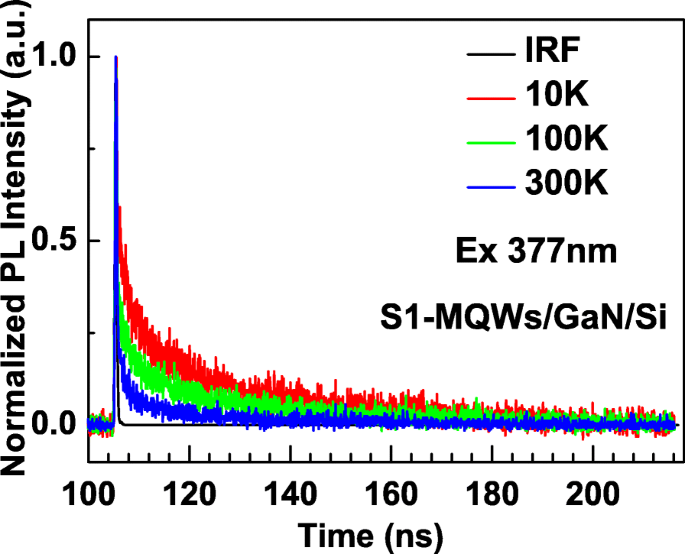
Curvas de desintegración PL para S1 excitado por láser pulsado de 377 nm a 10 K, 100 K y 300 K
donde yo 0 representa la intensidad de PL en t =0 y τ representa la vida útil de PL. Vale la pena señalar que no todas las curvas de desintegración pueden ajustarse perfectamente mediante la función de desintegración exponencial única anterior. Esto ha sido ampliamente discutido por varios grupos [31,32,33,34]. Una suposición razonable fue que existen múltiples centros de recombinación en el sistema. A veces se utilizó la función de decaimiento multi-exponencial para ajustar las curvas. Aquí, para evitar introducir demasiados supuestos que son difíciles de verificar al final, o hacer que el análisis se refleje incorrectamente solo en las partes menores de todas las propiedades de PL, usamos el modelo más simple para extraer una vida media de PL para cada muestra, que puede reflejar las propiedades dinámicas generales de PL. Los tiempos de vida obtenidos para S1-S4 se reunieron en la Fig. 4a. Para conectar los resultados dinámicos de PL a la probabilidad de recombinación, la tasa de recombinación k se definió como k =1 / τ . Manchas de k versus temperatura para S1-S4 también se muestran en la Fig. 4b. Los resultados muestran claramente dos tipos diversos de evolución de k con temperatura, las tasas de recombinación para las muestras S2 y S4 liberadas por tensión de tracción son menores que las de la muestra S1 original o la muestra S3 agravada por tensión de tracción en todo el rango de temperatura y aumentan más severamente con el aumento de temperatura. Tenga en cuenta que k = k r + k nr , en el que k r representa la tasa de recombinación radiativa y k nr representa la tasa de recombinación no radiativa. Se espera que k nr aumenta cuando la temperatura sube y domina k a temperatura ambiente, ya que siempre se relaciona con los procesos de intercambio de energía con calor [35]. Entonces, el k Los resultados en el lado de alta temperatura en la Fig. 4b exhiben la evidencia sólida de que los procesos de liberación de cepas como el dopaje de Si δ y la inserción de AlGaN tienen influencias positivas en la supresión de la recombinación no radiativa en los MQW a través de la reducción de defectos de dislocación o grietas que tienen una gran influencia en k nr . Pero k r se vuelve no despreciable en condiciones de baja temperatura. Por lo tanto, se necesita información adicional y más análisis para explicar el comportamiento de k en el lado de baja temperatura.

un Vida útil de PL frente a temperatura para S1 – S4. La longitud de onda detectada se mantiene en cada posición de pico de acuerdo con los resultados de SSPL en la Fig. 2. b Tasas de recombinación correspondientes para S1-S4, que se obtienen mediante k =1 / τ
Por lo tanto, para dividir k r y k nr de cada k valor, se midieron los espectros SSPL en diversas condiciones de temperatura para cada muestra. Luego, la intensidad de cada pico de PL correspondiente a sus longitudes de onda detectadas en pruebas anteriores de TRPL se registró como I ( T ). Después de eso, la eficiencia relativa de PL se definió como η = yo ( T ) / yo 0 , en el que yo 0 representa la intensidad de PL a 0 K. Las eficiencias de PL obtenidas para S1-S4 se reunieron en la Fig. 5a. Se puede encontrar que las eficiencias PL para S2 y S4 son ambas alrededor del 17%, que son 7 veces mayores que las de S1. Se sabe que solo la recombinación radiativa contribuye a la intensidad de PL; por lo tanto, esta eficiencia relativa de PL refleja la proporción de la tasa de recombinación radiativa en la tasa de recombinación total:
$$ \ eta ={k} _r / \ left ({k} _r + {k} _ {nr} \ right) ={k} _r / k $$ (2)
un Eficiencias relativas de PL vs. temperatura para S1 – S4. La longitud de onda detectada se mantiene en cada posición de pico de acuerdo con los resultados de SSPL en la Fig. 2. b Tasa de recombinación total, tasa de recombinación radiativa y tasa de recombinación no radiativa frente a la temperatura para S1
Por lo tanto, es capaz de resolver k r = kη y k nr = k (1 - η ) de los resultados de TRPL combinados con η . El cálculo respectivo para k r y k nr de S2 se mostró en la Fig. 5b como ejemplo. Los resultados resultaron que incluso para S2 con modificación de dopaje de Si, la tasa de recombinación no radiativa es mayor que la tasa de recombinación radiativa hasta alcanzar una temperatura muy baja de 50 K. Esto explica la razón por la cual k sigue aumentando cuando la temperatura aumenta porque es dominante en k nr . También indica la alta demanda de una mayor mejora de la calidad cristalina para MQW en estructuras de Si. La tasa de recombinación radiativa k r se encontró que declinaba monótonamente con el crecimiento de la temperatura, lo que no concuerda con las propiedades típicas de PL que se originan a partir de la recombinación de pares de electrones libres que k r está libre de temperatura. Sin embargo, es razonable si el proceso PL es dominante en la localización de excitones. Los excitones tienden a deslocalizarse en un rango de temperatura más alto; como resultado, el aumento de la temperatura conducirá a una disminución de la tasa de localización [32]. k nr y k r versus temperatura para S1-S4 se resumieron en la Fig. 6a, b, respectivamente. Como se muestra, los resultados de k nr a 300 K para S2 y S4 son 2,5 × 10 −2 s −1 y 2,8 × 10 −2 s −1 , respectivamente, que son inferiores a los de S1 (3,6 × 10 −2 s −1 ) y S4 (4,7 × 10 −2 s −1 ). Estos verifican además que los procesos de liberación de cepas suprimen la formación de dislocaciones y grietas en los MQW y, en consecuencia, disminuyen las densidades de los centros de recombinación no radiativa. Este efecto de supresión se vuelve más sensible cuando la temperatura baja. El k obtenido r los resultados son más complicados. Como se muestra, k r para S1 y S3 disminuyen mucho más severamente que para S2 y S4 después del aumento de temperatura. Como resultado, obtuvo k r a 300 K para S2 (5,7 × 10 −3 s −1 ) y S4 (5,8 × 10 −3 s −1 ) son mucho más altos que los de S1 (9 × 10 −4 s −1 ) y S3 (7 × 10 −4 s −1 ). Es razonable atribuir este fenómeno a los procesos de liberación de cepas:de acuerdo con la discusión anterior, los procesos radiativos en estas muestras de MQW están relacionados principalmente con la recombinación de excitones en estados localizados. Aquí, k r se determina principalmente por la tasa de localización de excitones k loc . El dramático declive de k loc con temperatura creciente indica que la profundidad promedio de los estados localizados es relativamente pequeña en el sistema, lo que hace que el excitón sea fácil de deslocalizar a alta temperatura. En otras palabras, las profundidades promedio de los estados localizados en muestras con liberación de tensión como S1 y S3 son más pequeñas que las que no tienen liberación de tensión. Con base en los trabajos anteriores [36], los centros de recombinación radiativa localizados en MQW de InGaN / GaN a menudo se ofrecen por defectos estructurales en las capas de pozos de InGaN, como variaciones de espesor de pozo y agrupaciones ricas en indio, en las que las variaciones de espesor de pozo ofrecen estados poco profundos, así como Los conglomerados ricos en indio ofrecen estados con profundidades mucho más profundas [33]. Aquí, el resultado de k r indica que una fuerte tensión de tracción en las interfaces MQW liderada por el sustrato de Si y GaN dopado con Si puede mejorar la formación de defectos estructurales superficiales radiativos, por lo que la profundidad de los estados localizados para S1 y S3 es menor y las variaciones de espesor son dominantes en los procesos de localización de excitones . Para S2 y S4, las variaciones de espesor de pozo se suprimen, por lo que los procesos de localización de excitones son dominantes en los estados profundos dentro de los pozos de InGaN, exhibiendo profundidades promedio mucho mayores de estados localizados y k más estables. r versus temperatura. En consecuencia, las muestras S1 y S3 demuestran un k más alto r que S2 y S4 en el lado de baja temperatura donde el efecto de deslocalización del excitón es débil, pero mucho menor k r a temperatura ambiente.

un Tasas de recombinación no radiativa frente a temperatura para S1-S4. b Tasas de recombinación radiativa frente a temperatura para S1-S4
Conclusiones
En resumen, se estudiaron espectros de SSPL y TRPL de temperatura variable para diferentes MQW de InGaN / GaN en estructuras de Si con o sin tratamientos de liberación de tensión de tracción. Se encontró que la muestra con la capa de GaN dopante de Si δ o la capa insertada de AlGaN tenía una tasa de recombinación más pequeña y una mayor eficiencia de PL (hasta 17%) que la muestra regular (2.5%) o muestra con la capa insertada de InGaN (1.6%). Un análisis más detallado aclaró que las tasas de recombinación más pequeñas se debieron principalmente a las tasas de recombinación no radiativa dominantes más pequeñas (2,5 × 10 −2 s −1 para la muestra de dopaje δ, 3.6 × 10 −2 s −1 para la muestra insertada de AlGaN en comparación con 3.6 × 10 −2 s −1 para muestra regular y 4,7 × 10 −2 s −1 para muestra insertada de InGaN), que eran atribuibles a la supresión de la formación de dislocaciones o grietas. Además de las tasas de recombinación no radiativa más pequeñas, los mejores rendimientos de PL también fueron liderados por las tasas de recombinación radiativa que eran más estables y más altas a temperatura ambiente (5,7 × 10 −3 s −1 para la muestra de dopaje δ, 5,8 × 10 −3 s −1 para la muestra insertada de AlGaN en comparación con 9 × 10 −4 s −1 para muestra regular y 7 × 10 −4 s −1 para la muestra insertada de InGaN). También fueron atribuibles a la supresión de variaciones de espesor de pozos en las interfaces MQW, dejando que los centros de localización radiativa profunda dentro de las capas de InGaN dominen el proceso de recombinación radiativa. Los resultados anteriores mostraron una imagen clara de los procesos de recombinación de dispositivos LED de InGaN / GaN MQW en sustratos de silicio, lo que puede guiar la fabricación del dispositivo en el futuro.
Abreviaturas
- IQE:
-
Eficiencia cuántica interna
- LD:
-
Diodo láser
- LED:
-
Diodo emisor de luz
- MQW:
-
Pozo cuántico múltiple
- PL:
-
Fotoluminiscencia
- SSPL:
-
Fotoluminiscencia en estado estacionario
- TRPL:
-
Fotoluminiscencia resuelta en el tiempo
Nanomateriales
- El transporte cuántico se vuelve balístico
- Construyendo qubits de un solo átomo bajo un microscopio
- Nanosilicio para producir hidrógeno
- Recubrimiento nano para varios colores
- Nano grafema, memoria transparente flexible basada en silicio
- El reordenamiento atómico de múltiples pozos cuánticos basados en GaN en gas mixto H2 / NH3 para mejorar las propiedades estructurales y ópticas
- Emisión multicolor de una estructura de nanopiramida cuasicristalina fotónica ultravioleta basada en GaN con múltiples pozos cuánticos semipolares InxGa1 − xN / GaN
- Desgaste triboquímico dependiente de la velocidad de deslizamiento del silicio libre de óxido
- Puntos cuánticos de bismuto en pozos cuánticos de GaAsBi / AlAs recocidos
- Investigación sobre la polarización de la superficie de la heteroestructura de GaN / AlGaN / GaN con cubierta de Al2O3 mediante espectroscopia de fotoelectrones de rayos X de ángulo resuelto
- Capas óptimas de dopaje de silicio de barreras cuánticas en la secuencia de crecimiento que forman el potencial de confinamiento suave de ocho períodos In0.2Ga0.8N / GaN Pozos cuánticos de azul LE…



