Avances recientes en β-Ga2O3 – Contactos metálicos
Resumen
Óxido de galio beta de banda prohibida ultra ancha (β-Ga 2 O 3 ) ha atraído una atención considerable como material semiconductor prometedor para la electrónica de potencia de próxima generación. Posee excelentes propiedades de material, como un ancho de banda prohibida de 4,6 a 4,9 eV, un campo eléctrico de alta ruptura de 8 MV / cm y una excepcional figura de mérito de Baliga (BFOM), junto con una estabilidad química y térmica superior. Estas características sugieren su gran potencial para futuras aplicaciones en dispositivos de potencia y optoelectrónicos. Sin embargo, el problema crítico de los contactos entre el metal y Ga 2 O 3 limita el rendimiento de β-Ga 2 O 3 dispositivos. En este trabajo, hemos revisado los avances en contactos de β-Ga 2 O 3 MOSFET. Para mejorar las propiedades de contacto, se resumen y analizan en detalle cuatro enfoques principales, incluido el pretratamiento, el postratamiento, el electrodo de metal multicapa y la introducción de una capa intermedia. En comparación, los dos últimos métodos están siendo estudiados de manera intensiva y más favorable que el pretratamiento que inevitablemente generaría daños incontrolables. Finalmente, se presentan las conclusiones y perspectivas futuras para mejorar aún más los contactos óhmicos.
Introducción
Recientemente, el óxido de galio (Ga 2 O 3 ) ha sido considerado como un candidato prometedor para la preparación de dispositivos de alta potencia y alta eficiencia en virtud de sus excelentes propiedades materiales [1, 2, 3]. Ga 2 O 3 tiene cinco polimorfos diferentes, designados como α-Ga 2 O 3 , β-Ga 2 O 3 , γ-Ga 2 O 3 , δ-Ga 2 O 3 y ε-Ga 2 O 3 , entre los cuales β-Ga 2 O 3 es el más estable termodinámicamente y ha sido ampliamente estudiado [4]. Con banda prohibida ultra ancha de 4,6 a 4,9 eV [5,6,7], el campo eléctrico de ruptura teórica ( E br ) de 8 MV / cm para β-Ga 2 O 3 es aproximadamente tres veces más grande que el de SiC o GaN [8,9,10], lo que permite la β-Ga 2 O 3 dispositivos basados en para manejar voltajes de conmutación gigantescos. La idoneidad de los semiconductores para aplicaciones de dispositivos de potencia suele evaluarse mediante la figura de mérito de Baliga (BFOM) [11]. El BFOM de β-Ga 2 O 3 es casi el triple que el de SiC y GaN, reduciendo significativamente la pérdida de conducción [3, 12,13,14]. Además, la velocidad del electrón de saturación se estima teóricamente en alrededor de 2 × 10 7 cm / s, lo que lo hace atractivo para operaciones de alta frecuencia [15,16,17,18,19,20]. Otro interés distintivo de β-Ga 2 O 3 Entre los semiconductores de banda prohibida amplia se encuentra que los monocristales de alta calidad se pueden sintetizar de forma rentable mediante el uso de técnicas de crecimiento en estado fundido [21,22,23,24]. Además, β-Ga 2 de tipo n de alta calidad O 3 Las películas epitaxiales se pueden realizar dopando con precisión con Sn, Si, Ge y Mg, y la densidad electrónica obtenida varía entre 10 16 a 10 19 cm −3 [25,26,27,28]. Debido a las ventajas mencionadas anteriormente sobre otros semiconductores de banda ancha, β-Ga 2 O 3 muestra sus capacidades para ser un material prometedor para la electrónica de potencia, así como para entornos extremos (alta temperatura, alto voltaje y alta radiación) [29,30,31] electrónica.
Muchos β-Ga 2 prometedores O 3 Se han informado dispositivos, incluidos diodos de barrera Schottky [32], MOSFET [1, 2, 3] y varios tipos de fotodetectores ciegos al sol [33, 34]. Entre estos dispositivos, los MOSFET son la configuración más predominante para el funcionamiento de radiofrecuencia y alta potencia [35], lo que permite aprovechar al máximo su alta E br y BFOM. Sin embargo, uno de los desafíos para β-Ga 2 O 3 La aplicación en los dispositivos MOSFET es la dificultad de formar contactos óhmicos en comparación con los semiconductores de banda estrecha [36]. Por lo general, un excelente contacto óhmico entre el semiconductor y el electrodo metálico es esencial para los dispositivos semiconductores de alto rendimiento [37, 38]. Los contactos de baja resistencia podrían reducir la caída de voltaje en el contacto y, en consecuencia, aumentar el voltaje a través del canal, asegurando la densidad de corriente diseñada y las altas velocidades de conmutación. Además, los contactos de baja resistencia contribuyen a reducir la generación de calor que podría agravar el efecto de autocalentamiento.
En consecuencia, la fabricación de contactos óhmicos de alta calidad es un requisito previo para lograr dispositivos de alto rendimiento. En esta revisión, comenzamos con conceptos fundamentales de contactos de metal / semiconductores. En la sección "Aproximaciones a los contactos óhmicos", un resumen de los recientes avances significativos sobre los contactos óhmicos para β-Ga 2 O 3 Se presenta, y se discuten y analizan los enfoques a los contactos óhmicos. Finalmente, se proporcionan algunas perspectivas para mejorar los contactos óhmicos a β-Ga 2 O 3 en el futuro.
Física básica de los contactos óhmicos
Un contacto óhmico es una unión de metal / semiconductor en la que no hay barrera en la interfaz que impida el transporte de portadores, como se ilustra en la Fig. 1a. Por el contrario, una barrera de energía existente en la interfaz inhibirá el transporte del portador entre el metal y el semiconductor, como es evidente en la Fig. 1b. En particular, los contactos formados entre semiconductores de banda ancha y metales son siempre Schottky. Por lo tanto, la resistencia de contacto normalmente depende de la altura de la barrera Schottky de metal / semiconductor (SBH) Φ B . Para un semiconductor de tipo n, obedece a la ecuación:
$$ {q \ Phi} _B ={q \ Phi} _m - {\ chi} _s $$ (1)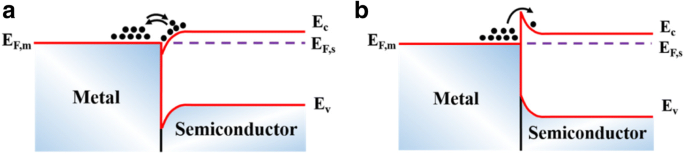
Ilustraciones esquemáticas de a Contactos óhmicos y b Contactos de Schottky. E C , E V , E F , m y E F , s son los niveles de energía del borde de la banda de conducción, el borde de la banda de valencia, la energía de Fermi del metal y el semiconductor, respectivamente
donde Φ m es la función de trabajo del metal y χ s es la afinidad electrónica del semiconductor.
Como se muestra en la ecuación. (1), es importante reducir el SBH para formar el contacto óhmico. Además, un alto dopaje en semiconductores podría facilitar la formación de contactos óhmicos, por ejemplo, para semiconductores muy dopados (N D > ~ 10 18 cm −3 ), la barrera se volverá lo suficientemente estrecha y permitirá que los electrones pasen directamente a través de la interfaz debido a una curvatura significativa de la banda de conducción [39], como se muestra en la Fig. 2. Sin embargo, los niveles de dopaje que se pueden lograr en β- Ga 2 O 3 suelen estar por debajo de lo que se puede obtener en Si, como es el caso de otros semiconductores anchos. Aparte de eso, los estados de la superficie también juegan un papel importante en la formación de contactos óhmicos que se definen frecuentemente como regiones de recombinación de alta velocidad. Esos niveles intermedios de defectos de banda prohibida inducidos por los estados de superficie pueden ayudar a los portadores a transportarse. Esto implica que se puede formar un buen contacto óhmico introduciendo estados de superficie adecuados en los semiconductores [40,41,42,43].
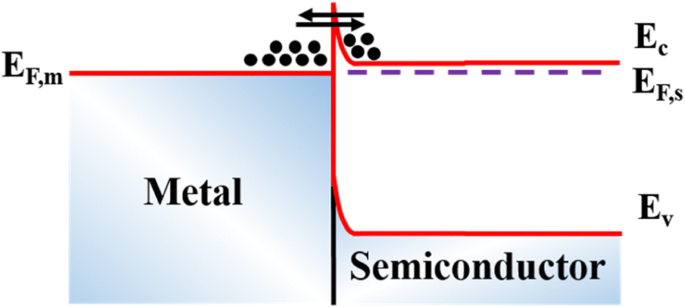
El diagrama de bandas de energía en la interfaz metal / semiconductor con semiconductores altamente dopados
Es necesaria una cuantificación eléctrica de las características de los contactos para evaluar la calidad de los contactos. Actualmente, la resistividad de contacto específica ρ C es uno de los parámetros más utilizados para acceder al rendimiento de los contactos óhmicos, normalmente expresado en Ω ∙ cm 2 [44]. La resistividad de contacto específica es una cantidad muy útil que es independiente de la geometría del contacto y se refiere únicamente a la interfaz metal / semiconductor. Hasta ahora, el ρ más bajo C de 4,6 × 10 −6 Ω ∙ cm 2 se informó para los contactos de Ti / Au a β-Ga 2 O 3 [45]. Wong y col. también obtuvo un bajo ρ C de 7,5 × 10 −6 Ω ∙ cm 2 con contactos de Ti / Au [46]. Hasta ahora, se han dedicado muchos esfuerzos para lograr el contacto con bajo ρ C , y los valores típicos para resistividades de contacto específicas distribuidas en un rango de 10 −5 –10 −6 Ω ∙ cm 2 para buenos contactos óhmicos [36].
Enfoques a los contactos óhmicos
Hasta la fecha, las investigaciones sobre las propiedades intrínsecas de β-Ga 2 O 3 en su mayoría se han llevado a cabo en su estructura MOSFET, en la que generalmente se adoptan dos tipos de método de síntesis de canal. Uno es la escama exfoliada micromecánicamente (nanomembrana); el otro es el β-Ga 2 epitaxial O 3 película en su sustrato nativo, como se resume en la Tabla 1.
Normalmente, β-Ga 2 exfoliado O 3 las escamas se pueden transferir a cualquier sustrato de manera conveniente y rentable. Se encuentra que las propiedades del material de β-Ga 2 O 3 las escamas no degenerarían durante la exfoliación, como lo demuestra la espectroscopía Raman y la microscopía de fuerza atómica [19], lo que significa que el rendimiento de los MOSFET basados en las escamas exfoliadas es comparable al basado en las capas epitaxiales. Debido a estas ventajas, este método se recomienda para estudiar las características eléctricas que consisten en la densidad de defectos interfaciales, voltaje de ruptura, dispersión de fonones ópticos superficiales [47,48,49] y propiedad térmica, es decir, efecto de autocalentamiento [50, 51].
Como se resume en la Tabla 1, los métodos empleados para mejorar los contactos óhmicos podrían clasificarse generalmente en tres tipos:(1) pretratamiento, (2) postratamiento y (3) electrodo metálico multicapa. Además, la introducción de una capa intermedia también puede obtener contactos óhmicos superiores que no se muestran en la Tabla 1.
Tratamiento previo
El pretratamiento se realiza antes de la deposición del metal, incluida la implantación de iones, el bombardeo de plasma y el grabado con iones reactivos (RIE). Higashiwaki y col. demostraron que los contactos formados mediante el uso de una pila de Ti / Au con el proceso de pretratamiento RIE mostraron un comportamiento casi óhmico, mientras que la muestra sin el tratamiento RIE mostró un comportamiento Schottky, como se ilustra en la Fig. 3 [1]. La diferencia significativa podría atribuirse a la difusión externa de los átomos de oxígeno libres que se generaron a través del bombardeo continuo al romper los enlaces Ga – O expuestos, dejando muchas vacantes de oxígeno que actúan como donantes en β-Ga 2 O 3 . Por otro lado, el tratamiento continuo de RIE también generaría estados superficiales considerables que juegan un papel importante durante la formación del contacto [41]. La Figura 4 muestra las características de salida de CC asociadas a partir de las cuales se puede observar una corriente cuasi-lineal a un voltaje de drenaje bajo. En su trabajo posterior, como se demuestra en la Fig.5, las características de salida exhibieron una buena relación de linealidad entre la corriente y el voltaje de drenaje en el que se aplicaron la implantación de iones de Si y RIE a β-Ga 2 O 3 juntos y una resistividad de contacto específica extremadamente baja de 8.1 × 10 −6 Ω ∙ cm 2 se logró [12]. Obviamente, el comportamiento óhmico obtenido por RIE y Si + la implantación en conjunto superaría la de RIE solo porque se sabe que los átomos de Si son donantes superficiales con pequeñas energías de activación en β-Ga 2 O 3 [34]. Además, Zhou et al. informó el β-Ga 2 de alto rendimiento O 3 transistores de efecto de campo con bombardeo de plasma de Ar antes de la deposición de metal por contacto [52]. Por el contrario, la muestra sin bombardeo de Ar mostró contacto con Schottky. La diferencia se puede atribuir a la generación de vacantes de oxígeno y estados de superficie durante el proceso de bombardeo de plasma de Ar, al igual que el tratamiento RIE.
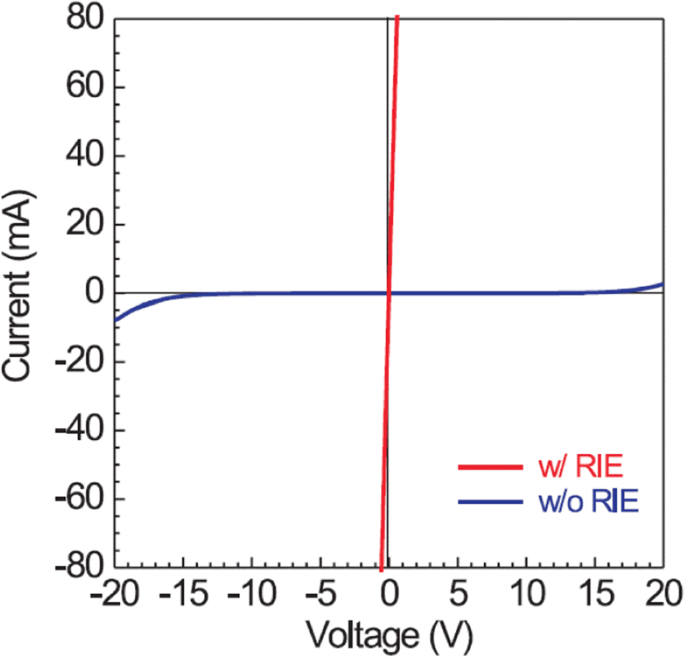
(Color en línea) Curvas I – V medidas entre dos contactos (Ti / Au depositado) fabricados con y sin tratamiento RIE en n-Ga 2 O 3 sustratos. Reproducido de Ref. [1]
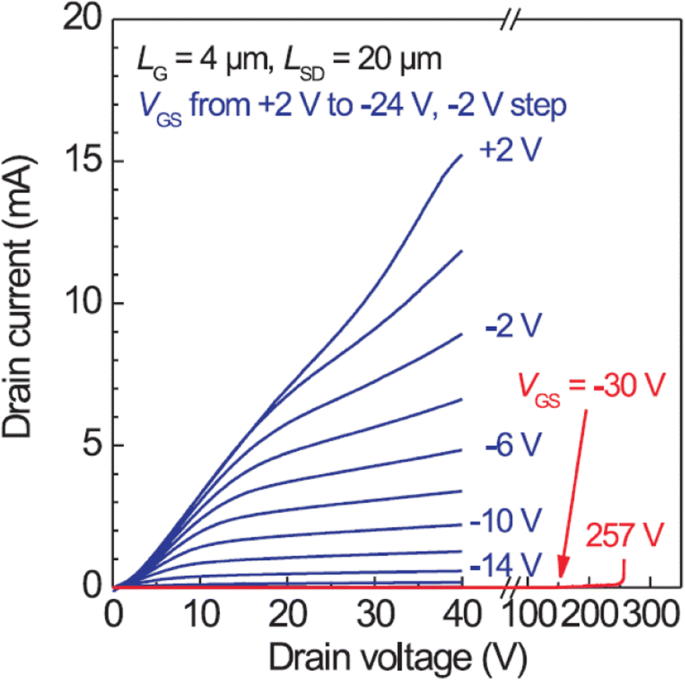
(Color en línea) Características de salida de CC de Ga 2 O 3 transistores de efecto de campo de metal / semiconductor. Reproducido de Ref. [1]
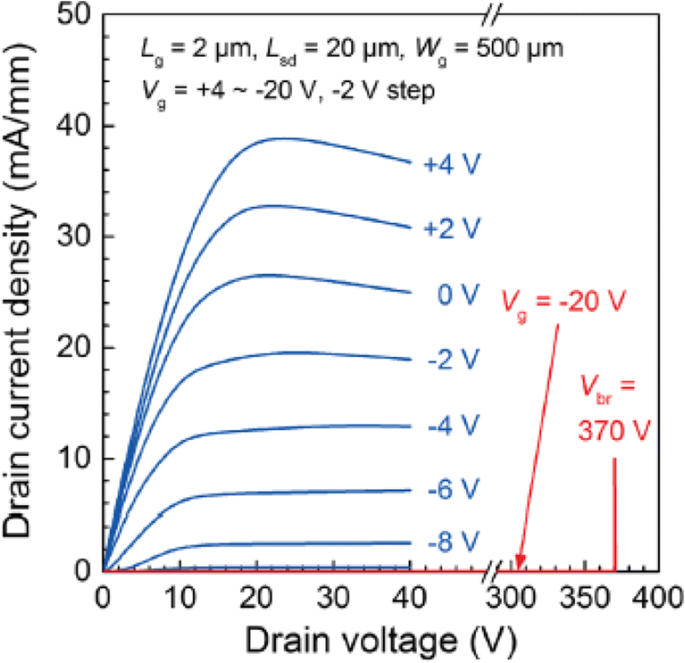
Curvas I – V CC de Ga 2 O 3 MOSFET ( L g =2 μm) medido a TA. Reproducido de Ref. [12]
Aunque las técnicas mencionadas anteriormente pueden mejorar el rendimiento de los contactos óhmicos, tales tecnologías no son prácticamente aplicables porque el daño inducido suele ser lo último que los ingenieros de procesos quieren en los dispositivos semiconductores y, además, los contactos óhmicos inducidos por el daño no siempre son reproducibles.
Por esta razón, además de las técnicas tradicionales antes mencionadas que se utilizan con frecuencia para formar contactos óhmicos de baja resistencia, recientemente se adoptó una técnica relativamente nueva, el dopaje giratorio sobre vidrio (SOG) [53], y una resistividad de contacto específica de 2,1 ± 1,4 × 10 −5 Ω ∙ cm 2 se logró, lo que verificó la efectividad de la técnica de dopaje SOG. La Figura 6 muestra las características de salida de β-Ga 2 dopado con SOG O 3 MOSFET que exhibieron un excelente comportamiento lineal a bajo voltaje de drenaje. En comparación con la implantación de iones, el dopaje SOG reduce la difusión de especies inducida por daños y reduce los costos al abandonar el costoso implantador de iones. De manera similar a las implantaciones de iones, el principio básico detrás de esta tecnología es el dopaje de la región S / D con donantes superficiales. Obviamente, el contacto óhmico superior se puede lograr con β-Ga 2 dopado intencionalmente O 3 . Por ejemplo, el β-Ga 2 altamente dopado O 3 se utilizó para fabricar β-Ga 2 O 3 transistores de efecto de campo con corrientes de drenaje superiores a 1,5 A / mm [50]. La alta corriente de drenaje récord se debe al fuerte dopaje en β-Ga 2 O 3 lo que causa una capa de agotamiento muy delgada, y los electrones pueden atravesar fácilmente esta barrera, lo que lleva a un comportamiento de contacto óhmico. Curiosamente, la orientación del β-Ga 2 O 3 La superficie también puede influir en el comportamiento de contacto. Baik y col. informó que los mismos electrodos en β-Ga 2 O 3 mostró diferentes propiedades de contacto, en las que la muestra en el sustrato (\ (\ overline {2} \) 01) se comportó como contactos óhmicos mientras que la muestra de control en (010) exhibió un comportamiento Schottky. Esto podría atribuirse a la diferente relación Ga / O y la densidad de los enlaces colgantes en orientaciones específicas [54].
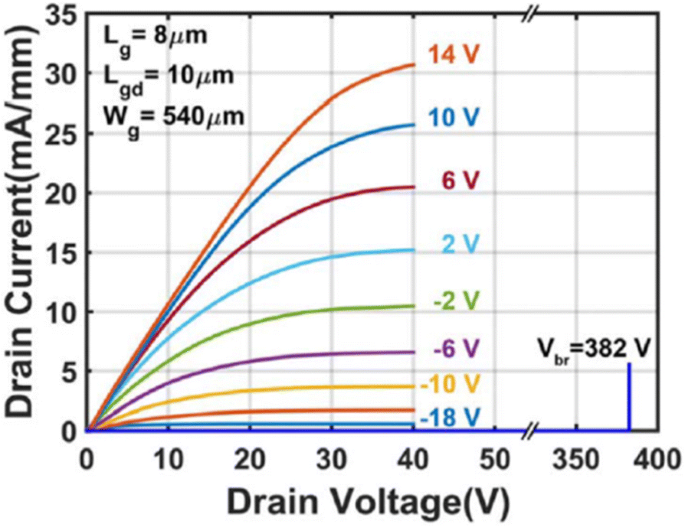
Características de salida del MOSFET dopado SOG S / D con L g =8 μm, espacio entre la compuerta de drenaje L gd =10 μm. Reproducido de Ref. [53]
Tratamiento posterior
El postratamiento se realiza después de la deposición del metal, refiriéndose principalmente al proceso de recocido. El recocido juega un papel en la reducción del daño inducido por tecnologías de procesos anteriores, como la implantación de iones y el bombardeo de plasma. Además, contribuye a la formación de una capa intermedia que puede reducir la discontinuidad de la banda de conducción entre el metal y el β-Ga 2 O 3 . Sorprendentemente, los parámetros que incluyen la temperatura, la atmósfera y el tiempo de recocido ejercen una influencia importante en el rendimiento de los dispositivos. El experimento sobre el recocido en aire y N 2 se implementó para comparar el efecto de la atmósfera de recocido en β-Ga 2 O 3 -contactos óhmicos de base [55]. Como se puede ver en la Fig.7, el rendimiento del recocido en N 2 superó al del aire, lo que podría atribuirse a que la mayor presión parcial de oxígeno en el aire suprimió la formación de vacantes de oxígeno. Sin embargo, no está clara la dependencia de las características de contacto de la temperatura, la atmósfera y el tiempo de recocido de las características de contacto; por lo tanto, es necesario optimizar los parámetros del proceso de recocido.
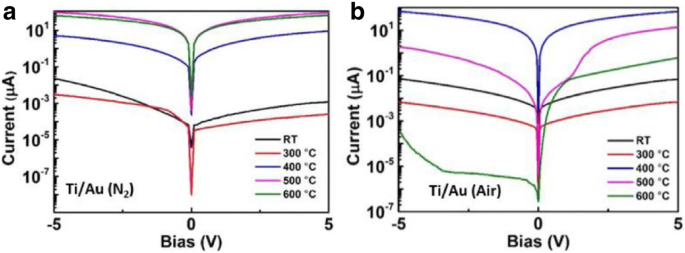
Propiedades eléctricas de β-Ga 2 O 3 escamas con diferente atmósfera de recocido térmico y temperatura de recocido. Contactos Ti / Au menores de a N 2 y b aire. Reproducido de Ref. [55]
Electrodo de metal multicapa
Otro enfoque para formar contactos óhmicos es reducir el SBH en la interfaz metal / semiconductor. El SBH es igual a la diferencia entre la función de trabajo del metal y la afinidad electrónica del semiconductor. Basado en este reconocimiento, uno podría esperar que los metales con baja función de trabajo formen contactos óhmicos en β-Ga 2 O 3 . Sin embargo, se ha demostrado que la función de trabajo no es el factor dominante en la formación del contacto óhmico [56].
Nueve metales depositados en β-Ga 2 O 3 se seleccionaron en función de propiedades como la función de trabajo, la temperatura de fusión y la estabilidad del óxido [57]. La función de trabajo del metal del Ti y la afinidad electrónica del β-Ga 2 dopado involuntariamente O 3 se sabe que son 4,33 eV y 4,00 ± 0,05 eV, respectivamente [19, 58, 59], por lo que debería existir una barrera de 0,22 eV en la interfaz que conduce al contacto Schottky. No obstante, resultó que los contactos de Ti con una capa de recubrimiento de Au eran óhmicos con la resistencia más baja entre nueve metales después del recocido. Mientras tanto, Bae et al. exploró la dependencia de las propiedades de contacto de Ti / Au y Ni / Au para dispositivos basados en el β-Ga 2 exfoliado O 3 copos [55]. Se observó que el rendimiento de los MOSFET con electrodos de metal de Ti / Au superó a los de los electrodos de metal de Ni / Au en las mismas condiciones de recocido. Al principio, se consideró que las funciones de trabajo de Ni y Ti son 5,01 eV y 4,33 eV, respectivamente, por lo que el Ti puede formar un contacto óhmico más fácilmente que el Ni; sin embargo, estudios a través de la espectroscopia dispersiva de energía (EDS) demostraron que el porcentaje atómico de oxígeno en el β-Ga 2 O 3 región disminuyó mientras que el porcentaje atómico de oxígeno en Ti cerca de la interfaz aumentó después del recocido, como se ilustra en la Fig. 8 [55]. Este fenómeno se atribuye a la difusión externa de átomos de oxígeno de β-Ga 2 O 3 en metal Ti, lo que lleva a la formación de vacantes de oxígeno que actúan como donantes. Además, durante el proceso de recocido, la difusión acelerada de átomos de oxígeno en β-Ga 2 O 3 podría reaccionar con Ti y formar Ti 2 O 3 que es útil para formar contactos óhmicos debido a su baja función de trabajo (3.6–3.9 eV). Por lo tanto, la reacción interfacial entre metales y β-Ga 2 O 3 es un factor importante en la formación de contactos óhmicos en la interfaz metal / semiconductor.
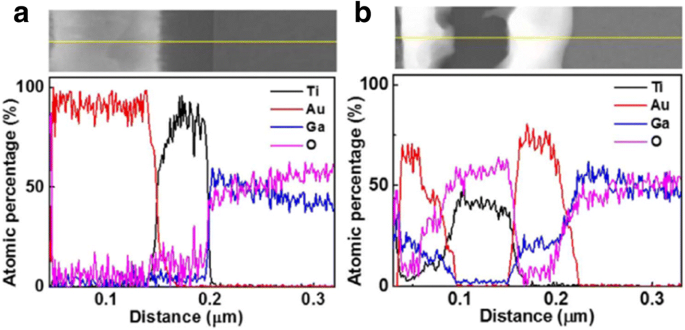
Perfiles de porcentaje atómico por EDS de metalización y β-Ga 2 O 3 un pre y b post-recocido a una temperatura de 500 ° C. Reproducido de Ref. [55]
Además, se encuentra que la mayoría de los electrodos de metal de Ti / Au utilizados para formar contactos óhmicos fueron recocidos a 450 ° C [45, 53] o 470 ° C [12, 46, 57, 60] por proceso térmico rápido. Se observó un comportamiento de degradación similar de las características de contacto cuando el recocido se realizó por encima de 500 ° C en Ref. [55, 56], como se ilustra en las Figs. 7 y 9, respectivamente. Yao y col. se especuló que se formó una capa de óxido aislante posiblemente a una temperatura de recocido elevada, lo que provocó el deterioro de los contactos. Sin embargo, Bae et al. observó que la superficie del metal depositado era mucho más rugosa después de 700 ° C recocido debido a la mezcla de metales y la difusión de átomos de galio y oxígeno en electrodos metálicos, que se atribuyó como la razón del comportamiento de degradación. Obviamente, los mecanismos de degradación de Ti / Au entran en contacto con β-Ga 2 O 3 después del recocido a alta temperatura todavía están en debate.
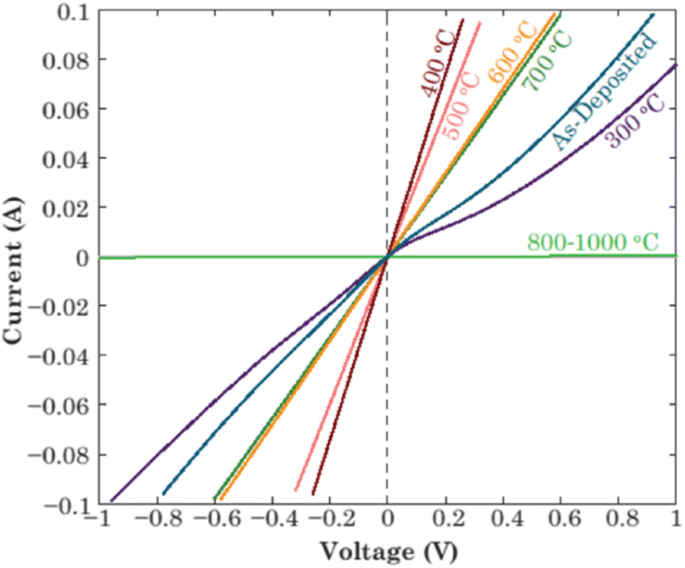
Gráficos I – V para contactos Ti / Au en Sn-dopado (\ (\ overline {2} \) 01) Ga 2 O 3 oblea en función de la temperatura de recocido en Ar (tiempo de recocido 1 min). Reproducido de Ref. [56]
β-Ga 2 O 3 Los dispositivos basados en Ti / Au no pueden satisfacer la demanda de trabajo a alta temperatura. Por tanto, para evitar la degradación de las características de contacto a temperaturas de recocido elevadas, deberían adoptarse pilas de metales más complejas. Con mucho, las pilas de metal Ti / Al / Au [50, 52], Ti / Au / Ni [61, 62] y Ti / Al / Ni / Au [13, 21, 63, 64] se han empleado para formar contactos en β-Ga 2 O 3 . Pero una comparación completa de las características de contacto entre estas pilas de metal sigue siendo insuficiente.
Mohammad [65] y Greco et al. [36] discutió el papel de cada capa de metal en las complejas pilas de metal, proporcionando algunas pautas para mejorar los contactos óhmicos. El esquema de las pilas de metal se muestra en la Fig. 10. Tenga en cuenta que este enfoque se está desarrollando actualmente para dispositivos de potencia basados en GaN [66,67,68,69].
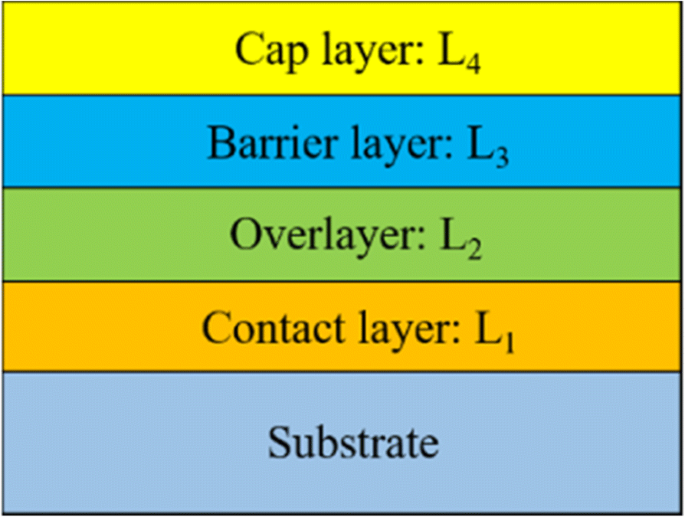
El esquema de pilas de metal para obtener contactos óhmicos para semiconductores de banda ancha
La primera capa de metal sobre el sustrato, denominada capa de contacto, debe tener una función de trabajo baja y una buena adherencia al sustrato. Además, también puede bloquear la difusión de metales de la capa superior con grandes funciones de trabajo en el sustrato. Actualmente, el Ti es el principal metal como capa de contacto con β-Ga 2 O 3 por su baja función (4,33 eV) y buena adherencia al sustrato. Además, la formación de Ti 2 O 3 y Ti 3 O 5 con funciones de trabajo menores que el Ti en la interfaz se ve favorecido en la formación de contactos óhmicos ya que los óxidos reducen el SBH y dejan vacantes de oxígeno que actúan como donantes. Sin embargo, todavía no se han explorado otros metales con funciones de trabajo bajas, incluidos Ta (3,1 eV) y Hf (3,9 eV). La segunda capa con una función de trabajo baja debería poder formar compuestos intermetálicos con la capa de contacto para evitar su difusión en la interfaz. Actualmente, se utiliza Al como capa superior, ya que puede cumplir con estos requisitos. La tercera capa de metal (capa de barrera) sirve para limitar la difusión interna de la capa metálica superior y la difusión externa de las capas metálicas inferiores [70, 71]. Ni es la capa de barrera más utilizada para β-Ga 2 O 3 . Hay otros buenos candidatos como Mo, Nb e Ir con altos puntos de fusión para sustituir al Ni, que se espera que tengan menor reactividad y solubilidad para el Au que el Ni [72,73,74,75]. La cuarta capa superior actúa como una capa protectora para prevenir o minimizar la oxidación de los metales subyacentes. En la práctica, Au se emplea comúnmente para cumplir este propósito.
Presentación de una capa intermedia
Existen principalmente dos métodos para introducir una capa intermedia en el metal / β-Ga 2 O 3 interfaz. Una es formar una capa semiconductora intermedia (ISL) con una función de trabajo baja por recocido, por ejemplo, Ti 2 O 3 . El otro es insertar el ISL depositado entre el metal y β-Ga 2 O 3 , que ha sido intensamente estudiado [76,77,78]. Comparado con el primer método, el último es más favorable para formar contactos óhmicos debido a la alta concentración de portadores de ISL. Los intervalos de banda de los ISL oscilan entre 3,5 y 4,0 eV [79,80,81], como AZO (~ 3,2 eV) [82], In 2 O 3 (~ 2,9 eV) [83, 84] e IGZO (~ 3,5 eV) [85]. Normalmente, los SBH de varios metales depositados en β-Ga 2 O 3 están en el rango de 0,95 a 1,47 eV [86, 87], como se muestra en la figura 11a. No obstante, la incorporación de un ISL delgado reduce el SBH, lo que facilita el transporte de electrones desde el metal a la banda de conducción de β-Ga 2 O 3 , como se ilustra en la Fig. 11b. Además, la alta densidad de electrones en ISL podría reducir aún más la resistencia de contacto.
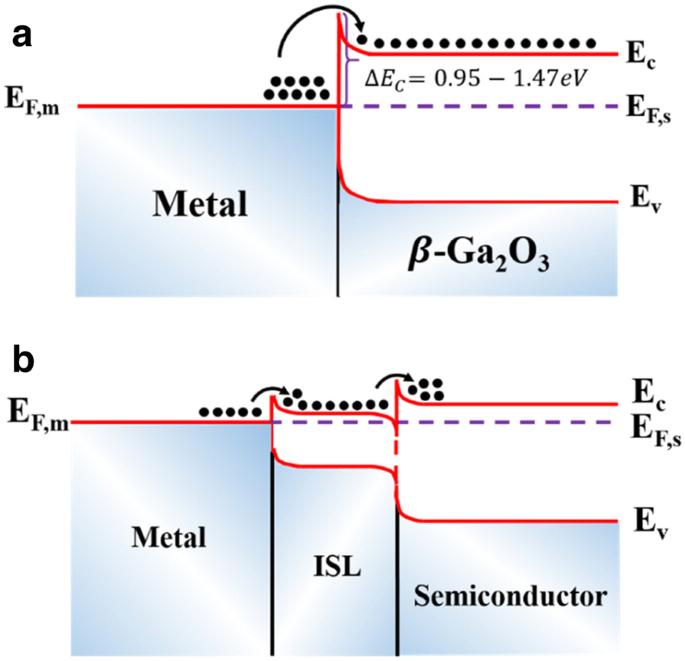
El esquema de las compensaciones de banda para a metal / β-Ga 2 O 3 y b metal / ISL / β-Ga 2 O 3 . ∆E c es igual a la diferencia de energía entre la energía de Fermi de los metales y la banda de conducción de los semiconductores
Últimamente, se utilizó AZO / Ti / Au como electrodos en Si + β-Ga 2 implantado O 3 , y la resistividad de contacto específica obtenida fue 2,82 × 10 −5 Ω ∙ cm 2 después del recocido [76]. Oshima y col. logró contactos óhmicos de platino / indio-óxido de estaño (Pt / ITO) a β-Ga 2 O 3 con una amplia gama de ventana de temperatura de proceso [77]. La gran ventana de proceso de 900-1150 ° C permite la realización de un funcionamiento a alta temperatura. Y electrodos ITO / Ti / Au para β-Ga 2 O 3 también fueron demostrados por Carey et al. [78] en el que la muestra mostró un comportamiento óhmico con ρ C de 6,3 × 10 - 5 Ω ∙ cm 2 después del recocido. Sin el ITO, el mismo recocido no proporcionó características de corriente-voltaje lineales. Estos resultados verifican la efectividad de agregar ISL para obtener contactos óhmicos.
En particular, se observó una burbuja en la superficie de los contactos de ITO / Ti / Au mientras que no había burbujas en la única capa de ITO sin la capa de metal por encima [78]. Se consideró como el resultado de la difusión de átomos de oxígeno en la capa de ITO hacia las capas superiores de metal. Por lo tanto, es necesario elegir pilas de metal o metal adecuadas como capas de cobertura en ITO para evitar la degradación de la morfología de la superficie.
Conclusiones
En este trabajo, hemos resumido el progreso significativo en I + D de β-Ga 2 O 3 MOSFET. Sin embargo, los contactos en β-Ga 2 O 3 son uno de los problemas clave que limitan su aplicación potencial como dispositivos de alta frecuencia y alto voltaje en el futuro. Aunque esta revisión proporciona una descripción general de los métodos más avanzados para formar contactos óhmicos, todavía queda mucho espacio por explorar, y un conjunto de perspectivas concisas se pueden digerir de la siguiente manera:(i) La dependencia de la temperatura y el mecanismo de degradación de las características de contacto necesita más investigaciones para una aclaración clara; (ii) Los metales con baja función de trabajo como Ta y Hf y los metales con alto punto de fusión como Mo, Nb e Ir son dignos de cribado para servir como capa de contacto y capa de barrera, respectivamente; (iii) Las pilas de metal óptimas en β-Ga 2 O 3 aún no se han realizado por completo, y un estudio exhaustivo y sistemático de las pilas de metal para β-Ga 2 O 3 es imperativo para lograr contactos óhmicos térmicamente estables y de baja resistencia; y (iv) Quedan sin explotar otros ISL potenciales que consisten en ZnO, IZO, IGZO, etc., así como la influencia de los diferentes espesores y proporciones de los ingredientes de los ISL en el rendimiento de los contactos. En resumen, los estudios sobre contactos óhmicos con β-Ga 2 O 3 son todavía bastante superficiales; Creemos que este tema seguirá siendo uno de los temas centrales en el futuro. Con suerte, los enfoques para formar contactos óhmicos presentados en esta revisión serían fundamentales para lograr un β-Ga 2 de alto rendimiento O 3 dispositivos.
Nanomateriales
- Contactos de tungsteno para electrodomésticos
- Cambiar diseño de contacto
- Funciones de lógica digital
- Los fabricantes impulsan nuevos avances en flash NAND 3D
- Supervisión de los avances de los dispositivos médicos
- Los artículos recientes detallan la escalabilidad de nanotubos de carbono, avances en la integración
- Los 10 principales avances en tecnología de fabricación de materiales compuestos
- Avances y desafíos de los nanomateriales fluorescentes para síntesis y aplicaciones biomédicas
- Transistores de efecto de campo de nanoflake SnSe multicapa con contactos au óhmicos de baja resistencia
- 5 grandes lecturas recientes en convergencia de TI/TO
- 5 grandes lecturas recientes en IIoT



