Diodos emisores de luz ultravioleta basados en AlGaN casi sin caída de eficiencia con una capa de bloqueo de electrones tipo p de superrejilla diseñada específicamente para una alta eficiencia de dopaje de Mg
Resumen
Este trabajo informa un diodo emisor de luz ultravioleta profunda (LED DUV) basado en AlGaN casi sin caída de eficiencia que emite en la longitud de onda máxima de 270 nm. El LED DUV utiliza una capa de bloqueo de electrones tipo p de superrejilla diseñada específicamente (p-EBL). La superrejilla p-EBL permite una alta concentración de orificios en la p-EBL que, en consecuencia, aumenta la eficiencia de inyección de orificios en los pozos cuánticos múltiples (MQW). La concentración de huecos mejorada dentro de la región MQW puede recombinarse de manera más eficiente con electrones en la forma de favorecer la recombinación radiativa, lo que conduce a un nivel de corriente de fuga de electrones reducido. Como resultado, la eficiencia cuántica externa para la estructura LED DUV propuesta se incrementa en un 100% y la estructura LED DUV casi libre de caída de eficiencia se obtiene experimentalmente.
Antecedentes
Los rayos ultravioleta en el régimen de longitud de onda de 200 nm ~ 280 nm han encontrado aplicaciones potenciales en sistemas de purificación de agua [1, 2]. Teniendo en cuenta el bajo voltaje de alimentación de CC y la mayor compatibilidad con el sistema de purificación de agua, los diodos emisores de luz ultravioleta profunda (LED DUV) basados en AlGaN se seleccionan como el candidato excelente. Cabe mencionar que tratar el agua con un gran volumen requiere que el sistema de purificación proporcione la fuente de luz UVC de alta potencia. Sin embargo, la eficiencia cuántica externa (EQE) de los LED DUV basados en AlGaN con una longitud de onda de emisión inferior a 280 nm no se cumple en este momento [3]. El principal factor limitante para la EQE deficiente surge en parte de la gran densidad de dislocación de subprocesos (TDD) en los pozos cuánticos ricos en Al [2, 3]. La eficiencia cuántica interna (IQE) disminuye rápidamente una vez que el TDD es del orden de 10 9 cm −2 [3]. Incluso si el TDD se reduce al orden de 10 8 cm −2 que puede habilitar el IQE de 60 ~ 80%, el efecto de la caída de eficiencia puede hacer que el EQE sea inferior al 5% para los LED UVC desnudos cuando la densidad de corriente de inyección excede 80 A / cm 2 [4]. Tenga en cuenta que la eficiencia de extracción de luz (LEE) para chips LED UVC desnudos es ~ 10% según los cálculos de FDTD [5]. Una de las principales interpretaciones de la caída de eficiencia de los LED basados en nitruro III es el derrame de electrones en la capa de inyección de orificios de tipo p [6]. La capa de inyección de orificios de tipo p de AlGaN rica en Al posee una concentración de orificios libres incluso inferior a 1 × 10 17 cm −3 [7], que tiende a provocar un nivel de fuga de electrones más grave. Mehnke y col. han medido la emisión parásita que tiene lugar en la capa de inyección del agujero tipo p y la emisión parásita se atribuye bien a la fuga de electrones [8]. Para reducir el escape de electrones de los pozos cuánticos múltiples (MQW), se puede aumentar la tasa de captura de electrones insertando capas de picos individuales en las barreras cuánticas [9]. Las capas de picos poseen una composición de Al más alta que la barrera cuántica, por lo que el campo eléctrico inducido por polarización en las capas de picos puede reducir la velocidad de deriva de los electrones. Por lo tanto, la eficiencia de captura mejorada solo se habilita si el LED DUV crece a lo largo de la orientación [0001]. Otro método eficaz para mejorar la tasa de captura de electrones es aumentar el desplazamiento de la banda de conducción entre la barrera cuántica y el pozo cuántico, lo que se puede lograr aumentando adecuadamente la composición de Al [10], mientras que la arquitectura de la barrera cuántica puede evolucionar aún más al tener la composición de Al calificada [11]. Como se ha mencionado anteriormente, la concentración de orificios libres para la capa de inyección de orificios de AlGaN de tipo p rica en Al es baja, lo que conduce a una capacidad deficiente de inyección de orificios en la región MQW. La mala inyección del orificio también se considera la causa de la fuga de electrones [12]. Un método prometedor para aumentar la emisión termoiónica de los huecos a través de la capa de bloqueo de electrones de tipo p (p-EBL) es energizar los huecos adoptando el depósito de campo eléctrico [13]. El transporte de agujeros también puede verse favorecido si la capa de inyección de agujeros basada en p-AlGaN con la composición de Al en forma de escalera se utiliza para LED DUV [14]. La composición de Al escalonada puede ser reemplazada por la composición de Al graduada para la capa de AlGaN para mejorar la concentración del agujero [15,16,17]. Además de diseñar la capa de inyección del orificio, también se han sugerido p-EBL alternativos para reducir el efecto de bloqueo del orificio, por ejemplo, insertando una capa delgada de AlGaN con una composición de Al más baja [18]. Una estructura muy importante para el candidato p-EBL es la superrejilla p-EBL. Se han realizado enormes esfuerzos de investigación para explorar el impacto de la superrejilla GaN / AlGaN para los LED azules basados en GaN [19,20,21]. Sin embargo, el AlGaN p-EBL para LED azules tiene una composición de AlN inferior al 20%, lo que hace que el efecto de bloqueo de orificios para los LED azules no sea tan severo como el de los LED DUV. Por lo tanto, la mejora de EQE es menor al 20% y la caída de eficiencia sigue siendo obvia incluso si se adopta el superlattice p-EBL de GaN / AlGaN para los LED azules. Los LED DUV emplean p-EBL ricos en Al, lo que da lugar a un problema de inyección de orificios aún más desafiante [1]. Para resolver el efecto de bloqueo de huecos causado por p-EBL rico en Al, también se sugiere p-EBL de superrejilla para LED DUV, por ejemplo, p-EBL de superrejilla de AlInGaN / AlGaN [22] y p-EBL de superrejilla de AlGaN / AlGaN [23]. Sin embargo, la prueba experimental de la superlattice p-EBL que ayuda a obtener un EQE alto y casi sin caída de eficiencia carece de LED DUV en esta etapa. Por lo tanto, este trabajo demuestra experimentalmente la efectividad de un p-EBL de superrejilla AlGaN / AlGaN específicamente diseñado para mejorar el EQE y suprimir significativamente la caída de eficiencia de los LED DUV. El EQE mejorado se atribuye bien a la inyección mejorada del orificio en la región MQW, mientras que el nivel reducido de fuga de electrones ayuda a suprimir notablemente la caída de eficiencia. El mecanismo detallado se presentará en este trabajo posteriormente.
Métodos / Experimental
Las dos arquitecturas LED DUV (LED A y B como se muestra en la Fig. 1) en este trabajo se cultivan en la plantilla de AlN mediante un sistema de deposición de vapor químico metal-orgánico (MOCVD). La plantilla de AlN de 4 µm de espesor se hace crecer sobre el sustrato de zafiro orientado a [0001] utilizando el método de epitaxia en fase de vapor de hidruro (HVPE). Crecemos AlN / Al de 20 periodos 0.50 Ga 0.50 N superrejilla en la plantilla de AlN, que sirve como capa de alivio de tensión para la capa de epi que creció posteriormente. Un n-Al 0.60 de 2 μm de espesor Ga 0.40 N capa que tiene una concentración de electrones de 1 x 10 18 cm −3 se cultiva para proporcionar electrones. Los fotones DUV son generados por cinco períodos Al 0.45 Ga 0,55 N / Al 0.56 Ga 0,44 N MQW que tienen Al 0.45 de 3 nm de espesor Ga 0,55 N pozos cuánticos y Al 0.56 de 12 nm de espesor Ga 0,44 N barreras cuánticas. Los MQW se cubren luego con una p-EBL basada en AlGaN de 10 nm de espesor. En nuestro experimento, diseñamos y cultivamos dos tipos de p-EBL para LED A y B, respectivamente. El LED A posee un Al 0.60 Ga 0.40 El p-EBL y el LED B basados en N tienen un Al 0.45 de 1 nm de cinco períodos Ga 0,55 N / 1-nm Al 0.60 Ga 0.40 P-EBL basado en N. Tenga en cuenta que nuestro bucle superlattice p-EBL comienza desde el Al 0.45 Ga 0,55 N capa fina después de cultivar el último Al 0.56 Ga 0,44 N barrera cuántica. Al hacerlo, la interfaz de la última barrera cuántica / superrejilla p-EBL se polariza produciendo cargas laminares inducidas por polarización negativa, lo que ayuda a agotar la acumulación de electrones en la última barrera cuántica y suprime aún más la fuga de electrones. Luego, el p-EBL es seguido por un p-Al 0.40 de 50 nm Ga 0.60 Proveedor de orificios de N / 50 nm p-GaN. Por último, la capa de p-GaN está recubierta con un p + de 10 nm de espesor fuertemente dopado con Mg -Capa de GaN. Las obleas LED DUV se recocen térmicamente in situ a una temperatura de 800 ° C en N 2 ambiente durante 15 min para dividir los enlaces H-Mg. A continuación, se estima aproximadamente que la concentración del agujero es 1 × 10 17 cm −3 y 3 × 10 17 cm −3 para la capa p-AlGaN rica en Al y la capa p-GaN, respectivamente.
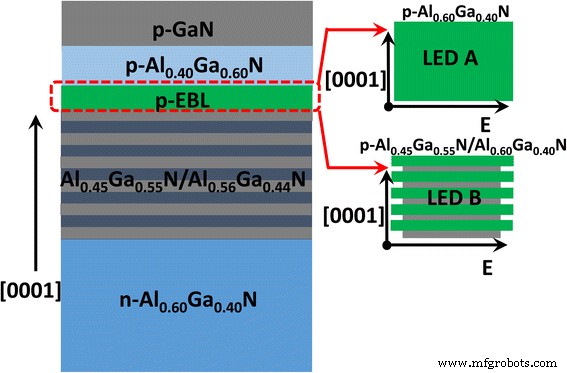
Estructuras arquitectónicas esquemáticas para los LED estudiados. También se proporcionan los diagramas de bandas de energía bosquejados para los dos p-EBL:el LED A tiene el p-Al 0.60 Ga 0.40 EBL y LED B basados en N tienen el p-Al 0.45 Ga 0,55 N / Al 0.60 Ga 0.40 N superrejilla EBL. El p-Al 0.45 Ga 0,55 N / Al 0.60 Ga 0.40 N superlattice EBL está específicamente diseñado de tal manera que inicia el p-Al delgado 0.45 Ga 0,55 N capa para que la interfaz para el p-Al 0.45 Ga 0,55 N / Al 0.56 Ga 0,44 La última barrera cuántica posee cargas de interfaz de polarización negativa. E significa nivel de energía.
Las obleas LED DUV se fabrican en chips LED DUV siguiendo un proceso de microfabricación estándar. La mesa se obtiene mediante grabado con plasma de acoplamiento inductivo (ICP) y el tamaño de la mesa es de 650 × 320 μm 2 . Se deposita una pila de metal de Ti / Al en el n-Al 0.60 Ga 0.40 N capa, que luego se templa en N 2 durante 1 min a la temperatura de 900 ° C. Se recubre una corriente de Ni / Au que se extiende sobre la superficie de la mesa y luego se recoce en O 2 durante 5 min a una temperatura de 550 ° C. Por último, depositamos metales Ti / Al / Ni / Au simultáneamente sobre la aleación de Ti / Al y la capa de difusión de corriente de Ni / Au que actúa como electrodo n y electrodo p reflectante, respectivamente. Los chips LED DUV son dispositivos flip-chip y los fotones DUV se recogen del lado del zafiro mediante una esfera integradora.
Para revelar mejor el origen en profundidad del EQE mejorado y la caída de eficiencia suprimida, los cálculos numéricos se realizan utilizando el paquete APSYS [13, 18]. Los parámetros físicos importantes que se utilizan para calcular los eventos de recombinación de portadora y la pérdida de portadora incluyen la vida útil de la recombinación Shockley-Read-Hall (SRH), el coeficiente de recombinación de Auger, la relación de compensación de banda de energía para las interfaces AlGaN / AlGaN y el nivel de polarización para [0001 ] -orientadas III-nitruro estructuras, que se establecen en 10 ns, 1 × 10 −30 cm 6 s −1 , 50:50 y 40%, respectivamente [13, 18]. El LEE se establece en 10% para chips LED DUV desnudos con una capa de p-GaN absorbente de 50 nm de espesor [5].
Resultados y discusiones
Los espectros de electroluminiscencia (EL) medidos experimentalmente a un nivel de densidad de corriente diferente para los LED A y B se presentan en la Fig. 2a. Los espectros EL se recogen en estado pulsado con un ciclo de trabajo del 0,1% para evitar el efecto de autocalentamiento. La Figura 2a muestra que la longitud de onda de emisión máxima para ambos dispositivos LED DUV es ~ 270 nm. La longitud de onda de emisión máxima es estable dentro del rango de corriente probado debido a la eliminación del efecto de autocalentamiento. La intensidad EL para el LED B es más fuerte que la del LED A. La figura 2b demuestra la potencia óptica y el EQE como función de la densidad de corriente de inyección, lo que ilustra que el EQE se mejora en ~ 90%. Además, los niveles de caída de eficiencia son ~ 24 y ~ 4% para los LED A y B al nivel de densidad de corriente de 110 A / cm 2 , respectivamente [droop =( EQE máx - EQE J ) / EQE máx , en el que EQE máx y EQE J denotar el EQE máximo y el EQE a la densidad de corriente de J ]. La Figura 2c presenta la densidad de potencia óptica calculada numéricamente y el EQE en términos de densidad de corriente de inyección. Los resultados calculados numéricamente y los medidos experimentalmente concuerdan bien entre sí, de modo que el LED B muestra el EQE mejorado y un nivel de caída de eficiencia sustancialmente reducido. La concordancia entre la Fig. 2b y 2c valida bien los modelos físicos y los parámetros que establecimos para los cálculos.
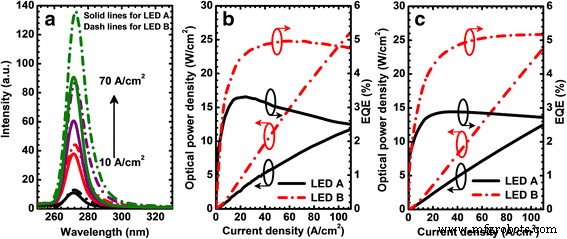
un Espectros EL medidos a la densidad de corriente de 10, 30, 50 y 70 A / cm 2 . b Potencia óptica medida y EQE. c Potencia óptica calculada y EQE para LED A y B, respectivamente
Los dos LED DUV se diferencian entre sí solo en el p-EBL. Por lo tanto, es necesario investigar el papel de la superrejilla p-EBL en la mejora del rendimiento óptico del LED B. La figura 3a presenta los perfiles de concentración de orificios en la región MQW para los LED A y B a la densidad de corriente de 50 A / cm 2 . Se muestra que el nivel de concentración de huecos dentro de los MQW para el LED B es más alto que el del LED A. Como se ha informado, el p-EBL reduce el nivel de fuga de electrones al mismo tiempo que dificulta la inyección del hueco [24]. Un enfoque útil para reducir el efecto de bloqueo de orificios es aumentar la concentración de orificios dentro de la región p-EBL, lo que luego ayuda a disminuir la altura de la barrera de la banda de valencia [25]. La Figura 3b muestra los niveles de concentración de huecos en las p-EBL y en p-Al 0.40 Ga 0.60 N capas para LED A y B con una densidad de corriente de 50 A / cm 2 . La concentración de orificios promedio en la superrejilla p-EBL para el LED B es mucho más alta que la del LED A en dos órdenes de magnitud. La mayor concentración de pozos en la superrejilla p-EBL se atribuye bien al excelente transporte de pozos. Curiosamente, si miramos más en la Fig. 3b, encontramos que la concentración de huecos en el p-EBL / p-Al 0.40 Ga 0.60 La interfaz N se vuelve más baja para el LED A, lo que también refleja la eficiencia de inyección del orificio más suave a través de la superrejilla p-EBL para el LED B.

Perfiles de concentración de agujeros calculados numéricamente a en los MQW y b en las capas de inyección de orificios de tipo p para los LED A y B, respectivamente; c espectros EL medidos experimentalmente en escala semilogarítmica a la densidad de corriente de 10, 30, 50 y 70 A / cm 2 para los LED A y B, respectivamente; d Niveles de concentración de electrones calculados numéricamente en las capas de inyección de orificios de tipo p para los LED A y B. Los datos calculados numéricamente se recopilan a la densidad de corriente de 50 A / cm 2
Como se mencionó anteriormente, la eficiencia de los LED está estrechamente asociada con el nivel de fuga de electrones. Por lo tanto, mostramos los espectros EL medidos para los LED A y B en una escala semilogarítmica (ver Fig. 3c) para indicar la información detallada sobre la luminiscencia parásita. La longitud de onda de emisión máxima para la luminiscencia parásita se centra en ~ 425 nm, que puede surgir de los niveles profundos asociados con los dopantes de Mg [26]. La intensidad de la luminiscencia parásita del LED B es más fuerte que la del LED A, y se especula que más portadores se recombinan en los niveles profundos. En nuestro experimento, las capas de inyección de orificios de tipo p para ambas arquitecturas LED DUV no están diseñadas, y el nivel de concentración de orificios en las capas de inyección de orificios será similar. Por lo tanto, se identifica que los electrones que escapan de la región MQW poseen una mayor concentración en la capa de inyección del agujero para el LED B que los del LED A. Nuestras sugerencias están respaldadas por la Fig. 3d que muestra los perfiles de concentración de electrones en el p- capas de inyección de orificios de tipo para LED A y B con una densidad de corriente de 50 A / cm 2 . Esto también significa que la corriente de fuga de electrones se ha reducido significativamente gracias a la superrejilla p-EBL para LED B.
A continuación, presentamos los perfiles calculados de la tasa de recombinación radiativa para los LED A y B en la Fig. 4 que se recopilan al nivel de densidad de corriente de 50 A / cm 2 . Se infiere que la tasa de recombinación radiativa para el LED B es más fuerte que la del LED A gracias a la superrejilla propuesta p-EBL, que favorece aún más la inyección de huecos en la región MQW y, mientras tanto, suprime el nivel de fuga de electrones.
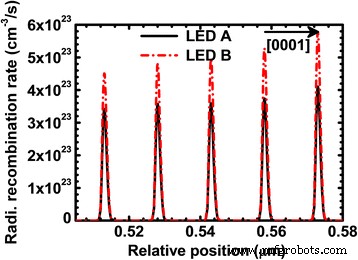
Perfiles calculados numéricamente de la tasa de recombinación radiativa para los LED A y B. Los datos se recopilan al nivel de densidad de corriente de 50 A / cm 2
Las figuras 5a y 5b muestran la banda de energía en las proximidades de las p-EBL para ambos dispositivos LED DUV. Las bandas de energía se calculan a la densidad de corriente de 50 A / cm 2 . Como han informado Zhang et al. [27], la fuerte polarización inducida por cargas positivas en la última interfaz barrera cuántica / p-EBL puede atraer electrones significativamente, dando lugar a una alta concentración local de electrones. La alta concentración de electrones locales puede reducir la altura de la barrera de la banda de conducción efectiva ( Ø e ) para el p-EBL que es ~ 295 meV para el LED A. Si el p-EBL basado en AlGaN a granel se reemplaza por el p-EBL de superrejilla específica en este trabajo (es decir, el bucle p-EBL de superrejilla comienza desde la capa delgada de AlGaN con una brecha de banda de energía menor que la última barrera cuántica de AlGaN), la banda de conducción para la última barrera cuántica se titula hacia arriba (ver Fig.5b), y esto favorece un agotamiento de electrones en la última barrera cuántica que luego aumenta el Ø e a ~ 391 meV y permite un escape de electrones más pequeño mediante emisión termoiónica [28]. Además, la superrejilla p-EBL facilita el proceso de tunelización dentro de la banda para los orificios, como resultado de lo cual la concentración de orificios en el p-EBL también aumenta (ver Fig.3b) La concentración de orificios mejorada en el p-EBL para los LED tiende a reducir la altura efectiva de la barrera de la banda de valencia ( Ø h ) [25], es decir, los valores de Ø h son ~ 324 meV y ~ 281 meV para los LED A y B, respectivamente a la densidad de corriente de 50 A / cm 2 . El Ø aún más pequeño h para LED B favorece a su vez la emisión termoiónica por huecos. Vale la pena señalar que la superrejilla p-EBL también puede causar el efecto túnel dentro de la banda para los electrones. Afortunadamente, la concentración mejorada de huecos en el MQW puede consumir mejor los electrones por recombinación radiativa, lo que también contribuye a aliviar la fuga de electrones [12]. Debido a la inyección de orificios más favorecida y la corriente de recombinación aún más fuerte que se produce por el proceso de recombinación radiativa que tiene lugar en la región MQW, el voltaje directo se vuelve más pequeño para el LED B que para el LED A según la Fig.5c.
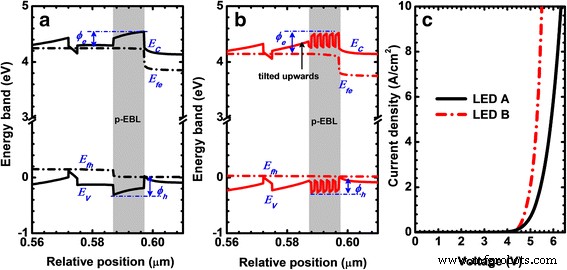
Perfiles de bandas de energía calculados numéricamente en las proximidades de a p-EBL a granel basado en AlGaN para LED A, b superlattice p-EBL para LED B y c densidad de corriente medida en términos de la polarización aplicada para los LED A y B. Datos para a y b se calculan a la densidad de corriente de 50 A / cm 2 . E C , E V , Ø e y Ø h denotar la banda de conducción, la banda de valencia y las alturas de barrera efectivas para la banda de conducción y la banda de valencia, respectivamente
Conclusiones
Para resumir, este trabajo ha reportado una superrejilla p-EBL específica para LED DUV, que puede mantener tanto la eficiencia de inyección de orificios promovida como la disminución de la fuga de electrones en la capa de inyección de orificios de tipo p pasiva. Por lo tanto, tanto numérica como experimentalmente, se obtienen la EQE mejorada y la caída de eficiencia notablemente suprimida. Creemos firmemente que la estructura LED DUV propuesta es muy prometedora para la realización de LED DUV de alta eficiencia y la física del dispositivo revelada por este trabajo introduce una mayor comprensión a la comunidad optoelectrónica basada en el nitruro III.
Abreviaturas
- APSYS:
-
Modelos físicos avanzados de dispositivos semiconductores
- DUV:
-
Diodos emisores de luz ultravioleta profunda
- EL:
-
Electroluminiscencia
- EQE:
-
Eficiencia cuántica externa
- HVPE:
-
Epitaxia en fase de vapor de hidruro
- ICP:
-
Plasma acoplado inductivamente
- IQE:
-
Eficiencia cuántica interna
- LEE:
-
Eficiencia de extracción de luz
- MOCVD:
-
Deposición de vapor químico metalorgánico
- MQW:
-
Múltiples pozos cuánticos
- p-EBL:
-
capa de bloqueo de electrones tipo p
- TDD:
-
densidad de dislocación de subprocesos
Nanomateriales
- El diseño de la capa de emisión para multiplicadores de electrones
- PEDOT altamente conductivo:Capa transportadora de orificios transparentes PSS con tratamiento solvente para células solares híbridas orgánicas / de silicio de alto rendimiento
- Síntesis ecológica de puntos cuánticos de núcleo / carcasa de InP / ZnS para su aplicación en diodos emisores de luz sin metales pesados
- Células solares de perovskita invertida altamente eficientes con capa de transporte de electrones CdSe QD / LiF
- Compuesto de nano fibras de TPU conductor de electricidad con alta capacidad de estiramiento para sensor de deformación flexible
- Diodos emisores de luz de perovskita de alta luminancia con disolvente de alcohol de alta polaridad que trata PEDOT:PSS como capa de transporte de huecos
- Tratamiento UV de capas de transporte de electrones de SnO2 procesado a baja temperatura para células solares planas de perovskita
- En la capa de difusión de corriente p-AlGaN / n-AlGaN / p-AlGaN para diodos emisores de luz ultravioleta profunda basados en AlGaN
- Sistema teórico de nanogeneradores triboeléctricos en modo de contacto para una alta eficiencia de conversión de energía
- Influencia del ancho del pozo cuántico en las propiedades de electroluminiscencia de los diodos emisores de luz ultravioleta profunda AlGaN a diferentes temperaturas
- Nanomembranas de TiO2 fabricadas por deposición de capa atómica para electrodo de supercondensador con capacitancia mejorada



