Desplazamiento de la estructura de GaN entre la red de nanowall, la nanocolumna y la película compacta cultivada en Si (111) por MBE
Resumen
El cambio de estructura de la red de nanopartículas de GaN, la nanocolumna y la película compacta se obtuvieron con éxito en Si (111) mediante epitaxia de haz molecular asistida por plasma (MBE). Como se esperaba, el crecimiento de las nanocolumnas de GaN se observó en condiciones ricas en N sobre Si desnudo, y el crecimiento se desplazó a una película compacta cuando se mejoró el flujo de Ga. Curiosamente, si se llevó a cabo una pre-deposición de aluminio (Al) durante 40 s antes del crecimiento de GaN, GaN crece en forma de red de nanopared. Los resultados muestran que el Al depositado previamente sale en forma de gotitas con un diámetro y una altura típicos de ~ 80 y ~ 6,7 nm, respectivamente. Se propone un modelo de crecimiento para la red de nano paredes y se discute el mecanismo de crecimiento. GaN crece en el área sin gotas de Al mientras que el crecimiento por encima de las gotas de Al se ve obstaculizado, lo que da como resultado la formación de una red continua de nanopared de GaN que elimina los obstáculos de la fabricación de nanodispositivos.
Antecedentes
Como semiconductores de banda ancha directa, GaN y compuestos relacionados han logrado un gran éxito en diodos emisores de luz [1, 2, 3], diodos láser [4] y transistores de alta movilidad de electrones [5, 6]. Sin embargo, la heteroepitaxia de la película de GaN sobre zafiro, carburo de silicio o silicio monocristalino induce una alta densidad de dislocación. Se cree que sus nanoestructuras tienen un rendimiento superior debido a la relación superficie-volumen libre de dislocaciones, libre de deformaciones y grande [7, 8]. Se han llevado a cabo de forma intensiva investigaciones sobre las nanocolumnas y nanocables de GaN [9,10,11,12]. La nucleación nanocolumnar de GaN ocurre espontáneamente por el mecanismo de crecimiento de Volmer-Weber [13], mientras que la condición rica en nitrógeno (rica en N) evita que los sitios de nucleación se fusionen. Se ha prestado mucha atención a la fabricación de un dispositivo eléctrico en los nanocables de GaN o en las nanocolumnas. Los nanocables de GaN se dispersaron mecánicamente en SiO 2 / Sustrato de Si y contactos óhmicos formados en dos lados de un nanoalambre individual al azar [14]. En otro caso [15], un lado del nanoalambre se fijó a una platina conectada al electrodo negativo mientras que el otro lado se alineó al electrodo positivo por medio de un microscopio electrónico de barrido (SEM), formando un dispositivo eléctrico para la investigación científica.
Alternativamente, una nanoestructura especial, a saber, la red de nanopared de GaN, que es conductora de electricidad en el plano, es prometedora, ya que no se necesita un proceso complejo para la fabricación de nanodispositivos. En 2007, el grupo de Kishino obtuvo el crecimiento de la red de nanowall de GaN utilizando una capa de Ti modelada por litografía por haz de electrones como máscara [16]. Hace varios años, el crecimiento de la red de nanopared de GaN sin ninguna litografía se obtuvo con éxito en sustratos de zafiro y silicio [17, 18, 19]. La intensidad de emisión del borde de la banda de la red de nanopared de GaN es similar a la de las nanocolumnas de GaN y la luminiscencia amarilla no es obvia, lo que indica una alta calidad de la red de nanopared de GaN. A diferencia de la nanoestructura separada, como las nanocolumnas, la red de nanopared es eléctricamente conductora en el plano [18, 20, 21], por lo que podría fabricarse en nanodispositivo tan fácilmente como la película [22]. Por lo tanto, el obstáculo de la fabricación de dispositivos en las nanocolumnas separadas podría eliminarse mediante la conducción eléctrica en el plano de la red de nanopared. Es fundamental estudiar el mecanismo de crecimiento de la red de nano paredes. La formación espontánea inducida por la dislocación de la red de nano-paredes se considera el mecanismo de crecimiento de la red de nano-paredes de GaN en c desnudo -zafiro plano [23]. Dado que la formación inducida por la dislocación de la red de nano-paredes es de bajo control, se ha llevado a cabo el crecimiento de la red de nano-paredes en el sustrato de Si (111) con una capa de amortiguación de Al [18]. El mecanismo de crecimiento del nanopared en Si (111) es significativamente diferente al del sustrato de zafiro desnudo; sin embargo, no se lleva a cabo ninguna investigación, aunque el mecanismo de crecimiento de Si (111) es la clave para el crecimiento de la red de nanowall.
En este trabajo, se estudia sistemáticamente el crecimiento de GaN en varias estructuras, incluida la red de nanopared, las nanocolumnas y la película compacta. Varias estructuras de GaN mencionadas anteriormente se cultivaron en Si (111) usando epitaxia de haz molecular asistida por plasma (MBE). Los resultados muestran que el cambio de estructura del crecimiento de GaN se puede lograr ajustando la relación Ga / N y agregando las gotas de Al depositadas previamente. La morfología y fotoluminiscencia de la red de nanopared de GaN se midieron mediante microscopía electrónica de barrido por emisión de campo (FESEM) y analizador de espectro de fotoluminiscencia con láser He-Cd (325 nm, 200 mW) como fuente de excitación. Se utilizó un microscopio de fuerza atómica (AFM) para la caracterización de la capa de Al depositada previamente. Se propone el mecanismo de crecimiento de la red de nanopartículas de GaN en Si (111) con gotas metálicas de Al.
Experimental
Las estructuras de GaN se cultivaron en los sustratos de Si (111) mediante el sistema Riber 32 MBE equipado con un N 2 Fuente de plasma RF (Veeco, RFS-N / TH). La presión de la cámara de crecimiento se bombeó a 3,0 × 10 - 10 Torr antes del crecimiento. El N 2 En este experimento se utilizaron gas, Ga y Al con una pureza del 99,9999%. El sustrato de Si (111) (sin dopaje, un lado pulido para el crecimiento, 380 ± 20 μm, proporcionado por Sigma-Aldrich) con resistividad> 5000 Ω cm se limpió mediante un proceso RCA estándar, seguido de inmersión en HF:H 2 O =1:50 durante unos segundos para eliminar la capa de óxido de silicio en la superficie del sustrato de Si y para formar una superficie terminada en hidrógeno.
Para el crecimiento de las nanocolumnas de GaN, las contraventanas del N 2 El plasma y la fuente de Ga se abrieron simultáneamente y el Si (111) desnudo se calentó a 973 K. La potencia y la presión del N 2 La fuente de plasma utilizada en todas las muestras en este trabajo se fijó en 400 W y 4,2 × 10 - 5 Torr, respectivamente. Antes del crecimiento de la red de nanopared de GaN, las gotas de Al con un diámetro de aproximadamente 80 nm se depositaron sobre el Si (111) desnudo calentado a 973 K. La fuente de Al se mantuvo a 1323 K. La pre-deposición de las gotas de Al dio como resultado una nucleación y crecimiento diferentes de GaN, lo que llevó al crecimiento de la red de nanopared. El flujo de Ga para el crecimiento de la red de nanopared fue el mismo que el de las nanocolumnas ( φ Ga =1,2 × 10 - 7 Torr a 1169 K). Para el crecimiento de la película de GaN, el flujo de Ga se aumentó a 5,3 × 10 - 7 Torr mientras que el flujo de N se mantuvo constante.
Resultados y discusión
Cuando las persianas de N 2 plasma y Ga se abrieron simultáneamente, GaN (S 1 ) creció en forma de nanocolumnas sobre el Si (111) desnudo como se muestra en la Fig. 1a. El flujo de Ga fue 1,2 × 10 - 7 Torr y el sustrato de Si (111) se mantuvieron a 973 K como se muestra en la Tabla 1. Se observa que el diámetro de las nanocolumnas de GaN varía de 52 a 125 nm con una longitud de ~ 460 nm. La densidad de las nanocolumnas contadas a partir de la imagen SEM es ~ 10 7 mm - 2 . Obviamente, la mayoría de las nanocolumnas observadas en la Fig. 1b no son perpendiculares al sustrato, sino que se inclinan con un ángulo de ~ 30 °. La superficie superior de las nanocolumnas es lisa, de acuerdo con el informe de Bertness [9]. Se cree que las nanocolumnas se nuclean espontáneamente y luego se propagan porque el coeficiente de adherencia en el (0 0 01) c -el avión es más alto que el del {110 0} m -avión. La longitud de difusión L del átomo de Ga absorbido (Ga ab ) es esencial para el crecimiento de las nanocolumnas. Como se describe en la ecuación. (1), la longitud de difusión L depende de la distancia media de salto a , el Ga ab energía de desorción Q des , y la energía de activación para un salto de difusión superficial Q d [13] .
$$ L =\ sqrt {2} a \ \ exp \ left (\ frac {Q _ {\ mathrm {d} \ mathrm {es}} - {Q} _ {\ mathrm {d}}} {2 kT} \ derecha) $$ (1)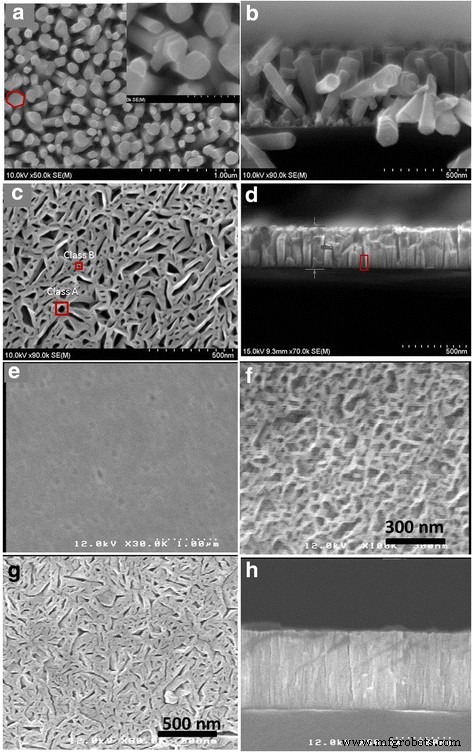
Imágenes FESEM de muestras cultivadas en diferentes condiciones. un , b Correspondiente a las nanocolumnas de GaN (muestra S 1 ). c , d Correspondiente a la red de nanowall de GaN (muestra S 2 ), e Correspondiente a la película compacta (muestra S 3 ), f Correspondiente a la red de nanowall de GaN (muestra S 4 ) en la etapa inicial de crecimiento. g , h Correspondiente a la red de nanowall de GaN cultivada a una temperatura más baja de 900 K (muestra S 5 )
Dado que las paredes laterales de nanocolumnas atómicamente planas proporcionan pocos sitios de adsorción, se supone que el Ga ab longitud de difusión L en el m -el plano de las paredes laterales es mucho más alto que el de la c -plano, lo que resulta en el crecimiento vertical de GaN a nanocolumnas. Si esta suposición fuera cierta, la anisotropía de la tasa de crecimiento fuerte cambiaría cuando se mejorara la relación Ga / N. De hecho, el GaN (S 3 ) la estructura cambió de la nanocolumna a la película compacta (Fig. 1e) cuando el flujo de Ga se incrementó a 5.3 × 10 - 7 Torr. Por lo tanto, el crecimiento de GaN en forma de nanocolumna o película compacta se puede controlar ajustando la relación Ш / V.
Aunque las nanocolumnas de GaN exhiben un rendimiento superior al de la película, la fabricación de un dispositivo eléctrico presenta una gran dificultad porque la nanocolumna separada necesita una alineación antes de la fabricación del contacto eléctrico. Por lo tanto, se favorece una nanoestructura conductora de electricidad en el plano. Para el crecimiento de la muestra S 2 , la pre-deposición de Al metálico se llevó a cabo en la cámara de crecimiento de MBE durante 40 s. Luego, el N 2 el plasma y la fuente de Ga se abrieron simultáneamente. El flujo de Ga para el S 2 El crecimiento se resume en la Tabla 1, lo mismo que el de S 1 . La Figura 1c muestra la imagen FESEM de vista superior de la muestra S 2. Es bastante interesante que el GaN crezca en forma de red de nanopared en el Al / Si (111). Los nanoparedones con un diámetro de 50 ~ 100 nm se superponen y entrelazan entre sí, formando una red continua en el plano, a saber, una red de nanopared. Se pueden observar dos clases de orificios, denominados clase A y clase B. Los diámetros de los orificios de la clase A y de la clase B son típicamente 50 ~ 100 y 10 ~ 49 nm, respectivamente. La característica continua en el plano hace que la red de nanopared dentro del panel sea eléctricamente conductora [18], eliminando los obstáculos de la fabricación de nanodispositivos hasta cierto punto. La superficie superior de los nanopared es relativamente plana, diferente de la matriz de GaN facetada informada en la Ref. [13]. Es observable que los agujeros que se muestran en la imagen de la vista superior se extienden hasta cerca del sustrato, como lo indica el rectángulo en la Fig. 1d.
Cabe preguntarse cómo se generan los agujeros mencionados anteriormente. Cultivamos una muestra S 5 a una temperatura de crecimiento más baja de 900 K. Los otros parámetros de crecimiento son los mismos con la muestra S 2 , como se muestra en la Tabla 1. De la Fig. 1g, observamos que la muestra S 5 también creció en forma de red de nanopared con agujeros más pequeños. La Figura 1h es la imagen en sección transversal de S 5 , mostrando una capa más compacta que S 2. Para ver el crecimiento inicial de la red de nanowall de GaN, crecimos otra muestra S 4 en poco tiempo con pre-deposición de Al. Todos los parámetros de crecimiento de S 4 son los mismos que los de la muestra S 2 excepto por el tiempo de crecimiento (20 vs 120 min). El espesor de S 4 es de aproximadamente 50 nm y su imagen de vista superior se muestra en la Fig. 1f. Se observa que se han formado agujeros en esta etapa y el GaN como vestido es una red continua en el plano, en lugar de los nanocables o islas de GaN. Del estudio de muestras S 1 , S 2 , S 4 y S 5 , está claro que la pre-deposición de la capa de Al cambia el comportamiento de crecimiento de GaN al principio, desde la nanocolumna a la red de nanopared continua en el plano.
Tenga en cuenta que todas las condiciones de crecimiento de S 2 excepto que la pre-deposición de Al es la misma que la de S 1 . Entonces, podemos preguntarnos cuál es la estructura del Al depositado previamente y cómo afecta el crecimiento posterior del GaN. Para encontrar estas respuestas, FESEM y AFM investigan la pre-deposición de Al durante 40 s en el Si (111) desnudo. La figura 2a muestra la imagen de la vista superior del Al depositado previamente. Se encuentra que el Al sobre el sustrato de Si existe en forma de gotitas (puntos blancos) distintas de la película. Las gotas de Al metálico con una densidad de ~ 4 × 10 7 mm - 2 distribuir relativamente uniformemente sin acumulación significativa. Recientemente, las gotas de Al se cultivaron con éxito usando MBE por Li et al. para mejorar la calidad del GaN recién crecido y reducir el estrés [24]. Para estudiar más a fondo la morfología de las gotas de Al, se utilizó AFM para medir sus imágenes tridimensionales y parámetros relacionados como se muestra en la Fig. 2b, c. Las gotas son esferas como se muestra en la Fig. 2b, de acuerdo con el resultado de SEM. La altura y el diámetro de la gota de Al medida son 6,7 y 80 nm, respectivamente. Poppitz y col. [25] han investigado el crecimiento de la red de nanopared de GaN en 6H-SiC (0001) desnudo mediante MBE asistido por haz de hierro. Sus resultados muestran que las condiciones de crecimiento extremadamente ricas en N en combinación con la alta temperatura del sustrato y la irradiación energética de iones de N durante el crecimiento son las principales razones para la formación de la red de nanopared en 6H-SiC (0001) desnudo. Como pionero, Kesaria et al. [17] han investigado la red de nanowall de GaN en un sustrato de zafiro desnudo utilizando PA-MBE. En su investigación, se considera que los nanoparedones de GaN se nuclean en el borde y los tornillos se dislocan y crecen bajo una atmósfera rica en nitrógeno.
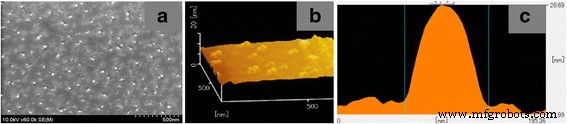
FESEM ( a ) y AFM ( b ) imágenes del Al depositado previamente sobre sustrato de Si. c Una medida de parámetro de una gota de Al por AFM
En nuestro caso, el mecanismo de crecimiento de la red de nanopared de GaN debería ser diferente ya que los nanopared crecen con el requerimiento de la pre-deposición de Al metálico. Por supuesto, hasta donde sabemos, todas las redes de nanopared de GaN incluidas en nuestro experimento se cultivan en una atmósfera rica en nitrógeno. Se requiere N rico para reducir la coalescencia de los nanopared. Ahora, centrémonos en el papel de las gotas de Al en la formación de la red de nanopared. Al igual que las gotas de Au que actúan como catalizador [26], si las gotas de Al actúan como catalizador, el GaN debería crecer hasta las nanocolumnas en lugar de la red de nanopared. El papel de las gotas de Al, por lo tanto, no es un catalizador en nuestro estudio. La temperatura de fusión del metal Al es de 933 K mientras que la temperatura del sustrato se mantiene a 973 K durante el crecimiento. Por tanto, al comienzo del crecimiento de GaN, las gotas de Al son gotas líquidas. Según un informe anterior, en el caso de GaN en Si (111) con gotas de Ga [13], las gotas de Ga actúan como depósitos que suministran átomos de Ga a su vecindad cercana. Sin embargo, las propias gotas de Ga impiden el crecimiento de GaN en ellas, ya que los sitios originales de las gotas de Ga son círculos huecos. En nuestro caso, el diámetro de las gotas de Al es de ~ 80 nm, similar al tamaño de los agujeros de clase A en la Fig. 1a. Por lo tanto, las gotas de Al pueden obstaculizar el crecimiento de GaN en ellas, lo que lleva a la formación de los agujeros de clase A observados en la red de nanopared de GaN. Debido a la misma relación Ш / V de muestras S 1 y S 2 , la longitud de difusión de Ga L en Si para la red de nanopartículas se espera que el crecimiento sea el mismo que para las nanocolumnas. El tamaño típico del sustrato de Si desnudo (el área sin gotas de Al) es ~ 80 nm, dentro del valor del diámetro de la nanocolumna en la Fig. 1a. En otras palabras, la longitud de difusión de Ga L cubre el tamaño del sustrato de Si desnudo, lo que da como resultado el crecimiento continuo de GaN en el área sin las gotas de Al, es decir, la red de nanopared de GaN.
Basándose en el análisis anterior, se propone un modelo de crecimiento de la red de nanopared de GaN y se muestra en la Fig. 3. GaN se nuclea en el sustrato de Si desnudo como se ilustra en la Fig. 3a. Dado que el Ga ab longitud de difusión L cubre el sustrato de Si desnudo, GaN crece en todo el sustrato de Si desnudo mientras que el crecimiento de GaN por encima de las gotas de Al se ve obstaculizado (Fig. 3b). Además, en condiciones ricas en N, GaN tiende a crecer verticalmente como se muestra en la Fig. 3c. Debido a que el sustrato de Si desnudo es una red continua en el plano, el crecimiento de GaN arriba también es una red continua denominada red de nanopared, como se ilustra en la Fig. 3d. Esta suposición se ve confirmada por la imagen de vista superior de la muestra S 4 en la Fig. 1f. Debido a la condición rica en N para la muestra S 2 crecimiento, el crecimiento lateral es limitado que los huecos son capaces de reservar en el crecimiento posterior. Tenga en cuenta que tanto las gotas de Al como la condición rica en N son esenciales para el crecimiento de la red de nanopared de GaN.
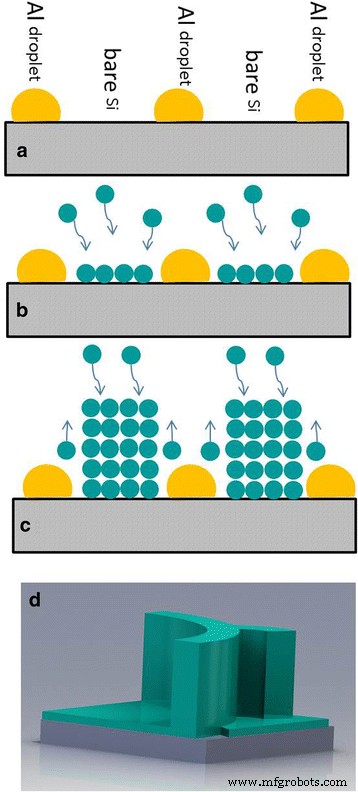
Modelos de crecimiento de la red de nanopartículas de GaN. un Las gotas de Al depositadas previamente sobre el sustrato de Si. b Nucleación de la red de nanowall de GaN en el Si desnudo. c Ilustración de la sección transversal de la red de nanopared de GaN que creció verticalmente en la condición rica en N. d Ilustración de inclinación de la red de nanowall de GaN
Se utilizó difracción de rayos X para la caracterización de la estructura cristalina de la red de nanopared de GaN como se muestra en la Fig. 4. Se observan dos picos de difracción de GaN (002) y GaN (004) junto con el pico de Si (111) del Sustrato de Si. El resultado revela que la red de nanopared de GaN es hexagonal y se orienta en gran medida a lo largo de C eje. Además del patrón XRD, también se midió la curva de oscilación de barrido ω de GaN (002) como se muestra en el recuadro de la Fig. 4. El ancho completo a la mitad del máximo es 52,2 minutos de arco, similar al informe anterior desarrollado en el zafiro sustrato [27]. Las propiedades eléctricas también se midieron utilizando el sistema de medición Van der Pauw Hall (HL5500PC, Nanometrics) a 293 K. La conductividad eléctrica, la movilidad de la sala y la concentración de electrones de la red de nanopared de GaN son 10,2 S / cm, 31 cm 2 / Vs y 2,1 × 10 18 cm - 3 , respectivamente. En cuanto a la película de GaN, la conductividad eléctrica aumenta a 666,7 S / cm debido a la mayor concentración de electrones de 2,2 × 10 20 cm - 3 . La alta concentración de portador en la película probablemente se atribuya a la alta concentración de defectos intrínsecos generada por la relación Ga / N no optimizada. En cuanto a la movilidad de la sala de la película, el valor es 18,7 cm 2 / Vs.

Patrón de difracción de rayos X de la red de nanowall de GaN (S 2 ). El recuadro es la curva de oscilación ω-scan de la muestra S 2
La Figura 5 muestra los espectros de fotoluminiscencia de la red de nanopared de GaN con un láser de He-Cd como fuente de excitación. Según el informe de Kesaria et al. [17], se llevó a cabo una comparación directa de la catodoluminiscencia entre la película de GaN, la red de nanopartículas y la nanocolumna cultivada sobre un sustrato de zafiro desnudo. Sus resultados muestran que la emisión en el borde de la banda de la red de nanopared es ligeramente superior a la de la nanocolumna y mucho más alta que la de la película. Se puede observar una emisión de defecto amplia centrada en 520 a 620 para la red de nanopared, mientras que no se pudo observar emisión de defecto para la nanocolumna. En la Fig. 5, se observa una fuerte emisión de borde de banda centrada en 363,7 nm con el ancho completo a la mitad del máximo de 14,1 nm. De acuerdo con el informe de Kesaria et al. [17], en el rango de 520 a 620 nm, una amplia emisión verde-amarilla atribuida a defectos puntuales [28] es detectable pero muy débil, lo que indica una alta calidad del nanoparal de GaN red. Por lo tanto, la luminiscencia de la red de nanopared de GaN que crece en el sustrato de zafiro desnudo y en el sustrato de Si con las gotas de Al es casi la misma, aunque el mecanismo de crecimiento es diferente.

Espectros de fotoluminiscencia (PL) de la red de nanopared de GaN medidos a temperatura ambiente
Conclusiones
En este trabajo, el cambio de estructura del crecimiento de GaN entre la nanocolumna, la red de nanowall y la película compacta se logró con éxito en el sustrato de Si (111) utilizando MBE. Las nanocolumnas de GaN se cultivaron sobre el sustrato de Si desnudo en condiciones ricas en N mientras que la película compacta se cultivó con un flujo de Ga mejorado. Al agregar una capa de Al depositada previamente, el crecimiento de GaN se desplaza de las nanocolumnas a la red de nanopared continua en el plano. La capa de Al depositada previamente existe en forma de gotitas con la altura y el diámetro típicos de 6,7 y 80 nm, respectivamente. Se aborda el mecanismo de crecimiento de la red de nano paredes. GaN crece continuamente en el sustrato de Si desnudo mientras que el crecimiento de GaN en las gotas de Al se ve obstaculizado, lo que resulta en la formación de la red de nanopared. Tanto las gotas de Al como las condiciones ricas en N son esenciales para el crecimiento de la red de nanopartículas.
Nanomateriales
- Operadores C# Bitwise y Bit Shift
- C Estructura y Función
- Química de equipo e Industria 4.0
- 5G y GaN:el cambio de LDMOS a GaN
- 5G y GaN:innovaciones futuras
- IoT y blockchain:un cambio de paradigma
- Diferencia entre estructura y unión.
- Presentación de la estructura atómica y electrónica de las nanofibras de carbono de copa apilada
- Estructura y propiedades electrónicas de la nanoarcilla de caolinita dopada con metal de transición
- Análisis de reflectancia infrarroja de capas de GaN dopadas de tipo n epitaxiales cultivadas en zafiro
- Nanocables de silicio amorfo cultivados en película de óxido de silicio mediante recocido



