Investigación de la nitruración en la alineación de la banda en las interfaces MoS2 / HfO2
Resumen
El efecto del tratamiento de nitruración en la alineación de la banda entre MoS 2 de pocas capas y HfO 2 ha sido investigado por espectroscopia de fotoelectrones de rayos X. Las compensaciones de la banda de valencia (conducción) de MoS 2 / HfO 2 con y sin tratamiento de nitruración se determinó que eran 2,09 ± 0,1 (2,41 ± 0,1) y 2,34 ± 0,1 (2,16 ± 0,1) eV, respectivamente. La alineación de la banda sintonizable podría atribuirse a la formación de enlaces Mo-N y a la flexión de la banda de la superficie para HfO 2 desencadenado por nitruración. Este estudio sobre la ingeniería de bandas de energía de MoS 2 / HfO 2 las heterouniones también pueden extenderse a otros dieléctricos de alto k para integrarse con materiales bidimensionales para diseñar y optimizar sus dispositivos electrónicos.
Antecedentes
Actualmente, los dicalcogenuros de metales de transición en capas (TMDC) han despertado un gran interés debido a sus fascinantes propiedades para aplicaciones potenciales en la electrónica moderna y optoelectrónica [1, 2]. En particular, el disulfuro de molibdeno (MoS 2 ) ha atraído una atención considerable como material de canal prometedor para continuar el escalado más allá del nodo de tecnología de 7 nm [3, 4]. Estructuralmente, el MoS 2 El cristal está formado por un plano Mo dispuesto hexagonalmente, intercalado por dos planos S dispuestos hexagonalmente. Se formó una disposición prismática triangular a través de las unidades S-Mo-S unidas covalentemente [5, 6]. MoS 2 posee un intervalo de banda dependiente de la capa, que varía desde un intervalo de banda directo (1.8 eV) para MoS de una sola capa (SL) 2 a una banda prohibida indirecta (1,2 eV) para MoS a granel 2 [7]. A diferencia del grafeno con un intervalo de banda cero, la modulación de intervalo de banda dependiente del grosor motivó la exploración de MoS 2 en dispositivos ópticos y eléctricos [3, 8]. Basado en la física de MoS 2 , la densidad de estados de MoS 2 de pocas capas es el triple que el MoS 2 de una sola capa , lo que da como resultado altas corrientes de excitación en el límite balístico [8]. En este contexto, MoS 2 de pocas capas puede ofrecer ventajas significativas para aplicaciones de transistores que SL MoS 2 [3].
Por otro lado, los dispositivos electrónicos basados en dieléctricos tradicionales de dióxido de silicio se están acercando al límite físico debido a su baja constante dieléctrica [9]. Para obtener un espesor de óxido equivalente (EOT) delgado, es de vital importancia integrar dieléctricos de alto k con MoS 2 . Hasta la fecha, se han investigado muchos dieléctricos de alto k con MoS 2 , incluido Al 2 O 3 , ZrO 2 , HfO 2 y h-BN [10,11,12,13,14]. DiStefano y col. obtuvieron los respectivos desplazamientos de banda de valencia y conducción de 3,3 ± 0,2 y 1,4 ± 0,2 eV para MoS 2 de pocas capas crecido por deposición de vapor de óxido en BN amorfa [13]. Tao y col. informó que el desplazamiento de la banda de conducción (CBO) para la monocapa MoS 2 / Al 2 O 3 (ZrO 2 ) se dedujo que la heterounión era 3,56 eV (1,22 eV), mientras que el desplazamiento de la banda de valencia (VBO) era 3,31 eV (2,76 eV) [15]. Y un CBO de 2,09 ± 0,35 eV y VBO de 2,67 ± 0,11 eV en el MoS 2 / HfO 2 interfase fueron reportados por McDonnell et al. [12]. Entre estos dieléctricos de puerta, HfO 2 fue considerado uno de los candidatos más prometedores debido a su alta constante dieléctrica (k ∼ 20), compatibilidad con poli-SiGe, puertas TaN y puerta de silicio policristalino [16]. Sin embargo, HfO 2 tiene una estabilidad térmica deficiente, una gran corriente de fuga, una alta densidad de trampa de óxido, densidad de trampa de interfaz, etc. [17]. Estas limitaciones han motivado extensas investigaciones de búsqueda de técnicas de pasivación, tales como tecnologías de tratamiento de fluoración o nitruración de interfaz [18, 19]. En este trabajo, estudiamos las alineaciones de bandas de energía de MoS 2 de pocas capas en HfO 2 dieléctricos con y sin nitruración por plasma, en los que el efecto de la nitruración superficial se caracterizó por espectroscopía de fotoelectrones de rayos X (XPS).
Métodos
El SiO 2 (280 nm) / La oblea de Si se limpió alternativamente con acetona e isopropanol mediante limpieza ultrasónica cada 10 minutos, seguido de un enjuague con agua desionizada y N 2 seco. El MoS 2 de pocas capas las películas se depositaron en SiO 2 / Sustrato de Si por deposición química de vapor (CVD) utilizando precursores de MoO 3 (0,08 mg, 99%, Alfa Aesar) y polvo S (1 g, 99%) [20, 21]. Después del procedimiento de crecimiento, el MoS 2 la película se transferiría a HfO 2 / Sustrato de Si por el método de poli (metacrilato de metilo) (PMMA) [22], como se muestra en la Fig. 1a. En este proceso, PMMA se revistió por primera vez en MoS 2 / SiO 2 / Muestras de Si como capa de soporte. Luego, las muestras se sumergieron en una solución de KOH para eliminar el SiO 2 , después de lo cual el MoS 2 capa con PMMA flotaría hasta la parte superior de la solución. Al final, la capa de PMMA se disolvería en acetona después de que la muestra se transfiriera a HfO 2 / Sustrato de Si. El HfO 2 se cultivaron películas sobre la oblea de silicio mediante deposición de capa atómica (ALD) a una temperatura de 200 ° C utilizando Hf [N (CH 3 ) (C 2 H 5 )] 4 [tetraquis (etilmetilamido) hafnio, TEMAH] y H 2 O vapor como precursores [23, 24]. Durante el proceso de optimización del tiempo de tratamiento con plasma, se encontró que el nitrógeno se difundiría en gran medida en el óxido después del tratamiento de nitruración de 70 s mediante mediciones SIMS, lo que deterioraría gravemente la calidad del óxido. Si bien el tiempo de tratamiento con plasma es de 30 s, no se observó ningún pico de N obvio en la superficie del óxido a partir de los resultados de SIMS. Para la muestra de control, 50 s N 2 El tratamiento con plasma se implementó en HfO 2 / Sustrato de Si a una presión de 3 Pa antes del MoS 2 transferir. En condiciones de plasma, la dosis de N resultante es de aproximadamente 8,4 × 10 14 átomos / cm 2 estimado a partir de los resultados de la espectrometría de masas de iones secundarios (SIMS). Y se calculó que la concentración de nitrógeno era de aproximadamente 1,5% después de la nitruración basándose en los datos de XPS. Se prepararon cuatro muestras 1–4 # para mediciones XPS:1 # MoS de pocas capas 2 película sobre SiO 2 / Sustrato de Si (MoS 2 de pocas capas ), 2 # de espesor HfO 2 película sobre sustrato de Si (a granel HfO 2 ), 3 # MoS transferido 2 película sobre HfO 2 recién crecido / Sustrato de Si (MoS 2 recién crecido / HfO 2 heterounión), y 4 # MoS transferido 2 película en N 2 HfO 2 tratado con plasma / Sustrato de Si (MoS nitrurado 2 / HfO 2 heterounión).
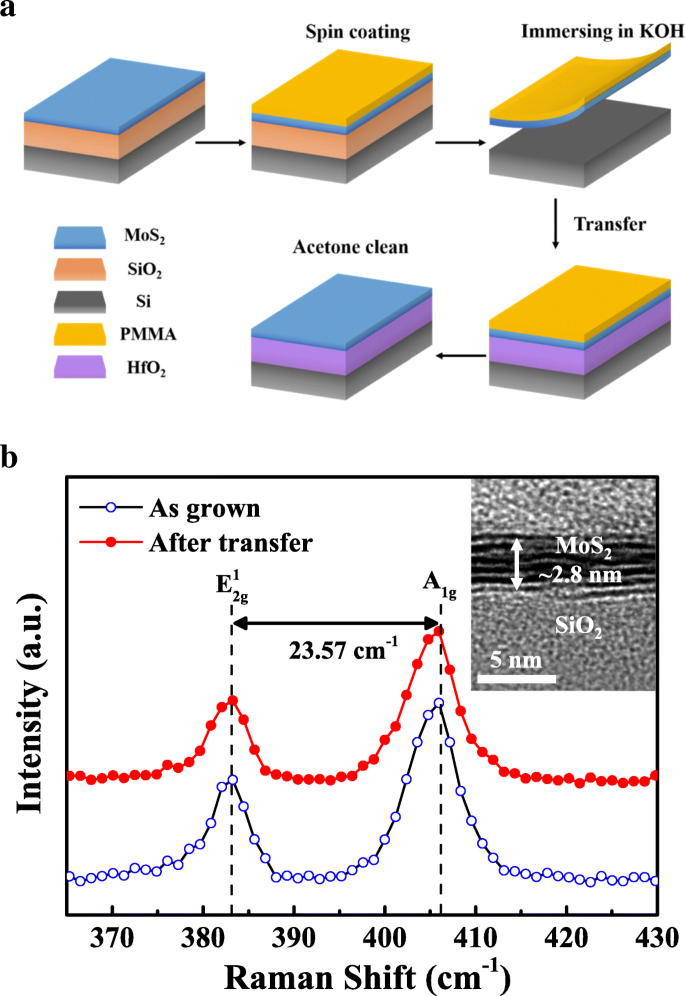
un Flujo de proceso del método de transferencia en húmedo asistido por PMMA para MoS 2 / ALD-HfO 2 formación de heterouniones. b Espectros Raman respectivos de MoS 2 recién crecido y transferido película. El recuadro son las imágenes de microscopía electrónica de transmisión de sección transversal de MoS 2 adulta en SiO 2 / Sustrato de Si
Resultados y discusiones
Se empleó la espectroscopía RENISHAW inVia Raman para caracterizar los espectros Raman de MoS 2 de pocas capas película antes y después del procedimiento de transferencia, como se ilustra en la Fig. 1b. Se pueden ver dos picos Raman a unos 382,86 cm −1 y 406,43 cm −1 , correspondiente al plano (\ ({E} _ {2g} ^ 1 \)) y fuera del plano ( A 1 g ) modos, respectivamente [25, 26]. Se encontró que casi no hay cambio Raman en \ ({E} _ {2g} ^ 1 \) y A 1 g frecuencias de modo después del proceso de transferencia, lo que indica una modificación mínima de la estructura. La diferencia de frecuencia ( ∆k ) entre \ ({E} _ {2g} ^ 1 \) y A 1 g se dedujo que el modo era de aproximadamente 23,57 cm −1 , designando alrededor de cuatro a cinco capas de MoS 2 película [27]. Como se muestra en el recuadro de la Fig. 1b, el grosor de MoS 2 Se verificó que la película era de aproximadamente 2,8 nm mediante un microscopio electrónico de transmisión de alta resolución (HRTEM), lo que concuerda con los espectros Raman antes mencionados. Además, presentamos perfiles de profundidad SIMS de MoS 2 transferidos película sobre HfO nitrurado 2 / Sustrato de Si. La medición SIMS se realizó en un instrumento Physical Electronics ADEPT 1010 SIMS con haz de iones primarios Cs a la energía de 1 keV, en el cual se recolectaron iones positivos y se realizó compensación de carga. En esta medición SIMS, el elemento nitrógeno se cuantificó, mientras que los otros elementos (Mo, Hf y Si) solo se entienden como marcadores de capa y no se cuantifican. Como se ilustra en la Fig. 2a, los perfiles de profundidad para MoS 2 transferidos película sobre HfO nitrurado 2 El sustrato / Si se determinó mediante SIMS, en el que las señales de los componentes principales representados por Mo, N, Hf y Si se representan frente a la profundidad. La propagación de N en el HfO 2 Se observó una capa, que podría estar intrigada por la inyección de N en la capa subyacente durante los bombardeos de haz primario o los tratamientos con plasma. También vale la pena señalar que los perfiles de profundidad cerca de la capa superficial son normalmente complicados y sin sentido debido a la contaminación de la superficie y los efectos de la superficie, por ejemplo, la intensidad anormal del elemento N cerca de la superficie [28]. La señal más alta del perfil N cerca del HfO 2 / Si la interfaz podría atribuirse a que el nitrógeno tiende a difundirse al HfO 2 / Si interfaz, que conduce a la acumulación de N cerca de la interfaz [29]. La cola de Mo en HfO 2 La película podría ser causada principalmente por bombardeos de haz primario en las mediciones SIMS [30]. La Figura 2b ilustra los respectivos espectros XPS de N 1s para las muestras 3 # y 4 #; los picos de alta intensidad para ambas heterouniones fueron Mo 3p 3/2 mientras que se detectó un pico de baja intensidad a ~ 395.80 eV para la heterounión nitrurada, lo que indica la formación de enlaces Mo-N [31].
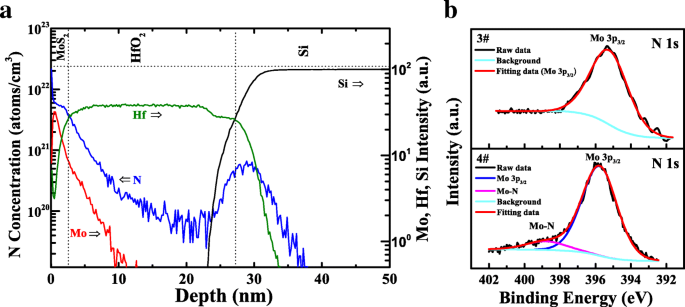
un Perfiles de profundidad SIMS de MoS transferido 2 película sobre HfO nitrurado 2 / Sustrato de Si. b Espectros XPS de N 1s para MoS 2 / HfO 2 heterouniones con y sin tratamiento de nitruración, respectivamente
Para obtener las alineaciones de banda entre MoS 2 de pocas capas y HfO 2 con y sin tratamiento de nitruración, se llevaron a cabo mediciones de XPS con un paso de 0,05 eV en el sistema VG ESCALAB 220i-XL utilizando una fuente de rayos X monocromática de Al Kα (hν =1486,6 eV). La energía de paso constante se fijó en 20 eV. Además, se utilizó el estándar C 1s (284,8 eV) para la calibración de la energía de enlace (BE) [32]. Para evaluar los valores de VBO para MoS 2 / HfO 2 heterouniones, los niveles centrales (CL) de Mo 3d y Hf 4f se seleccionaron para la muestra 1-4 #, respectivamente. La Figura 3a presenta el escaneo estrecho XPS de Mo 3d y los espectros de banda de valencia de la muestra 1 # [33]. Por lo tanto, la diferencia de energía de enlace (BED) entre Mo 3d 5/2 El nivel del núcleo y el máximo de banda de valencia (VBM) para la muestra 1 # se calculó en 228,49 ± 0,1 eV. La Figura 3b ilustra los CL de Hf 4f 7/2 y VBM para la muestra 2 #; se determinó que el BED correspondiente era 14,10 ± 0,1 eV. La Figura 3c muestra los espectros XPS medidos de las CL de Mo 3d y Hf 4f para MoS 2 / HfO 2 heterouniones con / sin tratamiento de nitruración. Se observa que el Mo 3d 5/2 CL cambió de 229,45 ± 0,05 eV para la muestra 3 # a 229,90 ± 0,05 eV para la muestra 4 #. Esto podría atribuirse a que se introdujo una capa interfacial de nitruración en el MoS 2 / HfO 2 interfase después del tratamiento con plasma, dando como resultado la unión Mo-N antes mencionada. Con la presencia de enlace Mo-N, la consiguiente transferencia de carga entre los elementos Mo y N contribuyó a la medición de Mo 3d 5/2 Cambio CL. Además, el Hf 4f 7/2 El CL de 17,40 ± 0,05 eV para la muestra 3 # se cambió a una energía de enlace más alta de 17,60 ± 0,05 eV para la muestra 4 # mientras que O 1s también mostró un cambio de 0,20 eV a un BED más alto, como se muestra en la Fig. 3d. Estos cambios máximos implicaron la flexión de la banda hacia abajo en el HfO 2 superficie, lo que podría interpretarse como que el plasma de nitrógeno indujo defectos similares al donante para HfO 2 [34]. Basado en el método Kraut [35], el VBO ( ∆E V ) los valores se pueden calcular a partir de la siguiente ecuación:
$$ \ Delta {E} _V =\ left ({E} _ {\ mathrm {Mo} \ 3 {\ mathrm {d}} _ {5/2}} ^ {\ mathrm {Mo} {\ mathrm {S }} _ 2} - {E} _ {\ mathrm {VBM}} ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} \ right) - \ left ({E} _ {\ mathrm {Hf} \ 4 {\ mathrm {f}} _ {7/2}} ^ {{\ mathrm {Hf} \ mathrm {O}} _ 2} - {E} _ {\ mathrm {VBM}} ^ {{\ mathrm {Hf } \ mathrm {O}} _ 2} \ right) - {\ Delta E} _ {\ mathrm {CL}} $$ (1)donde \ ({E} _ {\ mathrm {Mo} \ 3 {\ mathrm {d}} _ {5/2}} ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} \) y \ ( {E} _ {\ mathrm {VBM}} ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} \) son energías de enlace de Mo 3d 5/2 CL y VBM para MoS 2 , \ ({E} _ {\ mathrm {Hf} \ 4 {\ mathrm {f}} _ {7/2}} ^ {{\ mathrm {Hf} \ mathrm {O}} _ 2} \) y \ ( {E} _ {\ mathrm {VBM}} ^ {{\ mathrm {HfO}} _ 2} \) son energías de enlace de Hf 4f 7/2 CL y VBM para ALD-HfO 2 , ∆E CL =\ ({E} _ {\ mathrm {Mo} \ 3 {\ mathrm {d}} _ {5/2}} ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} - {E} _ {\ mathrm {Hf} \ 4 {\ mathrm {f}} _ {7/2}} ^ {{\ mathrm {Hf} \ mathrm {O}} _ 2} \) se refiere al BED entre Mo 3d 5/2 y Hf 4f 7/2 CL para ALD-HfO 2 / MoS 2 heterouniones. Por lo tanto, el ∆E V de MoS 2 en ALD-HfO 2 con y sin tratamiento de nitruración se calcularon en 2,09 ± 0,1 y 2,34 ± 0,1 eV, respectivamente.

un Espectros XPS de Mo 3d CL y banda de valencia para el MoS 2 de pocas capas . b Espectros XPS de Hf 4f CL y banda de valencia para HfO 2 a granel . Espectros XPS de c Mo 3d, Hf 4f y d CL de O 1s para MoS 2 transferidos película a granel HfO 2 con / sin tratamiento de nitruración
Para evaluar la influencia de N 2 tratamiento con plasma en el desplazamiento de la banda de conducción (CBO, ∆E C ) entre ALD-HfO 2 y MoS 2 de pocas capas , la banda prohibida de 5,9 ± 0,1 eV para HfO 2 y 1,4 ± 0,1 eV para MoS 2 se utilizaron aquí, respectivamente [7, 36]. Por lo tanto, la CBO se puede obtener mediante la siguiente ecuación:
$$ {\ Delta E} _C ={E} _g ^ {{\ mathrm {HfO}} _ 2} - {E} _g ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} - {\ Delta E } _V $$ (2)donde \ ({E} _g ^ {{\ mathrm {HfO}} _ 2} \) y \ ({E} _g ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} \) son las bandas prohibidas de HfO 2 y MoS 2 , respectivamente. Según Eq. (2), el ∆E C entre MoS 2 y ALD-HfO 2 con y sin tratamiento de nitruración se calcularon en 2,41 ± 0,1 y 2,16 ± 0,1 eV, respectivamente. Los diagramas de bandas correspondientes se ilustran en la Fig. 4. Sorprendentemente, los valores de VBO y CBO de estas dos heterouniones proporcionan excelentes confinamientos de electrones y huecos, lo que garantiza su idoneidad para MoS 2 FET basados en [37]. Además, la heterounión nitrurada tiene un CBO más alto en comparación con la heterounión no nitrurada, que es mejor para las aplicaciones de FET de canal n.
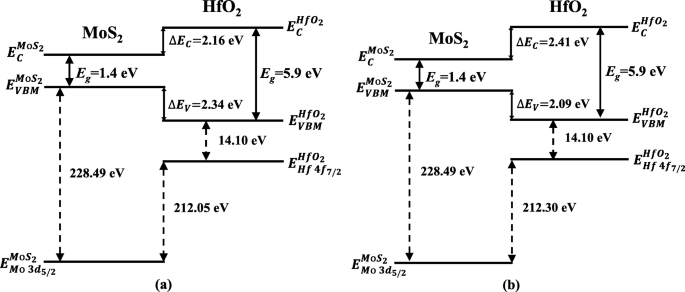
Diagramas de bandas de MoS 2 / HfO 2 heterounión a sin tratamiento de nitruración y b con tratamiento de nitruración
Conclusiones
En conclusión, las mediciones de XPS revelaron que la alineación de la banda en el MoS 2 / HfO 2 La interfaz podría modificarse introduciendo nitruración en HfO 2 superficie antes de apilar MoS 2 película. Se determinó que el CBO y el VBO eran 2,16 ± 0,1 y 2,34 ± 0,1 eV para el MoS 2 no nitrurado / HfO 2 heterounión, mientras que el CBO se alteró hasta 2,41 ± 0,1 eV y el VBO se alteró hasta 2,09 ± 0,1 eV para el MoS nitrurado 2 / HfO 2 heterounión, respectivamente. Se introdujo una capa interfacial de nitruración en la interfaz, que resultó en la formación de enlaces Mo-N. Además, el plasma de nitrógeno podría inducir defectos similares a los del donante, lo que provocaría que la banda de la superficie se doblara para HfO 2 . De esta manera, la ingeniería de alineación de bandas interfaciales proporcionaría rutas prometedoras hacia el diseño flexible y la optimización de la electrónica moderna.
Disponibilidad de datos y materiales
Los conjuntos de datos que respaldan las conclusiones de este manuscrito se incluyen dentro del manuscrito.
Abreviaturas
- ALD:
-
Deposición de la capa atómica
- BE:
-
Energía vinculante
- BED:
-
Diferencia de energía vinculante
- CBO:
-
Desplazamiento de la banda de conducción
- CL:
-
Nivel básico
- CVD:
-
Deposición de vapor químico
- FET:
-
Transistor de efecto de campo
- HfO2:
-
Óxido de hafnio
- HRTEM:
-
Microscopio electrónico de transmisión de alta resolución
- MoS 2 :
-
Disulfuro de molibdeno
- PMMA:
-
Poli (metacrilato de metilo)
- SIMS:
-
Espectrometría de masas de iones secundarios
- SL:
-
Una capa
- TEMAH:
-
Tetrakis (etilmetilamido) hafnio
- TMDC:
-
Dicalcogenuro de metal de transición
- VBM:
-
Máximo de banda de valencia
- VBO:
-
Desplazamiento de la banda de valencia
- XPS:
-
Espectroscopia de fotoelectrones de rayos X
Nanomateriales
- Introducción a la banda de terahercios
- MoS2 con espesor controlado para evolución electrocatalítica de hidrógeno
- Características de alineación interfacial, eléctrica y de banda de pilas de HfO2 / Ge con capa intermedia de SiO2 formada in situ mediante deposición de capa atómica mejorada por plasma
- Cristalización dependiente de la temperatura de nanoflakes de MoS2 en nanohojas de grafeno para electrocatálisis
- Efecto fotovoltaico lateral grande en heterounión MoS2 / GaAs
- Fotoresponsividad dependiente del sesgo de fototransistores MoS2 multicapa
- Una investigación sobre una célula solar de silicio cristalino con una capa de silicio negro en la parte posterior
- Los componentes principales de las máquinas de sierra de cinta
- ¿Cómo elegir la velocidad de aserrado?
- La potente sierra de cinta para corte de metales
- Presentamos el aserradero de banda vertical



