Estrategia de optimización de la carga de absorción separada 4H-SiC y la estructura del fotodiodo de avalancha de multiplicación para una alta eficiencia de detección ultravioleta
Resumen
En este trabajo, se realizan sistemáticamente investigaciones paramétricas sobre optimización estructural para fotodiodo ultravioleta de avalancha (UV APD) basado en 4H-SiC de carga de absorción separada y multiplicación (SACM). Según nuestros resultados, el voltaje de ruptura puede verse fuertemente afectado por el espesor de la capa de multiplicación y la concentración de dopaje para la capa de control de carga. El grosor de la capa de contacto óhmico de tipo n, la capa de absorción y la capa de control de carga pueden afectar notablemente a la profundidad de penetración de la luz, lo que influye correspondientemente en el número de pares de electrones y huecos fotogenerados y, por tanto, el grosor de la capa antes mencionado tiene un fuerte impacto en la capacidad de respuesta para SACM APD. Para mejorar la capacidad de respuesta del APD, necesitamos una altura de barrera de banda de energía reducida en la interfaz de la capa de absorción óptica y la capa de control de carga, de modo que se pueda favorecer el transporte de portador promovido a la capa de multiplicación. Además, investigamos mesas biseladas positivas con ángulos más pequeños para reducir el campo eléctrico en el borde de la mesa. Por lo tanto, la corriente oscura se suprime correspondientemente.
Introducción
Como material semiconductor con banda prohibida amplia, el carburo de silicio (SiC) y el nitruro de aluminio y galio (AlGaN) exhiben excelentes características de material, como un campo eléctrico crítico alto, un mejor efecto antirradiación y una buena conductividad térmica, que lo hacen adecuado para los rayos ultravioleta (UV). detección [1, 2, 3]. La banda prohibida ajustable entre 3,4 y 6,2 eV para los fotodetectores basados en AlGaN permite la respuesta de corte controlable en una longitud de onda de entre 365 y 200 nm. Sin embargo, debido a la dificultad de cultivar compuestos AlGaN ricos en Al de alta calidad, la corriente oscura de los fotodetectores basados en AlGaN es más alta que la de sus homólogos basados en SiC [4]. Por lo tanto, los fotodetectores basados en SiC han ganado un gran interés en la investigación. Hasta la fecha, los detectores ultravioleta de estado sólido basados en 4H-SiC comprenden diodo de barrera Schottky, fotodiodo metal-semiconductor-metal (MSM), fotodiodo p-i-n y fotodiodo de avalancha (APD) [5,6,7,8,9]. Debido a la alta ganancia de avalancha, la pequeña corriente oscura y el bajo ruido, los APD ultravioleta 4H-SiC tienen excelentes perspectivas de aplicación en muchos campos de vanguardia que requieren una detección de señal ultravioleta débil, como advertencia de incendio, comunicación cuántica y detección de misiles [ 10,11,12]. Sin embargo, el material de SiC tiene un coeficiente de absorción de luz bajo, por lo que una estructura de fotodiodo común con una capa de multiplicación delgada es difícil de lograr una alta eficiencia cuántica. El problema no se resuelve hasta que se propone la estructura APD de carga de absorción separada y multiplicación (SACM). Por un lado, la capa de absorción puede absorber eficazmente la luz ultravioleta y, por otro lado, la alta ganancia interna se puede obtener en la capa de multiplicación de alto campo mediante el proceso de ionización por impacto. El proceso de ionización por impacto en la capa de multiplicación puede ser terminado por la capa de control de carga [13, 14]. La ventaja para la estructura SACM surge de la reducción del ruido, porque solo un único tipo de portadores fotogenerados con mayor tasa de ionización puede inyectarse en la capa de multiplicación [15, 16]. Para obtener una alta capacidad de detección para una señal ultravioleta débil, se fabricarán APD SACM con una gran área de detección activa [17]. Sin embargo, el tamaño aumentado del dispositivo va acompañado de una corriente de fuga superficial y una corriente de fuga en masa significativamente mejoradas. Por lo tanto, esto no solo impone un requisito estricto sobre la calidad de la oblea epitaxial de SiC, sino que también refleja un gran desafío para el proceso de fabricación y el diseño del dispositivo. En las últimas décadas, Cree Company ha promovido en gran medida la tecnología de crecimiento epitaxial para películas de SiC, lo que, por lo tanto, ha llevado a la mejora continua de la calidad cristalina. Más recientemente, Zhou et al. han propuesto una técnica de reflujo fotorresistente de temperatura variable para crear paredes laterales muy suaves para la mesa biselada 4H-SiC APD [18], que permite una alta ganancia de multiplicación de más de 10 6 y una corriente oscura baja de ~ 0,2 nA / cm 2 . Sin embargo, la investigación anterior se ha centrado más en mejorar la calidad del material y optimizar la tecnología de fabricación de los APD SACM [19,20,21], mientras que el impacto del diseño estructural en el transporte de portadores fotogenerados y la detección de fotocorriente rara vez se ha discutido hasta ahora. . Por lo tanto, en esta carta, investigamos sistemáticamente el rendimiento optoelectrónico de los APD ultravioleta SACM basados en 4H-SiC de gran área con diferentes diseños estructurales. Mientras tanto, también se proporcionan interesantes imágenes físicas y debates. Creemos que los hallazgos de este trabajo son útiles para que los investigadores optimicen los APD de 4H-SiC a un costo menor.
Como es sabido, la multiplicación de portadores a gran escala se genera cuando tiene lugar la ionización por impacto, que, sin embargo, está fuertemente influenciada por el espesor de la capa de multiplicación y la concentración de dopaje para la capa de control de carga. El campo eléctrico muy fuerte se produce en la capa de multiplicación para permitir la ionización por impacto. El campo eléctrico puede terminar con la capa de control de carga debido a la mayor concentración de dopaje que contiene. Además, también encontramos que, al modular la banda de energía entre la capa de absorción y la capa de control de carga, podemos ajustar la capacidad de respuesta espectral. Una adopción razonable de una mesa biselada positiva puede lograr una reducción significativa en el campo eléctrico de la superficie de la pared lateral, lo que es útil para suprimir la corriente oscura y la ruptura de los bordes. Posteriormente se realizarán análisis y debates detallados.
Métodos de investigación y modelos físicos
La Figura 1a muestra la vista esquemática en sección transversal de un APD SACM 4H-SiC estándar empleado en este trabajo, que posee n + -capa de tipo 4H-SiC como sustrato. Luego, la pila arquitectónica comprende un p + de 3 μm de espesor -tipo capa ( N a =1 × 10 19 cm −3 ) que actúa como la capa de contacto óhmica de tipo p, una n - de 0,5 μm de espesor -tipo capa de multiplicación ( N d =1 × 10 15 cm −3 ) para la multiplicación de portadoras, una capa de control de carga de tipo n de 0,2 μm de espesor ( N d =5 × 10 18 cm −3 ) para terminar el proceso de ionización por impacto, y un espesor n - de 0,5 μm -tipo capa de absorción ( N d =1 × 10 15 cm −3 ) para absorber los fotones entrantes. En la parte superior de la estructura del dispositivo, hay un n + de 0,3 μm de espesor -tipo capa de contacto óhmico ( N d =1 × 10 19 cm −3 ). Un ángulo de bisel positivo ( θ =8 °) para que la estructura de mesa suprima la rotura del borde [22, 23]. El diámetro de los APD 4H-SiC SACM es de 800 μm. Tanto los contactos del cátodo como del ánodo se consideran contactos óhmicos ideales en nuestros cálculos. De acuerdo con la Fig. 1c yd, nuestros resultados ilustran que los resultados calculados para la estructura estándar de APD 4H-SiC SACM antes mencionada exhiben la corriente oscura de 2.5 nA / cm 2 , la tensión de ruptura de 161,6 V y la capacidad de respuesta máxima de 0,11 A / W a la longitud de onda de 280 nm. Las características de corriente-voltaje calculadas y la capacidad de respuesta para el APD SACM 4H-SiC estándar son consistentes con los datos experimentales. Esto prueba completamente que la ionización por impacto, el coeficiente de absorción del material 4H-SiC, la ecuación de Poisson, la ecuación de continuidad de la corriente y las ecuaciones de deriva-difusión utilizadas en este trabajo son razonables. Aquí, tomamos la estructura de la Fig. 1a como el punto de referencia de la investigación, mientras que las variables investigadas incluyen el ángulo de mesa biselado, el espesor y la concentración de dopaje para cada capa.
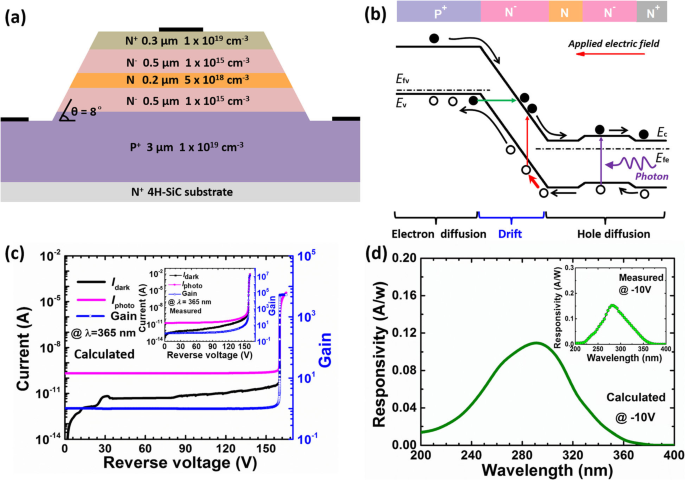
un Estructura esquemática en sección transversal (no dibujada a escala), b Diagrama esquemático de bandas de energía con polarización inversa para 4H-SiC SACM APD, c características de corriente-voltaje calculadas y la ganancia de multiplicación, y d características de respuesta espectral calculadas a la tensión inversa de 10 V para el APD estándar 4H-SiC SACM. Figura insertada en c muestra las características de corriente-voltaje medidas y la ganancia de multiplicación. Figura insertada en d muestra las características de respuesta espectral medidas para el APD SACM 4H-SiC estándar polarizado a - 10 V
Para comprender mejor el impacto de diferentes variables estructurales en las propiedades fotoeléctricas de los APD 4H-SiC SACM, la Fig. 1b muestra el diagrama esquemático de bandas de energía con polarización inversa. Los pares de agujeros de electrones fotogenerados en la capa de absorción se difundirán en la capa de multiplicación por medio de la capa de control de carga. Después de que los pares de huecos de electrones fotogenerados alcancen la región de multiplicación, serán separados por el campo eléctrico empobrecido. Luego, los agujeros experimentarán un proceso de multiplicación en la capa de multiplicación, lo que da lugar a una ganancia de corriente interna. Mientras tanto, los electrones fotogenerados volverán al cátodo y se convertirán en corriente sin experimentar ionización por impacto. Los factores importantes que influyen en la fotocorriente incluyen los perfiles de campo eléctrico en la capa de multiplicación, la alineación de la banda de energía en la capa de control de carga, la capa de absorción y la capa de contacto óhmico de tipo n, en la que cualquier barrera de energía puede obstaculizar el transporte del portador. También vale la pena señalar que los perfiles de campo eléctrico en la capa de multiplicación pueden determinarse mediante las concentraciones de dopaje tanto para la capa de multiplicación como para la capa de control de carga. Mientras tanto, el ángulo de mesa biselado también está sustancialmente asociado con la distribución del campo eléctrico. También prestaremos atención al espesor de cada capa para asegurar el proceso de difusión del portador de alta eficiencia. Por lo tanto, es importante estudiar sistemáticamente estos parámetros estructurales clave para optimizar el rendimiento del dispositivo.
Las investigaciones numéricas son realizadas por APSYS, que puede resolver ecuaciones de continuidad de corriente, ecuaciones de Poisson y ecuaciones de deriva-difusión de manera consistente con las condiciones de contorno adecuadas. Tanto la ionización por impacto como los procesos de tunelización Zener se han incluido en las ecuaciones de deriva-difusión. La dispersión de portador-portador para el proceso de transporte de portador también se ha incluido en el modelo de movilidad de campo bajo. Se supone que el tiempo de vida de la recombinación Shockley-Read-Hall (SRH) es de 1 µs [24]. Específicamente, el campo ( E ) dependencia de los coeficientes de ionización de impacto para electrones ( α n ) y agujeros ( β p ) para capas basadas en 4H-SiC pueden expresarse mediante las fórmulas de Chynoweth (1) y (2) de la siguiente manera, respectivamente [25]:
$$ {\ alpha} _n =1.98 \ times {10} ^ 6 \ exp \ left [- {\ left (\ frac {9.46 \ times {10} ^ 6} {E} \ right)} ^ {1.42} \ derecha] {\ mathrm {cm}} ^ {- 1} $$ (1) $$ {\ beta} _p =4.38 \ veces {10} ^ 6 \ exp \ left [- {\ left (\ frac {1.14 \ veces {10} ^ 7} {E} \ right)} ^ {1.06} \ right] {\ mathrm {cm}} ^ {- 1} $$ (2)El coeficiente de absorción (∂) en términos de diferentes longitudes de onda (λ) para material 4H-SiC se calcula mediante la siguiente ecuación. (3) [26]:
$$ \ partial =-790.3 + 18.2 \ uplambda -0.17 {\ uplambda} ^ 2 + 8.57 \ times {10} ^ {- 4} {\ uplambda} ^ 3-2.39 \ times {10} ^ {- 6} { \ uplambda} ^ 4 + 3.53 \ times {10} ^ {- 9} {\ uplambda} ^ 5-2.16 \ times {10} ^ {- 12} {\ uplambda} ^ 6 $$ (3)Los otros parámetros materiales utilizados en los modelos numéricos se pueden encontrar en otra parte [27]. Los cálculos se basan en el método de elementos finitos, que requiere que los usuarios ajusten correctamente las distribuciones de la malla para realizar cálculos precisos.
Resultados y discusiones
Impacto de los parámetros estructurales para la capa de contacto óhmico de tipo n en el rendimiento fotoeléctrico
Para probar el efecto del espesor y la concentración de dopaje para la capa de contacto óhmico de tipo n sobre el rendimiento fotoeléctrico, diseñamos el dispositivo de referencia, los dispositivos L1 a L4 y los dispositivos A1 a A4, respectivamente. Tenga en cuenta que el dispositivo de referencia es la estructura básica de SACM APD como se muestra en la Fig. 1a. Otros APD propuestos son idénticos al dispositivo de referencia, excepto la capa de contacto óhmico de SiC de tipo n, cuya información estructural detallada se presenta en la Tabla 1.
En primer lugar, mostramos el voltaje de ruptura en términos del grosor de la capa de contacto óhmico de SiC de tipo n en la Fig. 2a, es decir, los dispositivos L1 a L4. El recuadro de la Fig. 2a demuestra selectivamente la corriente oscura, la fotocorriente bajo la iluminación de 365 nm y la ganancia para el dispositivo L1. Para el dispositivo L1, el voltaje de ruptura es ~ 161,6 V y la densidad de corriente oscura permanece en el nivel de ~ 2,5 nA / cm 2 cuando la polarización es inferior a 161,6 V. Tenga en cuenta que el voltaje de ruptura se obtiene a la corriente de 10 −5 A. La corriente oscura aumenta cuando ocurre el proceso de ionización por impacto. El nivel de fotocorriente se vuelve alto en la región lineal cuando la iluminación de 365 nm brilla sobre el dispositivo, y esto muestra que la ganancia de multiplicación puede ser superior a 10 3 para el dispositivo L1 a la tensión inversa de 161,6 V. La tensión de ruptura de avalancha para los cinco APD investigados se resume en la Fig. 2a. De la Fig. 2a, podemos obtener que el espesor de la capa de contacto óhmico de tipo n tiene un efecto insignificante sobre el voltaje de ruptura. Para revelar el mecanismo subyacente de las observaciones, calculamos y mostramos la distribución del campo eléctrico vertical para el dispositivo de referencia y los dispositivos L1 a L4 en la Fig.2b, que ilustra que la capa de control de carga limita el límite para la región de agotamiento y el campo eléctrico en la capa de multiplicación. Por lo tanto, podemos especular que la capa de contacto óhmico de tipo n no afectará los perfiles del campo eléctrico en la capa de multiplicación y esto se demuestra en la Fig. 2b. Las observaciones en la Fig. 2b interpretan bien el voltaje de ruptura idéntico en la Fig. 2a para el dispositivo de referencia y los dispositivos L1 a L4. A continuación, mostramos la corriente fotogenerada para los cinco dispositivos en la Fig. 2c. Para una mejor resolución, recopilamos la corriente fotogenerada en el sesgo de 100 V que se muestra en el recuadro de la Fig 2c. Podemos ver que la corriente fotogenerada disminuye con el aumento del espesor de la capa de contacto óhmico de tipo n. Una capa de contacto óhmico de tipo n demasiado gruesa hará que los portadores fotogenerados tengan una recombinación no radiativa y, en consecuencia, reducirá la corriente de difusión. Con la corriente fotogenerada, podemos obtener la capacidad de respuesta espectral para el dispositivo de referencia y los dispositivos L1 a L4 al voltaje inverso de 100 V en la Fig. 2d. La longitud de onda de respuesta máxima para los cinco dispositivos investigados se centra en 280 nm. La capacidad de respuesta disminuye al aumentar el grosor de la capa de contacto de tipo n, lo que coincide con el recuadro de la Fig. 2c. Por lo tanto, resumimos aquí que el grosor de la capa de contacto óhmico de 4H-SiC de tipo n debe ser adecuadamente delgado para evitar el aumento de la recombinación no radiativa y la reducción de la corriente de difusión.

un Voltaje de ruptura, b Distribución vertical del campo eléctrico de los APD SACM polarizados a - 160 V, c características de fotocorriente-voltaje bajo iluminación de 280 nm, y d características de respuesta espectral de los APD SACM polarizados a - 100 V para dispositivos de referencia y dispositivos L1 a L4 con diferentes espesores de capa de contacto óhmico de tipo n, respectivamente. Figura insertada en a muestra las características de corriente-voltaje calculadas y la ganancia de multiplicación para el dispositivo L1. Figura insertada en c muestra la fotocorriente para el dispositivo de referencia y los dispositivos L1 a L4 polarizados a - 100 V
A continuación, investigamos el voltaje de ruptura en función de la concentración de dopaje en la capa de contacto óhmico de tipo n analizando el dispositivo de referencia y los dispositivos A1 a A4 en la Fig. 3a. El recuadro de la Fig. 3a presenta la corriente oscura, la corriente fotogenerada y la ganancia en términos de la polarización aplicada para el dispositivo A1. El voltaje de ruptura se define cuando la corriente alcanza 10 −5 A. Según la Fig. 3a, el voltaje de ruptura apenas depende de la concentración de dopaje en la capa de contacto óhmico de 4H-SiC de tipo n. Como se ha demostrado anteriormente, la capa de control de carga puede confinar eficazmente la región de agotamiento y el campo eléctrico en la capa de multiplicación. Por lo tanto, la variación de la concentración de dopaje en la capa de contacto óhmico de tipo n no afecta la distribución del campo eléctrico dentro del dispositivo [ver Fig. 3b]. Luego calculamos y mostramos la corriente fotogenerada en términos del sesgo aplicado para el dispositivo de referencia y los dispositivos A1 a A4 en la Fig. 3c. Puede verse en la Fig. 3c que la concentración de dopaje de la capa de contacto óhmico de tipo n tiene un efecto insignificante sobre la fotocorriente polarizada. La capacidad de respuesta espectral a diferentes longitudes de onda para los cinco dispositivos investigados se muestra en la Fig. 3d. Los datos se calculan al voltaje inverso de 100 V. La longitud de onda con una capacidad de respuesta máxima de ~ 0,11 A / W es de 280 nm. Siendo coherente con la Fig. 3c, la capacidad de respuesta depende menos de la concentración de dopaje en la capa de contacto óhmico de tipo n. Por lo tanto, concluimos que la capacidad de respuesta está más influenciada por el espesor que la concentración de dopaje para la capa de contacto óhmico de tipo n para los APD 4H-SiC SACM. También sugerimos aumentar la longitud de difusión del portador con el fin de mejorar la capacidad de respuesta.

un Voltaje de ruptura, b Distribución vertical del campo eléctrico de los APD SACM polarizados a - 160 V, c características de fotocorriente-voltaje bajo iluminación de 280 nm, y d características de respuesta espectral de los APD SACM polarizados a - 100 V para dispositivos de referencia y dispositivos A1 a A4 con diferente concentración de dopaje de capa de contacto óhmico de tipo n, respectivamente. Figura insertada en a muestra las características de corriente-voltaje calculadas y la ganancia de multiplicación para el dispositivo A1. Figura insertada en c muestra la fotocorriente para el dispositivo de referencia y los dispositivos A1 a A4 polarizados a - 100 V
Impacto de los parámetros estructurales de la capa de absorción en el rendimiento fotoeléctrico
En esta sección, se estudia el impacto del espesor y la concentración de dopaje de la capa de absorción sobre el rendimiento fotoeléctrico de los APD SACM basados en 4H-SiC. La información estructural detallada de la capa de absorción para los APD SACM se resume y se muestra en la Tabla 2. Los dispositivos M1 a M4 y los dispositivos B1 a B4 son estructuralmente idénticos al dispositivo de referencia excepto la capa de absorción. Los dispositivos M1 a M4 tienen diferentes espesores, mientras que los dispositivos B1 a B4 poseen varias concentraciones de dopaje para la capa de absorción.
Utilizando el dispositivo de referencia y los dispositivos M1 a M4, la figura 4a muestra el voltaje de ruptura en términos de diferentes espesores para la capa de absorción. Para fines de demostración, calculamos y presentamos la corriente oscura, la corriente fotogenerada y la ganancia en función de la polarización aplicada para el dispositivo M1 en el recuadro de la Fig. 4a. El voltaje de ruptura se recolecta cuando la corriente es 10 −5 A. Podemos ver que el voltaje de ruptura apenas depende del espesor de la capa de absorción. Se sabe que el voltaje de ruptura está fuertemente sujeto a la intensidad del campo eléctrico en la capa de multiplicación ligeramente dopada y, por lo tanto, la Fig. 4b muestra la distribución del campo eléctrico vertical para los cinco dispositivos estudiados en la polarización inversa de - 160 V. Las distribuciones de campo para el dispositivo de referencia y los dispositivos M1 a M4 son exactamente las mismas, lo que confirma la conclusión de la Fig. 4a. Posteriormente demostramos la corriente fotogenerada y la capacidad de respuesta en las Figs. 4c y d, respectivamente. Tanto la corriente fotogenerada [ver el recuadro de la Fig. 4c] como la capacidad de respuesta muestran la tendencia de disminución con el aumento del espesor de la capa de absorción. Para abordar aún más el mecanismo subyacente, también calculamos y mostramos la distribución de portadora dentro de la capa de multiplicación en la Fig. 4e cuando la polarización inversa es de 100 V para los cinco dispositivos investigados. Podemos ver que tanto los niveles de concentración de electrones como de huecos disminuyen con el aumento del espesor de la capa de absorción, lo que se atribuye a la recombinación no radiativa mejorada cuando la capa de absorción se vuelve gruesa. La recombinación no radiativa consume portadores, suprimiendo así la corriente de difusión y la capacidad de respuesta. Aquí, para evitar el consumo de portadores por recombinación no radiativa, sugerimos que la capa de absorción no puede ser demasiado gruesa para obtener APD 4H-SiC SACM con alta detectividad.

un Voltaje de ruptura, b Distribución vertical del campo eléctrico de los APD SACM polarizados a - 160 V, c Características de fotocorriente-voltaje bajo iluminación de 280 nm, d características de respuesta espectral y e Perfiles de concentración de portadores en la capa de multiplicación de los APD SACM polarizados a - 100 V para dispositivos de referencia y dispositivos M1 a M4 con diferentes espesores de capa de absorción, respectivamente. Figura insertada en a muestra las características de corriente-voltaje calculadas y la ganancia de multiplicación para el dispositivo M1. Figura insertada en c muestra la fotocorriente para el dispositivo de referencia y los dispositivos M1 a M4 polarizados a - 100 V
Además del grosor de la capa de absorción, la concentración de dopaje para la capa de absorción también tiene un impacto significativo en el rendimiento del dispositivo. Luego calculamos y mostramos el voltaje de ruptura para el dispositivo de referencia y los dispositivos B1 a B4 en la Fig. 5a. El voltaje de ruptura se define cuando la corriente es 10 −5 A como se muestra en el recuadro de la Fig. 5a. Puede verse en la Fig. 5a que la concentración de dopaje para la capa de absorción no tiene un efecto significativo sobre el voltaje de ruptura. Puede demostrarse además mediante las distribuciones de campo eléctrico unidimensionales verticales en la figura 5b, de manera que la concentración de dopaje para la capa de absorción no cambia significativamente los perfiles del campo eléctrico en la capa de multiplicación. También presentamos la corriente fotogenerada a la longitud de onda de 280 nm para los dispositivos estudiados en la Fig. 5c, que indica la corriente fotogenerada mejorada cuando aumenta la concentración de dopaje en la capa de absorción. De acuerdo con la Fig. 5c, la capacidad de respuesta dependiente de la longitud de onda en la Fig. 5d también se ve favorecida a medida que aumenta la concentración de dopaje para la capa de absorción, por ejemplo, el dispositivo B4.

un Voltaje de ruptura, b Distribución vertical del campo eléctrico de los APD SACM polarizados a - 160 V, c características de fotocorriente-voltaje bajo iluminación de 280 nm, y d características de respuesta espectral de los APD SACM polarizados a - 100 V para el dispositivo de referencia y los dispositivos B1 a B4 con diferente concentración de dopaje de la capa de absorción, respectivamente. Figura insertada en a muestra las características de corriente-voltaje calculadas y la ganancia de multiplicación para el dispositivo B1. Figura insertada en c muestra la fotocorriente para el dispositivo de referencia y los dispositivos B1 a B4 polarizados a - 100 V
Para mostrar el origen en profundidad de la capacidad de respuesta mejorada para el dispositivo B4, mostramos los perfiles de banda de energía para la capa de control de carga, la capa de absorción y la capa de contacto óhmico de tipo n para los dispositivos B1 y B4 en las Figs. 6a y b, respectivamente. Aquí, vale la pena mencionar que las concentraciones de dopaje para la capa de control de carga y la capa de contacto óhmico de tipo n son 5 × 10 18 cm −3 y 1 × 10 19 cm −3 , respectivamente. Por lo tanto, la concentración de dopaje más baja para la capa de absorción puede generar un campo eléctrico incorporado y crear las barreras de energía en las interfaces de la capa de control de carga / capa de absorción / capa de contacto óhmico de tipo n [28]. Las barreras de energía pueden retardar la difusión de los portadores fotogenerados en la capa de multiplicación. Un método muy conveniente que puede reducir las barreras es aumentar la concentración de dopaje en la capa de absorción. Como resultado, los valores efectivos de barrera de la banda de valencia ψ v para la capa de control de carga son 513 meV y 480 meV para los dispositivos B1 y B4, respectivamente. Se observa que el aumento de la concentración de dopaje para la capa de absorción promueve el transporte de los orificios fotogenerados [ver Fig. 6c]. La ionización del impacto se volverá fuerte una vez que se puedan inyectar más agujeros fotogenerados en la región de multiplicación, lo que da como resultado una mayor corriente fotogenerada y la capacidad de respuesta.
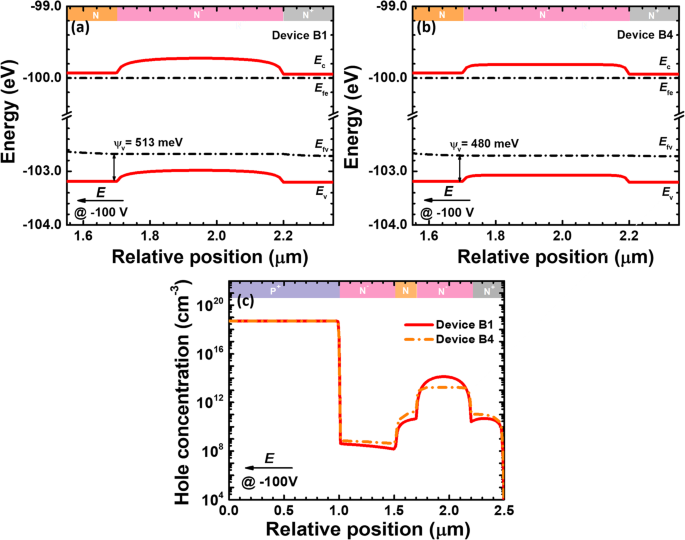
Diagramas de bandas de energía de la capa de control de carga, la capa de absorción y la capa de contacto óhmico de tipo n para a dispositivo B1 y b dispositivo B4, c Perfiles de concentración de agujeros con iluminación de 280 nm para los dispositivos B1 y B4. Los datos se calculan a la tensión inversa de 100 V
Impacto de los parámetros estructurales de la capa de control de carga en el rendimiento fotoeléctrico
Para probar el impacto del espesor y la concentración de dopaje de la capa de control de carga en el rendimiento fotoeléctrico, establecemos información arquitectónica diferente para la capa de control de carga como se muestra en la Tabla 3. Los dispositivos N1 a N4 y los dispositivos C1 a C4 son diferentes del dispositivo de referencia únicamente en la capa de control de carga. Se adoptan diferentes concentraciones de dopaje y espesores de capa para los dispositivos N1 a N4 y C1 a C4.
Como se mencionó anteriormente, el campo eléctrico que permite la ionización por impacto y la ruptura de la avalancha está confinado principalmente en la capa de multiplicación. El voltaje de ruptura en función del grosor de la capa de control de carga en la figura 7a infiere que el grosor de la capa de control de carga tiene un efecto muy leve sobre el proceso de multiplicación de portadoras. Esto se demuestra aún más mostrando la Fig. 7b. La Figura 7c demuestra la corriente fotogenerada en términos de la polarización aplicada para el dispositivo de referencia y los dispositivos N1 a N4. La corriente fotogenerada se vuelve baja una vez que aumenta el grosor de la capa de control de carga, lo que también traduce la menor capacidad de respuesta al aumentar el grosor de la capa de control de carga. También atribuimos a la recombinación no radiativa mejorada que consume portadores y suprime la corriente de difusión.

un Voltaje de ruptura, b Distribución vertical del campo eléctrico de los APD SACM polarizados a - 160 V, c características de fotocorriente-voltaje bajo iluminación de 280 nm, y d características de respuesta espectral de los APD SACM polarizados a - 100 V para dispositivos de referencia y dispositivos N1 a N4 con diferentes espesores de capa de control de carga, respectivamente. Figura insertada en a muestra las características de corriente-voltaje calculadas y la ganancia de multiplicación para el dispositivo N1. Figura insertada en c muestra la fotocorriente para el dispositivo de referencia y los dispositivos N1 a N4 polarizados a - 100 V
El papel de la capa de control de carga es confinar el campo eléctrico fuerte y el proceso de multiplicación de portadores dentro de la capa de multiplicación. Sin embargo, la anchura de la región de agotamiento puede extenderse más siempre que disminuya la concentración de dopaje en la capa de control de carga. Los perfiles de campo eléctrico pueden entonces afectar sustancialmente el voltaje de ruptura, la corriente fotogenerada, la ganancia y la capacidad de respuesta. Por lo tanto, diseñamos los dispositivos C1 a C4 en la Tabla 3. De acuerdo con la Fig. 8a, a medida que la concentración de dopaje disminuye, el voltaje de ruptura inicialmente permanece igual, y luego el voltaje de ruptura aumenta cuando la concentración de dopaje para la capa de control de carga es inferior a 2 × 10 18 cm −3 . El recuadro de la Fig. 8a indica que el voltaje de ruptura es ~ 315 V para el dispositivo C1 mientras que la corriente oscura también aumenta a 3.5 × 10 −11 A comparado con el del dispositivo N1. Para revelar el origen de las observaciones en la Fig. 8a, calculamos la distribución vertical del campo eléctrico en la Fig. 8b, que demuestra que el campo eléctrico se concentra principalmente en la capa de multiplicación para los dispositivos de referencia y los dispositivos C3 y C4. Sin embargo, el campo eléctrico y la región de agotamiento penetran en la capa de control de carga cuando la concentración de dopaje para la capa de control de carga es inferior a 2 × 10 18 cm −3 . La expansión de la región de agotamiento para los dispositivos C1 y C2 ayuda a reducir la intensidad del campo eléctrico y, por lo tanto, la tensión de ruptura aumenta correspondientemente para los dispositivos C1 y C2. El aumento del ancho de la región de agotamiento producirá más corriente de generación de carga espacial, lo que da como resultado un aumento de la corriente oscura, es decir, 3,5 × 10 - 11 A y 5 × 10 - 11 A para los dispositivos C1 y C2, respectivamente. Luego mostramos la corriente fotogenerada a la longitud de onda de 280 nm en la Fig. 8c. Las curvas de respuesta espectral polarizadas en 100 V a diferentes longitudes de onda para los cinco dispositivos investigados se ilustran en la figura 8d. Se obtiene una excelente concordancia entre las Figs. 8c yd, de manera que el aumento de la corriente fotogenerada da lugar a la capacidad de respuesta mejorada, es decir, los dispositivos C1 y C2. Other devices show similar photo-current level and the responsivity.

un Breakdown voltage, b vertical electric field distribution of the SACM APDs biased at − 160 V, c photocurrent biased at − 100 V, and d spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices C1 to C4 with different doping concentration of charge control layer, respectively. Inset figure in a shows the calculated current-voltage characteristics and the multiplication gain for device C1. Inset figure in c shows photocurrent-voltage characteristics for reference device and devices C1 to C4
As has been interpreted previously, the energy band barrier height at the interface of multiplication layer/charge control layer can soundly affect the carrier diffusion. Due to the expansion of the depletion region for devices C1 and C2, the electric field in the depletion region will annihilate the energy barrier at the interface of multiplication layer/charge control layer [e.g., the inset for device C1 in Fig. 9a]. Meanwhile, we observe the valence band barrier at the interface of multiplication layer/charge control layer for device C4 according to the inset for Fig. 9b. The energy barrier will correspondingly retard the hole diffusion into the multiplication layer from the charge control layer. We also selectively compute and show the hole concentration profiles for device C1 and C4 in Fig. 9c. Because the interface of multiplication layer/charge control layer for device C1 no longer hinders the injection of photo-generated holes into the multiplication layer, more holes are limited in the charge control layer and the absorption layer for device C4. As a result, the hole concentration in the multiplication layer for device C1 is higher than that for device C4. Thus, the enhanced photo-generated current and the responsivity for device C1 are obtained when compared with device C4.
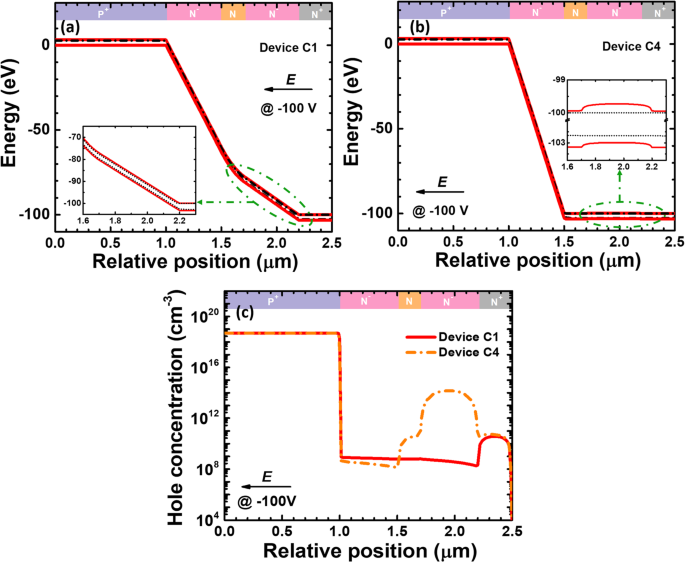
Energy band diagrams for a device C1 and b device C4, c hole concentration profiles for device C1 and C4. Data are calculated at the reverse voltage of 100 V. Insets for a y b show the local energy band diagrams for multiplication layer/charge control layer for devices C1 and C4, respectively
Impact of the Structural Parameters for the Multiplication Layer on the Photoelectric Performance
The impact ionization and the carrier multiplication process take place in the multiplication layer, making the design for the multiplication layer essentially vital for 4H-SiC SACM APDs. Therefore, we look into the impact of the thickness and doping concentration for the multiplication layer on the photoelectric performance for SACM APDs. The detailed structural information of the multiplication layer for different SACM APDs are summarized and presented in Table 4. The only difference for the devices in Table 4 lies on the multiplication layer.
As Fig. 10a presents, the breakdown voltage is enhanced from 110 to 210 V when the multiplication layer thickness is increased from 0.3 to 0.7 μm. For the purpose of demonstration, the inset of Fig. 10a demonstrates the current in terms of the voltage for reference device and devices P1 to P4. This indicates that a thick multiplication layer helps to reduce the electric field intensity [see Fig. 10b] and increase the breakdown voltage. We then show the photo-generated current for the five devices in Fig. 10c. The photo-generated current increases slightly with increasing the thickness of the multiplication layer for devices P2 to P4, except that device P1 has the highest photocurrent. The spectral responsivity characteristics for the five investigated devices at the reverse voltage of 100 V are provided in Fig. 10d. The peak responsivity for reference device and devices P2 to P4 improves slightly as the thickness of the multiplication layer increases, and this is because the number of carriers generated by impact ionization increases when the depletion region width increases. Note that device P1 with the thinnest multiplication layer owns the highest peak responsivity at the wavelength of 280 nm. This is because the − 100 V applied voltage is close to Geiger mode for device P1, and the avalanche gain is more likely to occur than that for other devices.

un Breakdown voltage, b vertical electric field distribution of the SACM APDs biased at − 160 V, c photocurrent biased at − 100 V, and d spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices P1 to P4 with different thicknesses of multiplication layer, respectively. Inset figure in a shows the calculated current-voltage characteristics for reference device and devices P1 to P4. Inset figure in c shows photocurrent-voltage characteristics under 280 nm illumination for reference device and devices P1 to P4
Then, we show the breakdown voltage in terms of the multiplication layer doping concentration for reference device and devices D1 to D4 in Fig. 11a. It seems that when the doping concentration for the multiplication layer is lower than 10 16 cm −3 , the breakdown voltage is less affected. We believe the breakdown voltage can be significantly decreased if the doping concentration in the multiplication layer exceeds 10 18 cm −3 . The dark current as a function of the applied bias for the five APDs are shown in the inset of Fig. 11a. The dark current increases with increasing doping concentration of the multiplication layer due to the enhanced space charge generation in the depletion region. Therefore, for the purpose of significantly decreasing the dark current and promoting the carrier multiplication process, we rarely have the multiplication layer heavily doped. Then, we calculate the vertical one-dimensional electric field profiles for the five studied devices, which are demonstrated in Fig. 11b. We can see that the electric field profiles of the five devices are mainly confined in the multiplication layer. In addition, Figs. 11c and d demonstrate the photo-generated current and the wavelength-dependent responsivity for the five devices. We can see that the photo-generated current for reference device and devices D1 and D2 are almost the same under the 280 nm illumination, while that the photon-generated current for the devices D3 and D4 is slightly increased. Therefore, the responsivity at the wavelength of 280 nm in Fig. 11d for devices D3 and D4 is slightly higher than the others.

un Breakdown voltage, b vertical electric field distribution of the SACM APDs biased at − 160 V, c photocurrent-voltage characteristics under 280 nm illumination, and d spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices D1 to D4 with different doping concentration of multiplication layer, respectively. Inset figure in a shows the calculated current-voltage characteristics for reference device and devices D1 to D4. Inset figure in c shows photocurrent for reference device and devices D1 to D4 biased at − 100 V
Impact of the Beveled Mesa Angle on the Photoelectric Performance
In order to eliminate premature breakdown and suppress leakage current that are caused by the junction termination, positive beveled mesas with a small inclination angle are usually adopted when fabricating 4H-SiC APDs [13,14,15,16, 18]. However, the angles of the positive beveled mesa adopted in previous reports are various. Thus, to get systematic insight into the influence of different mesa inclination angles on the electric field profiles for 4H-SiC SACM APDs, we design the devices that are shown in Table 5.
We firstly calculate and show the dark current-voltage characteristics for the six investigated devices with the various bevel angles in Fig. 12a. We can see that the dark current increases as the positive beveled angle becomes large [see Fig. 12a]. The breakdown voltages for the investigated devices are ~ 161.6 V except that device E5 is slightly less than 161.6 V. The premature breakdown is observed as the beveled mesa angle increase in the dark condition. Meanwhile, we calculate and show photo-generated current in terms of the applied bias for reference device and devices E1 to E5 in Fig. 12b. We also see that the photo-generated current also increases as the positive bevel increases according to the inset for Fig. 12b. The premature breakdown is also observed as the beveled mesa angle increase in Fig. 12b. Therefore, the responsivity of solar-blind waveband at − 100 V slightly enhances as the positive bevel angle increases according to Fig. 12c.
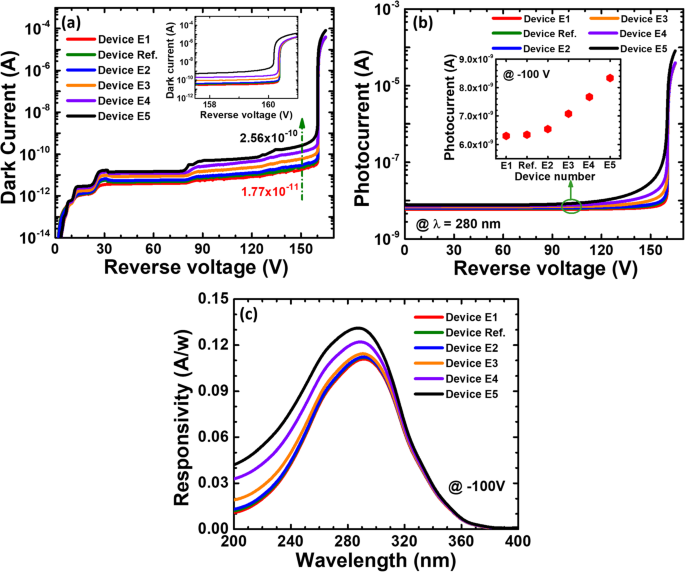
un Numerically calculated dark current-voltage characteristics, b photocurrent-voltage characteristics under 280 nm illumination, and c spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices E1 to E5, respectively
To reveal the origin for the observations in Figs. 12a and b, we calculate the lateral electric field distribution in the multiplication layer at the reverse bias of − 100 V in Fig. 13a, which demonstrates that, when the beveled mesas are utilized, the electric field decreases from the mesa center to the mesa edge. Moreover, the edge electric field intensity drops as the angle further decreases for the investigated devices. As has been mentioned, the junction termination will cause a large number of surface imperfections, which may cause the premature breakdown and the strongly leakage current, and the adopting of the beveled mesa shifts the premature breakdown from the mesa surface to the bulk [29]. Moreover, to get a full picture for the electric field profiles, the two-dimensional electric field distributions at the reverse bias of − 100 V for reference device and devices E1 to E5 are presented in Figs. 13b-g. We can see that the area of the high electric field in the entire multiplication layer gets narrowed, and this simultaneously causes the carriers that regenerated by impact ionization to decrease. As can be seen from Table 6, as the beveled mesa angle decreases, the surface electric field at the relative position of 700 μm decreases from 2.03 × 10 6 V/cm to 2.90 × 10 5 V/cm. As a result, the surface leakage and bulk leakage can be further suppressed as the beveled mesa angle get further decreased as shown in Fig. 12a. Although a small beveled mesa angle is preferred, this sacrifices the active detection area for APDs, and therefore, the responsivity is the lowest for device E1 according to Fig. 12c. Thus, one shall properly optimize beveled mesa angles depending on the crystalline quality for the 4H-SiC epitaxial layers and the surface conditions after junction termination. The suggested beveled angle in this works is in the range of 10–20°.
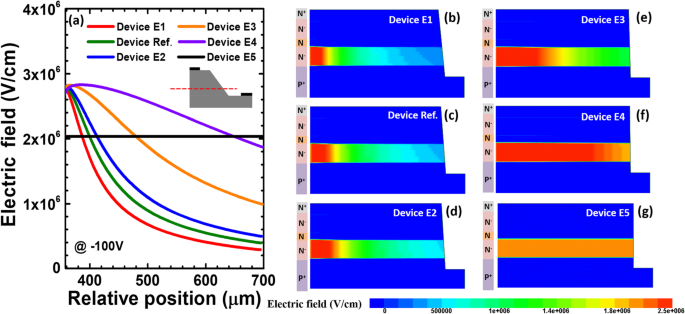
un Lateral electric field distribution of the multiplication layer at − 100 V, and numerically calculated two-dimensional electric field distribution at − 100 V for b device E1, c reference device, d device E2, e device E3, f device E4 and g device E5
Conclusiones
To summarize, we have numerically investigated and demonstrated the impact of the thickness and doping concentration of each layer on photoelectric performance for 4H-SiC SACM APDs. The obtained conclusions are as follows:(1) for n-type ohmic contact layer with a properly high doping concentration (N d ≈ 1 × 10 19 cm −3 ) to enable ohmic contact, the thickness and doping concentration hardly affect the breakdown voltage. Nevertheless, the responsivity decreases as the thickness of the n-type ohmic contact layer increases. The thickness shall be controlled to about 0.2 μm; (2) the doping concentration for the absorption layer is vitally important, which can modulate the photo-generated carrier transport and affect the responsivity. The doping concentration is generally controlled at the intrinsic concentration (N d ≈ 1 × 10 15 cm −3 ); (3) the doping concentration for the charge control layer regulates the electric field distribution and affects the depletion region width for 4H-SiC SACM APDs. The depletion region width increases as the doping concentration of the charge control layer decreases. According to our results, when the doping concentration is about 1 × 10 18 cm −3 , the depletion region can be completely terminated by the charge control layer; (4) the breakdown voltage can be strongly affected by the thickness of multiplication layer which is the main support region of the electric field. The dark current is sensitive to the doping concentration of multiplication layer, and a low doping concentration for the multiplication layer is required, since the doping concentration therein influences the space charge generation current. Thus, the suggested doping concentration in this works is intrinsic concentration (N d ≈ 1 × 10 15 cm −3 ); (5) we also point out the advantage of beveled mesa for 4H-SiC SACM APDs, and the optimized beveled mesa angles shall be a compromise among the active detection area, the surface conditions for the mesa, and the crystalline quality for 4H-SiC epitaxial films. This work indicates that the optimum beveled mesa angle is in the range of 10–20°. We strongly believe that this work provides the physical insight for the device physics and hence the findings in this work are very important for 4H-SiC-based SACM APDs.
Disponibilidad de datos y materiales
Los datos y el análisis del trabajo actual están disponibles a través de los autores correspondientes previa solicitud razonable.
Abreviaturas
- AlGaN:
-
Aluminum gallium nitride
- APSYS:
-
Modelos físicos avanzados de dispositivos semiconductores
- MSM:
-
Metal-semiconductor-metal
- SACM:
-
Separated absorption charge and multiplication
- SiC:
-
Silicon carbide
- SRH:
-
Shockley-Read-Hall
- UV APD:
-
Avalanche ultraviolet photodiode
Nanomateriales
- Arreglando una estrategia de mantenimiento rota:optimización de MP y AMFE
- Demostración de un biosensor flexible basado en grafeno para la detección rápida y sensible de células de cáncer de ovario
- Tecnologías avanzadas de deposición de capas atómicas para micro-LED y VCSEL
- Ingeniería del proceso de recubrimiento por inmersión y optimización del rendimiento para dispositivos electrocrómicos de tres estados
- Metasuperficies dieléctricas de alto orden para divisores de haz de polarización de alta eficiencia y generadores de vórtices ópticos
- Mejora de la absorción y modulación de frecuencia del microbolómetro THz con estructura de micropuente mediante antenas de tipo espiral
- Diodos emisores de luz ultravioleta basados en AlGaN casi sin caída de eficiencia con una capa de bloqueo de electrones tipo p de superrejilla diseñada específicamente para una alta eficiencia de…
- Cinética de la carga de dirección de los fotocatalizadores de niobato de estaño:funciones clave de la estructura de fase y la estructura electrónica
- En la capa de difusión de corriente p-AlGaN / n-AlGaN / p-AlGaN para diodos emisores de luz ultravioleta profunda basados en AlGaN
- Materiales y diseño de PCB para alta tensión
- Maquinaria VMC para producción y eficiencia



