Fiabilidad mejorada de los TFT a-IGZO con un tamaño de característica reducido y una estructura de capa limpia Etch-Stopper
Resumen
Los efectos del Cu + difuso en transistores de película delgada (TFT) amorfos de indio-galio-óxido de zinc (a-IGZO) sobre la microestructura y el rendimiento durante un proceso de tapón de grabado limpio (CL-ES) y un proceso de grabado de canal trasero (BCE) se investigan y comparan . La capa CL-ES formada con un componente limpio, según lo verificado por TOF-SIMS, puede proteger la capa a-IGZO del grabador S / D y prevenir Cu + difusión, que ayuda a reducir el número de defectos de tipo aceptador y mejora la fiabilidad de los TFT. Los TFT fabricados con estructura CL-ES tienen una estabilidad de salida superior (final I ds / inicial I ds =82,2%) en comparación con los TFT estructurados con BCE (53,5%) porque tienen un mejor valor SS inicial (0,09 V / dec vs 0,46 V / dec) y un mejor valor SS final (0,16 V / dec vs 0,24 V / dec) después de la evaluación de alta tensión de corriente (HCS). En particular, la variación en los voltajes de umbral tiene una gran diferencia (3,5 V para los TFT CL-ES y 7,2 V para los TFT BCE), lo que significa que los TFT estructurados CL-ES tienen una confiabilidad más alta que los TFT estructurados BCE. TFT. Por lo tanto, se espera que el proceso CL-ES promueva la aplicación generalizada de la tecnología a-IGZO en la industria de los semiconductores.
Antecedentes
Recientemente, los productos de visualización han enfatizado no solo áreas grandes y altas resoluciones, sino también diseños exteriores estéticamente agradables [1, 2, 3]. Se han adoptado biseles estrechos como una de las características vitales para este énfasis de diseño [4]. Para darse cuenta de esto, es esencial integrar los circuitos principales que impulsan la pantalla en el panel. Gate drive IC on array (GOA) es un método relativamente simple y de uso común, donde la señal de la puerta ingresa al panel una línea tras otra y el V en se mueve secuencialmente cada vez. GOA tiene múltiples ventajas, como un menor costo (eliminación de los costos G-IC, eliminación del proceso de unión G-IC, mayor utilización del sustrato de vidrio, etc.) y efecto estético (biseles estrechos o dispositivos sin bordes) [5]. Sin embargo, a diferencia de los TFT de píxeles individuales, los TFT GOA requieren condiciones de confiabilidad más estrictas para lograr una corriente de salida más alta y un rendimiento de tiempo más prolongado. Con el reciente aumento de las demandas del mercado de productos de alta resolución, la mejora de la confiabilidad del rendimiento de GOA se ha vuelto urgente y necesaria [6].
El óxido amorfo de indio-galio-zinc (a-IGZO) se usa ampliamente en la industria de las pantallas debido a su alta movilidad de electrones de saturación (5 ~ 10 cm 2 / V s) y baja corriente de inactividad (<1 pA) [7, 8]. La tecnología de grabado de canal posterior (BCE) se utiliza comúnmente para la producción de TFT en la industria [9, 10]. Los TFT a-IGZO estructurados con BCE tienen características satisfactorias para los TFT de píxeles individuales y la reducción de tamaño de los TFT GOA. Sin embargo, algunas características clave de TFT, en particular la estabilidad de la corriente de salida, no pueden satisfacer el entorno de alta tensión de corriente (HCS) requerido para los TFT GOA [11,12,13], principalmente debido a dos características del proceso BCE [14]. La primera es que la superficie de una película a-IGZO (canal posterior de a-IGZO TFT) está expuesta a grabadores S / D, que tradicionalmente consisten en HNO 3 , H 3 PO 4 y CH 3 COOH, que tiene una velocidad de grabado rápida que no es controlable para las películas a-IGZO [15]. Un H 2 suave O 2 El grabador a base de ácido con grabado estable y daño mínimo a las películas a-IGZO se puede utilizar para el grabado del electrodo S / D (metal Cu), pero el daño a la superficie de la película a-IGZO sigue siendo inevitable [16]. En segundo lugar, el contacto directo del metal S / D (Mo / Cu / Mo) con la película a-IGZO puede contaminar el canal posterior de TFT [17]. Afortunadamente, un proceso de tapón de grabado limpio (CL-ES), que es menos complicado y costoso y minimiza la contaminación, se puede utilizar para fabricar TFT basados en a-IGZO con uniformidad y estabilidad mejoradas para pantallas de gran superficie [18]. Aunque el TFT con estructura CL-ES muestra un rendimiento mejorado, las preguntas de cómo reaccionará el grabador con la película a-IGZO y cómo Cu + la difusión en películas a-IGZO afecta la microestructura y el rendimiento de los dispositivos sigue sin estar claro.
En este estudio, los TFT a-IGZO GOA con un tamaño de característica reducido y una estructura de canal trasero limpio se fabricaron mediante un proceso CL-ES mediante grabado por lotes de a-IGZO / Mo / Cu / Mo multicapa. Además, la influencia del grabador y Cu + La difusión de la microestructura y el rendimiento de los dispositivos a-IGZO GOA TFT con estructura CL-ES se estudian y se comparan con los de los dispositivos a-IGZO GOA TFT con estructura BCE. Más importante aún, la capa de tapón de grabado del dispositivo CL-ES sirve como la capa de protección de grabado S / D, así como la capa de Cu + capa de barrera de difusión, que ayuda a reducir la cantidad de defectos y mejorar la confiabilidad de la alta tensión de corriente confiabilidad, valores de SS, alta tensión de corriente y variaciones de voltaje de umbral, etc. El rendimiento de los TFT con estructura CL-ES está altamente correlacionado con su estructura CL-ES y sus componentes limpios y confirma que el proceso CL-ES podría ser una ruta eficiente para la producción en masa de pantallas con un rendimiento satisfactorio.
Métodos experimentales
Fabricación de TFT a-IGZO GOA
Los dispositivos a-IGZO TFT con estructura CL-ES se fabricaron mediante un proceso CL-ES modificado de cinco pasos (Fig. 1), como se informó en nuestro trabajo anterior [15]. Primero, el electrodo de puerta se formó con metal Mo / Cu y el aislante de puerta se depositó con una doble capa de SiNx / SiOx (3000 Å / 1000 Å) usando PECVD a 340 ° C. En segundo lugar, se depositó una película de a-IGZO de 300 Å utilizando pulverización catódica reactiva con magnetrón de CC a temperatura ambiente con una presión parcial de oxígeno del 15%. Se depositó una capa de tapón de grabado (SiOx, ESL) de 1000 Å usando PECVD a 240 ° C y se grabó reactivamente con CF 4 plasma para modelar, utilizando la máscara de fotolitografía activa del proceso BCE como máscara de grabado. Para este paso, la película a-IGZO debajo de los patrones de la capa ES se protegió de la exposición al CF 4 plasma, mientras que el resto de la película a-IGZO, no protegida por los patrones de la capa ES, tampoco se grabó, sino que se convirtió en una película conductora. En tercer lugar, los electrodos de fuente-drenaje (S / D) (capas triples de Mo / Cu / Mo) se depositaron por pulverización catódica y se grabaron utilizando un H 2 O 2 grabador que contiene 0,2% en peso de un aditivo de fluoruro, con la máscara de fotolitografía S / D y el patrón de capa ES sirviendo como máscara de grabado. Cuarto, se depositó una capa de pasivación de 3000 Å. Los procesos posteriores fueron similares a los de la fabricación típica de un panel posterior de LCD TFT.

Proceso de fabricación del a-IGZO GOA TFT
A modo de comparación, los dispositivos TFT a-IGZO estructurados con BCE se fabricaron utilizando el proceso BCE convencional y la misma máscara BCE.
Caracterización
Las morfologías, microestructuras y composiciones de las muestras se caracterizaron mediante SEM (Camscan Mx2600FE), espectroscopía de fotoelectrones de rayos X (XPS, PHI Quantera II) y espectrometría de masas de iones secundarios de tiempo de vuelo (IONTOF, TOF-SIMS 5). . Las mediciones eléctricas se llevaron a cabo utilizando un analizador de características de semiconductores (Keysight 4082A) en un ambiente oscuro y a 60 ° C. Para simplificar, la confiabilidad de HCS se evaluó durante más de 1000 s con V gs a 25 V y V ds a 25 V. Durante la evaluación, se controló el estado del GOA TFT midiendo el I ds actual a intervalos de 1 s, y la tendencia del I ds se analizó la corriente. El yo d -V g Las características de transferencia también se monitorearon a intervalos de 100 s.
Resultados y discusión
El dispositivo GOA TFT, que contiene canales TFT y componentes de compuerta, drenaje y fuente, fabricados por el proceso CL-ES, se muestra en la Fig. 2. Para medir con precisión cada característica TFT, todos los TFT se desconectaron usando un láser, por lo tanto volverse independientes, de modo que la puerta, la fuente y el drenaje no puedan compartir un nodo con ningún otro TFT. Como está marcado por la línea roja en la Fig. 2, este TFT tiene un diseño estructural GOA multicanal y separado, con un ancho y largo de canal de 120 μm y 10 μm, respectivamente, para conveniencia de las mediciones eléctricas. Este TFT también está diseñado para tener un nivel promedio de flujo de corriente a los canales TFT individuales colocando una pieza flotante de metal (ubicada en el medio de los canales), que integra cada canal. Antes de la evaluación de la confiabilidad del HCS, la confiabilidad de la operación separada se confirma primero evaluando la interferencia eléctrica del TFT de interés de los otros TFT periféricos. En este caso, el I desactivado La corriente de ruido de los TFT GOA separados se mide en 3 pA (inserte la curva en la Fig. 2), lo que confirma que no hay interferencia eléctrica de los otros dispositivos constituyentes del GOA en las cercanías.
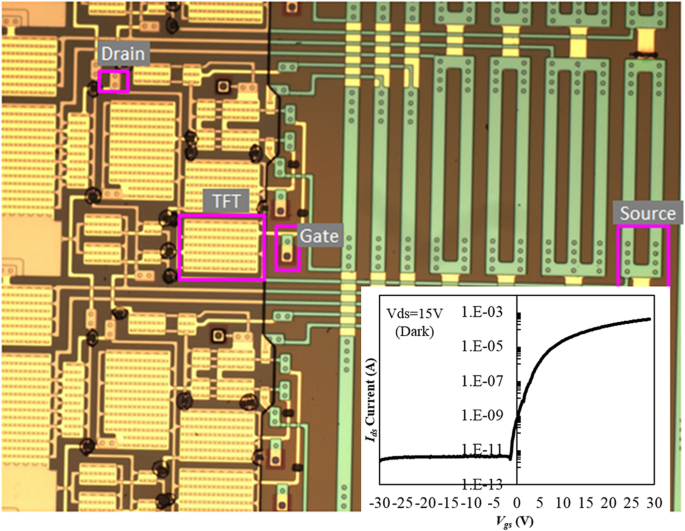
Fotografías de los TFT de GOA separados eléctricamente de los circuitos de GOA (insertar: I desactivado corriente de ruido entre el TFT de interés y los otros TFT periféricos)
Se miden y comparan varios tamaños de características de los TFT estructurados en CL-ES y los TFT estructurados en BCE. Para los TFT con estructura CL-ES (Fig. 3a), el ancho y la longitud son 4 μm y 6 μm, respectivamente, similares a los de los TFT a-IGZO estructurados con BCE en la Fig. 3b. Generalmente, el proceso BCE es deseable para la fabricación de TFT de óxido debido a su pequeño tamaño de característica. Por lo tanto, los TFT con estructura CL-ES obtenidos muestran un tamaño de característica reducido y un grado de integración tan alto como los TFT con estructura BCE. Además, el tamaño de la sección transversal de los TFT con estructura CL-ES es similar al de los TFT con estructura BCE (Fig.3c, d), mientras que los TFT con estructura CL-ES muestran una capa ES distinta que no se observa. en los TFT de BCE. El proceso CL-ES forma principalmente patrones ES, mientras que el proceso de grabado por lotes en a-IGZO / Mo / Cu / Mo multicapa se puede llevar a cabo con máscaras similares para los patrones activos y electrodos fuente-drenaje como los del proceso BCE. Por lo tanto, a excepción de los patrones ES, el número de máscaras fotolitográficas utilizadas en el proceso CL-ES es el mismo que para el proceso BCE. Este proceso CL-ES puede evitar el mayor número de máscaras del proceso ESL convencional y tiene un tamaño de característica reducido, lo que lo hace económicamente viable para la producción en masa. Además, sin usar la exposición de medio tono, un procedimiento de simplificación del proceso que se usa convencionalmente en la industria de TFT LCD, se reducen la complicación del proceso y el costo de fabricación.
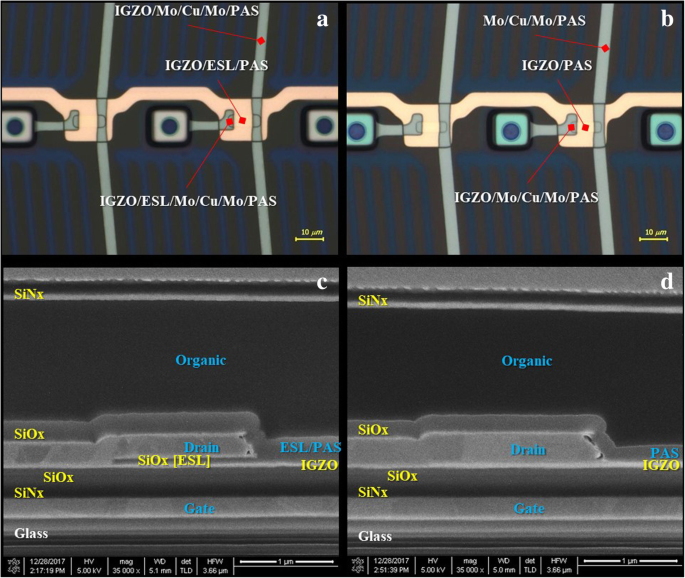
Imágenes SEM de los TFT a-IGZO: a Vista superior de TFT con estructura CL-ES, b Vista superior de TFT con estructura BCE, c Vista transversal de TFT con estructura CL-ES y d Vista transversal de TFT con estructura BCE
Para seguir observando los defectos superficiales de los TFT estructurados con BCE durante el proceso de fabricación de BCE, la composición de la superficie de las películas a-IGZO antes del recocido (muestra 1), después del recocido (muestra 2) y después de la exposición al H 2 O 2 El grabador de Cu (muestra 3) se estudia mediante XPS. En los espectros completamente escaneados de las películas a-IGZO (Fig. 4a-c), existen picos para los elementos In, Ga, Zn, O y C durante el proceso de fabricación de BCE. Como se muestra en la Fig.4d, aunque el TFT estructurado con BCE no muestra cambios significativos en la composición de las películas a-IGZO antes del recocido (muestra 1) y después del recocido a 330 ° C durante 1 h (muestra 2), se producen cambios significativos observado después de la exposición a productos químicos húmedos (muestra 3). En particular, el zinc, que tiene una energía de unión con oxígeno relativamente baja, se encuentra en 4.82% en la muestra 1 y 5.42% en la muestra 2, pero ha disminuido a 3.16% en la muestra 3. El indio tiene una variación mínima en las composiciones entre los diferentes procesos, y el cambio porcentual relativo de Zn con respecto a In es tremendo, a saber, 44,1%, 46,0% y 27,6% para las muestras 1, 2 y 3, respectivamente. Esto es similar para el galio, que también tiene una fuerte afinidad de unión con el oxígeno. En otras palabras, durante el proceso de grabado en húmedo, se produjeron defectos no deseados, incluida una pérdida sustancial de Zn y Ga, en la superficie posterior expuesta del semiconductor de óxido. Las razones de este fenómeno pueden estar relacionadas con sus diferentes energías de unión al oxígeno y las diferentes estructuras moleculares de la película a-IGZO [19].

Análisis XPS de la composición superficial de las películas delgadas a-IGZO a antes del recocido, b después del recocido y c después de la exposición al H 2 O 2 Cu etchant durante el proceso BCE. d Porcentajes atómicos correspondientes para el proceso anterior
Es bien sabido que la resistencia química de las películas a-IGZO a los agentes decapantes ácidos es muy débil [20]. En particular, la pérdida abrupta de Zn, que se cree que determina la estructura molecular de a-IGZO, provoca un debilitamiento de la estructura superficial de las películas de a-IGZO. Además, la reducción de Ga, que suprime la generación de portadores a través de su fuerte energía de enlace con el oxígeno, puede aumentar la probabilidad de desarrollar vacantes de oxígeno [Vo] [21]. Por lo tanto, los TFT GOA estructurados con BCE no pueden evitar grabar daños en el canal posterior de TFT, incluso en un H 2 relativamente leve. O 2 grabador de Cu a base de.
Para confirmar la protección de la capa ES, se estudia la composición de la región del canal a-IGZO TFT utilizando TOF-SIMS para muestras preparadas mediante los procesos BCE y CL-ES (clean etch stopper) (Fig. 5). Desde Cu + en la película a-IGZO puede producir defectos de tipo aceptor y atrapar electrones, el canal TFT a-IGZO debe estar limpio para mejorar la estabilidad eléctrica. Como se observó, el Cu + El pico detectado en la muestra BCE es 20 veces mayor que el de la muestra CL-ES. Además, la región de detección de Cu + se superpone con la región de detección de Zn + y Ga + en gran medida (Fig. 5a). Estos resultados indicaron que las películas a-IGZO en los TFT estructurados con BCE están contaminadas por Cu + debido al contacto directo de la película a-IGZO en la región del canal posterior de TFT con el metal Cu. Para los TFT con estructura CL-ES (Fig. 5b), Cu + sólo se detecta en la región ES, lo que indica que se evita el contacto directo de la región del canal a-IGZO TFT con el metal Cu. Sorprendentemente, una cantidad considerable de Zn + aparece en la ESL. El Zn + difuso es causado por las condiciones más altas del plasma previo al tratamiento y las condiciones de presión durante la deposición de ESL. Por lo tanto, la capa ES en los TFT con estructura CL-ES es esencial para mejorar la estabilidad eléctrica al evitar daños superficiales y la contaminación de las películas a-IGZO.

Análisis TOF-SIMS de las regiones de canal de a-IGZO TFT fabricados a través de a el BCE y b los procesos CL-ES
La evaluación de alta tensión de corriente (HCS) para los TFT GOA a-IGZO estructurados en CL-ES y BCE se muestra en la Fig. 6a. Para los mismos tamaños de características, el I inicial ds La corriente del TFT con estructura CL-ES es 429 μA, que es más alta que la del TFT con estructura BCE (343 μA). Después de la evaluación de HCS durante 1000 s, el I ds La corriente del TFT con estructura CL-ES es de 352 μA, aproximadamente el 82,2% de su valor inicial. En contraste, el I ds La corriente residual del TFT con estructura BCE ha disminuido a 183 μA y solo mantiene el 53,5% de su valor inicial. Además, según lo evaluado por extrapolación (Fig. 6b), el I ds Se espera que la corriente residual del TFT con estructura CL-ES sea de 302,6 μA, manteniendo el 70,5% de su valor inicial después de 10.000 s. Para el TFT estructurado por BCE, el I ds la corriente residual disminuye bruscamente a 111,7 μA, manteniendo solo el 33,7% de su valor inicial. Por lo tanto, bajo las mismas características de salida, el grado de integración para el GOA TFT fabricado mediante el proceso CL-ES puede incrementarse hasta en un 271% en comparación con el del proceso BCE.
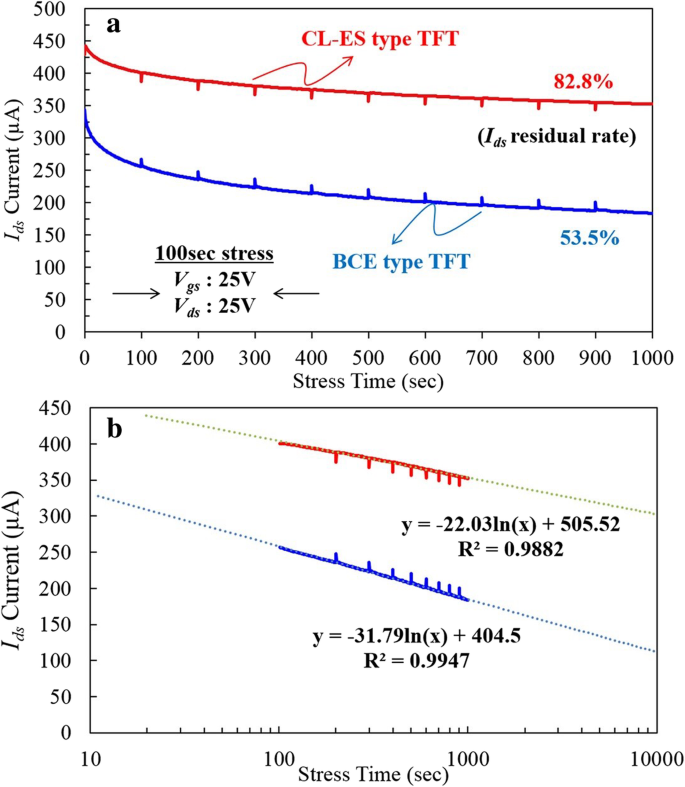
un Datos experimentales de 1000 sy b extrapolación para la evaluación de HCS a largo plazo de los TFT de GOA estructurados en CL-ES y BCE
Además, el I - V También se miden las características de transferencia de los TFT GOA con estructura CL-ES y BCE durante la evaluación de confiabilidad de HCS (Fig. 7 y Tabla 1). Para TFT con estructura CL-ES (Fig. 7a), el voltaje de umbral es 0.0 V en la evaluación inicial de HCS (25 ° C) y 3.5 V después de la evaluación de HCS a 60 ° C durante 1000 s. Además, el voltaje de umbral cambia continuamente en la dirección positiva con un cambio total ( ΔV th ) de 3,5 V. El valor de oscilación por debajo del umbral (SS) aumenta ligeramente de 0,09 a 0,16 V / dec. Para el TFT con estructura BCE, el voltaje de umbral es mucho más alto, es decir, 4.0 V a 25 ° C, y aumenta a 11.2 V después de la evaluación de HCS a 60 ° C durante 1000 s. Una posible razón de estos altos voltajes de umbral es la difusión de Cu + en la película a-IGZO durante el proceso de grabado en húmedo del proceso BCE. Cu + puede actuar como sitios de defectos de tipo aceptor en películas a-IGZO y una alta densidad de Cu + puede atrapar una gran cantidad de electrones. Los electrones atrapados generan un potencial culómbico filtrado que da como resultado el fenómeno de cambio de voltaje de umbral transitorio. Generalmente, el volumen del aislante de la puerta y los sitios de defectos recién formados dentro de la mayor parte de las películas a-IGZO pueden aumentar el valor SS de los TFT [11]. Estos resultados explican claramente la disminución del I ds corriente residual en los TFT estructurados con BCE. Sin embargo, el valor SS del TFT con estructura BCE muestra una tendencia a disminuir de 0,46 a 0,24 V / dec. Este valor de SS decreciente es el resultado de la acumulación de electrones cerca de la interfaz a-IGZO, después de lo cual el aislador de la puerta puede llenar rápidamente los altos niveles de los sitios de trampa de tipo aceptor que existían inicialmente. Además, los sitios de las trampas se llenan más rápido de lo que genera el HCS y, por lo tanto, el número de electrones atrapados disminuye gradualmente con el tiempo. Esto concuerda con el comportamiento de cambio positivo del voltaje umbral.

yo - V características de transferencia medidas durante la evaluación de HCS de un el CL-ES y b los TFT GOA estructurados por BCE. Comportamiento de c la tensión de umbral y d la oscilación del sub-umbral a intervalos de 1000 sy V ds =15 V. Las medidas iniciales del I d -V d características de salida para e el CL-ES- y f los TFT GOA estructurados en BCE con V gs =0, 5, 10, 15 y 20 V
En cuanto a la uniformidad de las características de CL-ES, porque ESL proporciona protección activa del canal trasero de Cu + contaminación y daño por grabado, su resultado es estable en comparación con el de BCE. Además, debe tenerse en cuenta que las características de la curva de producción no muestran diferencias para BCE y pueden prometer producción y estabilidad de CL-ES (Tabla 2, Fig. 7e, f).
Las figuras 7 cyd muestran los resultados de la oscilación por debajo del umbral y el comportamiento del voltaje de umbral junto con el progreso de la evaluación de HCS. Generalmente, el valor de oscilación por debajo del umbral del GOA TFT aumenta gradualmente, como se ve para el TFT con estructura CL-ES (Fig. 7d). Sin embargo, el TFT estructurado con BCE muestra un comportamiento anormal, con un valor de oscilación por debajo del umbral que aumenta inicialmente y luego disminuye durante la evaluación de HCS. El valor SS del TFT estructurado con BCE aumenta de 0,46 a 0,55 V / dec cuando la temperatura del sustrato aumenta de 25 a 60 ° C. Al mismo tiempo, el voltaje de umbral cambia negativamente de 4.0 a 2.9 V (Fig. 7c). Este fenómeno anormal resulta del daño de la superficie de la película a-IGZO por el H 2 O 2 grabador con fluoruro añadido. Como se mencionó anteriormente, el daño superficial de las películas a-IGZO implica una falta de átomos de Zn, Ga y oxígeno, lo que forma numerosos sitios de defectos, incluidas las vacantes de oxígeno. Se cree que estos sitios de defectos están activos como estados similares a donantes superficiales, que están cerca de la banda de conducción mínima, y son capaces de excitación térmica y actúan como fuentes de electrones para la banda de conducción, lo que lleva a una degradación de la a- Características IGZO TFT. Con base en los resultados anteriores, el TFT con estructura CL-ES con estados similares a aceptadores pequeños y deficiencias de oxígeno que actúan como estados similares a donantes superficiales es una estructura mucho mejor que el TFT estructurado con BCE.
Conclusión
En conclusión, demostramos que GOA TFT con estructura CL-ES, con un tamaño de función de dispositivo reducido y una capa de tapón de grabado limpia, puede mejorar significativamente el rendimiento y la estabilidad del dispositivo. Con el proceso de fabricación de TFT con estructura CL-ES propuesto, se minimizan el daño y la contaminación del canal posterior de TFT. Además, para el mismo grado de integración que el GOA TFT con estructura BCE, el proceso TFT con estructura CL-ES puede cumplir los objetivos de diseño estético y rentabilidad de fabricación. El GOA TFT con estructura CL-ES muestra un excelente rendimiento eléctrico en comparación con el GOA TFT con estructura BCE, que incluye una corriente de iones residuales mucho más alta (~ 187%), un valor SS inicial mucho más bajo (0.09 V / dec) y un variación mucho menor de la tensión de umbral (3,5 V). Esto implica la posibilidad de diseños GOA con mucha mayor integración y confiabilidad. El rendimiento y la estabilidad mejorados sugieren que el TFT con estructura CL-ES, con un proceso simplificado y una capa de tapón de grabado limpia, supera con éxito los defectos de tipo donante causados por deficiencias de oxígeno y los defectos de tipo aceptor causados por Cu + difusión durante el proceso BCE. Por lo tanto, una composición de superficie limpia para la región del canal a-IGZO en los TFT con estructura CL-ES es importante para la producción de placas posteriores TFT a-IGZO con pantallas de bisel estrecho, alta resolución y alta confiabilidad.
Abreviaturas
- TFT:
-
Transistor de película fina
- GOA:
-
Gate drive IC en la matriz
- a-IGZO:
-
Óxido de indio-galio-zinc amorfo
- LCD:
-
Pantalla de cristal líquido
- PEVCD:
-
Deposición de vapor químico mejorada con plasma
- ESL:
-
Capa de tapón de grabado
- BCE:
-
Grabado del canal trasero
- HCS:
-
Estrés por corriente alta
- SiOx:
-
Óxido de silicio
- SiNx:
-
Nitruro de silicio
- SS:
-
Oscilación por debajo del umbral
Nanomateriales
- Diseñar con Bluetooth Mesh:nodos y tipos de funciones
- Las MCU cuentan con rendimiento, conectividad y seguridad mejorados
- Impulsar la confiabilidad y mejorar los resultados de mantenimiento con el aprendizaje automático
- Diferencia entre estructura y clase:explicada con el ejemplo de C++
- Mejora de la absorción y modulación de frecuencia del microbolómetro THz con estructura de micropuente mediante antenas de tipo espiral
- Morfología, estructura y propiedades ópticas de películas semiconductoras con nanoislinas GeSiSn y capas tensas
- Mejora del rendimiento del dispositivo a-IGZO TFT mediante un proceso de interfaz limpia a través de nanocapas Etch-Stopper
- Resistencia de contacto reducida entre el metal y n-Ge mediante la inserción de ZnO con tratamiento con plasma de argón
- Transistor semiconductor de óxido metálico de doble difusión lateral de resistencia específica ultrabaja con doble puerta mejorada y capa parcialmente enterrada en P
- Nanoesferas de caolinita de estructura jerárquica con propiedades de adsorción notablemente mejoradas para el azul de metileno
- IBM:Garantía proactiva de confiabilidad y seguridad con EAM



