Influencia dominante de la dispersión de la rugosidad de la interfaz en el rendimiento de los láseres de cascada cuántica de Terahercios de GaN
Resumen
El efecto de la rugosidad de la interfaz de los pozos cuánticos, el dopaje no intencional y el desorden de la aleación sobre el rendimiento de los láseres en cascada cuántica de terahercios (QCL) basados en GaN se ha investigado mediante el formalismo de las funciones de Green sin equilibrio. Se encontró que la influencia del desorden de la aleación en la ganancia óptica es insignificante y el dopaje no intencional debe permanecer por debajo de una concentración razonable de 10 17 cm −3 para evitar la degradación por dispersión de impurezas de electrones y la absorción de portadores libres. Más importante aún, la dispersión de la rugosidad de la interfaz se considera el factor dominante en la degradación de la ganancia óptica. Por tanto, su control preciso durante la fabricación es fundamental. Finalmente, una ganancia de 60 cm −1 se puede obtener a 300 K, lo que muestra la posibilidad de fabricar GaN Terahertz QCL a temperatura ambiente.
Introducción
La región espectral de terahercios (THz) es un tema de investigación intensiva debido a sus posibles aplicaciones en el control de calidad y seguridad, el diagnóstico médico y las telecomunicaciones. Sin embargo, su desarrollo se ha visto obstaculizado por la falta de dispositivos compactos disponibles. El láser de cascada cuántica (QCL) es un candidato prometedor para desarrollar potentes fuentes de estado sólido de THz [1, 2]. Hasta ahora, el mejor THz QCL se basa en GaAs, cuya temperatura máxima de funcionamiento es de unos 200 K debido a la baja energía de LO-fonón (36 meV) de GaAs [3, 4]. Con la ayuda de un campo magnético, esta temperatura se puede elevar hasta 225 K. Sin embargo, este método no es adecuado para aplicaciones muy extendidas [5, 6]. Cuando la temperatura aumenta, los electrones en el estado de nivel superior pueden adquirir suficiente energía térmica para activar relajaciones no radiativas a través de la emisión de LO-fonones hacia el estado de nivel inferior, destruyendo así la inversión de población. En comparación con GaAs, GaN tiene una energía de fonón LO mucho más alta (92 meV) y, por lo tanto, brinda la posibilidad de producir THz QCL operando a temperatura ambiente [7, 8, 9]. Además, los QCL basados en GaAs no se pueden operar en el rango de frecuencia de 4.6-12 THz debido a su banda de Reststrahlen, la región espectral donde el material es completamente opaco debido a la absorción por fonones ópticos. La mayor energía de los fonones ópticos en GaN abre perspectivas para los dispositivos de cascada cuántica de THz, que pueden operar en un rango espectral mucho más amplio entre 1 y 15 THz.
El primer estudio de paso en GaN THz QCL fue el ajuste de la transición entre subbandas (ISB) al dominio del infrarrojo lejano. Se ha observado absorción de ISB a frecuencias de THz en pozos cuánticos (QW) basados en nitruros polares [10, 11] y no polares [12,13,14,15,16,17]. Los detectores ISB basados en GaN que funcionan con THz se demostraron a 13 THz [18] y 10 THz [19], respectivamente. Hasta ahora no se ha logrado ninguna demostración de electroluminiscencia en este rango, excepto por un controvertido informe del grupo Hirayama sobre la electroluminiscencia espontánea de una estructura QCL [20, 21]. Se han publicado varios estudios teóricos [7, 9, 22,23,24,25,26], entre ellos, algunos investigan los factores limitantes del rendimiento de GaN THz QCL, como la ampliación del espectro de ganancia debido a interacciones muy fuertes entre electrones y fonones LO en GaN [23].
En este artículo, proponemos completar estos estudios analizando otros factores que pueden dañar la ganancia óptica THz GaN QCL, como la rugosidad de la interfaz de los pozos cuánticos, el dopaje no intencional y el desorden de la aleación. Se encontró que la influencia del desorden de la aleación en la ganancia óptica es insignificante, y el dopaje no intencional debe permanecer por debajo de una concentración razonable de 10 17 cm −3 con el fin de evitar la degradación por dispersión de impurezas de electrones y la absorción de portadores libres [27]. Finalmente, encontramos que la dispersión de la rugosidad de la interfaz es el factor dominante en la degradación de la ganancia óptica. Y una ganancia de 60 cm −1 se puede obtener a 300 K, que está muy por encima de la pérdida teórica de una guía de ondas de doble metal, lo que muestra la posibilidad de fabricar GaN THz QCL a temperatura ambiente.
Métodos
Se sabe que la fabricación de dispositivos GaN THz QCL necesita desarrollar regiones activas gruesas con bajas densidades de dislocación. Esta tarea es un desafío debido al desajuste de la red entre GaN y AlGaN [28]. También pueden aparecer otros factores no deseados provenientes de la epitaxia:rugosidad de la interfaz (IFR) dependiendo de la condición de crecimiento, dopaje no intencional de tipo n (nid) proveniente de la incorporación de impurezas (principalmente oxígeno) durante el crecimiento y desorden de la aleación (AD) que se origina en la superficie de Ga segregación y baja movilidad de Al adatom. Para investigar cómo estos fenómenos influyen en el rendimiento de THz GaN QCL, utilizamos el formalismo de las funciones de Green de desequilibrio (NEGF). Los cálculos se realizan utilizando el software Nextnano QCL [29,30,31]. Este modelo incluye la relajación inducida por la rugosidad de la interfaz, las impurezas ionizadas, el desorden de la aleación, el fonón LO, el fonón acústico o la interacción electrón-electrón. Empleamos un QCL de tres pozos cuánticos con un esquema de despoblación de fonones resonantes ya que el diseño de THz QCL proporciona la temperatura de funcionamiento más alta hasta ahora [3, 32]. La figura 1a muestra la estructura de la región activa diseñada. La secuencia de capas para una estructura cuántica de AlGaN / estructura cuántica de AlGaN es 1.6 /6.2/1.6 /3.4/1.0 /3.4 nm, donde las cursivas muestran el espesor de las barreras. La Figura 1b muestra el diagrama de bandas de conducción de la estructura QCL diseñada con una polarización de - 84,5 kV / cm. Desde el período anterior a la derecha, los electrones se inyectan mediante tunelización resonante en el estado láser superior, etiquetado con 1. Luego, experimentan una transición radiativa al estado láser inferior 2. Este estado láser inferior se despobla mediante tunelización al estado 3. Finalmente, los electrones se relajan hasta el estado 4 por emisión de LO-fonón. El proceso se repite para cada período.
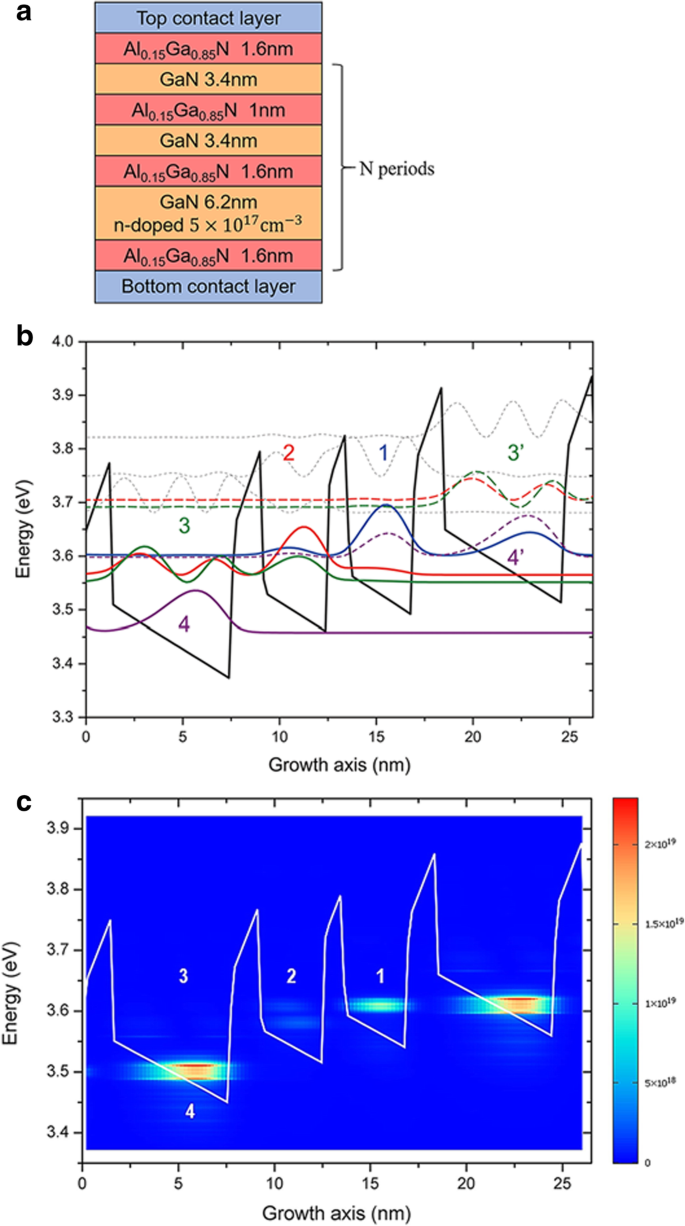
Se diseñó la estructura de la región activa, el perfil de la banda de conducción, las funciones de envolvente al cuadrado y las densidades de portadora. un La secuencia de capas para un período es 1.6 /6.2/1.6 /3.4/1.0 /3,4 nm. Las barreras se indican en cursiva. El pocillo de 6,2 nm de grosor está dopado en n con n =5 × 10 17 cm −3 . b Perfil de banda de conducción y funciones de envolvente cuadrada de GaN / Al 0.15 Ga 0,85 N QCL considerado en este estudio. Se aplica un campo eléctrico de - 84,5 kV / cm. c Densidades portadoras y banda de conducción del QCL calculadas en el modelo NEGF. El campo eléctrico aplicado es - 84,5 kV / cm. La temperatura se fija en 10 K.
En el cálculo, utilizamos los parámetros que normalmente se encuentran en la estructura desarrollada de GaN / AlGaN con epitaxia de haz molecular asistida por plasma (PAMBE):una rugosidad de la interfaz de 0,25 nm [33] con una longitud de correlación de 1 nm y una n- dopaje con una concentración de portador de 10 17 cm −3 . La dispersión por desorden de aleación también se incluye en la simulación.
Resultados y discusión
La Figura 1c muestra las densidades de portadora calculadas de esta estructura con el sesgo de funcionamiento de - 84,5 kV / cm. Observamos el anti-cruce entre el período anterior y el estado láser superior 1. También vemos que el estado láser inferior 2 está despoblado por fonón resonante en el estado 3 y 4. Para analizar y comparar la influencia de IFR, nid, y AD, calculamos nuestra ganancia óptica y características de corriente GaN THz QCL para varias configuraciones:la configuración de referencia teniendo en cuenta IFR, nid y AD, una configuración sin IFR, otra sin nid y una última sin AD. La figura 2 muestra la ganancia óptica máxima frente a la frecuencia (a) y las densidades de corriente frente al campo eléctrico aplicado (b) para cada configuración calculada a una temperatura de 10 K. La estructura de referencia muestra una ganancia máxima de 142 cm −1 a 8,7 THz, frecuencia inalcanzable para el material arseniuro. Veamos cómo influye n.i.d en nuestro rendimiento de QCL. Sin n.d., la ganancia máxima es de 127 cm −1 a 8,46 THz. La caída de ganancia se debe a que la concentración del portador disminuye en el estado de láser superior después de quitar los electrones provenientes de n.i.d. De hecho, en la configuración de referencia, la concentración de electrones del estado láser superior e inferior es ∆N = N 1 - N 2 =5,43 × 10 12 cm −2 , mientras que sin n.i.d se convierte en ∆N = N 1 - N 2 =5,06 × 10 12 cm −2 . El campo eléctrico aplicado cambia de - 84,5 a - 81,6 kV / cm. El umbral de corriente cae y cambia de 25,11 kA / cm 2 a - 84,49 kV / cm a 17,11 kA / cm 2 a - 93,24 kV / cm. La caída de la densidad de corriente se puede atribuir a la reducción de la dispersión de impurezas de electrones, lo que aumenta el transporte de electrones en el cálculo sin n.d. Otro indicio de esta hipótesis es el pico a - 64 kV / cm que vemos en el caso sin características de densidad de corriente n.d. Este es un túnel resonante entre períodos entre 4 'y 3 (no se muestra aquí). Este fenómeno está oculto por la dispersión de impurezas de electrones en las características actuales teniendo en cuenta n.i.d. El umbral de corriente y el cambio de campo eléctrico aplicado se atribuyen a la desalineación de la banda de conducción entre la configuración con o sin n.i.d. Curiosamente, aunque el pico de ganancia es mayor en el caso n.i.d, observamos un ensanchamiento del espectro de ganancia, la firma de la influencia de las impurezas cargadas [31] El dopaje no intencional debe permanecer en una concentración razonable de 10 17 cm −3 para evitar la degradación por dispersión de impurezas de electrones y la absorción de portadores libres. En la configuración sin dispersión de AD, la ganancia máxima es de 147 cm −1 a 8,7 THz. Observamos que la ganancia máxima está en la misma frecuencia con o sin dispersión AD. La ganancia óptica solo obtiene un aumento marginal del 3% cuando la dispersión AD no se incluye en el cálculo. Las características actuales también son casi idénticas. Dado que nuestro diseño utiliza un bajo contenido de aluminio del 15% y barreras bastante delgadas (1–1,5 nm), la influencia de la dispersión de AD en este QCL es insignificante.

Ganancia óptica máxima simulada frente a simulaciones de campo eléctrico de corriente y frecuencia para diferentes procesos de dispersión. un Ganancia óptica simulada frente a frecuencia teniendo en cuenta los diferentes procesos de dispersión. b Simulaciones de campo eléctrico de corriente del GaN THz QCL teniendo en cuenta diferentes parámetros de dispersión. La temperatura se establece en 10 K
Por el contrario, la influencia de la dispersión IFR en el rendimiento del dispositivo es importante. Sin dispersión IFR, observamos una ganancia máxima de 191 cm −1 a 8,7 THz. El umbral de densidad de corriente es 24,08 kA / cm 2 . Este aumento de ganancia del 34% y la caída del umbral de densidad de corriente reflejan el hecho de que muchos electrones se transportan a través de la dispersión IFR. Cuanto más dispersión IFR, menos dispersión radiativa hay para el láser. Al comparar la población de electrones de configuración de referencia del estado láser superior e inferior ∆N = N 1 - N 2 =6,6 × 10 12 - 1,27 × 10 12 =5,43 × 10 12 cm −2 al que no tiene IFR ∆N = N 1 - N 2 =7,4 × 10 12 - 1,17 × 10 12 =6.23 × 10 12 cm −2 , se puede ver que la población de electrones del estado superior es mayor. Esto se debe a la vida útil del estado de láser superior, que aumenta debido a la ausencia de dispersión IFR. En comparación con el caso sin nid, en las características de densidades de corriente del dispositivo sin dispersión IFR, observamos un pico a - 67 kV / cm, firma del túnel resonante entre períodos entre 4 'y 3. Este fenómeno es más visible en el caso sin tener en cuenta el proceso de dispersión IFR. Ésta es una prueba de su predominio sobre la tunelización resonante. Con esas observaciones, destacamos el predominio de la influencia de la dispersión IFR en el rendimiento de THz GaN QCL.
Después de notar la importancia de la dispersión IFR en el rendimiento de THz. Investigamos más a fondo variando el tamaño de IFR. Agregamos a nuestro estudio el caso de IFR =0.5 nm y 0.75 nm. La longitud de correlación se mantiene a 1 nm. En la figura 3, mostramos la ganancia máxima frente a la frecuencia (a) y las densidades de corriente frente a las características del campo eléctrico aplicado (b). Primero, observamos que para IFR =0.5 nm, la ganancia óptica máxima disminuye a 47.9 cm −1 e incluso se reduce drásticamente a - 8,8 cm −1 perdiendo ganancia óptica para IFR =0,75 nm. También es evidente el aumento de ganancia en función de la longitud de IFR. Como podemos ver en las características I-V, a medida que aumenta el tamaño de IFR, aumenta su papel en la dispersión de electrones, aumentando las densidades de corriente y disminuyendo el túnel resonante y el proceso de dispersión radiativa en los dispositivos. Este efecto se hace evidente cuando se compara la configuración de referencia de IFR =0.25 nm con el caso extremo de IFR =0.75 nm, la población de electrones del estado láser superior e inferior cae de ∆N =5,43 × 10 12 cm −2 a ∆N = N 1 - N 2 =3,71 × 10 12 cm −2 .
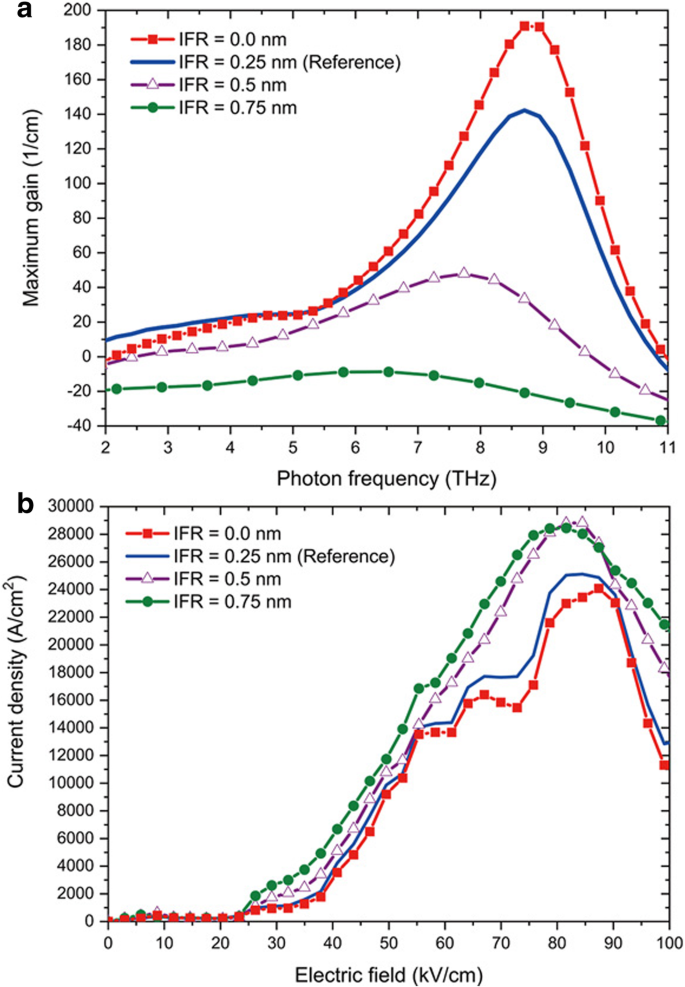
Ganancia óptica máxima simulada frente a simulaciones de campo eléctrico de frecuencia y corriente para diferentes IFR. un Ganancia óptica máxima simulada frente a frecuencia para diferentes IFR. b Simulaciones de campo eléctrico de corriente del GaN THz QCL teniendo en cuenta diferentes IFR. La temperatura se establece en 10 K
Este último disminuye hasta el punto de que ya no podemos ver el láser en los dispositivos. Como ya se señaló en estudios previos utilizando THz QCL basado en GaAs [25, 34,35,36], destacamos la importancia de considerar el tamaño de IFR durante la epitaxia y de mantenerlo por debajo de 0.5 nm para la fabricación de GaN THz QCL para poder para proporcionar una ganancia óptica positiva.
Una ventaja de GaN THz QCL es su potencial para operar a una temperatura más alta que el THz QCL basado en GaAs. En esta parte, analizamos el rendimiento de nuestro dispositivo en función de la temperatura de funcionamiento. Continuamos usando nuestros dispositivos de referencia con IFR =0.25 nm, n.d. y AD incluidos en el cálculo. La Figura 4 muestra la ganancia óptica máxima para diferentes temperaturas de celosía. El valor de ganancia es estable de 10 a 150 K a alrededor de 142 cm −1 , comienza a disminuir entre 150 y 250 K, para bajar a 61 cm −1 a 300 K. De hecho, a medida que aumenta la temperatura, la inversión de la población disminuye debido al relleno térmico y el aumento de la dispersión del fonón LO induce el ensanchamiento de la ganancia. Este valor de ganancia óptica de 61 cm −1 es aún mayor que la pérdida de una guía de ondas de metal doble GaN THz QCL (30 cm −1 ), lo que demuestra que este diseño de GaN THz QCL debería poder funcionar a temperatura ambiente. También mencionamos que además de poder operar a temperatura ambiente, el THz QCL basado en GaN tiene otra ventaja:debido a su mayor concentración de dopaje, menor índice de refracción y menor duración del período, tienen el potencial de proporcionar una ganancia óptica mucho mayor que en su contraparte de GaAs. Nuestro diseño proporciona un valor de ganancia óptica bastante alto de 142 cm −1 a 10 K, que es un buen ejemplo.
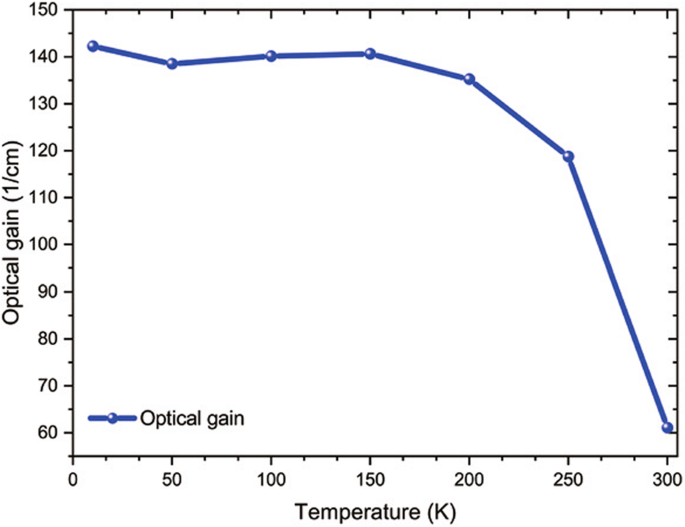
Características de la ganancia máxima calculada frente a la temperatura de la red
Conclusiones
En conclusión, informamos un diseño de QCL de GaN THz que opera a 8,7 THz. La simulación muestra una ganancia óptica de 142 cm −1 a 10 K y 60 cm −1 a temperatura ambiente. Entre los fenómenos no deseados que se originan en la epitaxia, hemos calculado la influencia de la rugosidad de la interfaz, el dopaje no intencional y el desorden de la aleación en el rendimiento de la ganancia de GaN THz QCL. La influencia del desorden de la aleación es despreciable:la ganancia óptica solo cae de 147 a 142 cm −1 al agregar dispersión por desorden de aleación en la simulación. El dopaje no intencional debe tenerse en cuenta en el diseño para evitar la desalineación de la banda de conducción. Observamos un cambio de campo eléctrico aplicado de - 84,5 a - 81,6 kV / cm inducido por n.i.d en nuestro estudio. Finalmente, observamos una gran disparidad en la ganancia óptica para diferentes valores de rugosidad de la interfaz:191, 142, 47,9 y - 8,8 cm −1 para una rugosidad de la interfaz igual a 0, 0,25, 0,5 y 0,75 nm, respectivamente. Es por eso que identificamos la influencia dominante de la dispersión de la rugosidad de la interfaz en la degradación de la ganancia óptica. Este trabajo proporciona rutas para la optimización del rendimiento de la futura fabricación de GaN THz QCL.
Disponibilidad de datos y materiales
Los conjuntos de datos generados durante y / o analizados durante el estudio actual están disponibles del autor correspondiente a solicitud razonable.
Abreviaturas
- AD:
-
Desorden de aleación
- IFR:
-
Rugosidad de la interfaz
- ISB:
-
Intersubbanda
- n.i.d:
-
Dopaje no intencional
- NEGF:
-
Funciones de Nonequilibrium Green
- QCL:
-
Láser de cascada cuántica
Nanomateriales
- Influencia del molibdeno en el rendimiento del acero inoxidable
- Introducción a la banda de terahercios
- El rendimiento de la fibra de vidrio
- Influencia del agua en la estructura y propiedades dieléctricas de la microcristalina y nanocelulosa
- Láseres de cascada cuántica DFB de bajo consumo de energía
- Capas óptimas de dopaje de silicio de barreras cuánticas en la secuencia de crecimiento que forman el potencial de confinamiento suave de ocho períodos In0.2Ga0.8N / GaN Pozos cuánticos de azul LE…
- Rendimiento fotovoltaico de una célula solar de matriz de nanoestructura híbrida de nanocables / puntos cuánticos
- Fotoconductividad entre bandas de puntos cuánticos de InAs / InGaAs metamórficos en la ventana de 1,3 a 1,55 μm
- Comprensión del mecanismo de crecimiento de las capas epitaxiales de GaN en grafito exfoliado mecánicamente
- Matrices láser de cascada cuántica cónicas integradas con cavidades Talbot
- Influencia del sustrato en la longitud de onda y resistencia del acoplamiento LSP



