Crecimiento directo de nanocables de GaN cristalino simple sobre sílice recubierta con óxido de indio y estaño
Resumen
En este trabajo, demostramos el crecimiento directo de nanocables de GaN en un sustrato de sílice fundido recubierto con óxido de indio y estaño (ITO). Los nanocables se cultivaron sin catalizador utilizando epitaxia de haz molecular asistida por plasma (PA-MBE). El efecto de la condición de crecimiento sobre la morfología y la calidad de los nanocables se investiga sistemáticamente. La caracterización estructural indica que los nanocables crecen en la dirección (0001) directamente sobre la capa de ITO perpendicular al plano del sustrato. La caracterización óptica de los nanocables muestra que la luminiscencia amarilla está ausente en la respuesta de fotoluminiscencia del nanoalambre, atribuida al bajo número de defectos. La medición de microscopía de fuerza atómica conductiva (C-AFM) en nanocables de GaN dopados con n muestra una buena conductividad para nanocables individuales, lo que confirma el potencial de utilizar esta plataforma para aplicaciones de dispositivos novedosos. Mediante el uso de un proceso de crecimiento a temperatura relativamente baja, pudimos cultivar con éxito material de GaN monocristalino de alta calidad sin la degradación de la capa de ITO subyacente.
Introducción
Los dispositivos basados en nitruro III disponibles comercialmente dependen principalmente del zafiro como sustrato de crecimiento, ya que pueden acomodar el crecimiento de GaN con una calidad de material aceptable. Sin embargo, el desafío de producir un sustrato de zafiro de gran diámetro mientras se mantiene una calidad superficial aceptable del sustrato sigue siendo un obstáculo para aumentar la producción [1, 2]. Una alternativa viable al zafiro como sustrato de crecimiento de nitruro III sería el uso de sustrato a base de sílice, ya que son económicamente menos costosos y se usan ampliamente en aplicaciones industriales y de consumo. Sin embargo, como los sustratos a base de sílice son inherentemente no conductores, se debe utilizar una capa conductora no transparente para permitir la conductividad eléctrica [3, 4]. Por tanto, se vuelve muy importante un método para proporcionar conductividad y transparencia simultáneas sobre el sustrato de sílice. Anteriormente, hemos empleado una capa intermedia delgada de Ti como sitio de nucleación de nanocables para proporcionar transparencia y conductividad simultáneas [5]. Sin embargo, como se requiere una capa delgada de Ti, la conductividad eléctrica de la muestra se vuelve limitada.
Otro método posible para un sustrato transparente y conductor es empleando óxido de indio y estaño (ITO) como sitio de nucleación de GaN, ya que es transparente y eléctricamente conductor y puede depositarse sobre una gran superficie. La tecnología ITO ya está madura y se ha utilizado ampliamente en varias industrias para electrodos transparentes. Sin embargo, la técnica convencional actual utilizada para fabricar GaN no es compatible con ITO. La alta temperatura necesaria para descomponer los precursores empleados en el crecimiento de la deposición de vapor químico orgánico metálico (MOCVD) conduce a la degradación de la capa de ITO. Por tanto, se requiere un método de crecimiento de GaN a baja temperatura capaz de producir material de alta calidad. Se han realizado intentos anteriores de cultivar GaN en ITO a baja temperatura mediante pulverización catódica y deposición química en fase de vapor mejorada con plasma (PECVD) [6-12]. Sin embargo, los métodos de crecimiento a baja temperatura suelen producir material policristalino y una gran cantidad de defectos.
En este trabajo, intentamos evitar este problema mediante el crecimiento directo de nanocables de GaN cristalino en sílice fundida recubierta de ITO utilizando epitaxia de haz molecular asistida por plasma (PA-MBE). En PA-MBE, las especies de nitrógeno activo se suministran al sistema rompiendo el enlace entre el N 2 puro gas utilizando potencia de RF. Por lo tanto, la temperatura de crecimiento puede ser significativamente menor en comparación con otros métodos de crecimiento epitaxial de GaN, evitando la degradación de la capa de ITO. Al utilizar nanocables de GaN, es posible cultivar GaN de alta calidad sobre la capa de ITO policristalino. Debido a la relajación de la deformación y el filtrado de la dislocación de los hilos atribuidos a la alta relación superficie / volumen de los nanocables [13, 14], los nanocables de GaN suelen exhibir cristalinidad única y ninguna dislocación de los hilos a pesar de la falta de correspondencia de la red entre los nanocables y el nanoalambre subyacente. capa de nucleación [15].
Investigamos la morfología de los nanocables y su relación con la capa de ITO subyacente, las características ópticas de los nanocables y la viabilidad de utilizar esta plataforma para aplicaciones de dispositivos. Las caracterizaciones estructurales mediante microscopía electrónica revelan que los nanocables crecen directamente en la capa de ITO perpendicular al plano del sustrato en la dirección del plano c (0001). La medición de fotoluminiscencia proporciona un buen valor de eficiencia cuántica interna (IQE), mientras que la luminiscencia amarilla asociada con el defecto está ausente del espectro de emisión. Finalmente, la microscopía de fuerza atómica conductiva (C-AFM) en nanocables de GaN dopados con n confirma que los nanocables son conductores, lo que destaca la posibilidad de fabricar dispositivos novedosos utilizando los nanocables de GaN en la plataforma ITO. A partir de nuestro trabajo, abrimos el potencial de cultivar nanocables de nitruro III además de ITO para aplicaciones de dispositivos donde se requiere transparencia y conductividad del sustrato.
Métodos
Deposición de película fina ITO
La película fina de ITO utilizada en este experimento se depositó utilizando el método de pulverización catódica con magnetrón de RF. La deposición se realizó a temperatura ambiente con plasma de argón a una potencia de RF de 60 W, una presión de cámara de 2,5 mTorr y un caudal de gas estándar de 25 centímetros cúbicos por minuto (sccm). Antes de la deposición, las muestras se limpian con solvente estándar usando acetona y alcohol isopropílico. Se depositó una película fina de ITO de aproximadamente 100 nm de espesor directamente sobre sílice desnuda.
Crecimiento de nanocables de nitruro III
Las muestras de nanocables de GaN se cultivan utilizando un reactor de epitaxia de haz molecular asistido por plasma (PA-MBE) Veeco Gen 930. Antes del crecimiento de MBE, el sustrato de sílice revestido con ITO se recoció dentro de un horno de recocido térmico rápido (RTA) a 650 ° C bajo una temperatura ambiente de Ar durante 5 min para mejorar la cristalinidad de la capa de ITO. Antes de cargarlas en la cámara, las muestras se limpian utilizando un método de limpieza con solvente estándar. Las muestras se someten a una limpieza térmica posterior a 200 ° C y 650 ° C dentro del cierre de carga MBE y la cámara de preparación para eliminar la humedad y otros contaminantes, respectivamente.
Durante el crecimiento de nanocables, usamos un valor de presión equivalente de haz de Ga (BEP) de 1 × 10 −7 Torr de acuerdo con la lectura del medidor de iones BFM. Todas las temperaturas del sustrato se miden utilizando el termopar. Para promover el crecimiento de los nanocables, se depositó una capa de siembra inicial a 500 ° C. Después de la deposición de la capa de siembra inicial, la temperatura del sustrato se elevó a 700 ° C para el crecimiento de nanocables.
Caracterización estructural, óptica y eléctrica
La morfología de la superficie de la capa de ITO se investigó utilizando el sistema de microscopía de fuerza atómica (AFM) Agilent 5500 SPM. La característica eléctrica de la muestra se midió utilizando AFM conductor (C-AFM) en modo de contacto. Para mejorar el contacto eléctrico entre los nanocables y la punta de C-AFM, se depositó una capa de Ni / Au con un grosor de 5/5 nm encima de los nanocables mediante evaporación por haz de electrones, seguido de un recocido térmico rápido a 600 ° C en ambiente atmosférico. La medición de C-AFM se realizó utilizando una punta de AFM recubierta de Pt / Ir y aplicando sesgo a la capa de ITO de la muestra. Como en nuestra configuración de C-AFM, el sesgo se aplica al sustrato, el flujo de corriente positivo indica que la corriente fluye desde la muestra a la punta del AFM.
La calidad estructural de los nanocables de GaN cultivados sobre ITO se investigó mediante caracterización por microscopía electrónica de transmisión (TEM). Se preparó una muestra de TEM de sección transversal utilizando un SEM FEI Helios Nanolab 400s Dual Beam Focused Ion Beam (FIB). Las imágenes SEM se realizaron utilizando el sistema FEI Nova Nano y Zeiss Merlin SEM. Se llevaron a cabo caracterizaciones de microscopía electrónica de transmisión de alta resolución (HRTEM) y STEM de campo oscuro anular de alto ángulo de alta resolución (HAADF-STEM) utilizando un microscopio electrónico de transmisión Titan 80-300 ST (Compañía FEI). El mapa de composición elemental se obtuvo mediante espectroscopia de pérdida de energía electrónica (EELS).
Para investigar la polaridad de los nanocables, utilizamos grabado a base de KOH. Se ha informado que el grabado químico húmedo usando KOH muestra un grabado preferencial para el N-face GaN. Por lo tanto, la polaridad se puede determinar comparando la morfología de los nanocables antes y después del grabado con KOH. Sumergimos el nanocable de GaN en muestras de ITO en una solución de KOH al 40% durante 1 hora a temperatura ambiente y comparamos la morfología antes y después de la inmersión química para determinar la polaridad de crecimiento del nanocable.
Investigamos las propiedades ópticas de los nanocables de GaN cultivados directamente sobre ITO mediante el uso de una configuración de medición de fotoluminiscencia (PL) dependiente de la temperatura y dependiente de la potencia. La muestra se cargó en un criostato enfriado con helio y se excitó usando un láser de 266 nm (Teem photonics SNU-20F-10x). La temperatura se varió de 10 a 290 K. Primero estudiamos la respuesta de fotoluminiscencia dependiente de la potencia, realizada a 10 K. La medición de la transmitancia se realizó utilizando un espectrofotómetro UV-Vis-NIR (Shimadzu UV-3600).
La medición de difracción de rayos X (XRD) se realizó utilizando un sistema de XRD de polvo Bruker D2 Phaser.
Resultados y discusión
Como el crecimiento a alta temperatura de los nanocables de GaN podría resultar en la degradación de la capa de ITO subyacente, primero investigamos el efecto del recocido térmico en el ITO desnudo depositado sobre el sustrato de sílice. El experimento se llevó a cabo dentro de la cámara tampón del MBE en típicamente 10 −8 Presión Torr para simular la condición de crecimiento real. Después del recocido, se mide la conductividad eléctrica del ITO desnudo usando una medición de sonda de cuatro puntos, y la rugosidad de la superficie se investiga usando microscopía de fuerza atómica (AFM). A partir del experimento de recocido, que se muestra en la Fig. 1a, encontramos que el valor de la resistencia laminar de la película delgada de ITO permanece por debajo de 10 \ (\ Omega / \ square \). Sin embargo, a una temperatura de recocido más alta, la película delgada de ITO se vuelve más áspera con un tamaño de grano más grande, como se muestra en la Fig. 1b – d.

Efecto de la temperatura de recocido sobre las características eléctricas y físicas de la película fina de ITO depositada. un Resistencia de la hoja medida con una sonda de cuatro puntos después del recocido a diferentes temperaturas. Topografía de superficie AFM de la película delgada de ITO adquirida después de recocer la muestra en b 500 ° C, c 600 ° C y d 700 ° C
El proceso de crecimiento de los nanocables se ilustra en la Fig. 2
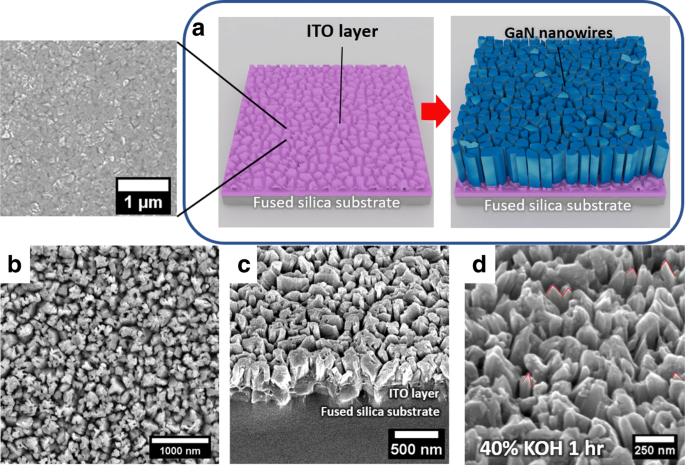
un Esquema que ilustra el crecimiento de nanocables de GaN en una superficie rugosa de ITO. El recuadro muestra una vista en planta SEM de la superficie rugosa de ITO después del recocido térmico. b Vista en planta de nanocables de GaN cultivados en ITO. c Vista en alzado de nanocables de GaN cultivados en ITO. d Vista en alzado de los nanocables de GaN después de 1 h de grabado con KOH, exponiendo la punta del nanocable de GaN grabada
una. Como se muestra en el resultado de AFM, el recocido de la capa de ITO a temperatura elevada dará como resultado una superficie de ITO rugosa con un gran tamaño de grano. Durante el crecimiento de MBE, los nanocables de GaN vecinos que crecen en la superficie de un solo grano tienden a fusionarse y formar un nanocable más grande compuesto por un grupo de nanocables. Por lo tanto, la morfología del ITO subyacente afectará directamente a la morfología de los nanocables que crecen sobre él. La vista en planta de la micrografía del microscopio electrónico de barrido (SEM) se muestra en la Fig. 2b. Desde la vista en planta, la densidad de nanocables se estima estadísticamente en 9,3 × 10 9 cm −2 con un factor de llenado del 73%. La vista en sección transversal de la muestra se muestra en la Fig. 2c. Los nanocables crecen perpendiculares al plano del sustrato con cierto grado de inclinación directamente sobre la capa de ITO.
La imagen SEM de la muestra de nanocables después de 1 h de inmersión en una solución de KOH al 40% se muestra en la Fig. 2d. Se puede ver que después del tratamiento químico, las puntas de los nanocables están parcialmente atacadas, lo que indica polaridad N. Este hallazgo concuerda con los resultados reportados anteriormente donde los nanocables de nitruro III que crecen espontáneamente son típicamente N-polares [16-19].
La Figura 3a muestra la microscopía electrónica de transmisión de barrido de campo oscuro anular de alto ángulo (HAADF-STEM) de los nanocables. Los nanocables crecen directamente sobre la capa de ITO. Para estudiar la composición elemental de la interfaz entre los nanocables y la capa de ITO, realizamos un escaneo de línea de mapeo elemental para Ga, In, N y O utilizando EELS en el área delimitada dentro de un recuadro rojo. El perfil de exploración de línea se muestra en la Fig. 3b. El perfil de la línea indica un límite claro entre los nanocables de GaN y el ITO. Una imagen TEM de alta resolución de un solo nanoalambre en la Fig. 3c muestra la disposición reticular del nanoalambre, lo que confirma la cristalinidad única del material. TEM de alta resolución en la interfaz entre los nanocables de GaN y la capa de ITO en la Fig.3d muestra lo que parece ser una capa intermedia (IL) compuesta por una mezcla entre la capa policristalina y amorfa de aproximadamente 4 nm de espesor entre la base del nanoalambre y el ITO . Se sugiere que esta capa delgada es una capa de GaN de transición, formada entre la capa de ITO policristalino y la capa de GaN cristalino. Se ha informado anteriormente de una capa similar en la que los nanocables de GaN se cultivan directamente sobre una capa de sílice fundida amorfa [15].

TEM y mapeo elemental de nanocables de GaN cultivados en la capa ITO. un Imagen HAADF de nanocables de GaN cultivados directamente sobre la capa de ITO. El cuadro rojo indica dónde se realizó el escaneo de línea EELS. b Perfil de exploración de línea EELS de la interfaz entre la base del nanocable de GaN y la capa de ITO. El mapeo elemental para Ga, In, N y O se muestra en el gráfico. c TEM de alta resolución del nanoalambre de GaN, que muestra cristalinidad única. La flecha roja indica la dirección del crecimiento. La separación entre planos corresponde al plano c de GaN. d Imagen TEM de alta resolución de la interfaz entre el nanocable de GaN y la capa ITO. Se puede ver una capa intermedia parcialmente amorfa (IL) entre los nanocables de GaN y la capa de ITO, unida por las líneas rojas discontinuas
El resultado de la fotoluminiscencia dependiente de la temperatura se muestra en la Fig. 4a. A partir de la medición, se muestra que la luminiscencia amarilla comúnmente asociada con defectos en los materiales de GaN es aproximadamente tres magnitudes más baja que la emisión del borde de la banda de GaN, lo que destaca el crecimiento del material de GaN de alta calidad. La fotoluminiscencia dependiente de la temperatura se muestra en la Fig. 4b. El resultado muestra un desplazamiento hacia el rojo con el aumento de la temperatura comúnmente asociado con la reducción de la banda prohibida de Varshni. La intensidad del pico de emisión se reduce con el aumento de temperatura debido a la activación de los centros de recombinación no radiativa. El ajuste de Arrhenius se realiza en función del cambio en la intensidad integrada de PL sobre la temperatura, que se muestra en la Fig. 4c. El accesorio proporciona una energía de activación de 195 meV. Al utilizar la relación de intensidad integrada a 290 K y 10 K, estimamos que la eficiencia cuántica interna de los nanocables es de alrededor del 67%.

un Medición dependiente de la potencia de nanocables de GaN cultivados en óxido de indio y estaño realizada a 10 K. b PL dependientes de la temperatura de nanocables de GaN cultivados en una capa de ITO. c Energía de activación calculada basada en la medición PL dependiente de la temperatura. d Transparencia del sustrato de sílice fundida, capa de ITO recocida sobre sílice fundida y nanocables de GaN cultivados en una capa de ITO; e Los perfiles XRD para sílice fundida desnuda, película fina de ITO depositada, película fina de ITO recocida y nanocables de GaN cultivados en ITO
La Figura 4d muestra el cambio en la transmitancia para el ITO recocido, la sílice fundida y el nanoalambre de GaN en ITO / sílice. La transmitancia de la muestra se reduce después del crecimiento del nanoalambre de GaN. Como los nanocables de GaN no absorben en el rango de longitud de onda visible, la transmitancia reducida se puede atribuir a la dispersión de la luz causada por los propios nanocables.
La Figura 4e muestra los resultados de XRD del sustrato de sílice desnudo, el sustrato de sílice con ITO depositado, ITO / sílice recocido con RTP y nanocables de GaN cultivados en ITO / sílice. No se puede observar ningún pico de XRD en la capa de ITO depositada, lo que indica una capa casi amorfa. Después del recocido RTP, se pueden observar picos de ITO (211), ITO (222), ITO (400), ITO (440) e ITO (622), lo que indica que el recocido mejora la cristalinidad de la capa de ITO, lo que concuerda con informes anteriores. [20]. Se muestra que los picos más dominantes son el pico ITO (222) y el pico ITO (400). El pico de GaN (0002) medido en el 2 θ El escaneo indica que este plano es paralelo a los planos de ITO, lo que muestra que los nanocables de GaN crecen en la capa de ITO policristalina.
Para probar si los nanocables de GaN en la plataforma ITO serían factibles para la aplicación del dispositivo, hemos cultivado nanocables de GaN con nanocables de GaN dopados con n utilizando silicio como dopante y medimos la característica I-V de los nanocables individuales utilizando C-AFM. Mediante este método, obtuvimos los datos estadísticos I-V de la muestra. La medición resultante se muestra en la Fig. 5.

un Mapeo C-AFM de la topología de nanocables. b Corriente de punta correspondiente, con un sesgo de -8V aplicado a la muestra. c Curva I-V de un solo nanocable con polarización de voltaje de muestra de -10 V a 10 V, que muestra una característica I-V diferente entre el barrido inicial y el segundo. d Distribución de la curva I-V de varios nanocables, después del barrido de perforación inicial
El mapeo de corriente en la Fig. 5b muestra que los nanocables en la Fig. 5a son inicialmente no conductores, con solo varios puntos que muestran el flujo de corriente. Para investigar mejor por qué los nanocables no son conductores, realizamos una caracterización I-V en nanocables individuales. El rango del barrido de voltaje de la muestra es de - 10 a 10 V, con la corriente de punta resultante en el rango de - 10 a 10 nA, que está limitada por la especificación del sistema AFM. El resultado se muestra en la Fig. 5c. Para el primer barrido, encontramos que los nanocables exhiben un voltaje de encendido muy alto, lo que indica un comportamiento de contacto de Schottky entre la capa n-GaN e ITO. Sin embargo, después de repetir la medición, encontramos que el voltaje de encendido de la curva I-V se ha reducido significativamente, lo que se atribuye a la disminución de la altura de la barrera Schottky. Observamos esta tendencia de voltaje de encendido reducido después del barrido de voltaje de perforación inicial a través de múltiples nanocables en el área de escaneo AFM que se muestra en la Fig. 5d, lo que confirma que esto se aplica a todos los nanocables cultivados en ITO. El mecanismo exacto de reducción del voltaje de encendido aún requiere más investigación. Informes anteriores han demostrado que la aplicación de un alto voltaje al material podría haber inducido rutas de transporte de corriente a través de una ruptura eléctrica [21, 22], o modificar la estructura del propio nanocable de GaN [23], lo que condujo a una mejora en el voltaje de encendido.
Conclusiones
En conclusión, hemos realizado el crecimiento de nanocables de GaN sobre una película delgada de ITO depositada sobre un sustrato de sílice fundida. La caracterización física mediante microscopía electrónica muestra que los nanocables crecen perpendiculares al plano del sustrato, al tiempo que conservan una alta calidad de cristal. Se detectó una fuerte emisión de borde de banda de GaN a través de la caracterización por fotoluminiscencia, mientras que la luminiscencia amarilla comúnmente asociada con los defectos está ausente. Los nanocables tienen una polaridad N preferida, indicada por el grabado preferencial del plano cristalino en una solución de KOH. Las mediciones de C-AFM en nanocables dopados con n muestran una buena conductividad, lo que destaca la posibilidad de la plataforma para la aplicación del dispositivo.
Abreviaturas
- AFM:
-
Microscopía de fuerza atómica
- BEP:
-
Haz de presión equivalente
- C-AFM:
-
Microscopía de fuerza atómica conductiva
- EELS:
-
Espectroscopía de pérdida de energía electrónica
- FIB:
-
Haz de iones enfocado
- IQE:
-
Eficiencia cuántica interna
- HAADF:
-
Campo oscuro anular de ángulo alto
- HRTEM:
-
Microscopía electrónica de transmisión de alta resolución
- ITO:
-
Óxido de indio y estaño
- MOCVD:
-
Deposición de vapor químico orgánico metálico
- PA-MBE:
-
Epitaxia de haz molecular asistida por plasma
- PECVD:
-
Deposición de vapor químico mejorada con plasma
- PL:
-
Fotoluminiscencia
- RF:
-
Radiofrecuencia
- RTA:
-
Recocido térmico rápido
- sccm:
-
Centímetro cúbico estándar por minuto
- SEM:
-
Microscopía electrónica de barrido
- STEM:
-
Microscopía electrónica de barrido de transmisión
- TEM:
-
Microscopía electrónica de transmisión
- XRD:
-
Difracción de rayos X
Nanomateriales
- Los científicos de materiales enseñan a los nanocables cómo 'bailar'
- Detección del magnetismo del núcleo de un solo átomo
- Nanocristales de estaño para futuras baterías
- Acerca de las nanopartículas semiconductoras
- Crecimiento autocatalizado de nanocables verticales de GaSb en vástagos de InAs mediante deposición de vapor químico metalorgánico
- Investigación sobre la polarización de la superficie de la heteroestructura de GaN / AlGaN / GaN con cubierta de Al2O3 mediante espectroscopia de fotoelectrones de rayos X de ángulo resuelto
- Hacia cadenas de átomos individuales con telurio exfoliado
- Crecimiento directo de estructuras de ZnO similares a plumas mediante una técnica de solución fácil para la aplicación de fotodetección
- Control del crecimiento de nanocables de selenuro de indio de alta uniformidad (In2Se3) mediante el proceso de recocido térmico rápido a baja temperatura
- Capas óptimas de dopaje de silicio de barreras cuánticas en la secuencia de crecimiento que forman el potencial de confinamiento suave de ocho períodos In0.2Ga0.8N / GaN Pozos cuánticos de azul LE…
- Crecimiento directo de un diodo emisor de luz amarillo a base de nanocables de nitruro III en cuarzo amorfo utilizando una capa intermedia fina de Ti



