Investigación de la banda de energía en las heterouniones de disulfuro de molibdeno y ZrO2
Resumen
La alineación de la banda de energía en el MoS multicapa 2 / ZrO 2 interfaz y los efectos de CHF 3 El tratamiento con plasma en el desplazamiento de banda se exploró mediante espectroscopía de fotoelectrones de rayos X. El desplazamiento de la banda de valencia (VBO) y el desplazamiento de la banda de conducción (CBO) para el MoS 2 / ZrO 2 muestra es de aproximadamente 1,87 eV y 2,49 eV, respectivamente. Mientras que el VBO se amplió en aproximadamente 0,75 eV para la muestra con CHF 3 tratamiento con plasma, que se atribuye al aumento del nivel central de Zr 3d. Los resultados del cálculo demostraron que los átomos de F tienen interacciones fuertes con los átomos de Zr, y el cambio de energía de la banda de valencia para el orbital d de los átomos de Zr es de aproximadamente 0,76 eV, de acuerdo con el resultado experimental. Este interesante hallazgo fomenta la aplicación de ZrO 2 como materiales de puerta en MoS 2 basados en dispositivos electrónicos y proporciona una forma prometedora de ajustar la alineación de la banda.
Introducción
En las últimas décadas, SiO 2 / Los materiales a base de Si desempeñaron el papel dominante en la fabricación de dispositivos electrónicos, como circuitos lógicos integrados, memoria no volátil, etc. Sin embargo, como el tamaño de los dispositivos se redujo incesantemente de micrómetros a menos de 10 nm, los semiconductores tradicionales han sido difíciles de satisfacer el requisito de capacitancia específica mejorada, corriente de fuga de puerta baja y alta movilidad de portadora. Por lo tanto, la exploración de nuevos semiconductores como canales del dispositivo y de óxidos con alto contenido de kappa como aislantes se vuelve inquietante. Desde el descubrimiento del grafeno, la fabricación exitosa de materiales bidimensionales (2D), especialmente los semiconductores con banda prohibida adecuada, ha proporcionado una forma prometedora de superar este inconveniente.
Entre los materiales 2D, el disulfuro de molibdeno (MoS 2 ) con propiedades ajustables basadas tanto en el recuento de capas como en la elección de los materiales del sustrato ha atraído una atención cada vez mayor debido no solo a su buena estabilidad química y flexibilidad mecánica, sino también a sus excelentes propiedades ópticas y eléctricas [1, 2]. La banda prohibida de energía de la monocapa MoS 2 es de aproximadamente 1,80 eV mientras que 1,20 eV a granel. El rendimiento prometedor de los dispositivos electrónicos y optoelectrónicos fabricados con MoS 2 capas, tales como transistores de efecto de campo [3, 4, 5], sensores [6] y fotodetectores [7], demuestra que es un posible sustituto del Si en la electrónica convencional y de los semiconductores orgánicos en sistemas portátiles y flexibles [8, 9,10,11]. Aunque MoS 2 de una sola capa Los transistores de efecto de campo (FET) basados en datos han mostrado un rendimiento excelente con una alta relación de encendido / apagado de aproximadamente 10 8 y una baja oscilación por debajo del umbral de ~ 77 mV / década [3], sus aplicaciones extensivas se vieron obstaculizadas por la síntesis de MoS 2 de una sola capa de alta calidad de área grande y la estabilidad de los dispositivos [12,13,14]. MoS de varias capas 2 podría ser más atractivo debido a la alta densidad de estados, lo que contribuye a una alta corriente de excitación en el límite balístico [15]. Además, la movilidad del portador de MoS 2 multicapa puede mejorarse aún más significativamente con óxidos de alto contenido de κ debido a los efectos de cribado dieléctrico [16, 17]. Por lo tanto, es esencial e importante investigar el MoS 2 multicapa / heterouniones de óxidos de alto κ.
En los dispositivos electrónicos de heterounión, las propiedades de transporte de electrones están controladas con precisión por los perfiles de banda de energía en la interfaz entre el semiconductor y el óxido aislante en términos de desplazamiento de banda de valencia (VBO) y desplazamiento de banda de conducción (CBO). El VBO y CBO deben ser lo más grandes posible para operar como una barrera con el fin de reducir la corriente de fuga formada por la inyección de huecos y electrones, especialmente el CBO juega un papel fundamental en la selección de óxidos de alto k adecuados para una puerta. terminal y debe ser al menos mayor de 1 eV para evitar fugas de corriente [18,19,20]. Mientras tanto, las cargas de interfaz ubicadas en semiconductores / óxidos imponen un efecto importante en la ingeniería de la banda y deben optimizarse mediante tecnología de pasivación, como SiH 4 pasivación y CHF 3 tratamiento. En este artículo, investigamos la alineación de bandas de MoS 2 multicapa / ZrO 2 sistemas, ya que la naturaleza de la interfaz tiene una relación directa con las características de los dispositivos y el efecto de CHF 3 tratamiento con plasma en la banda desplazada en MoS 2 / ZrO 2 se exploró la interfaz.
Métodos y experimentos
En los experimentos, el MoS 2 multicapa las películas se cultivaron en SiO 2 / Sustratos de Si mediante sistemas de deposición química de vapor (CVD) con MoO 3 y polvo de azufre como fuentes de Mo y precursores de S, respectivamente. Durante el proceso de crecimiento, se utilizó gas Ar como gas portador y la temperatura de crecimiento fue de 800 ° C durante 5 min. Luego, el MoS 2 / ZrO 2 Las muestras se prepararon transfiriendo el MoS 2 multicapa de área grande película en el ZrO 2 / Sustratos de Si utilizando el método de polimetacrilato de metilo (PMMA). El ZrO 2 Se depositó óxido (15 nm) sobre Si a 200 ° C utilizando un sistema de deposición de capa atómica (BENEQ TFS-200) con precursor de tetrakis dimetil amido circonio (TDMAZr) como fuente de circonio y agua (H 2 O) como fuente de oxígeno. Para investigar los efectos de CHF 3 tratamiento en la alineación de la banda en MoS 2 / ZrO 2 interfaces, para una muestra, el ZrO 2 / El sustrato de Si fue tratado por CHF 3 plasma con una potencia de RF de aproximadamente 20 W y un caudal de aproximadamente 26 sccm. Mientras tanto, el tiempo de tratamiento con plasma es de aproximadamente 60 sy la presión se mantuvo a 1 Pa durante el proceso. En consecuencia, la dosis de F resultante es de aproximadamente 2,0 × 10 14 átomos / cm 2 estimado mediante mediciones de espectrometría de masas de iones secundarios (SIMS). Durante el proceso de optimización del tiempo de tratamiento con plasma, el CHF 3 El plasma deterioró gravemente la calidad del material al introducir flúor difundido en ZrO 2 en gran parte cuando el tiempo se fijó en 70 s. Mientras que cuando el tiempo de tratamiento con plasma fue de 50 s, inferior a 60 s, los resultados de SIMS no demostraron ningún pico F obvio en la superficie del óxido. Para la otra muestra, no CHF 3 Se implementó el tratamiento con plasma. Las características Raman de las muestras se tomaron en un sistema RENISHAW a temperatura ambiente. La espectroscopia de fotoelectrones de rayos X (XPS) se midió utilizando un sistema VG ESCALAB 220i-XL. La energía fotónica de la fuente de rayos X monocromatizada de Al Kα es de aproximadamente 1486,6 eV. Durante las mediciones, la energía de paso se estableció en 20 eV para obtener los espectros XPS. Además, se utilizó el pico C 1 s (284,8 eV) para corregir la energía de enlace a nivel del núcleo con el fin de eliminar el efecto de carga diferencial de la superficie de la muestra.
Resultados y discusiones
Los espectros Raman del MoS 2 multicapa recién crecido y transferido posteriormente se caracterizaron a temperatura ambiente como se muestra en la Fig. 1. Dos modos Raman prominentes etiquetados como A 1 g y \ ({\ mathrm {E}} _ {2g} ^ 1 \) se observaron en el espectro. Específicamente, el modo \ ({E} _ {2g} ^ 1 \) es el resultado del movimiento opuesto de los átomos S en el plano con respecto al átomo de Mo central en la región de frecuencia más baja, mientras que A 1 g es relativo a las vibraciones fuera del plano de los átomos de S en la región de frecuencia más alta [21]. Se ha observado que \ ({\ mathrm {E}} _ {2g} ^ 1 \) y A 1 g modos de MoS 2 se someten a un desplazamiento al rojo y al azul, respectivamente, de una monocapa a muestras a granel, lo que se debe a la fuerza de restauración de Van der Waals de las diferentes capas intermedias ya la influencia de los cambios de estructura inducidos por el apilamiento [21]. Por lo tanto, la diferencia de frecuencia (Δk) entre A 1 g y los modos \ ({\ mathrm {E}} _ {2g} ^ 1 \) se utilizan a menudo para evaluar el número de capa o el grosor de MoS 2 película. Aquí, Δk del MoS 2 crecido la película mide aproximadamente 25,32 cm −1 , lo que indica que la película tiene más de seis capas. Además, el resultado de la microscopía electrónica de transmisión (TEM) de sección transversal que se muestra en el recuadro de la Fig.1 demostró el número de capa del MoS 2 crecido fue de aproximadamente 8 correspondiente al espesor de aproximadamente 4,5 nm. Además, la posición del pico Raman y el ancho completo a la mitad del máximo (FWHM) de MoS 2 es casi el mismo antes y después de la transferencia, lo que indica que el proceso de transferencia ejerce una pequeña influencia en la calidad del material.
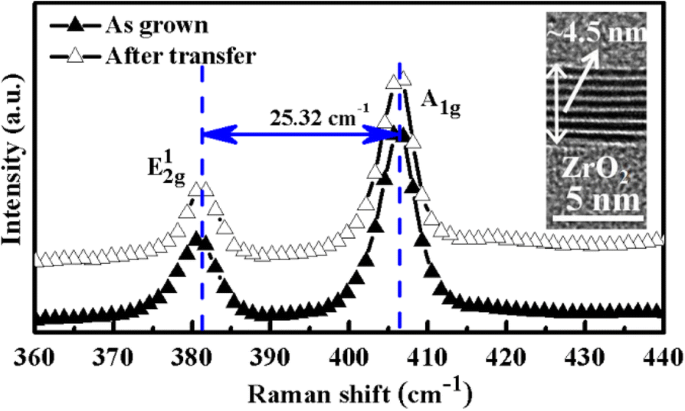
La espectroscopia Raman del ultrafino MoS 2 película antes y después de la transferencia. El recuadro es la imagen de microscopía electrónica de transmisión (TEM) de sección transversal del MoS 2 en ZrO 2 / Sustrato de Si, que muestra las capas de MoS 2
Se ha demostrado profundamente que XPS es una forma eficaz de determinar el desplazamiento de banda en la interfaz de heterounión [22, 23]. En MoS 2 / ZrO 2 heterounión, el valor de VBO se obtuvo a partir del cambio de los espectros de la banda de valencia del ZrO 2 entre los del óxido desnudo y con MoS 2 material [24]. La Figura 2a, b mostró el nivel del núcleo y los espectros de la banda de cenefa de ZrO 2 desnudo y multicapa-MoS 2 / ZrO 2 , respectivamente. La intersección entre la línea de base y la pendiente del borde de ataque da el máximo de la banda de valencia (VBM) de la muestra, donde el nivel de Fermi se toma como nivel de referencia. Los resultados demostraron que el VBM de ZrO 2 y multicapa-MoS 2 / ZrO 2 Los sistemas son de aproximadamente 1,88 eV y 0,06 eV, respectivamente. Además, el espectro de nivel de núcleo de Zr 3d de ZrO 2 desnudo exhibe picos de doblete bien separados denominados Zr 3d 5/2 y 3d 3/2 con valores de energía de 182.05 eV y 184.45 eV, respectivamente, mientras que los valores correspondientes para el MoS 2 / ZrO 2 muestra son 182,10 eV y 184,50 eV, respectivamente. El cambio de nivel central de Zr 3d 5/2 o 3d 3/2 ~ 0.05 eV está en el rango de error de procesamiento de datos y medición. En comparación con el ZrO 2 desnudo muestra, MoS multicapa 2 ejerció pequeños efectos sobre el espectro de Zr 3d como se muestra en la Fig. 2b. Entonces, la diferencia de energía entre el Zr 3d 5/2 y VBM es 180.17 eV y 182.04 eV para el ZrO 2 desnudo muestra y MoS 2 / ZrO 2 muestra, respectivamente. En consecuencia, el valor de VBO para el MoS multicapa 2 / ZrO 2 La interfaz es de aproximadamente 1,87 ± 0,05 eV, principalmente como resultado de la diferencia de VBM entre el ZrO 2 desnudo y MoS 2 / ZrO 2 . De manera similar, para el MoS multicapa 2 / ZrO 2 muestra con CHF 3 tratamiento con plasma antes de MoS 2 transferencia, el VBM es aproximadamente 0.02 eV como se muestra en la Fig. 2c, casi idéntico a la muestra sin CHF 3 tratamiento. Sin embargo, el espectro de Zr 3d se mueve hacia una energía más alta en aproximadamente 0,75 eV, Zr 3d 5/2 ~ 182,85 eV y 3d 3/2 ~ 185,25 eV, lo que indica que el valor de VBO aumentó en aproximadamente 0,75 ± 0,04 eV después del grabado con plasma. Entonces, el valor CBO ∆E C se puede obtener de acuerdo con la fórmula
$$ \ Delta {\ mathrm {E}} _ {\ mathrm {C}} ={E} _ {G, ZrO2} - {E} _ {G, MoS2} - \ Delta {E} _V. $$ (1)donde E G , ZrO 2 y E G , MoS 2 son la banda prohibida de ZrO 2 y MoS 2 , respectivamente, y ∆E V corresponde al valor VBO. Normalmente, la energía de la banda prohibida del aislante de óxido se puede obtener del espectro de energía de pérdida de O 1 s [25]. La Figura 3a muestra el espectro de pérdida de energía de O 1 s de ZrO 2 y el E G , ZrO 2 es aproximadamente 5,56 eV calculado a partir de la diferencia de energía extrapolando la línea base del borde lineal (535,95 eV) ajustada a la energía del nivel del núcleo de los enlaces Zr-O (530,39 eV). La banda prohibida de MoS 2 en este trabajo es de aproximadamente 1,2 eV. Por lo tanto, el valor de CBO para la muestra sin CHF 3 el tratamiento es de aproximadamente 2,49 eV y 1,74 eV para la muestra con CHF 3 tratamiento. Luego, las estructuras esquemáticas de la ingeniería de bandas para las muestras sin y con CHF 3 El tratamiento con plasma se ilustra en la Fig. 3b. Obviamente, el MoS multicapa 2 / ZrO 2 El sistema tiene una alineación de tipo I, que facilita los electrones y los huecos confinados en el MoS 2 . Mientras tanto, el gran ∆E C y ∆E V para MoS 2 / ZrO 2 interfaz implica que ZrO 2 Podría ser un buen dieléctrico de puerta para MoS 2 multicapa de canal n o p Aplicación basada en FET en términos de supresión de corriente de fuga de puerta. Además, la muestra con tratamiento con plasma tiene un VBO ∆E más alto V (CBO inferior ∆E C ) en comparación con la muestra sin tratamiento con plasma, que es mejor en la aplicación de FET de canal p.
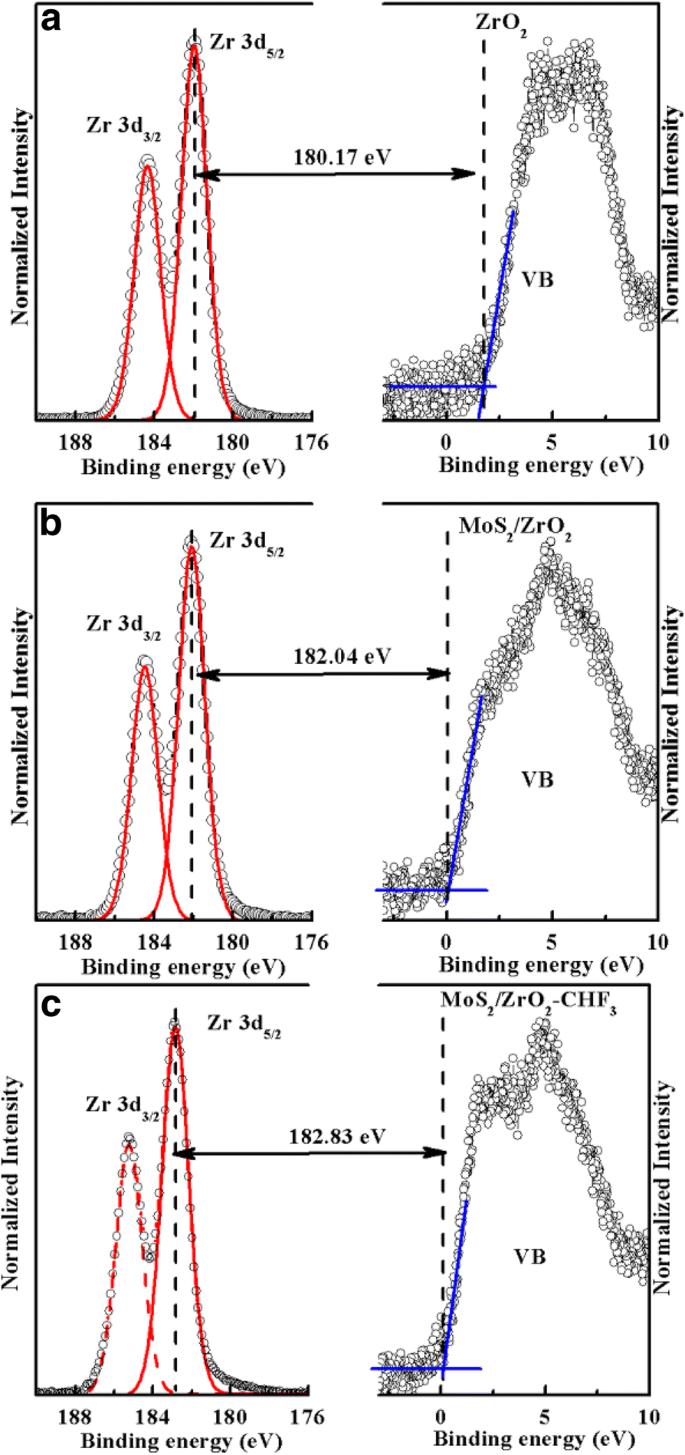
Los espectros de banda de valencia y Zr 3d a nivel de núcleo para a desnudo ZrO 2 óxido, b multicapa-MoS 2 / ZrO 2 sample y c CHF 3 MoS 2 multicapa tratado con plasma / ZrO 2 muestra

un Espectros de pérdida de energía de fotoelectrones de O 1 s para el ZrO 2 óxido. b La estructura esquemática de la alineación de la banda de energía en el MoS 2 / ZrO 2 interfaz sin (arriba) y con (abajo) CHF 3 tratamiento con plasma. c Los perfiles de profundidad SIMS (Si, Zr y F) para la muestra con CHF 3 tratamiento con plasma
El cambio de la alineación de la banda en el MoS multicapa 2 / ZrO 2 Se cree que la interfaz está estrechamente relacionada con la capa interfacial rica en F inducida por el CHF 3 tratamiento con plasma. La Figura 3c muestra el resultado SIMS de la muestra tratada con plasma para los elementos Zr, F y Si, presentando un pico obvio de iones F en la interfaz. Mientras tanto, algunos iones F se difundieron en el ZrO 2 subyacente capa debido a su pequeño tamaño. En el MoS 2 / ZrO 2 interfaz con CHF 3 tratamiento con plasma, el agrandamiento del VBO (reducción del CBO) se atribuye principalmente al cambio hacia arriba de los niveles centrales de Zr 3d que se muestran en la Fig. 2c, lo que indica que los iones F tienen una fuerte interacción con los átomos de Zr. Luego, los efectos de CHF 3 tratamiento de las propiedades electrónicas del ZrO 2 El óxido se investigó utilizando Material Studio combinado con el Paquete de Energía Total Secuencial de Cambridge (CASTEP) basado en la teoría funcional de la densidad (DFT) [26]. La aproximación de gradiente generalizada para el intercambio y el potencial de correlación propuesta por Perdew-Burk-Ernzerhof (PBE) [27] se utilizó para tratar las interacciones ion-electrón junto con el potencial de onda aumentado del proyector (PAW) [28]. La energía de corte de la onda plana se elige en 750 eV, y se utiliza una malla k Monkhorst-Pack de 1 × 1 × 1 para muestrear la zona de Brillouin en la optimización de la estructura y el cálculo de la energía total [29]. Todos los átomos se relajaron a sus posiciones de equilibrio hasta que los cambios de energía total durante la optimización finalmente convergieron a menos de 10 −6 eV / átomo, la fuerza y la tensión en cada átomo convergieron a 0.003 eV / nm y 0.05 GPa, respectivamente, y el desplazamiento convergió a 1 × 10 −4 Nuevo Méjico. La Figura 4a, b muestra la densidad total y parcial de estados (DOS) para MoS 2 / ZrO 2 muestras, donde cero eV corresponde al nivel de Fermi. Obviamente, los iones F tienen una fuerte interacción con los átomos de Zr, lo que hace que parte del orbital d de los átomos de Zr que se proyecta en la banda de valencia se mueva hacia abajo alrededor de 0,76 eV desde - 0,06 a - 0,82 eV por debajo del nivel de Fermi, lo cual es consistente con la ampliación del desplazamiento de la banda de la cenefa ∆E V ~ 0,75 eV. Los átomos de F tienden a atraer electrones debido a la gran electronegatividad (4.0) y se cargan parcialmente negativamente y luego forman dipolos con átomos de Zr, lo que eventualmente contribuye al cambio del desplazamiento de banda. Por lo tanto, la banda cambia en el MoS 2 / ZrO 2 interfaz introducida por CHF 3 El tratamiento con plasma proporciona una forma prometedora de ajustar la alineación de la banda en las heterouniones, lo que facilita el diseño de los dispositivos relacionados.

La densidad total de estados calculada (TDOS) y la densidad parcial de estados (PDOS) para las muestras sin CHF 3 tratamiento ( a ) y con CHF 3 tratamiento ( b )
Conclusiones
En este artículo, exploramos la ingeniería de bandas de energía en el MoS 2 multicapa / ZrO 2 interfaz e investigó los efectos de CHF 3 tratamiento mediante espectroscopia de fotoelectrones de rayos X. Los resultados demostraron que se formó una alineación de tipo I en el MoS 2 / ZrO 2 interfaz de heterounión con CBO y VBO alrededor de 2,49 eV y 1,87 eV, respectivamente. Mientras que el CHF 3 El tratamiento con plasma aumenta el VBO en aproximadamente 0,75 ± 0,04 eV principalmente debido al cambio hacia arriba de la energía a nivel del núcleo de Zr 3d, que es coherente con los resultados del cálculo. Este trabajo demuestra las grandes aplicaciones potenciales de alto κ ZrO 2 óxido en MoS multicapa 2 -basados en dispositivos y proporciona una forma posible de modificar la alineación de la banda de energía de la interfaz.
Abreviaturas
- 2D:
-
Bidimensional
- CASTEP:
-
Paquete de energía total secuencial de Cambridge
- CBO:
-
Desplazamiento de la banda de conducción
- CVD:
-
Deposición de vapor químico
- DFT:
-
Teoría funcional de la densidad
- DOS:
-
Densidad de estados
- FET:
-
Transistores de efecto de campo
- FWHM:
-
Ancho completo a la mitad del máximo
- MoS 2 :
-
Disulfuro de molibdeno
- PAW:
-
Proyector de onda aumentada
- PBE:
-
Perdew-Burk-Ernzerhof
- PMMA:
-
Polimetacrilato de metilo
- SIMS:
-
Espectrometría de masas de iones secundarios
- TDMAZr:
-
Tetrakis dimetil amido circonio
- TEM:
-
Microscopía electrónica de transmisión
- TMD:
-
Dicalcogenuros de metales de transición
- VBO:
-
Desplazamiento de la banda de valencia
- XPS:
-
Espectroscopia de fotoelectrones de rayos X
- ZrO 2 :
-
Dióxido de circonio
Nanomateriales
- Usos del molibdeno en la industria del acero
- Usos del molibdeno en la industria química
- ¿Cuáles son los tipos y usos de la varilla de molibdeno?
- Aplicaciones de molibdeno y aleaciones de molibdeno
- El impacto de la condición en la eficiencia y confiabilidad del motor
- Uso de ángulos para mejorar el futuro de la electrónica
- Absorbedor perfecto de banda ultra estrecha y su aplicación como sensor plasmónico en la región visible
- Fabricación y caracterización de nanoclips de ZnO mediante el proceso mediado por poliol
- Hacer el cambio a lo verde:pros y contras de la energía eólica
- Asegurar OT en el sector de energía y servicios públicos
- La historia del aserrado de cinta y sus ideas innovadoras



