Análisis de distribución Bi en GaAsBi epitaxial mediante HAADF-STEM con corrección de aberraciones
Resumen
El contenido de Bi en GaAs / GaAs 1 - x Bi x Las heteroestructuras de / GaAs cultivadas por epitaxia de haz molecular a una temperatura del sustrato cercana a 340 ° C se investigan mediante técnicas de campo oscuro anular de ángulo alto con corrección de aberración. El análisis a bajo aumento de imágenes de microscopía electrónica de transmisión de barrido de campo oscuro anular de alto ángulo, corroborado por el análisis EDX, reveló capas planas libres de defectos y una distribución Bi no homogénea en las interfaces y dentro de la capa GaAsBi. A gran aumento, el análisis qHAADF confirmó la distribución no homogénea y la segregación de Bi en la interfaz GaAsBi / GaAs con un flujo de Bi bajo y una forma de mancuerna distorsionada en áreas con mayor contenido de Bi. A un mayor flujo de Bi, el tamaño de la acumulación de Bi aumenta, lo que lleva a partículas ricas en Bi aproximadamente equiaxiales facetadas a lo largo de la mezcla de zinc {111} y uniformemente dispersas alrededor de la matriz y las interfaces. El análisis FFT comprueba la coexistencia de dos fases en algunos grupos:una Bi (rh-Bi) pura romboédrica rodeada por una mezcla de zinc GaAs 1 - x Bi x matriz. Los clústeres pueden estar afectando la relajación de la red local y dando lugar a un sistema GaAsBi / GaAs parcialmente relajado, de acuerdo con el análisis XRD.
Antecedentes
Hoy en día, los semiconductores basados en GaAsBi están atrayendo interés como dispositivos de infrarrojos medios y de temperatura estable [1]. La adición de una pequeña cantidad de Bi en la red de GaAs conduce a una gran reducción de la banda prohibida, siendo uno de los efectos optoelectrónicos más interesantes [2, 3]. Sin embargo, incorporar incluso una pequeña cantidad de Bi en GaAs es un desafío debido a la débil energía de enlace Ga – Bi, la gran brecha de miscibilidad y la gran diferencia en la constante de red entre GaBi y GaAs. En consecuencia, GaAsBi tiene que cultivarse bajo un proceso dinámico de no equilibrio para una incorporación eficiente de Bi. Aunque incluso si se sintetiza con éxito, la distribución de Bi a veces no es uniforme, lo que aumenta la densidad de los centros de recombinación no radiativa y, por lo tanto, afecta su eficiencia en la operación láser. El gran tamaño y la baja electronegatividad de Bi tienden a producir separación de fases [4], gotitas superficiales [5, 6], ordenamiento atómico [7,8,9], gotitas de líquido a nanoescala [10] o agrupaciones de Bi durante el crecimiento epitaxial. La presencia de racimos de Bi fue detectada previamente por Ciatto et al. mediante una combinación de espectroscopía de absorción de rayos X (XAS), microscopía de fuerza atómica y técnicas de difracción de rayos X (XRD) [11]. Luego, varios autores informaron de la presencia de grupos de Bi en muestras recocidas de GaAsBi mediante el uso de diferentes técnicas de microscopía electrónica de transmisión [4, 12, 13]. Además, Kunzer et al. [14] confirmó por resonancia de espín de electrones convencional (ESR) que aproximadamente el 10% del Bi incorporado había ocupado los sitios Ga en las capas de GaAsBi. Por lo tanto, comprender y controlar la incorporación de Bi y la formación de defectos es fundamental para la aplicación exitosa de GaAsBi a los dispositivos. Cabe mencionar que el desarrollo de nuevos materiales basados en Bi está vinculado al avance de las herramientas de caracterización. En este sentido, las técnicas de microscopía electrónica de transmisión de barrido de campo oscuro anular de alto ángulo (HAADF-STEM) en microscopios con corrección de aberraciones desempeñan un papel importante en la obtención de información a nivel subangstrom [15, 16]. En esta técnica, la intensidad de las imágenes es aproximadamente proporcional al número atómico promedio ( Z ) en la columna atómica proyectada, por lo que se puede aplicar con éxito en heteroestructuras diluidas de Ga (AsBi) debido a la gran diferencia en el número atómico de Bi con respecto a As y Ga. Además, las características brillantes en las imágenes HAADF, contrariamente a la La microscopía electrónica de transmisión de alta resolución (HRTEM), se puede asociar a columnas atómicas en un cristal alineado debido a la falta de inversiones de contraste y deslocalización. Además, las imágenes HAADF con corrección de aberraciones de muestras de GaAsBi muestran una baja dependencia del grosor de la muestra y una dependencia casi lineal de la composición de As / Bi [12]. Además, aplicando el algoritmo cuantitativo de análisis de imágenes HAADF (qHAADF), desarrollado por Molina et al. [17], es posible correlacionar eficazmente la intensidad de HAADF y la composición de la columna atómica en materiales semiconductores ternarios III-V [12, 16, 18] y, en consecuencia, en compuestos de GaAsBi. Además, las imágenes HAADF-STEM de alta resolución ofrecen información sobre la calidad cristalina [19,20,21,22].
En este trabajo, investigamos a través de imágenes HAADF-STEM con corrección de aberración y rayos X complementarios de dispersión de energía (EDX), la distribución de Bi en GaAs / GaAs 1 - x Bi x / Heteroestructuras de GaAs cultivadas por epitaxia de haz molecular (MBE) a una temperatura del sustrato cercana a los 340 ° C. También estudiamos el efecto de la recolección de Bi a nano y microescala. Para ello, hemos utilizado el enfoque qHAADF, el análisis de transformada rápida de Fourier (FFT) de imágenes de alta resolución y las técnicas XRD.
Métodos
Estudiamos una serie de dos muestras que constan de GaAs / GaAs 1 - x Bi x / Heteroestructuras de GaAs cultivadas por MBE de fuente sólida en 2 ″ n + GaAs:Obleas de Si (001) con diferente flujo Bi dado por las temperaturas de celda Bi S1 (460 ° C) y S2 (505 ° C). El sistema utilizado fue una máquina VG V80 MBE con una presión de fondo en reposo promedio de ~ 5 × 10 - 10 mbar. Las estructuras consisten nominalmente en un tampón de GaAs de 130 nm, una capa de GaAsBi de 130 nm, una capa espaciadora de GaAs de 5 nm y luego una capa de GaAs de 130 nm. Antes del crecimiento, el sustrato se desgasificó a 400 ° C durante 20 min y luego se eliminó el óxido de la superficie a 600 ° C. El tampón y la tapa de GaAs se cultivaron a ~ 580 ° C bajo un As 2 flujo, mientras que la capa de GaAsBi y la capa espaciadora de GaAs se cultivaron a ~ 340 ° C bajo un As 4 casi estequiométrico flujo. Por lo tanto, la capa de GaAsBi se recoció in situ a ~ 580 ° C durante ~ 20 min durante el crecimiento de la capa de GaAs. En estas condiciones de crecimiento, no se observaron gotas metálicas en la superficie. Las temperaturas del sustrato se estimaron mediante termometría óptica, y los resultados se calibraron contra las transiciones de reconstrucción de la superficie a temperaturas conocidas. Antes del crecimiento de GaAsBi, la superficie de la muestra se expuso a un flujo Bi durante 20 s; El propósito de este paso fue establecer una capa de superficie de Bi y mejorar la incorporación de Bi al comienzo del crecimiento de GaAsBi.
Las probetas para HAADF-STEM se prepararon en sección transversal mediante molienda mecánica y Ar + Fresado de iones mediante un sistema de pulido de iones de precisión (PIPS), con inclinaciones del haz de - 3 ° y + 4 ° y energía del haz entre 2,8 y 3,0 kV. En el último paso de molienda, la energía iónica se redujo a 1,5 kV para mejorar la calidad de la superficie. Las muestras antes de ser estudiadas se limpiaron con plasma para reducir el efecto de la deposición del haz de electrones en la superficie de la muestra [23]. Imágenes HAADF-STEM, espectro de pérdida de energía de electrones de pérdida cero (EELS) y escaneos de líneas de espectros de rayos X de dispersión de energía se realizaron a 200 kV, utilizando un Titan 3 Themis a 60–300 kV. El titán 3 Themis está equipado con una pistola de emisión de campo frío (FEG), un corrector de sonda Cs y un monocromador de electrones, lo que permite la resolución atómica en las imágenes HAADF. Este microscopio también incluye un detector EDX cuádruple Super-X para análisis elemental, que proporciona información sobre la posición y composición del átomo simultáneamente. Las imágenes de electrones secundarios (SE) para el estudio topográfico de la muestra TEM se realizaron utilizando un microscopio FEI NOVA NANOSEM 450 a 2 kV.
La línea Bi-M a 2,42 keV se utilizó para la determinación cuantitativa de la composición de Bi a través del software Bruker Espirit. El grosor de la muestra se determinó a partir del análisis de la señal EELS de pérdida cero resuelta espacialmente, utilizando el software Digital Micrograph (GATAN ™) [23]. La distribución Bi columna por columna se ha estudiado utilizando el software qHAADF disponible para ejecutarse en Digital Micrograph. Este software permite medir y mapear la intensidad integrada de áreas seleccionadas alrededor de columnas atómicas detectando picos de intensidad en la imagen HAADF-STEM [17]. Los espectros XRD ω-2θ (0 0 4) se midieron con un difractómetro de rayos X Bruker D8 Discover utilizando Cu-Kα 1 radiación. Los escaneos se simularon utilizando el software Bede Rads Mercury.
Resultados y discusión
La Figura 1 muestra imágenes HAADF-STEM de bajo aumento tomadas en el eje de la zona [110] de las muestras S1 (a) y S2 (b), junto con los perfiles de intensidad corregidos por gradiente de espesor tomados a lo largo de la dirección [001] de las regiones marcadas en las imágenes HAADF-STEM (rectángulos verdes). No se detectaron dislocaciones de roscado o fallas de apilamiento en las regiones estudiadas de ambas muestras. En HAADF, la intensidad obtenida es proporcional al número atómico medio. Entonces, para un grosor de muestra constante, el contraste más brillante en la imagen está relacionado con un mayor contenido de Bi ( Z Bi =83, Z Ga =31 y Z Como =33). Esto hace posible el estudio de la distribución de Bi en heteroestructuras GaAsBi / GaAs. Como se puede observar en la Fig. 1a, no se detectan variaciones claras de contraste en la capa de GaAsBi en la muestra S1, con un contenido de Bi más bajo, que no muestra evidencia clara de agrupamiento, ni siquiera en otras áreas con mayor espesor de muestra. Sin embargo, en la literatura se han descrito agrupaciones de Bi y As, incluso para muestras de GaAsBi con un contenido de Bi tan bajo como 1,44%, aunque se cultivan a temperaturas más bajas [11]. Con respecto a la muestra S2, con un mayor contenido de Bi, la Fig. 1b muestra algunas áreas con un contraste más brillante en la capa con un tamaño y distribución relativamente homogéneos. Estas regiones, distribuidas regularmente a lo largo de la capa y las interfaces de GaAsBi, pueden interpretarse directamente como agrupaciones que contienen Bi debido a su mayor intensidad de HAADF. Para una mejor visualización, la imagen filtrada de paso bajo correspondiente se muestra como un recuadro en la misma imagen, donde el color amarillo corresponde a las áreas de mayor contenido de Bi y el negro a las más bajas (escala de temperatura). La formación de grupos Bi en GaAsBi sin provocar defectos estructurales ha sido previamente informado por otros autores [7, 24, 25]. La integración de Bi (1,6 veces el volumen atómico de As) en la matriz de GaAs puede provocar un aumento de la energía de sustitución debido a la deformación, reduciendo la solubilidad de los átomos de As y permitiendo la acumulación de los de Bi. Se realizó un estudio de la muestra utilizando un microscopio electrónico de barrido con pistola de emisión de campo (FEG-SEM) para garantizar que los grupos de Bi estén incrustados dentro de la capa. Para ese propósito, las imágenes topográficas de electrones secundarios adquiridas a bajo voltaje (que no se muestran aquí) se compararon con las STEM tomadas de la misma área.

un Imágenes HAADF-STEM transversales de la muestra S1 que muestran interfaces GaAs / GaAsBi / GaAs. b Imagen HAADF-STEM de corte transversal de la muestra S2, en la capa de GaAsBi se observan puntos brillantes distribuidos a lo largo de la capa de GaAsBi relacionados con áreas ricas en Bi. Los detalles que utilizan la escala de colores de temperatura de un área después de aplicar un filtro de paso bajo se incluyen como un recuadro en la misma imagen para una mejor visualización. c Perfiles de intensidad corregidos por gradiente de espesor tomados a lo largo de la dirección [001] de las regiones marcadas con rectángulos verdes en las imágenes HAADF-STEM, línea azul para la muestra S1 y línea negra para la muestra S2, mostrando un comportamiento ligeramente diferente en las interfaces
Para obtener más información sobre la distribución de Bi en las muestras, los perfiles de intensidad a lo largo de la dirección de crecimiento con gradiente de espesor corregido se muestran en la Fig. 1c. Los perfiles, tomados de las imágenes HAADF-STEM en la Fig. 1a, b, señalan un comportamiento similar en ambas muestras:interfaces aproximadamente abruptas, capas de GaAsBi de longitud similar (~ 140 nm). Con respecto a la interfaz GaAsBi / GaAs, la intensidad de HAADF cae desde su valor máximo a ~ 0 en aproximadamente 10 nm (vea el rectángulo de rayas grises en el perfil), lo que sugiere cierta incorporación de Bi en toda la capa de la capa de GaAs incluso sin Bi flux. Los perfiles también muestran información sobre el tiempo de equilibrio. Como se puede observar en los perfiles, en la muestra de menor contenido de Bi (S1), la interfaz GaAs / GaAsBi es más abrupta que en la muestra de mayor contenido de Bi (S2). Esto puede explicarse por los diferentes coeficientes de incorporación de Bi de las dos muestras. S1, aunque se cultiva a la misma temperatura que S2, tiene un contenido de Bi mucho menor. Por lo tanto, es probable que S1 crezca en condiciones cinéticamente limitadas con una incorporación de Bi cercana a la unidad [26], lo que significa que la capa de superficie de Bi se equilibrará durante un período de tiempo menor que la vida útil de la superficie de un átomo de Bi a esta temperatura. S2, por otro lado, probablemente tiene un coeficiente de incorporación de Bi más bajo [27]. En este caso, la capa superficial de Bi tardaría más que la vida útil de la superficie de un átomo de Bi en equilibrarse, lo que conduciría a una estabilización más lenta de la incorporación de Bi.
Para confirmar la correlación realizada entre los perfiles de intensidad HAADF-STEM y la distribución Bi en la heteroestructura, se tomaron simultáneamente mapas composicionales STEM-EDX Bi de las muestras. Se muestran en la Fig. 2 para muestras con flujo bi bajo (a) y alto (b). Los correspondientes perfiles de composición de Bi a lo largo de la dirección de crecimiento, determinados mediante la integración de los espectros EDX puntuales de un área de alrededor de 130 nm, se muestran en la Fig. 2c como líneas azules y negras, respectivamente. Estos perfiles de composición muestran la misma tendencia detectada en las interfaces GaAs / GaAsBi / GaAs mediante análisis HAADF de bajo aumento. La fracción atómica Bi promedio en las capas de GaAsBi se cuantificó a partir de los espectros EDX correspondientes siendo 1,2 ± 0,4% y 5,3 ± 0,4% en las muestras S1 y S2, respectivamente, mostrando una distribución no homogénea de Bi en la capa de GaAsBi en ambas muestras. .

Mapas elementales STEM / EDX que representan la distribución de Bi en las muestras S1 ( a ) y S2 ( b ). Los detalles de los mapas elementales de Bi, Ga y As correspondientes al grupo marcado con un rectángulo blanco en la Fig. 1b revelan una caída en las señales de As y Ga donde hay una región de Bi alta. c Perfiles de contenido bi a lo largo de la dirección extraídos después de la integración de un área de alrededor de 130 nm del mapa EDX de las muestras S1 (línea azul) y S2 (línea negra). Se observaron características similares en los perfiles de intensidad a bajo aumento que se muestran en la Fig. 1c
La presencia de racimos de Bi se debería a un efecto de impedimento estérico. En este caso, la tensión superficial puede aumentar debido al mayor tamaño atómico de los átomos de Bi, por lo que para reducir la tensión en la estructura, los átomos de Bi podrían estar bloqueando la incorporación de Ga y, en consecuencia, provocando vacantes de Ga en la red. Se incluyen mapas de composición de Ga y As del grupo rodeado por un cuadrado blanco en la Fig. 2b para mostrar cómo caen ambas señales donde hay una señal de Bi alta. Esto sugiere que, en este grupo particular, Bi podría estar ocupando sub-redes tanto del grupo III como del grupo V. Esto también evidencia que los grupos no son superficiales formados durante la preparación de la muestra TEM.
Para llevar a cabo un estudio profundo de la distribución de Bi a nivel atómico, se tomaron imágenes HAADF-STEM corregidas por aberraciones de gran aumento en la proyección [110]. En esta aleación de semiconductores III-V, los dos picos de intensidad máxima de una mancuerna corresponden a las columnas atómicas del grupo III y del grupo V. Para correlacionar correctamente la intensidad en las columnas atómicas con su composición, el nivel de fondo se ha eliminado de las imágenes experimentales HAADF-STEM. Luego, se ha llevado a cabo una ubicación automática de los picos de intensidad, y se seleccionan cuidadosamente las áreas de integración alrededor de las columnas atómicas del grupo V. Las intensidades integradas se miden y mapean para cada mancuerna utilizando el enfoque qHAADF. El procedimiento para cuantificar el contenido de Bi fue similar al publicado en la Ref. [28]. En este trabajo, los cocientes de intensidad integrados de cada mancuerna ( R ) se calculó como una relación entre la intensidad integrada en las columnas del grupo V ( I Como - Bi ) en la imagen completa y la intensidad media integrada en las columnas del grupo V en la capa GaAs ( I Como ), como R =( yo (As - Bi) ) / yo Como .
La Figura 3a muestra una imagen HAADF-STEM de gran aumento de la interfaz GaAs / GaAsBi tomada de la muestra con contenido pobre de Bi (S1). El mapa de intensidad integrado normalizado coloreado de la imagen HAADF se muestra en la Fig. 3b. Los puntos de colores que van desde 1 (azul profundo) a 1,27 (rojo) representan el contenido de Bi en las columnas del grupo V. Como se puede observar, pequeñas fluctuaciones en R los valores del valor medio se encuentran en ambas capas. Para comparar la dispersión de los resultados obtenidos, hemos calculado el coeficiente de correlación Cv (definida como la relación entre la desviación estándar y la media R valor) en el GaAs (sustrato), la capa de GaAsBi y la capa superior de GaAs. El Cv los valores fueron 1.3, 2.6 y 2.6%, respectivamente, ya que las fluctuaciones observadas en la interfase GaAsBi / GaAs son mayores que las encontradas en el sustrato GaAs tomado como referencia; podemos considerar que estas variaciones en R los valores están relacionados con cambios en la composición de la columna Bi. La causa del Cv distinto de cero El factor en el sustrato puede deberse a fluctuaciones de espesor local, ruido del detector (medido en una región sin material como 0,6%) o hidrocarburos que se depositan en la muestra de superficie durante la caracterización microscópica.

un Imagen HAADF-STEM de sección transversal [110] de la interfaz GaAsBi / GaAs de la muestra S1. El detalle de una región no distorsionada en la capa de GaAs y pesas de anión-catión distorsionadas en un área rica en Bi con mayor aumento se incluyen como un recuadro en la misma imagen. b Mapa de colores que representa R valores alrededor de las columnas del grupo V de la imagen HAADF en la Fig. 3a. El color verde corresponde a la composición de Bi media en la capa de GaAsBi medida por EDX. A pesar de la distribución homogénea de Bi en la imagen HAADF-STEM, el mapa de intensidad muestra áreas con alta probabilidad de nanoclustering (puntos rojos) y columnas con contenido de Bi relativamente pobre (puntos azules) en la capa GaAsBi. c Perfil a lo largo de la dirección de crecimiento de toda la R mapa de intensidad, que muestra una interfaz GaAsBi / GaAs borrosa en aproximadamente 10 nm
Este análisis qHAADF confirma una interfaz superior GaAsBi / GaAs no abrupta sobre unos 10 nm percibida a bajo aumento, principalmente debido a la segregación de la superficie Bi durante el crecimiento, como se puede observar en el perfil tomado a lo largo de la dirección de crecimiento en toda la intensidad R mapa, que se muestra en la Fig. 3c. Además, las columnas Bi-rich dispersas dentro de la capa de GaAsBi (puntos rojos), junto con las áreas con un contenido pobre de Bi (puntos azules) en la capa de GaAsBi, también se detectan con este software, lo que confirma las fluctuaciones del contenido de Bi en la capa de GaAsBi. . La presencia de columnas ricas en Bi parece estar produciendo una clara distorsión en la forma de la mancuerna, como se puede apreciar en el recuadro con mayor aumento en la Fig. 3a. La sustitución de átomos de As por átomos Bi más grandes durante el crecimiento epitaxial habría ampliado localmente la red de la matriz, provocando una distorsión en la forma de la mancuerna mientras se mantiene la estructura.
Las técnicas HAADF-STEM también permiten el análisis estructural y composicional de los grupos detectados a bajo aumento en la muestra S2. Estos racimos, distribuidos casi homogéneamente, ocupan alrededor del 20-30% de la superficie de la capa de GaAsBi. Para conocer la composición de Bi, la forma y el tamaño de los grupos encontrados, se tomaron imágenes HAADF-STEM con corrección de aberración en la proyección [110] y se realizaron mapas elementales EDX y relaciones de mapas de intensidad alrededor de las columnas del grupo V. Para identificar las diferentes fases cristalinas, se llevó a cabo un estudio de transformada rápida de Fourier (FFT) en las imágenes de alta resolución en diferentes áreas dentro y cerca de los cúmulos.
La Figura 4a muestra una imagen HAADF-STEM de alta resolución [110] de la interfaz GaAsBi / GaAs con un grupo Bi claro de aproximadamente 12 nm de diámetro. Los rectángulos rojos en la imagen representan las áreas donde se realizó el estudio FFT. Es bien sabido que el filtrado de paso bajo no solo reduce la cantidad de ruido en los datos, sino que también elimina las características periódicas observadas en la imagen sin procesar, enfatizando los bordes del grupo Bi. La imagen HAADF-STEM filtrada, siguiendo el procedimiento descrito por Werner et al. [29], se muestra en la Fig. 4b. Como se puede apreciar, las facetas {111} y (001) en el área más brillante son claramente observables. Sin embargo, la distribución de intensidad sugiere la presencia de dos volúmenes de composición diferentes en la partícula:uno rico en Bi con forma trapezoidal rodeado por un área menos rica en Bi. Se observó una forma de racimo similar para Wood et al. en un GaAs de cinco períodos 1 - x Bi x / GaAs 1 - años Bi y estructura [10].
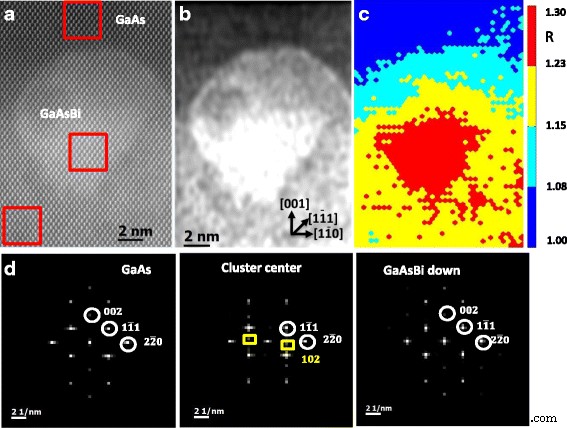
un Imagen HAADF-STEM de sección transversal [110] de la interfaz GaAsBi / GaAs de la muestra S2, capturando un grupo Bi de aproximadamente 12 nm de tamaño, junto a la interfaz GaAsBi / GaAs. b La imagen de filtrado bajo de la imagen HAADF-STEM muestra dos áreas con diferente contraste en la capa de GaAsBi, una zona Bi-rich está facetada a lo largo de los planos {111} y (001), rodeada por una Bi-rich inferior. c Mapa de colores que representa la R valores alrededor de las columnas del grupo V que representan una distribución de Bi graduada alrededor del conglomerado. d La correspondiente transformación de Fourier de las áreas seleccionadas marcadas con rectángulos rojos en la Fig. 1a. Se detectan puntos adicionales que coinciden con {102} planos relacionados con la fase rh-Bi en la región del grupo de mayor contraste
El análisis qHAADF a través de la intensidad R El mapa que se muestra en la Fig. 4c muestra una forma de partícula aproximadamente equiaxial y un gradiente de concentración de Bi que alcanzó su punto máximo en el centro del grupo.
Wu y col. [4] reportaron la presencia de diferentes estructuras cristalográficas en capas de GaAsBi estudiando micrografías HRTEM y modelando la formación y la transformación de fase de blenda de zinc Bi-rica a romboédrica Bi (rh-Bi) nucleada en planos de zinc blenda {111}. En este sentido, cabe mencionar que los puntos brillantes en la FFT de imágenes HAADF-STEM de alta resolución pueden interpretarse como puntos de difracción de planos cristalográficos. Luego, las manchas adicionales en el patrón convencional para la estructura de mezcla de zinc de GaAs deben interpretarse como fases adicionales. Para estudiar la presencia de diferentes estructuras cristalinas en el cúmulo, la Fig. 4d muestra las FFT correspondientes a tres áreas diferentes marcadas como cuadrados rojos en la Fig. 1a. De derecha a izquierda muestra una región homogénea en la capa superior de GaAs, la zona más brillante en la capa de GaAsBi y otra región con menor contraste en la misma capa de GaAsBi. Los círculos blancos indican la posición del pico de difracción con índices de Miller 002, \ (1 \ overline {1} 1 \) y \ (2 \ overline {2} 0 \). Como se puede observar, solo en el centro del cúmulo aparecen manchas claras, marcadas con un cuadrado amarillo, relacionados con planos {102} aproximadamente paralelos a los planos de mezcla de zinc {220}, lo que sugiere que una nueva fase rh-Bi se ha nucleado en la capa de mezcla de zinc GaAsBi. Las FFT también representan una ampliación de los picos de difracción relacionados con los planos {111}. Este pico asimétrico observado puede deberse a las micro-deformaciones causadas por los planos de cizallamiento {111} entre las fases rh-Bi y zinc blende en el grupo.
Para un estudio profundo de la composición de los cúmulos, vale la pena mencionar que cuando los electrones atraviesan un espécimen transparente de electrones con cúmulos incrustados, transportan información no solo sobre el cúmulo, sino también desde la matriz. Entonces, para estimar la composición real del conglomerado, seguimos el mismo procedimiento descrito en la Ref. [25]. Los resultados también señalaron que los conglomerados cercanos a la interfaz GaAsBi / GaAs tienden a ser de tamaño más pequeño (12 nm) con un contenido más alto de Bi (≈ 30%), probablemente debido a la presencia de Bi en la superficie cuando la capa superior comienza a endurecerse. ser crecido. Sin embargo, la mayoría de los grupos ubicados dentro de las capas de GaAsBi tienen un tamaño mayor (16 nm), pero su contenido de Bi es inferior (≈ 22%). Además, en la capa de GaAsBi, se detectaron grupos con contenido superior de Bi (35%) y mayor tamaño (23 nm). Además, como se mencionó anteriormente, el núcleo de algunos clústeres consiste en rh-Bi puro.
Para investigar el estado de deformación de la película epitaxial, se registraron curvas ω-2θ de rayos X de alta resolución. La Figura 5 muestra las exploraciones XRD (004) de las capas de GaAsBi / GaAs en azul y los ajustes simulados en naranja para las muestras S1 (a) y S2 (b). En ambas muestras, el pico de intensidad más agudo y más alto ubicado en 0 ° segundos de arco corresponde al sustrato de GaAs, mientras que el pico amplio de menor intensidad ubicado en segundos de arco negativos corresponde a la capa de GaAsBi deformada. El ángulo entre los picos se relaciona con la cantidad de desajuste de celosía entre ambas capas. El hombro a la derecha del pico de GaAs en el espectro de S2 indica una capa de GaAs sometida a deformación por tracción; esto implica la relajación de la deformación en la capa S2 GaAsBi. El espectro XRD de la muestra S1 se ajustó bien usando la fracción Bi y los espesores dados por las mediciones de EDX y HAADF. No hay indicios de relajación de la deformación en el espectro XRD de la muestra S1. El espectro XRD de la muestra S2 fue más problemático de ajustar. La Figura 5b muestra los datos modelados por una capa uniforme de GaAsBi del 5,8%, según lo determinado por el análisis HAADF-STEM, ignorando los grupos ricos en Bi, y una relajación de la capa de GaAsBi del 6%, según se determina ajustando la curva XRD; esto sería razonable si los conglomerados no fueran coherentes con el resto de la matriz GaAsBi. Este modelo no representa con precisión la capa; mientras que la división sustrato-GaAsBi es suficiente para tener en cuenta los datos, no es visible ningún pico de tensión de GaAs a ~ 250 ° segundos de arco. El pico de tensión de GaAs sugiere que se ha producido relajación dentro de la capa. La relajación de una capa compresiva reducirá la constante de celosía fuera del plano, lo que implica que el contenido de Bi promedio modelado de 5.8% es una subestimación del promedio real; esto es consistente con la observación de grupos ricos en Bi en la capa. No se observaron picos correspondientes a ~ 22-35% de GaAsBi mediante el mapeo del espacio recíproco (no se muestra), lo que sugiere que los grupos pueden no ser coherentes con la matriz de GaAsBi. No se intentó ningún otro modelado del espectro S2 XRD.

Datos de difracción de rayos X (líneas azules) y ajustes simulados (líneas naranjas) de la muestra S1 ( a ) y muestra S2 ( b ). Líneas punteadas verticales que resaltan el pico de GaAs en 0 ° segundos de arco y el pico de la película GaAsBi ubicado en segundos de arco negativos. El hombro en el pico derecho de GaAs en la Fig. 5b es indicativo de una capa superior de GaAs bajo tensión de tracción
Conclusiones
Los análisis ac-HAADF-STEM ofrecen información útil sobre la estructura y composición de las heteroestructuras de GaAs / GaAsBi / GaAs, y los resultados concuerdan bien con las investigaciones de EDX, FFT y XRD. El análisis de imágenes HAADF-STEM de bajo aumento permitió detectar una distribución Bi no homogénea e interfaces GaAsBi / GaAs no abruptas. A gran aumento, el análisis qHAADF reveló una clara segregación de Bi en la interfaz GaAsBi / GaAs con un bajo flujo de Bi (S1) y una forma de mancuerna distorsionada en áreas con una mayor fracción de Bi, debido a las posiciones de sustitución de As de los átomos de Bi en la subred del grupo V . En un flujo Bi más alto (S2), el tamaño de la reunión de Bi aumenta, lo que conduce a grupos aproximadamente equiaxiales dispersos uniformemente alrededor de toda la matriz y las interfaces. El estudio reveló la coexistencia de dos fases cristalinas diferentes en los clústeres estudiados rh-Bi y planos de cizallamiento de mezcla de zinc {111}, afectando a la relajación de la red local y dando lugar a un sistema GaAsBi / GaAs parcialmente relajado, de acuerdo con el análisis XRD.
Abreviaturas
- Ac-HAADF-STEM:
-
Microscopía electrónica de transmisión de barrido de campo oscuro anular de ángulo alto con corrección de aberraciones
- EDX:
-
Rayos X de energía dispersiva
- EELS:
-
Espectro de pérdida de energía de electrones
- ESR:
-
Resonancia de espín de electrones convencional
- FEG:
-
Pistola de emisión de campo frío
- FFT:
-
Transformada rápida de Fourier
- HRTEM:
-
Microscopía electrónica de transmisión de alta resolución
- IMEYMAT:
-
Instituto Universitario de Investigación en Microscopía Electrónica y Materiales
- MBE:
-
Epitaxia de haz molecular
- qHAADF:
-
Algoritmo cuantitativo de análisis de imágenes HAADF
- SEM:
-
Microscopio electrónico de barrido
- XAS:
-
Espectroscopia de absorción de rayos X
- XRD:
-
Difracción de rayos X
Nanomateriales
- Análisis de forma de onda
- Opciones de análisis
- Análisis de fallas de componentes
- Análisis de fallas de componentes (continuación)
- ¿Qué es el análisis de red?
- Más sobre análisis de espectro
- Mantenimiento industrial del centro de distribución
- Análisis de energía impulsado por software
- DISTRIBUCIÓN DE LA CASA DE USO
- ¿Qué es la distribución de energía?
- ¿Qué es la planificación de la distribución?



