Diseño de patrón de prueba para daño inducido por plasma en dieléctrico inter-metálico en procesos FinFET Cu BEOL
Resumen
Las interconexiones de alta densidad, habilitadas por tecnologías avanzadas CMOS Cu BEOL, conducen a capas de metales colocadas muy cerca. Las líneas de metal de alta relación de aspecto requieren extensos procesos de grabado con plasma, lo que puede causar problemas de confiabilidad en las capas de dieléctrico entre metales (IMD). Este estudio presenta patrones de prueba recientemente propuestos para evaluar el efecto del efecto de carga inducida por plasma sobre la integridad de la IMD entre líneas de metal colocadas muy cerca. Las fuertes correlaciones entre las intensidades de carga de plasma y los daños encontrados en las capas de IMD se encuentran y analizan de manera exhaustiva.
Introducción
Los procesos de back-end de línea (BEOL) basados en Cu se han utilizado ampliamente a medida que las tecnologías migran a un régimen de menos de 100 nm. Las interconexiones compactas constan de vías de alta relación de aspecto y las líneas de metal son posibles gracias a una serie de procesos de grabado mejorados con plasma [1, 2, 3]. Es bien sabido que los tratamientos con plasma de alta energía pueden provocar una degradación significativa y daños latentes en las pilas dieléctricas de las compuertas de los transistores, que se cree que son la principal vía de descarga durante los eventos de carga inducidos por el proceso. Para evitar problemas de confiabilidad en la calidad dieléctrica de la puerta, los fabricantes de circuitos integrados suelen proporcionar reglas y pautas de diseño que limitan el tamaño y la longitud de las capas metálicas interconectadas [4, 5]. Con un mayor número de capas de metal en los complejos sistemas de cableado, es difícil evitar la trayectoria de descarga a través de la película dieléctrica entre metales durante la carga inducida por el proceso. Con la introducción de material de baja k en los procesos BEOL [6, 7], los problemas de retardo RC que se han aliviado y que han empeorado, las películas de aislamiento pueden ser más susceptibles a las tensiones de carga [8, 9]. Los daños resultantes de las tensiones inducidas por la carga de plasma en las estructuras de interconexión compactas responsables de realizar los intrincados cables BEOL pueden afectar en gran medida el rendimiento y la confiabilidad de los circuitos integrados CMOS avanzados. En este estudio, incorporamos los registradores PID in situ reportados previamente [10, 11, 12], con patrones de prueba diferenciales recientemente propuestos para monitorear su posible daño IMD cuando sea posible una ruta de descarga adicional bajo procesos avanzados de Cu BEOL. Los niveles de carga de plasma informados por el registrador en diferentes ubicaciones a través de la oblea pueden correlacionarse con el daño de carga de plasma en las películas IMD a través de los nuevos patrones de prueba. Los comportamientos de falla inducidos por estrés en las estructuras de IMD se pueden revelar fácilmente a través de estos patrones de prueba que se pueden usar en la estructura de prueba estándar para el monitoreo de rutina de nuevos modos de falla y posibles problemas de confiabilidad de IMD.
Estructura y metodología del dispositivo
Los resultados del análisis de fallas en los circuitos integrados de FinFET sugieren que pueden ocurrir daños latentes del aumento de los estados de trampa dentro de las capas dieléctricas entre metales entre dos estructuras de interconexión aisladas ubicadas muy cerca, como se ilustra en la Fig. Reducir agresivamente por adelantado los procesos CMOS BEOL, las cargas recolectadas en grandes alambres metálicos, sirven como antenas, pueden descargarse a través de IMD a través de metales y vías / puertas y alambres metálicos, lo que resulta en tensiones de alto campo y / o alta corriente en estas películas dieléctricas. Al colocar el registrador PID in situ [10,11,12] junto a los dos patrones de prueba diferenciales en cada troquel, primero se pueden establecer los niveles de carga de plasma de referencia en una oblea de 12 pulgadas.
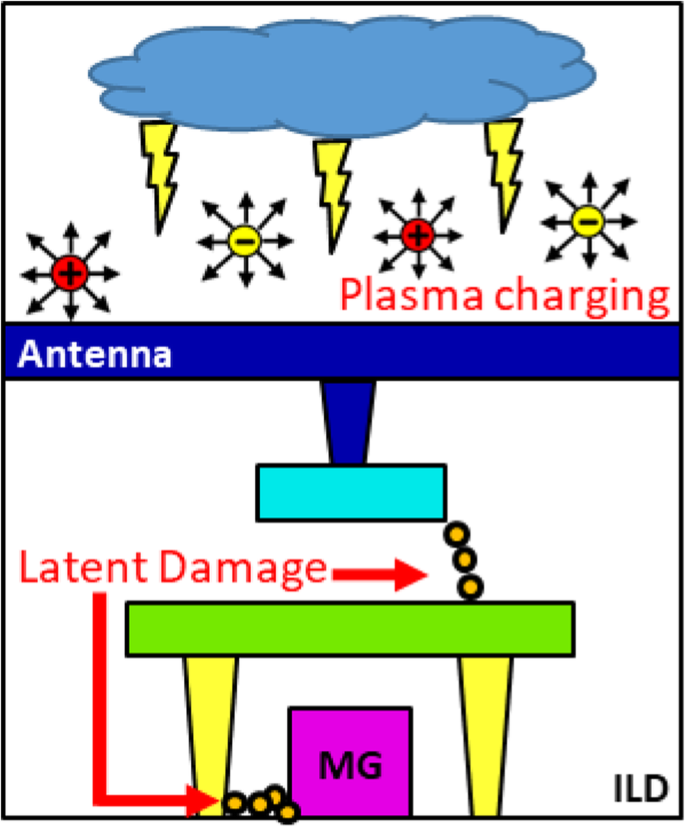
Los daños inducidos por el plasma en las capas dieléctricas entre metales entre patrones de interconexión muy compactos pueden vincularse a la degradación latente de su integridad de aislamiento
Para asegurar que a la corriente de carga de plasma que pasa a través de la capa dieléctrica entre capas de metal, el nodo M2 en el patrón de prueba en la Fig. 2 se aísle antes de hacer la estructura de la antena. En la Fig. 2a, b se proponen y se ilustran dos nuevos diseños de patrones de prueba diferenciales destinados a aumentar la posibilidad de causar el daño latente durante las tensiones de carga de plasma. El dispositivo con patrón de tipo I solo experimentará una alta tensión de corriente cuando los electrones se recojan en su antena correspondiente. Esto se debe a que la corriente de descarga es rectificada por la unión n + / p en serie en la vía conductora. Considerando que, el dispositivo con patrón de tipo II está sujeto a tensiones I en ambas direcciones [13]. Es decir, tanto la carga de iones como la carga de electrones se registrarán en este dispositivo de monitoreo. En consecuencia, las muestras de este estudio se obtienen mediante el proceso estándar FinFET / Cu BEOL en un nodo de tecnología de 16 nm. Las estructuras de antena en un registrador PID, así como los dispositivos con patrones de tipo I y II colocados en cada matriz, están diseñados con una gran estructura de metal 3. Ambos tipos de dispositivos de monitoreo están diseñados con configuración diferencial, lo que puede acentuar y posteriormente minimizar el ruido de desalineación que podría conducir a lecturas de fallas en los efectos PID.
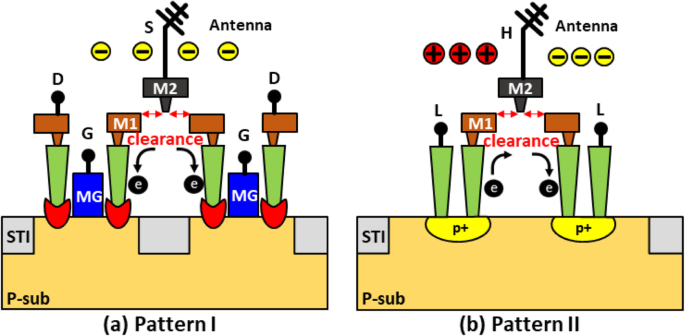
Ilustraciones de patrones de prueba diferenciales recientemente propuestos diseñados para acentuar el efecto del daño latente causado por a inducido por plasma negativo y b tensiones bidireccionales, donde el espacio libre entre la capa de metal se establece en 14 nm
Discusión y resultados experimentales
Los datos de la figura 3 se obtienen aplicando un barrido de voltaje en el metal 2 de 0 a 20 V a una velocidad de barrido de 0,7 V / seg, mientras que el voltaje de ruptura y la corriente de fuga IMD a cada lado de algunos dispositivos diferentes con patrón de prueba Entonces puedo ser obtenido y comparado. Durante la fabricación de la gran antena M3 de 82.000 μm 2 , se espera que el proceso de plasma induzca la carga de la antena. Se espera que la carga acumulada se descargue a través de la vía con la resistencia más baja. Los datos revelan que algunas muestras exhiben una ruptura dieléctrica temprana, mientras que el IMD en otros dispositivos permanece relativamente intacto con pocas fugas.
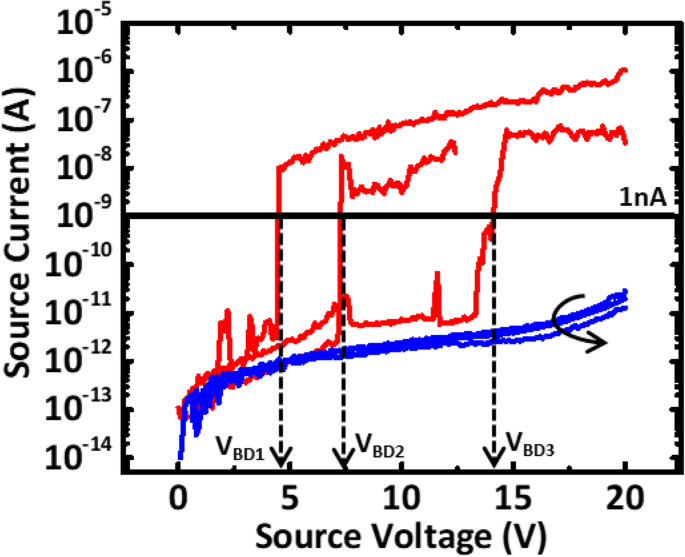
Corriente de fuga medida en dispositivos con patrones de prueba diferenciales conectados a una antena de metal 3 de 82.000 μm 2 . V BD se define como el voltaje cuando la corriente alcanza 1 nA para una longitud de vía de 32 nm
En un evento de carga, se espera que el lado más débil sirva a la ruta de descarga dominante, lo que lleva a un desequilibrio más prominente en el nivel de daños entre la izquierda y la derecha. Por lo tanto, solo los dispositivos con una V grande BD Es más probable que la diferencia entre los lados izquierdo y derecho se deba a la carga de plasma. Por lo tanto, la V más pequeña BD en IMD, la ruptura de un par se registra como el nivel correlacionado con el nivel de estrés del PID. La Figura 4a muestra tres tipos típicos de características que se encuentran en muestras en diferentes troqueles a través de una oblea. Estas muestras pueden clasificarse como sin desglose en ninguno de los lados, desglose de un lado o grupos de desglose de ambos lados. La porción de dispositivos que muestra las características particulares de cada grupo se muestra en el gráfico circular de la Fig. 4b. Descubrimos que en muestras sin antena tienen un cambio mucho menor de tener características de ruptura de un lado. Los comportamientos simétricos en ambos lados se encuentran en la mayoría de los dispositivos que no han experimentado estrés por carga de plasma. Estos sugieren además que la mayoría de las características asimétricas en un par diferencial provienen de las tensiones de carga cuando se conecta la estructura de la antena.
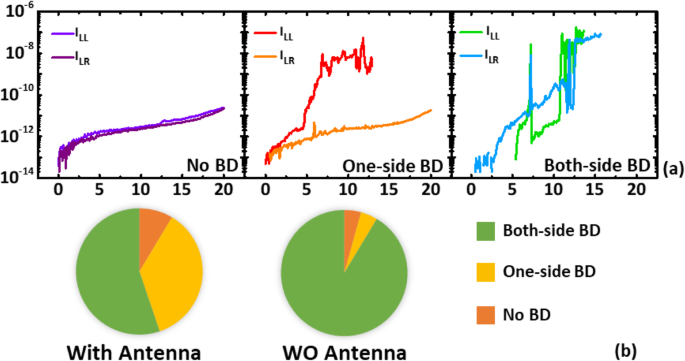
un Diferentes tipos de características de ruptura en los pares de prueba en una oblea y b comparar el porcentaje de muestras que exhiben tipos distintivos de características de ruptura en pares de dispositivos en más de 60 troqueles
Usando la V BD obtenido por el método anterior, los mapas de obleas del nivel PID y V BD de dispositivos de tipo I y II, los patrones se comparan en la Fig. 5. Gran similitud entre los mapas de obleas de V BD de ambos tipos de dispositivos de monitoreo y los niveles de carga de referencia correspondientes se obtienen del registrador PID, ver Fig. 5a. Se cree que el voltaje PID registra eventos de carga tanto de electrones como de iones durante los procesos metálicos [14]. Sin embargo, las muestras a través de una oblea son predominantemente sujetas a más carga de electrones que carga de iones [14]. Creemos que se puede ver una correlación regional entre la oblea de la Fig. 5a, b. Mientras que el mapa de obleas en la Fig. 5c del patrón II, que no tiene similitudes obvias con el de la Fig. 5a, sugiere que la tensión bidireccional [15] podría conducir a un efecto secundario sobre las capas dieléctricas, que necesitan más investigación. Los voltajes de ruptura medidos de los nuevos patrones de prueba frente a los niveles PID de referencia comparados en la Fig.6 revelan además que cuanto mayor es el nivel PID en un dado, menor es su V BD los nuevos patrones de prueba. Además, correlaciones negativas significativas entre V BD y se pueden establecer los niveles de carga de plasma. Para investigar el efecto de las tensiones unidireccionales y bidireccionales sobre el daño de IMD, V BD medida a partir de los patrones de tipo I y tipo II se resume y compara en la Fig. 7. La V BD La distribución obtenida de dispositivos en 60 matrices a través de obleas indica que los dispositivos que experimentaron tensiones de carga bidireccionales tienen más probabilidades de mostrar una ruptura de IMD a un voltaje más bajo. Esto podría explicarse por el nivel de estrés asimétrico a medida que cambia la polaridad a través de un IMD [16]. Además, la corriente de fuga inducida por tensión (SILC) medida con 10 V a través de la capa dieléctrica es otro indicador del aumento de los estados de trampa [17] dentro de la película IMD. Para minimizar aún más el efecto de variación de matriz a matriz causado por la variación del proceso, la relación de fuga de cada par se utiliza como índice para evaluar más a fondo el daño del IMD. La Figura 8 muestra que esencialmente no existe correlación entre la relación de corriente de fuga en los dos tipos de dispositivos en la misma matriz. Es decir, la desalineación entre las capas de metal 1 y via2 tiene efectos mínimos en ambos patrones. Observó que la razón corriente, R , definido como I LR / Yo LL , es un índice mejor para eliminar el ruido de la variación de matriz a matriz en estos patrones. En dispositivos completamente imparciales, el estrés de carga principal ocurre a la derecha oa la izquierda, lo que debería ser completamente aleatorio. Aquí, se encuentran algunos efectos de sesgo en las relaciones actuales, donde su medio de distribución no está en 1. Para garantizar que solo se tengan en cuenta los daños resultantes de los efectos de carga de plasma, R es la razón de corriente normalizada, como se describe en la Fig. 9. En la gráfica de distribución a través del centro de la oblea, R N de los dispositivos de patrón de tipo I sigue con el nivel de estrés plasmático de los registradores PID bastante cerca. Por otro lado, R N de dispositivos susceptibles a estrés bidireccional no puede explicarse completamente por los niveles de PID registrados. Esto podría deberse a un R significativamente más alto N nivel en dispositivos de patrón II, como resultado de eventos de carga de iones adicionales en la oblea.

Esquemas y mapas de obleas que muestran las distribuciones de ( a ) el voltaje PID y VBD de ( b ) patrón de prueba I y ( c ) II, que muestra el efecto regional dentro del área encerrada en un círculo debido al daño inducido por el plasma en la capa dieléctrica del extremo posterior que se puede atribuir a los niveles regionales de carga de plasma
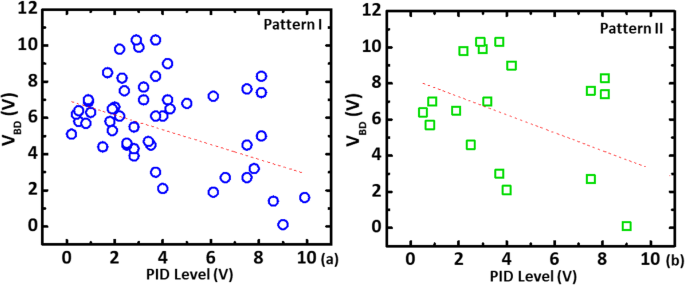
Correlaciones entre VBD y niveles PID para a patrón I y b muestras del patrón II, respectivamente [10,11,12]
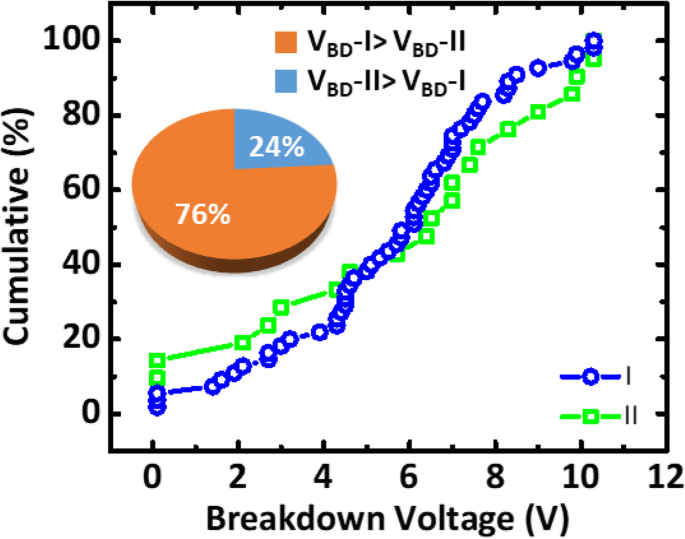
Comparación de la distribución acumulada de V BD de 60 troqueles a través de la oblea y la porción de muestras que muestran voltajes de ruptura más altos del patrón I frente al del patrón II

Relación de corriente de fuga del lado izquierdo y derecho del patrón I y II que muestra que no hay un efecto de desalineación sistemática de estas muestras
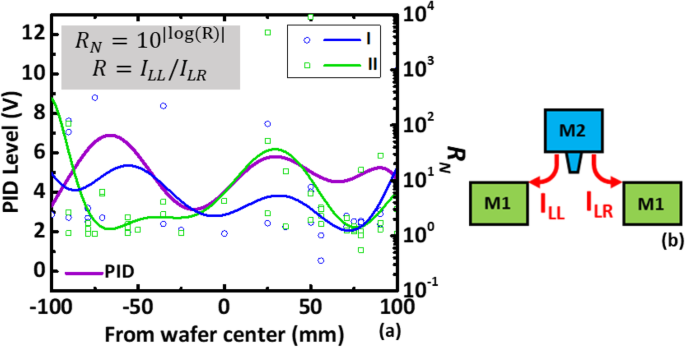
un Relaciones de corriente normalizadas de las muestras de patrón I y II en el centro de la oblea en comparación con los niveles de PID correspondientes y b la definición de corriente de fuga a la izquierda ( I LL ) y derecha ( I LR )
Conclusiones
El efecto de carga inducido por plasma sobre la integridad de las películas IMD se investiga a través de patrones de prueba diferenciales recientemente propuestos en plataformas avanzadas FinFET Cu BEOL. Se encontró que los daños en forma de descomposición temprana y aumento de SILC en las capas de IMD se correlacionan directamente con los niveles de carga de plasma en las obleas de 12 pulgadas.
Disponibilidad de datos y materiales
No aplica.
Nanomateriales
- Introducción a la fabricación de metales
- 6 Consideraciones de diseño importantes para la impresión 3D en metal
- El diseño de la capa de emisión para multiplicadores de electrones
- Directrices de diseño para la fabricación:Parte 1
- 5 consejos para el diseño de chapa metálica
- 6 consejos para optimizar su diseño para un proyecto de fabricación de metal
- ¿Qué es la identificación de metales? - Pruebas y consejos para identificar
- Cómo optimizar diseños para proyectos de fabricación de metal
- Consideraciones de diseño de impedancia para PCB rígido flexible
- Consejos de diseño para doblar chapa metálica
- Consejos de diseño para la impresión 3D de sinterización directa de metal por láser



