Rendimiento de recuperación de diodos de barrera Schottky GaN verticales dopados con Ge
Resumen
Se fabricaron diodos de barrera Schottky de GaN verticales (SBD) sobre sustratos de GaN independientes dopados con Ge. La calidad del cristal de los SBD se caracterizó mediante la medición de la luminiscencia del cátodo, y se determinó que la densidad de dislocación era ~ 1,3 × 10 6 cm - 2 . Con las mediciones de rendimiento eléctrico realizadas, los SBD muestran un voltaje de encendido bajo V en (0,70 ~ 0,78 V) y alta corriente I en / Yo desactivado proporción (9,9 × 10 7 ~ 1,3 × 10 10 ). Se investigaron las características de recuperación inversa. Se obtuvo que el tiempo de recuperación inverso fue de 15,8, 16,2, 18,1, 21,22 y 24,5 ns para los SBD de 100, 200, 300, 400 y 500 μm de diámetro, respectivamente. Mientras tanto, el tiempo de recuperación inverso y la carga de recuperación inversa muestran una correlación positiva significativa con el área del electrodo.
Introducción
Recientemente, un semiconductor de banda ancha ancha, como GaN, con las ventajas inherentes, ha atraído una enorme atención de investigación para los dispositivos electrónicos de próxima generación, particularmente en el campo de alta frecuencia, alta potencia y alto rendimiento [1,2,3 , 4, 5, 6]. Mientras tanto, gracias a los desarrollos de epitaxia en fase de vapor de hidruro (HVPE), baja densidad de dislocación (≤ 10 6 cm - 2 ) Los sustratos de GaN están ahora disponibles comercialmente [7,8,9,10]. En comparación con los dispositivos laterales, los dispositivos de tipo vertical fabricados con estos sustratos se consideran una estructura más avanzada que es propicia para lograr una corriente mayor, menor trayectoria de fugas y mejor confiabilidad para el sistema [11, 12]. Entre ellos, el diodo de barrera Schottky (SBD) basado en GaN es un componente vital en los dispositivos de conmutación. A diferencia de un diodo bipolar, el SBD con su naturaleza unipolar reduce en gran medida el efecto de almacenamiento de portadora minoritaria y, en consecuencia, ofrece una alta velocidad de conmutación con una baja pérdida de recuperación inversa. Sin embargo, pocos grupos han realizado un estudio sistemático de las características de recuperación inversa para los SBD de GaN verticales [13,14,15,16,17], de los cuales los estudios se centraron más en la comparación del tiempo de conmutación en dispositivos de diferentes estructuras. Por lo tanto, todavía existe una necesidad urgente de una investigación profunda sobre el mecanismo de rendimiento de recuperación de los SBD de GaN, especialmente para los verticales.
Mientras tanto, dado que la técnica de contacto óhmico se ha explorado continuamente para mejorar el rendimiento del dispositivo en muchos artículos publicados [18], el GaN de tipo n fuertemente dopado es un vínculo clave para la fabricación de dispositivos de nitruro. Últimamente, se propone Ge como una alternativa al dopante de Si en GaN, porque ambos comparten una característica similar de impureza de nivel superficial (se informa que la energía de activación es de 20 y 17 meV para Ge y Si, respectivamente) y la distorsión de la red causada por los átomos de Ge que se sustituyen en los sitios de Ga serían más pequeños debido a sus radios iónicos más cercanos [19, 20]. Se cree que el dopaje Ge forma una superficie más lisa con menos defectos [21, 22]. Además, con la menor distorsión de la celosía y la tensión de la película, este dopaje también se muestra prometedor en los dispositivos electrónicos de alta temperatura que ponen más énfasis en la estabilidad térmica. Aunque el GaN dopado con Ge se ha estudiado teóricamente, es esencial investigar el impacto real en el dispositivo relevante. En este artículo, se proponen los nuevos SBD de GaN verticales fabricados sobre un sustrato de GaN independiente (FS) dopado con Ge. Los SBD verticales de GaN exhiben una calidad de cristal y propiedades electrónicas superiores. Mientras tanto, se investiga sistemáticamente el rendimiento de recuperación de los SBD verticales. El tiempo de recuperación inverso y la carga de recuperación inversa finalmente muestran una correlación positiva significativa con el área del electrodo.
Métodos y experimentos
El esquema de las estructuras del dispositivo para los SBD fabricados se muestra en la Fig. 1a, que consiste principalmente en un FS n + de 390 μm -Sustrato de GaN y un n de 9 μm - -Capa de deriva de GaN. En este trabajo, la capa de sustrato de GaN orientada (0001) con una concentración de Ge de 1 × 10 18 cm - 3 y una densidad de dislocación de 1 × 10 6 cm - 2 fue cultivado por HVPE. Y la capa epitaxial sin dopar sobre este sustrato se hizo crecer mediante deposición de vapor químico metalorgánico, con una tasa de crecimiento de ~ 2 μm / h. Para la fabricación de SBD, se formaron contactos óhmicos Ti / Al / Ni / Au en la superficie posterior del sustrato de GaN. Se formaron electrodos Ni / Au Schottky en la superficie frontal de la capa epitaxial con cinco diámetros diferentes (100, 200, 300, 400 y 500 µm), como se muestra en la Fig. 1b. Puede encontrar más información sobre el proceso de fabricación en nuestro informe anterior [23, 24].
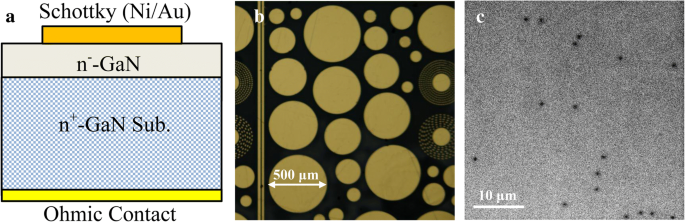
un Sección transversal esquemática del SBD vertical fabricado. b Imagen de microscopía óptica de los diferentes electrodos. c Imagen CL pancromática de la capa epitaxial
Las imágenes de catodoluminiscencia (CL) se obtuvieron utilizando un microscopio electrónico de barrido (SEM) Quanta 400 FEG con un voltaje de aceleración de 10 kV para estudiar la distribución espacial de la densidad de dislocación para la capa epitaxial. Capacitancia-voltaje ( C-V ) y corriente-voltaje ( I-V ) Las mediciones se realizaron utilizando un analizador de parámetros de semiconductores Keithley 4200 para evaluar las propiedades electrónicas de los SBD. Y las mediciones dependientes de la temperatura se realizaron en el rango de 300 a 500 K con una configuración experimental personalizada.
Resultados y discusión
El resultado de CL de la capa epitaxial se presenta en la figura 1c. Como se cree que la dislocación es un centro de recombinación no radiativa, aparece en la imagen CL en forma de una mancha oscura. Dado que no se observa una diferencia notable en la distribución espacial, el valor promedio de la densidad de dislocación se calculó en ~ 1.3 × 10 6 cm - 2 , con las mediciones de CL realizadas en varias regiones diferentes. Este resultado indica que se obtuvo una capa epitaxial de alta calidad para SBD verticales.
Como los SBD verticales se caracterizaron en modo paralelo, el C-V y G-V Las curvas se obtuvieron con una frecuencia de 1 MHz. Los resultados de los SBD se muestran en la Fig. 2a yb, respectivamente, donde ( 1 / C 2 ) versus voltaje aplicado V está trazado en el recuadro. Aquí, concentración de portador N d podría evaluarse con la expresión:\ ({N} _d =\ frac {-2} {A ^ 2 q \ varepsilon \ left [d \ left (1 / {C} ^ 2 \ right) / dV \ right]} \), donde A es el área de los electrodos Schottky, q es la carga del electrón (1,602 × 10 - 19 C) y ε es la constante dieléctrica de GaN (8.854 × 10 - 11 F / m). Por lo tanto, la N d de la capa epitaxial se determinó en ~ 6.2 × 10 15 cm - 3 . Y el ángulo de fase θ también podría calcularse mediante la siguiente ecuación:\ (\ theta ={\ tan} ^ {- 1} \ left (\ frac {2 \ pi fC} {G} \ right) \), donde f es la frecuencia aplicada, C es la capacitancia y G es la conductancia medida (fuga en la puerta). Dado que los resultados para diferentes diámetros son similares, el ángulo calculado θ versus voltaje aplicado V de los SBD de 300 μm de diámetro se muestra en el recuadro de la Fig. 2b como ejemplo. Tenga en cuenta que θ está muy cerca de los 90 °, confirma que en este estudio se logra una excelente puerta Schottky con una trayectoria de baja fuga. El J-V Las características también se presentan en la Fig. 2c. Se ve claramente que el I en / Yo desactivado las proporciones son 3.8 × 10 9 , 5,9 × 10 8 , 1,3 × 10 10 , 6,5 × 10 8 y 9,9 × 10 7 para los SBD de 100, 200, 300, 400 y 500 μm de diámetro, respectivamente, de los cuales I en y yo desactivado se definen como la corriente a la tensión de puerta de 1,6 y -2 V, respectivamente. Después del ajuste lineal, el voltaje de encendido V en de SBD verticales se determina en 0,70, 0,76, 0,72, 0,70 y 0,78 V, respectivamente, con un aumento de los diámetros de los electrodos de 100 a 500 μm. Estos resultados indican que se obtuvo una buena propiedad electrónica para los SBD verticales.
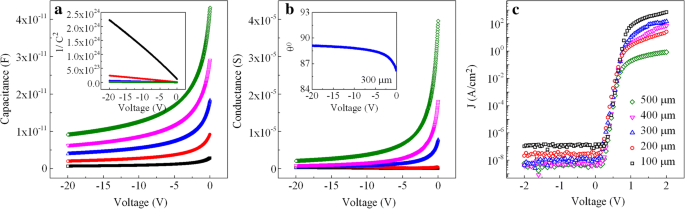
un Temperatura ambiente C-V curva de SBD verticales para cada electrodo diferente a una frecuencia de 1 MHz. El recuadro es un gráfico de ( 1 / C 2 ) versus voltaje V . b G-V curva de SBD verticales para cada electrodo diferente. El recuadro es un gráfico del ángulo de fase θ versus voltaje V para SBD de 300 μm de diámetro. c J-V curva de SBD verticales para cada electrodo diferente
Se utilizó un circuito de prueba típico para medir las características de recuperación inversa de los SBD verticales, como se muestra en la Fig. 3a. Las señales de voltaje de onda cuadrada periódicas (de + 20 a - 20 V) se aplicaron secuencialmente a un dispositivo bajo prueba (DUT), donde un inductor parásito almacenaría la energía magnética y afectaría la corriente. Cuando la señal de voltaje cambia, puede tener lugar una corriente de oscilación durante el período. Se dispuso una sonda de corriente de alta velocidad con un osciloscopio Tektronix MDO 4104-3 para detectar la variación de corriente transitoria en los SBD verticales. Como se muestra en la figura 3b, la forma de onda esquemática de la corriente de recuperación inversa, en este estudio, t a se define como el tiempo de almacenamiento mientras t b se define como el tiempo de retardo de la corriente inversa. Y el tiempo de recuperación inverso T rr se define como el momento en que la corriente inversa se recupera al 10% de la corriente máxima de recuperación inversa I RM , que es la suma de t a y t b . Y el cargo de recuperación inversa Q rr se obtiene integrando la corriente inversa hasta T rr que corresponde a la carga acumulada en un diodo.

un El circuito de prueba utilizado para medir las características de recuperación inversa de los SBD verticales. b Forma de onda esquemática de las características de recuperación inversa de SBD verticales
La Figura 4 muestra la curva de recuperación inversa de los SBD verticales para cada diámetro de electrodo cuando el voltaje aplicado cambió de + 20 a - 20 V.Aquí, para los SBD de 100, 200, 300, 400 y 500 μm de diámetro , la T rr Se obtuvieron valores de 15,8, 16,2, 18,1, 21,22 y 24,5 ns, mientras que Q rr Los valores se integraron para ser 0.0127, 0.0536, 0.150, 0.280 y 0.405 nC, respectivamente. Todos estos dispositivos verticales exhibieron un tiempo de conmutación rápido (menos de 25 ns). También se observa una corriente inversa considerablemente baja en los resultados, lo que podría deberse a la menor cantidad de carga almacenada en los SBD [13]. Mientras tanto, también se ve claramente que el valor de T rr y Q rr ambos aumentan junto con la ampliación de los diámetros de los electrodos, y el más pequeño muestra el T más rápido rr de 15,8 ns.
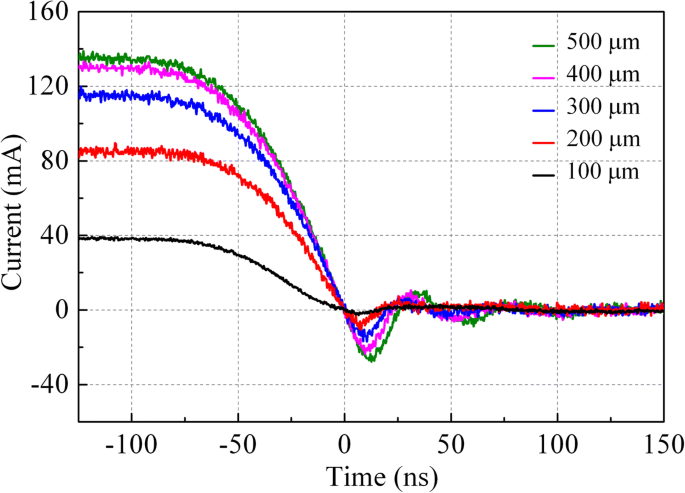
Corriente de recuperación inversa de SBD verticales para cada electrodo diferente
Para investigar más a fondo el mecanismo subyacente a esos cambios, los SBD verticales también se midieron cuando el voltaje cambió de + 10 a - 10 V. Como tiempo de recuperación inverso T rr versus el diámetro del diodo d se representa en la Fig.5, el valor de T rr para cada diodo no se alteró notablemente. El cargo de recuperación inversa Q rr versus el d se muestra en la Fig. 6 simultáneamente, donde los datos de dos curvas apuntan hacia la misma tendencia. Mientras tanto, es notable que el Q rr de ambas pruebas muestran una correlación positiva significativa con el d 2 , es decir, el área de los electrodos.
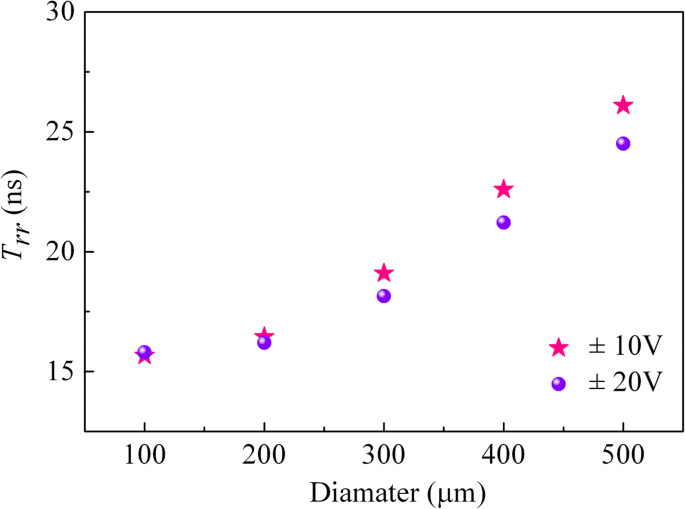
Tiempo de recuperación inverso T rr versus diámetro del electrodo d
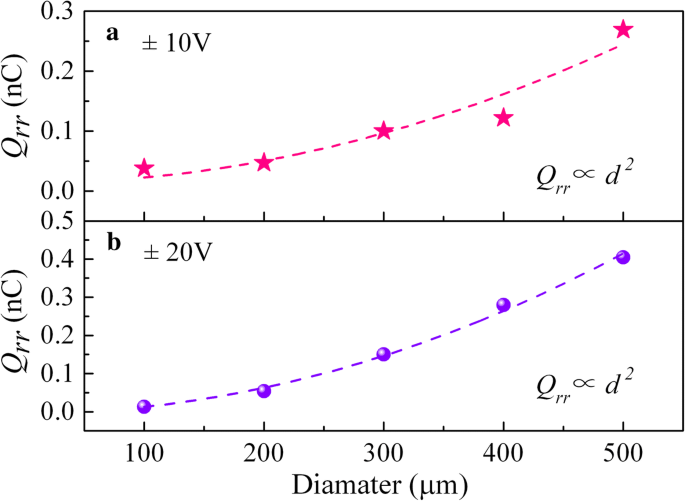
Cargo de recuperación inversa Q rr versus diámetro del electrodo d
De hecho, se ha informado de que el efecto de recuperación inverso debería deberse principalmente a la inductancia parasitaria y al atrapamiento de la interfaz de los SBD [25, 26]. Teniendo en cuenta que la contribución de la inductancia parásita se caracteriza en forma de corriente de oscilación que no se observa obviamente en estas curvas de recuperación inversa, el cambio del tiempo de recuperación inversa y la carga de recuperación inversa debería haber resultado de las trampas [27, 28]. Dado que la concentración de trampas es uniforme en SBD verticales, el Q rr dependería del área de contacto del dispositivo y finalmente aumentaría con el área del electrodo como se muestra en la Fig. 6. Por lo tanto, las trampas actúan como un tapón de campo eléctrico en la interfaz. Durante el t a período, la demora estuvo fuertemente influenciada por la captura de portadores en el cruce Schottky, mientras que en el t b período, la velocidad de recuperación inversa también se reduce en el momento de barrer la carga almacenada fuera de la unión. Estos resultados son consistentes con nuestro informe anterior [29], que sugirió el RC La constante de tiempo aumenta con el aumento del diámetro del dispositivo y muestra una buena dependencia con el tiempo de recuperación inverso. Y podría esperarse una mejora adicional de las características de recuperación inversa de un electrodo más pequeño o una capa de deriva más delgada en estos dispositivos.
Además, el rendimiento de recuperación de los SBD verticales se investiga más a fondo a temperaturas más altas. La Figura 7 muestra la corriente de recuperación inversa para SBD de GaN de 500 μm de diámetro que se midieron a 300, 400 y 500 K, respectivamente. No se observa cambio en el tiempo de recuperación inversa ni en la carga de recuperación inversa con el aumento de temperatura. Estos resultados son consistentes con el análisis anterior, ya que la concentración de la trampa no es muy sensible a la temperatura. Por el contrario, se informa que el tiempo de recuperación inverso de los SBD basados en Si aumentaría en un 191% a medida que la temperatura aumenta de 300 a 425 K [17]. Aquí, con una vida útil corta de la portadora y una banda prohibida más amplia, se muestra que los SBD de GaN proporcionan mejoras sustanciales en la capacidad de manejo de corriente, recuperación inversa y pérdida de energía. Dado que la estabilidad térmica de los SBD basados en GaN es superior a la de los semiconductores tradicionales con banda prohibida estrecha [30], se puede concluir que GaN también es un material adecuado para dispositivos de conmutación aplicados a un entorno de alta temperatura.
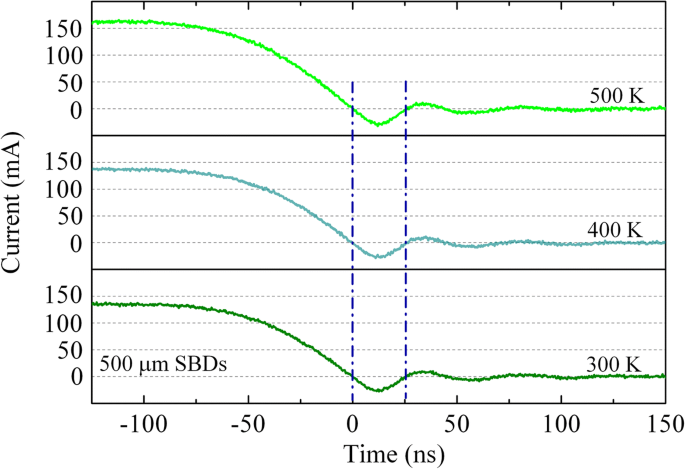
Características de recuperación inversa para SBD de 500 μm de diámetro medidos a 300, 400 y 500 K, respectivamente
Conclusiones
En resumen, fabricamos SBD de GaN verticales en sustratos FS GaN dopados con Ge cultivados por HVPE. Con la caracterización del material y las mediciones de corriente-voltaje realizadas, indica que se obtuvo una excelente calidad de cristal y propiedad electrónica para los SBD verticales. Las características de recuperación inversa se investigaron sistemáticamente. Se obtuvo que el tiempo de recuperación inverso fue de 15,8, 16,2, 18,1, 21,22 y 24,5 ns para los diodos de 100, 200, 300, 400 y 500 μm de diámetro, respectivamente. Mientras tanto, el tiempo de recuperación inverso y la carga de recuperación inversa muestran una correlación positiva significativa con el área del electrodo. Nuestros resultados pueden servir como referencia para mejorar aún más el rendimiento de recuperación de los SBD basados en GaN.
Abreviaturas
- CL:
-
Catodoluminiscencia
- C-V :
-
Capacitancia-voltaje
- DUT:
-
Dispositivo bajo prueba
- FS:
-
Independiente
- GaN:
-
Nitruro de galio
- HVPE:
-
Epitaxia en fase vapor de hidruro
- I-V :
-
Corriente-voltaje
- SBD:
-
Diodos de barrera Schottky
- SEM:
-
Microscopio electrónico de barrido
Nanomateriales
- Diodos
- Dispositivos cuánticos
- Diodos de propósito especial
- Navistar:Rendimiento de servicio pesado
- Tecnología HDPE de barrera de alta humedad para embalaje flexible multicapa
- Efecto de la irradiación ultravioleta en las características de los diodos 4H-SiC PiN
- Investigación sobre la polarización de la superficie de la heteroestructura de GaN / AlGaN / GaN con cubierta de Al2O3 mediante espectroscopia de fotoelectrones de rayos X de ángulo resuelto
- Dirigirse a las células endoteliales con nanopartículas multifuncionales de GaN / Fe
- Rendimiento fotocatalítico de luz visible de nanocompuestos de ZnO / g-C3N4 dopado con N
- Capas óptimas de dopaje de silicio de barreras cuánticas en la secuencia de crecimiento que forman el potencial de confinamiento suave de ocho períodos In0.2Ga0.8N / GaN Pozos cuánticos de azul LE…
- 3 formas de mejorar el rendimiento de su bomba vertical



