Revisión del progreso reciente en diodos PN verticales basados en GaN
Resumen
Como material semiconductor de banda ancha representativa, el nitruro de galio (GaN) ha atraído cada vez más atención debido a sus propiedades superiores del material (por ejemplo, alta movilidad de electrones, alta velocidad de saturación de electrones y campo eléctrico crítico). Se han investigado los dispositivos verticales de GaN, se los considera uno de los candidatos más prometedores para la aplicación de la electrónica de potencia y se caracterizan por su capacidad para alta tensión, alta corriente y alta tensión de ruptura. Entre esos dispositivos, el diodo de unión PN (PND) vertical basado en GaN se ha investigado considerablemente y muestra un gran progreso en el rendimiento sobre la base de la alta calidad de la epitaxia y el diseño de la estructura del dispositivo. Sin embargo, la calidad de la epitaxia de su dispositivo requiere una mejora adicional. En términos de rendimiento eléctrico del dispositivo, el efecto de apiñamiento del campo eléctrico en el borde del dispositivo es un problema urgente, que da como resultado una ruptura prematura y limita las superioridades de liberación del material GaN, pero actualmente se alivia con la terminación del borde. Esta revisión enfatiza los avances en el crecimiento epitaxial del material y las técnicas de terminales de borde, seguido de la exploración de los desarrollos actuales de GaN y las ventajas potenciales sobre el carbono de silicio (SiC) para materiales y dispositivos, las diferencias entre los diodos de barrera Schottky (SBD) y los PND de GaN como se refiere a los mecanismos y características, y las ventajas de los dispositivos verticales sobre sus contrapartes laterales. Luego, la revisión proporciona una perspectiva y revela la tendencia de diseño del PND de GaN vertical utilizado para un sistema de energía, incluso con un PND de GaN vertical incipiente.
Introducción
El consumo mundial de energía está aumentando mucho más rápidamente que en las últimas décadas debido al rápido crecimiento de la industria y la economía. Por lo tanto, se requieren tecnologías avanzadas de ahorro de energía para aliviar los problemas del aumento del consumo de energía.
Los dispositivos basados en silicio son actualmente el tipo dominante entre los dispositivos de potencia [1]. Entre estos dispositivos de potencia, las estructuras del transistor bipolar de puerta aislada (IGBT) desempeñan un papel importante y muestran una tendencia creciente hacia el reemplazo del transistor de unión bipolar de potencia (BJT) y el transistor de efecto de campo semiconductor de óxido metálico (MOSFET) desde la invención del IGBT en 1982 [2]. Actualmente, los IGBT son elementos esenciales de los campos electrónicos de potencia para la conversión y transmisión [3]. Sin embargo, los dispositivos de potencia basados en silicio han alcanzado sus límites materiales fundamentales hasta la fecha y se utilizan ampliamente en aplicaciones de energía eléctrica.
Dadas sus propiedades sobresalientes, GaN es uno de los materiales semiconductores con banda prohibida amplia (incluidos SiC, GaN, Ga 2 O 3 y diamante) capaces de fabricar dispositivos de potencia con baja capacitancia y resistencia para un voltaje de ruptura especificado con respecto a los dispositivos basados en Si. Por lo tanto, se esperan dispositivos basados en GaN con bajo consumo de energía, altas densidades de potencia y alta eficiencia de conversión para sistemas electrónicos de potencia.
Como se muestra en la Tabla 1, GaN tiene una figura de mérito de Baliga (BFOM) mucho más alta que el SiC (que se ha comercializado), una característica que se atribuye a su mayor velocidad de saturación de electrones y mayor campo eléctrico crítico. Sin embargo, el SiC tiene una mejor conductividad térmica. Además, GaN posee una mayor movilidad de portadora µ y una conductividad térmica más alta, y logró tanto p - y n -tipo de dopaje en comparación con Ga 2 O 3 . Mientras tanto, para el último semiconductor de banda prohibida amplia, el diamante, se debe lograr un progreso considerable para llegar a la etapa práctica. Hasta la fecha, los dispositivos basados en GaN, por ejemplo, el dispositivo de tres terminales (transistores de efecto de campo de heteroestructura (HFET) y MOSFET) y los dispositivos de dos terminales (SBD y PND) se han convertido en temas de investigación clave, y se han logrado grandes avances en su aplicaciones en rectificación y conversión de energía.
GaN versus SiC
Por sus propiedades materiales inherentes, GaN tiene ventajas ligeramente superiores sobre el SiC, incluyendo una banda prohibida de energía más amplia, un campo eléctrico crítico más alto, una velocidad de saturación de electrones más alta y un BFOM 3-4 veces mejor para dispositivos de potencia [6]. Por lo tanto, considerando sus características sobresalientes, los dispositivos basados en GaN deberían superar a sus homólogos basados en SiC. En la aplicación práctica, los dispositivos verticales basados en GaN son esenciales para una alta densidad de potencia y alta frecuencia de operación (Fig. 1) debido a sus excelentes propiedades de material.
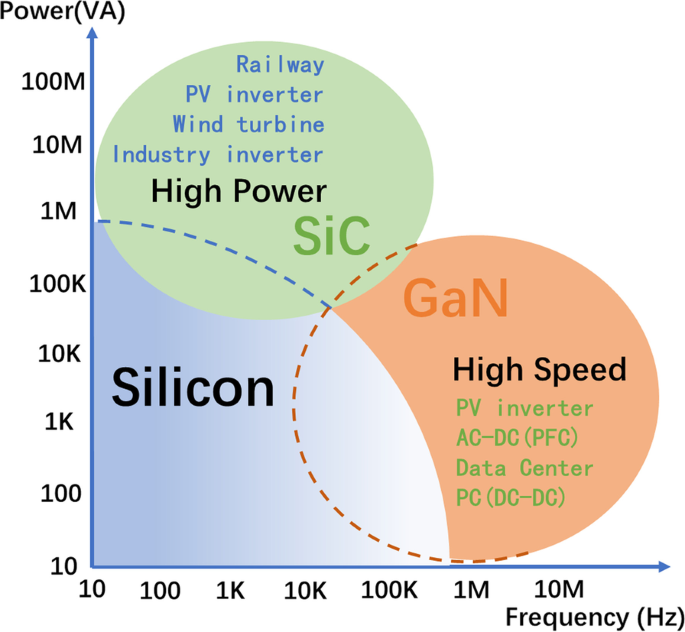
Aplicaciones potenciales de los transistores de conmutación de potencia de GaN y SiC [7]
Como los semiconductores de amplio espacio más maduros, los dispositivos de SiC han logrado avances notables en la última década y muestran un rendimiento prometedor en términos de alto voltaje, baja resistencia específica y velocidad de conmutación rápida [8]. Dada la base de investigación profunda desde 1980 y el sustrato de SiC más grande disponible con bajo defecto (<10 4 cm −2 ), Los SBD de SiC y los transistores de efecto de campo de unión (JFET) fueron los primeros dispositivos basados en SiC comercializados desde 2001. Otros dispositivos de potencia basados en SiC, incluidos MOSFET y BJT, se desarrollaron con éxito en el campo de la aplicación de alta tensión y potencia y han demostrado resultados impresionantes rendimiento [9].
En comparación con el SiC, los dispositivos de GaN se desarrollaron muy lentamente. Su calidad insatisfactoria del material impide la realización de algunas de sus propiedades teóricamente superiores. Dada la falta del sustrato de GaN, la mayoría de los estudios sobre dispositivos de GaN se basan principalmente en la estructura lateral (por ejemplo, heteroestructura de AlGaN / GaN) en esta etapa. Con su mayor movilidad de electrones de 2000 cm 2 / V s (gas de electrones bidimensionales (2DEG) en AlGaN / GaN), 1000 cm 2 / V s (volumen de GaN) y mayor velocidad de saturación de 2,5 × 10 7 cm / s en relación con sus homólogos de SiC, los dispositivos AlGaN / GaN se prefieren para aplicaciones de alta frecuencia y tienen vatios de baja potencia con respecto a los dispositivos de SiC [10]. En campos de alta frecuencia, los SBD de AlGaN / GaN alcanzan excelentes prestaciones de transporte eléctrico y son más adecuados para aplicaciones de microondas y ondas milimétricas a nivel de vatios [11, 12]. El AlGaN / GaN SBD es un dispositivo representativo para GaN SBD. La alta movilidad de 2DEG significa que los SBD AlGaN / GaN demuestran enormes ventajas de rendimiento en aplicaciones de alta frecuencia en relación con los SBD verticales y también mantienen un voltaje de encendido bajo. Recientemente, los SBD de AlGaN / GaN fueron la base para un circuito rectificador de 5,8 GHz con una potencia de entrada de 6,4 W y un voltaje de encendido de 0,38 V con un voltaje de ruptura ( BV ) de 3000 V [13, 14]. La frecuencia de corte máxima es cercana a 1 THz a 0 V con una distancia de ánodo a cátodo de 70 nm [15].
Para los dispositivos de potencia basados en GaN, el sustrato de GaN (GaN a granel) es ideal para el crecimiento de la epitaxia, que podría utilizar la tecnología de homo-epitaxia para eliminar el desajuste. La baja densidad de dislocación del GaN a granel es esencial para el sustrato epitaxial porque la alta densidad de dislocación puede afectar las características de rendimiento como BV , corriente de fuga inversa, volumen de producción y fiabilidad [16]. Los desarrollos de dispositivos verticales basados en GaN han sido impulsados por el progreso del sustrato de GaN en los últimos años. Sin embargo, dada la tecnología relativamente inmadura para el triodo vertical, el diodo de GaN vertical se ha convertido en un tema de investigación candente en esta etapa inicial. En comparación con los SBD de AlGaN / GaN, los SBD de GaN verticales tienen ventajas similares en los campos de frecuencia, como una alta velocidad de conmutación con un tiempo de recuperación inverso bajo y una pérdida de conducción baja; sin embargo, este último tiene una gran densidad de corriente y menos trayectoria de fuga que el primero [17, 18].
Han surgido algunos problemas para el sustrato de GaN. Primero, los sustratos de GaN están disponibles actualmente con densidades de dislocación de 10 4 –10 6 cm −2 , pero estas densidades de dislocación son aún mucho más altas que las de los sustratos de Si y SiC [19]. En segundo lugar, con respecto al tamaño de la oblea de 4 a 6 pulgadas y el costo razonable (10 euros / cm 2 ) de SiC, el tamaño de 2-3 pulgadas y el costo relativamente alto (100 euros / cm 2 ) del sustrato de GaN inhiben la comercialización y la productividad de GaN a gran escala [20]. Además de aumentar los proveedores proveedores, la heteroepitaxia en sustratos extraños (Si, zafiro o SiC) es una forma alternativa de reducir el costo del sustrato de GaN, pero se debe abordar el desafío de la falta de coincidencia relativamente alta y los defectos.
Además de los problemas antes mencionados en materiales a granel, el desafío para el diodo GaN es lograr una alta calidad de p -tipo de material. Con respecto a las técnicas relativamente avanzadas para formar p -tipo SiC por implantación de iones de Al, p inmaduro -tipo de tecnología de implantación de iones y la baja activación del aceptador para p -tipo GaN son obstáculos vitales que limitan el desarrollo de la estructura y fabricación de dispositivos basados en GaN. Por lo tanto, se proponen diferentes tipos de estructuras de terminación de borde para mejorar el rendimiento del diodo de GaN y constituyen una parte clave de esta revisión.
Dispositivos verticales basados en GaN en el sustrato FS
Hasta hace 10 años, la mayoría de los diodos de GaN, incluidos SBD y PND, se fabricaban sobre sustratos extraños que formaban estructuras de dispositivos laterales o cuasi verticales debido a la falta de disponibilidad de un sustrato de GaN a granel. Los diodos laterales o cuasi-verticales muestran características eléctricas sobresalientes, pero aún adolecen de inconvenientes inherentes a la estructura del dispositivo [21]. Primero, el desajuste y los defectos son inevitables. Luego, para los dispositivos de GaN en sustratos extraños, es esencial un amortiguador entre la capa de deriva de GaN y el sustrato extraño. Por lo tanto, la relajación de la tensión de la capa amortiguadora provocaría un arqueamiento de la oblea, lo que reduciría el grosor de las capas de epitaxia de GaN [22]. Además, la gran resistencia de límite térmico (GaN con sustrato) tiene una gran influencia en el rendimiento del dispositivo para los dispositivos de GaN que funcionan a alta densidad de potencia [23].
Según el desarrollo de las técnicas de epitaxia, el sustrato autónomo de GaN (FS-GaN) con baja densidad de dislocación adoptado para dispositivos verticales de GaN ha logrado un gran progreso. La calidad del material de GaN homoepitaxial en el sustrato FS-GaN tiene una mejora obvia y muestra el potencial para aplicaciones de energía. Los dispositivos verticales de GaN podrían mitigar los inconvenientes de las contrapartes laterales de GaN. Primero, se pueden cultivar capas epitaxiales de GaN más gruesas sin ningún tampón y un BV más alto (que superan a los de los dispositivos de GaN laterales) pueden obtenerse y determinarse por el espesor de la capa de deriva. Mientras tanto, un campo eléctrico máximo se encuentra en la parte interna de los dispositivos y está lejos de la superficie del dispositivo (eliminando el efecto de atrapamiento de electrones que generalmente ocurre en los dispositivos laterales). Dada la alta calidad del sustrato FS-GaN, los dispositivos verticales de GaN se han estudiado desde 2011 [24]. Desde entonces, los PND verticales de GaN con un alto BV y la baja resistencia en el estado se han fabricado y logran un rendimiento notable.
PND versus SBD
Para aplicaciones prácticas, los diodos son componentes esenciales para la conversión e inversión de potencia [25]. Con las distintas propiedades del material de GaN, los diodos basados en GaN (SBD y PND) exhiben rendimientos notables, que se espera que satisfagan los requisitos de las aplicaciones de energía. Como se muestra en la Fig. 2, los PND tienen el alcance más grande entre los dispositivos de GaN con estructuras variadas y soportan voltajes de 600 a 5000 V, una característica que indica escenarios de aplicación más amplios.
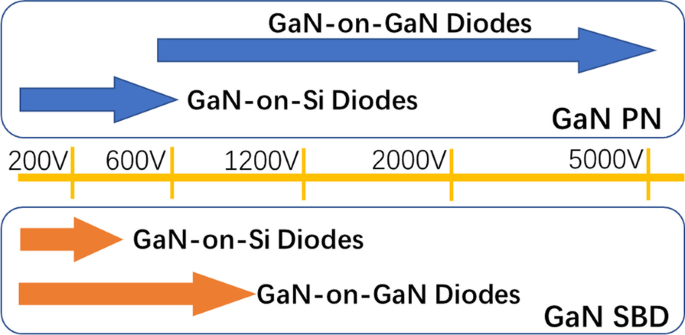
Descripción general de los tipos de dispositivos, informes y clases de voltaje de los principales dispositivos de potencia de GaN verticales informados en los últimos años [26]
En comparación con los PND, que no tienen problemas de almacenamiento de portadores minoritarios y una altura de barrera de SBD más baja, los SBD de GaN presentan un voltaje de encendido directo bajo ( V en ) y recuperación inversa rápida, y estas características indican que los méritos de SBD se revelan en baja pérdida de conducción / conmutación, operación de alta frecuencia, pero un BV más bajo valor que el de PND; Además, tenga en cuenta que un alto voltaje de encendido puede provocar una alta pérdida de conducción y degradar la eficiencia de los circuitos y sistemas [27, 28].
En los campos de alta potencia, los SBD cuasi-verticales o verticales tienen excelentes ventajas sobre los SBD AlGaN / GaN [29]. Además, se logra un voltaje de encendido bajo (<0,5 V) ajustando la altura de la barrera con un metal de baja función de trabajo. Sin embargo, una altura de barrera baja puede conducir fácilmente a una alta corriente de fuga inversa y reducir el BV . En consecuencia, se proponen diversas estructuras de terminación de borde para mejorar el rendimiento. Gracias a la ayuda de diversas tecnologías de terminación de borde [27, 28, 30, 31], la alta densidad de corriente en KA / cm 2 calificar con BV Se confirma s por encima de 1 kV. Mientras tanto, los SBD verticales también exhiben una gran capacidad para alta frecuencia, como 177-183 GHz y una frecuencia de corte máxima de 902 GHz a 0 V, una característica que se espera para fuentes de energía en sistemas de comunicación inalámbrica de terahercios [12, 32].
Con respecto a n -tipo GaN, el p -tipo GaN cultivado por deposición de vapor químico metalorgánico (MOCVD) y epitaxia de haz molecular (MBE) se introdujo utilizando Mg como aceptor [33]. En comparación con los SBD de GaN, los PND de GaN tienen muchas ventajas, como una baja resistencia específica ( R en A ) y una adecuada estabilidad del dispositivo y capacidad para inhibir las sobrecorrientes. A pesar del alto voltaje de encendido (> 3 V) y la velocidad de conmutación relativamente baja, una corriente de fuga ultrabaja debido a la mayor altura de la barrera y el alto BV es obtenido. Tenga en cuenta que un BV alto de 0,6 a 5 kV es el rendimiento más sobresaliente para los PND basados en GaN. Por lo tanto, los PND basados en GaN tienen un gran potencial como bloques de construcción importantes de los sistemas de energía de próxima generación para aplicaciones de alta potencia, que requieren alta eficiencia y baja pérdida de energía [34]. De manera similar a los SBD de GaN verticales, las terminaciones de los bordes de los PND de GaN también se fabrican para aliviar la acumulación de campos eléctricos alrededor del ánodo, una característica que se describirá en detalle más adelante en este artículo.
En los dispositivos de potencia, la unión PN también se puede tratar como una estructura de unión novedosa. Por utilizar un BV alto con baja corriente de fuga inversa de los PND, alto rendimiento de conmutación y bajo voltaje de encendido de los SBD al mismo tiempo, estructuras de dispositivos novedosas que incluyen la barrera de unión Schottky (JBS) y el PN Schottky (MPS) fusionado generan una combinación de SBD y PND mediante la formación de p -regiones de cuadrícula de tipo en la región de contacto de Schottky. Los dispositivos JBS o MPS poseen las características de conducción directa de SBD y bloqueo inverso de PND y se espera que tengan un mejor rendimiento de conmutación y un voltaje inverso más alto que los PND y SBD convencionales, respectivamente [35].
Además de su aplicación de alta potencia, los PND de GaN también se adoptan para dispositivos optoelectrónicos como diodos emisores de luz (LED), fotodetectores y para detección de llamas debido a las bajas corrientes oscuras de unos pocos pA en fotodiodos de unión PN basados en GaN [36 , 37].
Propósito de esta revisión
Sobre la base de las propiedades superiores del material de GaN, los dispositivos basados en GaN se han investigado ampliamente y se han utilizado en aplicaciones de electrónica de potencia como uno de los materiales semiconductores más calientes. Entre los dispositivos basados en GaN, el PND vertical basado en GaN se ha explorado considerablemente y muestra un BFOM excelente. Las técnicas de terminales de borde también son esenciales para aliviar el campo eléctrico que se amontona alrededor de la almohadilla del ánodo.
En esta revisión, los avances en el crecimiento de la epitaxia del material y las técnicas de terminales de borde como el énfasis principal se siguen ilustrando los desarrollos actuales de GaN, las diferencias entre los SBD de GaN y los PND en términos de mecanismos y características, y las ventajas de los dispositivos verticales sobre los laterales. . Esta revisión proporciona una perspectiva y revela la tendencia de diseño de los PND de GaN verticales utilizados para un sistema de energía, incluidos los PND de GaN verticales incipientes. El desarrollo del crecimiento epitaxial correspondiente a una capa diferente en los PND de GaN verticales se introduce en la Sect. 2. Las tecnologías de terminales de borde se exploran en la Sección. 3. En la sec. 4, los PND de GaN verticales sobre sustrato de Si se demuestran como un método alternativo. Finalmente, se proporcionan las conclusiones y perspectivas del desarrollo futuro de los PND verticales de GaN.
Crecimiento de epitaxia material
Sustrato de GaN de PND verticales
Como proceso epitaxial convencional, las capas epitaxiales de dispositivos verticales se cultivan actualmente principalmente mediante MOCVD sobre sustratos conductores de GaN fabricados por epitaxia en fase de vapor de hidruro (HVPE). En esta estructura, la calidad del sustrato afecta directamente a la siguiente estructura epitaxial. Muchos mecanismos de falla en el dispositivo se originan en la calidad de la epitaxia del sustrato [38]. Debe obtenerse un sustrato de GaN conductor de alta calidad para mejorar aún más el avance y retroceso I - V rendimientos, especialmente la corriente de fuga inversa y BV capacidad.
El sustrato cultivado por HVPE se ha considerado como el método más conveniente para la producción en masa debido a su costo relativamente bajo y su reproducibilidad. Sin embargo, en la etapa inicial, la tecnología de crecimiento inmaduro significó que el sustrato de GaN cultivado por HVPE tenía una alta concentración de portador de fondo (> 10 19 cm −3 ) y calidad de cristal insatisfactoria. Por tanto, el HVPE no se adoptó para hacer crecer la estructura del dispositivo [39]. Gracias al rápido desarrollo de la tecnología de crecimiento de epitaxia, los materiales de GaN a granel de alta calidad por HVPE se vuelven gradualmente posibles [40, 41]. Aparte del sustrato, la capa parcialmente epitaxial en el dispositivo ahora puede cultivarse con HVPE y puede resultar en una mayor uniformidad de corriente y la eliminación del macropaso en la superficie de GaN al combinar HVPE y el proceso epitaxial MOCVD con tecnología libre de carbono en comparación con los dispositivos cultivados únicamente por MOCVD [42].
Actualmente, un sustrato comercial de GaN con una densidad de dislocación mínima de menos de 10 4 cm −2 está disponible. Se procesaron los PND verticales de GaN en sustrato de GaN de baja densidad de defectos. Sin embargo, la inclinación de las obleas sigue siendo un problema. Como solución prometedora, el método amonotérmico puede lograr un sustrato de GaN con mejor calidad de epitaxia. Con los autoclaves de alta presión y el amoníaco supercrítico, la dislocación del hilo se puede reducir significativamente a 10 4 –10 5 cm −2 [43]. Usando el método ammonotermal, una baja resistencia de 0.001 Ω cm 2 en el sustrato de GaN con n altamente dopado -tipo (1 × 10 19 –1 × 10 20 cm −3 ), así como el BV de 3 kV [44]. Sin embargo, el inconveniente del método amonotérmico es la baja tasa de crecimiento de aproximadamente 80 a 90 μm / día, una característica que es adversa para la producción práctica. Mejorar la tasa de crecimiento y mantener una alta calidad del material también son direcciones rentables para la investigación posterior.
Además del sustrato comercial de GaN, también se investigaron algunos sustratos para determinar su rendimiento distintivo, incluido el plano que no es de Ga ( c -plano) sustratos. Generalmente, un Ga-polar (es decir, c -plano) se emplea un sustrato para un dispositivo vertical de GaN. Entonces, las siguientes capas epitaxiales muestran un efecto de polarización drástico. Sin embargo, en la dirección opuesta a las contrapartes polares Ga, las capas homoepitaxiales a lo largo de la N -La dirección polar demuestra propiedades únicas del dispositivo debido a la mayor temperatura de descomposición y la propiedad dependiente de la polaridad [45, 46]. Con la N -sustrato polar monocristalino FS-GaN, se logró un campo eléctrico de 2,2 MV / cm sin terminaciones de borde, así como un BV de 2,4 kV con N 2 O tratamiento con plasma de superficie y placa de campo (FP) [46, 47]. Como otro sustrato especial de GaN, el m -plano también atrae una gran atención dada su propiedad no polar para la cual el Ga:N era 1:1 en el m -plano con respecto a solo Ga en el c -polar y solo N en el N -sustratos polares. Con este sustrato de GaN no polar, se informaron las características de los PND con un campo eléctrico crítico de 2,0 MV / cm y una alta relación de encendido / apagado sin FP o terminación de borde [48].
Técnicas epitaxiales de N-GaN
Antes de la existencia de sustratos de GaN conductores de alta calidad, los PND de GaN se fabricaban principalmente sobre sustratos extraños, incluidos Si, SiC y zafiro. Por lo tanto, la estructura de los dispositivos siempre se limitó a los laterales. Se propuso un método basado en la estructura lateral para mejorar la calidad epitaxial. Dada la dislocación de rosca baja (TD) en la región de la ventana en los dispositivos laterales, la capa epitaxial de GaN que crece lateralmente a través de la máscara puede lograr una densidad de TD mucho más baja. Por tanto, se realizó un sobrecrecimiento epitaxial lateral para hacer crecer la capa epitaxial de GaN sobre un sustrato de zafiro para los PND laterales. La corriente de fuga inversa se suprimió en tres órdenes de magnitud [49].
Con el desarrollo de la tecnología epitaxial, sustratos de GaN monocristalinos de alta calidad con bajas densidades de dislocación de 3 × 10 –6 cm −2 estuvo disponible, y los PND de GaN se fabricaron sobre sustratos de GaN. Combinados con capas epitaxiales superiores por MOCVD crecido, los dispositivos muestran una corriente de fuga baja y un BV alto de 600 V a 4 kV correspondientes a espesores de deriva de 6 a 40 μm [16, 50]. Con respecto al dispositivo en el sustrato de zafiro, la corriente de fuga inversa y BV mejorado significativamente [51].
Con el sustrato de GaN nativo, no suele aparecer una capa tampón especial en la estructura epitaxial del PND como la de un sustrato extraño. El efecto de la capa tampón en el PND sobre el sustrato de GaN se investigó como referencia. La existencia de una capa amortiguadora significa que la capa de deriva tiene una menor densidad de defectos. Mientras tanto, un BV más alto se puede obtener con una capa de arrastre más fina pero con una capa amortiguadora más gruesa. También se mejoró la corriente de fuga inversa del dispositivo. Estos parámetros del dispositivo exhiben una fuerte relación con el grosor de la capa amortiguadora, lo que tiene un ligero efecto en las características de avance del dispositivo [52].
Las capas epitaxiales superiores son depositadas por MOCVD, epitaxia en fase de vapor orgánico metálico (MOVPE) y MBE, como se analiza en esta parte. La estructura epitaxial de los PND incluye un n altamente dopado + -Capa de GaN y una capa de deriva de n - -GaN entre el sustrato y p -GaN (Figura 3). La n altamente dopada + -La capa de GaN actúa como una capa de transición sobre el sustrato conductor de GaN en algunos informes.
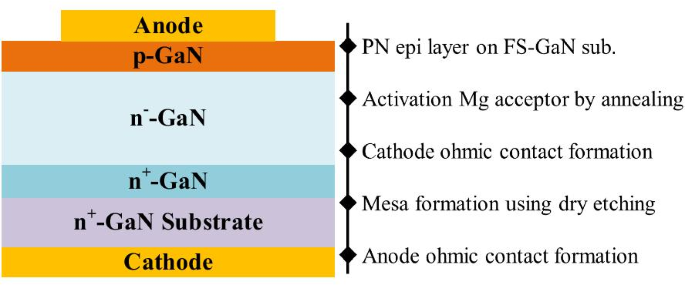
Estructura esquemática y proceso de fabricación de PND vertical de GaN
En general, el BV determina los escenarios de aplicación de los dispositivos. Por ejemplo, el BV más alto para un dispositivo de SiC en comparación con el de GaN permite que el dispositivo de SiC se utilice en aplicaciones de alta potencia y alto voltaje como vehículos eléctricos y trenes bala (Fig. 1). De manera similar, los diodos PN generalmente se aplican en voltajes más altos con respecto al diodo Schottky y los HEMT. En los PND, el BV se realiza principalmente por la capa de deriva (ligeramente dopada n - -GaN layer) con el ensanchamiento de la región de agotamiento (como se representa en la Ec. 1 con voltaje aplicado V para el cual V es positivo / negativo para la polarización directa / inversa cuando el dispositivo está bajo polarización inversa. Además, la ruptura se produce con un mayor aumento del sesgo inverso.
$$ {W _ {\ text {D}}} =\ sqrt {\ frac {{2 {\ varepsilon _ {\ text {s}}} \ left ({{V _ {{\ text {bi}}}} - V } \ right)}} {q} \ frac {{{N _ {\ text {A}}} + {N _ {\ text {D}}}}} {{{N _ {\ text {A}}} {N_ {\ text {D}}}}}} $$ (1)donde S , q , V bi , N D y N A son el área de la unión, la carga electrónica, el potencial incorporado, la concentración del donante y la concentración del aceptor, respectivamente [53].
Según el ancho de agotamiento, los dispositivos se pueden dividir en no perforados [ W D > W Dm ( W Dm :ancho máximo de capa de agotamiento)] y traspaso ( W D < W Dm ). Dados los problemas de la estructura y el borde de la epitaxia, la mayoría de los dispositivos verticales de GaN caen dentro del tipo de perforación, es decir, sus regiones de agotamiento se expanden más allá de la n completa - -GaN capa y alcanza la n + -GaN sustrato antes de la descomposición.
Además, como se describe en la Ec. (2), el BV se puede mejorar aumentando el grosor y disminuyendo el n concentración de dopaje de tipo de la capa de deriva.
$$ {\ text {BV}} ={E _ {\ text {C}}} t - \ frac {{q {N _ {\ text {D}}} {t ^ 2}}} {{2 {\ varepsilon_0 } {\ varepsilon _ {\ text {r}}}}} $$ (2)donde E C , q , t , N D y ε r son el campo eléctrico crítico, la carga de electrones, n - -Espesor de capa de GaN, concentración neta de portadores de n - -Capa de GaN y permitividad de semiconductores, respectivamente [54]. Afortunadamente, la experiencia indica que una capa de deriva con un grosor más grueso y menor dopaje contribuye solo a un ligero aumento de la resistencia en estado activo en la conducción hacia adelante.
En comparación con la mejora de BV aumentando el grosor de la capa de deriva, disminuyendo el n concentración de dopaje de tipo en el n - -La capa de GaN es actualmente difícil, debido a las altas concentraciones de fondo, incluidas las de Si, O, etc. Para una mayor disminución de la concentración de dopaje en n - -Capa de GaN, se investiga la concentración de dopaje involuntario. Muchos grupos de investigación introdujeron un i-GaN nominal aproximado de 10 15 –10 16 cm - 3 contactando a p -GaN para formar la p - yo - n estructura para mejorar la BV de diodos [55].
Ciertamente, la condición previa de estas medidas es una alta calidad epitaxial de la capa de deriva debido a que los TD pueden aumentar la fuga en estado apagado y degradar la BV propiedades [56].
Para mejorar aún más la calidad epitaxial de la capa de deriva en los PND verticales de GaN, se investigó el crecimiento por MBE en el sustrato de GaN. Una corriente de fuga de menos de 3 nA / cm 2 y un campo eléctrico de 3,1 MV / cm se obtuvieron por la muy baja densidad de dislocación. Los rendimientos de ruptura casi ideales indican que el MBE es un método eficaz para el crecimiento de capas epitaxiales en PND verticales de GaN [56]. Sin embargo, similar al crecimiento amonotérmico, la tasa epitaxial es otra desventaja.
Epitaxia de P-GaN
P-GaN, un componente importante en los PND verticales de GaN, se informó en 1989 desde la aparición de GaN por HVPE en 1969 [57, 58]. Primero se utilizó para obtener LED azul. Luego, la p -GaN se empleó gradualmente en el campo de los dispositivos eléctricos, como dispositivos normalmente apagados y PND. En PND verticales de GaN, el p -GaN constituye luz (alrededor de 10 19 cm −3 ) y pesado (≥ 10 20 cm −3 ) concentración de dopaje, que corresponde a formar una capa de unión PN con la capa de deriva y facilitar los contactos óhmicos como el electrodo del ánodo.
Generalmente, el crecimiento epitaxial de una p -GaN es fabricado por MOCVD a una temperatura de aproximadamente 1000 ° C y adopta el Mg 2+ como aceptador. Luego, el p crecido -La capa de GaN debe activarse a altas temperaturas de 700–800 ° C en N 2 ambiente o 400 ° C en O 2 ambiente, lo que facilita una concentración de agujeros relativamente alta [59, 60, 61]. Sin embargo, la alta energía de ionización de 150-200 meV del enlace Mg-H significa una p -Tasa de activación de GaN de solo 1-3%. Una tasa de activación baja también está relacionada con la temperatura. Los dopantes de Mg se pueden volver a pasivar a altas temperaturas de ≥ 600 ° C en NH 3 o ambiente de hidrógeno [62]. Para mejorar la concentración del hoyo, no es factible aumentar únicamente la concentración de dopaje debido a una mayor concentración de dopaje en la p -GaN podría conducir a un deterioro de la calidad cristalina de la capa y reducir la densidad del agujero a través de un efecto de autocompensación [63]. En la actualidad, normalmente se puede alcanzar un pico de densidad de agujeros a una concentración de aceptor de aproximadamente 3 × 10 19 cm −3 [64]. Aunque hay algunos problemas para p -GaN, los informes de investigación relacionados no son muchos. Puede atribuirse a dos razones. Una son las limitaciones de las propiedades intrínsecas del material y el equipo epitaxial. Otro es que el presente p -GaN también puede obtener un rendimiento comparativo del dispositivo.
Sin embargo, todavía se están investigando la optimización de la condición de crecimiento y el nuevo proceso epitaxial. Por ejemplo, en 2017, la p no activada volvió a crecer -Se propuso GaN by MBE y tiene una ventaja sobre MOCVD. Con el entorno de crecimiento bajo en hidrógeno, un BV de 1,1 kV y un factor de idealidad de 2,5 se lograron mediante los PND de GaN verticales fabricados [65]. Otro p interesante -El método de fabricación de GaN es la implantación de iones de Mg con un proceso de recocido de ultra alta presión (UHPA). Los resultados revelan que una alta tasa de activación del 70% y una movilidad del agujero de 24,1 cm 2 V −1 s −1 se lograron con un recocido posterior a la implantación a una temperatura de 1573-1753 K en N 2 presión de 1 GPa. Este resultado es comparable al del crecimiento de la epitaxia por MOCVD [66].
En conclusión, para el sustrato, ahora está disponible el sustrato comercial de GaN de bajo defecto. Mientras tanto, la tecnología epitaxial aún se está desarrollando, una situación que afecta fuertemente el rendimiento del dispositivo. En comparación con MOCVD, el MBE puede lograr una excelente calidad epitaxial, lo que da como resultado un gran rendimiento del dispositivo sin terminaciones de borde. Sin embargo, su lenta tasa de crecimiento y su alto costo hacen que el MBE no sea apto para la productividad a gran escala. El crecimiento de la epitaxia por MOCVD sigue siendo el principal método productivo en la práctica. Por lo tanto, mejorar la calidad de las capas epitaxiales cultivadas por MOCVD es un tema urgente, que llevaría un tiempo considerable. Por lo tanto, se proponen medidas o diseño avanzado de la estructura del dispositivo para lograr un gran rendimiento en esta etapa.
Técnicas de terminación de borde
Para PND de GaN verticales, BV es un parámetro importante. Almost all investigations on vertical GaN PNDs are centered on improving the withstanding voltage at reverse (i.e., BV ). However, due to the electric field crowding at the edge of PN junction, the depletion layer edge, or the electrode edge, premature breakdown often occurs. Therefore, to reduce the electric field crowding of the device, advanced device structure designs (i.e., edge termination techniques) are developed. Varied edge termination techniques have now been adopted to relax the electric field crowding at the edge of GaN PNDs for a higher BV . These techniques include mainly the field plate (FP), ion implantation and plasma treatment, and mesa etching in varied angle or steps and guard rings (GRs) [49, 67,68,69]. These features are discussed in this section.
Metal Field Plates
The FP has been widely utilized in GaN-based devices for transferring the peak electric field far from the edge of the gate, anode, or junction. This method has an identical feature to relax the intensity of the electric field at the PN edge under reverse bias. Moreover, the low leakage current and high breakdown voltage under reverse voltage can be achieved by using FP termination, which has a relatively simple fabricating process as well.
The merits of the FP structure include a simple fabrication process and compatibility with the device process. Simultaneously, the dielectric layer of FP is also the passivation layer of the device. As the earliest and most widely used edge termination for vertical GaN PNDs, the non-extended FP termination was initially used, as shown in Fig. 4a. For fabricating the FP structure, mesa structures were processed by inductively coupled plasma (ICP) dry etching. Then, to suppress the parasitic leakage currents from plasma damage, a passivation dielectric film was deposited all over the anode electrode and the entire mesa structure [70].
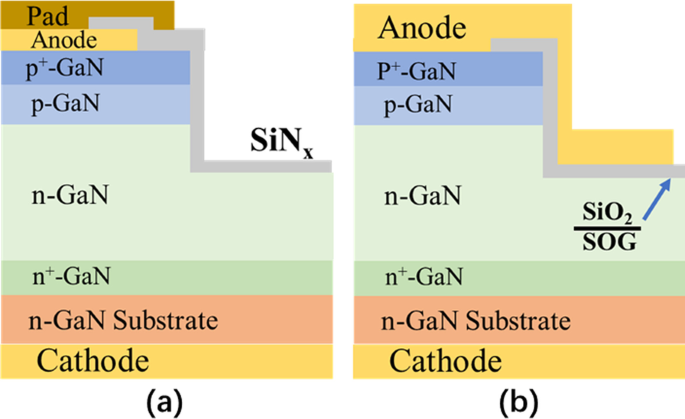
PNDs’ structures with a FP and extended passivation dielectric layer and b extended FP metal and passivation dielectric layer [70, 71]
To furtherly relax the electric field crowding at the periphery of the PN junction edge, the extended metal of the FP was utilized to cover the entire mesa to reduce the reverse leakage current and raise the BV [71]. This optimized FP structure is now widely employed in vertical GaN PNDs fabrications. As shown in Fig. 4b, the BV was raised over 3 kV with an extended FP structure. Meanwhile, the reverse leakage current was also suppressed to a quite low level at revere voltage of 3 kV.
As an essential component of the FP structure, the passivation layer has a considerable impact on the device characteristics. Thus, an appropriated passivation layer is essential. A passivation layer owned high-k permittivity is proposed by simulation, and uniform reverse current flow can be also obtained [50]. According to this theory, vertical GaN PNDs with FP termination using Ga2 O 3 (the dielectric permittivity of 10) as passivation film were reported. The BV had a large improvement from 200 to 550 V, thereby revealing that a high-k permittivity film such as Ga2 O 3 is promising as a passivation film of FP termination in vertical GaN PNDs for raising device characteristics [72]. However, some demerits arise for FP termination. The main issue is the defect during the dielectric layer deposition and interface between the dielectric and GaN, which result in carrier trapping. These would lead to the instability of device performance during long-term use. Therefore, the optimized deposition process of the dielectric layer must be investigated.
Mesa Termination
Mesa etching is an indispensable step to isolate adjacent devices in the fabrication of planar GaN-based devices. Given the simple process, this structure is popular for vertical GaN PND processes. Aside from a uniform electric field at the edge of PN junction, a high BV with nondestructive and avalanche characteristics can be achieved in PNDs. For instance, a simple but deep mesa structure can obtain great performance. As shown in Fig. 5a, with more than 10 µm depth of mesa structure in vertical PNDs, nondestructive BV and avalanche characteristics were confirmed [73].
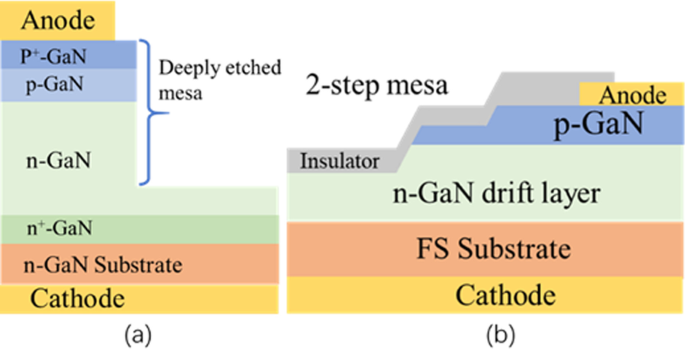
un PNDs with deeply etched mesa structure; b PNDs with two-step mesa [73, 74]
The novel mesa structures are investigated as shown in Fig. 5b. A multi-mesa (two-mesa) structure was adopted in vertical PNDs. With respect to the common single mesa structure, the two-mesa structure can shift the peak electric field from the edge of the PN junction to underneath the thinned p -GaN in the upper mesa because of the total depletion of holes in the thinned p -GaN layer. A high BV of 4.7–4.8 kV with nondestructive feature was successfully achieved by the two-mesa structure. Avalanche capability was obtained without lowering the forward I - V characteristics [74]. On the other hand, the two-mesa structure has the identical function for quasi-vertical PINDs [75]. The BV was enhanced from 665 to 835 V with the low leakage current simultaneously.
Besides the common perpendicular mesa structure, a mesa structure with negative bevel was recently proposed to mitigate the electric field crowding at edge of the PN junction. With the negative bevel mesa, the electric field at the edge has a decreasing trend when the bevel angle θ is lowered from 90˚. The peak electric field would be transferred into device inner. In [76], experimental investigation showed that beveled mesa structure (Fig. 6a) could induce a higher BV over 3 kV and a low leakage current with respect to BV of 3 kV in PNDs with steep mesa when using the same FP structure. Further investigation was performed by simulation using technology computer-aided design (TCAD). In vertical GaN PNDs with beveled mesa (Fig. 6b), the maximum electric field was determined by the acceptor concentration N A in p -GaN, donor concentration N D in n - -GaN drift layer, and θ of the beveled mesa. By theoretical analysis and simulation, the smaller θ could lead to higher E pp (parallel-plane breakdown field). At the same time, a lightly doped p -GaN is beneficial for achieving high BV for a fixed θ of the beveled mesa. Taking θ = 10° as an example, the experimental results support these findings. A parallel-plane breakdown field of 2.86 MV/cm was achieved, and this outcome is consistent with the simulation [77].
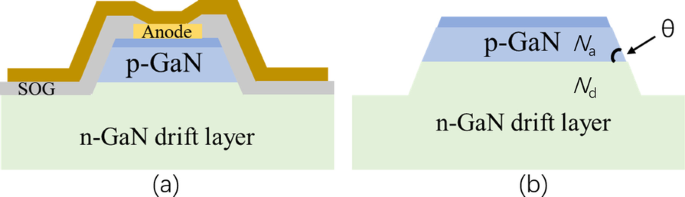
Schematic cross of PND structure with a bevel mesa and FP structure, b PND epitaxial structure is simulated by treating N A , N D y θ as variable [76, 77]
Similar with FP termination, the dry etching and/or insulator (or passivation film) is required in process of edge termination. Thus, the damage from dry etching must be considered and can cause a high reverse leakage current, even the premature breakdown. At the same time, it is a high demand to etched equipment for etched precision, and the etched depth is difficult to control. Meanwhile, the existence of damage generates a more complicated interface state between the insulator and the etched semiconductor, a situation that would affect device reliability. Consequently, reducing or alleviating damage is an inevitable issue. Now, some recipes (e.g., tetramethylammonium hydroxide (TMAH) and post-annealing that have the features of removing the damage by wet etching and repairing dry etching damage, respectively) have been adopted to treat etched surface to improve performance.
Ion Treatment
Ion implantation was employed to alleviate the electric field concentration near the edge. As a relatively simple termination structure, an implantation-based technique was investigated in GaN devices, which includes the compensating species (e.g., O, H, and Zn) or inert species (e.g., Ar, N, He, and Kr) to create deep-level traps in the termination regions [78,79,80,81,82]. Recently, for moderating the occurring of premature breakdown in vertical GaN PNDs, the ion implanted termination (e.g., N, F, Mg, and H) is also utilized. However, the mechanisms of these ion implanted terminations are different.
With respect to vertical GaN SBDs [83], N implantation in vertical GaN PNDs reveals a different mechanism, which entails creating the donor-like defects (N vacancy and N interstitial) to compensate for the p -type dopants. After processing by N implantation as shown in Fig. 7a and b, the conductivity of p -GaN can be reduced or eliminated (insulating) by N implantation [53]. To further improve the BV , a non-fully compensated layer was proposed, that is, a fully compensated layer coupled with a partially compensated counterpart in p -GaN. Thus, a higher BV was expected, and the mechanism was analyzed by simulation [84]. The experimental results show that N implantation with partially compensated p + -GaN could induce a BV of 1.68 kV without compromising the forward characteristics [85].
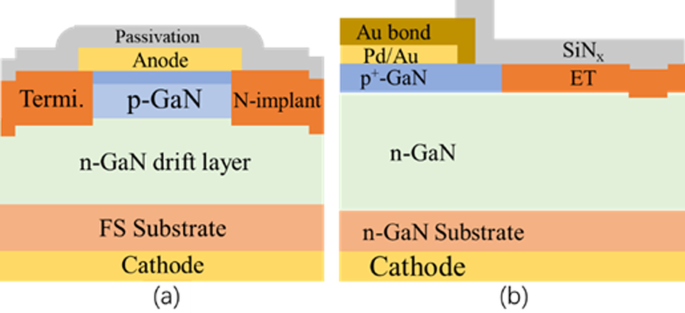
un Cross-sectional plot of the PNDs with N implantation termination, and b N implantation termination with fully and partially compensated [53, 84]
The hydrogen-plasma (H-plasma) edge termination can also reduce p -GaN conductivity, but with another mechanism. H-plasma treatment is an effective passivation method to transform the conductive p -GaN into a highly resistive one because of the strong bond of Mg-H in p -GaN. In contrast to N implantation, the H-plasma treatment is more appropriate for use in vertical GaN PNDs because of the low damage, low temperature, and simple operation involved. As shown in Fig. 8a, the PNDs exhibited an electric field of 3.0 MV/cm with just the H-plasma treatment. Simultaneously, the devices showed comparable forward I - V characteristics and a lower reverse leakage current [86].
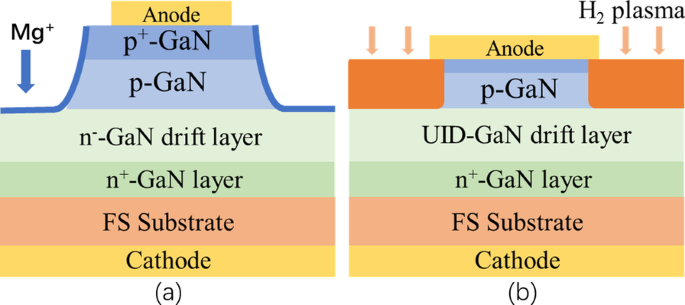
un Schematic view of PND structure by Mg ion treatment; b PNDs with H2 plasma treatment [86, 88]
At the same time, fluorine (F) ion also has the capability of modulating the peak electric field due to the negative fixed charges when the device is under a reverse bias. Nevertheless, if the F implanted edge termination is carried out in vertical GaN PINDs, strict design and structural optimization are needed [87].
In addition to the N, H, and F ion implantation as edge terminations, Mg ion implantation is also an alternative method to convert the surface/interface state, which originates from the damage of ICP dry etching. A novel Mg ion implantation coupled with moat mesa was recently adopted to compensate for the donor-like damage for GaN vertical PNDs (Fig. 8b). Then, a BV of 1.5 kV was achieved with a specific on-state R en of 0.7 mΩ cm 2 [88].
Ion implantation termination is an effective method for a high BV in vertical GaN PNDs. The ion implantation process is also relatively simple. However, crystal damage occurs during high-energy ion implantation. Moreover, post-annealing at high temperature is required in some of the ion implantation terminations for alleviating the crystal damage. The rectangle-shaped ion implantation profile is pursued, so the implantation depth must be controlled exactly. Finally, although the ion implantation process is simple, the equipment needed is costly due to usage of high energy ion.
Guard Rings
The use of floating guard rings (GR) as edge termination to improve BV is an effective method for vertical GaN PNDs, for which the reverse voltage has a voltage drop over the GR to relax the electric field crowding. At the same time, the GR fabrication process does not require a specialized step, which is synchronous with anode metal deposition. For a higher BV , a GR in the FP structure was fabricated in the PNDs (Fig. 9a), in which polyimide was set between the GR and anode portion as resistive device for a further voltage drop. Due to the resistance portion, an incremental 0.2–0.4 kV of BV to a maximum of 5.0 kV was obtained. Compared with normal PNDs without a GR structure, the device with a resistive GR exhibited a similar forward I - V characteristics with R en of 1.25 mΩ cm 2 , but a lower reverse leakage current with BFOM of 20 GW/cm 2 [69].
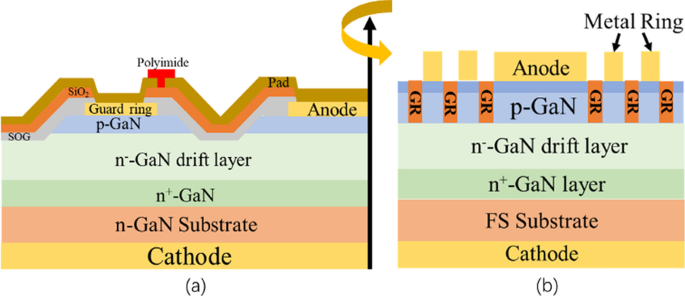
un Vertical GaN PNDs structure with floating GR termination; b PNDs structure with H-implanted GRs [69, 90]
Besides the floating GR, the H-plasma-based GR structure was also applied to form the edge termination. In addition to low damage, the low diffusivity of H-plasma could result in relatively ideal profile in GaN [89]. Owing to passivation effect of the H-plasma on p -GaN, the conductive p -GaN becomes highly resistive, and the GR structure was subsequently formed by the highly resistive p -GaN ring (Fig. 9b). The narrow GR width of 1–2 µm and decreasing spacing were used to improve the BV. GR structures with varied rings were measured. The PNDs with varied rings have similar forward characteristics with around 0.65 mΩ cm 2 and an ideality factor of 1.65 compared with those without GR. More GRs could further relax the electric field at the device edge. Thus, the devices exhibited a higher BV by increasing the number of rings after measurement. Consequently, the PNDs showed a BV of 1.7 kV with the highest electric field of 3.43 MV/cm 10 GRs [90].
The disadvantage of GR is its low area utilization rate, and the GR structure generally requires a large area, which is even bigger than anode. Then, the amount of GR raises the design difficulty such as the width and spacing of the GR. At present, two and more kinds of edge termination are adopted in single vertical GaN PNDs for a higher BV . These edge terminations typically include the FP, bevel mesa, and guard rings due to the relatively simple fabrications. On the other hand, these edge terminations are not meant to introduce the foreign element into the GaN crystal with respect to ion treatment, a feature that is beneficial for device performance. However, the quality of epitaxial layers still occupies a considerable proportion.
Vertical GaN PNDs on Si Substrate
To date, although vertical GaN-on-GaN devices exhibit excellent performance, the high cost and small diameter of GaN substrates still impede their large-scale market applications. Consider to the merit of a large scale and low cost of Si substrate, GaN-on-Si devices have attracted considerable many attentions at this stage.
For the quasi-vertical PND on Si substrate, high-quality buffer is essential. In [91], as shown in Fig. 10a, optimizing the AlN nucleation layer and the succeeding growth process, a GaN drift layer with a low threading dislocation density of 2.95 × 10 8 cm −2 and high electron mobility of 720 cm 2 Se obtuvo / Vs. With the FP structure, the device has a BV of 820 V with R en of 0.33 mΩ cm 2 .
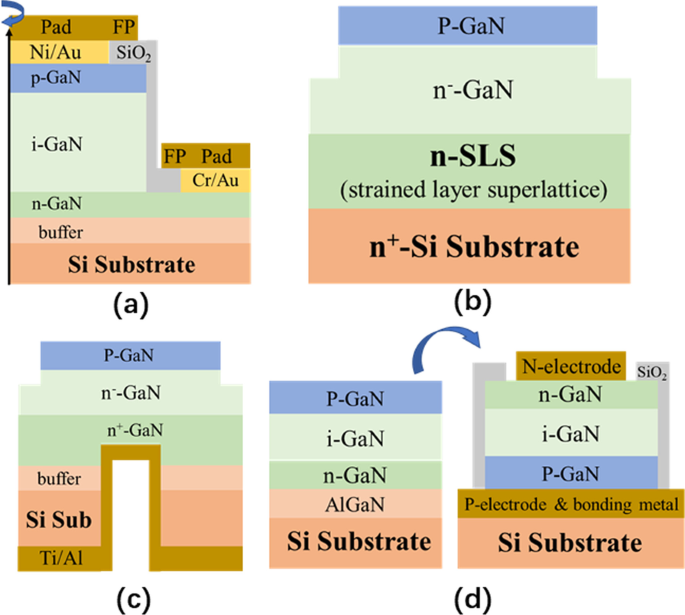
un Quasi-vertical PINDs with FP; b fully vertical PNDs by using the thin AlN and SLS superlattice structure on conductive Si substrate; c PNDs with trenched ohmic contact on back; d PNDs fabricated by layer transfer technology [91,92,93,94]
In addition to the challenge of materials mismatch, the conductive buffer layer and Si substrate are fundamental for fully vertical PNDs on Si substrate. In Fig. 10b, a n + -type Si substrate was first utilized as the cathode of vertical PNDs. Subsequently, the Si-doped thin AlN layer and GaN/AlN strained superlattice layer were employed to facilitate device performance [92]. Vertical PNDs on Si substrate are proposed with FP, and a BV of 288 V is confirmed with a drift layer of 1.5 µm. Moreover, a higher BV of 720 V in PNDs on Si with 5.7 µm drift layer is reported in Fig. 10c [93]. Unlike the conductive Si substrate method, the cathode ohmic on back approach was made by a trench, which reaches the n + -GaN layer through the selective removal of regular Si substrate and buffer layer.
Besides the conductive Si substrate and trenched ohmic contact on back, substrate removal technology is an alternative method to produce vertical GaN PNDs on Si substrates. In Fig. 10d, a layer transfer technology is used to process vertical PINDs on Si substrate. After Si substrate removal, transfer, n -electrode, and sidewall passivation, the devices exhibit a low R en of 3.3 mΩ cm 2 and BV of 350 V [94]. The high BFOM value of 37.0 MV/cm 2 in PINDs demonstrates that substrate removal technology is an effective way for GaN-based PIND fabrication on Si substrates. Relative to other technologies, however, the more complicated fabrication process and higher production cost are issues that must be addressed during the substrate removal part.
As an alternative technical route, PNDs on Si substrates are fabricated with quasi-vertical or vertical device structures. To mitigate the substantial material mismatch between the Si substrate and GaN epitaxial stacks, a more effective epitaxial technology must be investigated. For a higher BV , thicker drift layer is also essential for a higher BV . This fact presents another key issue to investigate because the drift layer thickness on Si substrate is approximately 5 µm.
Future Challenges and Conclusion
Vertical PNDs are essential to simultaneously obtain high current (> 100 A) with high voltages (> 600 V), which can meet the requirements of several applications including electric vehicles and recycled energy processing. Despite the great progress achieved, applications of vertical GaN PNDs remain several barriers such as cost and technical limitations.
For FS-GaN substrate, high epitaxial quality with low threading dislocation has been achieved by a common MOCVD. The small size and high cost of the FS-GaN substrate confine the applications of the vertical GaN PNDs within a narrow range, and the small size also raises the price of GaN. The commercial GaN substrate is only 2-inch and is much smaller than 4–6 inch SiC and 8–12 inch Si substrates. The primary challenge for vertical GaN PNDs is achieving high epitaxial quality, especially the high quality of the p -GaN layer with a high hole concentration. Recently, novel PNDs are proposed through replacing p -GaN with NiOx synthesized by thermal oxidation or sputtering; great performance is also demonstrated as replacement of p -GaN in vertical PND and guard ring in GaN SBD [95,96,97,98].
Vertical GaN PNDs, as one of the most promising power devices, are reviewed and summarized in this study. The recent progresses on vertical GaN PNDs, including comparison of different materials (SiC vs. GaN) and different device structures (SBD versus PND), material epitaxy growth and edge termination techniques (FP, MESA, ion implanted and GR edge terminations), are discussed. Los valores de R en versus BV by varied technologies are plotted in Fig. 11. Aside from the epitaxial technologies, edge termination technologies play a key role for vertical GaN PNDs to achieve high device performance at this stage. Despite its great progress in terms of device performance, the advantages of vertical GaN PNDs remain under-exploited. The characteristics of vertical GaN PNDs could be promoted by optimizing the device structure and epitaxial quality in succeeding studies. Then, commercialized vertical GaN PNDs will soon be available in the future with mature edge termination and epitaxial techniques.
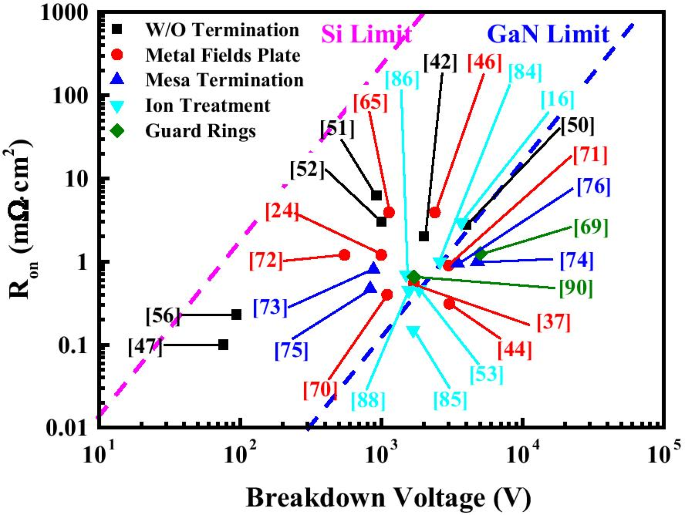
Benchmarking of the R en versus BV of quasi- or full-vertical GaN PNDs
Disponibilidad de datos y materiales
Los conjuntos de datos utilizados o analizados durante el estudio actual están disponibles del autor correspondiente a solicitud razonable.
Abreviaturas
- GaN:
-
gallium nitride
- SiC:
-
silicon carbon
- PND:
-
PN junction diode
- PIND:
-
P-i-N junction diode
- SBD:
-
Schottky barrier diode
- IGBT:
-
insulated gate bipolar transistors
- BJT:
-
bipolar junction transistor
- MOSFET:
-
metal oxide semiconductor field effect transistor
- BFOM:
-
Baliga’s figure of merit
- HFET:
-
heterostructure field-effect transistor
- JFET:
-
junction field-effect transistor
- 2DEG:
-
two-dimensional electron gas
- BV:
-
breakdown voltage
- FS:
-
free-standing
- MOCVD:
-
metalorganic chemical vapor deposition
- MBE:
-
molecular beam epitaxy
- JBS:
-
junction barrier Schottky
- MPS:
-
merged PN Schottky
- LED:
-
light-emitting diode
- HVPE:
-
hydride vapor phase epitaxy
- FP:
-
field plate
- TD:
-
threading dislocation
- MOVPE:
-
metalorganic vapor phase epitaxy
- HEMT:
-
high electron mobility transistor
- UHPA:
-
ultra-high-pressure annealing
- GR:
-
guard ring
- ICP:
-
inductively coupled plasma
- TCAD:
-
technology computer-aided design
- TMAH:
-
tetramethylammonium hydroxide
Nanomateriales
- Fuentes de energía
- Excavadora
- Los dispositivos de próxima generación brindan una capacidad PoE mejorada para dispositivos IoT
- Los dispositivos aumentan la potencia PoE sobre los interruptores y cables existentes
- Nanogenerador
- Seguridad de IoT:lo que podemos aprender de las amenazas recientes
- Los ingenieros desarrollan radios WiFi de potencia ultrabaja
- Cómo la energía inalámbrica está transformando la fabricación
- Alimentar de forma inalámbrica varios dispositivos portátiles con una sola fuente
- Uso de tecnología solar para alimentar dispositivos inteligentes en interiores
- El sistema recolecta energía de ondas de radio para alimentar dispositivos portátiles



