Efecto de la irradiación ultravioleta en las características de los diodos 4H-SiC PiN
Resumen
En este artículo, se investiga el efecto de la irradiación ultravioleta (UV) sobre las características estáticas del 4H-SiC PiN de alto voltaje. No se observa ningún cambio significativo en la característica de estado directo de los diodos 4H-SiC PiN antes y después de la irradiación con luz ultravioleta. Sin embargo, se encuentra que el voltaje de bloqueo aumenta significativamente con la irradiación UV, que es el resultado de la extensión del ancho de la región de agotamiento con la acumulación de cargas positivas bajo el aumento de la densidad de carga negativa de la superficie. La espectroscopia transitoria de nivel profundo revela que los defectos de nivel profundo inducidos por la radiación ultravioleta juegan un papel dominante sobre las cargas negativas atrapadas y, por lo tanto, conduce al aumento del voltaje de bloqueo de los diodos PiN 4H-SiC.
Introducción
Se espera que el carburo de silicio (SiC) sea un material candidato prometedor para los dispositivos electrónicos de alta potencia y alta temperatura de próxima generación, debido a su amplia banda prohibida, alta intensidad de campo eléctrico crítico, alta velocidad de saturación de electrones y conductividad térmica superior [1 , 2, 3, 4]. Los dispositivos de SiC se están desarrollando para reemplazar muchos de los dispositivos que se utilizan actualmente en el silicio, especialmente en los requisitos que necesitan operar a altos voltajes y niveles de corriente, y a temperaturas superiores a 200 ° C. En comparación con los dispositivos unipolares, los dispositivos bipolares de SiC están atrayendo un interés considerable debido a las aplicaciones de voltaje ultra alto debido al efecto de modulación de la conductividad en los últimos años. Como dispositivo bipolar típico, se ha demostrado el diodo 4H-SiC PiN de alto voltaje, que es una opción potencial para aplicaciones de rectificadores de alto voltaje, incluidas redes inteligentes avanzadas, almacenamiento de energía y energía pulsada [5,6,7,8]. En el proceso de fabricación de dispositivos de energía de SiC, se utilizan ampliamente varios procesos de plasma, como el grabado en seco y la deposición por pulverización catódica. Se han informado varios trabajos sobre daños inducidos por procesos en dispositivos de SiC para provocar degradación eléctrica [9, 10]. Además, estudios previos revelan que la irradiación ultravioleta reduce significativamente el rendimiento de los transistores de efecto de campo semiconductores de óxido metálico de SiC (MOSFET) por bombardeo de iones de alta energía y fotoemisión de plasma [11, 12]. Recientemente, se ha informado de que la irradiación con láser ultravioleta pulsado sobre semiconductor de óxido metálico (MOS) 4H-SiC puede inducir la trampa de óxido cercana a la interfaz y provocar una desviación del rendimiento del dispositivo y una degradación de la fiabilidad [13]. Sin embargo, hasta donde sabemos, la irradiación UV en los dispositivos SiC PiN no se ha investigado hasta ahora y es necesario comprender los efectos sobre las características del dispositivo SiC PiN.
En este estudio, investigamos el efecto de la irradiación ultravioleta en los diodos 4H-SiC PiN, las características de bloqueo directo e inverso utilizando irradiación ultravioleta de longitud de onda de 184,9 nm. La influencia de la acumulación de carga en la superficie sobre el voltaje de ruptura de los diodos SiC PiN se presenta mediante la simulación de tecnología de diseño asistido por computadora (TCAD). SiO 2 / Las densidades de estado de SiC antes y después de la irradiación se caracterizaron mediante un sistema de espectroscopía transitoria de nivel profundo (DLTS) en SiC MOS. DLTS se utiliza ampliamente para estudiar la distribución de la densidad de estados de la interfaz (Dit) y los defectos profundos en el condensador MOS [14, 15].
Métodos
La estructura esquemática del diodo 4H-SiC PiN informado en este artículo se muestra en la Fig. 1. La capa de amortiguación de 2 μm de espesor dopada a 1 × 10 18 cm −3 y una capa de derivación n de 60 μm de espesor con una concentración de dopaje de 2 × 10 14 cm −3 se cultivaron continuamente en sustratos 4H-SiC (0001) de tipo n fuertemente dopados fuera del eje a 4 °. Luego, la capa superior era p + ánodo con 2 μm de espesor y una concentración de dopaje de 2 × 10 19 cm −3 . Después del crecimiento epitaxial, se modeló una estructura de mesa de aislamiento circular con 2,5 µm de altura y 300 µm de diámetro utilizando plasma acoplado inductivamente que reaccionaba a través de la capa del ánodo p + en la capa n-deriva. Los gases de grabado y el material de la máscara fueron SF 6 / O 2 y depositados por deposición de vapor químico mejorada con plasma, respectivamente. Tras el aislamiento de mesa, un doble implante de Al de 1 × 10 17 cm −3 La extensión de terminación de unión (JTE) basada se formó para aliviar el amontonamiento del campo eléctrico cerca del borde de la mesa. Los implantes se activaron por recocido en Ar a 1650 ° C durante 30 min. Un SiO 2 de sacrificio La capa se hizo crecer a 1100 ° C durante 1 hora y se sumergió en HF para proporcionar una superficie nueva para la oxidación térmica. Luego, oxidación térmica en O 2 seco ambiente se realizó a 1100 ° C durante 3 h con SiO 2 capas de espesor de aproximadamente 40 nm, seguido de recocido en ambiente de Ar a 1100 ° C durante 1 h. Los materiales de contacto fueron Ni / Ti / Al para el ánodo y Ni para el cátodo. Estos metales se recocieron a 800 ° C y 1000 ° C durante 2 min para obtener un contacto óhmico de alta calidad, respectivamente. Las resistencias de contacto específicas caracterizadas por el método de longitud de transferencia lineal fueron 1 × 10 −5 Ω cm 2 y 3,75 × 10 −5 Ω cm 2 para contacto óhmico tipo Ni n y tipo Ni / Ti / Al p, respectivamente. Se depositó una capa de metal con Al espeso sobre el ánodo y el cátodo. La capa de dióxido de silicio y una capa gruesa de poliimida se modelaron en el frente para evitar chispas en la superficie durante las mediciones de alto voltaje. Además, los condensadores SiC-MOS se fabricaron en un tipo n de alta calidad (7 × 10 15 cm −3 ) capa de epitaxia sobre un sustrato de 4H-SiC fuertemente dopado. El óxido térmico de 40 nm se hizo crecer basándose en un proceso estándar de SiC PiN. El electrodo de puerta y el contacto óhmico trasero se formaron con Al y Ni, respectivamente.

Sección transversal esquemática de diodos PiN 4H-SiC
Se irradiaron diodos 4H-SiC PiN y condensadores SiC-MOS con luz ultravioleta utilizando una lámpara de mercurio con una longitud de onda de 184,9 nm en el aire durante 72 h sin tensión de polarización. Las características eléctricas de 4H-SiC PiN antes y después de la irradiación UV se evaluaron mediante la sonda Wentworth y el sistema de caracterización de semiconductores Agilent B1505A. Los estados de interfaz de los condensadores SiC-MOS y las cargas fijas se caracterizaron luego mediante un sistema PhysTech Fourier Transform DLTS. El sesgo inverso aplicado V R y el voltaje del pulso de llenado V P fueron 15 V y 2 V, respectivamente. El período de muestreo t w del pulso de polarización de V R a V P fue de 1,5 s.
Resultados y discusión
El efecto de la irradiación UV sobre las características estáticas de SiC PiN se muestra en las Figs. 2 y 3 donde se comparan las características medidas antes y después de la irradiación para el dispositivo 1 (D1) y el dispositivo 2 (D2). El diámetro de los diodos circulares de SiC PiN es de 3,5 mm y el área activa es de aproximadamente 10 mm 2 . La caída de voltaje directo para SiC PiN es de aproximadamente 3,95 V a una densidad de corriente de 100 A / cm 2 para ambos dos dispositivos antes de la irradiación UV. Se observa claramente en la Fig. 2 que no hay cambios significativos en la característica de estado de encendido directo para dos dispositivos, cambiando de 3,95 a 4,0 V después de la irradiación UV. Los voltajes de bloqueo logrados del dispositivo 1 y el dispositivo 2 fabricados en una depiladora n-drift de 60 μm de espesor son de 7 kV y 7,2 kV con una corriente de fuga de menos de 1 μA, respectivamente. Cabe señalar que la eficacia de bloqueo de los diodos PiN es aproximadamente el 70% del valor teórico de 9,7 kV para una capa de deriva de 60 μm de espesor, que la inexactitud de la activación de impurezas probablemente conduce a una desviación de la ventana de implante JTE óptima. Después de la irradiación UV, la tensión de bloqueo del dispositivo 1 muestra un aumento notable de 7 a 9,2 kV con una mejora de 2,2 kV, acercándose al valor ideal del plano paralelo. En consecuencia, se logra una mejora de 1,7 kV para el dispositivo 2 después de la irradiación UV.

Característica de estado de avance del diodo 4H-SiC PiN antes y después de la irradiación UV
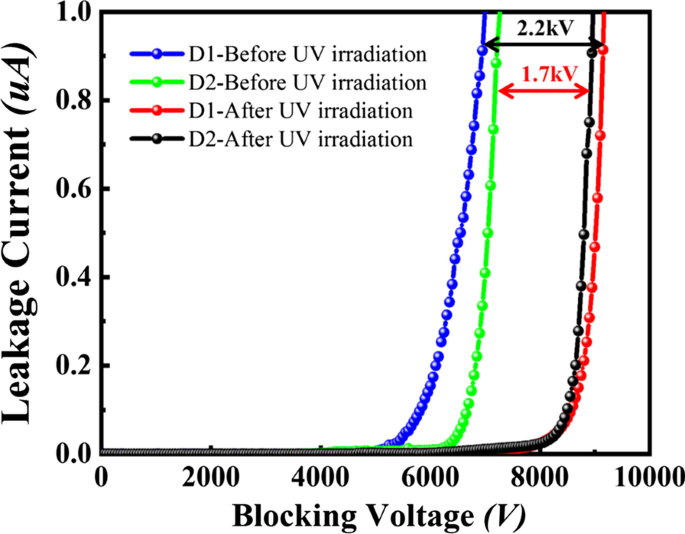
Característica inversa del diodo 4H-SiC PiN antes y después de la irradiación UV
Es bien sabido que las trampas de superficie tienen un efecto significativo sobre la distribución del campo eléctrico en la región terminal y luego afectan las características de bloqueo inverso en el dispositivo de potencia de SiC. Ikeguchi y col. han indicado que la iluminación ultravioleta de alta energía con energía de fotones ≥ 5 eV puede transformar los dobles enlaces C-C tensos preexistentes en trampas de electrones activos y, por lo tanto, conduce a la producción de defectos de interfase cargados negativamente observados por V

Voltaje de ruptura simulado versus concentración de implante JTE para carga negativa de superficie, incluida la ausencia de carga, 1 × 10 11 cm −2 , 5 × 10 11 cm −2 , 1 × 10 12 cm −2 , 5 × 10 12 cm −2 y 1 × 10 13 cm −2 respectivamente
La Figura 5 compara la influencia de la acumulación de carga superficial negativa en el perfil del campo eléctrico en la característica de bloqueo. La distribución del campo eléctrico con la evolución de la región de agotamiento en los diodos 4H-SiC PiN se muestra en la Fig. 5a. Cuando la carga negativa aumenta a 5 × 10 12 cm −2 en el SiO 2 / SiC (región de estructura JTE) de SiC PiN, la carga positiva de la capa de deriva de N se recoge en la superficie de la interfaz, lo que lleva a una extensión significativa de la región de agotamiento [16]. La Fig. 5b muestra la línea de corte del campo eléctrico debajo de la unión de la región JTE / n-deriva con la densidad de carga negativa superficial de 1 × 10 11 y 5 × 10 12 cm −2 . En el caso de una carga superficial baja de 1 × 10 11 cm −2 , aparece un severo apiñamiento del campo eléctrico en la región de terminación del borde con un valor máximo de 2.5 MV / cm y el voltaje de ruptura es de aproximadamente 8 kV. A medida que la densidad de cargas aumenta a 5 × 10 12 cm −2 , el campo eléctrico pico cae a 2,2 MV / cm y, en comparación, se suprime el apiñamiento del campo eléctrico en la región de terminación del borde. Mientras tanto, la distribución del campo eléctrico es más uniforme y la tensión de ruptura aumenta de forma evidente. Por lo tanto, la carga negativa de la superficie puede causar la extensión del agotamiento y aliviar el hacinamiento del campo eléctrico, lo que resulta en la mejora del voltaje de ruptura.

Distribuciones de campo eléctrico simulado de SiC PiN con densidad de carga negativa superficial de 1 × 10 11 cm −2 y 5 × 10 12 cm −2 : a distribución del campo eléctrico con la evolución de la región de agotamiento b línea de corte del campo eléctrico debajo de la unión de la región JTE / n-deriva. La concentración del implante se utiliza 6 × 10 16 cm −3
Para validar aún más los mecanismos físicos de generación de los defectos electrónicos inducidos por irradiación, una mejor caracterización eléctrica del SiO 2 / Se requiere la interfaz SiC para investigar con más detalles. Los espectros DLTS para capacitores 4H-SiC SiC-MOS se caracterizaron en un agotamiento de 15 a 2 V antes y después de la irradiación UV, como se muestra en la Fig. 6. A partir de los espectros DLTS, se observaron dos picos en los capacitores 4H-SiC MOS antes y después de la irradiación UV, ubicándose en 210 K y 490 K, respectivamente. Los picos negativos de DLTS indican que el nivel P1 y P2 son trampas de electrones. El nivel de P2 amplio y significativo muestra un aumento significativo de la amplitud máxima, lo que significa que la concentración de trampa de electrones aumenta con la irradiación UV. Además, se encuentra que la señal DLTS aumenta proporcionalmente al tiempo de llenado, exhibiendo una cinética de llenado de trampas característica de defectos extendidos, tales como defectos de interfaz en lugar de defectos puntuales. El inserto muestra las distribuciones de la densidad del estado de la interfaz frente a la energía de activación E T . La densidad del estado de la interfaz se calcula mediante \ (D _ {{{\ text {it}}}} =\ varepsilon _ {{{\ text {sic}}}} C _ {{{\ text {ACC}}}} AN _ {{ \ text {D}}} \ Delta C / \ left [{C_ {R} ^ {3} kT} \ right] \) [17]. Puede verse en la figura que el defecto de la interfaz da lugar a una banda de energía en la banda prohibida de E C - 0,65 eV a E C - 1,25 eV y su densidad aumentó significativamente de 2 × 10 12 cm −2 eV −1 hasta 6 × 10 12 cm −2 eV −1 después de la irradiación UV. Combinando mediciones de capacitancia transitoria, microscopía electrónica de transmisión de alta resolución y cálculos de teoría funcional de densidad, Dong et al. sugirió que estos defectos de la interfaz se originaron a partir de un exceso de carbono intersticial dividido cargado negativamente en la interfaz [18]. El pico P1 a 210 k corresponde a una trampa de electrones en E C - 0,41 eV. Su concentración no muestra ningún cambio esencial después de la irradiación UV y se asignó provisionalmente una trampa P1 a los defectos puntuales de la depiladora de SiC. Sin embargo, su configuración atómica aún no está clara y debe aclararse en futuras investigaciones.
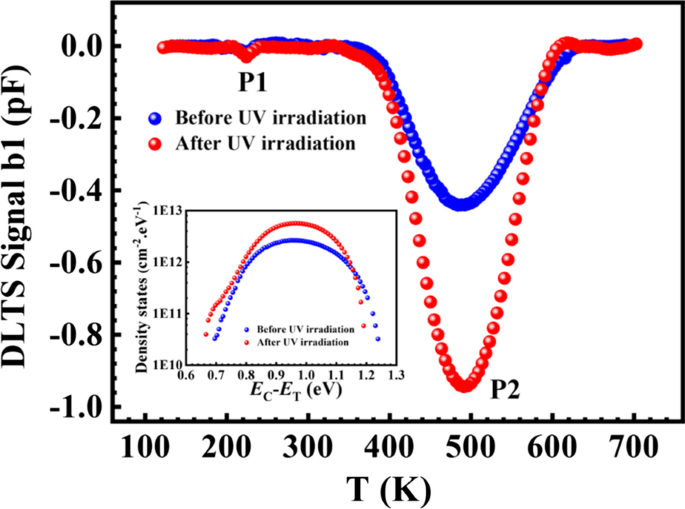
Espectros DLTS para diodos 4H-SiC PiN antes y después de la irradiación UV. El inserto muestra la D distribuciones para diodos 4H-SiC PiN antes y después de la irradiación UV
Conclusiones
Se ha investigado la influencia de la irradiación UV en las características eléctricas de los diodos 4H-SiC PiN. A partir de los resultados de los experimentos eléctricos, se observa un cambio insignificante de la corriente directa después de la irradiación UV. Sin embargo, la irradiación UV parece un aumento notable del voltaje de bloqueo. Se encuentra que la irradiación UV genera defectos de nivel profundo en la interfaz de los diodos PiN, lo que resulta en un aumento de los niveles de aceptadores profundos en la banda prohibida. Estos defectos de nivel profundo sirven como el centro de captura de electrones y conducen a un aumento significativo de carga negativa en SiO 2 / Interfaz SiC. Las cargas positivas de la capa de N dirft se recogen en la superficie de la interfaz y promueven aún más la extensión de la región de agotamiento con una distribución de campo eléctrico más uniforme, lo que provoca el aumento del voltaje de bloqueo.
Disponibilidad de datos y materiales
Todos los datos están disponibles sin restricciones.
Nanomateriales
- Diodos
- Diodos de propósito especial
- Rodillo
- Pin de bolos
- Características de la fibra de vidrio
- Efecto de la distribución de nanopartículas de oro en TiO2 sobre las características ópticas y eléctricas de las células solares sensibilizadas por colorante
- Efecto del polietilenglicol en el fotocátodo de NiO
- Efecto del recocido en microestructuras y endurecimiento de aleaciones de vanadio secuencialmente implantadas con hidrógeno-helio
- Efecto del recubrimiento de nanocapa de tungsteno en el electrodo de Si en una batería de iones de litio
- Diodos emisores de luz ultravioleta basados en AlGaN casi sin caída de eficiencia con una capa de bloqueo de electrones tipo p de superrejilla diseñada específicamente para una alta eficiencia de…
- Estructura electrónica y características I-V de las nanocintas InSe



