Transistores de efecto de campo de capacitancia negativa de germanio:Impactos de la composición de Zr en Hf1 − xZrxO2
Resumen
Transistores de efecto de campo de capacitancia negativa de germanio (Ge) (NCFET) con varias composiciones de Zr en Hf 1− x Zr x O 2 ( x =0,33, 0,48 y 0,67) se fabrican y caracterizan. Para cada composición de Zr, el NCFET muestra la caída repentina en algunos puntos de oscilación por debajo del umbral (SS), que es inducida por el efecto NC. Conducir la corriente I DS aumenta con el aumento de la temperatura de recocido, lo que debería deberse a la reducción de la resistencia a la fuente / drenaje y a la mejora de la movilidad del portador. Los puntos SS empinados son repetibles y estables a través de múltiples mediciones de barrido de CC, lo que demuestra que son inducidos por el efecto NC. Los valores del voltaje de la puerta V GS correspondientes a SS empinadas son consistentes y en el sentido de las agujas del reloj I DS - V GS se mantienen a través de los múltiples barridos de CC. A temperatura de recocido fija, dispositivo NC con Hf 0.52 Zr 0,48 O 2 logra el I más alto DS pero histéresis mayor en comparación con las otras composiciones. NCFET con Hf 0.67 Zr 0,33 O 2 puede obtener el excelente rendimiento con curvas sin histéresis y alto I DS .
Antecedentes
El transistor de efecto de campo de capacitancia negativa ferroeléctrica (NCFET) con una película ferroeléctrica insertada en la pila de compuertas es un candidato prometedor para las aplicaciones de disipación de baja potencia debido a su capacidad para superar la limitación fundamental en la oscilación por debajo del umbral (SS) para el metal convencional. transistor de efecto de campo de semiconductor de óxido (MOSFET) [1]. Los fenómenos de capacitancia negativa (NC) en los NCFET se han estudiado exhaustivamente en diferentes materiales de canales, incluidos el silicio (Si) [2, 3], el germanio (Ge) [4], el germanio-estaño (GeSn) [5], III – V [6] y materiales 2D [7]. Además, las características NC se han demostrado en NCFET con varios ferroeléctricos, como BiFeO 3 [8], PbZrTiO 3 (PZT) [9], PVDF [10] y Hf 1− x Zr x O 2 [11]. En comparación con otros ferroeléctricos, Hf 1− x Zr x O 2 tiene la ventaja de ser compatible con la integración CMOS. Los estudios experimentales han demostrado que el rendimiento eléctrico de los NCFET se puede optimizar variando el grosor y el área de Hf 1− x Zr x O 2 , que afecta la coincidencia entre la capacitancia MOS ( C MOS ) y capacitancia ferroeléctrica ( C FE ) [12, 13]. Se espera que la composición de Zr en Hf 1− x Zr x O 2 también tiene un gran impacto en el rendimiento de los NCFET, ya que determina las propiedades ferroeléctricas de Hf 1− x Zr x O 2 . Sin embargo, todavía falta un estudio detallado sobre los impactos de la composición de Zr en las características eléctricas de los NCFET.
En este artículo, estudiamos exhaustivamente las influencias de la temperatura de recocido y la composición de Zr en el rendimiento de Ge NCFET.
Métodos
Pasos clave del proceso para fabricar NCFET de canal p de Ge con las diferentes composiciones de Zr en Hf 1− x Zr x O 2 se muestran en la Fig. 1 (a). Después de la limpieza previa a la compuerta, se cargaron sustratos n-Ge (001) en la cámara de deposición de la capa de átomos (ALD). Una fina Al 2 O 3 (25 ciclos) se depositó la película, que fue seguida por el O 3 pasivación. Luego, el Hf 1- x Zr x O 2 Las películas (x =0,33, 0,48 y 0,67) se depositaron en la misma cámara de ALD utilizando [(CH 3 ) 2 N] 4 Hf (TDMAHf), [(CH 3 ) 2 N] 4 Zr (TDMAZr) y H 2 O como precursores de Hf, Zr y O, respectivamente. Después de eso, la puerta de metal TaN se depositó utilizando la pulverización catódica reactiva. Después del modelado y grabado de la puerta, los iones de boro (B + ) se implantaron en regiones de fuente / drenaje (S / D) a una energía de 20 keV y una dosis de 1 × 10 15 cm −2 . Los metales S / D no autoalineados se formaron mediante un proceso de despegue. Finalmente, se llevó a cabo un recocido térmico rápido (RTA) a varias temperaturas para la activación del dopante, la metalización S / D y la cristalización de Hf 1− x Zr x O 2 película. Controle los pMOSFET con el Al 2 O 3 / HfO 2 También se fabricó la pila.

( a ) Pasos clave del proceso para la fabricación de Ge NCFET con las diferentes composiciones de Zr en Hf 1 −x Zr x O 2 ferroeléctricos. ( b ) Esquema del transistor NC fabricado. ( c ) Imagen TEM de la pila de puertas del dispositivo NC que ilustra el H 0.52 de 7 nm Zr 0,48 O 2 capa y 2 nm Al 2 O 3 capa
La Figura 1 (b) muestra el esquema del NCFET fabricado. La imagen del microscopio electrónico de transmisión de alta resolución (HRTEM) en la Fig.1 (c) muestra la pila de puertas en el canal Ge del dispositivo con Hf 0.52 Zr 0,48 O 2 ferroeléctrico. Los espesores de Al 2 O 3 y Hf 0.52 Zr 0,48 O 2 las capas son de 2 nm y 7 nm, respectivamente.
Para confirmar las estequiometrías de Hf 1− x Zr x O 2 , se llevó a cabo la medición de espectroscopía de fotoelectrones de rayos X (XPS). La Figura 2 (a) y (b) muestran el Hf 4f y Zr 3d espectros de nivel de núcleo de fotoelectrón, respectivamente, para el Hf 0.67 Zr 0,33 O 2 , Hf 0.52 Zr 0,48 O 2 y Hf 0.33 Zr 0,67 O 2 Película (s. Las composiciones de material se calcularon basándose en la relación de áreas de los picos y los factores de sensibilidad correspondientes. Los dos picos de Zr 3d 5/2 y Zr 3d 3/2 tienen una división de espín-orbital de 2.4 eV, que consiste en Refs. [14, 15]. Con el incremento de la composición de Zr en Hf 1− x Zr x O 2 , Zr 3d y Hf 4f los picos cambian a la dirección de energía más baja.

( a ) Hf 4f y ( b ) Zr 3d espectros de nivel de núcleo para el Hf 1− x Zr x O 2 muestras con las diferentes composiciones de Zr
Las propiedades ferroeléctricas del Hf 1− x Zr x O 2 películas ( x =0.33, 0.48 y 0.66) se caracterizaron por la polarización P frente al voltaje de la unidad V Medición de bucles de histéresis. P - V Los bucles se registraron en los dispositivos prístinos. La Figura 3 muestra las curvas de P frente a V para TaN / Hf 1− x Zr x O 2 (10 nm) / TaN muestras en una serie de voltajes de excitación. Con el aumento de la temperatura posterior al recocido de 500 a 550 ° C, la P - V curvas de Hf 1− x Zr x O 2 tienden a estar saturados en un estado de sub-bucle. A medida que aumenta la composición de Zr, la polarización remanente de la película mejora obviamente y se observa el adelgazamiento del bucle de histéresis en el sesgo cero, que se puede describir fenomenológicamente mejor como características de tipo antiferroeléctrico superpuestas [16, 17].
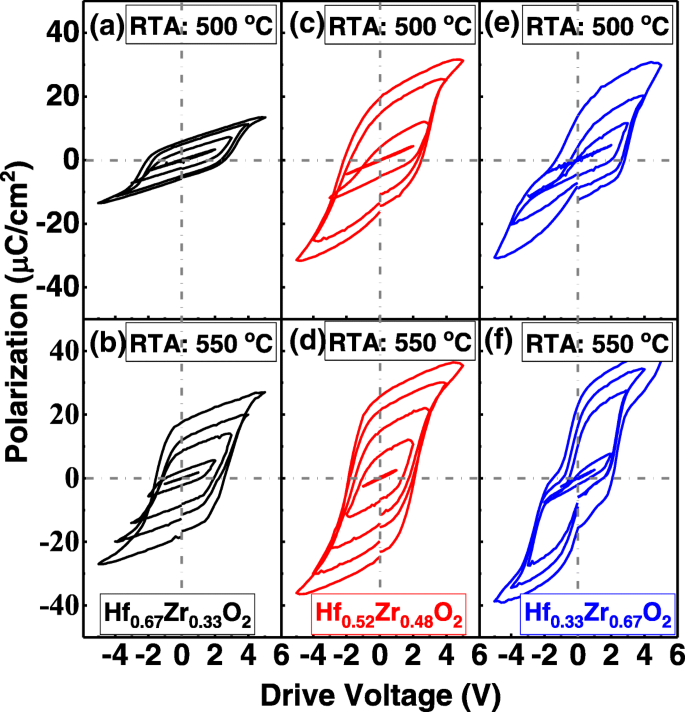
Curvas P-V medidas del Hf 1-x Películas de ZrxO2 con diferentes composiciones de Zr recocidas a 500 y 550 o C. ( a ) y ( b ) son los Hf 0.67 Zr 0,33 O 2 película recocida a 500 y 550 o C, respectivamente. ( c ) y ( d ) son los Hf 0.52 Zr 0,48 O 2 película recocida a 500 y 550 o C, respectivamente. ( e ) y ( f ) son los Hf 0.33 Zr 0,67 O 2 película recocida a 500 y 550 o C, respectivamente. Con el post recocido la temperatura aumenta de 500 a 550 o C, las curvas P-V del Hf 1-x Zr x O 2 tienden a estar saturados en un estado de sub-bucle. Se observa una evolución ferroeléctrica a un comportamiento similar al antiferroeléctrico con la composición de Zr aumentada
Resultados y discusión
La Figura 4 (a) muestra las características de transferencia medidas de Ge NCFET con Hf 0.52 Zr 0,48 O 2 ferroeléctricos con diferentes temperaturas de recocido y dispositivo de control con Al 2 O 3 / HfO 2 apilar dieléctrico. El dispositivo de control se recoció a 500 ° C. Todos los dispositivos tienen una longitud de puerta L G de 2 μm. El barrido hacia adelante y hacia atrás se indican mediante los símbolos abierto y sólido, respectivamente. Los NCFET tienen una corriente de accionamiento mucho más alta en comparación con el dispositivo de control. Se ve que, con la temperatura de recocido aumentando de 450 a 550 ° C, el voltaje umbral V TH de los dispositivos NC cambian al positivo V GS dirección. Los NCFET exhiben una pequeña histéresis, que se vuelve insignificante con el aumento de la temperatura del RTA. El efecto de captura también conduce a la histéresis, pero eso produce el I en sentido antihorario. DS - V GS bucle, opuesto a los resultados inducidos por la conmutación ferroeléctrica [18]. Punto SS frente a I DS Las curvas de la Fig. 4 (b) muestran que el transistor NC presenta la caída repentina en algunos puntos de SS, correspondiente al cambio brusco de I DS inducida por el efecto NC [19]. Se observa que los NCFET logran características SS mejoradas en comparación con el dispositivo de control. Descubrimos que los puntos de caída repentinos de los dispositivos son consistentes a las diferentes temperaturas de recocido. El I medido DS - V DS curvas de los NCFET con Hf 0.52 Zr 0,48 O 2 ferroeléctricos recocidos a diferentes temperaturas se muestran en la Fig. 4 (c). yo DS - V DS Las curvas del transistor NC muestran el obvio fenómeno NDR, que es una característica típica de los transistores NC [20, 21, 22, 23]. La Figura 4 (d) son las gráficas del I DS de los Ge NCFET con el Hf 0.52 Zr 0,48 O 2 capa ferroeléctrica recocida a 450, 500 y 550 ° C, respectivamente, a V DS =- 0.05 V y - 0.5 V, y | V GS - V TH | =1.0 V. Aquí, la V TH se define como la V GS en I DS de 10 −7 A / μm. yo DS aumenta con el aumento de la temperatura de RTA, que se debe a la reducción de la resistencia de la fuente / drenaje y la movilidad mejorada del portador a la temperatura de recocido más alta.
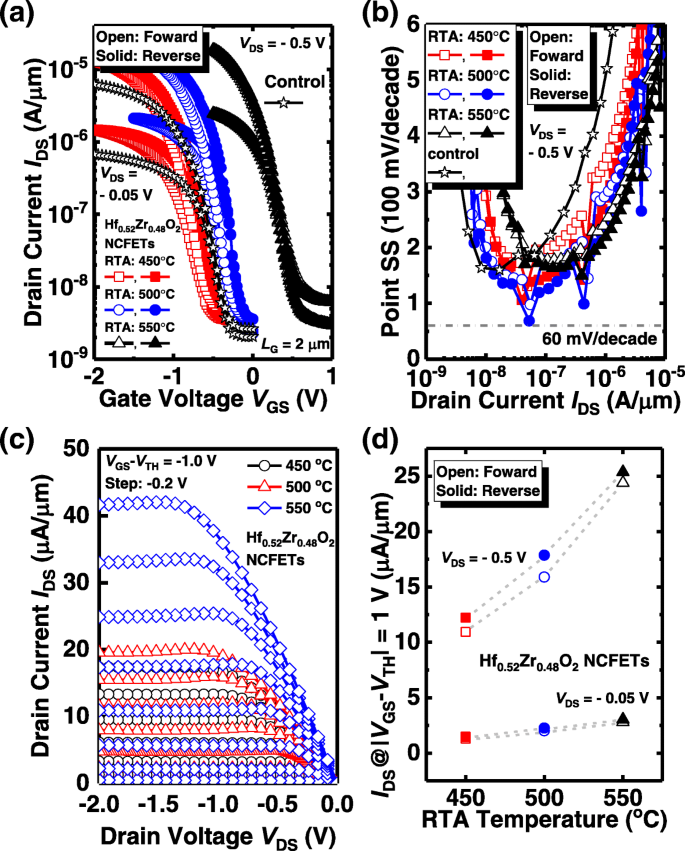
( a ) Medido I DS - V GS curvas para NCFET con Hf 0.52 Zr 0,48 O 2 Dispositivo ferroeléctrico y de control. ( b ) Punto SS frente a I DS curvas que muestran que los NCFET tienen la SS más pronunciada en comparación con los MOSFET de control. ( c ) Yo DS - V DS curvas para los NCFET que demuestran los fenómenos típicos de NDR. ( d ) Comparación de I DS para los NCFET recocidos a varias temperaturas con una sobremarcha de compuerta de 1 V
Además del Hf 0.52 Zr 0,48 O 2 transistor ferroeléctrico, también investigamos las características eléctricas de los transistores Ge NC con el Hf 0.33 Zr 0,67 O 2 ferroeléctrico. La Figura 5 (a) presenta el I DS - V GS características de los dispositivos con Hf 0.33 Zr 0,67 O 2 con las diferentes temperaturas de recocido a V DS =- 0.05 V y - 0.5 V. Comparado con el Hf 0.52 Zr 0,48 O 2 Transistores NC, se obtiene una histéresis aún menor. Similar al Hf 0.52 Zr 0,48 O 2 Transistores NC, a medida que la temperatura de recocido aumenta de 450 a 550 ° C, V TH del dispositivo aumenta de - 0,63 V a 0,51 V en el barrido hacia adelante en V DS =- 0.05 V. Punto SS en función de I DS características para el Hf 0.33 Zr 0,67 O 2 Los NCFET ferroeléctricos se muestran en la Fig. 5 (b). Además, los dispositivos con una temperatura de recocido de 450 ° C y 500 ° C obtienen la caída repentina más obvia en SS en comparación con el transistor recocido de 550 ° C. Los puntos de caída repentinos en diferentes temperaturas de recocido ocurren con el mismo voltaje de puerta. La figura 5 (c) muestra el avance y retroceso I DS del Hf 0.33 Zr 0,67 O 2 NCFET en V DS =- 0.05 V y - 0.5 V, y | V GS - V TH | =1.0 V. Ya sea para el barrido hacia adelante o hacia atrás, el I DS aumenta con la temperatura de recocido, que es consistente con la característica del Hf 0.52 Zr 0,48 O 2 dispositivo.
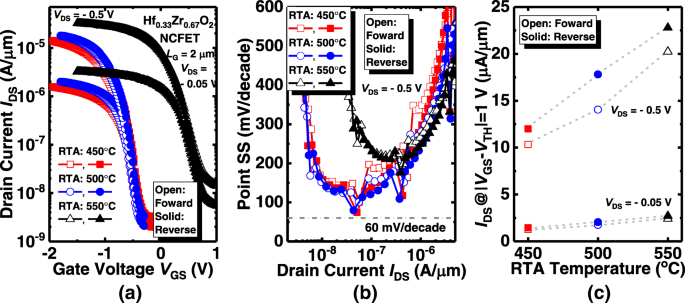
( a ) Características de transferencia medidas del Hf 0.33 Zr 0,67 O 2 NC Ge pFET recocidos de 450 a 550 ° C. ( b ) Punto SS en función de I DS para el Hf 0.33 Zr 0,67 O 2 dispositivos. ( c ) Yo DS para los transistores NC ferroeléctricos con diferentes temperaturas de recocido a una sobremarcha de puerta de 1 V
También investigamos el rendimiento eléctrico de Ge NCFET con la composición de Zr más pequeña. Las características de transferencia del Hf 0.67 Zr 0,33 O 2 Los NCFET recocidos a diferentes temperaturas de recocido se presentan en la Fig. 6 (a). No se observa ningún fenómeno de histéresis. Comparado con Hf 0.33 Zr 0,67 O 2 y Hf 0.52 Zr 0,48 O 2 dispositivos, el V TH El cambio inducido por la variación de la temperatura de recocido es menos pronunciado en Hf 0.67 Zr 0,33 O 2 NCFET. Punto SS frente a I DS Las curvas de la Fig.6 (b) muestran que el Hf 0.67 Zr 0,33 O 2 El transistor NC muestra la caída repentina en algunos puntos de SS del transistor NC en V DS =- 0.05 V. La Figura 6 (c) presenta el I DS de Hf 0.67 Zr 0,33 O 2 Ge NCFET recocidos a 450 ° C, 500 ° C y 550 ° C, a V DS =- 0.05 V y - 0.5 V, y | V GS - V TH | =1.0 V. Asimismo, I DS mejora a medida que aumenta la temperatura del RTA.
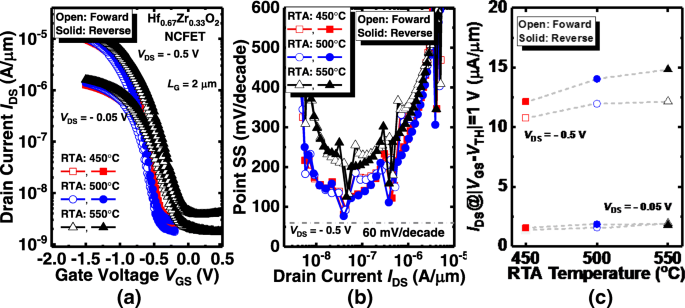
( a ) Medido I DS - V GS del Hf 0.67 Zr 0,33 O 2 NC Ge pFET recocidos a 450 ° C, 500 ° C y 550 ° C. ( b ) Punto SS frente a I DS características de los dispositivos. ( c ) Yo DS para los transistores NC ferroeléctricos con diferentes temperaturas de recocido a una sobremarcha de puerta de 1 V
La estabilidad del efecto NC inducido por la capa ferroeléctrica del Hf 0.52 Zr 0,48 O 2 NCFET se verificó mediante múltiples mediciones de barrido de CC. El I medido DS - V GS Las curvas de más de 100 ciclos de barrido de CC se muestran en la Fig. 7 (a). Puede verse que los valores de V GS correspondientes a SS empinadas son consistentes. Además, el I-V en el sentido de las agujas del reloj los bucles se mantienen a través de los múltiples barridos de CC. Los puntos SS empinados son repetibles y estables a través de múltiples barridos de CC, lo que demuestra además que son inducidos por el efecto NC. La Figura 7 (b) presenta el mejor punto SS y la corriente de excitación a través del número de ciclos de barrido. La figura 7 (c) muestra las características de histéresis en función del número de ciclos de barrido de CC. Estable I-V Se ven una ventana de histéresis de ~ 82 mV.
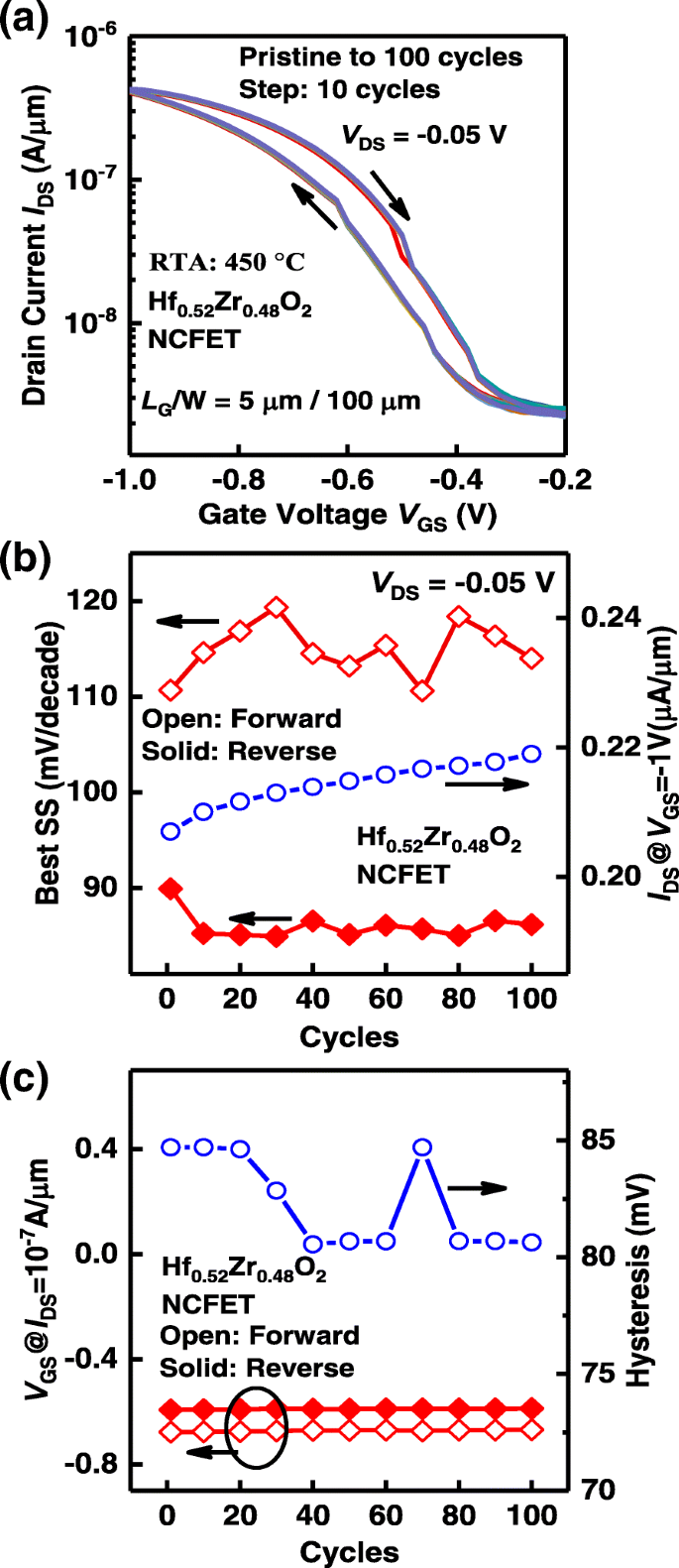
( a ) Medido I DS - V GS curvas de un Hf 0.52 Zr 0,48 O 2 NC Ge pFET durante 100 ciclos de barrido de CC. ( b ) Mejor punto SS y I DS vs. número de ciclo. ( c ) Características de histéresis en función del número de ciclos de barrido de CC
Resumimos la histéresis y las características de la corriente de impulso de los NCFET de Ge con diferentes composiciones de Zr en Hf 1− x Zr x O 2 en la Fig. 8. Como se muestra en la Fig. 8 (a), los valores de histéresis son 70, 148 y 106 mV para dispositivos con x =0,33, 0,48 y 0,67, respectivamente, en una V DS de - 0,5 V. A medida que la composición aumenta de 0,33 a 0,48, la histéresis del dispositivo NC aumenta significativamente. Con el aumento adicional de la composición de Zr, la histéresis disminuye rápidamente. El yo DS de NCFET recocidos a 450 ° C se representa en la Fig. 8 (b), en V DS =- 0 . 5 V y V GS - V TH =- 1 . 0 V. Abierto y sólido representan el barrido hacia adelante y hacia atrás, respectivamente. El dispositivo NC con Hf 0.52 Zr 0,48 O 2 logra el I más alto DS , pero su histéresis es grave. NCFET con Hf 0.67 Zr 0,33 O 2 puede obtener un rendimiento excelente con curvas sin histéresis y un I alto DS . A medida que aumenta la composición de Zr, la capacitancia ferroeléctrica C fe (=0.3849 * P r / ( E c * t fe ) [24]) aumenta con el aumento de P r , y mientras tanto, la capacitancia MOS ( C MOS ) también aumenta debido a la permitividad creciente de la película de HZO. El yo DS y la histéresis están determinadas por | C fe | y C MOS del transistor. Con la composición de Zr aumentando de 0,33 a 0,48, el aumento de | C fe | se especula que es más lento que el C MOS , lo que lleva a la ampliación de la histéresis. Sin embargo, la C más grande MOS produce un I más alto DS . Con el aumento adicional de la composición de Zr, el aumento de | C fe | es más rápido que C MOS , que podría proporcionar | C fe | ≥ C MOS , reduciendo la histéresis de NCFET.
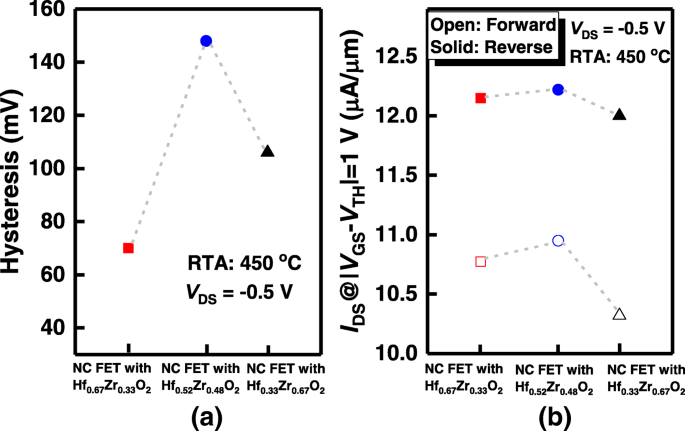
Gráficos estadísticos de ( a ) histéresis y ( b ) Yo DS de Ge NCFET con Hf 1− x Zr x O 2 ( x =0.33, 0.48 y 0.67)
Conclusiones
Los impactos de la temperatura de recocido y la composición de Zr en Hf 1 −x Zr x O 2 sobre el rendimiento eléctrico de los Ge NCFET se estudian experimentalmente. Las estequiometrías y propiedades ferroeléctricas de Hf 1− x Zr x O 2 fueron confirmados por XPS y P-V medidas, respectivamente. Los NCFET demuestran el punto empinado SS y la I mejorada DS en comparación con el dispositivo de control, debido al efecto NC. La V TH y yo DS del Hf 1 −x Zr x O 2 Los NCFET se ven muy afectados por la temperatura de recocido. Múltiples mediciones de barrido de CC muestran que la estabilidad del efecto NC inducido por la capa ferroeléctrica se logra en NCFET. Hf 0.67 Zr 0,33 O 2 NCFET puede lograr más fácilmente las características sin histéresis que los dispositivos con una composición de Zr más alta.
Abreviaturas
- Al 2 O 3 :
-
Óxido de aluminio
- ALD:
-
Deposición de la capa atómica
- BF 2 + :
-
Ión de fluoruro de boro
- DC:
-
Corriente continua
- Ge:
-
Germanio
- GeO x :
-
Óxido de germanio
- HF:
-
Ácido fluorhídrico
- HfO 2 :
-
Dióxido de hafnio
- HRTEM:
-
Microscopio electrónico de transmisión de alta resolución
- MOSFET:
-
Transistores de efecto de campo semiconductores de óxido metálico
- NC:
-
Capacitancia negativa
- Ni:
-
Níquel
- SS:
-
Oscilación del subumbral
- TaN:
-
Nitruro de tantalio
- TDMAHf:
-
Tetrakis (dimetilamido) hafnio
- TDMAZr:
-
Tetrakis (dimetilamido) circonio
Nanomateriales
- Campos eléctricos y capacitancia
- Factores que afectan la capacitancia
- Dispositivos de efecto Hall digitales (ON / OFF):interruptores y pestillos
- Detección de posición con efecto Hall:linealidad de respuesta y pendiente para configuraciones deslizantes
- Separadores de aire para chips de 10 nm
- Un salto nanométrico a billones de transistores
- Efecto de la irradiación ultravioleta en las características de los diodos 4H-SiC PiN
- Efecto del tratamiento de recocido in situ sobre la movilidad y morfología de transistores de efecto de campo orgánico basados en TIPS-pentaceno
- Efecto del polietilenglicol en el fotocátodo de NiO
- Investigación teórica de nanocables de germanio tensados biaxialmente por tracción
- Efecto del recubrimiento de nanocapa de tungsteno en el electrodo de Si en una batería de iones de litio



