Transistores de efecto de campo ferroeléctrico ZrO2 habilitados por los dipolos de vacantes de oxígeno conmutables
Resumen
Este artículo investiga los impactos del recocido térmico post-rápido (RTA) y el espesor de ZrO 2 sobre la polarización P y características eléctricas de TaN / ZrO 2 / Condensadores Ge y FeFET, respectivamente. Después del RTA que varía de 350 a 500 ° C, TaN / ZrO 2 / Condensadores de Ge con ZrO 2 amorfo de 2,5 y 4 nm de espesor película exhibe el P estable . Se propone que el comportamiento ferroeléctrico se origina a partir de la migración de los dipolos impulsados por voltaje formados por las vacantes de oxígeno y las cargas negativas. FeFET con ZrO 2 de 2,5 nm, 4 nm y 9 nm Demuestre la ventana de memoria decente (MW) con pulsos de programa / borrado de 100 ns. Un ZrO 2 de 4 nm de espesor FeFET ha mejorado significativamente las características de fatiga y retención en comparación con los dispositivos con ZrO 2 de 2,5 nm y 9 nm . El rendimiento de retención del ZrO 2 FeFET se puede mejorar con el aumento de la temperatura RTA. Se extrapola un MW de ~ 0,46 V para mantenerlo durante 10 años para el dispositivo con 4 nm ZrO 2 .
Antecedentes
Poli-HfO dopado 2 Los transistores ferroeléctricos de efecto de campo (FeFET) han atraído un interés considerable en las aplicaciones de memoria no volátil (NVM) debido a su compatibilidad con el proceso CMOS [1]. Aunque se ha demostrado un rendimiento eléctrico decente en HfO 2 dopado basados en FeFETs [2], algunas limitaciones fundamentales todavía afectan sus aplicaciones prácticas, incluyendo el alto balance térmico de recocido de 500 ° C requerido para formar fases cristalinas ortorrómbicas y la corriente de fuga no deseada a lo largo de los límites de los granos con la reducción del espesor ferroeléctrico. La ferroelectricidad se ha observado ampliamente en una variedad de materiales diferentes, por ejemplo, Sb 2 S 3 nanocables [3], GaFeO 3 película [4], LaAlO 3 -SrTiO 3 película [5] y Al 2 amorfo O 3 que contienen nanocristales [6, 7]. Recientemente, informamos los FeFET con ZrO 2 parcialmente cristalizado aislador de puerta que funciona como NVM y sinapsis analógica [8]. Aunque el ZrO 2 los transistores exhibieron un rendimiento eléctrico decente con un grosor más delgado en comparación con el HfO dopado 2 informado , el mecanismo subyacente de la ferroelectricidad en ZrO 2 la película sigue sin estar clara. Es fundamental e importante dilucidar el origen de la polarización conmutable P para evaluar el límite de rendimiento de ZrO 2 FeFETs.
En este trabajo, TaN / ZrO 2 Se fabrican FeFET de / Ge con aisladores de 2,5 nm, 4 nm y 9 nm de espesor. La P conmutable en TaN / ZrO 2 Se propone que el condensador / Ge se origine a partir de la migración de las vacantes de oxígeno y las cargas negativas impulsadas por el voltaje. Los impactos de ZrO 2 espesor y el recocido térmico post-rápido (RTA) en el P de TaN / ZrO 2 / Se investigan las características de la ventana de memoria (MW), la resistencia y la retención de los FeFET.
Métodos
FeFET con ZrO 2 aisladores de compuerta se fabricaron en 4 pulgadas. Sustrato n-Ge (001) usando un proceso similar en [8, 9]. Después de la limpieza previa a la compuerta en la solución diluida de HF (1:50), se cargaron obleas de Ge en una cámara de deposición de capa atómica (ALD). ZrO 2 películas con espesores de 2.5 nm, 4 nm y 9 nm se depositaron a 250 ° C usando TDMAZr y H 2 O como precursores de Zr y O, respectivamente. Se depositó un electrodo de puerta TaN de 100 nm de espesor mediante pulverización catódica reactiva. Después de la formación del electrodo de puerta, las regiones de fuente / drenaje (S / D) fueron implantadas por BF 2 + a una dosis de 1 × 10 15 cm −2 y una energía de 20 keV. Se formaron un total de contactos S / D de níquel (Ni) de 15 nm mediante un proceso de despegue. Finalmente, se llevó a cabo el RTA a 350, 450 y 500 ° C durante 30 s.
La figura 1a muestra el esquema del transistor fabricado. La Figura 1b – d muestra las imágenes de microscopio electrónico de transmisión (TEM) de TaN / ZrO 2 / Ge muestras con ZrO 2 de 2,5, 4 y 9 nm de espesor , respectivamente. Todas las muestras se sometieron a un RTA a 500 ° C durante 30 s. El ZrO 2 de 2,5 nm La muestra sigue siendo una película aislante después del recocido. Para la muestra de 4 nm, aunque se observan algunos nanocristales, ZrO 2 mantiene ser una capa amorfa. Mientras ocurre la cristalización completa para el ZrO 2 de 9 nm película. En particular, una capa interfacial (IL) de GeO x existe entre el ZrO 2 y la región del canal Ge, aunque es demasiado delgada para ser observada en las imágenes TEM.
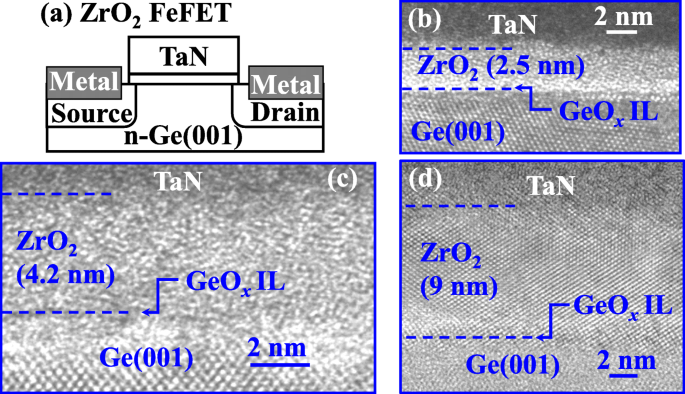
un Esquema del TaN / ZrO 2 fabricado / Ge FeFET. b , c y d Imágenes HRTEM del TaN / ZrO 2 / Ge se apila con diferentes ZrO 2 espesores. Las muestras se sometieron a un RTA a 500 ° C durante 30 s
Resultados y discusión
La figura 2 muestra la P frente a voltaje ( V ) curvas de TaN / ZrO 2 / Condensadores Ge con diferentes ZrO 2 espesores y diferentes temperaturas de recocido. Las líneas continuas con diferentes colores representan los bucles menores con varios rangos de voltaje de barrido ( V rango ). La frecuencia de medición es de 1 kHz. El ZrO 2 de 2,5 nm y 4 nm los dispositivos pueden exhibir ferroelectricidad estable después de un RTA a 350 ° C. La Figura 3 traza el P remanente ( P r ) en función del barrido V curvas de rango para los condensadores recocidos a varias temperaturas.

P medido frente a V características del TaN / ZrO 2 / Condensadores Ge con diferentes ZrO 2 espesores y distintas temperaturas de recocido
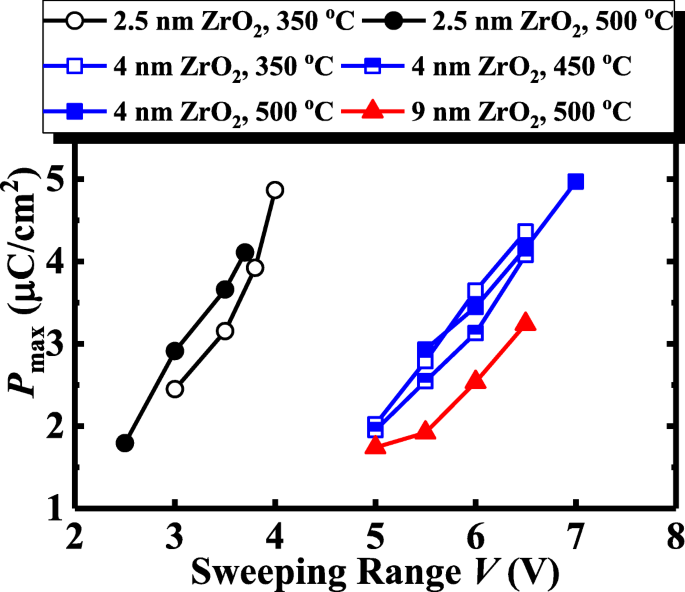
Comparación de P máx en función de V rango para TaN / ZrO 2 / Condensadores Ge con diferentes ZrO 2 espesores y distintas temperaturas de recocido
La Figura 3 muestra la comparación de P máx en función de V rango para TaN / ZrO 2 / Condensadores Ge con los diferentes ZrO 2 espesores y las diversas temperaturas RTA. Para el ZrO 2 de 4 nm dispositivos, a medida que la temperatura de recocido aumenta de 350 a 450 ° C, un V mayor rango es necesario para obtener una P fija máx . Esto se atribuye al hecho de que la temperatura de recocido más alta produce las capas interfaciales más gruesas (IL) entre en Ge / ZrO 2 y ZrO 2 / TaN interfaces, lo que conduce a un espesor equivalente de capacitancia unificada (CET) más grande. Para el ZrO 2 de 2,5 nm condensadores, la muestra con recocido de 500 ° C tiene un V menor rango que la muestra de recocido a 350 ° C con el mismo P máx . Aunque los IL se vuelven más gruesos con el aumento de la temperatura del RTA, algo de ZrO 2 fue consumida por la captación e interdifusión de oxígeno en la interfaz. Para el ZrO 2 muy delgado dispositivo, este último es dominante. En comparación con el ZrO 2 de 2,5 nm condensador, un V mucho más grande rango es necesario para lograr una P similar máx . Sin embargo, el ZrO 2 de 9 nm el condensador no exhibe el V más alto rango en comparación con el dispositivo de 4 nm. Esto se debe al cristal ZrO 2 que tiene un κ mucho más alto valor que la película amorfa, lo que reduce significativamente el CET del dispositivo de 9 nm.
La figura 4a muestra la evolución extraída de la P positiva y negativa r , denotado por \ ({P} _ {\ mathrm {r}} ^ {+} \) y \ ({P} _ {\ mathrm {r}} ^ {-} \), respectivamente, para los 4 nm- grueso ZrO 2 condensadores con RTA a diferentes temperaturas superiores a 10 6 ciclos de barrido medidos a 1 kHz. Los dispositivos recocidos a 350 ° C y 450 ° C exhiben el obvio efecto de despertar. No se observa ningún despertar o huella para el ZrO 2 de 4 nm El condensador ferroeléctrico se sometió a recocido a 500 ° C. La Figura 4b compara la P r en función de los ciclos de barrido para los dispositivos con los diferentes ZrO 2 espesores. El ZrO 2 de 4 nm El condensador ferroeléctrico logra una estabilidad mejorada de P r resistencia en comparación con los dispositivos de 2,5 nm y 9 nm durante los 10 6 prueba de resistencia.

un P r en comparación con el número de ciclos de barrido de pulsos ms para ZrO 2 de 4 nm condensadores con diferentes temperaturas RTA. b P r en comparación con el número de ciclos de barrido de pulsos ms para el ZrO 2 condensadores después del recocido a 500 ° C
El cambio P se observa en ZrO 2 amorfo capacitancia, y se infiere que el mecanismo debe ser diferente al del poli-HfO dopado reportado 2 películas ferroeléctricas. Proponemos que el mecanismo subyacente para el comportamiento ferroeléctrico está relacionado con los dipolos vacantes de oxígeno. Es bien sabido que, a medida que se deposita el metal TaN, las capas captadoras de oxígeno de Ta aumentarán la concentración de vacantes de oxígeno dentro de ZrO 2 [10]. Las vacantes de oxígeno también aparecen en el ZrO 2 / Ge interfaz. La Figura 5 muestra los esquemas de la P conmutable en TaN / ZrO 2 / Ge que se origina en la migración de las vacantes de oxígeno y las cargas negativas para formar los dipolos positivos y negativos. Se especula que las cargas negativas en ZrO 2 están relacionados con la vacante Zr [11], que es similar a las de Al 2 O 3 película [12]. La migración de las vacantes de oxígeno impulsadas por voltaje se ha demostrado ampliamente en dispositivos de memoria resistiva de acceso aleatorio [13, 14]. En particular, esta es la primera demostración de transistores no volátiles de tres terminales dominados por las vacantes de oxígeno impulsadas por voltaje.
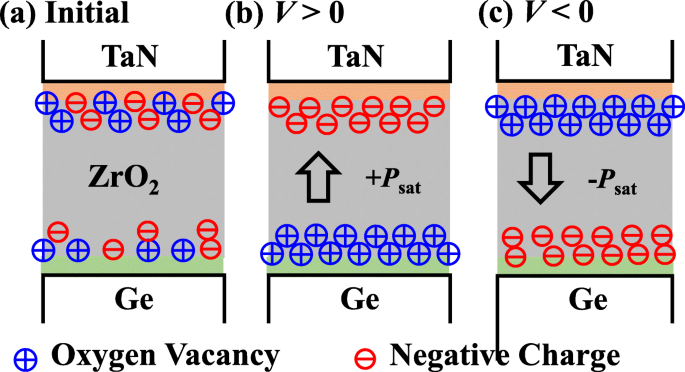
Esquemas del mecanismo para P conmutable en ZrO 2 condensadores, que se atribuye a la migración de las vacantes de oxígeno impulsadas por voltaje y las cargas negativas para formar dipolos
El P-V histéresis habilita el ZrO 2 FeFET para obtener un MW grande y estable para las aplicaciones NVM integradas (eNVM). La figura 6 muestra el I medido DS - V GS curvas de 2,5, 4 y 9 nm ZrO 2 FeFET para los dos estados de polarización con condiciones de programa / borrado (P / E) de 1 μs. Los transistores se recocieron a 500 ° C. La operación del programa (borrado) se logra aplicando pulsos de voltaje positivo (negativo) a la puerta del ZrO 2 FeFET, para aumentar (disminuir) su voltaje de umbral ( V TH ). V TH se define como V GS a 100 nA · W / L, y MW se define como el cambio máximo en V TH . Todos los FeFET con varios ZrO 2 los espesores tienen el MW por encima de 1 V con pulsos P / E de 1 μs. Para lograr un MW similar, se necesita un voltaje de borrado más alto para el ZrO 2 de 9 nm FeFET en comparación con los otros dos transistores. Se ve que una magnitud mayor borra V GS es necesario para obtener el desplazamiento aproximadamente igual de I-V relativo a la curva inicial en comparación con el programa V GS . Se especula que las vacantes de oxígeno que contribuyen a la P provienen principalmente de la reacción entre TaN y ZrO 2 , como el estado inicial del dispositivo en la Fig. 5a. Como una V positiva GS (programa), las vacantes de oxígeno se difunden y se acumulan en la capa cercana al ZrO 2 / Interfaz Ge (Fig. 5b), donde la distribución de los dipolos vacantes de oxígeno es bastante diferente del estado inicial. Por lo que es fácil cambiar el I-V curva a una | V más alta TH | con una V positiva GS . Sin embargo, como V negativo GS (borrar), la retrodifusión de las vacantes de oxígeno devuelve la pila de puertas a su estado original (Fig. 5c). Entonces, la magnitud del borrado negativo V GS debe aumentarse para lograr el cambio equivalente de I-V al programa positivo V GS .
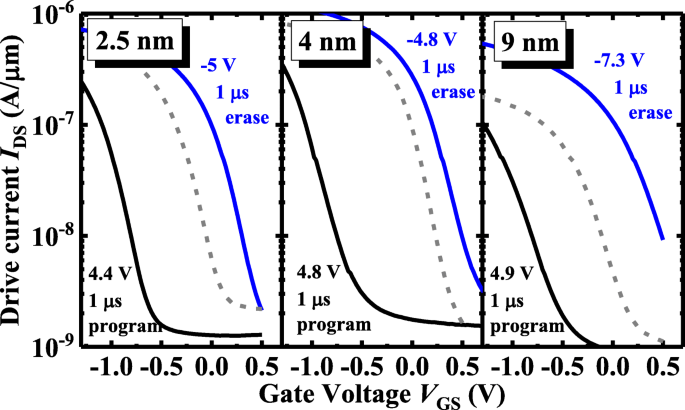
Medido I DS - V GS curvas de ZrO 2 de 2,5, 4 y 9 nm de espesor FeFET para los estados inicial y dos de polarización con pulsos P / E de 1 μs
A medida que el ancho del pulso P / E se reduce a 100 ns, el ZrO 2 Los FeFET todavía demuestran el MW decente, como se muestra en la Fig. 7a. Especialmente, el transistor con 2.5 nm ZrO 2 recocido a 350 ° C alcanza un MW de 0,28 V. La figura 7b traza el MW frente al número de ciclo para los FeFET con varios ZrO 2 espesores con condición de pulso P / E de 100 ns. El ZrO 2 de 4 nm El dispositivo logra un rendimiento de resistencia significativamente mejorado en comparación con el ZrO 2 de 2,5 nm y 9 nm FeFET, que exhiben un evidente efecto de despertar y fatiga dentro de los 10 3 ciclos.
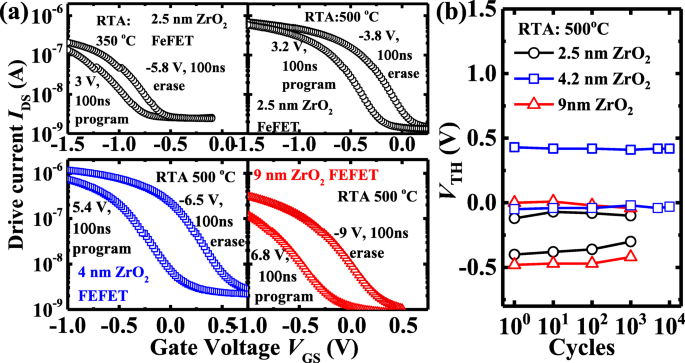
un yo DS - V GS curvas de ZrO 2 de 2,5, 4 y 9 nm de espesor FeFET para los dos estados de polarización con pulsos P / E de 100 ns. Los dispositivos se sometieron a una RTA a 500 ° C. b FeFET con 4 nm ZrO 2 tiene una resistencia mejorada en comparación con el ZrO 2 de 2,5 y 9 nm transistores
Finalmente, la prueba de retención del ZrO 2 Los FeFET se caracterizan y se muestran en las Figs. 8 y 9. La figura 8 a muestra la evolución de I DS - V GS curvas para los dos estados de polarización del ZrO 2 de 4 nm Los FeFET se sometieron a RTA a 350, 450 y 500 ° C. La captura de carga conduce a la reducción de los dispositivos con el tiempo. Como se muestra en la Fig. 8b, el rendimiento de retención de los dispositivos se puede mejorar con el aumento de la temperatura RTA. Se extrapola un MW de ~ 0,46 V para mantenerlo durante 10 años. La Figura 9 compara las características de retención de los FeFET con diferentes ZrO 2 espesores. El ZrO 2 de 4 nm El dispositivo tiene un rendimiento de retención mejorado en comparación con los transistores con ZrO 2 de 2,5 y 9 nm de espesor .
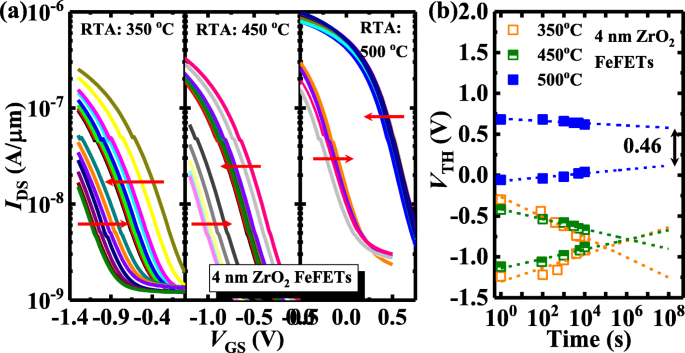
un La evolución de I DS - V GS curvas para los dos estados de polarización del ZrO 2 de 4 nm FeFET con diferentes temperaturas RTA. b El ZrO 2 de 4 nm El dispositivo recocido a 500 ° C tiene un rendimiento de retención mucho mejor en comparación con los transistores con RTA a temperaturas más bajas
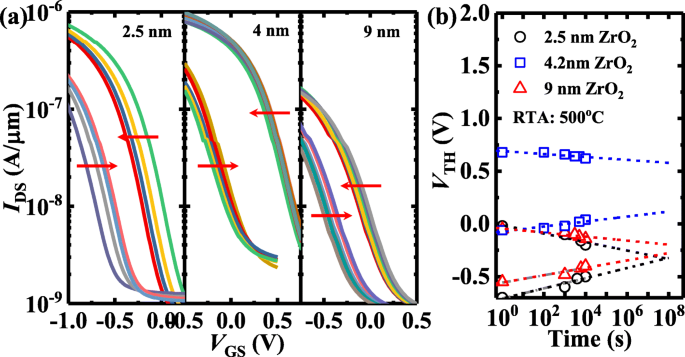
un La evolución de I DS - V GS curvas para los dos estados de polarización para el ZrO 2 de 2,5, 4 y 9 nm de espesor Los FeFET se sometieron a un RTA a 500 ° C. b El ZrO 2 de 4 nm El dispositivo tiene un rendimiento de retención mejorado en comparación con los transistores con ZrO 2 de 2,5 y 9 nm de espesor
Conclusiones
En resumen, ZrO 2 amorfo Los condensadores ferroeléctricos se demuestran experimentalmente y se especula que la ferroelectricidad se debe a la migración de los dipolos impulsados por voltaje formados por las vacantes de oxígeno y las cargas negativas. FeFET con ZrO 2 de 2,5 nm, 4 nm y 9 nm tener el MW por encima de 1 V con pulsos P / E de 1 μs. Las características mejoradas de fatiga y retención se obtienen en el ZrO 2 de 4 nm de espesor FeFET en comparación con los dispositivos con 2,5 nm y 9 nm ZrO 2 . La prueba de retención indica que el ZrO 2 de 4 nm El transistor mantiene un MW extrapolado a 10 años de ~ 0,46 V.
Disponibilidad de datos y materiales
Los conjuntos de datos que respaldan las conclusiones de este artículo se incluyen en el artículo.
Abreviaturas
- RTA:
-
Recocido térmico rápido
- IL:
-
Capa interfacial
- TaN:
-
Nitruro de tantalio
- FeFET:
-
Transistores de efecto de campo ferroeléctricos
- TDMAZr:
-
Tetrakis (dimetilamido) circonio
- Ge:
-
Germanio
- ZrO 2 :
-
Dióxido de circonio
- ALD:
-
Deposición de la capa atómica
- HF:
-
Ácido fluorhídrico
- BF 2 + :
-
Ión de fluoruro de boro
- MW:
-
Ventana de memoria
- NVM:
-
Memoria no volátil
- P r :
-
Polarización remanente
- TEM:
-
Microscopio electrónico de transmisión
- Ni:
-
Níquel
- P máx :
-
Polarización máxima
- RTA:
-
Recocido térmico reembolsado
- V rango :
-
Rango de voltaje de barrido
Nanomateriales
- DDS habilitado para web, IoT y la nube
- Transistores, efecto de campo de unión (JFET)
- Transistores, efecto de campo de puerta aislada (IGFET o MOSFET)
- Transistores de efecto de campo de unión
- Transistores de efecto de campo de puerta aislada (MOSFET)
- Introducción a los transistores de efecto de campo de unión (JFET)
- Introducción a los transistores de efecto de campo de puerta aislada
- Adaptación de la toxicidad de las especies reactivas del oxígeno a la terapia tumoral avanzada
- Transistores de efecto de campo de nanoflake SnSe multicapa con contactos au óhmicos de baja resistencia
- Efecto del tratamiento de recocido in situ sobre la movilidad y morfología de transistores de efecto de campo orgánico basados en TIPS-pentaceno
- Los beneficios de la generación de oxígeno in situ



