RTN y recocido relacionados con el estrés y la temperatura en la matriz FIND RRAM
Resumen
En este trabajo, se presenta una observación sobre la señal de ruido telegráfico aleatorio (RTN) en la corriente de lectura de un dispositivo RRAM dieléctrico FinFET (FIND RRAM). Se encuentra que la señal RTN de una celda FIND RRAM cambia después de que el dispositivo se somete a tensión cíclica. Después de someterse a un estrés cíclico, las células RRAM tienen una tendencia más fuerte a mostrar señales RTN más frecuentes e intensas. El aumento de los niveles de ruido en las celdas FIND RRAM se puede aliviar generalmente mediante el recocido a alta temperatura, y con este concepto, se propone y demuestra un esquema de recocido en el chip.
Introducción
El escalado continuo de la tecnología CMOS mejoró drásticamente las características y el rendimiento de los circuitos integrados en la última década. Sin embargo, a medida que el nodo de tecnología se reduce por debajo de 20 nm, las variaciones debidas a un solo átomo / electrón en las características del dispositivo aumentan, por ejemplo, las fluctuaciones aleatorias de dopantes (RDF) y, por lo tanto, surgen problemas fundamentales que no se pueden supervisar [1]. Por ejemplo, cualquier variación en el número de portadores o defectos estructurales tiene un impacto mucho mayor en la salida y el rendimiento en un dispositivo escalado, y los efectos de la escala del dispositivo en la variabilidad debido a RDF y la rugosidad de la línea de la puerta-borde (LER) también lo han hecho. ha informado [2, 3, 4]. Se cree que el ruido telegráfico aleatorio (RTN) es otro desafío importante para los dispositivos con áreas pequeñas, como NAND Flash y RRAM [5,6,7,8,9,10,11]. En este trabajo, investigamos el ruido RTN en una celda FIND RRAM basada en FinFET de canal n, que ya se ha implementado con éxito en un proceso lógico estándar en matrices de 1 kbit [12]. Se observan cambios en el RTN en respuesta a tensiones cíclicas y horneado a alta temperatura. En este trabajo, se estudian los efectos del estrés y la temperatura en el ruido RTN en las celdas FIND RRAM, y se propone un esquema de recocido en el chip para aliviar el ruido de corriente de lectura de la variante de tiempo después del ciclo.
Antecedentes y métodos
Un FIND RRAM consta de dos transistores FinFET. Uno actúa como el transistor de selección WL en serie del nodo RRAM. El dieléctrico de puerta de alta k entre el SiP y SL del otro transistor sirve como un nodo de almacenamiento, como se muestra en la Fig. 1a. Los dispositivos FIND consisten en la película dieléctrica de compuerta en los FinFET estándar, donde el electrodo de compuerta es W para el electrodo superior y TaN para el inferior. El óxido de la pila de compuertas consta de HfO 2 / SiO 2 / Capas apiladas de TiN [12]. La condición de lectura de una celda FIND RRAM se ilustra en la Fig. 1b, donde WL recibe 0,8 V para encender el transistor seleccionado, mientras que 0,8 V se agregan a SL para impulsar una corriente de lectura suficiente para la lectura de datos. La conmutación resistiva entre el estado de alta resistencia (HRS) y el estado de baja resistencia (LRS) se logra realizando un ajuste / reinicio en la celda FIND RRAM [13]. Un FIND RRAM muestra características de conmutación resistiva bastante estables bajo barridos de CC, vea la Fig. 2a, mientras que sus características de tiempo de ajuste y tiempo de reinicio se resumen en la Fig. 2b. Las condiciones de funcionamiento enumeradas en la Fig. 2a muestran que son posibles las operaciones de bajo voltaje. Las celdas se someten a múltiples ciclos de pulso tanto para el ajuste como para el reinicio con el fin de alcanzar los niveles de corriente de lectura objetivo. El ancho de pulso aumentará si el dispositivo no se configura o reinicia después de aplicar múltiples pulsos, como se ilustra en la Fig. 3a. Se puede encontrar una señal RTN distintiva en las células LRS y HRS FIND RRAM, como se muestra en la Fig. 3b. Las señales RTN causadas por la captura de carga y la eliminación de trampas en la ruta de conducción de la corriente pueden provocar una fluctuación significativa de la corriente [14, 15, 16, 17].
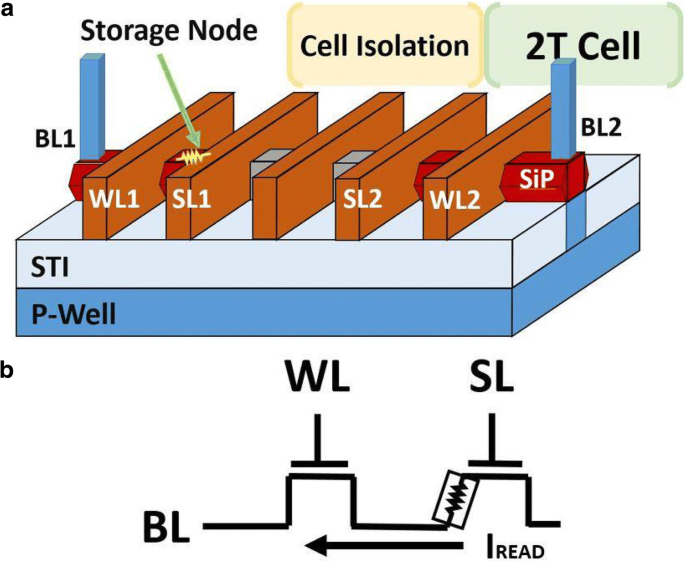
un Ilustración 3D de las 2 celdas T FIND RRAM implementadas por tecnologías CMOS FinFET y b Se muestra el esquema del circuito de una celda unitaria para FIND RRAM en condición de lectura, donde VSL =VWL =0.8 V y BL está polarizado a cero
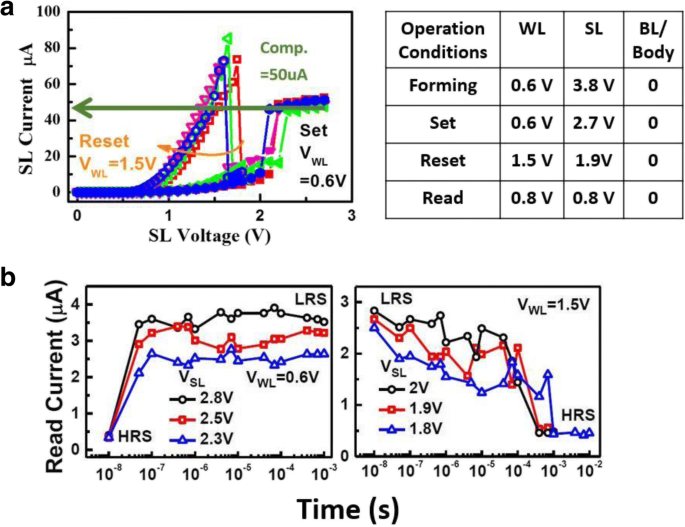
Las características de conmutación resistiva de CC del FIND RRAM y sus condiciones de funcionamiento se muestran en ( a ). Sus características de tiempo de fraguado y tiempo de reinicio se resumen en ( b )

un Ilustración del ancho de pulso creciente utilizado para realizar la operación de ajuste / reinicio. Después del primer pulso de 1 μs, se realiza una operación de lectura para evaluar si la corriente de lectura alcanza los niveles objetivo de 3 μA para LRS y menos de 1 μA para HRS. Si no se alcanza el estado requerido, se da el siguiente pulso. El ancho de pulso se amplía en un orden cada diez pulsos. b Comparación de la corriente de lectura a temperatura ambiente muestreada a VSL =VWL =0,8 V y VBL =0, con una frecuencia de muestreo de 500 Hz, antes y después de realizar un ciclo de 100 veces
Está bien establecido que los ciclos repetidos, es decir, el cambio entre los dos estados, puede inducir tensión en la capa dieléctrica de la puerta FinFET [18]. La capa de óxido de metal de transición (TMO) estresada en las celdas FIND RRAM tiene una tendencia más fuerte a mostrar ruidos RTN, lo que lleva a una corriente de lectura variable en el tiempo que puede causar errores de lectura y desafíos de estabilidad durante la lectura de datos. En este experimento, muestreamos las corrientes leídas de la matriz en fresco, después de 10 × ciclos y después de 100 × ciclos, para observar el efecto de tensión en RTN en FIND RRAM.
Para investigar el efecto de la temperatura en las células FIND RRAM estresadas, las muestras con distintas señales RTN en LRS se enfrían primero a 0 ° C y luego se calientan gradualmente hasta 50 ° C. Durante este proceso, las corrientes leídas a estas temperaturas se muestrean continuamente durante 20 s a una frecuencia de 500 Hz. Esto nos da alguna pista sobre cómo se comporta el RTN bajo el cambio de temperatura.
Resultados y discusión
A través de una medición extensa, se encuentra que RTN es más estable y fácilmente observable en una celda FIND RRAM en su LRS. Por lo tanto, en el estudio del efecto cíclico y de recocido en RTN de células FIND RRAM, la siguiente sección se centra en la investigación de células en LRS. Como se muestra en la Fig. 4a, los ruidos RTN conducen a una corriente de lectura variable en el tiempo que causa un error de lectura. Este efecto se puede observar en la matriz de celdas de 1 kbit. En una matriz que ha pasado por 10 ciclos, se encuentran fluctuaciones significativas de la corriente de lectura al muestrear la corriente de lectura durante un intervalo de 20 s. El mapa de corriente de bits normalizado en una matriz se organiza en la Fig. 4b, donde las fluctuaciones de corriente en LRS pueden ser tan altas como + 5%, que es comparable al RTN observado en la corriente de fuga de la puerta después de la tensión [19]. Para investigar el efecto del estrés, hicimos un seguimiento de los niveles de fluctuación actuales de 50 células antes y después del estrés cíclico. Los datos de la Fig. 5a revelan que más del 90% de las células presentan un aumento en ΔI / I después del ciclo. Es decir, se muestra que el ruido variable en el tiempo en FIND RRAM empeora gradualmente a medida que las células experimentan más tensiones cíclicas. Al comparar la distribución de corriente de lectura normalizada de células frescas y células cicladas, se encuentra que las células que pasaron por más ciclos exhiben señales RTN más significativas y muestran dos o más distribuciones de corriente pico en estados particulares. Por otro lado, las células frescas tienen una distribución de corriente de una distribución estándar, lo que sugiere que no hay ruidos RTN involucrados en la fluctuación, como se demuestra en la Fig. 5b [20, 21]. Esto sugiere que una vez que FIND RRAM se somete a una tensión cíclica prolongada, la corriente de su celda de bits puede estar sujeta a fluctuaciones más drásticas debido a la adición de RTN.

un Una corriente de lectura normalizada a 25 ° C muestreada a una frecuencia de 500 Hz en una celda RRAM que había pasado por 10 ciclos. Esto muestra que RTN causa corriente de lectura variable en el tiempo. b Muestra el gráfico de la corriente normalizada en una matriz de 1 kbit que había pasado por 10 ciclos, muestreados simultáneamente en t1 =3, t2 =7.5, t3 =14 y t4 =17.5 s, secuencialmente. Al comparar la instantánea en diferentes momentos, la corriente de lectura fluctúa en las mismas condiciones de lectura

un Comparando la distribución de | ΔI / I | de 50 muestras antes y después del estrés. Se puede ver que las células exhiben un ΔI / I en general más grande después del estrés. Los valores de percentiles del diagrama de caja de abajo hacia arriba representan los puntos percentiles 25, 50 y 75, respectivamente, mientras que los bigotes indican los valores máximo y mínimo. b Un histograma de distribución de corriente de lectura normalizada de una celda medida en fresco y después de 10 y 100 ciclos. Esto muestra que una vez que FIND RRAM se somete a una tensión cíclica prolongada, la corriente de su celda de bits puede estar sujeta a fluctuaciones más drásticas debido a la adición de RTN
Los resultados normalizados de la muestra de corriente leída en diferentes etapas de temperatura se comparan en la Fig. 6. Se han estudiado el tiempo de captura y el tiempo de emisión de las trampas RTN y se sabe que cambian con la temperatura, los cuales disminuyen a medida que aumenta la temperatura [22, 23 ]. Como era de esperar, la frecuencia del ruido RTN aumenta a medida que aumenta la temperatura, es decir, que las fluctuaciones de la corriente de lectura a 0 ° C ocurren con menos frecuencia que las de 25 ° C. Sin embargo, cuando se mide a 50 ° C, las fluctuaciones de corriente entre dos estados se vuelven menos prominentes. Esto se puede revelar más en la Fig. 7a, que traza el histograma de corrientes de lectura normalizadas medidas a 0 ° C, 50 ° C y temperatura ambiente. Las distribuciones de corriente de 0 ° C y 25 ° C tienen dos picos de distribución, lo que sugiere que los estados de captura única RTN dominan la ruta conductora [19], mientras que los estados discretos de la corriente muestreada a 50 ° C se vuelven menos prominentes. Esto sugiere que a temperaturas más altas, las trampas que causan la señal RTN pueden estar sujetas a inestabilidad como efecto de recocido o recombinación de defectos, lo que afecta la probabilidad de atrapamiento de electrones y, por lo tanto, alivia el efecto RTN [27].

Una comparación de las corrientes de lectura normalizadas de una celda RRAM (en estado LRS) que había pasado por 100 ciclos con ruido RTN medido a 0, 25 y 50 ° C, a una frecuencia de muestreo de 500 Hz

un Una comparación de histogramas de distribución de corriente de lectura normalizada de una celda en estado LRS medido a 0, 25 y 50 ° C. b Una comparación de la probabilidad acumulada de | ΔI / I | de 30 muestras antes del estrés, después del estrés y después del recocido, respectivamente. Se encuentra que una gran parte de las células vuelve a su ΔI / I original después del proceso de recocido
En estudios posteriores, las muestras se calientan hasta 75 ° C. Estas células se enfriaron a temperatura ambiente después de 30 min, luego se toman las muestras. Se eligen treinta células y sus niveles de fluctuación de corriente acumulada en fresco, estresado y después de recocido se comparan en la Fig. 7b. Esto muestra que la mayoría de las células vuelven a su ΔI / I original después del proceso de recocido. Las corrientes de lectura normalizadas de una celda en su estado fresco, estado estresado y después del horneado se comparan en la Fig. 8. La corriente después del horneado se parece a la que está fresca, lo que sugiere que el horneado a alta temperatura templa las trampas que causan las señales RTN. La Figura 9a es un gráfico ordenado de la corriente de lectura normalizada para una matriz de 1 kbit de células frescas, células ligeramente estresadas, células muy estresadas y después del horneado, respectivamente. A partir de la trama, se demuestra que las fluctuaciones de la corriente se vuelven más intensas cuando la RRAM está muy estresada y se reduce drásticamente después del horneado a alta temperatura. Este efecto se puede observar en toda la matriz, lo que confirma que el horneado a alta temperatura de hecho proporciona un efecto de recocido a las trampas que inducen ruido RTN [24,25,26,27,28,29]. La Figura 9b compara además las distribuciones de ΔI / I en una matriz de celdas obtenida mediante diez muestreos diferentes secuencialmente. Se encuentra que la misma matriz exhibe diferentes distribuciones de ΔI / I en sus estados fresco, de tensión y después de recocido. Los datos sugirieron que el recocido ayuda a que la matriz de células muestre fluctuaciones de corriente reducidas, similar al nivel de una matriz en su estado fresco. Este resultado se puede utilizar para corregir y extender la vida útil de las células FIND RRAM que han exhibido señales RTN después de un ciclo de estrés.

Lea las corrientes de las celdas frescas y estresadas muestreadas a 25 ° C, 500 Hz en comparación con las de la celda después de hornear a alta temperatura y enfriarlas en un período de 30 minutos a temperatura ambiente. Muestra que después del horneado, el estrés se alivia y la célula se comporta de manera similar a una nueva

un Corrientes de lectura normalizadas de una matriz de 1 kbit tomadas en un momento específico trazadas en fresco, ligeramente estresado, muy estresado y después de recocido. Se pudo ver que el número de células con fuertes fluctuaciones aumenta en gran medida en la matriz a medida que la matriz sufre más estrés y se apaga después de que se templa. b Comparación de las probabilidades acumuladas de | ΔI / I | distribuciones de 50 muestras de la misma matriz en su estado fresco, estresado y después de recocido, en diferentes instancias de tiempo con un intervalo de 1 s. El ΔI / I general en las muestras después de la tensión es mayor y vuelve a la normalidad después del recocido
Vale la pena mencionar que algunas células atrapadas en un estado medio durante el ciclo reviven después de un tratamiento a alta temperatura. A medida que una celda FinFET RRAM pasa por LRS y HRS, el filamento conductor en algunas celdas puede formar un canal que no se puede restablecer fácilmente. El proceso de horneado proporciona a esas células el camino para redistribuir sus vacantes de oxígeno, lo que permite un restablecimiento efectivo a HRS [30]. La Figura 10 muestra una celda que no pudo cambiar a HRS reviviéndose después de horneado a 125 ° C, 15 min. Con esto en mente, se propone un mecanismo de recocido en chip que implica calentar localmente la celda FIND RRAM. Se aplica una corriente constante de 1,5 mA con un período de 10 s a la celda a través de polarización directa en la unión de drenaje del FinFET seleccionado, como se ilustra en la Fig. 11a. Esta gran corriente calienta una región confinada cerca del RRAM TMO y proporciona un efecto de recocido similar. La corriente de lectura antes y después del recocido del dispositivo bajo prueba (DUT) se mide y analiza en la Fig. 11b. Las distribuciones acumulativas de la corriente de lectura muestreada continuamente demuestran la eliminación de RTN en una celda después del paso de recocido en el chip. Aquí, el recocido en chip de FIND RRAM se realizó en celdas individuales en pasos secuenciales para comprender la respuesta nominal a una celda típica de RRAM después del estrés. Es necesario desarrollar un nuevo procedimiento de recocido en chip para un experimento a nivel de matriz.

Al aplicar horneado a 125 ° C a las celdas que están atascadas en el estado medio y proporcionar un proceso de recocido, convertimos estas celdas de nuevo al estado funcional, prolongando así la vida útil de la celda

El esquema de recocido en el chip que propusimos implica aplicar - 1 V en BL resultante de polarización directa y una corriente medida de 1,5 mA, que calienta y templa la celda estresada. En el gráfico, al comparar el porcentaje acumulado de la corriente normalizada de la celda antes y después del proceso, podemos ver que la fluctuación de corriente causada por RTN se reduce considerablemente
Conclusión
En este artículo, se discute el efecto del estrés y la temperatura en RTN en la matriz de celdas FIND RRAM. Se observa un aumento de RTN inducido por estrés cíclico. Se observa el efecto del tratamiento a alta temperatura sobre la reducción de RTN y el alivio del estrés para TMO en un FIND RRAM. Finalmente, se propone y demuestra un esquema de recocido en chip.
Abreviaturas
- BUSCAR RRAM:
-
Memoria de acceso aleatorio resistiva dieléctrica de transistor de efecto de campo de aleta
- HRS:
-
Estado de alta resistencia
- LER:
-
Rugosidad del borde de la línea
- LRS:
-
Estado de baja resistencia
- RTN:
-
Ruido de telégrafo aleatorio
- TMO:
-
Óxido de metal de transición
Nanomateriales
- [Explicado] ¿Qué es el seguimiento de activos y preguntas relacionadas
- Control de acceso con QR, RFID y verificación de temperatura
- Sensor de temperatura Python y Raspberry Pi
- Temperatura y humedad sencillas en Raspberry Pi
- Bricolaje:Regulación y monitoreo de temperatura para HomeBrew
- Sensor de temperatura y luz Raspberry Pi
- Simulación del rendimiento de la bomba de corriente con tolerancia y temperatura
- Materiales:Consejos de recocido para polímeros amorfos, Parte 2
- Medición de temperatura dentro de materiales compuestos y líneas de unión
- ¿Qué es el recocido? - Definición, proceso y etapas
- Sensor de temperatura y flujo de laboratorio en chip



