Impactos del dopaje de Cu en el rendimiento de los dispositivos RRAM basados en La
Resumen
En este artículo, se han investigado los efectos de la capa de inserción de Cu y el recocido térmico rápido sobre los comportamientos de conmutación resistiva de los dispositivos de memoria de acceso de conmutación resistiva (RRAM) basados en La. En comparación con la muestra de control sin dopar (Cu / LaAlO 3 / Pt), los dispositivos integrados en Cu muestran un mayor rendimiento del dispositivo y restablecen el voltaje de parada, lo que indica que la confiabilidad de la RRAM basada en La se ha mejorado de manera efectiva. Sin embargo, el Cu / LaAlO 3 no recocido :El dispositivo RRAM de Cu / Pt todavía sufre una gran dispersión de parámetros. Se demostró que el dispositivo RRAM con capa de inserción de Cu y tratamiento de recocido exhibe las mejores características de conmutación resistiva, como bajo voltaje de formación, alta relación de encendido / apagado y uniformidad eléctrica fina. Estas mejoras se pueden atribuir a la difusión de átomos de Cu y la formación de nanocristales de Cu (Cu-NC) después del proceso de recocido, ya que los átomos de Cu difundidos y los Cu-NC podrían mejorar el campo eléctrico local y debilitar la aleatoriedad de la formación / ruptura de filamentos conductores.
Introducción
La memoria resistiva de acceso aleatorio (RRAM) se considera una dirección de desarrollo para los dispositivos de memoria no volátil de próxima generación, que ha estado atrayendo mucha atención debido a su estructura simple, bajo consumo de energía, alta escalabilidad, velocidad de operación rápida y valor múltiple. capacidad de almacenamiento [1]. RRAM a menudo se fabrica en una estructura sándwich de metal-aislante-metal (M-I-M), y la capa dieléctrica intermedia tiene una influencia significativa en su desempeño de conmutación resistiva (RS). Por lo tanto, una amplia variedad de materiales, incluidos muchos de alta constante dieléctrica de uso común (alta- k ) materiales (como HfO 2 [2], Al 2 O 3 [3] y ZrO 2 [4]), se han investigado ampliamente para aplicaciones RRAM. Entre todos los materiales de óxido, el óxido a base de lantano es uno de los más prometedores con alto contenido de k materiales dieléctricos, que ha suscitado un gran interés en la investigación debido a su alto contenido de k valor, banda prohibida grande y estabilidad térmica fina [5]. Recientemente, se han encontrado buenas características de conmutación de resistencia, como bajo voltaje de operación, ventana de alta resistencia, tiempo de retención prolongado, resistencia de ciclo largo y buena consistencia, en RRAM basadas en La, lo que indica la aplicación potencial de la alta- k materiales en RRAM [6, 7].
Además, debido a las ventajas de una excelente uniformidad, un control preciso del espesor y la compatibilidad con el proceso CMOS, la tecnología de deposición de capa atómica (ALD) ha sido uno de los métodos de crecimiento más utilizados para producir películas dieléctricas basadas en La [8]. Desafortunadamente, siempre se requieren voltajes de formación altos no deseables en los dispositivos RRAM depositados con ALD debido a las películas dieléctricas de buena calidad, que pueden conducir a una alta tasa de fallas, una baja relación de encendido / apagado, poca resistencia y una amplia dispersión de los dispositivos [9]. . Para obtener dispositivos RRAM con un mejor rendimiento de RS, la ingeniería de materiales / estructura de dispositivos, incluida la implantación de iones [10], la difusión de dopantes [11] o la inserción de nanocristales (NC) [12], deben adoptarse en la LA preparada por ALD. RRAM basados en.
En informes recientes, diferentes tecnologías de dopaje para mejorar los comportamientos de RS de la tradicional alta k materiales (HfO 2 [13], ZrO 2 [14], etc.) han sido ampliamente estudiados. Sin embargo, los comportamientos RS mejorados por NC de los dispositivos RRAM basados en La no se han informado hasta ahora. Por lo tanto, un LaAlO 3 incrustado en Cu dispositivo con la estructura de Cu / LaAlO 3 / Cu / LaAlO 3 / Pt está fabricado para la aplicación de memoria, y la atención se centró en los impactos del dopaje con Cu en el rendimiento y el mecanismo de conmutación de los dispositivos RRAM basados en La.
Métodos
El diagrama esquemático del dispositivo fabricado con la estructura de Cu / LaAlO 3 / Cu / LaAlO 3 / Pt se muestra en la Fig. 1. El proceso de fabricación del dispositivo RRAM basado en La es el siguiente:Primero se depositó un metal bicapa, Pt de 100 nm / Ti de 10 nm, en un dispositivo de 2 pulg. SiO 2 / Oblea de Si como electrodo inferior (BE) por evaporación por haz de electrones. Posteriormente, la temperatura del reactor Picosun R-150 ALD se estableció en 300 ° C y ~ 10 nm LaAlO 3 (Relación La / Al como 3:1) se depositó una película delgada sobre el Pt / Ti / SiO 2 / Si sustratos, utilizando La ( i- PrCp) 3 como precursor de La, Al (CH 3 ) 3 como precursor de Al y O 3 como oxidante. Luego, se cultivó una capa de ~ 2 nm Cu en LaAlO 3 a una velocidad de 0,1 Å / s utilizando un evaporador de haz de electrones (EBE). Nuevamente, ~ 10 nm LaAlO 3 (Relación La / Al como 3:1) se depositó una película delgada mediante ALD a 300 ° C. Después de LaAlO 3 / Cu / LaAlO 3 La capa de conmutación se preparó utilizando el proceso ALD-EBE-ALD, el proceso de recocido térmico rápido (RTA) se llevó a cabo en un N 2 ambiente a 600 ° C durante 30 s. El electrodo superior (TE) de 10 nm Au / 150 nm Cu se depositó en el LaAlO 3 dieléctrico por evaporación por haz de electrones después de la litografía, y seguido de desprendimiento para fabricar dispositivos que tienen tamaños de 50 × 50 μm 2 hasta 250 × 250 μm 2 . Para comprender mejor los impactos del dopaje con Cu en el rendimiento de los dispositivos RRAM basados en La, dos muestras de control, S1:Au / Cu / LaAlO 3 / Pt (no recocido) y S2:Au / Cu / LaAlO 3 :Cu / Pt (no recocido), se instalaron. Y la muestra con Au / Cu / LaAlO 3 :La estructura Cu-NC / Pt se asignó como S3.
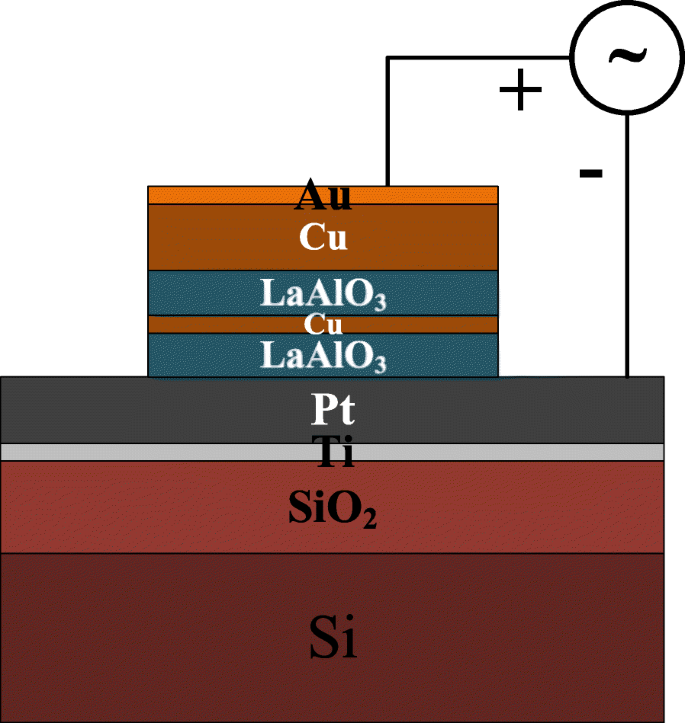
Diagrama esquemático de LaAlO 3 incrustado en Cu dispositivo con la estructura de Cu / LaAlO 3 / Cu / LaAlO 3 / Pt
Se usó espectroscopía de fotoelectrones de rayos X (XPS) para analizar la distribución de los átomos de Cu dopados y se usó microscopía electrónica de transmisión transversal (TEM) para observar la microestructura de los dispositivos RRAM fabricados. Las propiedades de RS se midieron en diferentes modos utilizando un analizador de parámetros de semiconductores Agilent B1500A. Se impuso un cumplimiento de corriente de 1 mA para proteger las unidades de dispositivo fabricadas de daños por corrientes elevadas durante los procesos de conformado y fraguado.
Resultados y discusión
La Figura 2 muestra el análisis de profundidad de espectroscopía de fotoelectrones de rayos X (XPS) de los espectros de Cu 2p en el LaAlO 3 dopado con Cu película (parámetros de grabado:2 KVM Ar ion, ~ 1 Å / s velocidad de grabado). Como se puede ver en la Fig.2, el pico de Cu 2p difícilmente se puede encontrar en la muestra no recocida (S2) después de grabar durante 30 so 60 s, mientras que después de grabar durante 90 s, aparece un pico de Cu 2p notable, lo que indica que el Cu los átomos se concentran principalmente en la capa incrustada en Cu. De manera diferente, los átomos de Cu se observan en todo el LaAlO 3 película después del tratamiento de recocido, es decir, después de grabar durante 30 s, 60 sy 90 s, se pueden observar picos obvios de Cu 2p en S3. Los resultados de XPS confirman que el recocido a alta temperatura conducirá a la redistribución de los átomos de Cu dopados, lo que puede ayudar a mejorar las características eléctricas de las RRAM basadas en La.
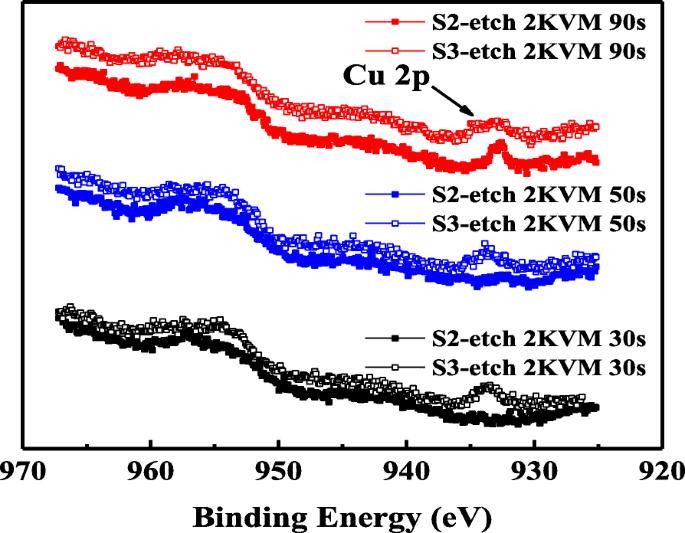
Resultados XPS de los espectros de Cu 2p para S2 y S3 después del grabado con iones de Ar durante 30 s, 60 sy 90 s
La Figura 3 muestra la imagen típica de microscopio electrónico de transmisión (TEM) de sección transversal de los dos LaAlO 3 incrustados en Cu RRAM (es decir, S2 y S3). Como se muestra en la Fig. 3a, la estructura laminada del Cu / LaAlO no recocido 3 / Cu / LaAlO 3 / El dispositivo Pt se pudo reconocer claramente en la imagen TEM de S2. Vale la pena señalar que después de la deposición del LaAlO superior 3 capa a 300 ° C del proceso ALD, la nanocapa de Cu de ~ 2 nm incrustada se ha visto ligeramente afectada por la difusión térmica. Por lo tanto, a partir de la imagen de alta resolución de la Fig. 3b, las nanopartículas de Cu irregulares y separadas con el tamaño de 2 ~ 6 nm incrustadas en LaAlO 3 capa se puede observar claramente. El tratamiento de recocido adicional después del proceso ALD mejoraría aún más la difusión térmica de los átomos de Cu, haciendo difícil distinguir la existencia de nanocapa de Cu como se muestra en la Fig. 3c. Con la ayuda de una imagen TEM de mayor resolución como se muestra en la Fig. 3d, una aproximación de LaAlO 3 de 25 nm de espesor Se pudo observar una capa incrustada con varios Cu-NC esféricos y separados, lo que indica que parte de la nanocapa de Cu ya se ha difundido en el LaAlO 3 dieléctrico con algunos Cu-NC de menor tamaño que quedan atrás después del tratamiento de recocido a 600 ° C.
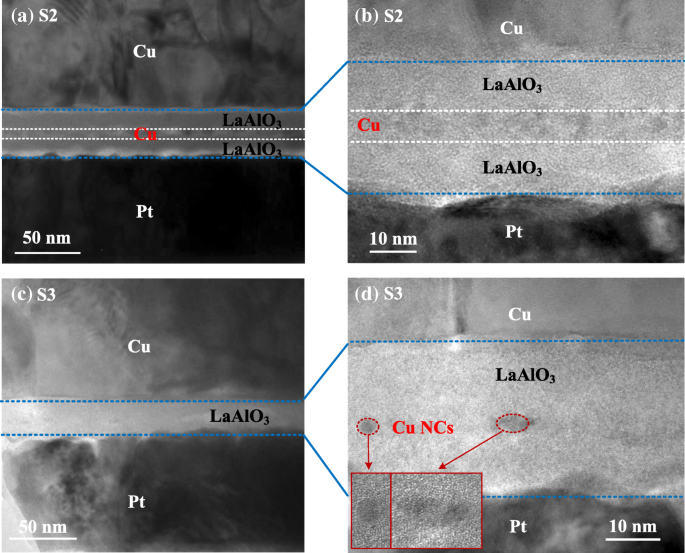
Imágenes TEM de los dispositivos RRAM integrados en Cu. un Una imagen TEM de sección transversal típica de S2. b Una imagen HRTEM de S2. c Una imagen TEM de sección transversal de S3. d Una imagen HRTEM de S3
El proceso de formación eléctrica de las muestras S1, S2 y S3 se muestra en la Fig. 4. Como se puede ver en la Fig. 4, se requiere un alto voltaje de aproximadamente 12 V en el proceso de formación de S1, y un voltaje de formación mucho más bajo. Se necesita (~ 7 V) en S2 y S3, lo que demuestra que el voltaje de formación de los dispositivos basados en La se puede reducir de manera efectiva insertando una nanocapa de Cu en la película dieléctrica. Además, en comparación con el valor de resistencia inicial de S1 (2,51 × 10 12 Ω, leído a 1 V), la resistencia de S2 es mucho menor (2,65 × 10 6 Ω, leído a 1 V), y este valor aumenta después del proceso de recocido (S3, 2,83 × 10 12 Ω, leer a 1 V). Las variaciones anteriores del voltaje de formación y la resistencia inicial se pueden atribuir a los cambios de las propiedades dieléctricas de LaAlO 3 películas a través de la ingeniería de estructuras de materiales / dispositivos. Debido a la excelente calidad de las películas dieléctricas a base de La preparadas mediante el método ALD, se necesita una fuerza de campo eléctrico extremadamente alta para romper el aislante (es decir, S1). Después de que se insertó la nanocapa de Cu en la película dieléctrica, la capa de conmutación de alta calidad cultivada con ALD se verá afectada por esta nanocapa de metal, lo que haría que el dieléctrico sea más fácil de descomponer y, en última instancia, conduce a un voltaje de formación mucho más bajo en S2. Además, la barrera de energía de la formación de vacantes de oxígeno podría reducirse eficazmente y se introducirían más defectos metaestables en la película dieléctrica debido a las diferencias estructurales entre Cu y LaAlO 3 materiales (juego de celosía, juego de expansión térmica, etc.) [15]. En consecuencia, se introduciría una mayor cantidad de defectos (trampas de carga, iones metálicos, vacantes de oxígeno, etc.) en el LaAlO 3 capa de conmutación resistiva, que conduce a la reducción de la resistencia inicial de S2 [16]. Sin embargo, este gran número de defectos en las películas delgadas dieléctricas de S2 podría reducirse (o eliminarse) eficazmente mediante un tratamiento de recocido adicional, lo que daría lugar a una alta resistencia inicial de S3 [17]. Además, el tratamiento de recocido adicional ha traído algunos Cu-NC y átomos de Cu difundidos al LaAlO 3 películas dieléctricas, que mejorarían aún más el campo eléctrico local y darían como resultado un voltaje de formación bajo de S3 [18].
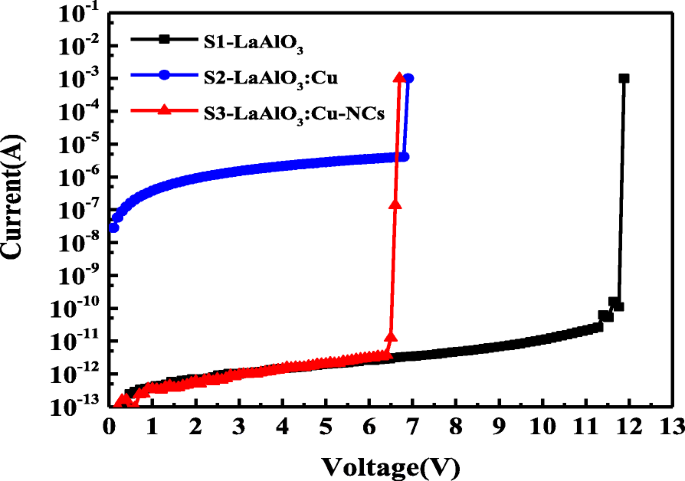
Proceso de formación de los tres tipos de RRAM basados en La
Corriente-voltaje bipolar típico ( I - V ) Las curvas de ~ 100 ciclos de barrido de corriente continua (CC) para los tres tipos de dispositivos RRAM basados en La (tamaño de área de 50 μm × 50 μm) se obtienen en la Fig. 5a-c. La tensión de prueba (0 a - 1,5 V y - 1,5 a 0 V para el proceso de reinicio; 0 a 5 V y 5 a 0 V para el proceso de configuración) está polarizada en el TE (Cu) mientras que el BE (Pt) está conectado a tierra . Aunque tres dispositivos RRAM basados en La muestran 100 ciclos consecutivos de comportamiento RS bipolar repetible, existen grandes diferencias entre ellos. En primer lugar, en comparación con S2 y S3, la muestra sin dopar S1 es más fácil de dañar durante las operaciones cíclicas de ajuste-reinicio con el voltaje de parada de reinicio ( V detener ) de - 1,5 V (como se muestra en la inserción de la Fig. 5a), lo que indica que el máximo V detener de S1 es menor que los de S2 y S3. Considerando esto, un V relativamente bajo detener de - 1,4 V se utiliza en el caso de la muestra S1. Otra diferencia es que el I - V Las curvas de S1 y S2 muestran fluctuaciones anormales (subida y bajada) durante el proceso de fraguado, que es bastante diferente del suave I - V curvas de S3. Este fenómeno está estrechamente relacionado con el remanente de algunos filamentos conductores (CF) en el LaAlO 3 sin dopar (o dopado pero no recocido) películas dieléctricas después del proceso de reinicio. Además, en comparación con S1 y S2, S3 tiene I - V curvas que muestran una mayor consistencia y una distribución más pequeña de los voltajes de ajuste / reinicio, lo que implica que la estabilidad de los dispositivos RRAM se puede mejorar eficazmente mediante el tratamiento de dopaje y recocido. Las Figuras 5d – f son la prueba de resistencia (~ 100 ciclos, leídos a - 0.1 V) de S1 – S3 extraídos de la izquierda de la Fig. 5a – c. La relación de resistencia máxima de Cu / LaAlO 3 / Pt RRAM dispositivos, es decir, el estado de máxima resistencia alta (HRS) al estado mínimo de baja resistencia (LRS) puede ser tan alto como 6 órdenes de magnitud. Sin embargo, la amplia fluctuación aleatoria en HRS de S1 y S2 produce una ventana de activación / desactivación de nivel muy bajo (~ 10). A diferencia de S1 y S2, la ventana de encendido / apagado de S3 es aproximadamente 100 veces mayor que la de S1 y S2, lo que indica que la característica de consistencia de los dispositivos RRAM basados en La dopados con Cu se mejora efectivamente después del recocido. El tratamiento de recocido en S3 no solo hace que los átomos de Cu se difundan alrededor de todo el LaAlO 3 película, sino que también forma Cu-NC en el dieléctrico. Por tanto, se ha mejorado el campo eléctrico local; se ha controlado la aleatoriedad de la formación / ruptura de la FQ y se ha mejorado la distribución de HRS (LRS) [19]. Los resultados anteriores sugieren que la idea de incrustar una nanocapa de Cu en la RRAM basada en La requiere un cierto grado de tratamiento térmico para lograr un mejor rendimiento del dispositivo.

un - c I bipolar típico - V curvas y d - f la prueba de resistencia de S1, S2 y S3
La Figura 6 a muestra la probabilidad acumulada de las resistencias HRS y LRS (leídas a - 0.1 V), y la Figura 6b registra la probabilidad acumulativa de los voltajes de armado y reajuste. En la Fig. 6a, los valores medios ( μ ) de LRS y HRS en S1, S2 y S3 se obtienen en 50,7 Ω y 1,59 MΩ, 100,6 Ω y 1,51 MΩ, y 80,6 Ω y 1,95 MΩ, respectivamente. Sin embargo, el coeficiente de variación ( σ / μ ) de LRS y HRS varían mucho en comparación con los valores medios aproximadamente similares en S1, S2 y S3. Entre ellos, S3 tiene el valor mínimo de σ / μ (LRS - 0.74, HRS - 1.02), seguido de S2 (LRS - 1.33, HRS - 1.23), y el σ / μ de S1 es el peor (LRS - 1.22, HRS - 3,00). Como se muestra en la Fig. 6b, los valores medios de los voltajes de reinicio / ajuste son aproximadamente - 0,79 V / 2,36 V, - 0,83 V / 2,49 V y - 1,25 V / 2,59 V para las muestras S1, S2 y S3 respectivamente. La desviación estándar ( σ ) de los voltajes de reinicio / ajuste, que se utilizan para evaluar la dispersión de los parámetros, son 0,20 / 0,82 (S1), 0,23 / 1,16 (S2) y 0,13 / 0,45 (S3), respectivamente. Se puede encontrar que amplias variaciones de HRS, LRS, V establecer y V restablecer en S1 y S2 se mejoran después del recocido. Comparado con S1 y S2, el dopado y recocido (S3) exhibe una mejor uniformidad, lo que indica que S3 tiene la mejor estabilidad de operación entre los tres. Como se mencionó anteriormente, es probable que se introduzcan un gran número de defectos en S2, lo que provocará problemas con la confiabilidad y estabilidad de los dispositivos. Para S3, ese gran número de defectos son eliminados por el proceso térmico, y la aleatoriedad de formación / ruptura de los CF se reduce debido a la existencia de Cu-NC. Por lo tanto, en S3 se obtiene una fina uniformidad con pequeñas variaciones en los voltajes de conmutación y valores de resistencia.
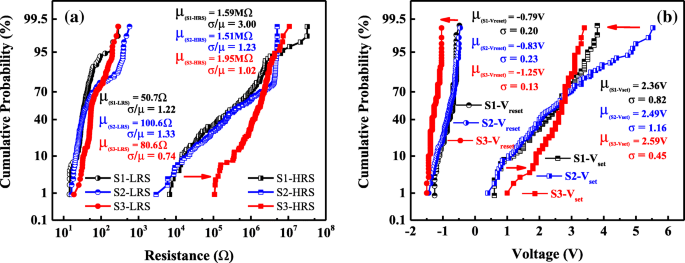
Probabilidad acumulada de a HRS y LRS (lectura a - 0,1 V) y b establecer y restablecer voltajes
Las características de retención de los tres tipos de dispositivos RRAM basados en La bajo voltaje de lectura de - 0.1 V a temperatura ambiente se ilustran en la Fig. 7. Durante la prueba de retención, el Cu / LaAlO 3 :Los dispositivos Cu-NC / Pt exhiben un rendimiento de retención estable durante más de 10 4 s a temperatura ambiente con un R casi constante HRS / R LRS relación de hasta tres órdenes de magnitud, conforme a las características no volátiles de las RRAM basadas en La. DC SET / RESET se mide el rendimiento bipolar de 10 ciclos para evaluar la capacidad de conmutación de S1, S2 y S3. Como se muestra en la Fig. 8, S3 tiene el mejor rendimiento, seguido de S2 y S1 es el peor. Este resultado muestra que una capa de Cu incrustada es útil para aumentar el rendimiento de las RRAM basadas en La, y el rendimiento de los dispositivos se puede mejorar aún más mediante un tratamiento térmico adicional. Además, se puede encontrar en la Fig. 8 que los rendimientos de los dispositivos aumentan con la disminución del área del dispositivo. Este fenómeno indica que el mecanismo de conmutación resistiva de Cu / LaAlO 3 / Los dispositivos Pt RRAM pueden estar estrechamente relacionados con el efecto de calor Joule, es decir, el calor Joule participa en la formación / ruptura de filamentos conductores y parece ser más prominente en dispositivos de menor tamaño.
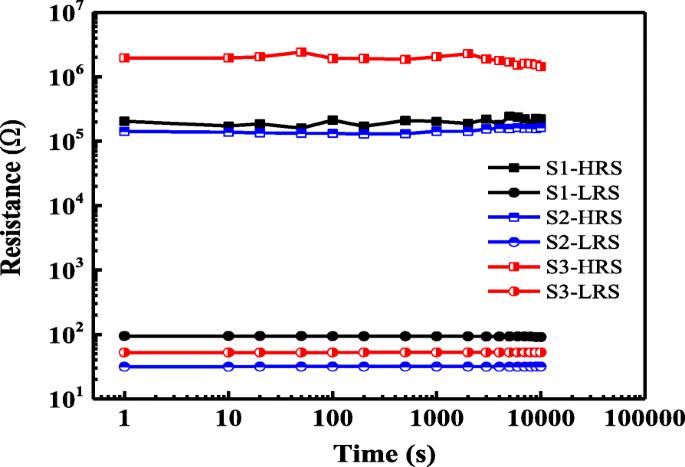
Comportamientos de retención de dispositivos RRAM basados en La a temperatura ambiente
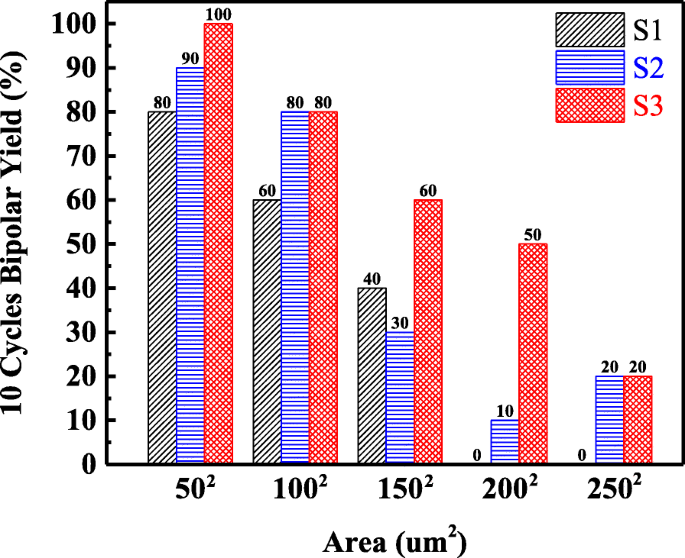
DC SET / RESET Rendimiento bipolar de 10 ciclos de dispositivos RRAM basados en La
Con el fin de obtener más información sobre las RRAM basadas en La tratadas con Cu-NC, se han realizado análisis adicionales sobre el mecanismo de conmutación de resistencia de S3. Como se muestra en la Fig. 9a, el ajuste y reinicio de voltajes en diferentes direcciones se aplican en el I - V medición de S3. Los resultados de la prueba muestran que S3 tiene comportamientos de conmutación resistiva unipolar y bipolar, lo que indica que las RRAM basadas en La tratadas con Cu-NC son no polares. Los investigadores creen que los comportamientos de conmutación resistiva no polar (unipolar) están estrechamente relacionados con la formación / ruptura de FQ asistida por calor de Joule [7]. En el proceso de reinicio de RRAM basado en La, se observa un fenómeno de sobreimpulso de alta corriente y luego se induce el efecto de calentamiento de Joule, lo que lleva a la fusión, sinterización u oxidación térmica de los CF. La Figura 9b muestra la representación logarítmica doble de I - V curvas y accesorios lineales de S3, y el inserto muestra el ln ( I / V ) - V 1/2 curva del proceso de fraguado. Obviamente, el yo - V La relación en LRS exhibe un comportamiento de conducción óhmica con una pendiente de aproximadamente 1, lo que implica la existencia de CF en el dieléctrico después del proceso de fraguado. Sin embargo, el mecanismo de conducción de HRS es un poco complicado y el I - V Las curvas en HRS se pueden dividir en tres líneas rectas con tres pendientes diferentes. En la región de bajo voltaje (<0,8 V, línea naranja), la pendiente de la línea de ajuste es de aproximadamente 1,33, que está cerca del mecanismo de transporte óhmico. Con el aumento de voltaje (~ 0.8 a ~ 2 V, línea verde), la pendiente de la línea de ajuste aumenta a 1.93 ( I ~ V 1,93 ), que se ajusta a la ley del cuadrado del niño ( I ~ V 2 ). En la tercera región (> 2 V, línea violeta), la pendiente de la línea de ajuste seguirá aumentando (p. Ej., 2,86 en este caso) y la corriente aumentará bruscamente cuando V establecer es alcanzado. El modo de conducción de HRS, que se compone de la región de transporte óhmico y la región de la ley de Child, concuerda con el mecanismo clásico de corriente limitada de carga espacial (SCLC) [20, 21]. La aparición del mecanismo de conducción del SCLC indica la formación y ruptura de la vía de conducción local [22], que se considera el principal mecanismo RS de Cu / LaAlO 3 :Dispositivos Cu-NC / Pt. Además, la conducción HRS también encaja bien con el mecanismo de conducción de Poole-Frenkel (el inserto). El efecto Poole-Frenkel es causado principalmente por los portadores excitados por el campo eléctrico que saltan a través de los estados atrapados [23], lo que sugiere que todavía hay una gran cantidad de defectos en el LaAlO 3 películas incluso después del tratamiento de recocido.
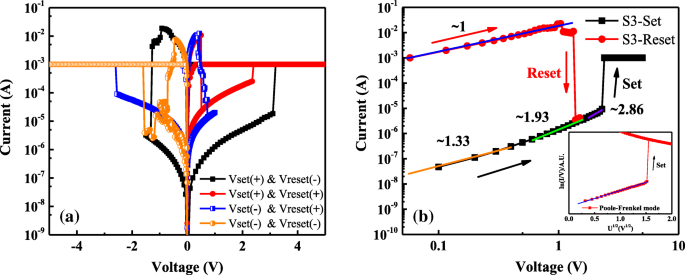
un yo - V medición de S3 en diferentes direcciones de voltaje. b Representación logarítmica doble de I - V curvas y accesorios lineales de S3, y el inserto muestra el ln ( I / V ) - V 1/2 trazado del proceso establecido
Se ha estudiado la dependencia de S3 en el área del electrodo (Fig. 10a) y la temperatura (Fig. 10b) para comprender mejor el mecanismo RS. Se puede ver en la Fig.10a que la resistencia LRS es independiente del área del electrodo, mientras que la resistencia HRS (y la resistencia inicial) disminuye con el aumento del área del dispositivo, lo que indica que el mecanismo RS de S3 se origina en la formación y ruptura. de las FC. En la Fig. 10b, las resistencias HRS disminuyen al aumentar la temperatura, lo que muestra que el estado APAGADO de S3 se puede asociar con un comportamiento semiconductor. Por el contrario, las resistencias LRS aumentan con el aumento de temperatura, lo que indica una característica metálica en estado ON [24]. Según la literatura, la relación entre la resistencia del metal y la temperatura se suele estudiar mediante la ecuación de R ( T ) = R 0 [1 + α ( T - T 0 )] [25]. Y el ajuste lineal azul en la Fig. 10b determina el coeficiente de temperatura ( α ) sea 1.03 × 10 −3 K −1 . Este valor es ligeramente menor que los valores reportados de los nanocables de Cu en otras publicaciones (2.5 × 10 −3 K −1 [26], 2,39 × 10 −3 K −1 [27]). Debido al hecho de que se han introducido un gran número de defectos en el LaAlO 3 dopado con Cu-NC películas, una α más baja El valor de Cu CF se obtiene en este documento.
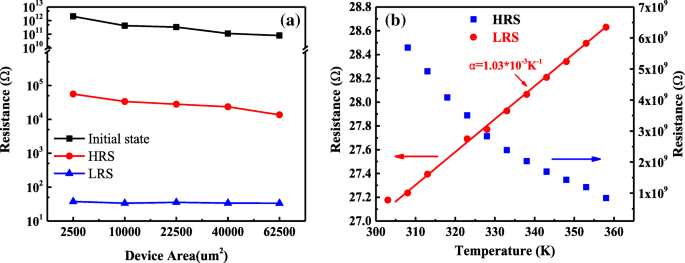
un Dependencia del área de electrodos del HRS y LRS. b Dependencia de la temperatura del HRS y LRS
Por lo tanto, se ha propuesto una explicación razonable para el efecto RS de Cu / LaAlO 3 :Dispositivos Cu-NC / Pt en nuestro caso. Es muy probable que la formación y ruptura de Cu CF esté mediada por la metalización electroquímica (ECM) y el efecto de calor de Joule. La Figura 11 muestra diagramas esquemáticos para el mecanismo RS de Cu / LaAlO3:dispositivos Cu-NC / Pt en (a) estado inicial; (b), (c) Proceso de establecimiento; (d) estado ON; y (e) proceso de reinicio. Cuando se aplica un voltaje positivo a TE (Cu), se produce una reacción de oxidación, que se describe como Cu → Cu 2+ + 2e - , ocurre en el material electroquímicamente activo (Fig. 11b). Bajo la acción del campo eléctrico, el móvil Cu 2+ Los cationes migran hacia BE (Pt) a través de LaAlO 3 película y una reacción de reducción de Cu 2+ + 2e - → Se produce Cu en el cátodo (Fig. 11c). Vale la pena señalar que hay algunos Cu-NC y átomos de Cu difundidos en los dieléctricos basados en La de S3, que son las vías naturales para la formación de Cu CF. Por lo tanto, los átomos de metal Cu precipitados continuamente tenderán a crecer a lo largo de estas vías naturales y eventualmente alcanzarán el TE para formar un canal conductor (Fig. 11d). Cuando se invierte la polaridad del voltaje aplicado, el proceso de disolución, que se relaciona estrechamente con el efecto electroquímico y el efecto de calor Joule, ocurre en algún lugar a lo largo del filamento, lo que resulta en una fractura casi completa de los CF y el dispositivo en el estado APAGADO (Fig. 11e ).
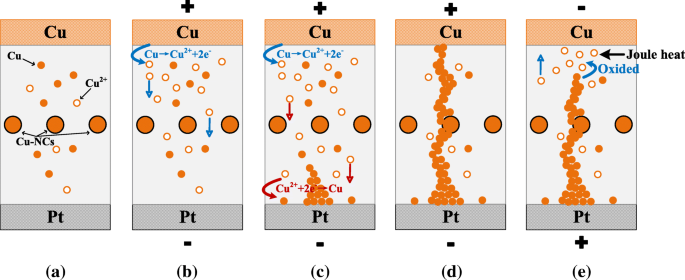
Diagramas esquemáticos del mecanismo RS de Cu / LaAlO3:dispositivos Cu-NC / Pt en a estado inicial; b , c establecer proceso; d En estado; y e proceso de reinicio
Conclusión
En resumen, se introduce un método dopado con metal para mejorar el rendimiento de los dispositivos RRAM basados en La. Las mejoras obvias de las características de conmutación resistiva, que incluyen un voltaje de formación más bajo, una relación de encendido / apagado más alta, una mejor uniformidad eléctrica y un rendimiento superior del dispositivo, están corroboradas por el I - V resultados de la medición de la muestra recocida y dopada con Cu. Los resultados de los análisis de XPS y TEM confirmaron que las mejoras en el rendimiento de conmutación podrían atribuirse a la difusión de átomos de Cu y la formación de nanocristales de Cu (Cu-NC) después del proceso de recocido. Otros estudios revelan que el mecanismo de conmutación resistiva de Cu \ LaAlO 3 :Los dispositivos Cu-NC \ Pt se pueden atribuir a la formación y ruptura de filamentos conductores de Cu, que están estrechamente relacionados con el mecanismo SCLC y el efecto de calentamiento de Joule. Este estudio demuestra un método factible para controlar los comportamientos de conmutación resistiva de las RRAM mediante la incorporación de nanocristales de Cu, y es necesario realizar más trabajos para comprender el mecanismo físico y las leyes inherentes de las RRAM basadas en La.
Disponibilidad de datos y materiales
Los conjuntos de datos que respaldan las conclusiones de este manuscrito se incluyen dentro del manuscrito.
Abreviaturas
- ALD:
-
deposición de la capa atómica; RRAM
memoria resistiva de acceso aleatorio; NC
nanocristales; M-I-M
metal-aislante-metal; RS
conmutación resistiva; Alto- k
alta constante dieléctrica; RS
conmutación resistiva; SER
electrodo inferior; RTA
recocido térmico rápido; TE
electrodo superior; XPS
Espectroscopía de fotoelectrones de rayos X; DC
corriente continua; CF
filamentos conductores; HRS
estado de alta resistencia; LRS
estado de baja resistencia; SCLC
carga espacial corriente limitada
Nanomateriales
- 5 impactos que la IoT tendrá en la fabricación
- Los dispositivos SAW ultrapequeños de Murata satisfacen las necesidades de 5G
- La creciente amenaza de IoT habilitado para Wi-Fi
- Conexión de IoT:la oportunidad de banda estrecha
- El papel de IoT en la atención médica durante Covid-19
- Descubriendo el punto ciego de IoT en un mundo pospandémico
- Cómo el efector final robótico correcto afecta el rendimiento robótico
- Los desafíos de las pruebas de software de los dispositivos IOT
- El rendimiento efectivo del moldeo por inyección rápida
- Kaizen, ¿la gestión del rendimiento operativo?
- La ubicación del compresor afecta el rendimiento



