Una descripción general del diodo de barrera Schottky basado en semiconductores Ga2O3 ultraancho para aplicaciones de electrónica de potencia
Resumen
Óxido de galio (Ga 2 O 3 ) es un nuevo material semiconductor que tiene la ventaja de una banda prohibida ultra ancha, un campo eléctrico de alta ruptura y una gran figura de mérito de Baliga (BFOM), por lo que es un candidato prometedor para los dispositivos de alta potencia de próxima generación, incluido el diodo de barrera Schottky (SBD). ). En este artículo, las propiedades físicas básicas de Ga 2 O 3 Se han analizado los semiconductores. Y las investigaciones recientes sobre el Ga 2 O 3 SBD basados en. Mientras tanto, se han resumido y comparado varios métodos para mejorar el rendimiento, incluido el voltaje de ruptura y la resistencia activa. Finalmente, la perspectiva de Ga 2 O 3 SBD basado en aplicaciones de electrónica de potencia.
Antecedentes
Con el rápido desarrollo de las industrias de energía eléctrica, control industrial, electrónica automotriz y electrónica de consumo, existe una gran demanda de dispositivos semiconductores de potencia de alto rendimiento. Los materiales semiconductores con banda prohibida amplia y ultraancha pueden satisfacer esta demanda [1, 2]. Entre las cinco estructuras de Ga 2 O 3 monocristal, monoclínico β -Ga 2 O 3 es el más estable y tiene una banda prohibida ultra ancha ( E g ~ 4.8 eV) y campo eléctrico de ruptura muy alta ( E br ~ 8 MV cm −1 ), en comparación con el material SiC y GaN tradicional y posteriormente desarrollado. En consecuencia, β -Ga 2 O 3 muestra una figura de mérito de Baliga mucho más grande (BFOM =\ (\ varepsilon \ mu {E} _ {\ mathrm {b}} ^ 3 \); ε es la constante dieléctrica relativa, y μ es la movilidad de los electrones). BFOM es un criterio importante para evaluar la idoneidad de un material para la aplicación de dispositivos de potencia [3, 4, 5, 6, 7, 8, 9, 10, 11]. La Tabla 1 compara las propiedades físicas básicas de Si, banda prohibida amplia (GaN, SiC) y banda prohibida ultra ancha ( β -Ga 2 O 3 ) material semiconductor. Además, para el crecimiento de β monocristalino -Ga 2 O 3 substrato, existen métodos fáciles, de bajo costo y producibles en masa de crecimiento en fusión a presión atmosférica, como la zona flotante (FZ) [12, 13] y el crecimiento alimentado por película de borde definido (EFG) [14,15 , 16,17]. Esta es otra superioridad de Ga 2 O 3 en el aspecto de crecimiento monocristalino de alta calidad, en comparación con SiC y GaN. Por lo tanto, β -Ga 2 O 3 es un candidato prometedor para dispositivos semiconductores de alta potencia de próxima generación como el diodo de barrera Schottky (SBD) [18,19,20,21,22,23,24] y el transistor de efecto de campo semiconductor de óxido metálico (MOSFET) [ 25,26,27,28,29]. Vale la pena señalar que muchos estudios sobre Ga 2 O 3 El crecimiento del material y la fabricación y caracterización de dispositivos de potencia se han llevado a cabo en los últimos años, por lo que en este artículo revisamos las propiedades del material de la banda prohibida ultraancha Ga 2 O 3 semiconductor y las investigaciones del Ga 2 O 3 SBD basado en aplicaciones de electrónica de potencia. En SBD, los parámetros de rendimiento más importantes son el voltaje de ruptura ( V br ) y resistencia activa ( R en ), por lo que al resumir y comparar los diversos métodos para mejorar la V br y R en actuaciones, deseamos que nuestro trabajo de revisión sea beneficioso para el desarrollo de Ga 2 O 3 dispositivos de energía basados en.
Propiedades físicas del semiconductor de óxido de galio
Óxido de galio (Ga 2 O 3 ) es un nuevo material semiconductor de óxido, pero tiene una larga historia de investigación. La investigación sobre los equilibrios de fase en el Al 2 O 3 -Ga 2 O 3 -H 2 El sistema O se remonta a 1952, y R. Roy et al. determinó la existencia de polimorfos de Ga 2 O 3 y sus relaciones de estabilidad [30]. En 1965, H. H. Tippins et al. estudió la absorción óptica y la fotoconductividad en el borde de la banda de β -Ga 2 O 3 y confirmó su banda prohibida con un valor de 4,7 eV [6]. En la década de 1990, varios métodos sobre el crecimiento por fusión de Ga 2 O 3 crecimiento epitaxial y monocristalino a granel de Ga 2 O 3 se había revelado la película. En los últimos 5 años, debido a sus propiedades especiales y al crecimiento exitoso de sustrato monocristalino de gran tamaño y alta calidad, Ga 2 O 3 El material ha atraído mucho interés en la investigación.
Hasta ahora, la gente ha encontrado cinco fases cristalinas de Ga 2 O 3 , es decir, α , β , γ , δ y ε etapas. Las relaciones de transformación entre estas cinco fases se muestran en la Fig. 1 [30]. La fase monoclínica β- Ga 2 O 3 tiene la mejor estabilidad térmica, mientras que las otras cuatro fases son metaestables y son aptas para transformarse en β- Ga 2 O 3 a altas temperaturas. Por lo tanto, en la actualidad, la mayoría de los estudios se centran en β- Ga 2 O 3 . Algunas investigaciones recientes también encontraron que otras fases presentaban algunas propiedades materiales especiales que β fase no tenía. Por ejemplo, α- Ga 2 O 3 tiene una estructura de cristal de corindón similar a la del zafiro (Al 2 O 3 ), por lo que es comparativamente fácil cultivar epitaxialmente α- de alta calidad Ga 2 O 3 película monocristalina en el Al 2 existente actualmente O 3 sustrato monocristalino. Fase hexagonal ε- Ga 2 O 3 es la segunda fase estable y presenta un fuerte efecto de polarización espontánea que es beneficioso para formar gas de electrones 2D de alta densidad en la interfaz de heterounión [31], similar a la condición en la unión AlGaN / GaN. En los últimos años, debido al exitoso crecimiento de β- de gran tamaño Ga 2 O 3 sustrato monocristalino y su mejor estabilidad, hasta ahora, los estudios sobre β- Ga 2 O 3 son mucho más que los de las otras cuatro fases. Entonces, en este artículo, revisamos principalmente los trabajos de investigación sobre β- Ga 2 O 3 .
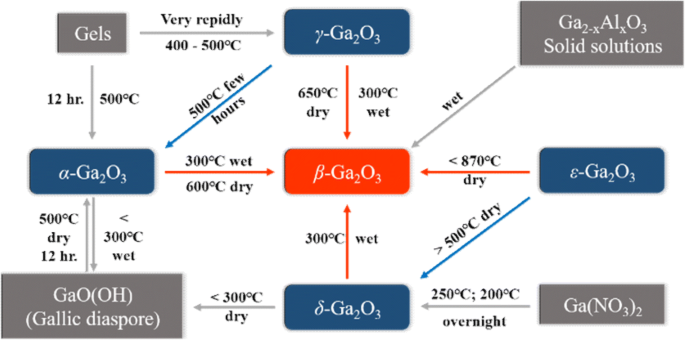
Relaciones de transformación entre las fases cristalinas de Ga2O3 y sus hidratos [30]
β- Ga 2 O 3 Pertenece al sistema monoclínico y es térmicamente estable. Sus constantes de celosía son a =1,22 nm, b =0.30 nm y c =0,58 nm, como se muestra en la Fig. 2. La estructura cristalina de β- Ga 2 O 3 determina que tiene una cierta conductividad, pero que está limitada por su banda prohibida ultra ancha (4,7–4,9 eV), el más ancho de todos los materiales semiconductores transparentes conocidos. Solo si existen algunos niveles de energía de defecto en la banda prohibida y se generan electrones libres, el material tiene una conductividad comparativamente fuerte. Para la mayoría de los semiconductores con banda prohibida amplia, la conductividad se forma simplemente debido a la existencia de niveles de defecto en la banda prohibida, como el semiconductor de ZnO [32]. La conducción eléctrica intrínseca de β- Ga 2 O 3 se origina en los electrones libres conducidos por los defectos puntuales formados en la mayor parte del cristal. La mayoría de los estudios han demostrado que las vacantes de oxígeno son los defectos clave de la conducción eléctrica [33,34,35].

La estructura reticular de β-Ga 2 O 3 cristal. Reimpreso de ref. [5]
Es interesante que debido a la existencia de abundantes vacantes de oxígeno en policristalinos β- Ga 2 O 3 , es fácil absorber algún tipo de gas para hacer que la resistividad cambie, por lo que ha habido muchos informes sobre el uso de β- Ga 2 O 3 para fabricar sensores de gas para la detección de H 2 , CH 4 , CO y O 2 [36,37,38,39]. Además, debido a que la constante de celosía de β- Ga 2 O 3 en la dirección [100] es mucho más grande que en las direcciones [001] y [010], es fácil despegar la película ultrafina a lo largo de la dirección [100] para la fabricación del dispositivo [27, 40, 41, 42, 43]. Al mismo tiempo, debido a esta característica de estructura cristalina, en la fabricación de β- Ga 2 O 3 obleas, cortar el volumen a lo largo de la dirección [100] puede adquirir una superficie plana con una rugosidad muy baja.
En comparación con SiC y GaN, β- Ga 2 O 3 posee características eléctricas particulares, entre las que la banda prohibida ultraancha (4,7–4,9 eV) es la más destacada. Esto hace que tenga un campo eléctrico de ruptura crítica muy alto ( E br ≈8 MV / cm), aproximadamente el doble de los de SiC y GaN. El campo eléctrico de ruptura del material es un parámetro muy importante para los dispositivos de potencia unipolar. Si un material tiene una E más alta br , en el material de espesor unitario, se puede mantener un campo eléctrico más alto, lo que es ventajoso para la reducción del tamaño del dispositivo y la mejora del nivel de integración de los módulos de potencia. La Figura 3 muestra los límites fundamentales de la resistencia activa ( R en ) en función de la tensión de ruptura ( V br ) para varios semiconductores importantes, incluidos Si, GaAs, SiC, GaN, Ga 2 O 3 y diamante [5]. A partir de esta figura, podemos encontrar que la pérdida de conducción de Ga 2 O 3 dispositivos es un orden de magnitud más bajo que los dispositivos de SiC y GaN al mismo V br . Por lo tanto, Ga 2 O 3 muestra su gran potencial en dispositivos unipolares. Como la movilidad de electrones de saturación de β- Ga 2 O 3 es comparativamente bajo (~ 200 cm 2 V - 1 s - 1 ), β- Ga 2 O 3 no es adecuado para dispositivos de alta frecuencia en comparación con GaN. Sin embargo, su ancho de banda prohibida puede compensar esta desventaja ya que la capa de deriva más delgada tiene un ancho de empobrecimiento más pequeño; por lo tanto, la capacitancia parásita se puede reducir para cumplir con los requisitos de las aplicaciones de alta frecuencia. Además, la banda prohibida de aproximadamente 4.8 eV hace que Ga 2 O 3 Poseen una banda de onda de absorción especial (250-280 nm) que se encuentra en el rango de los rayos ultravioleta (UV) ciegos al sol, por lo que Ga 2 O 3 es un buen material natural para fabricar detectores UV [44,45,46,47].
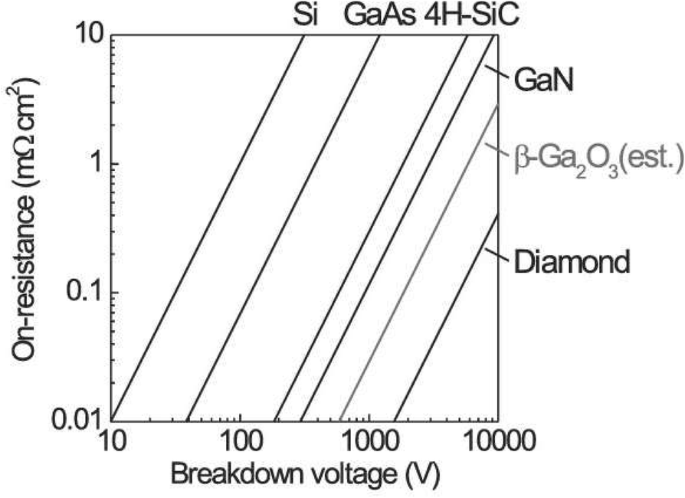
Límites teóricos de on-resistencia ( R en ) en función de la tensión de ruptura ( V br ) para β-Ga 2 O 3 y semiconductores representativos. Reimpreso de ref. [26]
En los últimos años, el dopaje de tipo n de β- Ga 2 O 3 se ha realizado básicamente. Los elementos Si y Sn, como sus impurezas donantes con un nivel de energía poco profundo, tienen una energía de activación baja. La concentración de dopaje se puede modular bien para estar en el rango de 10 15 –10 19 cm −3 [47], con el valor más alto de 10 20 cm −3 alcanzado. Al mismo tiempo, con el cambio de concentración de dopaje, las propiedades ópticas y eléctricas también cambiarán. Por ejemplo, la resistividad de tipo n β- Ga 2 O 3 cambios en el rango de 10 −3 - 10 12 Ω cm con la concentración de dopaje cambiante [48, 49]. La banda prohibida también cambia con diferentes concentraciones de dopaje, por lo que las características de absorción de luz de Ga 2 O 3 están influenciados [50].
Desde el desarrollo de Ga 2 O 3 , este material todavía tiene algunas desventajas como sigue. (1) El dopaje de tipo P es un gran desafío para Ga 2 O 3 material. Debido a que los niveles de aceptor están lejos de la banda de valencia de β- Ga 2 O 3 , la energía de activación de las impurezas aceptoras es muy alta. Mientras tanto, las impurezas de fondo de tipo n en Ga 2 O 3 El cristal también producirá un efecto de autocompensación sobre las impurezas aceptoras, lo que dará como resultado el autoaislamiento del material. Por lo tanto, todavía no se ha realizado una acción de tipo p eficaz. (2) La conductividad térmica de Ga 2 O 3 es demasiado bajo. Investigaciones experimentales y teóricas han demostrado que la conductividad térmica de β- Ga 2 O 3 es de solo 0,1–0,3 W cm −1 K −1 [51,52,53]. Esto es adverso para el dispositivo de potencia utilizado en circunstancias de alta tensión y alta corriente. La acumulación excesiva de calor afectará seriamente el rendimiento y la confiabilidad del dispositivo. (3) La movilidad del transportista es baja. La movilidad teórica de Ga 2 O 3 está limitado a unos 200 cm 2 / V s debido a la influencia de la dispersión [54]. La baja movilidad tiene un impacto negativo en las características de frecuencia y corriente.
El concepto básico del diodo de barrera Schottky
El contacto Schottky, el contacto óhmico y la distribución del campo eléctrico son los factores clave en SBD para lograr altos rendimientos, incluida la resistencia activa ( R en ) y voltaje de ruptura ( V br ), por lo que varios métodos para mejorarlos son especialmente importantes.
Según el concepto de barrera de Schottky, la altura de la barrera está relacionada con la función de trabajo del metal Schottky y la afinidad electrónica del semiconductor. La función de trabajo de diferentes metales cambia periódicamente, y el metal debe tener una función de trabajo más grande que el semiconductor para formar la barrera Schottky. El níquel (Ni) y el platino (Pt) son los metales comunes de Schottky para β- Ga 2 O 3 , y sus alturas de barrera se derivan con diversos métodos [55,56,57,58,59,60,61,62,63,64,65,66,67,68,69,70,71,72,73,74 , 75,76,77]. La región de agotamiento debajo de la superficie del semiconductor necesita el espesor necesario para evitar la formación de túneles del portador, y esto requiere la concentración de dopaje limitada del semiconductor. Los valores comunes de concentración de dopaje son 10 16 –10 17 cm −3 en el β- Ga 2 O 3 sustrato o capa de epitaxia [56,57,58,59,60,61,62]. La altura de la barrera se ve realmente afectada por los estados de la interfaz y se desvía de una relación simple con la función de trabajo. El pretratamiento de la superficie tiene como objetivo reducir los estados de la interfaz, incluidas las vacantes de oxígeno cerca de la superficie y los enlaces colgantes [78].
El contacto óhmico es el vínculo básico entre el metal y el semiconductor. Una baja resistencia específica de contacto óhmico es útil para que los dispositivos disminuyan la resistencia de contacto ( R s ) y resistencia activa ( R en ). Los métodos tradicionales para lograr una baja resistencia al contacto son elegir metales de baja función y dopaje pesado. De hecho, la función de trabajo del metal de contacto siempre no influye en la formación del contacto óhmico debido a la fijación de los estados de la interfaz. El fuerte dopaje de semiconductores se convierte en la técnica principal para el contacto óhmico. Los principales objetivos son mejorar la concentración de portadores y reducir la barrera de la interfaz. El RTA (recocido térmico rápido) mejora las características interfaciales y redunda en la reducción de la resistencia de contacto. Y. Yao y col. probó nueve metales como metales de contacto óhmico con el β- Ga 2 O 3 y encontró que el titanio (Ti) y el indio (In) muestran un buen comportamiento óhmico en condiciones específicas [79]. Después del recocido a altas temperaturas, solo el titanio puede mantener la morfología continua. Similar a esto, la mayoría de los estudios aplicaron titanio como metal de contacto óhmico con β- Ga 2 O 3 y obtuvieron rendimientos favorables del dispositivo [60,61,62,63,64,65,66,67,68,69,70].
El comportamiento de ruptura está relacionado con la distribución del campo eléctrico dentro de los dispositivos, y la unión cilíndrica y la unión esférica tienen un campo eléctrico mayor que la unión de plano paralelo en la misma condición [1]. Por lo tanto, se necesitan algunos métodos de protección de terminación de borde, como la placa de campo, para mejorar la tensión de ruptura [19, 23, 68]. Los estados de la interfaz denominados cargas de la interfaz normalmente impactan en el campo eléctrico cerca de la superficie del semiconductor y provocan una avería prematura. La corriente de fuga es el indicador del comportamiento de ruptura y comúnmente se ve afectada por los defectos internos del semiconductor, incluidas las dislocaciones. Ambas situaciones provocan la inestabilidad de los dispositivos y pueden disminuir la tensión de ruptura, lo que debe evitarse. La práctica común para reducir el impacto de los estados de la interfaz es la pasivación de la superficie, y también se requiere un sustrato de alta calidad para aumentar el voltaje de ruptura.
Diodo de barrera Schottky Basado en β- Ga 2 O 3
Las dificultades en el crecimiento de sustratos monocristalinos de alta calidad y bajo costo han afectado la comercialización de dispositivos de SiC y GaN. Mientras Ga 2 O 3 Los sustratos monocristalinos se pueden cultivar mediante un método de fusión de bajo costo, los dispositivos de energía basados en Ga 2 O 3 Los monocristales han atraído mucha atención en los últimos años. En la actualidad, la tecnología de dopaje de tipo n de Ga 2 O 3 es bastante maduro, pero la falta de dopaje de tipo p hace que Ga 2 O 3 No se puede aplicar en dispositivos bipolares. La banda prohibida ultra grande lo convierte en una gran ventaja en la aplicación de dispositivos unipolares. Por lo tanto, el desarrollo de Ga 2 O 3 Los dispositivos de potencia están dominados por dos tipos de dispositivos unipolares, es decir, el diodo de barrera Schottky (SBD) y el transistor de efecto de campo semiconductor de óxido metálico (MOSFET) [23, 55, 56].
Con el desarrollo de la tecnología de material semiconductor de banda ancha ancha (WBG), el dispositivo SBD basado en semiconductores WBG comienza a reemplazar el diodo de unión p-n para aplicarlo en el sistema electrónico de potencia porque no existe un efecto de almacenamiento de portadora minoritaria en SBD y su pérdida de conmutación es bastante baja. En teoría, en comparación con SiC y GaN SBD, Ga 2 O 3 SBD puede lograr el mismo voltaje de ruptura con una capa de deriva mucho más delgada. Al mismo tiempo, la capa de deriva más delgada produce una capacitancia parásita más baja, acortando el tiempo de recuperación inversa del dispositivo. El principal progreso de desarrollo de Ga 2 O 3 SBD se muestra en la Fig. 4. Con el desarrollo de la tecnología de epitaxia, la estructura de SBD se ha desarrollado desde la estructura simple inicial basada en sustrato hasta el sustrato y la estructura compleja basada en película epitaxial. Posteriormente, a través de la exploración gradual de los procesos de fabricación del dispositivo, han aparecido estructuras terminales avanzadas que incluyen la placa limada y la zanja, mejorando aún más el rendimiento del dispositivo. Ga 2 O 3 SBD comienza a presentar su potencial en aplicaciones de electrónica de potencia.
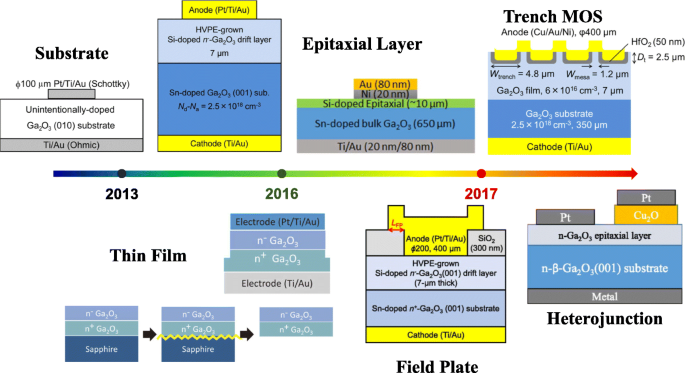
El desarrollo de Ga 2 O 3 SBD en los últimos años [16, 18, 62, 68–71]
Como nuevo material semiconductor con banda prohibida amplia, la gente enfrentó muchos problemas básicos en la etapa de desarrollo inicial de Ga 2 O 3 , por lo que el progreso del desarrollo de Ga 2 O 3 SBD refleja muy bien la evolución de la potencia SBD. La parte más importante en SBD es la unión Schottky, por lo que en los primeros trabajos de investigación sobre Ga 2 O 3 SBD, hay un número sustancial de los que se centran en el estudio de la unión Schottky, que incluyen principalmente el contacto entre Ga 2 O 3 y diferentes electrodos Schottky (Ni 、 Cu 、 Au 、 Pt 、 TiN) [57,58,59], el mecanismo de transporte de electrones de la unión Schottky, los problemas de los estados de interfaz, la falta de homogeneidad de la barrera y la fuerza de la imagen existente en el contacto Schottky, y los métodos de cómo adquirir un contacto óhmico perfecto en la interfaz del cátodo [60, 61].
Con la claridad gradual de las propiedades físicas y la mejora cada vez mayor de los procesos de fabricación, las prestaciones del dispositivo se mejoran progresivamente. Los siguientes son algunos trabajos típicos en el desarrollo de Ga 2 O 3 SBD.
En 2013, K. Sasaki et al. en Tamura Corporation fabricó SBD basado en (010) β de alta calidad –Ga 2 O 3 sustrato monocristalino cultivado por el método de la zona flotante [62]. Investigaron el impacto de las diferentes concentraciones de dopaje en el sustrato en el rendimiento del dispositivo y encontraron que una mayor concentración de dopaje inducía una menor resistencia a la activación, pero un voltaje de ruptura inverso más bajo y una corriente de fuga inversa más grande. La Figura 5 muestra las características de descomposición inversa de los dos SBD fabricados con (010) β –Ga 2 O 3 sustratos con diferentes concentraciones de dopaje. El voltaje de ruptura alcanza los 150 V. El factor de idealidad de ambos dispositivos es cercano a 1. Y la altura de la barrera Schottky del Pt / β –Ga 2 O 3 se estimó que la interfaz era de 1,3 a 1,5 eV.
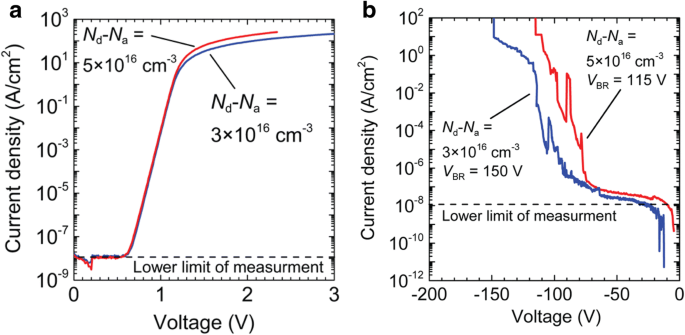
un , b Características eléctricas de avance y retroceso del SBD basadas en (010) β -Ga 2 O 3 sustratos con diferentes concentraciones de dopaje. El límite inferior de la medición de la densidad de corriente es 10 -8 A / cm 2 . Reimpreso de ref. [62]
Investigadores del Instituto de Microelectrónica de la Academia de Ciencias de China (IMECAS) y la Universidad de Shandong han colaborado para investigar el SBD basado en β orientado a (100) –Ga 2 O 3 sustrato a granel. En 2017, reportaron un Pt / β –Ga 2 O 3 SBD y sus características eléctricas dependientes de la temperatura. El análisis de difracción de rayos X (XRD) y microscopía electrónica de transmisión de alta resolución (HRTEM) mostró que el β –Ga 2 O 3 Los monocristales a granel cultivados mediante la técnica de crecimiento alimentado con película de bordes definidos (EFG) presentaron una buena orientación (100) y una buena calidad de cristal (Figs. 6a, b). A través de mediciones I – V y modelado de emisiones termoiónicas, el Pt / β fabricado –Ga 2 O 3 El dispositivo SBD mostró un buen rendimiento, incluida una relación de rectificación de 10 10 , factor de idealidad ( n ) de 1,1, altura de la barrera Schottky ( Φ B ) de 1,39 eV, voltaje umbral ( V bi ) de 1,07 V, encendido-resistencia ( R en ) de 12,5 mΩ cm 2 , densidad de corriente directa a 2 V ( J @ 2V ) de 56 A / cm 2 y concentración efectiva de donantes ( N d - N a ) de 2,3 × 10 14 cm −3 (Figuras 6c, d). También se encontró en el dispositivo un buen rendimiento dependiente de la temperatura (Figuras 6e, f). Con el aumento de temperatura, R en y J @ 2V mejoró, demostrando que el dispositivo podía funcionar bien a alta temperatura. En su siguiente trabajo, investigaron más profundamente la dependencia de la temperatura del factor de idealidad y la altura de la barrera de Schottky y encontraron que este tipo de características de temperatura pueden explicarse por la distribución gaussiana de la inhomogeneidad de la altura de la barrera [61]. En 2018, optimizaron aún más los parámetros de crecimiento de cristales y mejoraron la concentración de dopaje de Sn ( N d - N a =2,3 × 10 14 cm −3 ). El nuevo Pt / β –Ga 2 O 3 El dispositivo SBD muestra un rendimiento notablemente mejorado, incluida la densidad de corriente directa ( J @ 2V =421 A / cm 2 ), Resistencia en estado ON ( R en =2,9 mΩ cm 2 ), un tiempo de recuperación inverso corto (20 ns) y una tensión de ruptura inversa superior a 200 V [63]. Su trabajo indica que EFG creció β –Ga 2 O 3 monocristal es una aplicación prometedora para dispositivos de energía.

un Curva de difracción de rayos X (XRD) de (100) β -Ga 2 O 3 sustrato monocristalino, que muestra claramente los picos de los planos (400), (600) y (800). b Imagen de microscopio electrónico de transmisión de alta resolución (HRTEM) de sección transversal de Pt / β -Ga 2 O 3 Micrografía de contacto Schottky y rápida transformada de Fourier (FFT) de β -Ga 2 O 3 cristal. c Curva J – V hacia adelante y hacia atrás de una Pt / β -Ga 2 O 3 SBD y el esquema del SBD (recuadro). d Curva J – V directa en gráfico lineal y semilogarítmico. e Curvas J – V dependientes de la temperatura y gráfico de Richardson (recuadro). f Dependencia de la resistencia ON y la densidad de corriente directa de la temperatura. Reimpreso de ref. [60]
Q. Feng y col. de la Universidad de Xidian han estudiado los procesos de preparación de la deposición por láser pulsado (PLD) y las propiedades físicas básicas del β dopado con Al –Ga 2 O 3 película [64,65,66]. Doping Al es capaz de ajustar la banda prohibida de β –Ga 2 O 3 incorporando diferentes proporciones de átomos de Al. Basado en este tipo de película dopada con Al, Ni / β - (AlGa) 2 O 3 Se fabricó y caracterizó el dispositivo SBD. La altura de la barrera de Schottky es de 1,33 eV. La relación actual de encendido y apagado y la resistencia de encendido alcanzan 10 11 y 2,1 mΩ cm 2 , respectivamente [65]. También estudiaron la influencia de la temperatura en el factor de idealidad y la altura de la barrera de Schottky y también llegaron a la conclusión de que estas características de dependencia de la temperatura de n y Φ B se atribuyeron a las inhomogeneidades de la barrera de Schottky asumiendo la existencia de una distribución gaussiana de la altura de la barrera [66].
Con el desarrollo de la tecnología de epitaxia de película, se utilizó la epitaxia de fase de vapor de haluro (HVPE) para hacer crecer Ga 2 O 3 película. Debido a las ventajas de la rápida velocidad de la epitaxia y la alta calidad de la película, Ga 2 O 3 es muy adecuado para fabricar la capa de deriva del SBD de alto voltaje. En 2015, M. Higashiwaki et al. en el Instituto Nacional de Tecnología de la Información y las Comunicaciones (NICT) creció 7 μm de espesor ligeramente dopado (~ 1 × 10 16 cm −3 ) capa epitaxial en el muy dopado ( N d - N a =2,5 × 10 18 cm −3 ) (001) β- Ga 2 O 3 sustrato a través del método HVPE y dispositivo SBD fabricado adicionalmente. Se investigaron las características C – V e I – V del dispositivo a diferentes temperaturas. Se señaló la tendencia de cambio de la altura de la barrera de Schottky, el voltaje umbral, las curvas C – V e I – V con la temperatura. La Figura 7 muestra la estructura del dispositivo y las curvas J – V – T directa e inversa [16]. Se encontró que a 21-200 ° C, la altura de la barrera se mantuvo casi constante. La corriente directa e inversa concordaban bien con el modelo de emisión termoiónica (TE) y de emisión de campo termoiónico (TFE), respectivamente. Sus resultados demostraron el potencial de la aplicación de Ga 2 O 3 SBD en dispositivos de energía de próxima generación.
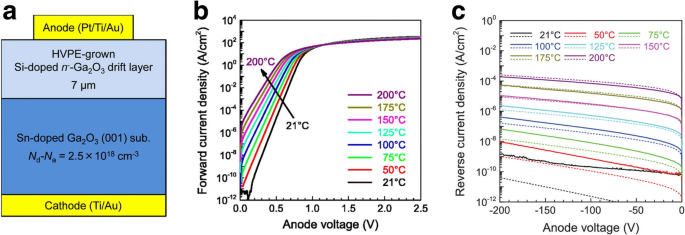
un Estructura del dispositivo SBD basada en el HVPE de 7 μm de espesor n - - Ga 2 O 3 capa de deriva homoepitaxial en n + - Ga 2 O 3 sustrato monocristalino. b Características J – V de avance del dispositivo medidas a 21–200 ° C. c Invertir J – V a 21–200 ° C (las líneas continuas y punteadas representan los resultados experimentales y simulados, respectivamente). Reimpreso de ref. [16]
En 2016, M. Oda et al. en FLOSFIA Inc. publicó un trabajo sobre α -Ga 2 O 3 SBD [18]. A través de una técnica de deposición química en fase vapor (CVD), es decir, MIST EPITAXY®, crecieron sucesivamente en gran medida (de 3 a 4 μm de espesor) y ligeramente dopadas α -Ga 2 O 3 películas sobre zafiro (Al 2 O 3 ) sustratos. Después de levantar el α -Ga 2 O 3 capas de los sustratos, cátodo y ánodo se depositaron en la superficie inferior y superior del n - - Ga 2 O 3 / n + - Ga 2 O 3 capas, respectivamente (Fig. 8). El dispositivo con un n - de 2580 nm de espesor - Ga 2 O 3 La capa mostró un alto voltaje de ruptura de 855 V y una resistencia de encendido de 0,4 mΩ cm 2 . Mientras que el dispositivo con un n - más delgado (430 nm) - Ga 2 O 3 Los SBD de capa exhibieron una resistencia muy baja de 0.1 mΩ cm 2 y una tensión de ruptura de 531 V. En 2018, informaron además este tipo de dispositivo realizado con un paquete TO220 [67]. Se obtuvo una capacitancia de unión de 130 pF, por lo que el dispositivo mostró una mejor característica de recuperación inversa en comparación con SiC SBD y Si SBD. Al mismo tiempo, después del paquete, el dispositivo exhibió una resistencia térmica de 13,9 ° C / W, comparable a la del SiC SBD con el mismo paquete (12,5 ° C / W), lo que demuestra que la adopción de una capa delgada de deriva puede compensar eficazmente el desventaja de la mala conductividad térmica de Ga 2 O 3 material. En este informe, los autores también señalaron que α - (Rh, Ga) 2 O 3 puede actuar como una capa de canal de tipo p eficaz de α -Ga 2 O 3 dispositivos.

Procesos de fabricación del α -Ga 2 O 3 SBD propuesto por FLOSFIA Inc. Reimpreso de la ref. [18, 67]
En 2017, K. Konishi et al. en NTIC informó un Pt / HVPE-n - - Ga 2 O 3 / (001) n + - Ga 2 O 3 Dispositivo SBD con un voltaje de ruptura de 1076 V y una resistencia de encendido de 5,1 mΩ cm 2 (Figura 9) [68]. La ingeniería de placa de campo (FP), un tipo de tecnología de terminación de borde, se utilizó por primera vez en Ga 2 O 3 SBD. Añadiendo un ánodo conectado SiO 2 FP, el campo eléctrico máximo en toda la estructura del dispositivo se mantuvo por debajo del campo crítico, especialmente el campo eléctrico alrededor del ánodo obviamente se puede disminuir. Empleando este método, se pueden lograr tanto un voltaje de ruptura alto como una resistencia de encendido baja. En el mismo año, J. Yang, et al. de la Universidad de Florida en su dispositivo SBD con Ni / MOCVD-n - - Ga 2 O 3 / (- 201) n + - Ga 2 O 3 estructura [69], pero la resistencia de encendido es muy grande (25 mΩ cm 2 ). No se utilizó terminación de borde. Su investigación mostró que el tamaño del electrodo Schottky influyó en el voltaje de ruptura y en la resistencia porque el electrodo más grande tendría más defectos y conduciría a una ruptura más fácil.
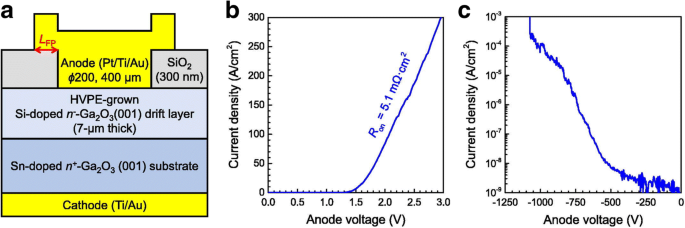
un Estructura del SBD con placa de campo. b , c Características eléctricas de avance y retroceso ( V br =1076 V). Reimpreso de ref. [68]
En 2017, K. Sasaki et al. from Novel Crystal Technology Inc. first fabricated β -Ga2 O 3 SBD with trench termination structure (Fig. 10) [70]. By adopting this kind of structure, the electric field in the Schottky junction can be effectively decreased; thus, the leakage current can be greatly reduced while the forward properties are well maintained. The on-resistance of the device was 2.9 mΩ cm 2 , and the breakdown voltage reached about 240 V. At the same time, the threshold voltage was remarkably reduced compared with the previous reports. This work is a valuable exploration on the advanced fabrication process of Ga2 O 3 SBD. In the 2nd International Workshop on Gallium Oxide and Related Materials (IWGO 2017) held in Italy, they further reported the improved trench SBD. The threshold voltage decreased to 0.5 V. On-resistance was 2.4 mΩ cm 2 , and breakdown voltage was over 400 V. Compared to the commercialized 600 V SiC SBD, the improved trench Ga2 O 3 SBD exhibited superiority in switching loss.
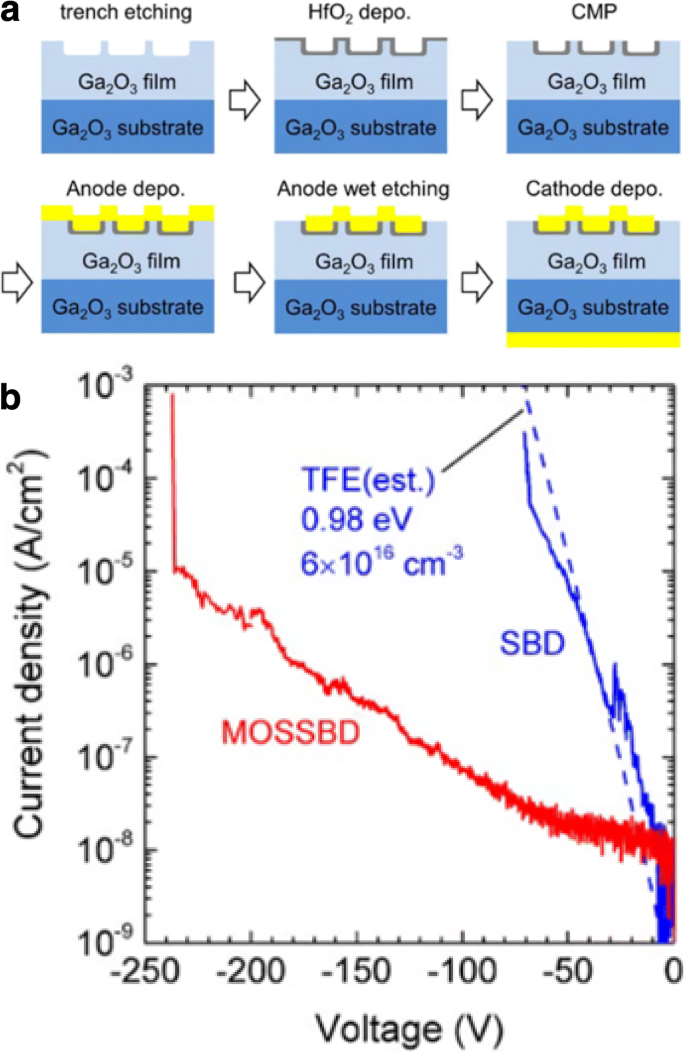
un Fabrication processes of the MOS-type Ga2 O 3 SBD with trench termination structure. b Comparison of the reverse characteristics of the Ga2 O 3 SBDs with and without trenches. Reprinted from ref. [70]
To date, there has been no effective p-type doping in Ga2 O 3 , so bipolar devices are not easy to be realized. In 2017, T. Watahiki et al. from Mitsubishi Electric Corporation reported a heterojunction p-Cu2 O/n-Ga2 O 3 p-n diode without local termination structure [71]. Figure 11 shows the schematic, band diagram and J–V curves of this p-n diode. Pt/Ga2 O 3 SBD was simultaneously fabricated and measured for comparison. The breakdown voltage of the p-n diode reached as high as 1.49 kV. The on-resistance was 8.2 mΩ cm 2 , much lower than that of the SBD with a thick drift layer reported by J. Yang et al. [69]. So, it can be found that bipolar Ga2 O 3 device has a certain advantage over unipolar device in regard to the low on-resistance. This work provides a possible solution for the design Ga2 O 3 -based bipolar devices. However, this p-n diode exhibited a high threshold voltage (1.7 V). Moreover, in bipolar device, there is the minority carrier storage effect. With the improvement of SBD device structure, this p-n diode appears to show significant competitivity in the aspect of 600–1200 V voltage-resistant level and high frequency. It is believed that with the continuous exploration on the materials, SBD might still be a more effective approach for development of the high-voltage Ga2 O 3 device before the successful preparation of p-type Ga2 O 3 .
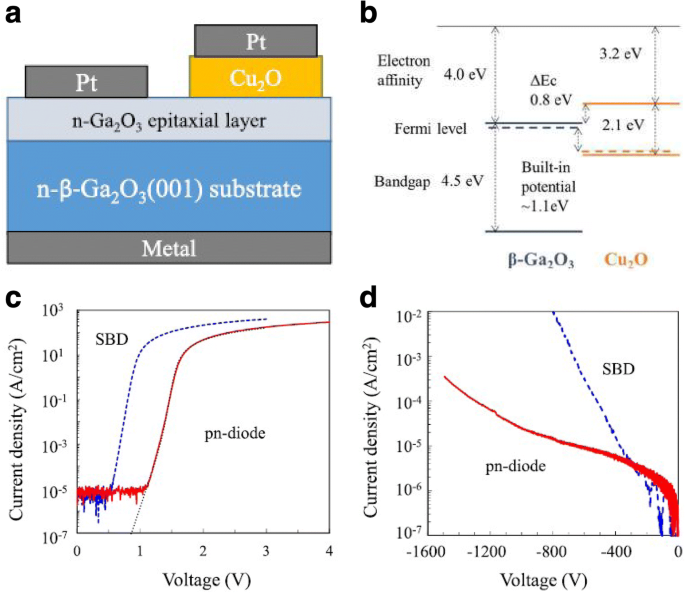
un Schematic of the cross-sectional Pt/Ga2 O 3 SBD and p-Cu2 O/n-Ga2 O 3 diodo. b Band diagram of the p-Cu2 O/n-Ga2 O 3 interfaz. c , d Forward and reverse J–V characteristics of the SBD and p-n diode. Reprinted from ref. [71]
In practical applications, SBD is usually used to rectify the AC or pulse signals as a rectifier in a circuit. It should work at different frequencies. Q. He et al. from IMECAS investigated the rectification characteristics of the Pt/Ga2 O 3 SBD under the AC frequency under 10 kHz to 1 MHz by using a half-wave rectification circuit (Fig. 12) [63]. The testing result proves that the device has the ideal working frequency of 100 kHz, which is equivalent to that of SiC. This work is beneficial for people to further explore how Ga2 O 3 Schottky rectifier can operate at higher frequency and also to construct power circuit modules based on Ga2 O 3 SBD single device.

un Rectification circuit. b - e Rectifying effect of Pt/Ga2 O 3 SBD on the AC signals under frequency of 10 kHz, 100 kHz, 500 kHz, and 1 MHz. Reprinted from ref. [63]
Table 2 lists and compares the basic performance parameters of some typical Ga2 O 3 Schottky barrier diode reported since 2012. From this table, it is apparent that with the improvement of device structure and fabrication processes, the performances are getting better and better.
Conclusiones
Currently, Ga2 O 3 SBD is still in its early stage. With the continuous development of fabrication processes, device structure becomes more and more complicated. At the same time, the improvement of the quality of single-crystal substrates and epitaxial films also significantly push forward device performances. However, to date, the development process of Ga2 O 3 SBD is very similar to those of previous Si SBD and SiC SBD. Furthermore, the research works on the intrinsic properties of Ga2 O 3 materials are still very few. But it is believed that on the basis of its ultrawide bandgap of 4.7–4.9 eV and the development of device structure, Ga2 O 3 will better display its unique application value, which requires the joint efforts of the researchers.
Abreviaturas
- AC:
-
Alternating current
- BFOM:
-
Baliga’s figure of merit
- CVD:
-
Deposición de vapor químico
- EFG:
-
Edge-defined film-fed growth
- FFT:
-
Fast Fourier transform
- FP:
-
Field plat
- FZ:
-
Floating zone
- HRTEM:
-
Microscopía electrónica de transmisión de alta resolución
- HVPE:
-
Halide vapor-phase epitaxy
- IMECAS:
-
Institute of Microelectronics of Chinese Academy of Sciences
- MOCVD:
-
Deposición de vapor químico metalorgánico
- MOSFET:
-
Metal-oxide-semiconductor field-effect transistor
- NICT:
-
National Institute of Information and Communications Technology
- PLD:
-
Pulsed laser deposition
- SBD:
-
Schottky barrier diode
- TE:
-
Emisión termoiónica
- TFE:
-
Thermionic field emission
- WBG:
-
Wide bandgap
- XRD:
-
Difracción de rayos X
Nanomateriales
- Elección de tintes solventes de la mejor calidad para una aplicación perfecta
- Seguimiento de ubicación WiFi:¿Es la tecnología adecuada para su aplicación?
- 10 factores para encontrar el interruptor perfecto para su aplicación
- Aprovechar el poder de las ciudades inteligentes para un futuro más brillante
- En electrónica, India aspira a convertirse en una "fábrica para el mundo"
- La búsqueda de un generador de repuesto:4 preguntas vitales
- Las mejores opciones de fabricación para cajas electrónicas
- Una visión general rápida de las perspectivas del mercado de grúas para los próximos años
- Cómo elegir el generador de energía adecuado para su empresa
- El material de electrodo adecuado para su aplicación de soldadura por resistencia
- Cómo elegir el filtro adecuado para su aplicación



