Diodo Schottky β-Ga2O3 de alto voltaje con terminación de borde implantado con argón
Resumen
Au / Ni / β-Ga 2 con terminación de borde O 3 Los diodos de barrera de Schottky se fabricaron utilizando implantación de argón para formar las capas de alta resistividad en la periferia de los contactos del ánodo. Con la energía de implantación de 50 keV y dosis de 5 × 10 14 cm −2 y 1 × 10 16 cm −2 , la tensión de ruptura inversa aumenta de 209 a 252 y 451 V (el máximo hasta 550 V) y la figura de mérito de Baliga (V BR 2 / R en ) también aumenta de 25,7 a 30,2 y 61,6 MW cm −2 , alrededor de 17,5% y 140% de mejora, respectivamente. De acuerdo con la simulación 2D, los campos eléctricos en la esquina de unión se suavizan después de la implantación de argón y la posición del campo eléctrico de ruptura máxima, 5.05 MV / cm, cambia desde la esquina del ánodo en la interfaz hasta la esquina de superposición justo debajo de la implantación. región. También se investigó la dependencia de la temperatura de las características directas.
Antecedentes
Desarrollo de dispositivos de alta potencia que utilizan materiales semiconductores de banda prohibida ultra ancha como Ga 2 O 3 , AlN, diamante, etc. se está acelerando en los últimos años. La banda prohibida de β-Ga 2 O 3 es tan grande como 4.8–4.9 eV y el campo de ruptura de β-Ga 2 O 3 se estima en 8 MV / cm, aproximadamente tres veces más grande que el de 4H-SiC y GaN. La cifra de mérito de Baliga, 3400, es al menos diez veces mayor que la del 4H-SiC y cuatro veces mayor que la del GaN [1]. Además, el gran monocristal y el β-Ga 2 de bajo costo O 3 el sustrato se puede fabricar con métodos de crecimiento en fusión, tales como zona flotante (FZ) [2] y crecimiento alimentado por película con bordes definidos (EFG) [3, 4]. La densidad de electrones se puede controlar en un amplio rango de 10 16 a 10 19 cm −3 dopando con Sn, Si o Ge [5,6,7]. Estas excelentes propiedades hacen que β-Ga 2 O 3 ideal para aplicaciones de alta potencia, conmutación de alto voltaje y baja pérdida, incluido el diodo de barrera Schottky (SBD) de alto voltaje de ruptura y el transistor de efecto de campo semiconductor de óxido metálico (MOSFET) [8,9,10,11,12] . Los diodos de barrera Schottky poseen las ventajas de una velocidad de conmutación rápida y una caída de voltaje directa baja en comparación con el diodo de unión p-n, lo que puede disminuir la pérdida de energía y mejorar la eficiencia de las fuentes de alimentación.
Aunque se han obtenido grandes voltajes de ruptura de 1016 V, 2300 V y 1600 V en β-Ga 2 O 3 Diodos de barrera Schottky sin terminación de borde, todos están alrededor del 34%, 8% y 10% del valor ideal [10, 13, 14]. Para aliviar el efecto de apiñamiento del campo eléctrico y realizar completamente el potencial de voltaje de β-Ga 2 O 3 , deben diseñarse terminaciones de borde adecuadas. Hay una serie de técnicas de terminación de borde para aumentar el voltaje de ruptura del dispositivo, como placas de campo, anillos metálicos flotantes, estructura MOS de zanja, anillos de protección implantados y extensión de terminación de unión (JTE) [12, 15, 16, 17]. Sin embargo, los anillos de protección implantados y la estructura JTE no son aplicables a Ga 2 O 3 Diodo Schottky debido a la falta de dopaje tipo p. H. Matsunami y BJ Baliga propusieron una estructura de terminación de borde, utilizando la implantación de argón para formar una capa amorfa de alta resistividad en los bordes del ánodo, para reducir el hacinamiento del campo eléctrico [18,19,20,21,22], que es una técnica simple que no requiere multifotolitografía o pasos de grabado profundo en zanjas, y se usa ampliamente en rectificadores de SiC y GaN para suavizar la distribución del campo eléctrico alrededor de la periferia del contacto rectificador [15, 23, 24].
En este artículo, el β-Ga 2 terminado en borde vertical O 3 Los diodos Schottky se fabricaron con implantación de argón en los bordes de los contactos Schottky. Las características de capacitancia-voltaje (C-V) y de densidad de corriente-voltaje (J-V) dependientes de la temperatura se registraron utilizando el sistema de caracterización de semiconductores Keithley 4200 y también se analizó la distribución del campo eléctrico.
Métodos / Experimental
La capa de deriva con un espesor de 10 μm se obtuvo a partir de β-Ga 2 orientado con Sn dopado (100) de alta calidad O 3 sustrato a granel por exfoliación mecánica. El β-Ga 2 O 3 a granel se cultivó mediante la técnica EFG con Ga 2 puro 4 N O 3 polvo como material de partida. La excelente calidad del cristal y la superficie lisa se confirmaron mediante difracción de rayos X de alta resolución (HRXRD) y mediciones con microscopio de fuerza atómica (AFM), como se presenta en la Fig. 1a, b. El ancho completo a la mitad del máximo (FWHM) y la raíz cuadrada media (RMS) se estimaron en 37,4 segundos de arco y 0,203 nm, respectivamente. La Figura 1c muestra la distribución de β-Ga 2 O 3 resistencia de la hoja de sustrato con un espesor de 10 μm mediante una medición de sonda de cuatro puntos. Usando una concentración de portador de (1.3 ± 0.04) × 10 17 cm −3 y resistencia laminar de (563 ± 18,5) Ω / □, la movilidad de los electrones se calcula en 85,3 ~ 95,2 cm 2 / Vs por μ n =1 / (R Hoja × n × q × t ), donde μ n, R Hoja, n , q y t son la movilidad de los electrones, la resistencia laminar, la concentración de electrones, la carga de electrones y el espesor de β-Ga 2 O 3 sustrato, similar a los resultados reportados [25]. Implantación de iones de argón con una energía de 50 keV, la dosis de 2,5 × 10 14 cm −2 y recocido a alta temperatura a 950 ° C durante 60 min en N 2 La atmósfera se realizó primero en la parte posterior, seguida de la evaporación con haz E de una pila de metal óhmico de Ti / Au (20 nm / 100 nm) y un recocido térmico rápido a 600 ° C durante 60 s en N 2 ambiente. Luego se utilizó el fotorresistente de 2 μm de espesor como máscara para la implantación de argón a temperatura ambiente con una energía de 50 keV y la dosis de 5 × 10 14 cm −2 (muestra B) y 1 × 10 16 cm −2 (muestra C), respectivamente. Para reparar el daño de la implantación y reducir la corriente de fuga bajo polarización inversa, las muestras implantadas se sometieron a un recocido térmico rápido a 400 ° C durante 60 s bajo N 2 ambiente [13, 26]. Finalmente, los electrodos circulares de ánodo de Schottky con un diámetro de 100 μm se fabricaron en la parte frontal mediante un patrón fotolitográfico estándar, evaporación de Ni / Au (30 nm / 200 nm) pila y despegue. También se fabricó el dispositivo de referencia sin implante de argón (muestra A). La Figura 2a muestra el TEM de sección transversal de Ga 2 fabricado O 3 Diodo Schottky con terminación de borde implantada con argón. Un β-Ga 2 amorfo casi superficial O 3 Se creó una capa en la región de implantación. La fotografía real del β-Ga 2 terminado O 3 El diodo Schottky se muestra en la Fig. 2b. La Figura 2c representa la configuración de medición de corriente directa-voltaje ( I - V ) características del β-Ga 2 O 3 SBD, mientras que el voltaje de medición varía entre 0 y 3 V y el paso es de 10 mV. La Figura 2d muestra la configuración de medición de voltaje-corriente inversa ( I - V ) características de β-Ga 2 O 3 Rectificadores Schottky para obtener el voltaje de ruptura, mientras que el voltaje de medición varía entre 0 y - 500 V y el paso es - 1 V.

un Curva oscilante XRD y b Imagen AFM del β-Ga 2 O 3 capa de deriva exfoliada mecánicamente de (100) β-Ga 2 O 3 sustrato c resistencia de hoja medida de 10 mm × 10 mm β-Ga 2 O 3 sustrato
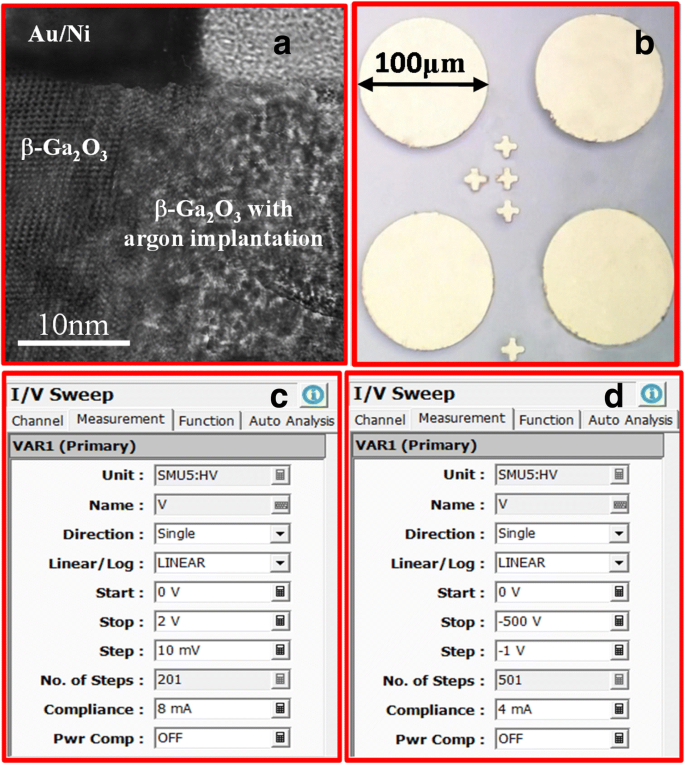
un Imagen TEM de la muestra C y b fotografía del β-Ga 2 terminado O 3 Diodo Schottky c la configuración de medición de corriente directa y d Características de corriente-voltaje inversa (I-V) del β-Ga 2 O 3 SBD para obtener la tensión de ruptura
Resultados y discusión
La figura 3 muestra el 1 / C experimental 2 versus V características de tres muestras de SBD a temperatura ambiente. La concentración de portador efectiva N d - N a de β-Ga 2 O 3 capa de deriva y potencial incorporado ( eV bi ) se extraen para ser (1,3 ± 0,04) × 10 17 cm −3 y (1,30 ± 0,08) eV, respectivamente. De acuerdo con las siguientes ecuaciones, la altura de la barrera de Schottky φ b_CV se calcula que es (1,32 ± 0,08) eV.
$$ \ frac {1} {C ^ 2} =\ frac {2} {q \ varepsilon {A} ^ 2 \ left ({N} _d- {N} _ {\ mathrm {a}} \ right)} \ left ({V} _ {bi} -V \ right) $$ (1) $$ e {\ varphi} _b ={eV} _ {bi} + \ left ({E} _c- {E} _f \ derecha) -e \ Delta \ varphi $$ (2) $$ {E} _c- {E} _f =kT \ ln \ left (\ frac {N_c} {N_d- {N} _a} \ right) $$ ( 3) $$ e \ Delta \ varphi ={\ left \ {\ frac {e} {4 \ pi \ varepsilon} {\ left [\ frac {2 {eV} _ {bi} \ left ({N} _d- {N} _a \ right)} {\ varepsilon} \ right]} ^ {1/2} \ right \}} ^ {1/2} $$ (4)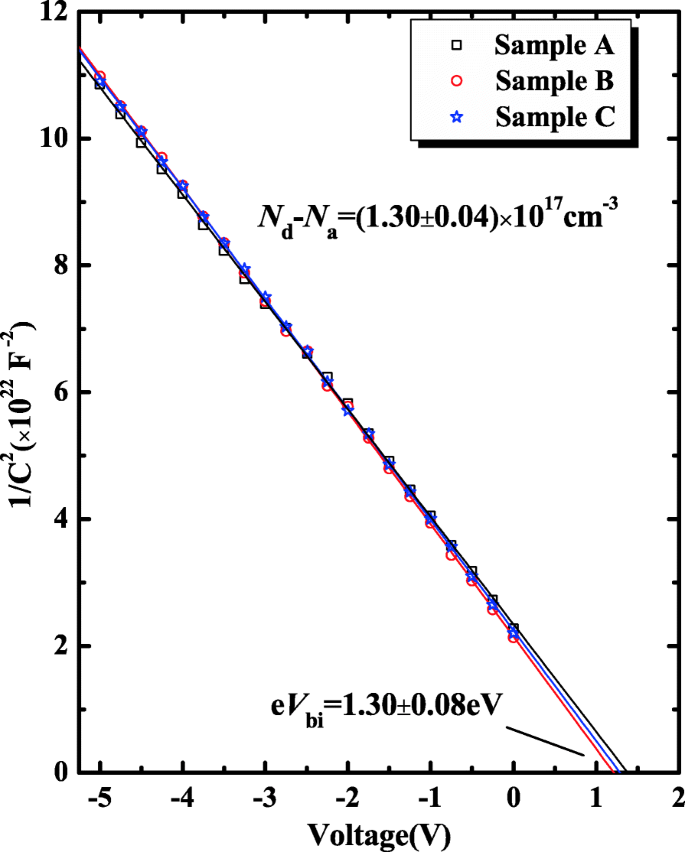
1 / C 2 - V parcelas de tres β-Ga 2 O 3 Muestras SBD
donde A , q y ε son el área de contacto de Schottky, la carga de electrones y la permitividad de β-Ga 2 O 3 . E c , E f , eΔφ , k , T y N c son el mínimo de la banda de conducción, el nivel de Fermi, la disminución de la barrera potencial causada por la fuerza de la imagen, la constante de Boltzmann, la temperatura absoluta en K y la densidad efectiva de estados de la banda de conducción, respectivamente.
La figura 4a representa la densidad-voltaje de corriente directa ( J - V ) características del β-Ga 2 O 3 SBD. Bajo la polarización directa, la implantación de argón no tiene un efecto significativo sobre las características eléctricas. Se determina que el voltaje de umbral es 0.91 V, 0.92 V y 0.95 V para tres muestras, el I en / Yo desactivado todas las proporciones son superiores a 10 9 a temperatura ambiente y ajustando la región lineal, las resistencias específicas ( R en ) son 1,7,2,1 y 3,3 mΩ cm 2 y las densidades de corriente directa a 2 V son 857, 699 y 621 A / cm 2 para tres muestras, respectivamente, como se muestra en la Figura 4a insertada. Las densidades de corriente son más altas y las resistencias de encendido específicas son más bajas o comparables a los valores reportados para la conductividad y densidad de portadora más altas en la capa de deriva [12, 13, 26,27,28,29,30].
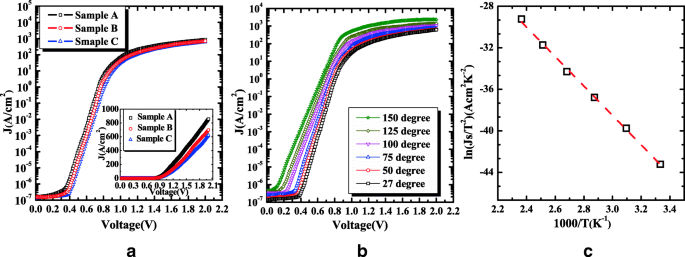
un El delantero J - V características del β-Ga 2 terminado y no terminado O 3 a temperatura ambiente y b el avance J dependiente de la temperatura - V características de la muestra C de 300 a 423 K. c La trama de Richardson de ln ( J s / T 2 ) frente a 1000 / T de la muestra C
Para investigar los efectos de la implantación de argón sobre la dependencia de la temperatura de las características directas, la direccional J - V las mediciones de la muestra C se realizan de 300 a 423 K, como se muestra en la Fig. 4b. El factor ideal n y la altura de la barrera de Schottky φ b_JV se determina que son 1.06 y 1.22 eV a temperatura ambiente, más bajo que el φ b_CV de (1,32 ± 0,08) eV, según el modelo de emisión termoiónica (TE) [31, 32]. Con el aumento de temperatura, el n disminuye de 1.06 a 1.02 y la altura de la barrera se reduce ligeramente pero es casi constante a 1.21 ± 0.01 eV sobre el rango de temperatura, lo cual es contrario a la disminución de la altura de la barrera de un diodo Schottky ideal con aumento de temperatura, pero se ha observado en β-Ga fabricado 2 O 3 SBD [26]. Usando la ecuación ln ( J s / T 2 ) =Ln (A *) - q ϕ b / kT , la altura de la barrera ϕ b y la constante de Richardson efectiva A * se determina en 1,22 eV y 48,5 A / cm 2 K 2 para la muestra C de la pendiente y la y intersección del eje de la región lineal del gráfico, como se muestra en la Fig. 4c. Además, los valores A * extraídos para decenas de dispositivos en las tres muestras están entre 24 y 58 A / cm 2 K 2 , de acuerdo con los resultados del experimento anterior y el valor teórico, 24–58 A / cm 2 K 2 , con la masa de electrones efectiva m * =0,23–0,34 m 0 de β-Ga 2 O 3 [33,34,35,36,37].
La Figura 5a muestra la J inversa - V características de las muestras. Después de la implantación del argón, el voltaje de ruptura aumenta de 209 a 252 y 451 V y la cifra de mérito de Baliga (V BR 2 / R en ) para tres muestras son aproximadamente 25,7, 30,2 y 61,6 MW cm −2 , respectivamente. Durante la implantación, pueden introducirse algunos defectos y dar lugar a un aumento significativo e indeseable de la corriente de fuga, que también se informó en los dispositivos de diodo Schottky de SiC y GaN [18,19,20]. Aunque el recocido térmico se realizó después de la implantación del argón, todavía existen corrientes de fuga ligeramente mayores para las muestras B y C. Por lo tanto, el detalle de la investigación de la temperatura y la duración del recocido posterior en las características eléctricas directas e inversas se deben abordar en el siguiente artículo.

un El reverso J - V características del β-Ga 2 O 3 muestras a temperatura ambiente. b y c Distribución de voltajes de ruptura de β-Ga 2 O 3 SBD con y sin implantación de argón
La Figura 5b, c presenta la distribución de los voltajes de ruptura de β-Ga 2 O 3 Rectificadores Schottky con y sin implantación de argón. Los voltajes de ruptura en paralelo en el plano ideal de estos dispositivos se determinan como 553 ~ 598 V, utilizando el campo eléctrico crítico de 5,1 ~ 5,3 MV / cm [11, 39]. El voltaje de ruptura sin implantación de argón es de aproximadamente 110 ~ 310 V, que es alrededor del 50% de los valores ideales. Sin embargo, con una dosis de implantación de argón de 5 × 10 14 cm −2 , el voltaje de ruptura aumenta a 150 ~ 350 V, no mucho más grande que el dispositivo de referencia, mientras que con la dosis de 1 × 10 16 cm −2 , la tensión de ruptura se acerca a los valores ideales. En este trabajo se puede obtener la tensión máxima de ruptura de 550 V. Además, se simuló la distribución del campo eléctrico a la tensión de ruptura. Para simplificar, se agregó un solo nivel de aceptor de intervalo medio con la profundidad de implantación de 50 nm determinada por la simulación TRIM y también se consideró el modelo de ionización incompleto [38], como se muestra en la Fig. 6. Obviamente, la capa de alta resistividad suaviza efectivamente campo eléctrico en las esquinas de unión y mejora enormemente el voltaje de ruptura en comparación con la muestra de referencia. Los campos eléctricos máximos a voltaje de ruptura son todos de aproximadamente 5.05 MV / cm, similar a los resultados reportados [11, 39], mientras que la posición cambia desde la esquina del ánodo en la interfaz hasta la esquina de superposición justo debajo de la región de implantación, como se indica en Fig. 6d, e.
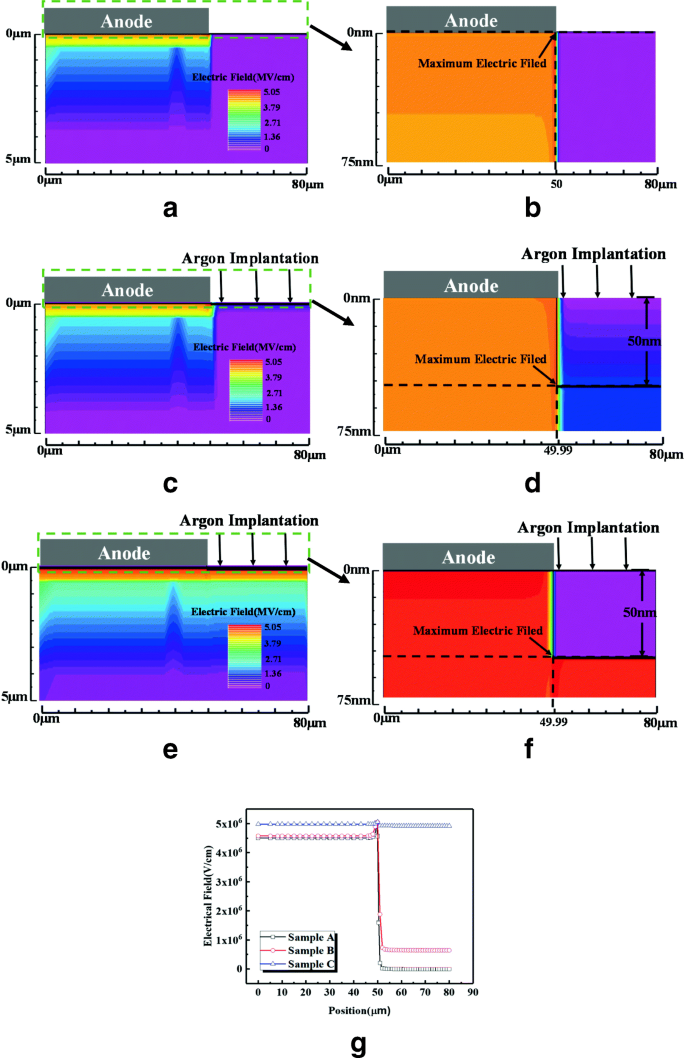
Simulación de la distribución del campo eléctrico a la tensión de ruptura de las muestras A – C ( a , c , e ), la imagen ampliada de las regiones seleccionadas en un cuadro de guiones ( b , d , f , g ), el campo eléctrico simulado frente a la posición a lo largo de la línea discontinua en ( b , d , f ) para tres muestras, Au / Ni / β-Ga 2 O 3 interfaz para la muestra A, 50 nm por debajo de la interfaz para las muestras B y C, respectivamente. El campo máximo es 5.05 MV / cm
Conclusiones
Vertical Au / Ni / β-Ga 2 O 3 Se fabricaron diodos de barrera Schottky con terminación de borde formada por implantación de argón en β-Ga 2 O 3 capa de deriva exfoliada mecánicamente de β-Ga 2 de alta calidad (100) orientado O 3 sustrato a granel. En comparación con el dispositivo de control, las resistencias de encendido específicas ( R en ) aumenta de 1,7 a 2,1 y 3,3 mΩ cm 2 y el voltaje de ruptura aumenta de 209 a 252 y 451 V para una dosis de implantación de 5 × 10 14 cm −2 y 1 × 10 16 cm −2 , respectivamente, con una corriente de fuga inversa mayor. El campo eléctrico máximo a la tensión de ruptura es de aproximadamente 5,05 MV / cm, mucho mayor que el de SiC y GaN.
Abreviaturas
- AFM:
-
Microscopio de fuerza atómica
- EFG:
-
Crecimiento alimentado por película con bordes definidos
- FWHM:
-
El ancho completo a la mitad del máximo
- FZ:
-
Zona flotante
- HRXRD:
-
Difracción de rayos X de alta resolución
- JTE:
-
Extensión de terminación de cruce
- MOSFET:
-
Transistor de efecto de campo semiconductor de óxido metálico
- RMS:
-
Raíz cuadrada media
- SBD:
-
Diodo de barrera Schottky
- TE:
-
Emisión termoiónica
Nanomateriales
- ST impulsa la IA a los dispositivos embebidos de nodo y de borde con la caja de herramientas para desarrolladores de redes neuronales STM32
- ept:Conector de tarjeta de borde SMT de alta velocidad con paso de 0,8 mm
- Future Electronics:micrófono MEMS de CUI con calidad de audio mejorada
- Advantech lleva la computación acelerada desde la nube al borde con NVIDIA
- ADLINK:implemente AI desde el borde hasta la nube con Edge AI Solutions y la plataforma NVIDIA EGX
- ADLINK debuta con una logística más rápida y precisa con Edge IoT Smart Pallet Experience
- Cisco une el perímetro empresarial e industrial con nuevos enrutadores
- Actualización de Industry 4.0 con análisis de borde
- Avanzando en Edge Computing, la IIC se une a OpenFog
- Robots de patrulla inteligentes 5G equipados con la computadora de vanguardia de Advantech empleados para combatir el coronavirus
- Cómo comenzar con la inferencia de IA en el perímetro



